Hochleistungs-AlGaN-Doppelkanal-HEMTs mit verbesserter Drainstromdichte und hoher Durchbruchspannung
Zusammenfassung
In dieser Arbeit wird eine AlGaN-Doppelkanal-Heterostruktur vorgeschlagen und durch metallorganische chemische Gasphasenabscheidung (MOCVD) gezüchtet, und es werden Hochleistungs-AlGaN-Doppelkanaltransistoren mit hoher Elektronenmobilität (HEMTs) hergestellt und untersucht. Die Implementierung des Doppelkanalmerkmals verbessert effektiv die Transporteigenschaften von AlGaN-Kanal-Heterostrukturen. Einerseits wird die gesamte zweidimensionale Elektronengas-(DEG)-Dichte aufgrund der doppelten Potentialsenken entlang der vertikalen Richtung und der erhöhten Ladungsträgereinschließung gefördert. Andererseits wird die durchschnittliche 2DEG-Dichte in jedem Kanal verringert, und die Mobilität wird aufgrund der Unterdrückung des Träger-Träger-Streueffekts erhöht. Dadurch wird die maximale Drainstromdichte (I max ) von AlGaN-Doppelkanal-HEMTs erreicht 473 mA/mm bei einer Gatespannung von 0 V. Darüber hinaus wird auch die überlegene Durchbruchleistung der AlGaN-Doppelkanal-HEMTs demonstriert. Diese Ergebnisse zeigen nicht nur das große Anwendungspotenzial von AlGaN-Doppelkanal-HEMTs in der Mikrowellen-Leistungselektronik, sondern entwickeln auch ein neues Denken für die Untersuchung von Gruppe-III-Nitrid-basierten elektronischen Geräten.
Einführung
Gruppe-III-Nitrid-basierte Transistoren mit hoher Elektronenmobilität (HEMTs) wurden aufgrund ihrer schnellen Schaltgeschwindigkeit und ihres geringen Schaltverlusts als der vielversprechendste Kandidat für die Mikrowellen-Leistungselektronik der nächsten Generation identifiziert [1,2,3,4,5] . In letzter Zeit haben die fortschrittlichsten Nitrid-HEMTs eine anfängliche Kommerzialisierung bis zu 650 V erreicht. Mit der Reife der Bauelementeherstellungstechnologie wurde es jedoch immer schwieriger, die Durchbruchspannungen (V b ) und verbessert die Gerätezuverlässigkeit bei hohen Temperaturen. Angesichts der größeren Bandlücke und der überlegenen thermischen Stabilität von AlGaN gegenüber GaN wurden daher AlGaN-Kanalbauelemente als vielversprechende Kandidaten vorgeschlagen, um die Leistungsgrenzen von Nitrid-HEMTs in Hochspannungs- und Hochtemperaturanwendungen weiter zu verbessern [6,7,8 ,9,10,11,12,13,14,15].
Nanjoet al. demonstrierten die bemerkenswerte Erhöhung der Durchbruchspannung von AlGaN-Kanal-HEMTs, und die erhaltenen maximalen Durchbruchspannungen betrugen 1650 V in der Al0,53 Ga0,47 N/Al0,38 Ga0,62 N HEMTs mit den Gate-Drain-Abständen von 10 μm [6]. Danach haben Nanjo et al. die Durchbruchspannung des Al0,40 . weiter gefördert Ga0.60 N/Al0,15 Ga0,85 N-HEMTs bis 1700 V [8]. Zhanget al. stellten die AlGaN-Kanal-HEMTs mit einem neuartigen Ohmschen/Schottky-Hybrid-Drain-Kontakt her, und für die AlGaN-Kanal-HEMTs wurde eine rekordhohe Durchbruchspannung von mehr als 2200 V erreicht [11]. Xiaoet al. schlugen die AlGaN-Kanal-Heterostrukturen mit einer hohen 2DEG-Mobilität von 807 cm 2 . vor /V·s und die Aufzeichnungen des maximalen Drainstroms und Ion /Iaus Verhältnis wurden für die hergestellten AlGaN-Kanal-HEMTs berichtet [14]. Danach haben Xiao et al. schlugen zum ersten Mal die selbstsperrenden HEMTs mit Übergitter-AlGaN-Kanalschicht vor, und die hergestellten Bauelemente zeigten eine Durchbruchspannung von über 2000 V, eine hohe Einschaltstromdichte von 768 mA/mm und eine Schwellenspannung (V T ) von 1,0 V [15]. Kürzlich haben Baca et al. bewertete die Hochfrequenzleistung (HF) von AlGaN-Kanal-HEMTs mit 80 nm langem Gate. Das fT von 28,4 GHz und fMAX von 18,5 GHz wurden aus Kleinsignal-S-Parameter-Messungen ermittelt [12]. Diese Ergebnisse veranschaulichen das Versprechen von AlGaN-Kanal-HEMTs für HF-Leistungsanwendungen.
Die Einschränkungen der zuvor beschriebenen AlGaN-Kanal-Bauelemente sind jedoch ebenso offensichtlich. Einerseits ist aufgrund des ungeordneten Streueffekts der ternären Legierung die zweidimensionale Elektronengas-(2DEG)-Mobilität im AlGaN-Kanal viel geringer als die im GaN-Kanal. Als Ergebnis ist die Stromtreiberkapazität von AlGaN-Kanal-Bauelementen viel geringer als die von herkömmlichen GaN-Kanal-Bauelementen. Andererseits sollte, um die gleiche Menge an 2DEG im AlGaN-Kanal zu induzieren, die AlN-Komponente in der AlGaN-Barriereschicht höher sein als die von herkömmlichen GaN-Kanal-Heterostrukturen, was die Schwierigkeiten beim Materialwachstumsprozess erhöht. Diese Widersprüche hemmen ernsthaft die weit verbreitete Anwendung von AlGaN-Kanal-Bauelementen, und die Optimierungen des Heterostruktur-Layouts sind dringend erforderlich.
Die Doppelkanaltechnik ist ein faszinierender Ansatz zur Förderung der Kanalträgerdichte von nitridbasierten Heterostrukturen ohne nachteilige Auswirkungen auf die Elektronenmobilität, und die Stromleitfähigkeit der Bauelemente wird verbessert [16,17,18]. Allerdings gab es bisher nur wenige Berichte über AlGaN-Doppelkanal-Heterostrukturen oder Elektronenvorrichtungen. In dieser Arbeit wird zum ersten Mal eine AlGaN-Doppelkanal-Heterostruktur vorgeschlagen und gezüchtet, um die Widersprüche zwischen der Stromtreiberfähigkeit und der Durchschlagsleistung von Nitrid-basierten Elektronenbauelementen aufzulösen. Darüber hinaus werden Hochleistungs-AlGaN-Doppelkanal-HEMTs basierend auf der neuartigen Heterostruktur hergestellt und im Detail untersucht.
Methoden
Das Querschnittsschema der AlGaN-Doppelkanal-Heterostruktur ist in 1a gezeigt und die Wachstumsprozesse können wie folgt zusammengefasst werden. Zuerst wurde eine 1600 nm GaN-Pufferschicht auf dem Saphirsubstrat aufgewachsen. Dann wurde eine 500 nm abgestufte AlGaN-Pufferschicht mit einer AlN-Zusammensetzung, die von 0 auf 10 % zunahm, gezüchtet, was vorteilhaft war, um die Bildung von parasitären Kanälen zu unterdrücken. Danach wurden nacheinander ein 100 nm unterer AlGaN-Kanal, eine 1 nm AlN-Zwischenschicht und eine 23 nm untere AlGaN-Barriere aufgewachsen, und die AlN-Zusammensetzungen in den Kanal- und Sperrschichten betragen 10 % bzw. 31 %. Schließlich wurden ein 30 nm oberer AlGaN-Kanal, eine 1 nm AlN-Zwischenschicht und 23 nm obere AlGaN-Barriereschichten gezüchtet, wobei die Zusammensetzungen die gleichen wie bei den unteren Schichten waren. Das Leitungsbanddiagramm der AlGaN-Doppelkanal-Heterostruktur kann durch selbstkonsistentes Lösen der eindimensionalen Poisson-Schrödinger-Gleichung berechnet werden, die die Finite-Differenzen-Methode mit ungleichmäßiger Maschenweite verwendet [19]. Das Leitungsbanddiagramm und die extrahierte Elektronendichteverteilung der AlGaN-Doppelkanal-Heterostruktur sind in Fig. 2a dargestellt, und die Ergebnisse der AlGaN-Einzelkanal-Heterostruktur sind auch in Fig. 2b für die Zusammensetzung angegeben. An der Grenzfläche von AlN-Zwischenschichten und Al0,10 . werden zwei tiefe Potentialtöpfe gebildet Ga0,90 N-Kanal-Schichten für die AlGaN-Doppelkanal-Heterostruktur, die den doppelten 2DEG-Kanälen entsprechen. Außerdem ist zu beobachten, dass die 2DEG-Dichte im oberen Kanal höher ist als im unteren Kanal, was durch zwei Aspekte erklärt werden kann. Einerseits wirkt die untere AlGaN-Barriere als Rückbarriere des oberen Kanals, was die 2DEG-Eingrenzung des oberen Kanals begünstigt. Andererseits sind die Donor-ähnlichen Oberflächenzustände [20] die Hauptquelle des Kanals 2DEG in Nitrid-Heterostrukturen, die näher am oberen Kanal liegen.
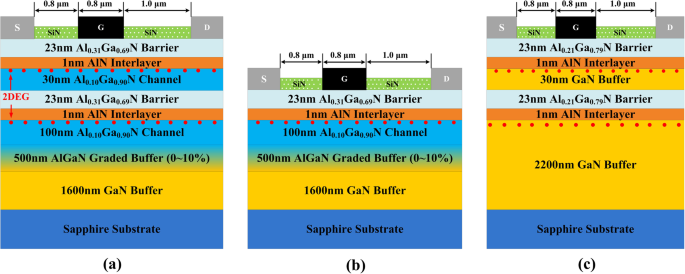
Querschnittsansicht (nicht maßstabsgetreu) von a AlGaN-Doppelkanal, b AlGaN-Einzelkanal und c GaN-Doppelkanal-Heterostrukturen (HEMTs)
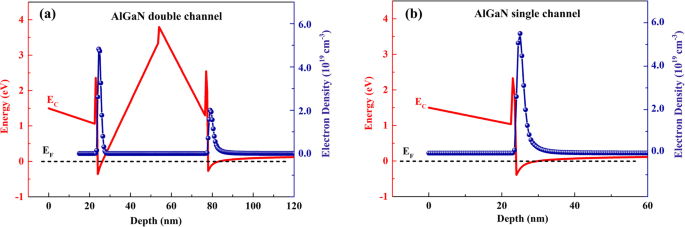
Leitungsbanddiagramme und Elektronendichteverteilungen von AlGaN-Doppelkanal- und Einzelkanal-Heterostrukturen
Ergebnisse und Diskussion
Abbildung 3 zeigt das hochauflösende Röntgenbeugungs-(HRXRD)-ω-2θ-Scan-Ergebnis der AlGaN-Doppelkanal-Heterostruktur aus symmetrischer (0004) Reflexion. Die Beugungsintensität der AlN-Keimbildungsschicht, des GaN-Puffers, des abgestuften AlGaN-Puffers, des AlGaN-Kanals und der AlGaN-Barriereschichten kann beobachtet werden. Darüber hinaus ist der Spektralscan von 71,0 bis 73,2° in Fig. 2b mit einer Vergrößerung zur Deutlichkeit dargestellt, und die Lorentz-Funktion wird angewendet, um die Multipeaks anzupassen. Die Beugungspeaks von GaN-Puffer, AlGaN-Kanal und AlGaN-Barriere liegen bei 71,6°, 72,2° und 72,8°, und der AlGaN-gestufte Puffer führt zu einer Plattform zwischen den Peaks von GaN-Puffer und AlGaN-Kanal. Diese Ergebnisse zeigen die ausgeprägte Mehrschichtstruktur und die ausgeklügelte Kontrolle des Wachstumsprozesses, und die AlN-Zusammensetzungen von 10 % und 31 % im AlGaN-Kanal und in der Barriere können extrahiert werden.

HRXRD (0004) Ebene ω-2θ Scan einer AlGaN-Doppelkanal-Heterostruktur
Die Messung der Kapazitätsspannung (C-V) mit einer Quecksilbersondenkonfiguration wurde durchgeführt, um die Doppelkanaleigenschaften der Heterostruktur zu untersuchen. Wie im Einschub von Abb. 4 gezeigt, können zwei unterschiedliche Kapazitätsstufen bei etwa −2,5 V und −10 V beobachtet werden, wobei die angelegte Spannung von 0 auf −15 V gewobbelt wird, entsprechend der Verarmung von 2DEG bei AlN/Al0,10 Ga0,90 Schnittstellen. Außerdem können die Trägerverteilungseigenschaften aus der C-V-Kurve extrahiert werden, und das Ergebnis ist in Fig. 4 dargestellt. Zwei Trägerkonzentrationspeaks liegen bei 24 und 78 nm mit den Werten von 6,1 × 10 19 und 2,5 × 10 19 cm −3 , was mit dem in Abb. 2 gezeigten berechneten Ergebnis übereinstimmt. Insbesondere kann kein parasitärer Leitungskanal beobachtet werden, bis die Testtiefe 1 μm erreicht, was auf das erfolgreiche Erreichen von Doppelkanaleigenschaften der Heterostruktur schließen lässt. Darüber hinaus wurden die 2DEG-Blattdichte und -mobilität mit 1,3 × 10 13 . bestimmt cm −2 und 1130 cm 2 /V∙s durch die Hall-Effekt-Messung.
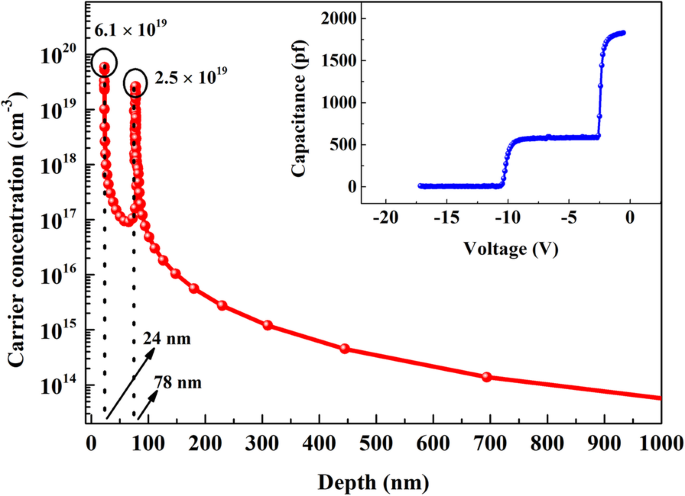
C-V-Eigenschaften und Elektronenverteilungskurve der AlGaN-Doppelkanal-Heterostruktur
Der Standard-HEMTs-Herstellungsprozess wurde auf der AlGaN-Doppelkanal-Heterostruktur durchgeführt. Der Herstellungsprozess der Vorrichtung begann mit einem ohmschen Kontakt, der mit einem mehrschichtigen Ti/Al/Ni/Au-Metallstapel gebildet wurde, der durch Elektronenstrahlverdampfung abgeschieden wurde, gefolgt von einer schnellen thermischen Ausheilung bei 850 °C für 30 s in N2 Atmosphäre. Dann wurde die Mesa-Isolierung durch Cl2 . durchgeführt /BCl3 induktiv gekoppeltes Plasmaätzen bis zu einer Tiefe von 200 nm, und eine 100 nm dicke SiN-Passivierungsschicht wurde durch plasmaunterstützte chemische Gasphasenabscheidung gebildet. Danach wird ein Gate-Bereich mit einer Länge (L G ) von 0.8 μm wurde durch Photolithographie nach dem Ätzen des oberen SiN mit CF4 . definiert Plasma, und dann wurde eine Ni/Au-Schottky-Gate-Elektrode abgeschieden. Die Gate-Source (L GS ) und Gate-Drain (L GD ) die Abstände betragen 0,8 bzw. 1 μm. Zu Vergleichszwecken wurden auch zwei zusätzliche HEMTs-Proben basierend auf den herkömmlichen AlGaN-Einkanal- und GaN-Doppelkanal-Heterostrukturen hergestellt, und die Querschnittsschemata sind in Abb. 1 b und c gezeigt. Der Geräteprozess und die charakteristischen Parameter der zusätzlichen HEMTs-Proben sind bei den AlGaN-Doppelkanal-HEMTs genau gleich. Die Ausgabe- und Übertragungseigenschaften der Geräte wurden mit dem Halbleiterparameteranalysator Keithley 4200 und die Durchschlagseigenschaften mit dem Hochspannungs-Halbleiteranalysatorsystem Agilent B1505A durchgeführt.
Die typischen Ausgangskennlinien der HEMTs sind in Abb. 5 dargestellt, für die die VGS und VDS wurden von 0~− 10 V und 0~10 V gewobbelt. Die maximale Drainstromdichte (I max ) und differentiellem Einschaltwiderstand (R an ) der AlGaN-Einkanalprobe betragen 265,3 mA/mm bzw. 27,1 mm. Diese Ergebnisse stimmen mit den vorherigen Berichten überein, was auf den Mangel von AlGaN-Kanal-HEMTs in der Stromtreiberkapazität hindeutet. Für die AlGaN-Doppelkanal-HEMTs ist das I max steigt dramatisch auf 473 mA/mm an, was 1,8-mal höher ist als bei AlGaN-Einkanal-HEMTs. Wir schreiben die Verbesserung in I . zu max zu den überlegenen Transporteigenschaften der AlGaN-Doppelkanal-Heterostruktur. Einerseits besitzt die Doppelkanalstruktur zwei Potentialsenken entlang der vertikalen Richtung, und die Ladungsträgerspeicherfähigkeit des AlGaN-Leitungskanals wird gefördert. Andererseits wird, obwohl die Gesamtträgerdichte des Kanals erhöht wird, die durchschnittliche Elektronendichte in jedem Kanal verringert. Als Ergebnis wird der Träger-Träger-Streueffekt unterdrückt und die Kanalelektronenmobilität wird erhöht. Es kann jedoch beobachtet werden, dass die R an der AlGaN-Doppelkanal-HEMTs beträgt 12,5 mm, immer noch größer als die der GaN-Doppelkanal-HEMTs. Dieses Phänomen hängt mit der großen Kontaktbarrierehöhe der AlGaN-Barriereschichten zusammen, für die die AlN-Zusammensetzung bis zu 31% beträgt. Aufgrund des Eigenerwärmungseffekts aufgrund der hohen Verlustleistung kann der negative differentielle Widerstandseffekt für die GaN-Doppelkanal-HEMTs beobachtet werden, wenn V GS>− 4 V und V DS> 6 V. Dennoch wird dieser negative differentielle Widerstandseffekt bei den AlGaN-Kanal-HEMTs (sowohl Einkanal- als auch Doppelkanal) deutlich unterdrückt, was die überlegene Leistung von AlGaN-Kanal-HEMTs unter erhöhten Temperaturbedingungen manifestiert.

Ausgangseigenschaften von AlGaN-Doppelkanal-, AlGaN-Einzelkanal- und GaN-Doppelkanal-HEMTs
Abbildung 6 veranschaulicht die typischen Übertragungseigenschaften der HEMTs mit V DS von 10 V. Die AlGaN-Einkanal-HEMTs weisen eine Schwellenspannung (V T ) von − 3,8 V, zusammen mit einer geringeren extrinsischen Spitzentranskonduktanz (G m,max ) von 80,5 mS/mm in der Nähe von V GS =− 1,5 V. Für die AlGaN-Doppelkanal- und GaN-Doppelkanal-HEMTs beträgt die V T fällt deutlich auf −9.2 und −11.2 V ab, was auf die hohe Kanalträgerdichte und den relativ großen Abstand von der Gate-Elektrode zum unteren 2DEG-Kanal zurückzuführen ist. Das hohe V T kann zu einem hohen Leistungsverlust der Bauelemente im ausgeschalteten Zustand führen, und dieses Problem kann verbessert werden, indem die Wachstumsparameter von Doppelkanalstrukturen weiter optimiert werden, beispielsweise durch geeignetes Reduzieren der Dicke der Barriere- und oberen Kanalschichten. Insbesondere können Doppelhöcker-Charakteristiken der Transkonduktanzkurven von AlGaN-Doppelkanal- und GaN-Doppelkanal-HEMTs beobachtet werden. Für die AlGaN-Doppelkanal-HEMTs können zwei Spitzenwerte von 97,9 und 42,5 mS/mm bei V . extrahiert werden G =− 1.0 und − 6.0 V. Der Sub-Peak-Wert erreicht 43% von Gm,max , was die gute Gate-Steuerungsfähigkeit und Linearität der AlGaN-Doppelkanal-HEMTs anzeigt. Darüber hinaus können basierend auf unseren bisherigen Forschungsergebnissen [21] die Ergebnisse durch Modulieren der Strukturparameter, wie Dicke und Zusammensetzung der AlGaN-Doppelkanäle, weiter verbessert und der Kopplungseffekt zwischen den Doppelkanälen und der Gerätelinearität kann verbessert.

Übertragungseigenschaften von AlGaN-Doppelkanal-, AlGaN-Einkanal- und GaN-Doppelkanal-HEMTs
Die Durchbruchseigenschaften der HEMTs auf Basis unterschiedlicher Heterostrukturen werden gemessen und in Abb. 7 gezeigt. Die V b wird durch das Kriterium des Ableitstroms von 5 μA/mm definiert. Es kann beobachtet werden, dass alle drei Proben harte Durchbrucheigenschaften aufweisen und die Durchbruchleistung von AlGaN-Kanal-HEMTs offensichtlich besser ist als die der GaN-Kanal-HEMTs. Das V b der AlGaN-Doppelkanal-HEMTs beträgt 143,5 V, mehr als doppelt so hoch wie die der GaN-Doppelkanal-HEMTs. Mit dem L GD =1 μm berücksichtigt, die V b,standard (definiert durch V b /L GD ) beträgt bei den AlGaN-Doppelkanal-HEMTs bis zu 143,5 V/μm. Das Ich max und V b,standard Die Ergebnisse der AlGaN-Doppelkanal-HEMTs in dieser Arbeit werden mit den GaN-Kanal- und AlGaN-Kanal-HEMTs verglichen, die von anderen Gruppen in 8 berichtet wurden, und die Ergebnisse von Verarmungsmodus-(DM)- und Anreicherungsmodus-(EM)-Bauelementen werden unterschieden. Darüber hinaus sind die Kernindizes der AlGaN-Kanal-HEMTs (Heterostrukturen) in früheren Berichten und dieser Arbeit in Tabelle 1 zusammengefasst. Wie Abb. 8 zeigt, ist es offensichtlich, dass die Durchbruchsleistung von AlGaN-Kanal-HEMTs im Allgemeinen besser ist als die von GaN Kanal-HEMTs, begleitet von der Verschlechterung des I max . Auffallend ist, dass das Ich max des AlGaN-Doppelkanals in dieser Arbeit ist mit den meisten Ergebnissen der GaN-Kanal-HEMTs vergleichbar. Außerdem ist zu beachten, dass das I max Wert in dieser Arbeit erhält man bei V GS =0 V, was konservativ ist und durch angelegte positive Gatespannung weiter verbessert werden kann. Daher zeigen diese Ergebnisse überzeugend das enorme Potenzial von AlGaN-Doppelkanal-HEMTs in Mikrowellen-Leistungsbauelementen.

Durchbrucheigenschaften von AlGaN-Doppelkanal-, AlGaN-Einkanal- und GaN-Doppelkanal-HEMTs
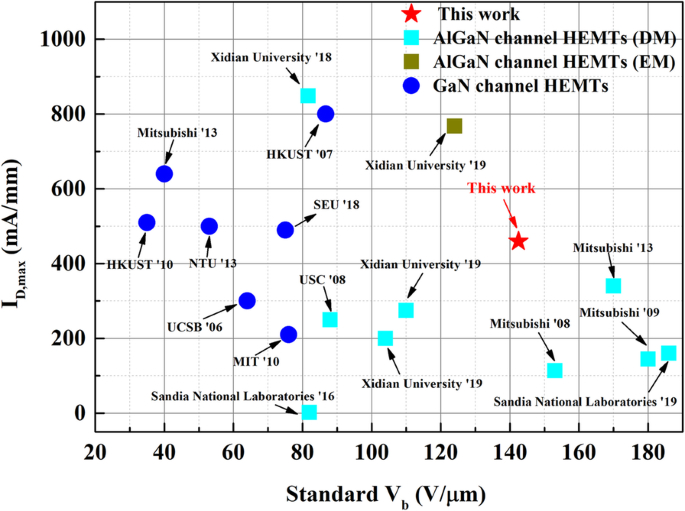
Benchmark von I max und V b,standard für AlGaN-Kanal- und GaN-Kanal-HEMTs
Schlussfolgerungen
Zusammenfassend wird eine AlGaN-Doppelkanal-Heterostruktur vorgeschlagen, um Hochleistungs-HEMTs herzustellen. Die überlegenen Transporteigenschaften der AlGaN-Doppelkanal-Heterostruktur werden offenbart, was zu einer verbesserten Stromtreiberfähigkeit der HEMTs führt. Darüber hinaus wird die hervorragende Durchbruchleistung der AlGaN-Doppelkanal-HEMTs demonstriert. Die Ergebnisse dieser Arbeit zeigen das große Potenzial von AlGaN-Doppelkanalbauelementen in zukünftigen Mikrowellenanwendungen.
Verfügbarkeit von Daten und Materialien
Alle während dieser Studie generierten oder analysierten Daten sind in diesem veröffentlichten Artikel und seinen ergänzenden Informationsdateien enthalten.
Abkürzungen
- MOCVD:
-
Metallorganische chemische Gasphasenabscheidung
- HEMTs:
-
Transistoren mit hoher Elektronenmobilität
- 2DEG:
-
Zweidimensionales Elektronengas
- I max :
-
Maximale Drainstromdichte
- V b :
-
Durchbruchspannung
- V T :
-
Schwellenspannung
- RF:
-
Funkfrequenz
- HRXRD:
-
Hochauflösende Röntgenbeugung
- C-V:
-
Kapazität-Spannung
- L G :
-
Torlänge
- L GS :
-
Gate-Source-Abstand
- L GD :
-
Gate-Drain-Abstand
- R an :
-
Einschaltwiderstand
- G m :
-
Transkonduktanz
- DM:
-
Erschöpfungsmodus
- EM:
-
Verbesserungsmodus
Nanomaterialien
- Spannung und Strom
- Spannung und Strom in einer praktischen Schaltung
- Isolator-Durchbruchspannung
- Kondensatoren und Berechnungen
- Spannungs- und Stromberechnungen
- Komplexe Spannungs- und Stromberechnungen
- Gegeninduktivität und grundlegender Betrieb
- Was ist Pannenwartung und wie man damit umgeht
- Einfluss von Oberflächenzuständen und Aluminium-Molekülfraktion auf das Oberflächenpotential und 2DEG in AlGaN/GaN-HEMTs
- PCB-Materialien und Design für Hochspannung



