ZrOx-Feldeffekttransistor mit negativer Kapazität und Schwingverhalten unter 60 unter der Schwelle
Zusammenfassung
Hier berichten wir über das ZrOx -basierte negative Kapazitäts-(NC)-FETs mit 45,06 mV/Dekade unter dem Schwellenwert (SS) unter ± 1 V V GS Bereich, der neue Möglichkeiten in zukünftigen spannungsskalierbaren NCFET-Anwendungen eröffnen kann. Das ferroelektrische Verhalten von Ge/ZrOx /TaN-Kondensatoren sollen von den Sauerstoff-Leerstellen-Dipolen stammen. Der NC-Effekt des amorphen HfO2 und ZrOx Filmgeräte können durch den plötzlichen Abfall des Gate-Leckstroms, das Phänomen des negativen Differentialwiderstands (NDR), die Erhöhung von I . nachgewiesen werden DS und Sub-60 Subthreshold Swing. 5 nm ZrOx -basierte NCFETs erreichen eine Hysterese von 0,24 V im Uhrzeigersinn, weniger als 60 mV/Dekade SS und einen I . von 12 % DS-Verbesserung im Vergleich zum Kontrollgerät ohne ZrOx . Der unterdrückte NC-Effekt von Al2 O3 /HfO2 NCFET im Vergleich zu ZrOx NCFET steht im Zusammenhang mit dem teilweisen Schalten von Sauerstoffleerstellen-Dipolen beim Vorwärts-Sweepen aufgrund negativer Grenzflächendipole am Al2 O3 /HfO2 Schnittstelle.
Hintergrund
Da sich komplementäre Metalloxid-Halbleiter (CMOS) ständig verkleinern, ist die Technik der integrierten Schaltungen (IC) in die Ära der „mehr als Moore-Ära“ eingetreten. Die treibende Kraft der IC-Industrie und -Technologie wird die Reduzierung des Stromverbrauchs anstelle der Miniaturisierung von Transistoren [1, 2]. Die Boltzmann-Tyrannei der MOSFETs, mehr als 60 mV/Dekade SS, hat jedoch die Energie-/Leistungseffizienz eingeschränkt [3]. In den letzten Jahren haben viele vorgeschlagene neuartige Bauelemente die Fähigkeit, einen Schwellenhub von unter 60 mV/Dekade zu erreichen, einschließlich Stoßionisations-MOSFETs, Tunnel-FETs und NCFETs [4,5,6,7]. Aufgrund der einfachen Struktur, des steilen SS und des verbesserten Ansteuerstroms wurden NCFETs mit einem ferroelektrischen (FE)-Film als attraktive Alternative zu diesen neuen Geräten angesehen [8,9,10]. Die berichteten Experimente an NCFETs umfassen hauptsächlich PbZrTiO3 (PZT), P(VDF-TrFE) und HfZrOx (HZO) [11,12,13,14,15,16,17]. Allerdings haben die hohe Prozesstemperatur und der unerwünschte Gate-Leckstrom entlang der Korngrenzen polykristalliner ferroelektrischer Materialien deren Entwicklung für die hochmodernen Technologieknoten eingeschränkt [18,19,20,21,22,23,24,25 ,26]. Kürzlich Ferroelektrizität in amorphem Al2 O3 und ZrOx Filme, die durch die spannungsmodulierten Sauerstoffleerstellendipole ermöglicht werden, wurden untersucht [27,28,29]. Verglichen mit dem kristallinen Gegenstück haben die amorphen ferroelektrisch-ähnlichen Filme signifikante Vorteile in Bezug auf eine reduzierte Prozesstemperatur und einen reduzierten Leckstrom. Daher gibt es Massenforschungen zu FeFETs mit amorphem Gate-Isolator für den nichtflüchtigen Speicher und analoge Synapsenanwendungen [27, 30, 31, 32, 33, 34]. Die systematische Untersuchung von Eintransistor-ZrOx -basierter NCFET wurde nicht durchgeführt.
In dieser Arbeit werden Ge-NCFETs mit 5 nm ZrOx ferroelektrische dielektrische Schicht und 5 nm Al2 O3 /HfO2 ferroelektrische dielektrische Schichten wurden jeweils vorgeschlagen. Wir haben experimentell einen steilen Anstieg von unter 60 mV/Dekade in ZrOx . beobachtet (5 nm) NCFET, der auf den NC-Effekt von ZrOx . zurückgeführt werden kann ferroelektrische Schicht. Und wir haben die Polarisation analysiert P als Funktion der angelegten Spannung V für Ge/ZrOx /TaN-Kondensatoren. Das ferroelektrische Verhalten von Ge/ZrOx /TaN-Kondensatoren wird durch die spannungsinduzierten Sauerstoff-Leerstellen-Dipole induziert. Darüber hinaus haben wir das verbesserte I DS und der plötzliche Abfall von I G in der Al2 O3 /HfO2 NCFETs und ZrOx NCFETs zum NC-Effekt. Wir haben auch das NDR-Phänomen im Al2 . beobachtet O3 /HfO2 NCFETs und ZrOx NCFETs. Darüber hinaus haben wir den physikalischen Mechanismus des durch Grenzflächendipole induzierten verringerten NC-Effekts im Al2 . weiter analysiert O3 /HfO2 NCFET. Das ZrOx NCFETs mit einer steilen Steilheit von unter 60 mV/Dekade, verbesserter Drainspannung und niedriger Betriebsspannung eignen sich für das Design von NCFETs mit geringem Stromverbrauch in der "more than Moore-Ära".
Methoden
Wichtige Prozessschritte für NCFETs mit ZrOx und Al2 O3 /HfO2 Herstellung sind in Abb. 1a gezeigt. Verschiedene dielektrische Gate-Isolatoren, einschließlich Al2 O3 /amorphes HfO2 (5 nm) Filme und amorphes ZrOx (4,2 nm) Filme wurden auf n-Ge(001)-Substraten durch Atomlagenabscheidung (ALD) bei 300 °C gezüchtet. TMA, TDMAHf, TDMAZr und H2 Als Vorläufer von Al, Hf, Zr bzw. O wurden O-Dampf verwendet. Die Pulszeit und die Spülzeit der Vorläufer von Hf und Zr betragen 1,6 s bzw. 8 s. Die Pulszeit und die Spülzeit der Vorläufer von Al betragen 0,2 s bzw. 8 s. Dann wurde eine TaN-Top-Gate-Elektrode auf HfO2 . abgeschieden oder ZrOx Oberflächen durch reaktives Sputtern. Source/Drain-(S/D)-Bereiche wurden durch lithographisches Mustern und Trockenätzen definiert. Danach Bor (B + ) und Nickel (Ni) wurde in Source/Drain (S/D)-Gebieten abgeschieden. Schließlich schnelles thermisches Tempern (RTA) bei 350 °C für 30 s in einem 10 8 Pa Stickstoffumgebung wurde durchgeführt. Abbildung 1b, d zeigen die schematische Darstellung des hergestellten Al2 . O3 /HfO2 NCFETs und ZrOx NCFETs. Das hochauflösende Transmissionselektronenmikroskop (HRTEM)-Bild in Abb. 1c zeigt das amorphe HfO2 (5 nm) Film auf Ge (001) mit Al2 O3 Grenzflächenschicht. Das HRTEM-Bild in Abb. 1e zeigt das amorphe ZrOx (4,2 nm) Film auf Ge (001). Die C-V-Kurve von ZrOx NCFETs und die Röntgen-Photoelektronenspektren (XPS) von TaN/ZrOx (4,2 nm)/Ge-Kondensatoren wurden in Zusatzdatei 1 gemessen:Abb. S1.
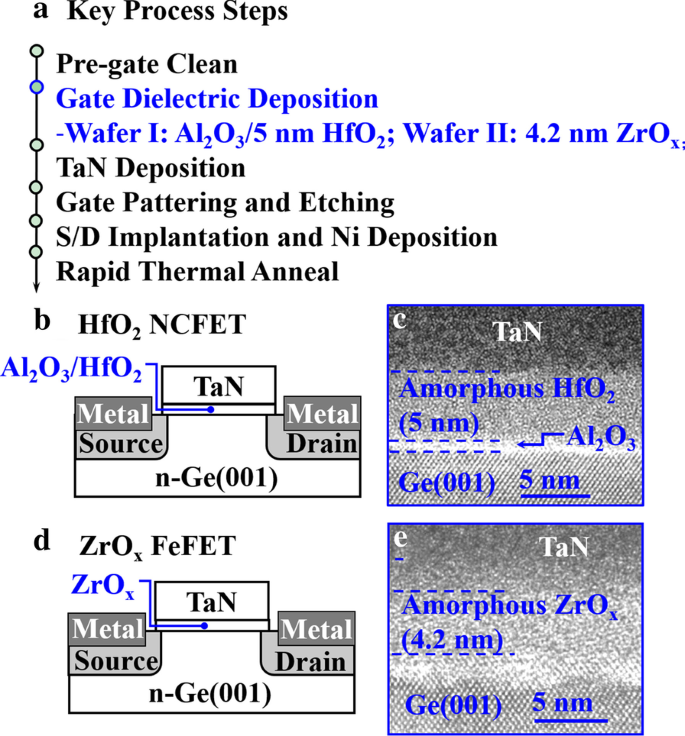
a Wichtige Prozessschritte für die Herstellung des Al2 O3 /5 nm HfO2 NCFETs und 4,2 nm ZrOx NCFETs. b Schaltpläne und c HRTEM-Bilder des hergestellten ZrOx NCFETs. d Schaltpläne und e HRTEM-Bilder des hergestellten Al2 O3 /HfO2 NCFETs
Ergebnisse und Diskussion
Abbildung 2a zeigt die gemessenen Polarisationskurven P vs. angelegte Spannung V Eigenschaften für Ge/ZrOx /TaN-Kondensatoren bei 3,3 kHz. Die Gate-Länge (L G ) der Kondensatoren sind 8 μm groß. Es wird beobachtet, dass die Restpolarisation P r des Ge/ZrOx /TaN-Kondensatoren können mit einem größeren Abtastbereich von V . verbessert werden . Das ferroelektrische Verhalten des amorphen ZrOx Es wird vermutet, dass der Film in Abb. 2a von den spannungsgesteuerten Sauerstoffleerstellendipolen stammt [35]. Abbildung 2b zeigt den gemessenen P–V Kurven für Ge/ZrOx /TaN-Kondensatoren bei verschiedenen Frequenzen von 200 bis 10 kHz. Wir können sehen, dass das ferroelektrische Verhalten des amorphen ZrOx Film bleibt für alle Frequenzen stabil. Die P r des amorphen ZrOx Film wird mit den erhöhten Frequenzen reduziert. Dieses Phänomen kann durch das unvollständige Schalten der Dipole bei hohen Messfrequenzen erklärt werden [36, 37]. Mit zunehmenden Messfrequenzen wird die Zeit für die Richtungsänderung des elektrischen Feldes im amorphen ZrOx Film abnimmt. Daher ist ein Teil des Umschaltens von Sauerstoffleerstellen-Diploen unvollständig, was zu einem verringerten P . führt r .

Gemessener P gegen V Eigenschaften des 4,2 nm ZrOx Kondensatoren mit a verschiedene Kehrbereiche von V und b verschiedene Messfrequenzen
Abbildung 3a zeigt das gemessene I DS –V GS Kurven eines ferroelektrischen Al2 O3 /HfO2 NCFET am V DS von − 0,05 V und − 0,5 V. Das L G der Geräte beträgt 3 μm. Die Hystereseschleifen von 0,14 V (V DS = − 0,05 V, I ds = 1 nA/μm) und 0,08 V (V DS = − 0.5 V, I ds = 1 nA/μm) werden jeweils demonstriert. Die Hystereseschleifen im Uhrzeigersinn werden der Wanderung von Sauerstoffleerstellen und den begleitenden negativen Ladungen zugeschrieben. Die Sauerstoff-Leerstellen-Dipole akkumulieren (verarmen) im Ge/Al2 O3 Schnittstelle unter positiv (negativ) V GS . Daher ist die Schwellenspannung (V TH ) steigt (sinkt) unter Vorwärts- (Rückwärts-) Wobbeln von Gatespannungen. Wie in Fig. 3b gezeigt, sind die Ausgangseigenschaften des Al2 O3 /HfO2 NCFET und der Steuer-FET werden verglichen. Der Sättigungsstrom des Al2 O3 /HfO2 NCFET überschreitet 26 μA/μm, mit einem Anstieg von 23% im Vergleich zum Steuer-FET bei |V GS –V TH | =|V DS |= 0,8 V. Die Stromverstärkung wird durch die erhöhte Inversionsladungsintensität (Q inv ) im elektrischen Feld mit umgekehrter Polarisation und der Verstärkung des Oberflächenpotentials [38, 39]. Zusätzlich zur Stromverstärkung beweist der erhaltene offensichtliche NDR den NC-Effekt des amorphen HfO2 Film. Der NDR-Effekt wird durch das unvollständige Schalten von Sauerstoffleerstellen-Dipolen aufgrund der Kopplung von Drain-Kanal als V . verursacht DS steigt [40, 41]. Abbildung 3c vergleicht die gemessene Gate-Leckage I G –V GS Kurven für das 5 nm Al2 O3 /HfO2 NCFET am V DS von − 0,05 V und − 0,5 V. Der plötzliche Abfall von I G nur während des Rückwärts-Sweeps zeigen die verringerte Spannung im amorphen HfO2 Film und die Verstärkung des Oberflächenpotentials [42]. Das Fehlen des NC-Effekts während des Vorwärts-Sweeps wird durch das partielle Umschalten von Sauerstoff-Leerstellen-Dipolen im amorphen HfO2 . verursacht Film [43]. Die unterschiedliche Fähigkeit, Sauerstoffatome zwischen Al2 . zu enthalten O3 und HfO2 Schicht führt zu Sauerstoffumverteilung und negativen Grenzflächendipolen am Al2 O3 /HfO2 Schnittstelle [44, 45]. Aufgrund des Vorhandenseins negativer Grenzflächendipole ist es für das amorphe HfO2 . schwierig Film, um eine vollständige Polarisationsumschaltung (NC-Effekt) im Vorwärts-Sweep zu realisieren (Zusatzdatei 1).
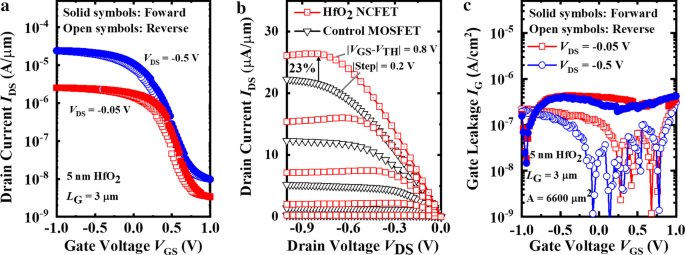
a Gemessen I DS –V GS Kurven des 5 nm-HfO2 NCFET bei V DS = − 0.5 V und V DS = − 0,05 V. b Gemessen I DS –V DS Kurven des HfO2 NCFET und der Steuer-MOSFET. c Gemessen I G –V GS Kurven des 5 nm-HfO2 NCFET bei V DS = − 0.5 V und V DS = − 0,05 V
Abbildung 4a zeigt die gemessenen Übertragungskurven eines ferroelektrischen ZrOx NCFET am V DS von − 0,05 V und − 0,5 V. Das L G der beiden Geräte sind 4 μm groß. Die Hystereseschleifen im Uhrzeigersinn von 0,24 V (V DS = − 0,05 V, I ds = 1 nA/μm) und 0,14 V (V DS = − 0.5 V, I DS = 1 nA/μm) werden jeweils demonstriert. Wie in Abb. 4b gezeigt, sind die Ausgangseigenschaften von ZrOx NCFET und der Steuer-FET werden verglichen. Der Sättigungsstrom des ZrOx NCFET überschreitet 30 μA/μm, mit einem Anstieg von 12 % im Vergleich zum Steuer-FET bei |V GS –V TH | =|V DS |= 1 V. Die verbesserte Stromverstärkung und der deutlichere NDR zeigen den verbesserten NC-Effekt des amorphen ZrOx Film (5 nm) Kontrast zu dem von 5 nm HfO2 Film. Abbildung 4c vergleicht den gemessenen Gate-Leckstrom I G –V GS Kurven für das 5 nm ZrOx NCFET am V DS von − 0,05 V und − 0,5 V. Verglichen mit dem plötzlichen I G Tropfen Al2 O3 /HfO2 NCFET nur während des Rückwärts-Sweeps in Abb. 3c, die plötzlichen Abfalle von I G sowohl beim Vorwärts- als auch beim Rückwärts-Sweepen in Abb. 4c beweisen auch den verstärkten NC-Effekt im amorphen ZrOx filmen.
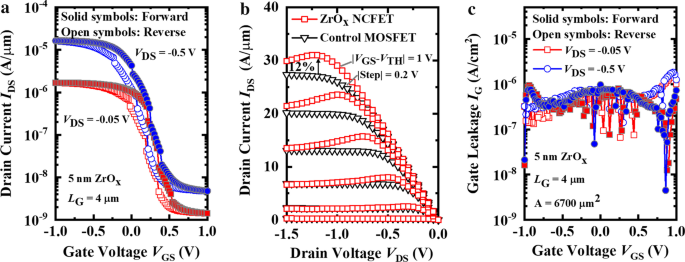
a Gemessen I DS –V GS Kurven des 5 nm ZrOx NCFET bei V DS = − 0.5 V und V DS = − 0,05 V. b Gemessen I DS –V DS Kurven des ZrOx NCFET und der Kontroll-MOSFET demonstrieren das offensichtliche NDR-Phänomen. c Gemessen I G –V GS Kurven des 5 nm ZrOx NCFET bei V DS = − 0.5 V und V DS = − 0,05 V
Abbildung 5a, b zeigt den Punkt SS als Funktion von I DS für die Al2 O3 /HfO2 und ZrOx NCFET am V DS von − 0,05 V und − 0,5 V. Wie in Abb. 5b gezeigt, kann beim Vorwärts- oder Rückwärts-Wobbeln von V . ein Unterschwellenhub (SS) von unter 60 mV/Dekade erreicht werden GS am V DS von − 0,05 V und − 0,5 V. Wenn V DS - 0,05 V, ein Punkt-Vorwärts-SS von 45,1 mV/Dez und ein Punkt-Rückwärts-SS von 55,2 mV/Dez wurden erreicht. Wenn V DS – 0,5 V, ein Punkt-Vorwärts-SS von 51,16 mV/Dez und ein Punkt-Rückwärts-SS von 46,52 mV/Dez wurden erreicht. Aufgrund der unterschiedlichen Fähigkeit der Spülwirkung für das Al2 O3 /HfO2 und ZrOx Schicht wird das Schalten der partikulären Dipole in der Al2 . verursacht O3 /HfO2 NCFET. Daher wird der offensichtlichere NC-Effekt mit sub-60 mV/Dekade SS in 5 nm ZrOx . erreicht NCFET.
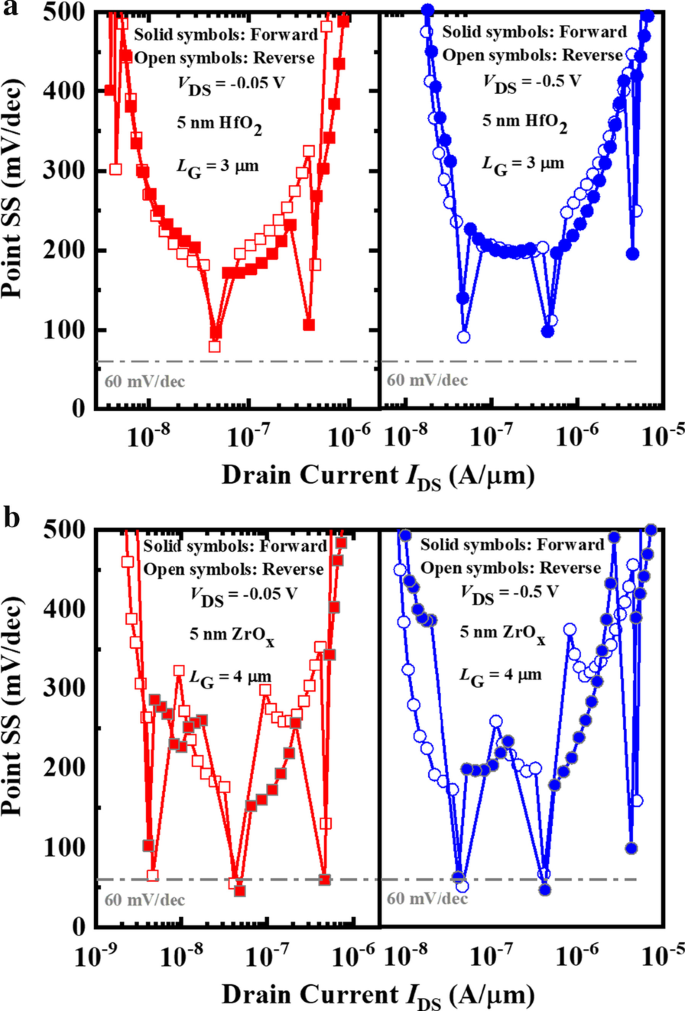
Punkt SS als Funktion von I DS für die a Al2 O3 /5 nm HfO2 NCFETs und b 5 nm ZrOx NCFETs
Schlussfolgerungen
Wir berichten über die Demonstration von ferroelektrischem NC ZrOx pFETs mit einem SS unter 60 mV/Dekade, einer niedrigen Betriebsspannung von 1 V und einer Hysterese von weniger als 60 mV. Der Einfluss des amorphen ZrOx Filme auf das ferroelektrische Verhalten wird durch die Sauerstoffleerstellendipole erklärt. Das verbesserte I DS und NDR-Phänomen werden auch in Al2 . erhalten O3 /HfO2 NCFETs und ZrOx NCFETs im Vergleich zum Steuergerät. Der unterdrückte NC-Effekt des Al2 O3 /HfO2 NCFET kann auf partielle Dipolumschaltung aufgrund von Grenzflächendipolen am Al2 . zurückgeführt werden O3 /HfO2 Schnittstelle. Das ZrOx NCFETs mit einer steilen Flanke von unter 60 mV/Dekade, verbesserter Drainspannung und niedriger Betriebsspannung ebnen einen neuen Weg für das zukünftige Design von NCFETs mit geringem Stromverbrauch.
Verfügbarkeit von Daten und Materialien
Die Datensätze, die die Schlussfolgerungen dieses Artikels unterstützen, sind im Artikel enthalten.
Abkürzungen
- TaN:
-
Tantalnitrid
- ZrOx :
-
Zirkoniumdioxid
- TDMAZr:
-
Tetrakis (Dimethylamido) Zirkonium
- P r :
-
Restpolarisation
- E c :
-
Elektrisches Koerzitivfeld
- MOSFETs:
-
Metall-Oxid-Halbleiter-Feldeffekttransistoren
- Ge:
-
Germanium
- ALD:
-
Atomlagenabscheidung
- B + :
-
Bor-Ionen
- Al2 O3 :
-
Aluminiumoxid
- HRTEM:
-
Hochauflösendes Transmissionselektronenmikroskop
- Ni:
-
Nickel
- RTA:
-
Vergütetes thermisches Glühen
- I DS :
-
Strom entziehen
- V GS :
-
Gate-Spannung
- V TH :
-
Schwellenspannung
- NCFET:
-
Feldeffekttransistor mit negativer Kapazität
Nanomaterialien
- Der Sperrschicht-Feldeffekttransistor (JFET) als Schalter
- Materialien:EPP-Schaum mit verbesserten Oberflächeneigenschaften und optimiertem Füllverhalten
- Mehrschichtige SnSe-Nanoflake-Feldeffekttransistoren mit niederohmigen Au-Ohm-Kontakten
- Sinterverhalten von funkenplasmagesintertem SiC mit Si-SiC-Verbund-Nanopartikeln, die durch thermisches DC-Plasmaverfahren hergestellt wurden
- Graphen/Polyanilin-Aerogel mit Superelastizität und hoher Kapazität als hochkompressionstolerante Superkondensatorelektrode
- Einwandige Kohlenstoff-Nanoröhrchen-dominierte mikrometerbreite Streifenmusterbasierte ferroelektrische Feldeffekttransistoren mit HfO2-Defektkontrollschicht
- Analog/HF-Leistung eines T-Gate-Dual-Source-Tunnel-Feldeffekttransistors
- Graphen-basierter Vakuumkanaltransistor im Nanobereich
- Lateraler, doppelt diffundierter Metall-Oxid-Halbleiter-Transistor mit extrem niedrigem spezifischen On-Widerstand mit verbessertem Dual-Gate und partieller P-vergrabener Schicht
- Hochleistungs-Drehkapazität bei geringem Platzbedarf



