Analyse der Bi-Verteilung in epitaktischem GaAsBi durch aberrationskorrigierten HAADF-STEM
Zusammenfassung
Der Bi-Gehalt in GaAs/GaAs1 − x Bi x /GaAs-Heterostrukturen, die durch Molekularstrahlepitaxie bei einer Substrattemperatur nahe 340 °C gezüchtet wurden, werden durch aberrationskorrigierte ringförmige Dunkelfeldtechniken mit großem Winkel untersucht. Die Analyse von ringförmigen Großwinkel-Dunkelfeld-Rastertransmissionselektronenmikroskopie-Bildern bei geringer Vergrößerung, bestätigt durch EDX-Analyse, zeigte planare defektfreie Schichten und eine inhomogene Bi-Verteilung an den Grenzflächen und innerhalb der GaAsBi-Schicht. Bei hoher Vergrößerung bestätigte die qHAADF-Analyse die inhomogene Verteilung und Bi-Segregation an der GaAsBi/GaAs-Grenzfläche bei niedrigem Bi-Fluss und verzerrter Hantelform in Bereichen mit höherem Bi-Gehalt. Bei höherem Bi-Fluss nimmt die Größe der Bi-Ansammlung zu, was zu ungefähr gleichachsigen Bi-reichen Partikeln führt, die entlang der Zinkblende {111} facettiert und gleichmäßig um die Matrix und die Grenzflächen verteilt sind. Die FFT-Analyse überprüft die Koexistenz zweier Phasen in einigen Clustern:ein rhomboedrisches reines Bi (rh-Bi), umgeben von einer Zinkblende GaAs1 − x Bi x Matrix. Cluster können die lokale Gitterrelaxation beeinflussen und zu einem teilweise relaxierten GaAsBi/GaAs-System führen, in guter Übereinstimmung mit der XRD-Analyse.
Hintergrund
Heutzutage ziehen GaAsBi-basierte Halbleiter als temperaturstabile und mittlere Infrarotbauteile Interesse auf sich [1]. Das Hinzufügen einer kleinen Menge Bi in das GaAs-Gitter führt zu einer großen Bandlückenreduzierung, was einer der interessantesten optoelektronischen Effekte ist [2, 3]. Allerdings ist es aufgrund der schwachen Ga-Bi-Bindungsenergie, der großen Mischungslücke und des großen Unterschieds in der Gitterkonstante zwischen GaBi und GaAs schwierig, selbst eine kleine Menge an Bi in GaAs einzubauen. Folglich muss GaAsBi für einen effizienten Bi-Einbau unter einem dynamischen Nichtgleichgewichtsprozess gezüchtet werden. Auch wenn es erfolgreich synthetisiert wird, ist die Verteilung von Bi manchmal ungleichmäßig, was die Dichte der nichtstrahlenden Rekombinationszentren erhöht und daher ihre Effizienz im Laserbetrieb beeinträchtigt. Die große Größe und die geringe Elektronegativität von Bi neigen dazu, während des epitaktischen Wachstums Phasentrennung [4], Oberflächentröpfchen [5, 6], atomare Ordnung [7,8,9], nanoskalige Flüssigkeitströpfchen [10] oder Bi-Cluster zu erzeugen. Das Vorhandensein von Bi-Clustern wurde zuvor von Ciatto et al. durch eine Kombination aus Röntgenabsorptionsspektroskopie (XAS), Rasterkraftmikroskopie und Röntgenbeugung (XRD) [11]. Dann berichteten mehrere Autoren über das Vorhandensein von Bi-Clustern in getemperten GaAsBi-Proben unter Verwendung verschiedener Techniken der Transmissionselektronenmikroskopie [4, 12, 13]. Darüber hinaus haben Kunzer et al. [14] bestätigte durch konventionelle Elektronenspinresonanz (ESR), dass etwa 10 % des eingebauten Bi die Ga-Plätze in GaAsBi-Schichten besetzt hatten. Daher ist das Verständnis und die Kontrolle des Bi-Einbaus und der Defektbildung entscheidend für die erfolgreiche Anwendung von GaAsBi auf Bauelemente. Es ist erwähnenswert, dass die Entwicklung neuer Bi-basierter Materialien mit der Weiterentwicklung von Charakterisierungswerkzeugen verbunden ist. In diesem Sinne spielen die Techniken der High Angle Annular Dark-Field Scanning Transmission Electron Microscopy (HAADF-STEM) in aberrationskorrigierten Mikroskopen eine wichtige Rolle bei der Gewinnung von Informationen im Sub-Angström-Bereich [15, 16]. Bei dieser Technik ist die Intensität in den Bildern ungefähr proportional zur durchschnittlichen Ordnungszahl (Z ) in der projizierten Atomsäule, sodass es aufgrund des großen Unterschieds in der Ordnungszahl von Bi zu As und Ga erfolgreich in verdünnten Ga(AsBi)-Heterostrukturen angewendet werden kann. Außerdem sind helle Strukturen in HAADF-Bildern im Gegensatz zu den hochauflösende Transmissionselektronenmikroskopie (HRTEM) kann aufgrund des Fehlens von Kontrastumkehrungen und Delokalisierung atomaren Säulen in einem ausgerichteten Kristall zugeordnet werden. Aberrationskorrigierte HAADF-Bilder von GaAsBi-Proben zeigen eine geringe Abhängigkeit von der Probendicke und eine fast lineare Abhängigkeit von der As/Bi-Zusammensetzung [12]. Durch Anwendung des quantitativen HAADF (qHAADF) Bildanalysealgorithmus, entwickelt von Molina et al. [17] ist es möglich, die HAADF-Intensität und die atomare Säulenzusammensetzung in ternären III-V-Halbleitermaterialien [12, 16, 18] und folglich in GaAsBi-Verbindungen effektiv zu korrelieren. Darüber hinaus bieten hochauflösende HAADF-STEM-Bilder Informationen über die kristalline Qualität [19,20,21,22].
In dieser Arbeit untersuchen wir durch aberrationskorrigierte HAADF-STEM-Bildgebung und komplementäres energiedispersives Röntgen (EDX) die Bi-Verteilung in GaAs/GaAs1 − x Bi x /GaAs-Heterostrukturen, die durch Molekularstrahlepitaxie (MBE) bei einer Substrattemperatur nahe 340 °C gezüchtet wurden. Wir haben auch die Wirkung der Bi-Ansammlung im Nano- und Mikrobereich untersucht. Zu diesem Zweck haben wir den qHAADF-Ansatz, die Fourier Fast Transformation (FFT)-Analyse von hochauflösenden Bildern und die XRD-Techniken verwendet.
Methoden
Wir untersuchen eine Serie von zwei Proben bestehend aus GaAs/GaAs1 − x Bi x /GaAs-Heterostrukturen, gewachsen durch Festquellen-MBE auf 2″ n + GaAs:Si (001)-Wafer mit unterschiedlichem Bi-Fluss, gegeben durch die Bi-Zelltemperaturen S1 (460 °C) und S2 (505 °C). Das verwendete System war ein VG V80 MBE-Gerät mit einem durchschnittlichen Ruhe-Hintergrunddruck von ~ 5 × 10 − 10 mbar. Die Strukturen bestehen nominell aus einem 130-nm-GaAs-Puffer, einer 130-nm-GaAsBi-Schicht, einer 5-nm-GaAs-Abstandsschicht und dann einer 130-nm-GaAs-Kappe. Vor dem Wachstum wurde das Substrat 20 Minuten lang bei 400 °C entgast und dann das Oberflächenoxid bei 600 °C entfernt. Der GaAs-Puffer und die Kappe wurden bei ~ 580 °C unter einem As2 . gezüchtet Fluss, während die GaAsBi-Schicht und die GaAs-Abstandsschicht bei ~ 340 °C unter einem nahezu stöchiometrischen As4 . aufgewachsen wurden Fluss. Die GaAsBi-Schicht wurde daher während des Wachstums der GaAs-Kappe in situ bei ~ 580 °C für ~ 20 min getempert. Unter diesen Wachstumsbedingungen wurden keine Metalltröpfchen an der Oberfläche beobachtet. Die Substrattemperaturen wurden mittels optischer Thermometrie abgeschätzt, wobei die Ergebnisse gegen Oberflächenrekonstruktionsübergänge bei bekannten Temperaturen kalibriert wurden. Vor dem GaAsBi-Wachstum wurde die Probenoberfläche 20 s lang einem Bi-Fluss ausgesetzt; Der Zweck dieses Schrittes bestand darin, eine Bi-Oberflächenschicht aufzubauen und den Bi-Einbau zu Beginn des GaAsBi-Wachstums zu verbessern.
Die Proben für HAADF-STEM wurden im Querschnitt durch mechanisches Schleifen und Ar + . hergestellt Ionenfräsen unter Verwendung eines Präzisions-Ionenpoliersystems (PIPS), mit Strahlneigungen von – 3° und + 4° und einer Strahlenergie zwischen 2,8 und 3,0 kV. Beim letzten Mahlschritt wurde die Ionenenergie auf 1,5 kV verringert, um die Oberflächenqualität zu verbessern. Proben wurden vor der Untersuchung plasmagereinigt, um die Wirkung der Elektronenstrahlabscheidung auf der Probenoberfläche zu reduzieren [23]. HAADF-STEM-Bilder, verlustfreies Elektronenenergieverlustspektrum (EELS) und energiedispersive Röntgenspektren-Linienscans wurden bei 200 kV mit einem Titan 3 . durchgeführt Themis bei 60–300 kV. Der Titan 3 Themis ist mit einer Kaltfeldemissionskanone (FEG), einem Cs-Sondenkorrektor und einem Elektronenmonochromator ausgestattet, die eine atomare Auflösung bei der HAADF-Bildgebung ermöglichen. Dieses Mikroskop enthält auch einen Super-X-Quad-EDX-Detektor für die Elementaranalyse, der gleichzeitig Informationen über die Position und Zusammensetzung der Atome liefert. Sekundärelektronen(SE)-Bilder für die Topographiestudie der TEM-Probe wurden mit einem FEI NOVA NANOSEM 450-Mikroskop bei 2 kV durchgeführt.
Die Bi-M-Linie bei 2,42 keV wurde für die quantitative Bestimmung der Bi-Zusammensetzung durch die Bruker Espirit-Software verwendet. Die Dicke der Probe wurde aus der Analyse des ortsaufgelösten verlustfreien EELS-Signals unter Verwendung der Software Digital Micrograph (GATAN™) bestimmt [23]. Die spaltenweise Bi-Verteilung wurde mit der qHAADF-Software untersucht, die für die Ausführung auf dem Digital Micrograph verfügbar ist. Diese Software ermöglicht es, die integrierte Intensität ausgewählter Bereiche um Atomsäulen herum zu messen und zu kartieren, indem Intensitätspeaks im HAADF-STEM-Bild erkannt werden [17]. Die ω-2θ (0 0 4) XRD-Spektren wurden mit einem Bruker D8 Discover Röntgendiffraktometer unter Verwendung von Cu-Kα1 . gemessen Strahlung. Die Scans wurden mit der Bede Rads Mercury Software simuliert.
Ergebnisse und Diskussion
Abbildung 1 zeigt HAADF-STEM-Bilder mit geringer Vergrößerung, die auf der [110]-Zonenachse der Proben S1 (a) und S2 (b) aufgenommen wurden, zusammen mit den dickegradientkorrigierten Intensitätsprofilen, die entlang der [001]-Richtung aus den in markierten Regionen aufgenommen wurden die HAADF-STEM-Bilder (grüne Rechtecke). In den untersuchten Bereichen beider Proben wurden keine Einfädelungsversetzungen oder Stapelfehler festgestellt. Bei HAADF ist die erhaltene Intensität proportional zur durchschnittlichen Ordnungszahl. Bei konstanter Probendicke hängt der hellere Kontrast im Bild also mit einem höheren Bi-Gehalt zusammen (Z Bi = 83, Z Ga = 31 und Z Als = 33). Dies ermöglicht die Untersuchung der Bi-Verteilung in GaAsBi/GaAs-Heterostrukturen. Wie in Abb. 1a zu sehen ist, werden in der GaAsBi-Schicht in Probe S1 – mit einem niedrigeren Bi-Gehalt – keine klaren Kontrastschwankungen festgestellt, die keine klaren Hinweise auf Clusterbildung zeigen, nicht einmal in anderen Bereichen mit höherer Probendicke. In der Literatur wurden jedoch Bi- und As-Cluster beschrieben, sogar für GaAsBi-Proben mit einem Bi-Gehalt von nur 1,44%, obwohl sie bei niedrigeren Temperaturen gezüchtet wurden [11]. In Bezug auf Probe S2 mit einem höheren Bi-Gehalt zeigt Abb. 1b einige Bereiche mit einem helleren Kontrast in der Schicht mit einer relativ homogenen Größe und Verteilung. Diese Bereiche, die regelmäßig entlang der GaAsBi-Schicht und den Grenzflächen verteilt sind, können aufgrund ihrer höheren HAADF-Intensität direkt als Bi-haltige Cluster interpretiert werden. Zur besseren Visualisierung wird das entsprechende tiefpassgefilterte Bild als Einschub im selben Bild dargestellt, wobei die gelbe Farbe den höheren Bi-Gehaltsbereichen und die schwarzen den niedrigeren (Temperaturskala) entspricht. Die Bildung von Bi-Clustern in GaAsBi, ohne strukturelle Defekte hervorzurufen, wurde bereits von anderen Autoren beschrieben [7, 24, 25]. Die Integration von Bi (das 1,6-fache des Atomvolumens von As) in die GaAs-Matrix kann aufgrund der Spannung eine Erhöhung der Substitutionsenergie bewirken, wodurch die Löslichkeit der As-Atome verringert und die Ansammlung der Bi-Atome ermöglicht wird. Eine Untersuchung der Probe unter Verwendung eines Rasterelektronenmikroskops mit Feldemissionskanone (FEG-SEM) wurde durchgeführt, um sicherzustellen, dass Bi-Cluster in die Schicht eingebettet sind. Zu diesem Zweck wurden Topographiebilder von Sekundärelektronen, die bei niedriger Spannung aufgenommen wurden (hier nicht gezeigt), mit STEM-Bildern aus dem gleichen Gebiet verglichen.

a HAADF-STEM-Querschnittsbilder von Probe S1, die GaAs/GaAsBi/GaAs-Grenzflächen zeigen. b Querschnitts-HAADF-STEM-Bild von Probe S2, in der GaAsBi-Schicht werden helle Flecken entlang der GaAsBi-Schicht in Bezug auf Bi-reiche Bereiche beobachtet. Details unter Verwendung der Temperaturfarbskala eines Bereichs nach Anwendung eines Tiefpassfilters werden zur besseren Visualisierung als Einschub in dasselbe Bild eingefügt. c Dickengradient-korrigierte Intensitätsprofile, aufgenommen entlang der [001]-Richtung aus den mit grünen Rechtecken markierten Bereichen in den HAADF-STEM-Bildern, blaue Linie für Probe S1 und schwarze Linie für Probe S2, die ein leicht unterschiedliches Verhalten an den Grenzflächen zeigen
Um weitere Informationen zur Bi-Verteilung in den Proben zu erhalten, sind in Abb. 1c Intensitätsprofile entlang der Wachstumsrichtung mit korrigiertem Dickengradienten dargestellt. Profile aus den HAADF-STEM-Bildern in Abb. 1a, b zeigen ein ähnliches Verhalten in beiden Proben:grob abrupte Grenzflächen, GaAsBi-Schichten ähnlicher Länge (~ 140 nm). In Bezug auf die GaAsBi/GaAs-Grenzfläche fällt die HAADF-Intensität von ihrem Maximalwert auf ~ 0 in etwa 10 nm (siehe das graue gestrichelte Rechteck im Profil), was auch ohne Bi-Fluss auf einen gewissen Bi-Einbau in der gesamten GaAs-Deckschicht hindeutet. Profile enthalten auch Informationen zur Äquilibrierungszeit. Wie aus den Profilen ersichtlich ist, ist in der Probe mit niedrigerem Bi-Gehalt (S1) die GaAs/GaAsBi-Grenzfläche abrupter als die in der Probe mit höherem Bi-Gehalt (S2). Dies kann durch die unterschiedlichen Bi-Einbaukoeffizienten der beiden Proben erklärt werden. S1, obwohl es bei der gleichen Temperatur wie S2 gewachsen ist, hat einen viel geringeren Bi-Gehalt. S1 wird daher wahrscheinlich unter kinetisch begrenzten Bedingungen mit einem Bi-Einbau von nahezu Eins gezüchtet [26], was bedeutet, dass die Bi-Oberflächenschicht über einen Zeitrahmen äquilibriert, der kürzer ist als die Oberflächenlebensdauer eines Bi-Atoms bei dieser Temperatur. S2 hingegen hat wahrscheinlich einen niedrigeren Bi-Einbaukoeffizienten [27]. Die Bi-Oberflächenschicht würde in diesem Fall mehr als die Oberflächenlebensdauer eines Bi-Atoms benötigen, um sich auszugleichen, was zu einer langsameren Stabilisierung des Bi-Einbaus führt.
Um die Korrelation zwischen den HAADF-STEM-Intensitätsprofilen und der Bi-Verteilung in der Heterostruktur zu bestätigen, wurden gleichzeitig STEM-EDX-Bi-Zusammensetzungskarten der Proben aufgenommen. Sie sind in Abb. 2 für eine Probe bei niedrigem (a) und hohem (b) Bi-Fluss dargestellt. Die entsprechenden Bi-Zusammensetzungsprofile entlang der Wachstumsrichtung, die durch Integration der Punkt-EDX-Spektren einer Fläche von etwa 130 nm bestimmt wurden, sind in Abb. 2c als blaue bzw. schwarze Linie dargestellt. Diese Zusammensetzungsprofile zeigen die gleiche Tendenz, die in den GaAs/GaAsBi/GaAs-Grenzflächen durch HAADF-Analyse mit geringer Vergrößerung nachgewiesen wurde. Der durchschnittliche Bi-Atomanteil in den GaAsBi-Schichten wurde aus den entsprechenden EDX-Spektren mit 1,2 ± ± 0,4 % und 5,3 ± ± 0,4 % in den Proben S1 bzw. S2 quantifiziert, was eine inhomogene Verteilung von Bi in der GaAsBi-Schicht in beiden Proben zeigte .

STEM/EDX-Elementarkarten, die die Bi-Verteilung in Stichproben S1 darstellen (a ) und S2 (b ). Details der Bi-, Ga- und As-Elementarkarten, die dem in Fig. 1b mit einem weißen Rechteck markierten Cluster entsprechen, zeigen einen Abfall der As- und Ga-Signale, wo ein hoher Bi-Bereich vorhanden ist. c Bi-Inhaltsprofile entlang der [001]-Richtung, extrahiert nach Integration eines Bereichs von etwa 130 nm aus der EDX-Karte der Proben S1 (blaue Linie) und S2 (schwarze Linie). Ähnliche Merkmale wurden in den Intensitätsprofilen bei geringer Vergrößerung in Abb. 1c beobachtet
Die Anwesenheit von Bi-Clustern wäre auf einen sterischen Hinderungseffekt zurückzuführen. In diesem Fall kann die Oberflächenspannung aufgrund der größeren Atomgröße der Bi-Atome zunehmen, so dass zur Verringerung der Spannung in der Struktur Bi-Atome den Ga-Einbau blockieren und folglich Ga-Leerstellen im Netz verursachen könnten. Ga- und As-Zusammensetzungskarten des Clusters, umgeben von einem weißen Quadrat in Abb. 2b, sind enthalten, um zu zeigen, wie beide Signale fallen, wenn ein hohes Bi-Signal vorhanden ist. Dies legt nahe, dass Bi in diesem speziellen Cluster sowohl Gruppe-III- als auch Gruppe-V-Untergitter besetzen könnte. Dies beweist auch, dass die Cluster keine oberflächlichen Cluster sind, die während der TEM-Probenvorbereitung gebildet wurden.
Um eine tiefgreifende Untersuchung der Bi-Verteilung auf atomarer Ebene durchzuführen, wurden in der [110]-Projektion aberrationskorrigierte HAADF-STEM-Bilder mit hoher Vergrößerung aufgenommen. In dieser III-V-Halbleiterlegierung entsprechen die beiden maximalen Intensitätspeaks einer Hantel den Atomsäulen der Gruppe III und der Gruppe V. Um die Intensität in den Atomsäulen richtig mit ihrer Zusammensetzung zu korrelieren, wurde das Hintergrundniveau aus den experimentellen HAADF-STEM-Bildern entfernt. Dann wurde eine automatische Lokalisierung der Intensitätspeaks durchgeführt, und Integrationsbereiche um die Atomsäulen der Gruppe V werden sorgfältig ausgewählt. Integrierte Intensitäten werden für jede Hantel mit dem qHAADF-Ansatz gemessen und abgebildet. Das Verfahren zur Quantifizierung des Bi-Gehalts war ähnlich dem in Lit. [28]. In dieser Arbeit werden die integrierten Intensitätsquotienten jeder Hantel (R ) wurde als Verhältnis zwischen der integrierten Intensität in den Spalten der Gruppe V berechnet (I As − Bi ) im gesamten Bild und die mittlere integrierte Intensität in den Spalten der Gruppe V in der GaAs-Schicht (I Als ), als R = (ich (As − Bi) )/Ich Als .
Abbildung 3a zeigt ein stark vergrößertes HAADF-STEM-Bild der GaAs/GaAsBi-Grenzfläche aus der Probe mit geringem Bi-Gehalt (S1). Die farbige normalisierte integrierte Intensitätskarte des HAADF-Bildes ist in Abb. 3b gezeigt. Farbige Punkte im Bereich von 1 (tiefblau) bis 1,27 (rot) zeigen den Bi-Gehalt in den Spalten der Gruppe V. Wie zu beobachten ist, sind kleine Schwankungen im R Werte aus dem Mittelwert werden in beiden Schichten gefunden. Um die Streuung der erhaltenen Ergebnisse zu vergleichen, haben wir den Korrelationskoeffizienten Cv . berechnet (definiert als das Verhältnis zwischen der Standardabweichung und dem Mittelwert R Wert) im GaAs (Substrat), der GaAsBi-Schicht und der GaAs-Deckschicht. Der Lebenslauf die Werte betrugen 1,3, 2,6 bzw. 2,6%, da die beobachteten Fluktuationen in der GaAsBi/GaAs-Grenzfläche höher sind als diejenigen, die in dem als Referenz genommenen GaAs-Substrat gefunden wurden; wir können davon ausgehen, dass diese Variationen in R Werte beziehen sich auf Änderungen in der Zusammensetzung der Bi-Spalte. Die Ursache für den Cv ungleich null Faktor im Substrat kann auf lokale Dickenschwankungen, Detektorrauschen (gemessen in einem Bereich ohne Material von 0,6%) oder Kohlenwasserstoffe zurückzuführen sein, die sich während der mikroskopischen Charakterisierung auf der Oberflächenprobe ablagern.

a Querschnitt [110] HAADF-STEM-Bild der Grenzfläche GaAsBi/GaAs von Probe S1. Das Detail einer unverzerrten Region in der GaAs-Schicht und verzerrte Anionen-Kationen-Hanteln in einem Bi-reichen Bereich bei höherer Vergrößerung sind im selben Bild als Einschub enthalten. b Farbige Karte, die R . darstellt Werte um die Gruppe-V-Spalten des HAADF-Bildes in Abb. 3a. Die grüne Farbe entspricht der mittleren Bi-Zusammensetzung in der GaAsBi-Schicht, gemessen durch EDX. Trotz der homogenen Verteilung von Bi im HAADF-STEM-Bild zeigt die Intensitätskarte Bereiche mit hoher Wahrscheinlichkeit von Nanoclustering (rote Punkte) und Spalten mit relativ geringem Bi-Gehalt (blaue Punkte) in der GaAsBi-Schicht. c Profil entlang der Wachstumsrichtung des gesamten R Intensitätskarte, die eine verschwommene GaAsBi/GaAs-Grenzfläche in etwa 10 nm zeigt
Diese qHAADF-Analyse bestätigt eine nicht abrupte obere GaAsBi/GaAs-Grenzfläche über etwa 10 nm, die bei geringer Vergrößerung wahrgenommen wird, hauptsächlich aufgrund der Bi-Oberflächensegregation während des Wachstums, wie aus dem Profil entlang der Wachstumsrichtung in der gesamten Intensität R Karte, gezeigt in Abb. 3c. Darüber hinaus werden mit dieser Software auch verteilte Bi-reiche Säulen innerhalb der GaAsBi-Schicht (rote Punkte) zusammen mit Bereichen mit niedrigem Bi-Gehalt (blaue Punkte) in der GaAsBi-Schicht detektiert, was die Schwankungen des Bi-Gehalts in der GaAsBi-Schicht bestätigt . Das Vorhandensein von Bi-reichen Säulen scheint eine deutliche Verzerrung der Hantelform zu erzeugen, wie im Einschub bei höherer Vergrößerung in Abb. 3a zu erkennen ist. Die Substitution größerer Bi-Atome durch As-Atome während des epitaktischen Wachstums hätte das Gitter der Matrix lokal verbreitert und eine Verzerrung der Hantelform verursacht, während die Struktur beibehalten wird.
HAADF-STEM-Techniken ermöglichen auch eine Struktur- und Zusammensetzungsanalyse der Cluster, die bei geringer Vergrößerung in Probe S2 nachgewiesen wurden. Diese nahezu homogen verteilten Cluster nehmen etwa 20–30% der GaAsBi-Schichtoberfläche ein. Um die Zusammensetzung von Bi, Form und Größe der gefundenen Cluster zu kennen, wurden aberrationskorrigierte HAADF-STEM-Bilder in der [110]-Projektion aufgenommen und EDX-Elementarkarten und Intensitätskartenverhältnisse um Gruppe-V-Säulen herum durchgeführt. Um verschiedene kristalline Phasen zu identifizieren, wurde eine Fast-Fourier-Transformation (FFT)-Studie in den hochauflösenden Bildern in verschiedenen Bereichen innerhalb und in der Nähe der Cluster durchgeführt.
Abbildung 4a zeigt ein hochauflösendes [110] HAADF-STEM-Bild der GaAsBi/GaAs-Grenzfläche mit einem klaren Bi-Cluster von etwa 12 nm Durchmesser. Rote Rechtecke im Bild stellen die Bereiche dar, in denen die FFT-Studie durchgeführt wurde. Es ist bekannt, dass die Tiefpassfilterung nicht nur das Rauschen in den Daten reduziert, sondern auch die im Rohbild beobachteten periodischen Merkmale entfernt, indem die Kanten des Bi-Clusters betont werden. Das gefilterte HAADF-STEM-Bild nach dem von Werner et al. [29], ist in Abb. 4b gezeigt. Wie zu erkennen ist, sind {111}- und (001)-Facetten im hellsten Bereich deutlich zu beobachten. Die Intensitätsverteilung deutet jedoch auf das Vorhandensein von zwei unterschiedlichen Zusammensetzungsvolumina im Partikel hin:ein Bi-reiches mit trapezförmiger Form, umgeben von einem weniger Bi-reichen Bereich. Eine ähnliche Clusterform wurde für Wood et al. in einem Fünfperioden-GaAs1 − x Bi x /GaAs1 − y Bi y Struktur [10].
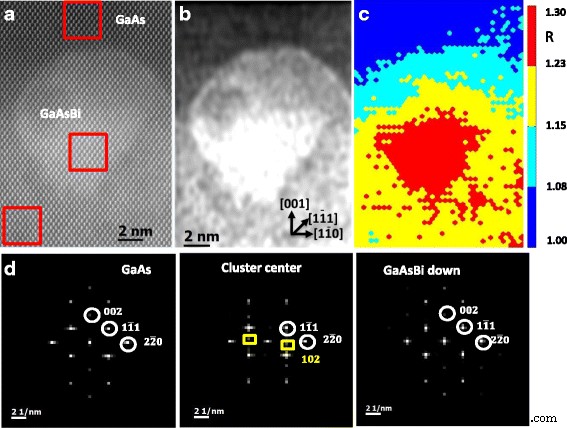
a Querschnitt [110] HAADF-STEM-Bild der Grenzfläche GaAsBi/GaAs der Probe S2, die einen etwa 12 nm großen Bi-Cluster neben der GaAsBi/GaAs-Grenzfläche einfängt. b Das niedrig gefilterte Bild des HAADF-STEM-Bildes zeigt zwei Bereiche mit unterschiedlichem Kontrast in der GaAsBi-Schicht, eine Bi-reiche Zone ist entlang {111}- und (001)-Ebenen facettiert, umgeben von einer niedrigeren Bi-reichen Zone. c Farbige Karte, die den R darstellt Werte um Gruppe-V-Spalten, die eine abgestufte Bi-Verteilung um den Cluster darstellen. d Die entsprechende Fourier-Transformation aus den ausgewählten Bereichen, die in Abb. 1a mit roten Rechtecken markiert sind. Zusätzliche Spots, die mit {102}-Ebenen in Bezug auf die rh-Bi-Phase übereinstimmen, werden in der Clusterregion mit dem höchsten Kontrast erkannt
Die qHAADF-Analyse durch die Intensität R Die in Abb. 4c gezeigte Karte zeigt eine ungefähr äquiaxiale Partikelform und einen Bi-Konzentrationsgradienten, der in der Mitte des Clusters seinen Höhepunkt erreicht.
Wuet al. [4] berichteten über das Vorhandensein unterschiedlicher kristallographischer Strukturen in GaAsBi-Schichten, indem sie HRTEM-Mikroaufnahmen untersuchten und die Bildung und die Phasenumwandlung von Zinkblende-Bi-reich zu rhomboedrischem Bi (rh-Bi) modelliert, das in Zinkblende-{111}-Ebenen nukleiert ist. In diesem Sinne ist es erwähnenswert, dass helle Flecken in der FFT aus hochauflösenden HAADF-STEM-Bildern als Beugungsflecken aus kristallographischen Ebenen interpretiert werden können. Dann sollten zusätzliche Punkte im herkömmlichen Muster für die Zinkblendestruktur von GaAs als zusätzliche Phasen interpretiert werden. Um das Vorhandensein verschiedener Kristallstrukturen im Cluster zu untersuchen, zeigt Abb. 4d die FFTs, die drei verschiedenen Bereichen entsprechen, die in Abb. 1a als rote Quadrate markiert sind. Von rechts nach links zeigt eine homogene Region in der GaAs-Deckschicht, die hellste Zone in der GaAsBi-Schicht und eine weitere Region mit geringerem Kontrast in derselben GaAsBi-Schicht. Weiße Kreise bezeichnen die Position des Beugungspeaks mit den Miller-Indizes 002, \( 1\overline{1}1\) und \( 2\overline{2}0\). Wie zu sehen ist, erscheinen nur in der Mitte des Clusters klare Flecken, die mit einem gelben Quadrat markiert sind und sich auf {102}-Ebenen beziehen, die ungefähr parallel zu den {220}-Ebenen der Zinkblende verlaufen, was darauf hindeutet, dass eine neue rh-Bi-Phase in nukleiert wurde die GaAsBi-Zinkblende-Schicht. FFTs zeigen auch eine Verbreiterung der Beugungspeaks bezogen auf {111}-Ebenen. Dieser beobachtete asymmetrische Peak kann auf die Mikrospannung zurückzuführen sein, die durch die Scherung der {111}-Ebenen zwischen rh-Bi- und Zinkblende-Phasen im Cluster verursacht wird.
Für eine eingehende Untersuchung der Clusterzusammensetzung ist es erwähnenswert, dass Elektronen, wenn sie eine elektronentransparente Probe mit eingebetteten Clustern durchlaufen, nicht nur Informationen über den Cluster, sondern auch von der Matrix tragen. Um die reale Clusterzusammensetzung abzuschätzen, folgen wir dem gleichen Verfahren wie in Lit. [25]. Die Ergebnisse zeigten auch, dass Cluster in der Nähe der GaAsBi/GaAs-Grenzfläche tendenziell kleiner (12 nm) mit einem höheren Bi-Gehalt (≈ 30 %) sind, wahrscheinlich aufgrund des Vorhandenseins von Bi auf der Oberfläche, wenn die Deckschicht beginnt zu gewachsen sein. Die meisten Cluster innerhalb der GaAsBi-Schichten haben jedoch eine größere Größe (16 nm), aber ihr Bi-Gehalt ist geringer (≈ 22%). Darüber hinaus wurden in der GaAsBi-Schicht Cluster mit höherem Bi-Gehalt (35 %) und größerer Größe (23 nm) nachgewiesen. Außerdem besteht der Kern einiger Cluster, wie bereits erwähnt, aus reinem rh-Bi.
Um den Spannungszustand des Epitaxiefilms zu untersuchen, wurden hochauflösende Röntgen-ω-2θ-Kurven aufgenommen. Abbildung 5 zeigt die (004) XRD-Scans der GaAsBi/GaAs-Schichten in Blau und simulierte Anpassungen in Orange für die Proben S1 (a) und S2 (b). In beiden Proben entspricht der schärfste und höchste Intensitätspeak bei 0° Bogensekunden dem GaAs-Substrat, während der breite untere Intensitätspeak bei negativen Bogensekunden der verspannten GaAsBi-Schicht entspricht. Der Winkel zwischen den Peaks bezieht sich auf das Ausmaß der Gitterfehlanpassung zwischen beiden Schichten. Die Schulter rechts vom GaAs-Peak im Spektrum von S2 zeigt eine GaAs-Schicht unter Zugspannung an; dies impliziert eine Spannungsrelaxation in der S2-GaAsBi-Schicht. Das XRD-Spektrum von Probe S1 wurde unter Verwendung der Bi-Fraktion und der Dicken, die durch die EDX- und HAADF-Messungen angegeben wurden, gut angepasst. Im XRD-Spektrum der Probe S1 gibt es keinen Hinweis auf eine Spannungsrelaxation. Das XRD-Spektrum von Probe S2 war schwieriger anzupassen. Abbildung 5b zeigt die Daten, die durch eine einheitliche GaAsBi-Schicht von 5,8 % modelliert wurden, wie durch die HAADF-STEM-Analyse bestimmt, wobei die Bi-reichen Cluster ignoriert wurden, und eine Relaxation der GaAsBi-Schicht von 6 %, wie durch Anpassen der XRD-Kurve bestimmt; dies wäre sinnvoll, wenn die Cluster nicht mit dem Rest der GaAsBi-Matrix kohärent wären. Dieses Modell stellt die Ebene nicht genau dar; während die Substrat-GaAsBi-Aufspaltung ausreichend ist, um die Daten zu berücksichtigen, ist kein Zug-GaAs-Peak bei ~250° Bogensekunden sichtbar. Der Zug-GaAs-Peak legt nahe, dass innerhalb der Schicht Relaxation aufgetreten ist. Die Relaxation einer Kompressionsschicht verringert die Gitterkonstante außerhalb der Ebene, was bedeutet, dass der modellierte durchschnittliche Bi-Gehalt von 5,8% eine Unterschätzung des realen Durchschnitts ist; dies stimmt mit der Beobachtung von Bi-reichen Clustern in der Schicht überein. Bei der reziproken Raumkartierung (nicht gezeigt) wurden keine Peaks beobachtet, die ~ 22–35% GaAsBi entsprachen, was darauf hindeutet, dass die Cluster möglicherweise nicht mit der GaAsBi-Matrix kohärent sind. Es wurde keine weitere Modellierung des S2-XRD-Spektrums versucht.

Röntgenbeugungsdaten (blaue Linien) und simulierte Anpassungen (orange Linien) von Probe S1 (a ) und Probe S2 (b ). Vertikale gestrichelte Linien, die den GaAs-Peak bei 0° Bogensekunden und den GaAsBi-Filmpeak bei negativen Bogensekunden hervorheben. Die Schulter auf dem rechten GaAs-Peak in Fig. 5b weist auf eine GaAs-Deckschicht unter Zugspannung hin
Schlussfolgerungen
Die ac-HAADF-STEM-Analysen bieten nützliche Informationen über Struktur und Zusammensetzung von GaAs/GaAsBi/GaAs-Heterostrukturen, wobei die Ergebnisse gut mit EDX-, FFT- und XRD-Untersuchungen übereinstimmen. Die Analyse von HAADF-STEM-Bildern mit geringer Vergrößerung ermöglichte den Nachweis einer inhomogenen Bi-Verteilung und nicht abrupten GaAsBi/GaAs-Grenzflächen. Bei hoher Vergrößerung zeigte die qHAADF-Analyse eine klare Bi-Segregation an der GaAsBi/GaAs-Grenzfläche bei niedrigem Bi-Fluss (S1) und eine verzerrte Hantelform in Bereichen mit höherem Bi-Anteil aufgrund der As-Substitutionspositionen von Bi-Atomen im Gruppe-V-Subnetz . Bei höherem Bi-Fluss (S2) nimmt die Größe der Bi-Ansammlung zu, was zu ungefähr gleichachsigen Clustern führt, die gleichmäßig um die gesamte Matrix und die Grenzflächen verteilt sind. Die Studie zeigte die Koexistenz von zwei unterschiedlichen kristallinen Phasen in den untersuchten Clustern rh-Bi und Zinkblende, die {111}-Scherebenen scheren, was sich auf die lokale Gitterrelaxation auswirkt und zu einem teilweise relaxierten GaAsBi/GaAs-System führt, in guter Übereinstimmung mit der XRD-Analyse.
Abkürzungen
- Ac-HAADF-STEM:
-
Aberrationskorrigierte ringförmige Dunkelfeld-Rastertransmissionselektronenmikroskopie mit großem Winkel
- EDX:
-
Energiedispersive Röntgenstrahlung
- EELS:
-
Elektronenenergieverlustspektrum
- ESR:
-
Konventionelle Elektronenspinresonanz
- FEG:
-
Kaltfeld-Emissionskanone
- FFT:
-
Fourier-schnelle Transformation
- HRTEM:
-
Hochauflösende Transmissionselektronenmikroskopie
- IMEYMAT:
-
Instituto Universitario de Investigación en Microscopía Electrónica y Materiales
- MBE:
-
Molekularstrahlepitaxie
- qHAADF:
-
Algorithmus zur quantitativen HAADF-Bildanalyse
- SEM:
-
Rasterelektronenmikroskop
- XAS:
-
Röntgenabsorptionsspektroskopie
- XRD:
-
Röntgenbeugung
Nanomaterialien



