Optimale Silizium-Dotierungsschichten von Quantenbarrieren in der Wachstumssequenz, die ein weiches Einschlusspotential von In0,2Ga0,8N/GaN-Quantenquellen von Blau mit acht Perioden bilden LEDs
Zusammenfassung
Die Merkmale von In0.2 . mit acht Perioden Ga0.8 Untersucht werden N/GaN-Quantentöpfe (QWs) mit Silizium (Si)-Dotierung in den ersten zwei bis fünf Quantenbarrieren (QBs) in der Wachstumssequenz von blauen Leuchtdioden (LEDs). Epischichten von QWs-Strukturen werden auf 20 Paaren von In0,02 . gezüchtet Ga0.98 N/GaN-Übergitter, die als Zugentlastungsschichten (SRLs) auf strukturierten Saphirsubstraten (PSSs) durch ein metallorganisches chemisches Gasphasenabscheidungssystem (LP-MOCVD) bei niedrigem Druck wirken. Temperaturabhängige Photolumineszenz (PL)-Spektren, Strom gegen Spannung (I -V ) Kurven, Lichtausgangsleistung gegen Injektionsstrom (L -ich )-Kurven und Bilder der hochauflösenden Transmissionselektronenmikroskopie (HRTEM) von Epischichten werden gemessen. Die Konsequenzen zeigen, dass QWs mit vier Si-dotierten QBs eine größere Ladungsträgerlokalisierungsenergie (41 meV), niedrigere Einschalt- (3,27 V) und Durchbruchspannungen (− 6,77 V) und eine höhere Ausgangsleistung des Lichts blauer LEDs bei höherer Injektion haben aktueller als andere Proben. Eine niedrige Barrierehöhe von QBs in einer vier-Si-dotierten QB-Probe führt zu einem weichen Begrenzungspotential von QWs und niedrigeren Einschalt- und Durchbruchspannungen der Diode. HRTEM-Bilder belegen, dass diese Probe relativ diffusive Grenzflächen von QWs aufweist. Eine gleichmäßige Verteilung von Ladungsträgern unter acht QWs und eine überlegene Lokalisierung von Ladungsträgern in jeder Wanne sind für die Verbesserung der Lichtausgangsleistung verantwortlich, insbesondere für einen hohen Injektionsstrom in der mit vier Si dotierten QB-Probe. Die Ergebnisse zeigen, dass vier QBs von acht In0,2 Ga0.8 N/GaN-QWs mit Si-Dotierung reduzieren nicht nur den quantenbegrenzten Stark-Effekt (QCSE), sondern verbessern auch die Verteilung und Lokalisierung von Ladungsträgern in QWs für eine bessere optische Leistung blauer LEDs.
Hintergrund
Die Dotierung von Silizium (Si) in GaN-Quantenbarrieren (QBs) kann die Coulomb-Abschirmung des Polarisationsfeldes entzünden und eine Unterdrückung des quantenbegrenzten Stark-Effekts (QCSE) in InGaN/GaN-Quantentöpfen (QWs) bewirken. Strahlungsrekombinationen von Exzitonen in InGaN/GaN-QWs können durch Si-dotierte QBs erheblich verbessert werden [1,2,3,4]. In der ternären Legierung InGaN treten aufgrund der inhärenten Festphasen-Mischungslücke von GaN und InN Zusammensetzungsschwankungen von Indium (In) und spinodale Phasentrennung auf. Die Bildung von In-reichen Clustern könnte als starke Ladungsträgerlokalisierung wirken, die Fallen von nichtstrahlenden Rekombinationszentren (NRCs) verhindern und die strahlende Rekombination von Exzitonen in InGaN/GaN-QWs erleichtern [5,6,7,8,9,10]. Schwankungen der Indiumzusammensetzung in InGaN/GaN-QWs haben einen signifikanten Einfluss auf das Verhalten von Geräten, z. B. interne Quanteneffizienz (IQE), externe Quanteneffizienz (EQE) und Strom-Spannungs-Eigenschaften. Die Indiumfluktuation in InGaN/GaN-QWs sollte berücksichtigt werden, um die Leistung von Geräten besser erklären zu können [11]. InGaN/GaN-QWs mit Si-dotierten QBs haben die Eigenschaften von Modifikationen der Materialnanostruktur und Bildung von nanoskaligen Inseln aufgrund des spiralförmigen Wachstums der QW-Schichten gezeigt [12], Förderung der thermischen Stabilität von InGaN/GaN-QWs [13], Verbesserung der Lichtausgangsleistung und des Verhaltens der LED durch elektrostatische Entladung (ESD), wenn die Dotierungskonzentration in QBs erhöht wird [14], leichtes Blockieren des Lochträgertransports, was zur Rekombination von Exzitonen an den Wells zwischen p-Typ-GaN (p-GaN ) und die dotierten Barrieren [15] usw.
Die günstigen Perioden und Dicken von InGaN/GaN-QWs für hohe Helligkeit und hohe EQE unter hohem Injektionsstrom (über mehrere zehn mA) von blauen LEDs werden berichtet [16,17,18]. In den Berichten zeigen neun Perioden von InGaN/GaN-QWs, die auf strukturierten Saphirsubstraten (PSSs) gewachsen sind, eine signifikante Verbesserung der Lichtemissionsleistung und der Droop-Eigenschaften von EQE [16]. Die besten optischen und elektrischen Leistungen von blauen LEDs werden demonstriert, wenn der aktive Bereich aus 12 Perioden von InGaN/GaN-QWs bei einem Injektionsstrom von 42 A/cm 2 . besteht [17]. In den Simulationsergebnissen von InGaN/GaN-LEDs wird eine scheinbare Reduzierung des EQE-Drops und eine Verbesserung des IQE für die Dicke von QB von 24,5 auf 9,1 nm reduziert [18]. Die Si-Dotierung in der richtigen Dicke und Anzahl von QBs in InGaN/GaN-QWs ist entscheidend für die weitere Förderung der Helligkeit und Effizienz von blauen InGaN-LEDs, die mit hohem Injektionsstrom betrieben werden. In diesem Bericht stellen wir die optischen, elektrischen und Materialeigenschaften von In0,2 . mit acht Perioden vor Ga0.8 N/GaN-QWs mit den ersten zwei bis fünf QBs in der Wachstumssequenz mit Si-Dotierung blauer LEDs. Die Ergebnisse geben einen tieferen Einblick in die Mechanismen der Ladungsträgerlokalisierung, des Einschlusspotentials und der QCSE von QWs auf das Lumineszenzverhalten blauer LEDs unter hohem Injektionsstrom.
Experimentelle Methoden
Abbildung 1 zeigt die schematische Darstellung von Materialschichtstrukturen von blauen LED-Proben. Epischichten werden durch einen horizontalen Reaktor eines Niederdruck-Metall-organischen chemischen Gasphasenabscheidungssystems (LP-MOCVD) auf PSSs mit (0001)-Orientierung (c-Ebene) abgeschieden. Der Durchmesser, die Höhe und das Intervall von regelmäßigen Pyramidenstrukturen auf PSSs betragen 2, 1,5 bzw. 1 μm. PSSs haben eine Dicke von 3 μm und werden vor dem Wachstum der Epischichten auf 1150 °C in der Umgebung von Wasserstoff vorgewärmt. Trimethylgallium (TMGa), Trimethylindium (TMIn), Trimethylaluminium (TMAl) und gasförmiges NH3 werden als Vorstufen in der Dampfphase von elementarem Gallium (Ga), In, Aluminium (Al) bzw. Stickstoff (N) verwendet. Silan (SiH4 .) ) und Bis-cyclopentadienylmagnesium (Cp2 Mg) sind Vorläufer der Dotierstoffe Si und Magnesium (Mg) in den n- bzw. p-Typ-Substanzen. Trägergase von Vorläufern sind die Mischung aus Wasserstoff (H2 ) und Stickstoff (N2 ) mit dem chemisch nicht reaktiven Verhältnis 1:1.
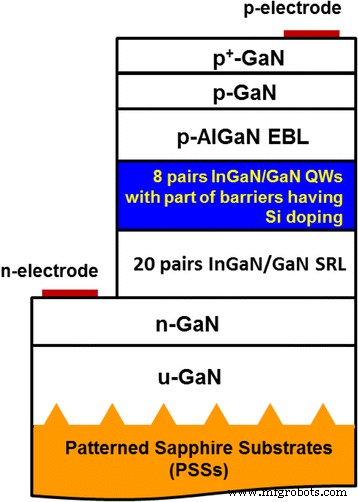
Schematische Darstellung der Schichtstrukturen von hergestellten blauen LED-Chips. Diese schematischen Zeichnungen der Epitaxieschichtdicken sind der Übersichtlichkeit halber übertrieben und nicht maßstabsgetreu
Auf PSSs werden eine undotierte GaN (u-GaN)-Pufferschicht und dann Si-dotiertes n-Typ-GaN (n-GaN) mit einer Dicke von 3 und 3,3 μm aufgewachsen. Die Dotierungskonzentration von n-GaN beträgt 10 19 cm −3 . Zwanzig Paare In0.02 Ga0.98 Anschließend werden N/GaN-Übergitter mit der Dicke 2/2 nm auf n-GaN abgeschieden. Es spielt die Rolle von Zugentlastungsschichten (SRLs), die verwendet werden, um die Dehnung der Epischichten auf PSSs zu reduzieren.
Aktive Schichten blauer LEDs enthalten In0,2 . mit acht Perioden Ga0.8 N/GaN-QWs. Die Dicken von QW und QB betragen 2,5 und 8 nm bei einer Wachstumstemperatur von 750 bzw. 900 °C. Si-Dotierung mit einer Konzentration von etwa 3 × 10 17 cm −3 in den ersten zwei, drei, vier und fünf QBs in der Wachstumssequenz werden als Proben A, B, C bzw. D bezeichnet. p-Typ Al0,16 Ga0,84 Die N-Elektronenblockierungsschicht (EBL) hat eine Dicke von 20 nm und wird bei 950 °C mit Mg-Dotierung aufgewachsen. p-GaN-Fensterschicht und p + -GaN-Kontaktschichten werden bei 950 °C mit einer Dicke von 100 und 20 nm aufgewachsen und die Dotierungskonzentration beträgt 10 19 und 10 20 cm −3 .
Epischichten werden durch ein induktiv gekoppeltes Plasma (ICP)-System selektiv auf die n-GaN-Schicht geätzt, um eine LED mit Mesastruktur zu bilden. Die transparente Kontaktschicht (TCL) aus Indium-Zinn-Oxid (ITO) wird auf dem p + . abgeschieden -GaN-Oberfläche durch einen Elektronenstrahlverdampfer. Chrom/Platin/Gold (Cr/Pt/Au) Multimetall-Kontaktelektrodenschichten werden anschließend auf das p + . aufgedampft -GaN- und n-GaN-Schichten für guten ohmschen Kontakt. LED-Wafer werden zum Chip-Dicing geläppt und auf etwa 120 μm herunterpoliert. Standard-LED-Geräte vom Mesa-Typ mit einer quadratischen Chipgröße von 1 mm 2 produziert werden.
Der Strom gegen die Spannung (I -V ) Kurven und die Lichtleistung (P aus ) gegen Injektionsstrom (L -ich ) werden Kurven von 20 bis 300 mA bei Raumtemperatur (RT) von Dioden gemessen. Temperaturabhängige Photolumineszenz (PL)-Spektren von In0,2 . mit acht Perioden Ga0.8 N/GaN-QWs werden untersucht. Die Anregungslichtquelle von PL ist ein He-Cd-Laser (325 nm) mit einer durchschnittlichen Leistung von 45 mW. Die hochauflösenden Transmissionselektronenmikroskopie-(HRTEM-)Bilder stammen von einem EM-3000F-Feldemissions-Transmissionselektronenmikroskop (FE-TEM) mit einer Beschleunigungsspannung von 300 kV und einer Auflösung von 0,14 nm.
Ergebnisse und Diskussion
Abbildung 2 zeigt die PL-Spektren von Proben bei verschiedenen Temperaturen von 10 bis 300 K. Die monotone Abnahme der PL-Peakintensität mit steigender Temperatur kann beobachtet werden. Dies ist auf den Anstieg des nichtstrahlenden Rekombinationsprozesses mit dem Anstieg der Temperatur zurückzuführen. Alle PL-Spektralprofile werden durch Gaußsche Linienformfunktionen angepasst, um die Variationen der maximalen Spitzenenergie mit der Temperatur zu finden, wie in Abb. 3 gezeigt. Die maximale Emissionsspitzenenergie von PL für das undotierte In0,2 Ga0.8 N/GaN-QWs beträgt 2,68 eV bei Raumtemperatur. Dies bedeutet, dass die PL-Spitzenenergien von Proben mit den ersten zwei bis fünf QBs mit Si-Dotierung eine Blauverschiebung aufweisen, wenn sie mit der undotierten verglichen wird. Die ersten zwei bis fünf QBs mit Si-Dotierung können die QCSE in QWs effektiv senken. Es sollte darauf hingewiesen werden, dass die Verwendung von PSSs und SRLs in den Strukturen von Epischichten den Anteil des piezoelektrischen (PZ) Felds sowie QCSE in In0.2 . reduzieren kann Ga0.8 N/GaN-QWs.

Temperaturabhängige PL-Spektren von Proben bei verschiedenen Temperaturen von 10 bis 300 K

Variationen der maximalen PL-Peak-Energie gegenüber der Temperatur der Proben. Die am besten passenden Kurven mit der Varshni-Gleichung werden in dicken und schwarzen durchgezogenen Linien angezeigt
In Abb. 3 können Variationen der maximalen PL-Spitzenenergie gegenüber der Temperatur gezeigt werden, die S-förmige Kurven aller Proben aufweisen. Die S-förmigen Kurven zeigen eine anfängliche Rot-, dann Blau- und dann eine Rotverschiebung mit steigender Temperatur. Dieses Verhalten wird der temperaturabhängigen kollektiven Lumineszenz von stark lokalisierten Exzitonen in QWs zugeschrieben. Die unten gezeigte empirische Varshni-Gleichung kann verwendet werden, um den Bereich der Blau-zu-Rot-Verschiebung der S-förmigen Variationen anzupassen [19,20,21].
$$ {E}_{\mathrm{g}}(T)={E}_{\mathrm{g}}(0)-\frac{\alpha {T}^2}{\left(T-\ beta \right)}-\frac{\sigma^2}{k_{\mathrm{B}}T} $$ (1)wo E g (0), α , β , und σ sind die passenden Parameter. E g (0) ist die Bandlückenenergie von QW bei der absoluten Temperatur 0 K. α und β sind die thermischen Koeffizienten, die materialabhängige Parameter sind. σ ist der Gaußsche Verbreiterungsparameter und spiegelt physikalisch den Grad der thermischen Verteilung der Ladungsträger innerhalb der Bandschwanz-lokalisierten Zustände wider. Der zweite Term in Gl. (1) zeigt an, dass die Bandlückenenergie von Halbleitern mit steigender Temperatur tendenziell abnimmt, und wird aufgrund der Zunahme der Amplitude der Atomschwingungen als Energielückenschrumpfung bezeichnet. Der dritte Term wird verwendet, um den Grad der Ladungsträgerlokalisierung mit der Temperatur unter der Annahme einer nicht entarteten Ladungsträgerverteilung und einer Gauß-ähnlichen lokalisierten Zustandsdichte zu charakterisieren. Eine starke Ladungsträgerlokalisierung ist ein entscheidender Aspekt bei der Realisierung der Erhöhung der Strahlungsrekombination und des IQE in InGaN-QWs aufgrund der Verbesserung der Überlappung zwischen Elektronen- und Lochwellenfunktionen. Die Varshni-Gleichung ist im Bereich der Rotverschiebung der PL-Peakenergie bei niedriger Temperatur aufgrund der starken Entartung der Ladungsträgerverteilung nicht anwendbar. Die besten Anpassungsergebnisse der Proben sind in Abb. 3 in dicken und schwarzen durchgezogenen Kurven dargestellt. Die Lokalisierungsenergie der Proben A, B, C und D beträgt 24, 28, 41 bzw. 13 meV. Probe C besitzt die größte Lokalisierungsenergie, σ (41 meV). Die Trägerlokalisierung in den QWs mit vier Si-dotierten QBs ist stärker als die anderen. Die kleinste Lokalisierungsenergie (σ ) tritt in Probe D mit dem Wert 13 meV auf.
Strom-Spannung (I -V )-Eigenschaften unter Vorwärts- und Rückwärtsvorspannung von blauen LEDs sind in Abb. 4 gezeigt. In dieser Abbildung betragen die Einschaltspannungen für die Proben A, B, C und D 3,41, 3,47, 3,27 und 4,03 V beim Vorwärtsstrom 20 mA. Die Durchbruchspannungen für die Proben A, B, C und D betragen – 8,85, – 9,99, – 6,77 bzw. – 11,55 V bei einem Sperrstrom von 1 μA. Probe C hat die kleinsten Einschalt- und Durchbruchspannungen. Probe D hat die größten Einschalt- und Durchbruchspannungen. Dementsprechend wird in Probe C eine niedrigere Barrierehöhe der QBs vorgeschlagen. In der Probe mit den ersten vier QBs mit Si-Dotierung wird ein weiches (glattes) Begrenzungspotential der QWs erwartet. Ein weiches Begrenzungspotentialprofil impliziert, dass Leitungs- und Valenzband-Offsets von QWs nicht als scharfe Stufenfunktionen, d. h. nicht als rechteckiges Begrenzungspotential, genommen werden. Glatte Begrenzungspotentiale können die Auger-Rekombination weitgehend unterdrücken und die Ansammlung vieler Ladungsträger in den ersten mehreren Wells in Injektionsrichtung von InGaN/GaN-QWs verhindern [22,23,24]. Ein glattes Begrenzungspotential kann auch durch eine lineare Abnahme der In-Zusammensetzung entlang der Wachstumsrichtung von InGaN/GaN-QWs erreicht werden. Dies kann zu einer besseren Verteilung der Ladungsträger zwischen QWs und zum Transport von Löchern führen, was zu einer Verbesserung des schnellen Abfalls von EQE und der Lichtausgangsleistung führt [25,26,27,28,29,30].
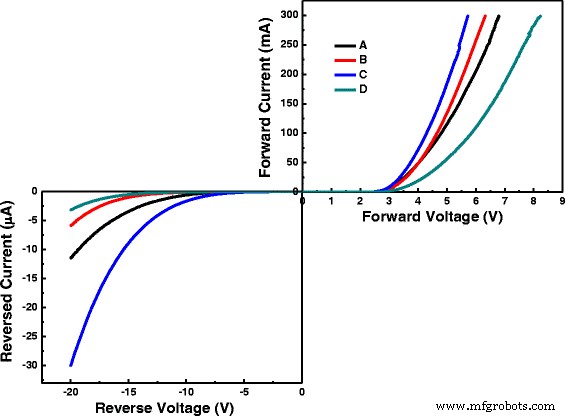
Strom-Spannung (I -V ) Kurven unter Vorwärts- und Rückwärtsvorspannung von Dioden
Abbildung 5 zeigt die Messungen der Lichtausgangsleistung (P aus ) von LEDs versus Injektionsstrom (L -ich ) Kurve von 0 bis 300 mA mit einem Chiptester. Der Anstieg des P aus mit der Erhöhung des Injektionsstroms von L -ich Kurven können beobachtet werden. Das höchste und das niedrigste P aus für hohen Injektionsstrom sind in den Proben C bzw. D gezeigt. Sättigungen von P aus beim Injektionsstrom werden 300 mA in allen Proben mit Ausnahme von Probe C angezeigt. Sättigungseffekt von P aus bezieht sich auf den die QWs überfließenden Strom. Der geringere Strom, der die QWs überfließt, findet im weichen Einschlusspotential der QWs und der starken Ladungsträgerlokalisierung innerhalb der QW-Probe statt. Eine bessere Ladungsverteilung zwischen acht QWs und eine starke strahlende Rekombination von Ladungsträgern innerhalb von QWs werden in der Probe mit vier QBs mit Si-Dotierung angezeigt.

Lichtausgangsleistung (P aus ) gegen Injektionsstrom (L -ich ) Kurven von 0 bis 300 mA von Dioden
Die Dunkelfeld-, Hellfeld- und vergrößerten Hellfeldbilder eines hochauflösenden Transmissionselektronenmikroskops (HRTEM) im Querschnitt von Proben sind in den Fig. 1 und 2 gezeigt. 6, 7 und 8. In Fig. 6 entsprechen helle und dunkle Kontraste InGaN- und GaN-Epischichten. Acht Perioden von QWs und 20 Paare von Übergittern können beobachtet werden. In Abb. 7 repräsentieren dunkle Kontrastvariationen die Schwankungen des lokalen In-Gehalts und die Bildung von indiumreichen Clustern in QWs [31,32,33,34]. Indiumreiche Cluster wirken als relativ tiefe lokalisierte Zustände von Ladungsträgern, was zu einer starken exzitonischen Rekombination mit Strahlung führt. Um diese indiumreichen Cluster werden Gitterverzerrung und Stapelfehler festgestellt, was darauf hindeutet, dass sich die Spannungsenergie in der InGaN-Schicht teilweise entspannt hat, wie im vergrößerten Bild des roten Quadrats in Abb. 8a gezeigt. Im Vergleich zu den vergrößerten Hellfeldbildern sind in den Proben C und D diffusere (nicht abrupte) Grenzflächen von QWs zu sehen, wie in Abb. 8c, d gezeigt. Der Wirkstoff stammt aus der wohlbekannten Interdiffusion von In- und Ga-Atomen an der Grenzfläche Wanne/Barriere. In Probe D trat eine sehr schwache Begrenzung und Trägerlokalisierung von QWs auf, was mit dem schlechtesten optoelektronischen Verhalten dieser Probe übereinstimmt. In den Bildern bilden sich nicht in allen Proben Threading-Dislokationen (TDs). NRCs treten hauptsächlich an TD-Standorten auf. Aufgrund der Verwendung von PSSs und SRLs zeigt sich in diesen Proben wie erwartet eine bessere Qualität der Epischichten [35,36,37]. Vier QBs mit Si-Dotierung in Acht-Perioden-QWs sind die günstige Voraussetzung, um das Begrenzungspotential zu modifizieren, um ein weiches Begrenzungspotential von InGaN/GaN-QWs zu erreichen, was zu der besten optoelektronischen Leistung der blauen LED führt.
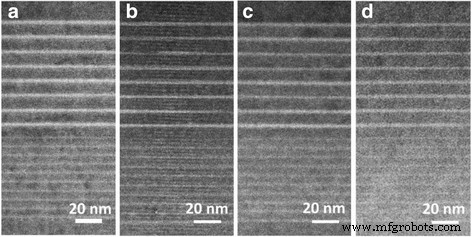
Dunkelfeldaufnahmen der Proben. a Probe A. b Probe B. c Probe C. d Beispiel D
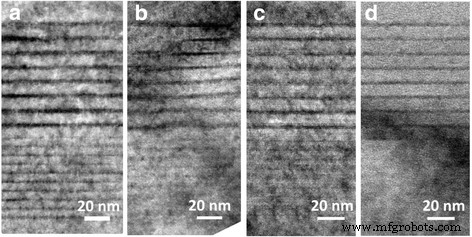
Hellfeldaufnahmen der Proben. a Probe A. b Probe B. c Probe C. d Beispiel D
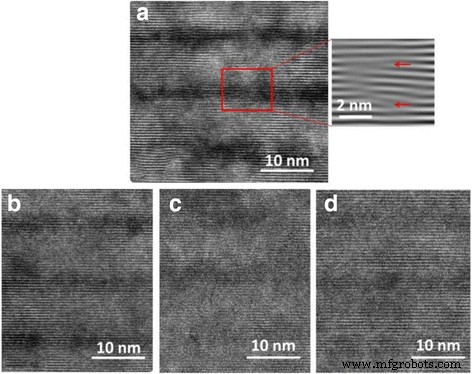
Vergrößerte Hellfeldbilder der Proben. a Probe A. b Probe B. c Probe C. d Beispiel D
Schlussfolgerungen
Temperaturabhängige PL-Spektren, I -V Kurven, L -ich Kurven und HRTEM-Bilder von blauen LEDs mit Acht-Perioden-In0,2 Ga0.8 Es wurden N/GaN-QWs mit den ersten zwei bis fünf QBs in der Abscheidungssequenz mit Si-Dotierung untersucht. Die Ergebnisse zeigen, dass die Probe mit den ersten vier QBs mit Si-Dotierung eine relativ niedrigere Barrierehöhe und eine größere Lokalisierungsenergie der Ladungsträger aufweist, was durch diffusive Grenzflächen von QWs in HRTEM-Bildern belegt wird. Ein weiches Einschlusspotential von QWs, begleitet von einer stärkeren Trägerlokalisierung innerhalb von QWs, führt zu einer gleichmäßigeren Verteilung von Trägern unter acht QWs und einer höheren Strahlungsrekombination von Trägern innerhalb von QWs in dieser Probe. Bei blauen LEDs mit vier Si-dotierten QBs unter hohem Injektionsstrom trat eine Abnahme von Auger-Prozessen und Ladungsverlusten sowie eine Zunahme der strahlenden Rekombination von QWs auf. Die Ergebnisse liefern optimale Bedingungen für QBs mit Si-Dotierung durch die Analyse der Auswirkungen von Ladungsträgerlokalisierung, Einschlusspotential, PZ-Feld und Material-Nanostrukturen auf die Lumineszenzeigenschaften von In0,2 Ga0.8 N/GaN-QWs von blauen LEDs.
Abkürzungen
- Al:
-
Aluminium
- Cp2 Mg:
-
Bis-cyclopentadienylmagnesium
- EBL:
-
Elektronenblockierschicht
- EQE:
-
Externe Quanteneffizienz
- FE-TEM:
-
Feldemissions-Transmissionselektronenmikroskop
- Ga:
-
Gallium
- HRTEM:
-
Hochauflösende Transmissionselektronenmikroskopie
- ICP:
-
Induktiv gekoppeltes Plasma
- In:
-
Indium
- IQE:
-
Interne Quanteneffizienz
- ITO:
-
Indium-Zinn-Oxid
- I -V :
-
Strom gegen Spannung
- L -ich :
-
Lichtausgangsleistung versus Injektionsstrom
- LP-MOCVD:
-
Niederdruckmetallorganische chemische Gasphasenabscheidung
- Mg:
-
Magnesium
- N:
-
Stickstoff
- n-GaN:
-
n-Typ GaN
- NRCs:
-
Strahlungsfreie Rekombinationszentren
- PL:
-
Photolumineszenz
- PSSs:
-
Gemusterte Saphirsubstrate
- PZ:
-
Piezoelektrisch
- QBs:
-
Quantenbarrieren
- QCSE:
-
Quantenbegrenzter Stark-Effekt
- QWs:
-
Quantenbrunnen
- RT:
-
Raumtemperatur
- Si:
-
Silizium
- SiH4 :
-
Silan
- SRLs:
-
Zugentlastungsschichten
- TCL:
-
Transparente Kontaktschicht
- TMAl:
-
Trimethylaluminium
- TMGa:
-
Trimethylgallium
- TMIn:
-
Trimethylindium
- u-GaN:
-
Undotiertes GaN
Nanomaterialien
- 5G und GaN:Der Wechsel von LDMOS zu GaN
- Die atomare Umlagerung von GaN-basierten mehreren Quantenquellen in H2/NH3-Mischgas zur Verbesserung der strukturellen und optischen Eigenschaften
- Einfluss von Oberflächenzuständen und Aluminium-Molekülfraktion auf das Oberflächenpotential und 2DEG in AlGaN/GaN-HEMTs
- Mehrfarbige Emission von ultravioletter GaN-basierter photonischer Quasikristall-Nanopyramidenstruktur mit semipolaren InxGa1−xN/GaN-Mehrfachquantenquellen
- Infrarotreflexionsanalyse von epitaktischen n-dotierten GaN-Schichten, die auf Saphir gewachsen sind
- Wismut-Quantenpunkte in geglühten GaAsBi/AlAs-Quantenbrunnen
- Durchbrechen der Multi-Mesa-Kanal-Breite begrenzt von normalerweise Off GaN-HEMTs durch Modulation der Via-Hole-Länge
- Untersuchung der Oberflächenpolarisation einer Al2O3-beschichteten GaN/AlGaN/GaN-Heterostruktur durch winkelaufgelöste Röntgenphotoelektronenspektroskopie
- Verstehen des Wachstumsmechanismus von GaN-Epitaxieschichten auf mechanisch abgeblättertem Graphit
- Herstellung eines periodischen Polystyrol-Nanosphären-Arrays unter Verwendung der Dip-Drop-Methode mit Ätzen nach der Abscheidung und deren Anwendung zur Verbesserung der Lichtextraktionseffizienz v…



