Elektrische Eigenschaften von mittel- und langwelligen InAs/GaSb-Übergittern, die auf GaAs-Substraten durch Molekularstrahlepitaxie gewachsen sind
Zusammenfassung
In der vorliegenden Arbeit berichten wir über die elektrischen Transporteigenschaften in der Ebene von mittelwelligen (MWIR) und langwelligen Infrarot (LWIR) InAs/GaSb Typ-II-Übergittern (T2SLs), die durch Molekularstrahlepitaxie (MBE)-System auf GaAs (001) gezüchtet wurden. Substrat. Die große Gitterfehlanpassung zwischen dem T2SL- und dem GaAs-Substrat wird durch das Wachstum der GaSb-Pufferschicht basierend auf der Interfacial Misfit Array (IMF)-Technik reduziert. Um die Dehnung im InAs/GaSb T2SL zu kompensieren, haben wir eine spezielle Shutter-Sequenz verwendet, um InSb-ähnliche und GaAs-ähnliche Grenzflächen zu erhalten. Es zeigt sich, dass das MWIR InAs/GaSb T2SL ein p - und n -Typ-Leitung bei niedrigen bzw. hohen Temperaturen. Interessanterweise wird beobachtet, dass die Temperatur der Leitungsänderung von der Wachstumstemperatur abhängt. Andererseits wird die LWIR-T2SL-Leitung nur von Elektronen dominiert. Es ist wichtig zu beachten, dass der dominante Streumechanismus in LWIR T2SL bei niedrigen Temperaturen der Streumechanismus der Grenzflächenrauheit ist.
Hintergrund
Da InAs/GaSb T2SL von Sai-Halasz et al. [1] 1977 wurde der Untersuchung dieses Halbleitermaterials große Aufmerksamkeit geschenkt. Auf dieser T2SL basierende Photodetektoren bieten theoretisch ein höheres Potenzial gegenüber Quecksilber-Cadmium-Tellurid (HgCdTe) und den hochmodernen Infrarot-Materialsystemen für die nächste Generation von Infrarot (IR)-Anwendungen [2, 3]. Interessanterweise weist InAs/GaSb-T2SL eine ungewöhnliche Typ-II-Bandanordnung mit unterbrochener Gap auf, bei der das Minimum des InAs-Leitungsbandes 140 meV niedriger liegt als das obere Ende des GaSb-Valenzbandes [1]. Folglich hängt der fundamentale Übergang zwischen den Subbändern der schweren Löcher und dem Boden des Leitungsbandes von der Dicke der InAs- oder GaSb-Schicht ab [4]. Der Hauptvorteil dieser Ausrichtung ist jedoch die Verringerung der Auger-Rekombinationsrate dank der Unterdrückung einiger nicht-strahlender Pfade im Valenzband [5]. Darüber hinaus wird das Tunneln von Band zu Band aufgrund der großen effektiven Massen (≈ 0,04 m 0 ) von Elektronen und Löchern [6]. Diese beiden letzteren Merkmale ermöglichen die Reduzierung des Dunkelstroms, was zu einer hohen Betriebstemperatur (HOT) des Photodetektors führt.
InAs/GaSb T2SL wird traditionell auf einem gitterangepassten GaSb-Substrat aufgewachsen. Letzteres ist jedoch teuer und in kleinen Größen von weniger als 3 Zoll erhältlich, was die Realisierung großformatiger Focal Plane Arrays (FPAs) erschwert. Darüber hinaus sind GaSb-Substrate nicht „epi-ready“ und ihre Wachstumsoberflächen enthalten viele makroskopische Defekte [7]. Darüber hinaus ist der Absorptionskoeffizient im GaSb-Substrat relativ hoch (≈ 100 cm –1 ) für IR-Strahlung über 5 μm [8]. Aufgrund seiner zahlreichen Vorteile wurde GaAs als geeigneter Kandidat für das Wachstum von InAs/GaSb T2SL vorgeschlagen [9,10,11,12]. Tatsächlich sind sie „epi-ready“, kosteneffizient und in großen Größen bis zu 6 Zoll erhältlich. Außerdem hat GaAs einen Absorptionskoeffizienten, der zwei Größenordnungen niedriger ist als der von GaSb. Leider besteht zwischen GaAs und InAs/GaSb T2SL eine große Gitterfehlanpassung (~7,5 %), die zu einer hohen Fehlanpassungsversetzungsdichte (10 9 cm −2 ) [13]. Daher ist es zwingend erforderlich, neue Wachstumstechniken zu konzipieren, um die Belastung zu verringern und die Versetzungsdichte zu reduzieren. Zu diesen Techniken gehören die Niedertemperatur-Keimbildung [14] und die IMF-Technik [15, 16].
Um die Leistung von Photodetektoren basierend auf InAs/GaSb T2SL zu verbessern, ist ein besseres Verständnis der grundlegenden Parameter erforderlich. Einer dieser Parameter ist die Hintergrundträgerkonzentration, die mit der Minoritätsträgerlebensdauer und den Diffusionslängen verbunden ist. Es ist erwähnenswert, dass InAs- und GaSb-Volumenmaterialien eine entgegengesetzte Polarität der Ladungsträgerkonzentration aufweisen. Tatsächlich sind InAs- und GaSb-Materialien, die mit Molekularstrahlepitaxie (MBE) gezüchtet wurden, restlich n - und p -Typ bzw. [17, 18]. Folglich wird vorhergesagt, dass die Leitfähigkeit des InAs/GaSb T2SL von der Dicke jedes Bestandteils abhängt.
In diesem Artikel untersuchen wir die Transporteigenschaften in der Ebene von 10 ML InAs/10 ML GaSb und 24 ML InAs/7 ML GaSb T2SLs für die Detektion in MWIR- bzw. LWIR-Regionen, die auf halbisolierendem GaAs (001) aufgewachsen sind. Substrate. Diese Studie wird durch eine temperaturabhängige Hall-Effekt-Messung nach der Van-der-Pauw-Methode durchgeführt. Außerdem wird der Einfluss der Wachstumstemperatur auf die Leitfähigkeit des InAs/GaSb T2SL dargestellt.
Methoden
InAs/GaSb-T2SL-Proben wurden auf halbisolierenden GaAs (001)-Substraten in einem RIBER Compact 21-DZ-Feststoffquellen-MBE-System gezüchtet. Letztere ist mit Standard-Effusionszellen für Gruppe-III-Elemente (Indium (In) und Gallium (Ga)) und mit Ventilen versehenen Crackzellen für Gruppe-V-Materialien (Arsen (As) und Antimon (Sb)) ausgestattet. Die Crackertemperaturen wurden sowohl für As als auch für Sb bei 900 °C gehalten, um As2 . zu produzieren und Sb2 , bzw. Das Manipulator-Thermoelement (TC) und BandiT (BT) werden verwendet, um die Wachstumstemperatur zu überwachen. Letzteres wurde anhand der Desorptionstemperatur des GaAs-Oxids kalibriert. Nach der Desoxidation von GaAs-Substraten bei 610 °C (gemessen mit BT) wurde eine 250 nm dicke GaAs-Schicht bei 585 °C (BT) abgeschieden, um eine glatte Startoberfläche zu erhalten. Anschließend wurde eine 1 µm dicke GaSb-Pufferschicht mittels IMF-Technik bei einer BT-Temperatur von 440 °C aufgewachsen [16, 19]. Diese Technik besteht in der Bildung einer periodischen Anordnung von 90°-Fehlanpassungsversetzungen an der GaAs/GaSb-Grenzfläche, was zu einer geringen Versetzungsdichte (≈ 10 6 cm −2 ) [20]. Nach dem Wachstum der GaSb-Pufferschicht kann der BT aufgrund der Emissionsgradänderungen, der Oberflächenaufrauhung und der zusätzlichen Strahlungsabsorptionsmechanismen nicht mehr verwendet werden [21]. Somit wird die Wachstumstemperatur des InAs/GaSb T2SL nur durch den TC gesteuert. MWIR 10 ML InAs/10 ML GaSb T2SLs werden bei verschiedenen Substrattemperaturen, 330, 390 und 400 °C (TC) gezüchtet, um den Einfluss der Wachstumstemperatur auf die Transporteigenschaften zu untersuchen. Andererseits wurde LWIR 24 ML InAs/7 ML GaSb T2SL bei nur 390 °C abgeschieden. Um die Spannungen zwischen InAs und GaSb zu kompensieren, wurde eine spezielle Shutter-Sequenz, von der berichtet wurde, dass sie zu einer besseren strukturellen Qualität führt [22, 23], wie folgt verwendet:Auf das Wachstum von InAs folgte eine Sb-Soak von 8 s zu InSb -ähnliche Bindungen, während auf das GaSb-Wachstum eine 2 s lange As-Soak-Phase folgte, um eine GaAs-ähnliche Grenzfläche wachsen zu lassen. Das Flussverhältnis V/III beträgt 8,3 bzw. 4,6 für InAs bzw. GaSb. Außerdem beträgt die Wachstumsrate sowohl für InAs als auch für GaSb 0,5 ML/s. Das Wachstum wurde in situ durch ein hochenergetisches Reflexionselektronenbeugungssystem (RHEED) überwacht.
Die gewachsenen Proben wurden durch hochauflösende Röntgenbeugung (HRXRD) von PANalytical X’Pert untersucht, um die strukturellen Eigenschaften zu untersuchen. Der Cu-Kα1 Strahlung (λ ≈ 1.5406 Å), die aus einem Linienfokus und einem Vier-Bounce-Ge(004)-Monochromator stammen, wurden verwendet. Die Transporteigenschaften wurden durch Hall-Effekt-Messungen unter Verwendung der Van-der-Pauw-Methode in einem ECOPIA-System mit einem Temperaturbereich von 80–300 K bewertet. Die Messungen wurden an quadratischen Proben von 6 × 6 mm 2 . durchgeführt; Der Kontakt wurde durch Indiumpunkte in jeder Ecke hergestellt. Ein Magnetfeld von 0,4 T wurde normal an die Proben angelegt.
Ergebnisse und Diskussion
Abbildung 1 zeigt die gemessene und simulierte HRXRD 2θ-ω Abtastkurven der symmetrischen (004)-Reflexion für die MWIR- und LWIR-InAs/GaSb-T2SLs. Die Simulation wird von der Software „Epitaxy“ von PANalytical X’Pert durchgeführt. Wie man sieht, gibt es gut aufgelöste Satelliten mit einer Ordnung von bis zu 4 für MWIR T2SL und bis zu 7 für LWIR eins. Dies deutet auf die hohe strukturelle Qualität der gewachsenen Schichten, insbesondere für LWIR T2SL, hin. Andererseits ist die Halbwertsbreite (FWHM) des Peaks nullter Ordnung gemessen in ω-2θ Die Richtung beträgt 107 Bogensekunden und 99 Bogensekunden für MWIR- bzw. LWIR-T2SLs. Die Übergitterperiode (L ) wird aus dem Winkelabstand zwischen zwei benachbarten Satelliten (Δθ ) wie folgt:

HRXRD 004 2θ-ω Scan von a MWIR b und LWIR-InAs/GaSb-T2SLs. Experimentell (schwarze Linie) und simuliert (rote Linie) HRXRD 2θ-ω sucht nach der (004)-Reflexion von a MWIR T2SL; es gibt gut aufgelöste Satelliten mit einer Ordnung bis 4, was für eine gute Qualität des Übergitters charakteristisch ist. Die FWHM des Peaks nullter Ordnung beträgt 107 Bogensekunden, b und LWIR-InAs/GaSb-T2SLs; es gibt Satellitenpeaks mit einer Ordnung bis 7, was die hohe kristalline Qualität bestätigt. Die FWHM des Peaks nullter Ordnung beträgt 99 Arcsec. Die Periode jedes Übergitters wird aus dem Abstand zwischen benachbarten Satelliten berechnet
$$ L=\lambda /\left(2\times \Updelta \theta\times\mathit{\cos}{\theta}_{SL}\\right) $$ (1)wo λ die Wellenlänge des oben erwähnten einfallenden Röntgenstrahls ist und θ SL ist der Bragg-Winkel des Peaks nullter Ordnung des Übergitters. In Abb. 1 beträgt die Periode der MWIR- und LWIR-T2SLs 6,74 ± 0,01 bzw. 10,24 ± 0,02 nm. Durch Anpassen der gemessenen Kurve an die simulierte ergibt sich die Zusammensetzung einer Periode von MWIR T2SL wie folgt:GaSb 3,4 nm (11,2 ML), GaAs 0,1 nm (0,2 ML), InAs 3,0 nm (10,1 ML) und InSb 0,2 nm (0,5 ML). Darüber hinaus sind die Dicken der LWIR-T2SL-Bestandteile wie folgt:GaSb 2,3 nm (7,5 ML), GaAs 0,1 nm (0,2 ML), InAs 7,4 nm (24,7 ML) und InSb 0,4 nm (1 ML). Die aus dem Winkel zwischen dem Peak nullter Ordnung und der GaSb-Pufferschicht bestimmte Gitterfehlanpassung beträgt 8,9 × 10 –3 und 4,5 × 10 −3 für MWIR- bzw. LWIR-T2SLs. Abbildung 2 zeigt die asymmetrische (115) reziproke Raumkarte (RSM) für die gewachsenen T2SLs. In beiden Proben sind die Satelliten der Übergitter und des GaSb-Peaks vertikal ausgerichtet (sie haben die gleiche Komponente des Streuvektors Qx ), was zu dem Schluss führt, dass beide T2SLs praktisch voll belastet sind.

Asymmetrische 115 RSM von a MWIR und b LWIR-InAs/GaSb-T2SLs. Die reziproke Raumkarte für die asymmetrische Reflexion (115) von a MWIR und b LWIR-InAs/GaSb-T2SLs. Die Peaks in beiden Übergittern sind vertikal ausgerichtet (sie haben den gleichen Wert des Streuvektors Qx ). Daher sind die beiden Übergitter für MWIR und LWIR praktisch vollständig gespannt
Die elektrischen Parameter in der Ebene der gewachsenen MWIR InAs/GaSb T2SLs sind in Abb. 3 dargestellt. Wie zu sehen ist, zeigt das unbeabsichtigt dotierte InAs/GaSb T2SL eine reproduzierbare Änderung des Leitfähigkeitstyps. Trotz des Einflusses der GaSb-Pufferschicht (p -type) bei den Hall-Effekt-Messungen ist zu beachten, dass die Änderung des Leitfähigkeitstyps nur auf die T2SL-Schicht zurückzuführen ist. Diese Veränderung wurde auch von mehreren Gruppen berichtet [6, 24,25,26]. Die T2SL weist ein p . auf -Typ-Leitung unterhalb der Temperatur, bei der die Änderung auftritt (T ch ) und ein n -Typ-Leitung über T ch . Wie bereits erwähnt, weisen die InAs- und GaSb-Schichten ein n . auf -typ und p -Typ Leitung bzw. Daher wird der Resthintergrund des InAs/GaSb-T2SL mit ähnlicher Dicke für die beiden Bestandteile durch die Majoritätsträgerkompensation aus den binären Bestandteilen des T2SL induziert [27]. Für den Wert von T ch , Mohseni et al. [6] berichteten über einen Wert von 140 K, Christol et al. [24] erhielt einen Wert von 190 K, während Khoshakhlagh et al. [25] wies auf einen Wert von 200 K hin. Das Verhalten der Schichtträgerkonzentration und -beweglichkeit wird durch die bekannten intrinsischen Phononenstreuungsmechanismen (akustisch, piezoelektrisch, polar und unpolar optisch) bestimmt. Ausnahmsweise steigt die Hall-Mobilität mit einer Temperaturerhöhung über T ch (Abb. 3b); das ist wahrscheinlich wegen der ionisierten Fallen aufgrund der InSb-Grenzfläche an der GaSb-auf-InAs-Grenzfläche [6]. T ch der Wert beträgt 145, 195 und 225 K für die T2SL, die bei 330, 390 bzw. 400 °C gewachsen ist (Abb. 3); das liegt wahrscheinlich auf die hohe Lochkonzentration bei höherer Wachstumstemperatur, was die T ch Temperatur zu senken. Die hohe Lochkonzentration ist auf Defekte und ionisierte Leerstellen bei hoher Wachstumstemperatur zurückzuführen. Das bei 390 °C gewachsene InAs/GaSb-T2SL zeichnet sich durch eine Ladungsträgerkonzentration von 1,8 × 10 16 . aus und 2,5 × 10 16 cm −3 bei 80 bzw. 300 K. Dieses Ergebnis ist besser als das von Mohseni et al. [6] (Hall-Konzentration reicht von 1,5 bis 4 × 10 17 cm −3 ) und praktisch die gleiche wie die von Christol et al. [24] (Hallkonzentration von 1,6 × 10 16 und 6 × 10 16 cm −3 bei 100 bzw. 300 K). Andererseits beträgt die Hallenmobilität 1300 (p -Typ) und 3200 cm 2 /V s (n -Typ) bei 80 bzw. 300 K. Die erreichte Mobilität ist viel höher als die von Christol et al. [24], die eine Hall-Mobilität von 100 und 1800 cm 2 erreicht haben /V s bei 100 bzw. 300 K.

a Hallenkonzentration und b Hall-Mobilität von MWIR InAs/GaSb T2SL, gewachsen bei verschiedenen Temperaturen. Die elektrischen Parameter der bei verschiedenen Temperaturen gewachsenen MWIR InAs/GaSb T2SLs. a Hall-Konzentration:Die drei T2SL weisen eine Leitfähigkeitsänderung auf. Sie sind p -Typ bei niedrigen Temperaturen und n -Typ bei hohen Temperaturen. b Hallenmobilität:Für die Mobilitätstendenz gibt es zwei Regionen. Bei niedriger Temperatur nimmt die Mobilität aufgrund der unterschiedlichen Streumechanismen ab. Bei hohen Temperaturen erhöht sich die Mobilität durch Temperaturerhöhung, was durch die ionisierten Fallen in der InSb-ähnlichen Grenzfläche erklärt werden kann. Die Temperatur, bei der die Leitfähigkeitsänderung auftritt, steigt mit steigender Wachstumstemperatur, was auf die hohen Defektniveaus bei höheren Temperaturen zurückzuführen ist
Der spezifische Widerstand der drei verschiedenen Proben ist in Abb. 4 dargestellt. Es ist zu erkennen, dass der spezifische Widerstand und die Temperatur zwei gut definierte Steigungen aufweisen. Für jede Probe können aus dem Arrhenius-Gesetz zwei thermische Aktivierungsenergien extrahiert werden. Für die n -Typ Region, die Aktivierungsenergie E ein beträgt 58, 72 und 68 meV für die T2SL, die bei 330, 390 bzw. 400 °C gewachsen ist. Während für die p -Typ Region, E ap gleich 7, 12 und 14 meV für das bei 330, 390 bzw. 400 °C abgeschiedene InAs/GaSb-T2SL. Für niedrige Temperaturen (unter T ch ), zeigt die T2SL ein p -Typ wegen p -Typ-Träger, die mit E . verbunden sind ap die die Trägererzeugungs- und Rekombinationsmechanismen dominieren. Für Temperaturen über T ch , weist die T2SL ein n . auf -Typ-Leitung aufgrund der Aktivierung von tiefen Ladungsträgern verbunden mit hoher Aktivierungsenergie E ein . Die Quelle dieser tiefen Niveaus sind die flachen Niveaus im Bulk-InAs, die das Ergebnis der Bandanordnung zwischen InAs und InAs/GaSb T2SL sind und die als tiefe Niveaus im InAs/GaSb T2SL wirken [28].
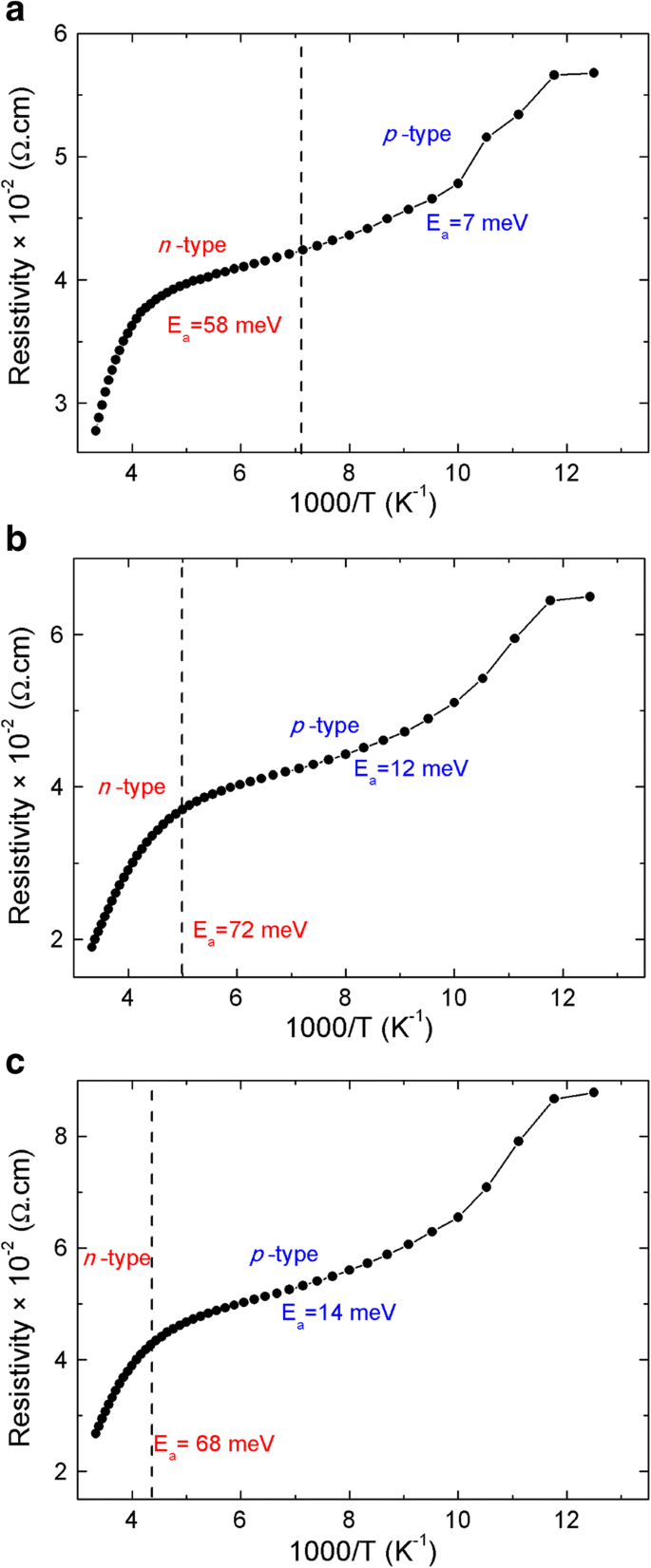
Hall-Widerstand des MWIR InAs/GaSb T2SL, gewachsen bei a 330 °C, b 390 °C und c 400 °C. Der Hall-Widerstand des MWIR InAs/GaSb T2SL, abgeschieden bei verschiedenen Wachstumstemperaturen, a 330 °C, b 390 °C und c 400 °C. Für jeden Graphen gibt es zwei wohldefinierte Steigungen. Aus dem Arrhenius-Gesetz können zwei thermische Energien extrahiert werden, was die Existenz von zwei Verunreinigungsniveaus bestätigt. Einer repräsentiert die n -Typ-Träger, und der zweite entspricht dem p -Typ Träger. Die tiefe Verunreinigungsstufe, die mit dem n . verbunden ist -Type Carriers ist das Ergebnis der Bandaufstellung zwischen InAs und InAs/GaSb T2SL
Die Hall-Konzentration, Mobilität und der spezifische Widerstand des LWIR InAs/GaSb T2SL sind in Abb. 5 dargestellt. Im Gegensatz zum MWIR T2SL gibt es bei dieser Probe keine Änderung des Leitfähigkeitstyps. Diese T2SL weist ein n . auf -Typ Leitung. Der Einfluss des p -Typ-GaSb-Pufferschicht (Low-Mobility-Carrier) auf der Hall-Effekt-Messung für dieses n -Typ T2SL (High-Mobility Carrier) ist vernachlässigbar, da die Hall-Mobilität proportional zum Quadrat der Mobilität der Carrier ist. Khoshakhlagh et al. [25] berichteten das gleiche Ergebnis für 13 ML InAs/7 ML GaSb T2SL. Darüber hinaus haben Szmulowicz et al. [29] wies darauf hin, dass LWIR T2SL, bei dem die InAs-Schicht dicker als GaSb ist, tendenziell n . ist -Typ. Dieses n -Typ-Leitung ist auf die große Dicke der InAs-Schicht zurückzuführen (restlich n -dotiert.) im Vergleich zu GaSb. Diese n -Typ-Träger sind mit einer Aktivierungsenergie von 33 meV verbunden (Abb. 5b). Das Verhalten der Hall-Konzentration und -Mobilität ist typisch für n -Halbleiter, mit Ausnahme des Temperaturbereichs unter 95 K, wo die Konzentration und Mobilität der Ladungsträger nahezu temperaturunabhängig sind. Dies ist ein Hinweis auf die Existenz eines temperaturunabhängigen Streumechanismus in diesem Temperaturbereich. Letzteres ist der Mechanismus der Grenzflächenrauheitsstreuung (IRS) [30, 31, 32, 33, 34]. Dieser Mechanismus ist bei tiefen Temperaturen dominant, wo die Phononenstreuung ausgefroren ist [35]. Der IRS-Mechanismus ist auf das Vorhandensein von Grenzflächen sowie auf die Variation der Schichtdicken zurückzuführen, die zu einer Variation der elektronischen Energieniveaus führt; daher wirken sie als Quelle der Trägerstreuung [35]. Darüber hinaus ist die vom IRS-Mechanismus dominierte Hall-Mobilität proportional zur sechsten Potenz der InAs-Dicke (\(\mu\propto{d}_{\mathrm{InAs}}^{6,2}\)) [35].

a Hallenkonzentration, Hallenmobilität und b Hall-Widerstand von unbeabsichtigt dotiertem LWIR InAs/GaSb T2SL. Die Transporteigenschaften des LWIR InAs/GaSb T2SL. a Hallenkonzentration und Mobilität:Dieses Übergitter weist nur n . auf -Typ-Leitung für den gesamten Temperaturbereich. Die Hall-Konzentration erhöht sich durch Temperaturerhöhung, die durch die Ionisationseffekte verursacht wird. Andererseits wird das Hall-Mobilitätsverhalten für Temperaturen über 95 K durch die unterschiedlichen Streumechanismen (Phononen und ionisierte Verunreinigungen) bestimmt. Für Temperaturen unter 95 K ist die Mobilität konstant (ebenso wie die Hall-Konzentration), was bestätigt die Existenz eines anderen temperaturunabhängigen Streumechanismus. Letzteres ist der Grenzflächenrauheitsmechanismus. b Hall-Widerstand:Nach dem Arrhenius-Gesetz gibt es nur eine thermische Energie, die mit einer Verunreinigungsstufe verbunden ist
Schlussfolgerungen
Zusammenfassend lässt sich sagen, dass InAs/GaSb-T2SLs auf GaAs-Substrat unter Verwendung einer GaSb-Pufferschicht basierend auf der IMF-Technik aufgewachsen wurden. Darüber hinaus wurden diese T2SLs für MWIR- und LWIR-Detektionsregionen nachgewiesen. Es wurde festgestellt, dass MWIR T2SL eine Änderung des Leitungstyps zeigt, Form p - zu n -Typ mit steigender Temperatur. Darüber hinaus steigt die Temperatur, bei der die Änderung auftritt, mit zunehmender Wachstumstemperatur der T2SLs. Diese Änderung des Leitungstyps wird der Existenz zweier Verunreinigungsniveaus mit zwei unterschiedlichen Aktivierungsenergien zugeschrieben. Andererseits wird gezeigt, dass die LWIR InAs/GaSb T2SL-Leitung n . beträgt -Typ für den gesamten Temperaturbereich. Neben den konventionellen Streumechanismen hat sich der IRS-Mechanismus als der dominierende Streumechanismus bei tiefen Temperaturen erwiesen. Diese Ergebnisse ermöglichen ein besseres Verständnis der physikalischen Eigenschaften des InAs/GaSb T2SL, was zu einer Verbesserung der IR-Photodetektorleistung auf Basis dieses Materials führt.
Abkürzungen
- BT:
-
BandiT
- FPAs:
-
Focal-Plane-Arrays
- FWHM:
-
Volle Breite auf halbem Maximum
- HOT:
-
Hohe Betriebstemperatur
- HRXRD:
-
Hochauflösende Röntgenbeugung
- IMF:
-
Grenzflächen-Misfit-Array
- IR:
-
Infrarot
- IRS:
-
Streuung der Grenzflächenrauheit
- LWIR:
-
Langwelliges Infrarot
- MBE:
-
Molekularstrahlepitaxie
- MWIR:
-
Mittelwellen-Infrarot
- RHEED:
-
Reflexion hochenergetische Elektronenbeugung
- RSM:
-
Reziproke Raumkarte
- T2SL:
-
Typ-II-Übergitter
- TC:
-
Thermoelement
Nanomaterialien
- Herstellung und magnetische Eigenschaften von kobaltdotierten FeMn2O4-Spinell-Nanopartikeln
- Auf dem Weg zu TiO2-Nanofluiden – Teil 1:Vorbereitung und Eigenschaften
- Molekulardynamische Modellierung und Simulation des Diamantschneidens von Cer
- Optische und elektrische Eigenschaften von Silizium-Nanodrähten, die durch stromloses Ätzen hergestellt wurden
- Temperaturabhängigkeit der Bandlücke in MoSe2, das durch Molekularstrahlepitaxie gezüchtet wurde
- Auswirkungen der Doppelschichtdicke auf die morphologischen, optischen und elektrischen Eigenschaften von Al2O3/ZnO-Nanolaminaten
- Bipolare Effekte der Photospannung metamorpher InAs/InGaAs/GaAs-Quantenpunkt-Heterostrukturen:Charakterisierungs- und Designlösungen für lichtempfindliche Bauelemente
- Herstellung und optische Eigenschaften von GeBi-Filmen unter Verwendung der Molekularstrahl-Epitaxie-Methode
- Untersuchung der strukturellen, elektronischen und magnetischen Eigenschaften von Ag n V (n = 1–12)-Clustern
- Abhängigkeit der Nanopartikeltoxizität von ihren physikalischen und chemischen Eigenschaften



