Dickenabhängigkeit von Grenzflächen- und elektrischen Eigenschaften in Atomlagen-abgeschiedenem AlN auf c-Ebenen-GaN
Zusammenfassung
Die Grenzflächen- und elektrischen Eigenschaften von AlN mit Atomlagenabscheidung auf n-GaN mit unterschiedlichen AlN-Dicken wurden untersucht. Nach Kapazität–Spannung (C –V )-Eigenschaften zeigte die Probe mit einem 7,4 nm dicken AlN die höchsten Grenzflächen- und Oxidfallendichten. Bei einer AlN-Dicke von 0,7 nm zeigten Röntgenphotoelektronenspektroskopie (XPS)-Spektren den dominanten Peak, der mit Al-O-Bindungen verbunden ist, zusammen mit keinem klaren AlN-Peak. Es wurde festgestellt, dass die Menge der verbleibenden Sauerstoffatome in der Nähe der GaN-Oberfläche für das dickere AlN abnimmt. Über der AlN-Schicht waren jedoch viele Sauerstoffatome vorhanden, die die sauerstoffbezogenen Defekte zur Verfügung stellten, die schließlich die Grenzflächenzustandsdichte erhöhten. Das Modell der Barriere-Inhomogenität mit thermionischer Emission (TE) war geeignet, den Durchlassstrom für die Probe mit einem 7,4 nm dicken AlN zu erklären, der für die Probe mit einem 0,7 nm dicken AlN nicht geeignet war. Die Rückwärtsleckströme für beide Proben mit 0,7 und 7,4 nm dickem AlN wurden besser mit Fowler-Nordheim (FN) als mit Poole-Frenkel-Emissionen erklärt.
Hintergrund
Aufgrund der großen Bandlücke, der hohen Elektronensättigungsgeschwindigkeit und des hohen Durchbruchfeldes sind III-Nitrid-Materialien nicht nur für optoelektronische Geräte wie blaues Licht emittierende Dioden (LEDs), Laserdioden (LDs) und UV-Detektoren von großem Interesse, sondern auch für elektronische Geräte wie Transistoren mit hoher Elektronenmobilität (HEMTs) und Leistungsgeräte [1,2,3,4]. Die Realisierung hochleistungsfähiger GaN-basierter Bauelemente erfordert eine Metall/GaN-Grenzfläche mit einer minimalen Grenzflächenzustandsdichte, die als Elektronenfallen fungieren oder begrenzen kann, um die Barrierenhöhen gemäß der Metallaustrittsarbeit durch Festlegen des Fermi-Niveaus zu modulieren [5, 6]. Für andere GaN-basierte Techniken zur Geräteverbesserung, einige Methoden wie Koaleszenzüberwachsen von GaN-Nanosäulen, unpolare m -plane GaN, Nanoimprint-GaN-Template und semipolare GaN-Nanostäbchen wurden ebenfalls demonstriert [7,8,9,10,11]. Unter den III-Nitrid-Verbindungshalbleitern kann Aluminiumnitrid (AlN) aufgrund seiner hohen Bandlücke (∼ 6,2 eV), seiner hohen Wärmeleitfähigkeit, seines hohen elektrischen Widerstands sowie seiner geringen Ausdehnung auf UV-Detektoren, kurzwellige Emitter und Detektoren angewendet werden bei hohen Temperaturen [12, 13]. Darüber hinaus kann AlN in einem komplementären Metall-Oxid-Halbleiter (CMOS)-kompatiblen Prozess durch Atomlagenabscheidung (ALD) (~ 300 °C) abgeschieden werden, was ein großer Vorteil ist. Polykristalline und amorphe ALD-gewachsene AlN-Filme können als dielektrische Schicht für mikroelektronische Bauelemente verwendet werden [14]. Trotz des Fortschritts der AlN-Wachstumstechniken zeigt ALD-gezüchtetes AlN immer noch nicht-stöchiometrische Eigenschaften, die eine große Menge an sauerstoffbezogenen Verunreinigungen enthalten [15]. Die Menge an Sauerstoffatomen in AlN kann die elektrischen und optischen Eigenschaften von AlN stark beeinflussen [16].
Hoch-k dielektrische Oxide wie Al2 O3 und HfO2 wurden als Passivierungsschicht in AlGaN/GaN-Transistoren mit hoher Elektronenmobilität (HEMTs) eingesetzt [17, 18]. Aber die Bildung von Ga-O-Bindungen am Al2 O3 Es ist bekannt, dass die /(Al)GaN-Grenzfläche eine hohe Dichte an tiefen (und langsamen) Grenzflächenzuständen erzeugt [19]. Als alternatives Passivierungsmaterial mit niedrigen Grenzflächenzuständen wurde AlN aufgrund seiner kleineren Gitterfehlanpassung zu GaN für GaN-basierte Bauelemente in Betracht gezogen [20, 21]. Darüber hinaus wurde in GaN über die Modulation elektrischer Eigenschaften wie Barrierehöhen in Metall/Halbleiter(MS)-Kontakten durch das Einfügen einer sehr dünnen Oxidschicht berichtet [22, 23]. Erhöhung der Barrierehöhe in Pt/HfO2 /GaN-Metall-Isolator-Halbleiter-Dioden (MIS) mit einem 5 nm dicken HfO2 Schicht wurde berichtet [22]. Es wurde festgestellt, dass das Einfügen einer 3-nm-MgO-Schicht an einer Fe/GaN-Grenzfläche die effektive Barrierehöhe auf 0,4 eV reduziert [23]. Bis heute gibt es jedoch nur eine begrenzte Anzahl von Veröffentlichungen, die über die technischen Kontakteigenschaften mit ALD-gewachsenem AlN auf GaN berichten. In dieser Arbeit haben wir AlN-Schichten auf n-GaN mittels ALD mit unterschiedlichen Dicken abgeschieden und die Eigenschaften der AlN/n-GaN-Grenzfläche untersucht.
Methoden
Material- und Geräteherstellung
Hydrid-Dampfphasen-Epitaxie (HVPE) – gezüchtet, undotiert, c -plane (0001) Bulk-GaN (Dicke 300 μm, Ladungsträgerkonzentration 5 × 10 14 cm −3 , Einfädelungsversetzungsdichte 1,5 × 10 7 cm −2 ) von Lumilog gekauft wurde in dieser Arbeit verwendet. Nachdem der Wafer in kleine Stücke geschnitten wurde, wurden einige von ihnen nach dem Reinigungsprozess in einem HCl:H2 . in eine ALD-Kammer geladen O (1:1)-Lösung. Dann wurde die Temperatur auf 350 °C erhöht, um die AlN-Schicht abzuscheiden. AlN-Dünnschichten wurden mit einem thermischen ALD-System (Hersteller:CN-1 in Korea; Modell:Atomic Classic) unter Verwendung von Trimethylaluminium (TMA) und NH3 . abgeschieden als Vorläufer. Durch Variation der Anzahl der ALD-Zyklen wurden drei unterschiedlich dicke AlN-Schichten (0,7, 1,5 und 7,4 nm) hergestellt. Die Dicken des AlN-Films wurden mit einem FS-1-Multiwellenlängen-Ellipsometer (Hersteller:Film Sense in den USA; Modell:FS-1) gemessen. Um die elektrischen Eigenschaften der Filme zu untersuchen, wurden MIS-Dioden mit einer Pt-Schottky-Elektrode (Durchmesser 500 µm, Dicke 50 nm) und einem Al-Rückkontakt (Dicke 100 nm) hergestellt. Als Referenz wurden auch Pt/n-GaN-Schottky-Dioden (d. h. ohne AlN-Schicht) hergestellt.
Charakterisierung
Temperaturabhängige Strom–Spannung (I –V –T ) Messungen wurden mit einem HP 4155B Halbleiterparameteranalysator durchgeführt, nachdem die Proben auf ein heißes Spannfutter gelegt wurden, das mit einem Temperaturregler verbunden war, und die Kapazitätsspannung (C –V ) wurden Messungen mit einem HP 4284A LCR-Messgerät durchgeführt. Röntgenphotoelektronenspektroskopie (XPS)-Messungen wurden mit einem monochromatischen Al Κα . durchgeführt Röntgenquelle zur Beobachtung des Bildungsmechanismus an der AlN/GaN-Grenzfläche.
Ergebnisse und Diskussion
Abbildung 1a–c zeigt die Querschnittsbilder der Rastertransmissionselektronenmikroskopie (STEM) um die AlN-Schicht. Die geschätzten Dicken der AlN-Schichten waren ähnlich den Werten des Ellipsometers. Die typische halblogarithmische Stromdichte–Spannung (J –V )-Kurven sind in Abb. 2a dargestellt. Im Vergleich zur Probe ohne AlN (d. h. Referenzprobe) stiegen die Stromwerte bei der Probe mit 0,7 nm dickem AlN und sanken bei den Proben mit 1,5 und 7,4 nm dickem AlN. Unter Verwendung des Modells der thermionischen Emission (TE) [24] wurde der Vorwärtsstromtransport einer Schottky-Diode analysiert, um sowohl die Barrierehöhe als auch den Idealitätsfaktor zu erhalten. Die Barrierehöhen wurden mit 0,77 (± 0,03), 0,61 (± 0,01), 0,83 (± 0,05) und 1,00 (± 0,08) eV für die Proben mit 0-, 0,7-, 1,5- und 7,4-nm- berechnet. dickes AlN bzw. Die Idealitätsfaktoren waren 1,63 (± 0,18), 4,19 (± 0,16), 1,83 (± 0,33) und 1,57 (± 0,03) für die Proben mit einer Dicke von 0, 0,7, 1,5 und 7,4 nm AlN bzw. Bei einem 0,7 nm dicken AlN verringerte sich die Barrierehöhe und der Idealitätsfaktor stieg. Bei dickeren AlN-Schichten war der Idealitätsfaktor ähnlich, jedoch erhöhte sich die Barrierehöhe im Vergleich zur Referenzprobe. In 2c ist zu sehen, dass mit zunehmender AlN-Dicke die Barrierenhöhe aufgrund des durch die dicke AlN-Schicht induzierten Tunnelwiderstands zuerst abnahm und dann zunahm. Dies deutet darauf hin, dass etwa 0,7 nm ein Wendepunkt für die Barrierenhöhe in Bezug auf die AlN-Dicke sind.
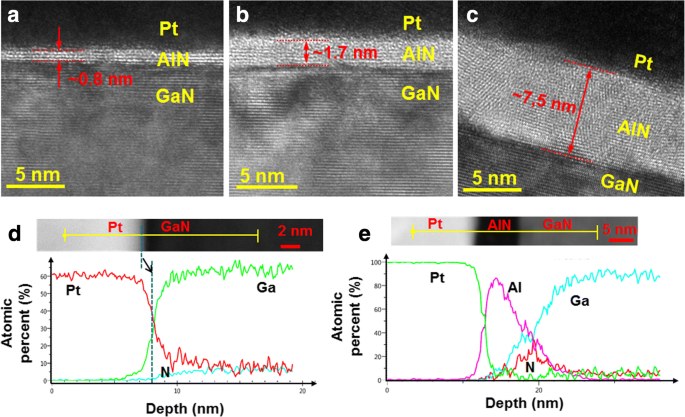
Querschnitt-Rastertransmissionselektronenmikroskopie (STEM)-Bilder mit a 0,7-, b 1,5- und c 7,4 nm dickes AlN. d , e Atomprozente vs. Tiefenprofile, die aus energiedispersiven Röntgenspektroskopie (EDS)-Linienscans für die Proben mit 0- bzw. 7,4 nm dickem AlN erhalten wurden

a Typische halblogarithmische Strom-Spannung (I –V ) Eigenschaften. b Barrierenhöhe vs. Idealitätsfaktor-Plots. c Barrierehöhen und Idealitätsfaktoren in Abhängigkeit von der AlN-Dicke
Abbildung 3 zeigt das C –V Kurven bei verschiedenen Frequenzen gemessen. Wenn die AlN-Dicken 0 und 0,7 nm betragen, wurde die Inversion der Kapazitätswerte unterhalb von 10 kHz beobachtet. Anstelle einer Inversion wird normalerweise bei Materialien mit großer Bandlücke wie GaN aufgrund der geringen Erzeugungsrate von Minoritätsträgern (Löchern) eine tiefe Verarmung beobachtet [25, 26]. Wie in Fig. 3c, d gezeigt, wurde eine solche Inversion für dickere AlN-Schichten nicht beobachtet. Hierbei ist zu beachten, dass im Au/GaN-Übergang bei niedrigen Frequenzen keine Inversion beobachtet wurde. Auret et al. beobachteten Elektronenstrahl-induzierte Defekte in Pt/n-GaN-Schottky-Übergängen [27]. Hier haben wir energiedispersive Röntgenspektroskopie (EDS)-Messungen durchgeführt und die Tiefenprofile für die Proben mit 0- und 7,4-nm-dickem AlN sind in Abb. 1d bzw. e gezeigt. In Fig. 1d ist deutlich zu sehen, dass Pt-Atome in die GaN-Schicht diffundierten, während die Diffusion von Pt-Atomen in die GaN-Schicht aufgrund der AlN-Schicht effektiv unterdrückt wurde. Daher wäre es möglich, darauf hinzuweisen, dass durch Pt-Abscheidung induzierte Defekte nahe der GaN-Oberfläche die Inversionskapazität bei niedrigen Frequenzen erzeugten und die Bildung dieser Defekte mit einer relativ dicken AlN-Schicht (> 1,5 nm) unterdrückt wurde.
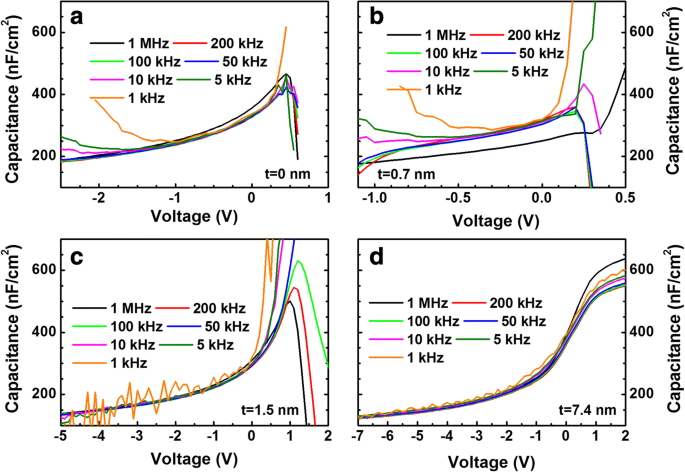
Kapazität–Spannung (C –V ) bei verschiedenen Frequenzen gemessene Daten für die Proben mit a 0-, b 0,7-, c 1,5- und d 7,4 nm dickes AlN
Mit Ausnahme der Probe mit 7,4 dickem AlN zeigten alle anderen Proben den anomalen Peak im C –V Kurve mit zunehmender Vorspannung, die mit der Verteilung der tiefen Fallen in der Lücke, dem Serienwiderstand und den Grenzflächenzuständen verbunden waren [28, 29]. Die Frequenzdispersion im Akkumulationsgebiet ist mit der Bildung einer inhomogenen Schicht an der Grenzfläche verbunden. Die Kapazität einer solchen Schicht wirkt in Reihe mit der Oxidkapazität, was die Streuung in der Akkumulation verursacht [30]. Die Streuung der Verarmung ist auf das Vorhandensein von Grenzflächenzuständen zurückzuführen, die auf die angelegte Frequenz reagieren. Wenn die Zeitkonstanten der Grenzflächenzustände mit der Frequenz von Kleinsignalen vergleichbar sind, tragen die Grenzflächenzustände zur Gesamtkapazität bei, so dass die Schwellenkapazität mit abnehmender Frequenz zunimmt [31].
Abbildung 4 zeigt die Leitwert–Spannung (G /ω –V ) bei verschiedenen Frequenzen gemessene Kurven. Bei ausreichend hohen Vorwärts- und Rückwärtsvorspannungen könnten die aktivierten Defekte bei niedrigen Frequenzen effektiver mit benachbarten Grenzflächenzuständen kommunizieren und somit die Leitfähigkeit erhöhen. Etwa im Bereich von – 1 und 0 V zeigten alle Proben den Anstieg des Leitwerts mit zunehmender Frequenz. Dieses Verhalten wurde bei der Probe mit einem 7,4 nm dicken AlN deutlicher. Der Anstieg der Leitfähigkeit mit zunehmender Frequenz war mit den Rekombinationszentren verbunden, die den Rekombinationsstrom in der Verarmungsregion fördern, und die Grenzflächenzustände, die Lade- und Entladestrom bereitstellen, oder den Sprungleitungsprozess, der bei hoher Frequenz auftritt [32]. Die Ergebnisse zeigen daher, dass für alle Proben Grenzflächenzustände mit verschiedenen Zeitkonstanten vorhanden sind und das Vorhandensein solcher Defekte für die Probe mit einem 7,4 nm dicken AlN am signifikantesten ist.
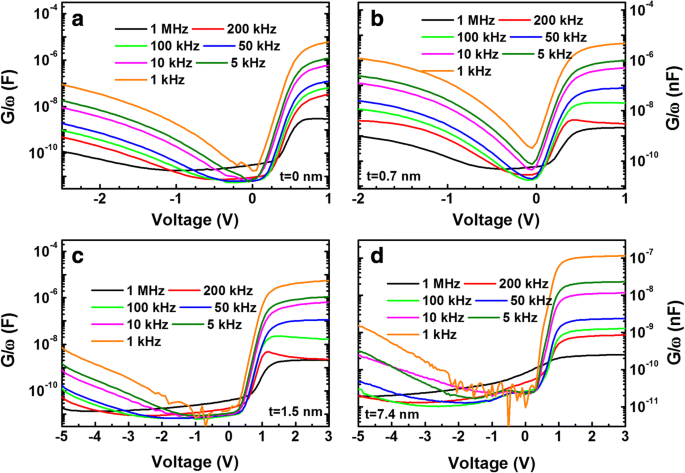
Leitwert–Spannung (G /ω –V ) bei verschiedenen Frequenzen gemessene Daten für die Proben mit a 0-, b 0,7-, c 1,5- und d 7,4 nm dickes AlN
Wie in Fig. 5a gezeigt, ist eine Schätzung der Grenzflächenzustandsdichte (D es ) wurde durch Anwendung der Terman-Methode auf das experimentelle C–V Kurven gemessen bei 1 MHz [33]. Das erhaltene D es vs. E C –E t (Ort des Schnittstellenzustands) ist in Fig. 5b dargestellt. Hier haben wir den C–V . nicht analysiert Kurve aus der Probe mit einem 0,7 nm dicken AlN, weil die Probe undicht war und die genaue Oxidkapazität (C OX ) war nicht gut definiert. Die Probe mit 7,4 nm dickem AlN zeigte die höchste Grenzflächenzustandsdichte, insbesondere für E C –E t> 0,4 eV. Darüber hinaus werden die durchschnittliche Grenzflächen- und Oxidfallendichte (Q T ) entlang der GaN-Bandlücke (E g ) wurden durch die Analyse von C . berechnet –V Hysteresediagramme unter Verwendung der Flachbandspannungsverschiebung (ΔV FB ) durch die Gleichung Q T = (C OX V FB )/qE g [34]. Die kleine Flachbandspannungsverschiebung und das kleine Hysteresefenster weisen auf eine niedrige Fallendichte hin. Der Einschub in Abb. 4b zeigt C –V Hysterese-Plots. Die eingeschlossenen Ladungsdichten wurden mit 4,2 × 10 9 . berechnet , 9,3 × 10 9 , und 3,6 × 10 11 cm −2 eV −1 für die Proben mit 0-, 1,5- bzw. 7,4-nm-dickem AlN. Die Hysterese kann von den Grenzflächenfallen von AlN/GaN und den Grenz-(oder Massen-)fallen in der AlN-Schicht herrühren. Wie bei der Terman-Methode zeigte eine 7,4 nm dicke AlN-Schicht die höchste Grenzflächen- und Oxidfallendichte. Daher lässt sich in dieser Probe vermuten, dass sowohl die Grenzfallen in der AlN-Schicht als auch die Grenzflächenfallen wesentlich zur Verschiebung von C . beigetragen haben –V Grundstücke.
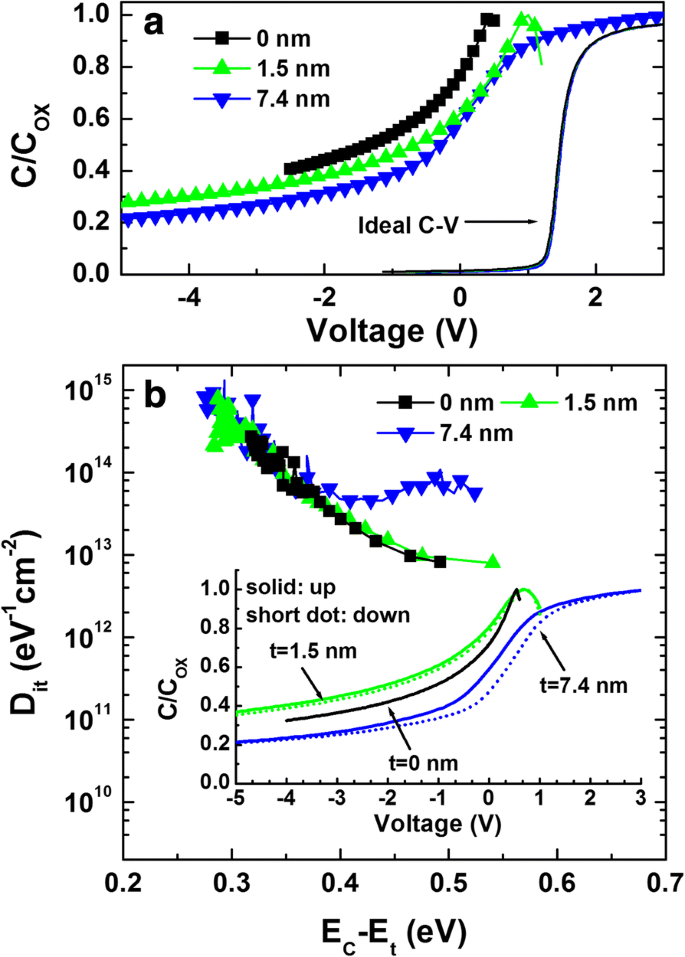
a Vergleich der experimentellen Kapazität-Spannung (C –V ) Daten gemessen bei 1 MHz und idealem C–V Daten und b Schnittstellenzustandsdichte (D es ) Verteilungen bestimmt durch Anwendung der Terman-Methode für die Proben mit 0-, 1,5- und 7,4-nm-dicker AlN-Schicht. Der Einschub in b zeigt das C –V Hysteresekurven gemessen bei 1 MHz
Die chemische Zusammensetzung an der AlN/GaN-Grenzfläche wurde mittels XPS-Messungen an zwei Proben mit 0,7 und 7,4 nm dickem AlN untersucht. Hier wurde eine Sputterätzbehandlung an der Probe mit einem 7,4 nm dicken AlN durchgeführt, da die Dicke von AlN zu dick war, um die genauen Informationen in der Nähe der AlN/InP-Grenzfläche zu erhalten. Als Referenz wurde auch blankes GaN oberflächengescannt. Abbildung 6a zeigt die XPS-Tiefenprofile für jedes Element, die aus der Probe mit einem 7,4 nm dicken AlN erhalten wurden. Die Diffusion von Ga-Atomen in die AlN-Schicht wurde deutlich gesehen. Es wurde gefunden, dass eine ziemlich große Menge an Sauerstoffatomen über der AlN-Schicht vorhanden ist. Jedoch wurden sowohl O- als auch Al-Atome in der Nähe der AlN/GaN-Grenzfläche nicht gut beobachtet. Die höhere Sauerstoffmenge in der Nähe der AlN-Oberfläche im Vergleich zur AlN/GaN-Grenzfläche weist darauf hin, dass ein erheblicher Teil davon aus der atmosphärischen Oxidation resultierte, nicht aus dem ALD-Abscheidungsprozess selbst. Wir wählten dann die schmal gescannten XPS-Spektren bei einer Ätztiefe aus (die Dicke des verbleibenden AlN betrug etwa 1,5–2,0 nm) und verglichen sie mit den Daten anderer Proben. Abbildung 6b zeigt das Ga 2p 3/2 Spektren auf Kernebene. Die Peaks bei ~ 1118,0 eV und ~ 1119,2 eV sowohl für das reine GaN als auch für die Probe mit einem 0,7 nm dicken AlN sind mit GaN und Ga2 . verbunden O3 , bzw. [35, 36]. Der Peak bei ~ 1117,4 eV für die Probe mit einem 7,4 nm dicken AlN ist auf an AlN gebundenes Ga zurückzuführen [37]. Wir können jedoch nicht ausschließen, dass es von Ga2 . stammt O-Peak (~ 1117.3 eV) [38].

a XPS-Tiefenprofile für jedes Element, die aus der Probe mit einem 7,4 nm dicken AlN erhalten wurden. XPS-Kernspektren von b Ga 3p 3/2, c O 1s , und d Al 2p für die Proben mit 0-, 1,5- und 7,4-nm-dickem AlN
Wie in Abb. 6c gezeigt, werden die Peaks bei ~ 530,2 und ~ 531,9 eV dem chemisorbierten O und Ga2 . zugeschrieben O3 , bzw. [39]. Außerdem ist der Peak bei ~ 532,8 eV mit Al-OH assoziiert [40]. Bei der Probe mit einem 7,4 nm dicken AlN in der ausgewählten Tiefe wurde jedoch kein besonderer Peak beobachtet. In ähnlicher Weise wurde bei den tieferen Ätztiefen (nicht gezeigt) kein Peak beobachtet. Wenn die AlN-Dicke dünn ist (0,7 nm), wurden die chemisorbierten Sauerstoffatome entfernt, aber Al-Atome mit OH gebunden. Mit zunehmender AlN-Dicke war eine sehr geringe Menge an Sauerstoffatomen in der Nähe des GaN-Oberflächenbereichs vorhanden, was auf den Reinigungseffekt hinweist. In der überwachsenen AlN-Region waren jedoch große Mengen an Sauerstoffatomen vorhanden, die für Oxidladungen sorgten. O 1s Spektren auf Kernebene bei Ätztiefen, in denen die Menge an Ga-Atomen vernachlässigbar ist (ungefähr 0~3 nm von der AlN-Oberfläche in Fig. 6a), zeigten den dominanten Peak bei ~~531.8 eV, assoziiert mit Al2 O3 [41]. Dies bedeutet, dass ein Teil der AlN-Schicht aus Al2 . besteht O3 . Wie in Fig. 6d gezeigt, wird der mit AlN zusammenhängende Peak für die Probe mit einem 0,7 nm dicken AlN nicht gut beobachtet. Stattdessen werden zwei Peaks bei ~ 74,1 und ~ 75,6 eV beobachtet, die mit AlOx . assoziiert sind bzw. Al-OH [42]. Diese mit der Al-O-Bindung verbundenen Peaks wie AlOx und Al-OH können als Defekte wirken. Der Peak bei ~ 73,6 eV für die Probe mit einem 7,4 nm dicken AlN ist mit AlN assoziiert [43].
Die Stromtransporteigenschaften der Proben mit 0,7 und 7,4 nm dickem AlN wurden mit temperaturabhängiger Strom-Spannung (I –V –T ) Messungen. Wie in Fig. 7 gezeigt, nahmen sowohl der Vorwärts- als auch der Rückwärts-Vorspannungsstrom für die Probe mit einer Dicke von 0,7 nm in ähnlichem Maße zu. Bei der Probe mit einem 7,4 nm dicken AlN waren die Rückwärtsleckströme jedoch stärker temperaturabhängig als die Vorwärtsströme. Bei umgekehrter Vorspannung könnte eine höhere Temperatur eine thermische Lochemission aus den tiefen Niveaus in das AlN-Valenzband verursachen und somit eine weitere Zufuhr von Elektronen einführen [44]. Nach dem inhomogenen Barrieremodell [24] ist die temperaturabhängige effektive Barrierehöhe (φ B ) steht im Zusammenhang mit einer Null-Bias-Mittelwert-Barrierehöhe (\( {\overline{\varphi}}_B \)) und einer Standardabweichung (σ 0 ) als \( {\varphi}_B={\overline{\varphi}}_B-q{\sigma_0}^2/2 kT\). Die σ 0 Werte wurden als 0,147 und 0,204 V für die Proben mit 0,7 bzw. 7,4 nm dickem AlN erhalten. Unter Verwendung dieser Werte werden die modifizierten Richardson-Plots von ln(I 0 /T 2 ) − q 2 σ 0 2 /2k 2 T 2 vs. 1/kT erhalten wurden, gezeigt in Abb. 8a. Die Achsenabschnitte auf der Ordinate ergaben die Richardson-Konstanten von A ** wie 397.3 und 27,1 A cm −2 K −2 für die Proben mit 0,7 bzw. 7,4 nm dickem AlN. Der Wert für die Probe mit einem 7,4 nm dicken AlN entspricht dem theoretischen Wert von 26,4 A cm −2 K −2 für n-GaN, was darauf hinweist, dass die Barriere-Inhomogenität mit dem TE-Modell den Stromtransport erklären kann. Für die Probe mit einem 0,7 nm dicken AlN ist der Wert jedoch im Vergleich zum theoretischen Wert zu hoch, was darauf hindeutet, dass das TE-Modell selbst einschließlich der Barriere-Inhomogenität den Stromtransport nicht erklären kann. Abbildung 8b zeigt die Werte von nkT als Funktion von kT . Die Gerade mit Steigungen von 1,15 stimmt gut mit den experimentellen Daten für die Probe mit einem 7,4 nm dicken AlN unter Verwendung des TE-Modells überein. Für die Probe mit einem 0,7 nm dicken AlN wurde jedoch eine Steigung von 5,11 gefunden. Eine solch große Abweichung von der Einheit könnte von den Grenzflächenzuständen, der Isolatorschicht und dem Tunnelstrom herrühren.
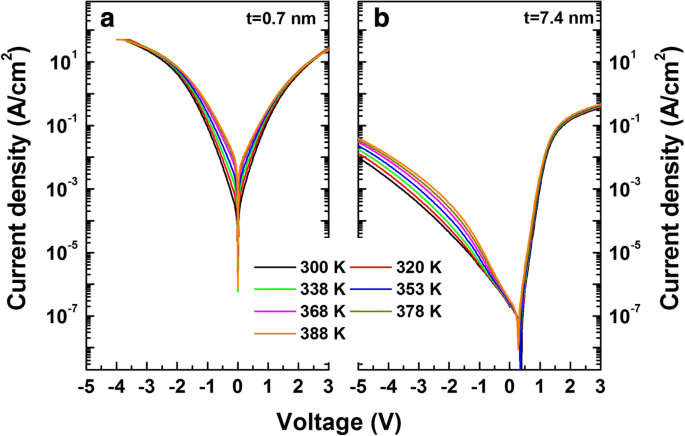
Temperaturabhängige Stromdichte–Spannung (J –V ) Merkmale für die Proben mit a 0.7- und b 7,4 nm dickes AlN
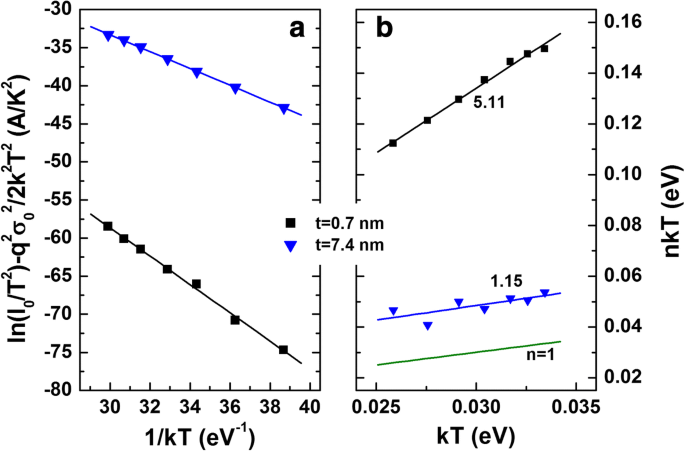
a Modifizierte Richardson-Plots und b nkT vs. kT Plots mit den linearen Anpassungen an die experimentellen Daten. In b , die Linie mit einer Steigung von 1 (n = 1) wurde auch als Referenz aufgenommen
Die Rückwärtsleckstromdichte wurde mit dem Fowler-Nordheim (FN)-Tunnelmodell nach [45] analysiert.
$$ J=\alpha {E}^2\exp \left(-\beta /E\right) $$ (1)wobei α = 1,54 × 10 −6 /m ∗ ΦB und β = 6.83 × 10 −7 (m ∗ ) 1/2 (ΦB ) 3/2 ; m * (m * = 0.30 für AlN [46]) ist die effektive Elektronenmasse im Isolator und ΦB ist die Tunnelbarrierehöhe. Abbildung 9a, b zeigt, dass für die Proben mit 0.7- und 7.4 nm dickem AlN eine FN-Emission beobachtet wurde, wenn die Vorspannungen höher als − 0.9 V bzw. − 3 V waren. Die höhere Spannung für die Probe mit einem 7,4 nm dicken AlN ist darauf zurückzuführen, dass dickeres AlN eine höhere Tunnelspannung benötigt. Aus dem in Abb. 9 gezeigten Gefälle wurden die Tunnelbarrierehöhen für jede Temperatur bestimmt, die im Einschub in Abb. 9b dargestellt sind. Bei Raumtemperatur wurden die Barrierehöhen für die Proben mit 0,7 und 7,4 nm dickem AlN mit etwa 1,67 bzw. 0,78 eV berechnet. Diese Werte sind niedriger als der berichtete Leitungsband-Offset von 2,58 eV an der AlN/GaN-Grenzfläche [47]. Die schlechte Grenzflächenqualität nahe der AlN/GaN-Grenzfläche könnte solch niedrigere Werte erzeugen. Die niedrigere Barrierehöhe für die Probe mit einem 7,4 nm dicken AlN kann auch mit der hohen Grenzflächen- und Oxidfallendichte nahe der AlN/GaN-Grenzfläche und sauerstoffbezogenen Defekten in der AlN-Schicht in Verbindung gebracht werden. Infolgedessen trat ein Fallen-unterstütztes Tunneln leichter auf und erhöhte den Rückwärtsleckstrom.
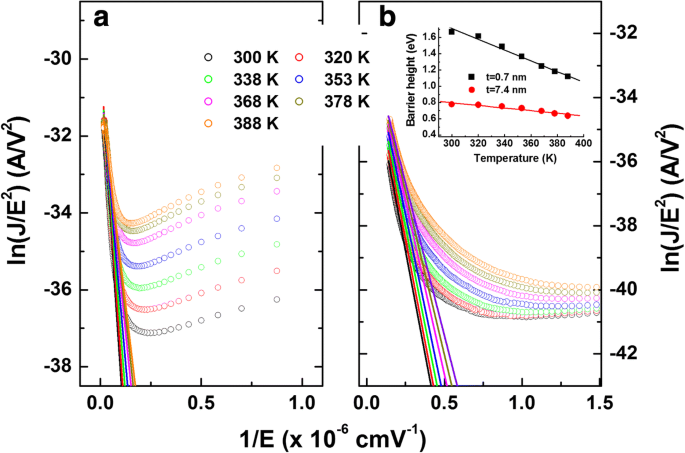
Fowler-Nordheim (FN) Tunnelbaupläne von ln(J /E 2 ) vs. 1/E mit den linearen Anpassungen an die experimentellen Daten für die Proben mit a 0.7- und b 7,4 nm dickes AlN. Der Einschub in b stellt die berechneten Barrierehöhen als Funktion der Temperatur dar
Das Poole-Frenkel(PF)-Emissionsmodell wurde auch auf den Rückwärtsleckstrom angewendet, der durch [48] gegeben ist.
$$ \ln \left(J/E\right)=m(T){E}^{1/2}+b(T)\Groß) $$ (2)mit
$$ m(T)=\frac{q}{kT}\sqrt{\frac{q}{{\pi\varepsilon}_0{\varepsilon}_{\textrm{AlN}}}},b(T) =-\frac{q{\varphi}_t}{kT}+\ln C $$ (3)wo ϕ t ist die Höhe der Elektronenemissionsbarriere aus den Fallenzuständen, ε AlN ist die relative Dielektrizitätskonstante des Gate-Isolators bei hoher Frequenz (ε AlN 4,77 [49]), ε 0 die Permittivität des freien Raums ist und C ist eine Konstante. Die Gültigkeit der PF-Emissionsarmatur wurde durch Überprüfung der Temperaturabhängigkeit des linearen Koeffizienten m . überprüft (T ) aus der linearen Anpassung der PF-Plots ln(J /E ) als Funktion von E 1/2 [50], das in Abb. 10 dargestellt ist. Aus dem m (T ) Werte aus der linearen Anpassung an diese Diagramme (Einschub in Abb. 10a), ε AlN für die Proben mit 0,7 bzw. 7,4 nm dickem AlN wurden 64,9 und 959,0 gefunden. Die erhaltenen Werte sind im Vergleich zum theoretischen Wert von 4,77 zu hoch, was darauf hinweist, dass die PF-Emission den Stromtransport für beide Proben nicht richtig erklären kann. Daher ist FN-Tunneln der geeignetere Transportmechanismus im Rückwärtsleckstrom.
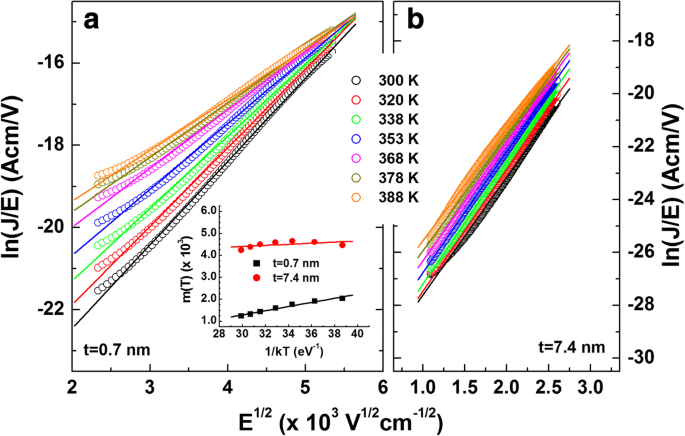
Poole-Frenkel (PF)-Emissionsdiagramme von ln(J /E ) vs. E 1/2/ mit der linearen Anpassung an die experimentellen Daten für die Probe mit a 0.7- und b 7,4 nm dickes AlN. Der Einsatz in a präsentiert das berechnete m (T ) Werte vs. Temperatur
Auch wenn Gl. (1) keine Temperaturabhängigkeit enthält, die erhaltenen Barrierehöhen nehmen mit steigender Temperatur ab. Die Steigungen wurden mit – 6,67 meV/K und – 1,62 meV/K für die Proben mit 0,7 bzw. 7,4 nm dickem AlN erhalten. In der SiO2/4H-SiC-Struktur wurde berichtet, dass das FN-Tunneln eine Temperaturabhängigkeit mit einer Steigung von − 7,6 meV/K besitzt [51]. Die von der Pt-Elektrode ausgestoßenen Elektronen folgten der Fermi-Dirac-Verteilung [52], und somit konnte auch der Rückwärtsleckstrom durch das Tunneln mit der Temperatur zunehmen. In diesem Fall wäre der Anstieg mit der Temperatur für eine dünnere AlN-Schicht größer.
Inzwischen wurde berichtet, dass Stromtransportmechanismen bei hohen elektrischen Feldern nicht allein durch das FN-Tunneln erklärt werden können [53, 54]. Auch unter Einbeziehung der Ladungsänderungen im Oxid- und Fermi-Niveau des Substrats und der Elektronenenergieverteilung am SiO2 /SiC-Schnittstelle mit Temperatur, dem Rückwärtsleckstrom in SiO2 /4H-SiC wurde nicht zufriedenstellend erklärt [53]. Es wurde vorgeschlagen, dass die thermisch aktivierte PF-Emission von eingefangenen Elektronen aus den Grenzflächen-Elektronenfallen signifikant zur Erhöhung des Leckstroms beiträgt [54]. Daher ist die Reduzierung solcher Defekte in AlN während des ALD-Prozesses entscheidend für die Leistung der AlN/GaN-basierten Vorrichtung, insbesondere während des Hochtemperaturbetriebs.
Wie aus der Auftragung der Barrierenhöhe gegen die AlN-Dicke in Fig. 2c ersichtlich, haben Li et al. beobachtete ein ähnliches Verhalten bei Metall/n-Ge-Kontakten mit Y2 O3 Schichten [55]. Sie führten die Verringerung der Barrierenhöhe auf die Unterdrückung des instabilen GeOx . zurück Wachstum und die Passivierung von Dangling Bonds auf der Ge-Oberfläche. Karpov et al. eingefügtes Si3 N4 Schicht in Ni/n-GaN-Kontakte und stellte fest, dass die Barrierehöhe mit einem Si3 . von 0,78 auf 0,27–0,30 eV abnahm N4 Schicht. Die Ergebnisse wurden durch die Dipolbildung am Si3 . erklärt N4 /GaN-Schnittstelle [56]. Außerdem haben Zheng et al. untersuchte den Kontaktwiderstand vs. Al2 O3 Dicke in der Al/n-SiC-Struktur und fanden heraus, dass sich der Grenzflächendipol bei einer Dicke von 1,98 nm zu bilden begann [57]. Oberhalb dieser Dicke nahm der Kontaktwiderstand zuerst aufgrund des Dipoleffekts ab und dann aufgrund des erhöhten Tunnelwiderstands zu. Gemäß den XPS-Daten in Abb. 6 ist die Bildung der AlN-Schicht für die Probe mit einem 0,7 nm dicken AlN unklar. Daher ist die Verringerung der Barrierehöhe bei einem 0,7 nm dicken AlN eher auf den Passivierungseffekt als auf die Bildung von Grenzflächendipolen zurückzuführen.
Trockenätzverfahren wie das Ätzen mit induktiv gekoppeltem Plasma (ICP) werden aufgrund der chemischen Stabilität von GaN häufig in GaN-basierten Vorrichtungen verwendet [58], obwohl ein UV-unterstütztes nasschemisches Ätzen demonstriert wurde [59]. Der Trockenätzprozess kann jedoch Schäden an der GaN-Oberfläche verursachen, den Leckstrom erhöhen und das Gleichrichtungsverhalten verschlechtern. Es wurde festgestellt, dass eine Nachätzbehandlung unter Verwendung von thermischem Glühen und einer KOH-Lösung nach dem reaktiven Ionenätzen (RIE) die Oberflächenschäden auf GaN effektiv beseitigt [60]. In Anbetracht der bisherigen Ergebnisse schlagen wir vor, dass eine AlN-Abscheidung (größer als 1 nm) angewendet werden kann, um die Beschädigung der geätzten GaN-Oberfläche zu reduzieren, wodurch die Grenzflächenqualität und die Gleichrichtungseigenschaften weiter verbessert werden sollen.
Schlussfolgerungen
Wir haben die Grenzflächen- und elektrischen Eigenschaften von AlN mit Atomlagenabscheidung auf n-GaN mit unterschiedlichen AlN-Dicken untersucht. Nach Kapazität–Spannung (C –V )-Eigenschaften zeigte die Probe mit einem 7,4 nm dicken AlN die höchste Grenzflächen- und Oxidfallendichte. Laut Röntgenphotoelektronenspektroskopie (XPS)-Messungen zeigte die Probe mit einem 0,7 nm dicken AlN einen dominanten Peak im Zusammenhang mit Al-O-Bindungen, ohne einen klaren Peak im Zusammenhang mit AlN. Die verbleibenden Sauerstoffatome in der Nähe der GaN-Oberfläche waren für die Probe mit einem 7,4 nm dicken AlN sehr gering. Andererseits wurde gefunden, dass viele Sauerstoffatome über der AlN-Schicht vorhanden waren, was die sauerstoffbezogenen Defekte in der AlN-Schicht bereitstellte. Analysen des Rückwärtsleckstroms ergaben, dass die Fowler-Nordheim (FN)- und nicht die Poole-Frenkel (PF)-Emission geeigneter war, den Stromtransport für die Proben mit 0,7 und 7,4 nm dickem AlN zu erklären.
Abkürzungen
- ALD:
-
Atomlagenabscheidung
- AlN:
-
Aluminiumnitrid
- C –V :
-
Kapazität–Spannung
- FN:
-
Fowler–Nordheim
- J –V :
-
Stromdichte–Spannung
- PF:
-
Poole–Frenkel
- TE:
-
Thermionische Emission
- XPS:
-
Röntgenphotoelektronenspektroskopie
Nanomaterialien
- Advanced Atomic Layer Deposition Technologies für Mikro-LEDs und VCSELs
- Grenzflächen-, elektrische und Bandausrichtungseigenschaften von HfO2/Ge-Stapeln mit in situ gebildeter SiO2-Zwischenschicht durch plasmaunterstützte Atomlagenabscheidung
- Optische und elektrische Eigenschaften von Silizium-Nanodrähten, die durch stromloses Ätzen hergestellt wurden
- Die antibakteriellen hierarchischen Polyamid-6-ZnO-Nanofasern, hergestellt durch Atomlagenabscheidung und hydrothermales Wachstum
- Untersuchung der Oberflächenpolarisation einer Al2O3-beschichteten GaN/AlGaN/GaN-Heterostruktur durch winkelaufgelöste Röntgenphotoelektronenspektroskopie
- Photokatalytische Eigenschaften von Co3O4-beschichteten TiO2-Pulvern, hergestellt durch plasmaunterstützte Atomlagenabscheidung
- Auswirkungen der Doppelschichtdicke auf die morphologischen, optischen und elektrischen Eigenschaften von Al2O3/ZnO-Nanolaminaten
- Abstimmung der Oberflächenmorphologien und -eigenschaften von ZnO-Filmen durch das Design der Grenzflächenschicht
- Fermi-Level-Tuning von ZnO-Filmen durch Supercycling-Atomschichtabscheidung
- Abhängigkeit der Nanopartikeltoxizität von ihren physikalischen und chemischen Eigenschaften



