Verbesserter Nahinfrarot-Absorber:zweistufig hergestelltes strukturiertes schwarzes Silizium und seine Anwendung
Zusammenfassung
Silizium wird in der Halbleiterindustrie weit verbreitet verwendet, weist jedoch aufgrund seines hohen Reflexionsvermögens und seiner Bandlückengrenze eine schlechte Leistung in photoelektronischen Vorrichtungen im nahen Infrarot auf. In dieser Studie wird ein zweistufiger Prozess, ein tiefes reaktives Ionenätzverfahren (DRIE), kombiniert mit einer Plasmaimmersions-Ionenimplantation (PIII), verwendet, um mikrostrukturiertes schwarzes Silizium auf der Oberfläche von C-Si herzustellen. Diese verbesserten, mit Schwefelelementen dotierten Oberflächen realisieren eine schmalere Bandlücke und eine Verbesserung der Lichtabsorption, insbesondere im nahen Infrarotbereich (800 bis 2000 nm). Inzwischen erhöht sich die maximale Lichtabsorption deutlich auf bis zu 83%. Ein photoelektronischer Si-PIN-Detektor mit mikrostrukturiertem schwarzem Silizium auf der Rückseite weist eine bemerkenswerte Geräteleistung auf, die zu einer Empfindlichkeit von 0,53 A/W bei 1060 nm führt. Dieses neuartige mikrostrukturierte schwarze Silizium, das die Eigenschaften einer schmalen Bandlücke kombiniert, könnte eine potenzielle Anwendung bei der photoelektronischen Detektion im nahen Infrarotbereich haben.
Hintergrund
Bisher können viele mikro- und nanostrukturierte schwarze Siliziummaterialien auch durch DRIE-Behandlung und Ionenimplantation hergestellt werden, um die Lichtreflexion zu reduzieren und die Absorption im nahen Infrarot zu verbessern [1,2,3,4,5]. Der DRIE-Prozess wird normalerweise in einem Modus zyklischer Ätz-Passivierungs-Schritte mit einer Photoresistmaske durchgeführt, die die Silizium-Mikrofabrikation von Strukturen mit hohem Aspektverhältnis ermöglichen kann. Im Allgemeinen verwendet dieser Ansatz F-basierte Plasmen wie SF6 für schnelles isotropes Ätzen und schaltet dann auf einen Seitenwandpassivierungszyklus mit C4 . um F8 [6,7,8]. Beim anschließenden Ätzzyklus wird der Passivierungsfilm durch den Ionenbeschuss vorzugsweise vom Boden der Nut entfernt, während das Ätzen der Seitenwände verhindert wird [9]. Schließlich könnte das Abwechseln von Ätz- und Passivierungszyklen die spezifischen Geometrien der geätzten Siliziumstrukturen bilden, die hauptsächlich von Maskengröße, Gasfluss, Elektrodenleistung, Prozesszeit, Zykluszeiten usw. abhängen. Um die Absorption von Silizium im nahen Infrarot zu verbessern, werden die geätzten Siliziumstrukturen nach dem DRIE-Prozess durch Ionenimplantation dotiert. Unter bestimmten Bedingungen können schwarze Silizium-Arrays erhalten werden, und die resultierenden Schwefel-Dotierstoffe, die innerhalb des Siliziumgitters enthalten sind, werden schließlich eine signifikante Absorption von Strahlung unterhalb der Bandlücke verursachen [10, 11].
Als eines der wichtigsten Materialien in der Halbleiterindustrie wird schwarzes Silizium häufig in empfindlichen photoelektronischen Detektoren, Solarzellen, biochemischen Sensoren, Anzeigegeräten und optischen Kommunikationsobjekten verwendet [12,13,14,15,16,17,18, 19,20]. Mikro- und Nanostrukturen aus schwarzem Silizium standen in den letzten Jahren aufgrund ihrer umfangreichen Anwendung in Bauelementen im Fokus intensiver Forschung. Ein photoelektronischer Si-PIN-Detektor mit schwarzem Silizium auf der Vorderseite wurde in unserer frühen Studie untersucht [21]. Diese Vorrichtungsstruktur weist eine breite Verarmungsschicht auf, so dass sie den Einfluss der Ladungsträgerdiffusionsbewegung reduzieren und den Zweck erfüllen kann, die Empfindlichkeit und Ansprechgeschwindigkeit der Vorrichtung zu verbessern. Es ist auch anzumerken, dass die Verwendung von schwarzem Silizium als lichtempfindliche Oberfläche sehr schwierig ist, damit die erzeugten Ladungsträger von der P-Schicht gesammelt werden, um einen Fotostrom durch die Elektrode auszugeben, was zu einer relativ geringen Reaktion auf sichtbares Licht im Vergleich zu einem herkömmlichen Si-PIN-Detektor führt. Es stellt sich also die Frage, ob ein photoelektronischer Si-PIN-Detektor mit schwarzem Silizium auf der Rückseite zwei Aufgaben gleichzeitig erfüllen könnte, dh die Geräteempfindlichkeit nicht nur im nahen Infrarot, sondern auch im sichtbaren Wellenlängenbereich zu erhöhen?
In diesem Artikel berichten wir über die Lichtabsorptionsverbesserung und die schmalere Bandlücke, die für mikrostrukturiertes schwarzes Silizium charakteristisch sind, das durch einen zweistufigen Prozess hergestellt wird:DRIE kombiniert mit PIII. Der Einfluss verschiedener Ätzprozesse auf die Lichtabsorption im Wellenlängenbereich von 400 bis 2000 nm wurde untersucht, und der Detektor auf der Grundlage dieses mikrostrukturierten schwarzen Siliziums auf der Rückseite wurde auch mit Schwerpunkt auf der Geräteempfindlichkeit im Wellenlängenbereich von . untersucht 400~1100 nm.
Methoden
Wie in Abb. 1a gezeigt, wurden gleichmäßig und periodisch verteilende zylindrische Arrays ausgewählt, um die optischen Eigenschaften von mikrostrukturiertem Silizium mit der FDTD-Simulationssoftware zu untersuchen. Abbildung 1b stellt die Beziehung zwischen der Extinktion und vier verschiedenen Modellgrößen des mikrostrukturierten Siliziums nach optimierter Simulation dar, wobei vier Modelle den gleichen Zylinderdurchmesser (D = 4 μm), aber unterschiedlicher Achsabstand (T 1 = 12 μm, T 2 = 10 μm, T 3 = 8 μm, T 4 = 6 μm).
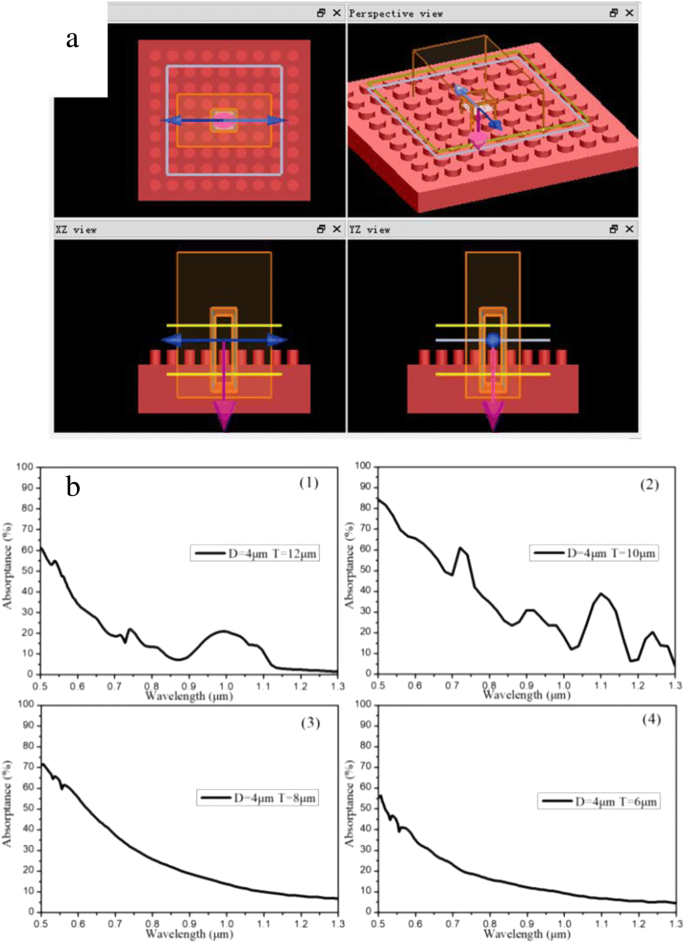
Optisches Simulationsmodell (a ) und Simulationsergebnisse (b ) aus mikrostrukturiertem Silizium
Wie in Abb. 2 gezeigt, wurden basierend auf den oben genannten optimierten Simulationsergebnissen drei verschiedene Fotolithografiemasken entworfen, indem die Maskengröße variiert wurde, die als Maske I bezeichnet wurde (D = 4 μm, T = 6 μm), Maske II (D = 4 μm, T = 8 μm) und Maske III (D = 4 μm, T = 10 μm). Dann wurde Photoresist NR9-1500PY aufgetragen, um eine kreisförmige Array-Maske auf der Polieroberfläche von Siliziumstücken (15 × 15 cm 2 .) abzuscheiden ), die aus n-Typ-Siliziumwafern mit einer Dicke von 500 μm und einem spezifischen Widerstand von 2500 bis 3000 Ω · cm geschnitten wurden. Um den Einfluss des Ätzprozesses auf die Lichtabsorption von mikrostrukturiertem Silizium zu untersuchen, haben wir die aus Maske III resultierenden Testproben in die Prozesskavität (DRIE, ICP-100D) verschoben und die Zykluszeiten verändert, in denen SF6 wurde als Ätzgas und C4 . verwendet F8 als Passivierungsgas, 30-mal, 70-mal und 100-mal, unterschiedlich. Nach den Ätzprozessen wurden die Siliziumstücke unter Sauerstoffatmosphäre von jeglichem restlichen Fotolack befreit, um sicherzustellen, dass die Siliziumoberfläche sauber und glatt war. Um die Absorption von mikrostrukturiertem Silizium, insbesondere im Nahinfrarotband, zu verbessern, wurden die aus der Maske III resultierenden Testproben nachfolgend mit Schwefelelementen durch den PIII-Prozess unter der Bedingung 1,0E + 15 cm – 2 Implantationsdosis bzw. 800 eV Implantationsenergie.

Das schematische Diagramm der Maskengröße
Die Morphologien von schwarzem Silizium wurden durch ein Feldemissions-Rasterelektronenmikroskop (SEM, JSM-7500F) charakterisiert. Die Lichtabsorption wurde bei Raumtemperatur unter Verwendung eines faseroptischen Spektrometers (NIR2500) mit einer Ulbrichtkugel (Idea Optics, IS-20-5) erhalten. Die Ansprechempfindlichkeit des Detektors wurde unter Verwendung eines optischen Leistungsmessers (OPHIR, Vega), eines optischen Zerhackers (Scitec Instruments, Modell-300CD) und eines Keithley2636B-Geräts in einer Dunkelkammerumgebung gemessen. Um die Genauigkeit der Messung zu gewährleisten, haben wir vor dem Test eine Kalibrierung durchgeführt und jede dieser Messungen wurde an einigen wenigen Proben (normalerweise 4 bis 6) durchgeführt.
Ergebnisse und Diskussion
Abbildung 3 zeigt die typischen SEM-Bilder von ausgerichteten mikrostrukturierten Silizium-Arrays, die für drei verschiedene Maskengrößen senkrecht zur Substratoberfläche stehen. Es wird deutlich gezeigt, dass die Draufsicht auf das mikrostrukturierte Silizium eigentlich keine Standardkreise ist, da der DRIE-Prozess hauptsächlich von der Maskengröße und der Qualität der Fotolithografietechnik abhängt. Um dann die Wirkung des Ätzprozesses auf die Lichtabsorption von mikrostrukturiertem Silizium zu untersuchen, ändern wir die Zykluszeiten auf Maske III-Testproben auf 30, 70 und 100 Mal unter den Bedingungen des Ätzens mit SF6 3 s lang und passivieren mit C4 F8 für 2 s, jede Zykluszeit.
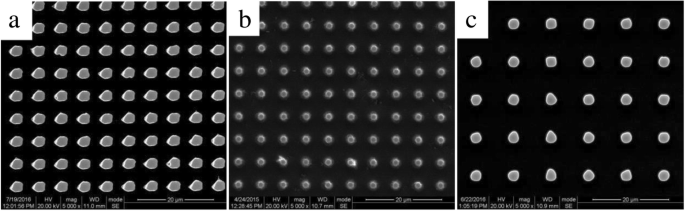
Typische mikrostrukturierte Silizium-Arrays von DRIE für unterschiedliche Maskengrößen. a Maske I. b Maske II. c Maske III
Entsprechend dem unterschiedlichen Ätzratenverhältnis zwischen Fotolack und Silizium kann die Ätztiefe durch Prozessparameter gesteuert werden, solange der Fotolack als Maske dick genug ist. Aus Abb. 4 ist ersichtlich, dass die Höhe der Zylinder mit der Anzahl der Zykluszeiten zunimmt, wobei die Höhe von der Oberseite bis zum Substrat etwa 1,87 μm, 2,35 μm bzw. 3,15 μm beträgt. Es ist allgemein bekannt, dass beim DRIE-Prozess, obwohl Passivierungsgase zum Schutz der Seitenwand des Ätztargets vorhanden sind, dieser immer noch mehr oder weniger von seitlichem Ätzen begleitet wird. Dies ist der Grund, warum die resultierenden Morphologien keine idealen zylindrischen Arrays sind. Offensichtlich können die Morphologien dieser mikrostrukturierten Silizium-Arrays durch unterschiedliche Lithographieprozesse und Ätzzykluszeiten gut kontrolliert werden.
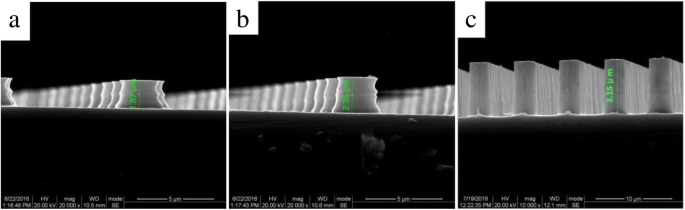
Schnittansichten von Masken III-Proben, die für verschiedene Zykluszeiten hergestellt wurden. (a ) 30, (b ) 70 und (c ) 100
Abbildung 5a stellt die Lichtabsorption von mikrostrukturierten zylindrischen Arrays bei verschiedenen Zykluszeiten ohne PIII-Prozess dar. Es wird gezeigt, dass C-Si mit geätzten Silizium-Arrays im Vergleich zu gewöhnlichem C-Si die Lichtabsorption im gesamten Wellenlängenbereich von 400 bis 2000 nm bis zu einem gewissen Grad verbessern kann. Die für 100 Zykluszeiten geätzte Probe weist die höchste Absorption auf, bis zu 70 % im NIR-Bereich (800 bis 2000 nm), und die durchschnittliche Absorption dieser Probe erreicht 55 % im Wellenlängenbereich von 400 bis 2000 nm. Dies liegt an der Mehrfachreflexion und -absorption von mikrostrukturiertem Silizium (wie in Abb. 6). Während einfallendes Licht kontinuierlich an der Seitenfläche des Zylinders reflektiert wird, nimmt die Absorptionsweglänge des einfallenden Lichts zu, was zu einer Verbesserung des Absorptionsvermögens führt. Trotzdem ist die Absorptionsrate immer noch nicht hoch genug, wenn die Wellenlänge mehr als 1000 nm beträgt. Um die Absorption von mikrostrukturiertem Silizium, insbesondere im Nahinfrarotband, weiter zu verbessern, werden daher dieselben Proben durch den PIII-Prozess mit Schwefelelementen unter der Bedingung 1,0E + 15 cm – 2 . dotiert Implantationsdosis bzw. 800 eV Implantationsenergie. Wie in Fig. 5b gezeigt, wird die Lichtabsorption im Wellenlängenbereich von 400 bis 2000 nm nach der Ionenimplantation offensichtlich erhöht. Hier ist die Lichtabsorption der für 100 Zykluszeiten geätzten Probe viel höher als die von C-Si. Die maximale und durchschnittliche Lichtabsorption steigen deutlich auf bis zu 83 % bzw. 62 % an. Darüber hinaus kann man leicht beobachten (wie in Abb. 5c), dass die Absorption von Proben mit 100 Zyklen eine signifikante Änderung der Wellenlänge von 800 auf 2000 nm vor und nach der Dotierung mit Schwefelelementen aufweist, bei der die Maximal- und Mittelwerte um 13% ansteigen. bzw. 7%.
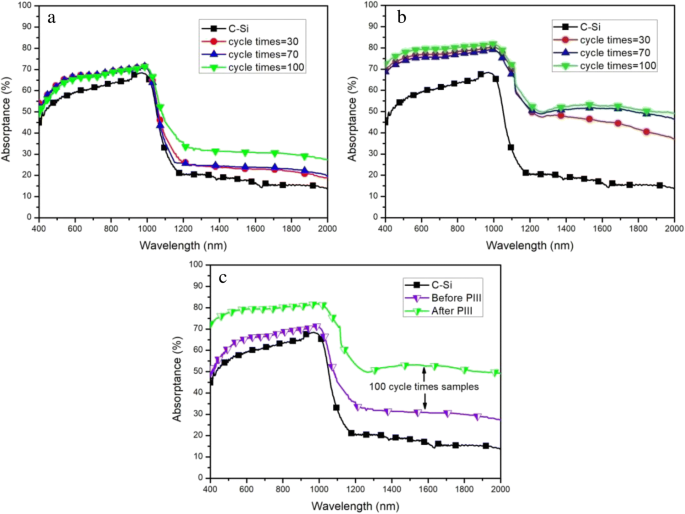
Absorption von C-Si und schwarzem Silizium, hergestellt durch unterschiedliche Zykluszeiten vor (a ) und nach PIII (b ) und Vergleich von 100 Zyklusproben (c )

Der Übertragungsweg von einfallendem Licht auf der Oberfläche von mikrostrukturiertem Silizium
Dieses hohe Absorptionsvermögen kommt hauptsächlich von der Schwefeldotierung zwischen mikrostrukturierten zylindrischen Arrays, die mehrere Verunreinigungsniveaus in der Energiebandstruktur von C-Si bilden. Als Ergebnis wird, wenn sich diese induzierten mehrfachen Verunreinigungsniveaus überlappen, nach der Verbreiterung ein neues Verunreinigungsband gebildet, was schließlich die Bandlücke von C-Si verringert. Die Bandlücke kann aus dem Absorptionsspektrum der Probe durch Tauc-Mapping erhalten werden. Die konkreten Schritte sind wie folgt:
(i) das Reflexionsspektrum wird in die K-M-Funktion F . umgewandelt (R ∞ ) unter Verwendung der Kubelka-Munk-Theorie:
$$ F\left(R\infty \right)\approx \frac{A^2}{2R} $$ (1)in denen R und A sind das Reflexionsspektrum bzw. das Absorptionsspektrum der Probe.
(ii) Die K-M-Funktion F (R ∞ ) wird wie folgt in die Tauc-Formel eingesetzt:
$$ {\left( hv\alpha \right)}^{1/n}=K\left( hv- zB\right) $$ (2) $$ hv=\frac{1239.7}{\lambda } $$ (3)wobei sich der Wert von Index n auf den Übergangstyp der Stichprobe bezieht:direkter Übergang, n = 1/2; indirekter Übergang, n = 2. F (R ∞ ) ist proportional zum Absorptionskoeffizienten α, der ersetzt werden kann durch F (R ∞ ) und n = 2 wird in die Formel (2) eingesetzt, um zu erhalten:
$$ {\left(hv F\left(R\infty\right)\right)}^{1/2}=K\left(hv- zB\right) $$ (4)(iii) Die Reflexions- und Absorptionsspektraldaten der Probe werden in Gl. (1) und Gl. (1) wird in Gl. (4), mit hv als Abszisse (X Achse) und (hvF(R ∞ )) 1/2 als Ordinate (Y Achse).
(iv) Der Wendepunkt (der Maximalpunkt der ersten Ableitung) wird durch Berechnung der ersten Ableitung von hv . erhalten -(hvF(R ∞ )) 1/2 Kurve, und die Tangente der Kurve wird an dieser Stelle gebildet. Der Abszissenwert des Schnittpunkts von Tangente und X Achse sind die Bandlücke der Probe.
Abbildung 7 zeigt die endgültig berechneten Bandlücken von C-Si und schwarzem Silizium mit unterschiedlichen Zykluszeiten. Es ist leicht zu erkennen, dass drei niedrigere Bandlücken von schwarzem Silizium mit 1,045 eV, 1,033 eV und 1,025 eV im Vergleich zur Bandlücke von 1,12 eV von C-Si offensichtlich verringert sind.
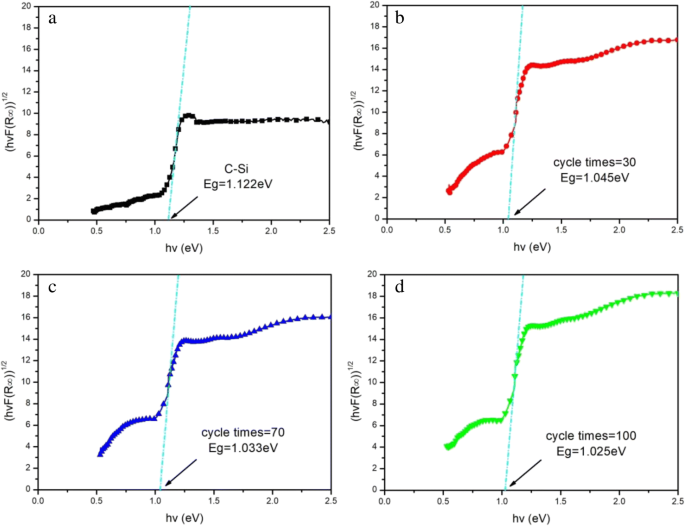
Bandlücken von C-Si (a ) und schwarzes Silikon mit unterschiedlichen Zykluszeiten:(b ) 30, (c ) 70, (d ) 100
Auf der Grundlage des obigen schwarzen Siliziums mit verbesserten optischen Eigenschaften wurde ein Si-PIN-Detektor mit schwarzem Silizium auf der Rückseite hergestellt. Zuerst wird ein reiner intrinsischer monokristalliner Siliziumwafer (n-Typ) auf beiden Seiten oxidiert und bildet SiO2 Schichten. Zweitens wird die P-Schicht durch Bordiffusion auf dem lichtempfindlichen Bereich hergestellt, der früh durch Ätzen des SiO2 . gebildet wird Schicht auf der Vorderseite des Wafers durch einen Photolithographieprozess. Drittens, eine Schicht aus Si3 N4 Auf der P-Schicht wird ein Permeationsfilm abgeschieden, und dann wird die Rückseite des Wafers poliert und auf eine Dicke von etwa 200 μm geschliffen. Viertens, ein P-dotiertes N + Auf der geschliffenen Oberfläche wird eine Schicht abgeschieden, und dann wird das mikrostrukturierte schwarze Silizium auf der Oberseite von N + . gebildet Schicht. Schließlich werden die Elektrodenfenster durch einen Photolithographieprozess geätzt und Metallelektroden werden auf beiden Seiten des Wafers abgeschieden. Abbildung 8 zeigt ein reales Gerätebild (a), einen Dunkelstrom (b), eine I-V-Kurve bei einer Beleuchtung mit einer Wellenlänge von 1060 nm (c) und den Vergleich der Empfindlichkeit von zwei verschiedenen Detektoren (d). Hiermit wird erklärt, dass die Empfindlichkeit von Gerät 1 (S1336-44BK, ein kommerzieller Si-PIN-Detektor) auf der Grundlage der öffentlichen Website der Hamamatsu Photonics Company [22] neu aufgetragen wird, und die Empfindlichkeit von Gerät 2 wird auf unserer neu hergestellter Si-PIN-Detektor mit schwarzem Silizium auf der Rückseite, bei dem die lichtempfindliche Oberfläche ein Kreis mit einem Durchmesser von 2 mm war. Es ist deutlich zu erkennen, dass Gerät 2 eine erhebliche Steigerung der Ansprechempfindlichkeit durchführt, insbesondere bei Wellenlängen im nahen Infrarot, d. h. 0,53 A/W bei 1060 nm bzw. 0,31 A/W bei 1100 nm.
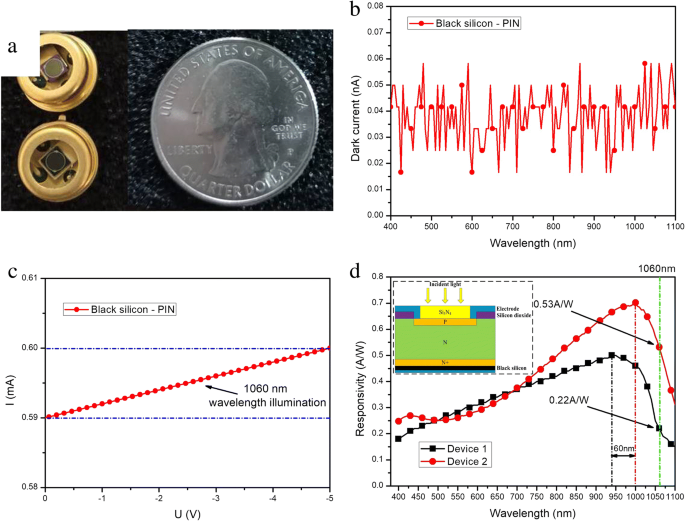
Detektorbild (a ), Dunkelstrom (b ), I-V-Kurve unter Beleuchtung mit einer Wellenlänge von 1060 nm (c ) und Ansprechverhalten von zwei verschiedenen Detektoren (d ):Gerät 1 aus Ref.-Nr. [22] und Gerät 2 basierend auf den Ergebnissen der vorliegenden Arbeit. Der Einsatz von d zeigt die Gerätestruktur
Aus Abb. 8b ist ersichtlich, dass der Si-PIN-Detektor mit schwarzem Silizium auf der Rückseite (Vorrichtung 2) zwar eine relativ geringe Verbesserung des Ansprechverhaltens im sichtbaren Spektrum zeigt, sein Ansprechspektrum jedoch ein noch höheres Ansprechverhalten in der Wellenlänge . ergibt Bereich von 680 bis 1100 nm mit einer Rotverschiebung der Spitzenempfindlichkeit von etwa 60 nm im Vergleich zum kommerziellen Si-PIN-Detektor (Gerät 1). Der Hauptgrund für eine solche Unterscheidung ist, dass der Geräteaufbau dieser beiden Detektoren (Geräte 1 und 2) unterschiedlich ist. Wenn die Photonenenergie größer als die Bandlücke von C-Si ist, wird das einfallende Licht hauptsächlich von der P-Schicht absorbiert und so haben die erzeugten Ladungsträger genügend Energie, um die N-Schicht zu passieren. Die meisten der generierten Träger können von N + . abgeholt werden Schicht, um Photostrom durch die Elektrode auszugeben. Unter dieser Bedingung, unabhängig davon, ob die Rückseite des Detektors mit oder ohne schwarzes Silizium eingeführt wird, gibt es einen begrenzten Einfluss auf die Reaktion der Vorrichtung im sichtbaren Wellenlängenbereich. Anders als der Detektor mit schwarzem Silizium auf der Vorderseite [21] zeigt Gerät 2 ein besseres Ansprechverhalten im sichtbaren Wellenlängenbereich. Aus diesem Grund gibt es gemäß der gemessenen Empfindlichkeitskurve eine relativ geringe Verbesserung der Reaktion auf sichtbares Licht. Da die schwarze Siliziumschicht auf der Rückseite angeordnet ist, kann wiederum in Vorrichtung 2 Nahinfrarotlicht die P-Schicht durchdringen und von der N-Schicht absorbiert werden, selbst wenn die Photonenenergie kleiner als die Bandlücke von C-Si ist, und dann kann eine große Anzahl von generierten Trägern vom N + . gesammelt werden Schicht unter der Wirkung von Sperrvorspannung. Als Ergebnis gibt es einen zählbaren Photostromausgang und das Gerät stellt eine wesentliche Erhöhung der Empfindlichkeit im Nahinfrarot-Wellenlängenbereich dar.
Gemäß den obigen Ergebnissen könnte unsere vorliegende Studie eine praktikable Strategie für ein photoelektronisches Detektionsfeld im nahen Infrarot darstellen, aber es gibt noch viele Aspekte, die berücksichtigt werden sollten. Beispielsweise sollten bessere Herstellungsprozesse und Ionenimplantationstechnologien von mikrostrukturiertem schwarzem Silizium erforscht werden, die die Morphologien und Bandlücken des strukturierten Siliziums präzise steuern könnten. Darüber hinaus sollten einige andere neuartige Bauelementstrukturen von photoelektronischen Detektoren auf Basis von schwarzem Silizium entwickelt werden, um eine bessere Bauelementleistung zu erzielen.
Schlussfolgerungen
Zusammenfassend lässt sich sagen, dass die mikrostrukturierten schwarzen Siliziummaterialien durch einen zweistufigen Prozess hergestellt werden:tiefes reaktives Ionenätzen kombiniert mit Plasmaimmersions-Ionenimplantation. Die mikrostrukturierten zylindrischen Arrays auf der Oberfläche von Siliziumwafern haben drei verschiedene Größen:Maske I (D = 4 μm, T = 6 μm), Maske II (D = 4 μm, T = 8 μm) und Maske III (D = 4 μm, T = 10 μm), mit einer Höhe von 1,87 μm, 2,35 μm bzw. 3,15 μm. Offensichtlich wurde eine verbesserte Lichtabsorption von schwarzem Silizium in einem breiten Wellenlängenbereich von 400 bis 2000 nm erhalten, und die maximale und durchschnittliche Lichtabsorption erreichen 83 % bzw. 62 %. Diese Verbesserungen werden ausführlich auf der Grundlage von Mehrfachreflexion, erhöhter Absorptionspfadlänge und schmaler Bandlücke diskutiert. Ein neuartiger photoelektronischer Si-PIN-Detektor mit schwarzem Silizium auf der Rückseite wurde hergestellt, und ein Vergleich der Geräteempfindlichkeit wurde mit einem kommerziellen Gerät mit der Bezeichnung S1336-44BK durchgeführt. Es wird der Schluss gezogen, dass unser photoelektronischer Si-PIN-Detektor mit schwarzem Silizium auf der Rückseite eine beträchtliche Zunahme der Empfindlichkeit aufweist, insbesondere im nahen Infrarot, die auf 0,53 A/W bei 1060 nm und 0,31 A/W bei 1100 nm . ansteigt , bzw.
Nanomaterialien
- Anwendung von Molybdänmetall und seinen Legierungen
- So erreichen Sie ein reibungsloses und effektives Onboarding von Geräten über eine mobile Anwendung
- IoT-Geräteverwaltung und ihre Rolle bei der Erleichterung von IoT-Bereitstellungen in großem Maßstab
- Coin Paradox Spin-Bahn-Interaktion verbessert magnetooptischen Effekt und seine Anwendung in integrierten optischen Isolatoren auf dem Chip
- Elektronische Zustände von mit Sauerstoff dotierten Nanokristallen und sichtbarer Emission auf schwarzem Silizium, hergestellt mit ns-Laser
- Ultraschmalbandiger perfekter Absorber und seine Anwendung als plasmonischer Sensor im sichtbaren Bereich
- Eine wiederaufladbare Fluoreszenzsonde BHN-Fe3O4@SiO2 Hybrid-Nanostruktur für Fe3+ und ihre Anwendung in der Biobildgebung
- Überprüfung der Anwendung von nanostrukturiertem schwarzem Silizium
- Magnetischer Goldnanopartikel-markierter monoklonaler Heparanase-Antikörper und seine anschließende Anwendung für die Tumor-Magnetresonanztomographie
- Einfache Synthese ultralanger und dünner Kupfer-Nanodrähte und ihre Anwendung auf flexible, transparente leitfähige Hochleistungselektroden



