Theoretische Analyse von InGaAs/InAlAs Single-Photon Avalanche Photodioden
Zusammenfassung
Es wird über theoretische Analysen und zweidimensionale Simulationen von InGaAs/InAlAs-Lawinen-Photodioden (APDs) und Einzelphotonen-APDs (SPADs) berichtet. Die elektrische Feldverteilung und der Tunneleffekt von InGaAs/InAlAs-APDs und SPADs werden untersucht. Wenn die InGaAs/InAlAs-SPADs im Geiger-Modus betrieben werden, steigt das elektrische Feld in der Absorptionsschicht linear an und weicht von seinen linearen Beziehungen in der Multiplikationsschicht ab. In Anbetracht des elektrischen Tunnelschwellenfelds in der Multiplikationsschicht sollte die Dicke der Multiplikationsschicht größer als 300 nm sein. Darüber hinaus können SPADs unter einer großen Vorspannung arbeiten, um Tunneln in der Absorptionsschicht mit hohen Dotierungskonzentrationen in der Ladungsschicht zu vermeiden.
Hintergrund
In0,53 Ga0,47 As/In0,52 Al0,48 As (im Folgenden als InGaAs/InAlAs bezeichnet) und InGaAs/InP-Lawinenphotodioden (APDs) sind die bedeutendsten Photodetektoren für die kurzwellige Infrarotdetektion. In den letzten Jahren hat die Forschung zur Quantenschlüsselverteilung schnell Fortschritte gemacht, und jetzt können InGaAs/InAlAs- und InGaAs/InP-APDs die Einzelphotonenzählung und das Timing als Einzelphotonen-APDs (SPADs) realisieren [1]. Im Vergleich zu anderen Einphotonen-Detektoren im SWIR-Wellenlängenbereich, wie z. B. Photomultiplier-Röhren, haben InGaAs-Einphotonen-Avalanche-Dioden die entscheidenden Vorteile einer hohen Leistung, einer hohen Zuverlässigkeit, einer geringen Vorspannung, einer geringen Größe, einer guten Zeitauflösung und einer einfachen Bedienung [ 2, 3]. Daher ziehen InGaAs/InAlAs- und InGaAs/InP-APDs große Aufmerksamkeit auf sich [4, 5]. Im Vergleich zu APDs, die im Linearmodus betrieben werden, werden APDs, die im Geiger-Modus als SPADs betrieben werden, mit einer Sperrspannung beaufschlagt, die die Durchbruchspannung überschreitet [6]. SPADs erreichen eine hohe Verstärkung in der Multiplikationsschicht, und ein einzelnes Photon kann einen makroskopischen Stromimpuls auslösen, der die Möglichkeit bietet, die Ankunft eines einzelnen Photons am Detektor genau zu erfassen [7]. Somit können SPADs das einzelne Photon bei einer Wellenlänge von 1550 nm nachweisen [8]. Unterdessen kann die Absorptionswellenlänge durch die Materialien der Absorptionsschicht [9] gesteuert werden.
Im Vergleich zu InAlAs-basierten SPADs sind theoretische und Simulationsstudien von InP-basierten SPADs umfassender [2, 10, 11, 12]. Allerdings werden InAlAs-basierte APDs zunehmend anstelle von InP-basierten APDs verwendet, da sie die Leistung sowohl bei APDs als auch bei SPADs verbessern können [13]. Das Verhältnis des Ionisationskoeffizienten von Elektron (α) zu Loch (β) in InAlAs ist größer als das in InP, was zu einem niedrigen Überschussrauschfaktor und einem hohen Verstärkungs-Bandbreiten-Produkt in InAlAs-basierten APDs führt [14]. Die größere Bandlücke von InAlAs kann die Durchbrucheigenschaften verbessern und die Dunkelzählrate (DCR) in SPADs verringern [15]. InAlAs-basierte APDs haben eine hohe Elektronenmobilität, was zu schnelleren Reaktionszeiten als die von InP-basierten APDs führt [16]. Darüber hinaus ist das Ionisationskoeffizientenverhältnis von InAlAs-APDs weniger empfindlich gegenüber Temperaturänderungen von InP-basierten APDs [17]. Folglich können InGaAs/InAlAs-APDs eine hohe Leistung in Bezug auf Durchbrucheigenschaften, DCRs, Rauschüberschuss, Verstärkungsbandbreite, Reaktionszeit und Temperatureigenschaften erreichen.
Studien zu InGaAs/InAlAs-APDs konzentrierten sich hauptsächlich auf die Erhöhung der Einzelphotonen-Detektionseffizienz (SPDE) und die Verringerung der DCR in SPADs. Karveet al. demonstrierten die ersten InGaAs/InAlAs-SAPDs mit einer SPDE von 16 % bei 130 K [18]. Nakataet al. verbesserte die Temperaturleistung von SPADs, die bei 213 K eine SPDE von 10 % erreicht [19]. Zhao et al. entwarf einen selbstlöschenden und sich selbst erholenden InGaAs/InAlAs-SPAD mit einer SPDE von 11,5% bei 160 K; gleichzeitig wurde ein DCR von 3,3 M Hz beobachtet [20]. Meng et al. entwarfen eine Mesastruktur InGaAs/InAlAs SPAD, die eine SPDE von 21% bei 260 K erreicht [21]. Dann haben sie eine dicke Absorptions- und Multiplikationsschicht in einer ähnlichen Struktur aufgetragen, die die SPDE bei 210 K auf 26 % verbessert und die DCR auf 1 × 10 8 . verringert Hz [22]. Allerdings sind in diesen Studien die DCRs von InGaAs/InAlAs SPADs im Vergleich zu InGaAs/InP SPADs zu hoch (in neueren InP SPADs sind DCRs typisch < 10 4 Hz) [23]. Die hohen DCRs in InGaAs/InAlAs SPADs werden Tunnelströmen zugeschrieben, die durch das hohe Feld bei der Übervorspannung verursacht werden [21, 22, 24]. Somit sind abnehmende Tunneling-bezogene Mechanismen für InGaAs/InAlAs-SPADs signifikant, und diese Mechanismen hängen mit der elektrischen Feldverteilung in SAPDs zusammen. Aus Literaturen [1. 9] beträgt das elektrische Tunnelschwellenfeld 2,0 × 10 5 V/cm in der Absorptionsschicht (InGaAs) und 6,8 × 10 5 V/cm in der Multiplikationsschicht (InAlAs). Daher ist für InAlAs-SPADs eine geeignete elektrische Feldverteilung von Bedeutung, die durch die Dicke der Ladungsschicht und der Multiplikationsschicht bestimmt wird. In Anbetracht der Ladungsschicht von InAlAs-APDs haben Kleinow et al. untersuchten den Einfluss der Dotierungskonzentration in dieser Schicht und fanden heraus, dass die Dotierungskonzentration für die Leistung von InGaAs/InAlAs-APDs wichtiger ist [25, 26]. Chenet al. untersuchten den Einfluss der Ladungs- und Multiplikationsschichten auf Durchgriffs- und Durchbruchspannungen durch theoretische Analyse und Simulation [27]. Diese Studien haben sich auf die Leistung von InAlAs-APDs unter dem linearen Modell konzentriert. Allerdings ist die Leistung von InAlAs SPADs im Geiger-Modus noch nicht vollständig verstanden.
In diesem Artikel werden theoretische Analysen und Simulationen verwendet, um den Tunneleffekt und die elektrische Feldverteilung in InGaAs/InAlAs-SPADs zu untersuchen. Unter Berücksichtigung des elektrischen Tunnelschwellenfeldes im Geiger-Modus werden die Designkriterien von SPADs optimiert, um den Tunneleffekt zu vermeiden.
Methoden
Numerische Simulationen werden für die frontbeleuchteten SAGCM InGaAs/InAlAs APDs unter Verwendung von TCAD durchgeführt [28]. Die für die Simulation verwendeten physikalischen Modelle werden wie folgt dargestellt. Das Ionisationsmodell von Selberherr simuliert die Lawinenvermehrung in InAlAs. Die Verteilung des elektrischen Feldes und der Diffusionsstrom werden durch das Drift-Diffusions-Modell beschrieben, das die Poisson- und Ladungsträgerkontinuitätsgleichungen enthält. Für den Tunnelstrom werden Band-zu-Band- und Fallen-unterstützte Tunnelmodelle verwendet. Andere grundlegende Modelle, einschließlich der Fermi-Dirac-Trägerstatistik, Auger-Rekombination, Trägerkonzentrationsabhängigkeit, Shockley-Read-Hall-Rekombination, Niederfeldmobilität, Geschwindigkeitssättigung, Stoßionisation und Raytracing-Methode werden in der Simulation verwendet. Der schematische Querschnitt der von vorne beleuchteten epitaktischen APD-Struktur für die Simulation ist in Abb. 1 gezeigt.
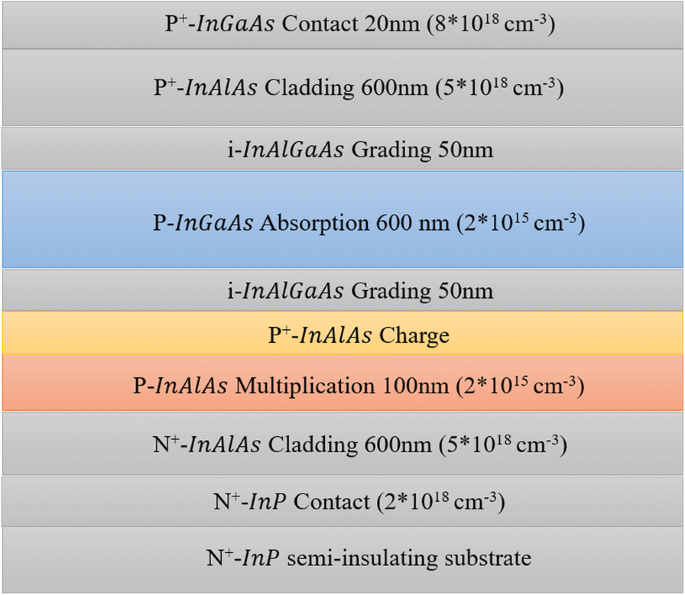
Schematischer Querschnitt der von vorne beleuchteten SAGCM-APDs. Zeigt den schematischen Querschnitt der von oben beleuchteten SAGCM InGaAs/InAlAs APD. Es umfasst Struktur, Materialien, Dotierung und Dicke. Von unten nach oben werden die Schichten nacheinander als Substrat, Kontaktschicht, Mantelschicht, Vervielfachungsschicht, Ladungsschicht, Abstufungsschicht, Absorptionsschicht, Abstufungsschicht, Mantelschicht und Kontaktschicht bezeichnet
Von unten nach oben werden die Schichten nacheinander als Substrat, Kontaktschicht, Mantelschicht, Vervielfachungsschicht, Ladungsschicht, Abstufungsschicht, Absorptionsschicht, Abstufungsschicht, Mantelschicht und Kontaktschicht bezeichnet. Die in der Absorptionsschicht induzierten photogenerierten Ladungsträger driften zur Vervielfachungsschicht, wo sie einen Lawinendurchbruch auslösen. Das elektrische Feld in der Absorption wird über die Ladungsschichtsteuerung eingestellt und nur in der Vervielfachungsschicht ein hohes Feld aufrechterhalten. Zwischen den Ladungs- und Absorptionsschichten vermeidet eine InAlGaAs-Abstufungsschicht die Elektronenanhäufung am InGaAs-InAlAs-Heteroübergang. Die Gerätestruktur in unserer Simulation ähnelt der experimentellen Struktur in Lit. [21].
Die elektrische Feldverteilung in SAGCM APD kann mit der Poisson-Gleichung, dem PN-Verarmungsschichtmodell und der Randbedingungsgleichung [29] gelöst werden. Die Poisson-Gleichung ist gegeben als
$$ \frac{d\xi}{d x}=\frac{\rho}{\varepsilon}=\frac{q\ast N}{\varepsilon}. $$ (1)Die Randbedingungsgleichung ist gegeben als
$$ Vbias+ Vbi=-{\int}_0^w\xi\left(x,\textrm{w}\right) dx. $$ (2)In diesen Gleichungen ist ρ ist gleich dem Dotierstoff-Ion q × N in der Verarmungsschicht, ε ist die Dielektrizitätskonstante des Materials, V Voreingenommenheit ist die Vorspannung an den APDs, V bi ist das eingebaute Potenzial und w ist die Dicke der Sperrschicht. Die mathematische Beziehung zwischen der Verteilung des elektrischen Felds und der Vorspannung, wenn die Grenze der Verarmungsschicht die Kontaktschicht in der Vorrichtung erreicht, kann unter Verwendung von Gl. (1) und (2).
Die Tunnelströme setzen sich aus Band-zu-Band- und Fallen-unterstütztem Tunneln zusammen. Der Tunnelstrom von Band zu Band hängt vom Feld im Material ab und wird bei hohen Feldern zu einer dominanten Komponente des Dunkelstroms [24, 30]. Die Erzeugungsrate des Band-zu-Band-Tunnels wird als [31] angegeben.
$$ {G}_{\mathrm{btb}}={\left(\frac{2{m}^{\ast}}{E_g}\right)}^{1/2}\frac{q^2E }{{\left(2\pi\right)}^3\mathrm{\hslash}}\exp \left(\frac{-\pi }{4q\mathrm{\hslash}E}{\left(2{ m}^{\ast}\ast {E}_g^3\right)}^{\raisebox{1ex}{$1$}\!\left/ \!\raisebox{-1ex}{$2$}\right. }\rechts) $$ (3)In der obigen Gleichung ist E g ist die Energiebandlücke von InGaAs (0,75 eV) oder InAlAs (1,46 eV), m* (entspricht 0,04 m e in InGaAs und 0,07 m e in InAlAs) ist die effektive reduzierte Masse und E ist das maximale elektrische Feld. G btb abhängig vom elektrischen Feld E und Energiebandlücke E g , w Tunnel als effektive Dicke für den Tunnelprozess angenommen wird und A wird als Bereich des Gerätes angenommen. Somit ist der Tunnelstrom des Band-zu-Band-Tunnels gegeben als [13].
$$ {I}_{\mathrm{tunnel}}/A={G}_{\mathrm{btb}}\ast q\ast {w}_{\mathrm{tunnel}} $$ (4)Die berechneten Ergebnisse von I Tunnel /A (w Tunnel = 1 μm) sind in Abb. 2 dargestellt. I Tunnel wird bei 2,0 × 10 5 . signifikant V/cm von InGaAs und 6,9 × 10 5 V/cm von InAlAs bzw. Wir stellen fest, dass diese berechneten Werte gut mit dem elektrischen Tunnelschwellenfeld übereinstimmen (2,0 × 10 5 V/cm, InGaAs) und (6,8 × 10 5 V/cm, InAlAs) in Referenzen. Der Tunnelstrom kann die Leistung von SPADs bei einem hohen Feld ausreichend beeinflussen. Somit sollte das Feld sowohl in InGaAs als auch in InAlAs von SPADs auf einen niedrigeren Wert als den Tunnelschwellenwert eingestellt werden. Tabelle 1 zeigt die in der Simulation verwendeten Parameter.
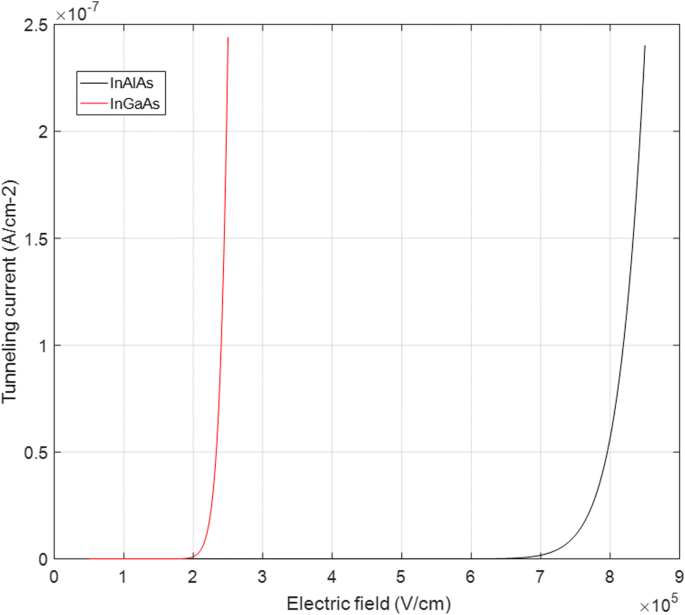
Beziehung zwischen ich Tunnel /A und elektrisches Feld in InGaAs und InAlAs. Präsentiert die berechneten Ergebnisse von I Tunnel /A . Ich Tunnel wird bei 2,0 × 10 5 . signifikant V/cm von InGaAs und 6,9 × 10 5 V/cm von InAlAs bzw.
Ergebnisse und Diskussion
In diesem Abschnitt wurden die theoretische Analyse und die Schlussfolgerungen durch Simulation untersucht. Zunächst wurde in Abschnitt A die Verteilung des elektrischen Feldes im Geiger-Modus untersucht. Anschließend werden unter Berücksichtigung des elektrischen Tunnelschwellenfeldes im Geiger-Modus die Designkriterien von SPADs optimiert, um den Tunneleffekt in Abschnitt B zu vermeiden. Die typische Vorrichtung Struktur in der Referenz [22] wurde verwendet, um das Simulationsmodell zu testen. In dieser Simulation haben wir dieselbe Simulationsmaschine wie in der Referenz [28] verwendet, und die Strom-Spannungs-Kurve zusammen mit der Verstärkungs-Spannungs-Kurve wurde in Abb. 3 angegeben plötzlicher Anstieg bei Durchbruchspannung.
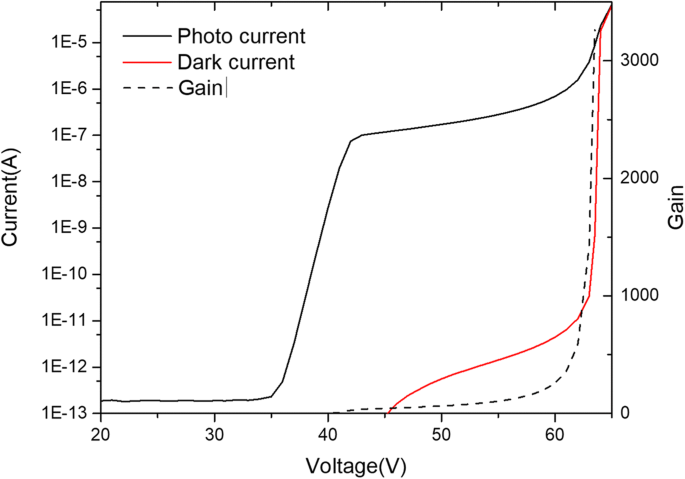
Strom-Spannungs-Kurve zusammen mit Verstärkung vs. Spannung von InGaAs/InAlAs APD. Stellt die i-v-Kurve zusammen mit der Verstärkungs-Spannungs-Kurve für einige typische Gerätestrukturen als Abbildung dar.
Elektrische Feldverteilung im Geiger-Modus
Wir haben festgestellt, dass die Geräteleistung stark von der Verteilung des elektrischen Felds beeinflusst wird. Um die hohe Verstärkung und den kleinen Dunkelstrom aufrechtzuerhalten, ist die richtige Steuerung des elektrischen Felds in den Multiplikations- und Absorptionsschichten wichtig. Aus der Ref.-Nr. [32] sollte eine geeignete Feldverteilung in InGaAs/InAlAs-APD diesen Regeln entsprechen. Die Garantie Vpt (Durchgriffsspannung) < Vbr (Durchbruchspannung) und Vbr -Vpt sollte eine Sicherheitsmarge für Verarbeitungsschwankungen bei Temperaturschwankungen und Betriebsbereich aufweisen. Bei der Durchbruchspannung geht die Multiplikationsverstärkung gegen unendlich und der Strom plötzlich ansteigen [32]. Wenn der Dunkel- oder Fotostrom 50 μA erreicht, wird die entsprechende Spannung als Durchbruchspannung Vbr . bezeichnet . In der Absorptionsschicht sollte das elektrische Feld größer als 50–100 kV/cm sein, um eine ausreichende Geschwindigkeit für die photoinduzierten Ladungsträger sicherzustellen. Gleichzeitig muss das elektrische Feld weniger als 180 kV/cm betragen, um den Tunneleffekt in der Absorptionsschicht zu vermeiden. Die Verteilung des elektrischen Felds beeinflusst die Geräteleistung stark. Die Wahl des elektrischen Feldes in der Absorptionsschicht hat einen Ausgleich des Kompromisses zwischen kleiner Laufzeit, Dunkelstrom und hoher Ansprechempfindlichkeit für die praktischen Anforderungen.
Die Abbildungen 4 und 5 zeigen die simulierten Feldspannungseigenschaften in der Multiplikations- bzw. Absorptionsschicht im Geiger-Modus. APDs, die im Geiger-Modus als SPADs betrieben werden, werden mit einer Sperrspannung angelegt, die in der Simulation die Durchbruchspannung von 1 bis 6 V überschreitet. Die Dicke der Ladungsschicht (W Aufladung ) beträgt 50 nm und die Dicke der Multiplikationsschicht (W Multiplikation ) sind 100, 200 bzw. 300 nm.
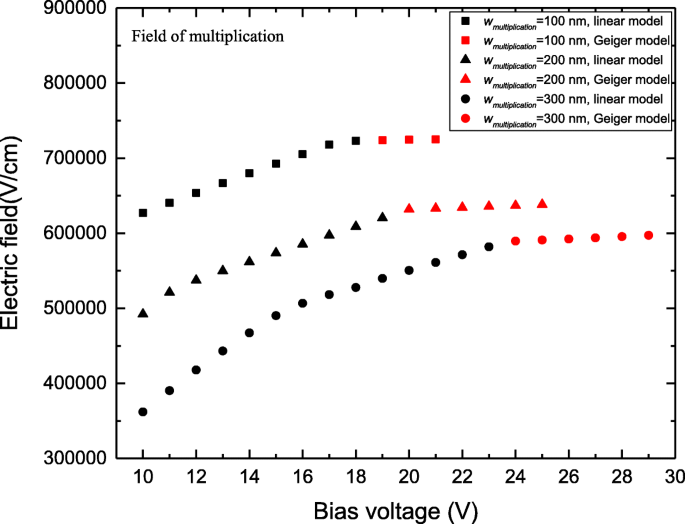
Simulationsergebnisse elektrisches Feld in Multiplikation im Geiger-Modus. Die Werte von W Multiplikation beträgt 100 nm (schwarzes Quadrat), 200 nm (schwarzes Dreieck), 300 nm (schwarzer Kreis). Abbildung 3 zeigt die simulierten Feldspannungs-Kennlinien in den Multiplikationsschichten im Geiger-Modus. Die Dicke der Ladungsschicht beträgt 50 nm und die Dicke der Multiplikationsschicht beträgt 100, 200 bzw. 300 nm
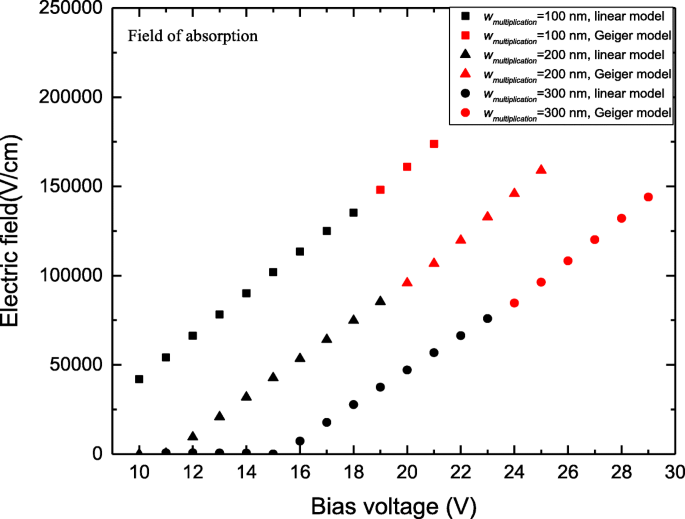
Simulationsergebnisse elektrisches Feld in Absorption im Geiger-Modus. Die Werte von W Multiplikation beträgt 100 nm (schwarzes Quadrat), 200 nm (schwarzes Dreieck), 300 nm (schwarzer Kreis). Abbildung 4 zeigt die simulierten Feldspannungseigenschaften in den Absorptionsschichten im Geigermodus. Die Dicke der Ladungsschicht beträgt 50 nm und die Dicke der Multiplikationsschicht beträgt 100, 200 bzw. 300 nm.
Wenn die InGaAs/InAlAs-SPADs unter dem linearen Modell (APDs) betrieben werden, nimmt das elektrische Feld in der Absorptionsschicht und der Multiplikationsschicht mit erhöhter Vorspannung linear zu. Wenn die Vorspannung jedoch die Durchbruchspannung im Geiger-Modus überschreitet, steigt das elektrische Feld in der Absorptionsschicht wie zuvor linear an, während die Zunahme des elektrischen Lawinenfelds in der Vervielfachungsschicht langsam wird. Im Vergleich zu InGaAs/InAlAs-APDs, die im Linearmodus arbeiten, erreichen die InGaAs/InAlAs-SPADs mit dem höheren Avalanche-Feld eine hohe Verstärkung in der Multiplikationsschicht, und ein einzelnes Photon kann einen makroskopischen Strompuls auslösen. Gleichzeitig ist das Absorptionsfeld beim Geiger-Mode größer als beim linearen Modell. Der Tunnelstrom wird zur dominanten Komponente des Dunkelstroms im Hochfeld und ein einzelnes Photon kann einen makroskopischen Stromimpuls mit der Avalanche-Verstärkung auslösen, die viel größer ist als der lineare Modus.
Designüberlegungen von SPADs
Wir wissen, dass SAPDs in einem gesättigten Modus arbeiten. Um die hohe Verstärkung und den kleinen Dunkelstrom aufrechtzuerhalten, ist die Steuerung des elektrischen Felds in den Multiplikations- und Absorptionsschichten wichtig. Wenn das Absorptionsfeld kleiner als das Tunnelschwellenfeld ist, kann es ein hohes elektrisches Lawinenfeld in der Vervielfachungsschicht aufrechterhalten und einen Tunnelstrom vermeiden. Folglich sollten die Konzentration und die Dicke jeder Schicht für SPADs geeignet sein.
Abbildung 2 zeigt, dass die SPADs aufgrund des hohen Felds in den Multiplikations- und Absorptionsschichten, die den elektrischen Tunnelschwellenwert überschreiten, wahrscheinlich einen großen Tunneleffekt haben. Somit sollten die elektrischen Felder sowohl bei der InGaAs-Absorption als auch bei der InAlAs-Multiplikation auf einen niedrigeren Wert als den Tunnelschwellenwert eingestellt werden. Die theoretische Analyse zeigt, dass das elektrische Lawinenfeld der Multiplikation durch die Produkte von N . verringert wird Aufladung und w Aufladung [28]. Somit kann die Ladungsschicht das Feld bei der Absorption steuern; das elektrische Lawinenfeld der Multiplikationsschicht wird jedoch durch w . bestimmt Multiplikation . Abbildung 6 zeigt die simulierten Feldspannungseigenschaften für verschiedene Multiplikationsdicken (100–500 nm), wenn das Gerät einen Lawinendurchbruch erleidet. Die Hintergrunddotierung in der Multiplikationsschicht und Absorptionsschicht beträgt 2 × 10 15 cm −3 , die die intrinsische Konzentration der Molekularstrahlepitaxie (MBE) ist. Die Simulationsergebnisse zeigen, dass das elektrische Lawinenfeld in der Vervielfachungsschicht mit zunehmender Dicke der Vervielfachungsschicht abnimmt. Somit kann eine dicke Multiplikationsschicht die Wahrscheinlichkeit eines Tunneleffekts durch ein niedriges elektrisches Lawinenfeld bei der Multiplikation vermeiden.

Elektrisches Feld in der Multiplikationsschicht mit unterschiedlichem W Multiplikation . Abbildung 5 zeigt die simulierten Feldspannungseigenschaften für verschiedene Multiplikationsdicken (100–500 nm), wenn das Gerät einen Lawinendurchbruch erleidet.
Um zu vermeiden, dass das elektrische Lawinenfeld bei der Multiplikation den Tunnelschwellenwert im Geiger-Modus überschreitet, sollte die Dicke der Multiplikation> 300 nm betragen, was ein elektrisches Lawinenfeld von weniger als 6 × 10 5 . hat V/cm und überschreitet sogar die Durchbruchspannung in Abb. 4. Somit kann eine dicke Multiplikationsschicht den Tunneleffekt in SPADs unter dem Geiger-Modus vermeiden. Dies ist der Grund für die niedrige DCR in SPADs mit einer dicken Multiplikation.
Wie in Abschnitt A erwähnt, nimmt das elektrische Feld in der Absorptionsschicht unter der Geiger-Mode linear zu. Der Anstieg der Vorspannung beeinflusst das elektrische Feld in der Absorptionsschicht erheblich, was dazu führt, dass das Feld mit großer Wahrscheinlichkeit 2,0 × 10 5 . überschreitet V/cm. Abbildung 7 zeigt die simulierte Verteilung des elektrischen Felds für verschiedene Dotierungskonzentrationen in der Ladungsschicht (w Aufladung = 50 nm). Wir stellen fest, dass höhere Dotierungskonzentrationen ein niedriges elektrisches Feld in der Absorptionsschicht aufweisen und sogar die Durchbruchspannung von 5 V im Geiger-Modus überschreiten; bei niedrigeren Dotierungskonzentrationen wird jedoch das elektrische Tunnelschwellenfeld schnell erreicht. Folglich bewirken die geringeren Dotierungskonzentrationen in der Ladungsschicht eine frühere Initiierung von Tunneleffekten. Um im Geiger-Modus eine ausreichende Betriebsvorspannung zu erhalten, muss der N Aufladung der SPADs ist größer als die N Aufladung von APDs. Verglichen mit den niedrigeren N Aufladung der SPADs, je höher N Aufladung von SPADs können unter einer großen Vorspannung arbeiten, um den Tunneleffekt zu vermeiden und eine hohe Verstärkung in der Multiplikationsschicht zu erzielen.
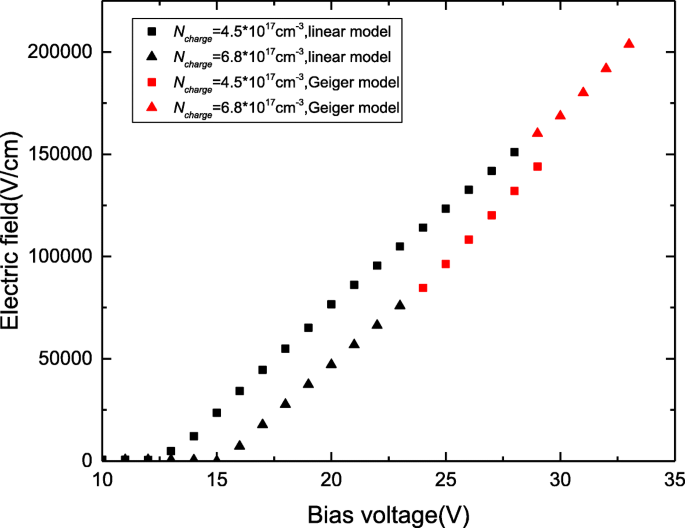
Feld in der Absorptionsschicht mit unterschiedlichem N Aufladung . Die Werte von N Aufladung ist 4,5*10 17 cm − 3 (schwarzes Quadrat), 6,8 * 10 17 cm −3 (schwarzes Dreieck). Abbildung 6 zeigt die elektrische Feldverteilung der Absorption für verschiedene Dotierungskonzentrationen in der Ladungsschicht (W Aufladung = 50 nm)
Schlussfolgerungen
Wir untersuchen die elektrische Feldverteilung und den Tunneleffekt von InGaAs/InAlAs APDs und SPADs durch theoretische Analyse und Simulation. Wenn die InGaAs/InAlAs-SPADs im Geiger-Modus betrieben werden, steigt das elektrische Feld in der Absorptionsschicht linear an und weicht von seinen linearen Beziehungen nach unten ab. In Anbetracht des elektrischen Tunnelschwellenfelds in der Multiplikationsschicht sollte die Dicke der Multiplikationsschicht größer als 300 nm sein. Darüber hinaus können SPADs unter einer großen Vorspannung arbeiten, um Tunneln in der Absorptionsschicht mit hohen Dotierungskonzentrationen in der Ladungsschicht zu vermeiden.
Abkürzungen
- 2D:
-
Zweidimensional
- APD:
-
Lawinenphotodiode
- DCR:
-
Dunkelzählrate
- SAGMAPDs:
-
Separate Absorptions-, Abstufungs-, Ladungs- und Multiplikations-Lawinen-Photodioden
- SPAD:
-
Einzelphotonen-Lawinen-Photodiode
- SPDE:
-
Effizienz der Einzelphotonenerkennung
Nanomaterialien
- Analyseoptionen
- Analyse der Aktin- und fokalen Adhäsionsorganisation in U2OS-Zellen auf Polymer-Nanostrukturen
- Infrarotreflexionsanalyse von epitaktischen n-dotierten GaN-Schichten, die auf Saphir gewachsen sind
- Helle Einzelphotonenquelle bei 1,3 μm basierend auf InAs-Doppelschicht-Quantenpunkt in Micropillar
- Theoretische Untersuchung von biaxial zugbelasteten Germanium-Nanodrähten
- Raman-Mapping-Analyse von Graphen-integrierten Silizium-Mikroring-Resonatoren
- Herstellung von helikalen CA/TPU-Nanofasern und deren Mechanismusanalyse
- Interband-Photoleitfähigkeit von metamorphen InAs/InGaAs-Quantenpunkten im 1,3–1,55-μm-Fenster
- Theoretische Studien zu InGaAs/InAlAs SAGCM Avalanche Photodioden
- Eine theoretische Simulation des Strahlungsverhaltens von Si-, Ge- und Si/Ge-Übergittern auf niederenergetische Bestrahlung



