Theoretische Studien zu InGaAs/InAlAs SAGCM Avalanche Photodioden
Zusammenfassung
In diesem Papier geben wir einen detaillierten Einblick in InGaAs/InAlAs separate Absorptions-, Grading-, Ladungs- und Multiplikations-Lawinen-Photodioden (SAGCM APDs) und es wird ein theoretisches Modell von APDs erstellt. Durch theoretische Analyse und zweidimensionale (2D) Simulation wird der Einfluss der Ladungsschicht und des Tunneleffekts auf die APDs vollständig verstanden. Das Design der Ladungsschicht (einschließlich Dotierungsgrad und Dicke) kann durch unser Vorhersagemodell für unterschiedliche Multiplikationsdicken berechnet werden. Wir stellen fest, dass mit zunehmender Dicke der Ladungsschicht der geeignete Dotierungsniveaubereich in der Ladungsschicht abnimmt. Im Vergleich zu einer dünneren Ladungsschicht variiert die Leistung von APD signifikant über mehrere Prozent Abweichungen der Dotierungskonzentrationen in dickeren Ladungsschichten. Darüber hinaus ist die Erzeugungsrate (G btt ) des Band-zu-Band-Tunnels berechnet und der Einfluss des Tunneleffekts auf das Lawinenfeld analysiert. Wir bestätigen, dass Lawinenfeld und Multiplikationsfaktor (M n ) bei der Multiplikation nimmt durch den Tunneleffekt ab. Das theoretische Modell und die Analyse basieren auf InGaAs/InAlAs APD; sie sind jedoch auch auf andere APD-Materialsysteme anwendbar.
Hintergrund
In0,53 Ga0,47 Als (im Folgenden InGaAs bezeichnete) Avalanche-Photodioden (APDs) sind die wichtigsten Photodetektoren für die kurzwellige Infrarot-Detektion. Sie sind in traditionellen Bereichen wie der Glasfaserkommunikation, in Aufklärungsanwendungen und in der Fernerkundung von Bedeutung. InP und In0,52 Al0,48 As (nachstehend als InAlAs bezeichnet) haben den gleichen Gitterabstand wie InGaAs und große Lawinendurchbrucheigenschaften; daher sind sie die geeigneten Multiplikationsschichtmaterialien von InGaAs-APDs in den traditionellen Anwendungen. In den letzten Jahren wurden aufgrund der schnellen Entwicklung der Einzelphotonendetektion in der Quantenschlüsselverteilung [1], der zeitaufgelösten Spektroskopie [2], der optischen VLSI-Schaltungsinspektion [3] und der 3D-Laserentfernung [4] APDs als Schlüssel Komponente in diesen Anwendungen haben zunehmend Aufmerksamkeit auf sich gezogen [5, 6]. Pellegriniet al. beschrieben das Design, die Herstellung und die Leistung von InGaAs/InP-Bauelementen mit planarer Geometrie, die für die Einzelphotonen-Detektion mit einer Einzelphotonen-Detektionseffizienz (SPDE) von 10 % bei 1550 nm (200 K) entwickelt wurden [7]. Tosiet al. präsentierten die Designkriterien einer neuartigen InGaAs/InP Single-Photon Avalanche Photodiode (SPAD) mit hoher SPDE (30%, 225 K), geringem Rauschen und geringem Timing-Jitter [8]. In der Simulation wurde ein auf experimentellen Daten basierendes Gerätemodell erstellt, um die Dunkelzählrate (DCR) und SPDE von InGaAsP/InP-SPADs in [9] vorherzusagen, und eine integrierte Simulationsplattform, die die Quantenschlüsselverteilungsleistung von InGaAs im Täuschungszustand bewerten kann /InP SPADs wurde in [10] eingebaut. Acerbiet al. präsentierten Designkriterien für InGaAs/InP-Einphotonen-APDs mit einem benutzerdefinierten SPAD-Simulator [11]. Für InGaAs/InAlAs-APDs wurde gezeigt, dass ein SPAD InGaAs/InAlAs mit Mesastruktur eine SPDE von 21 % (260 K) erreicht; jedoch wurde eine hohe DCR beobachtet und einem übermäßigen Tunnelstrom zugeschrieben [12]. Dann [13] verwendete eine dicke InAlAs-Lawinenschicht in InGaAs/InAlAs-APDs, um die SPDE (26%, 210 K) zu verbessern und die DCR zu verringern (1 × 10 8 Hz). Bei der Simulation von InAlAs-basierten APDs wurde ein auf der Monte-Carlo-Methode basierendes Gerätemodell erstellt, um die grundlegende Charakterisierung von InGaAs/InAlAs-APDs in [14] und den Einfluss von Ladungsschicht und Multiplikationsschicht auf die Durchgriffsspannung und den Durchbruch zu untersuchen Spannung wurden mit stationären 2D-numerischen Simulationen in [15] untersucht.
Im Vergleich zu InAlAs-basierten APDs sind die Untersuchungen zu InP-basierten APDs umfassender und eingehender in Theorie und Simulation. Anstelle von InP wird jedoch zunehmend APD auf InAlAs-Basis verwendet, da es eine größere Bandlücke aufweist, die die Durchbruchseigenschaften sowohl in den APDs als auch in den SPADs verbessern kann [16]. Das Verhältnis des Ionisationskoeffizienten von Elektron (α) zu Loch (β) in InAlAs ist im Vergleich zu InP größer, und daher weist es einen geringen Überschussrauschfaktor und ein hohes Verstärkungs-Bandbreiten-Produkt auf. Darüber hinaus weist InAlAs eine starke Zunahme der Durchbruchwahrscheinlichkeit mit einem zu hohen Vorspannungsverhältnis auf, wodurch InAlAs-SPADs eine niedrigere DCR aufweisen [17]. Einige wichtige Eigenschaften und Schlussfolgerungen zu InAlAs-basierten APDs wurden aus früheren Studien gewonnen, wie z. Das elektrische Tunnelschwellenfeld in der Absorption (InGaAs) beträgt 1,8 × 10 5 V/cm, und der Tunnelstrom wird zur dominierenden Komponente des Dunkelstroms im Hochfeld [14]. Eine vertikale Beleuchtungsstruktur weist eine größere optische Toleranz auf, hat jedoch einen schwerwiegenderen Kompromiss zwischen der Trägerlaufzeit und der Ansprechempfindlichkeit [19]. Darüber hinaus wurden in [20,21,22] das theoretische Modell, die Struktur (Dicke und Dotierung), das elektrische Feld und andere InAlAs-basierte APD-Parameter untersucht. Diese Studien konzentrierten sich jedoch nur auf Einflüsse üblicher APD-Strukturparameter, wie etwa der Dicke der Absorptionsschicht, der Multiplikationsdicke und des Dotierungsniveaus der Ladungsschicht. Die Beziehung zwischen den Strukturparametern und der Leistung der InAlAs-basierten APD ist noch nicht vollständig verstanden und optimiert.
In diesem Beitrag wurden eine theoretische Studie und numerische Simulationsanalysen basierend auf der vertikalen Struktur von InGaAs/InAlAs für die Detektion von 1,55 μm Wellenlänge untersucht. Wir haben ein theoretisches Modell erstellt, um den Einfluss von Strukturparametern auf das Gerät und die detaillierte Beziehung jeder Schicht in APDs zu untersuchen. Das Design der Ladungsschicht mit unterschiedlichen Multiplikationsdicken, der Einfluss der Dicke auf das Dotierungsniveau in der Ladungsschicht und der Tunneleffekt auf das Lawinenfeld bei der Multiplikation wurden analysiert und simuliert.
Methoden
In diesem Abschnitt wurde eine mathematische Beziehung zwischen den Geräteparametern und der elektrischen Feldverteilung im Gerät aufgebaut, die zur Analyse der Ladungsschicht und des Tunneleffekts verwendet wurde. Gleichzeitig wurde ein Simulationsmodell erstellt, das Simulationsstruktur, Materialparameter und grundlegende physikalische Modelle umfasste. Das theoretische Analyse- und Simulationsmodell basierte auf der vertikalen Struktur von SAGCM InGaAs/InAlAs APD.
Theoretisches Modell und Analyse der Ladungsschicht
Geräteparameter wie Dotierungsgrad, Dicke, Materialien und Struktur wurden verwendet, um das mathematische Modell zur Berechnung der elektrischen Feldverteilung in APD zu erstellen. Die grundlegenden physikalischen Theorien, die die Poisson-Gleichung, das Verarmungsschichtmodell und das PN-Übergangsmodell von Halbleiterbauelementen umfassen, finden sich in den Kapiteln 1, 2 und 4 in [23] und [24]. Die Gleichung für den Übergangsmultiplikationsfaktor kann in [25] gefunden werden, und die Materialparameter von Halbleitern stammen aus [26]. Das vorgestellte Modell verwendet die Poisson-Gleichung, die Tunnelstromdichtegleichung, das Verarmungsschichtmodell, das Übergangstheoriemodell und das lokale Modell der Lawinenverstärkung. Das vereinfachte mathematische Koordinatensystem der APD, das grundlegende Strukturparameter (Materialien, Dicke, Dotierung und Dielektrizitätskonstante) enthält, ist in Abb. 1 dargestellt. Es handelt sich um eine vereinfachte SACM-APD-Struktur, die die Abstufungsschicht ignoriert. Die Materialien der Kontaktschicht, Ladungsschicht und Vervielfachungsschicht sind InAlAs und die Absorptionsschicht ist InGaAs. Die Übergänge der Schichten werden durch X . getrennt n , 0, X m , X c , und X a und X p durch das x Koordinate. Dopingwerte werden durch N . ausgedrückt 0 , N 1 , N 2 , N 3 , und N 4 , die Schichtdicken werden ausgedrückt durch w 0 , w 1 , w 2 , w 3 , und w 4 , und Dielektrizitätskonstanten werden durch ε . ausgedrückt s0 , ε s1 , ε s2 , ε s3 , und ε s4 von Kontakt A, Multiplikation, Ladung, Absorption bzw. Kontakt B.
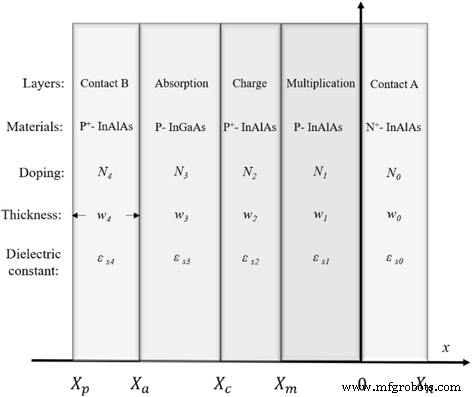
Das vereinfachte mathematische Koordinatensystem der SACM InGaAs/InAlAs APD. Stellt die vereinfachten Strukturen einer APD dar, die verwendet wird, um ein theoretisches Modell zu erstellen. Das vereinfachte mathematische Koordinatensystem der APD, das grundlegende Strukturparameter enthält (Materialien, Dicke, Dotierung und Dielektrizitätskonstante)
Gleichung 1 ist die Poisson-Gleichung, die die elektrische Potenzialverteilung mithilfe der Ladungsdichte ρ . lösen kann . In dieser Gleichung ist ρ ist gleich Dotierstoffion N im Verarmungsschichtmodell w gleich der Dicke der Sperrschicht ist und ε ist die Dielektrizitätskonstante des Materials. Im allgemeinen Modell der elektrischen Feldverteilung mit PN-Übergang ist ρ ist eine Variable, die von der Dicke der Sperrschicht abhängt w und Dotierstoffion N . In diesem Modell ändert es sich unter Berücksichtigung des Tunneleffekts. Bevor wir jedoch den Tunneleffekt betrachteten, haben wir zunächst die Verteilung des elektrischen Felds mit einer üblichen Methode erstellt.
$$ \frac{d\xi}{d x}=\frac{\rho}{\varepsilon}=\frac{q\times N}{\varepsilon} $$ (1)Durch Lösen der Poisson-Gleichung mit den Geräteparametern erhält man den mathematischen Ausdruck des maximalen elektrischen Felds. Dieser Ausdruck wird durch die Variation der Eindringdicke in der Verarmungsschicht bestimmt, die in den Formeln 2 und 3 gezeigt ist. In diesem Ausdruck sind die Parameter, die Dotierungsniveaus (N ), Dicken der Sperrschicht (w ) und Dielektrizitätskonstanten (ε) der verschiedenen Schichten finden Sie in Abb. 1.
$$ {\xi}_{\max(w)}={\sum}_{k=1}^4\left(-\frac{q\times {N}_k\times {w}_k}{\ varepsilon_{sk}}\right) $$ (2) $$ {\xi}_{\max (w)}=\frac{q\times {N}_0\times {w}_0}{\varepsilon_{s0 }} $$ (3)Dann kann die elektrische Feldverteilung in allen Punkten mit den Formeln 4 und 5 abgeleitet werden. Die Randbedingung ignoriert das eingebaute Potenzial V br in Formel 6; daher kann die mathematische Beziehung zwischen der Dicke der Verarmungsschicht und der Vorspannung berechnet werden.
$$ {\xi}_{\left(x,w\right)}={\xi}_{\max(w)}+{\sum}_{k=1}^4\left(\frac{ q\times {N}_k\times \left|x\right|}{\varepsilon_{sk}}\right)\left({X}_pSobald die Grenze der Verarmungsschicht den Kontaktbereich erreicht, können aus dem Modell die Formeln 7–11 verwendet werden, um das elektrische Feld in jeder Schicht zu analysieren. Bei der praktischen APD werden die Absorptions- und Vervielfachungsschichten ungewollt in intrinsische Schichten dotiert. N 3 und N 1 kleiner als N . sind 2 . Somit ist Formel 9 ungefähr gleich Formel 12. Dies ist der Grund dafür, dass die Ladungsschicht die Verteilung des elektrischen Felds im Gerät steuern kann.
$$ {\displaystyle \begin{array}{l}\xi \left(x,{V}_{\mathrm{bias}}\right)={\xi}_{\max \left({V}_ {\textrm{bias}}\right)}+\frac{q\times {N}_1\times {w}_1}{\varepsilon_{s1}}+\frac{q\times {N}_2\times { w}_2}{\varepsilon_{s2}}+\frac{q\times {N}_3\times \left|x-{X}_c\right|}{\varepsilon_{s3}}\\ {}\kern4em \approx {\xi}_{\max \left({V}_{\textrm{bias}}\right)}+\frac{q\times {N}_2\times {w}_2}{\varepsilon_{ s2}}\left({X}_{\textrm{c}}\ge x\ge {X}_a\right)\end{array}} $$ (12)In Formel 8 wird die elektrische Felddifferenz zwischen Multiplikation und Absorption unter Verwendung des Produkts von N . bestimmt 2 und w 2 . N 2 ist das Dotierungsniveau in der Ladungsschicht und w 2 ist die Dicke der Ladungsschicht. Für eine geeignete elektrische Feldverteilung in InGaAs/InAlAs APD sollte das elektrische Feld in der Absorptionsschicht (InGaAs) innerhalb der Intervallwerte von 50–180 kV/cm liegen, die eine ausreichende Geschwindigkeit für die photoinduzierten Ladungsträger gewährleisten und den Tunneleffekt vermeiden in der Absorptionsschicht [10]. Das heißt, das Lawinenfeld bei der Vervielfachung sollte bei der Absorption durch die Ladungsschicht auf 50–180 kV/cm sinken. Somit können wir Formel 8 verwenden, um optimal berechnete Dotierungsniveaus und Dicken der Ladungsschicht zu finden. Wenn die Multiplikationsschicht 200 nm beträgt (das Lawinenfeld E in der Multiplikation ist 6,7 × 10 5 V/cm, während die Multiplikationsschicht 200 nm beträgt [27]); die berechneten Werte des Dotierungsniveaus und der Dicke in der Ladungsschicht werden mit Ergebnissen aus [28,29,30,31,32,33] in Abb. 2 verglichen. Der Bereich der theoretischen Werte stimmt gut mit den experimentellen Daten überein. Dieses Ergebnis beweist, dass Formel 8 verwendet werden kann, um das Dotierungsniveau mit unterschiedlichen Dicken in der Ladungsschicht vorherzusagen, wenn die Multiplikationsdicke sicher ist.
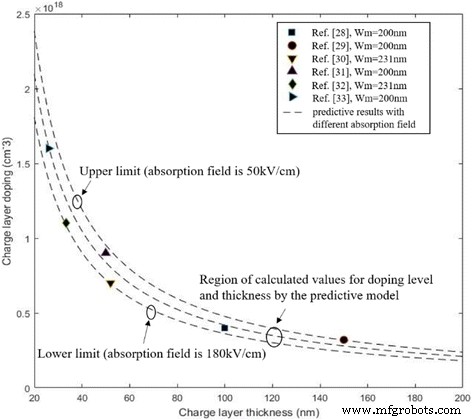
Vergleich theoretischer Ergebnisse und experimenteller Daten aus verschiedenen Berichten (w m = 200 nm). Geschlossene Symbole:Dotierungsgrad und Dicke der Ladungsschicht mit Multiplikationsdicke von 200 nm (schwarzes Quadrat, schwarzer Kreis, schwarzes Dreieck, schwarzes nach rechts zeigendes Dreieck) und 231 nm (schwarze Raute, schwarzes nach unten zeigendes Dreieck) in den Referenzen. Stellt die berechneten Werte der Ladungsschicht (Dotierungsgrad und -dicke) nach Formel 8 dar (das Absorptionsfeld beträgt 50–180 kV/cm). Wenn das Absorptionsfeld 50 kV/cm beträgt, kann die Obergrenze des Dotierungsniveaus in der Ladungsschicht erhalten werden. Wenn das Absorptionsfeld 180 kV/cm beträgt, kann die untere Grenze des Dotierungsniveaus in der Ladungsschicht erhalten werden. Wir vergleichen die theoretischen Ergebnisse und Versuchsdaten aus verschiedenen Berichten. Der Bereich der theoretischen Werte stimmt gut mit den experimentellen Daten überein. Gestrichelte Linien die berechneten Werte von Dotierungsniveau und -dicke nach der Formel
Wir berechnen das optimale Dotierungsniveau für verschiedene Dicken der Ladungsschicht mit der Multiplikationsschicht von 300, 500 und 700 nm, und die Ergebnisse sind in Abb. 3 dargestellt. Dieses Ergebnis zeigt, dass die Toleranz des Dotierungsniveaus in der Ladungsschicht . ist bezogen auf seine Dicke und der Bereich des Dotierungsniveaus nimmt mit der Dickenzunahme der Ladungsschicht ab. Das heißt, wenn wir einen dicken Ladungsbereich anwenden, würde nur ein kleiner Bereich des Dotierungsniveaus in der Ladungsschicht existieren, um das optimale elektrische Feld zu erfüllen. Als Ergebnis variiert die Leistung der APD signifikant über mehrere Prozent Abweichungen der Dotierungskonzentrationen in der dickeren Ladungsschicht. Im Abschnitt „Ergebnisse und Diskussion“ wurden die praktischen Strukturen von APDs simuliert, um die theoretische Analyse zu untersuchen und zu überprüfen, die den Einfluss der Ladungsschichtdicke auf den Dotierungsniveaubereich in der Ladungsschicht und die Leistungsvielfalt für unterschiedliche Ladungsschichtdicken umfasst APDs.

Das optimale Dotierungsniveau und die Dicke der Ladungsschicht für verschiedene Multiplikationsschichten. Durchgezogene Linie:w m = 300 nm. Gestrichelte Linie:w m = 500 nm. Punktlinie:w m = 700 nm. Stellt die berechneten Werte der Ladungsschicht (Dotierungsgrad und Dicke) durch die Formel dar, während das Feld der Absorptionsschicht geeignet ist. Die Dicken der Multiplikationsschicht betragen 300, 500 und 700 nm. Wenn die Dicke der Multiplikationsschicht sicher ist, können wir die Formel verwenden, um das optimale Dotierungsniveau und die Dicke der Ladungsschicht zu finden
Theoretisches Modell unter Berücksichtigung des Tunnelns
Das obige Analysemodell befasst sich mit der Verteilung des elektrischen Felds im Gerät und basiert auf der Prämisse, dass ρ ist das Dotierstoff-Ion in der Verarmungsschicht. Wenn innerhalb der Absorptionsschicht ein ausreichend hohes elektrisches Feld vorhanden ist, kann die lokale Bandkrümmung ausreichend sein, um Elektronen zum Tunneln zu ermöglichen [34]. Daher kann Elektronentunneln auftreten. Aus dem schematischen Tunneldiagramm in Abb. 4 geht hervor, dass der Tunneleffekt die Ladungsdichte ρ . ändert, wenn die Absorptionsschicht eine Durchbruchtunnelung aufweist , nimmt die positive Ladung bei der Absorption zu und die negative Ladung in den Multiplikations- und Ladungsschichten nimmt zu. Also, ρ nicht gleich der Dotierstoffionen-Ladungsdichte in der Verarmungsschicht ist, während der Tunneleffekt auftritt. Die zuvor besprochenen Formeln ändern sich nach Berücksichtigung des Tunneleffekts.

Tunnelprozess und Ladungsdichteänderung in den Multiplikations- und Absorptionsschichten. Stellt ein schematisches Diagramm des Tunnelprozesses im Gerät dar. Wenn innerhalb der Absorptionsschicht ein ausreichend hohes elektrisches Feld vorhanden ist, kann die lokale Bandkrümmung ausreichend sein, um ein Tunneln von Elektronen zu ermöglichen. Wenn die Absorptionsschicht ein Durchschlagstunneln aufweist, nimmt die positive Ladung in der Absorption zu und die negative Ladung in den Multiplikations- und Ladungsschichten nimmt zu. Also, ρ ist nicht gleich der Dotierstoffionen-Ladungsdichte in der Verarmungsschicht, während der Tunneleffekt auftritt
Die Generationsrate G bbt des Band-zu-Band-Tunnels ist in Formel 13 beschrieben [35, 36].
$$ {G}_{bbt}={\left(\frac{2{m}^{\ast}}{E_g}\right)}^{1/2}\frac{q^2{E_p}^ {\gamma}}{{\left(2\pi\right)}^3{\hbar}^2}\exp \left(\frac{-\pi }{4{q\mathit{\hbar E}} _p}{\left(2{m}^{\ast}\times {E_g}^3\right)}^{\raisebox{1ex}{$1$}\!\left/ \!\raisebox{-1ex} {$2$}\right.}\right)=A\times {E_p}^{\gamma}\times \exp \left(-\frac{B}{E_p}\right) $$ (13)In Formel 13 E g ist die Energiebandlücke von InGaAs, m* (entspricht 0,04 m e ) ist die effektive reduzierte Masse, E p das elektrische Durchschlagsfeld in der Absorptionsschicht ist und γ ist ein benutzerdefinierbarer Parameter, der normalerweise auf 1 bis 2 beschränkt ist. Die A und B sind die Charakterisierungsparameter. Wir berechnen das G bbt mit verschiedenen γ , und die Ergebnisse sind in Abb. 5 dargestellt. Es kann festgestellt werden, dass G bbt passt die gleiche Größenordnung für das Dotierungsniveau der Ladungsschicht an, während γ ist auf 1~1.5 beschränkt.

Die G btt für verschiedene Felder in der Absorptionsschicht mit verschiedenen γ . Die Werte von γ ist 1,0 (schwarzer Stern), 1,1 (schwarzes nach unten zeigendes Dreieck), 1,2 (schwarze Raute), 1,3 (schwarzes Dreieck), 1,4 (schwarzes Quadrat), 1,5 (schwarzer Kreis). Zeigt die berechneten Ergebnisse von G btt nach Formel 13. Wenn das Absorptionsfeld 19 kV/cm überschreitet, ist G bbt nimmt allmählich zu. Es kann auch festgestellt werden, dass G bbt passt die gleiche Größenordnung für das Dotierungsniveau der Ladungsschicht an, während γ ist auf 1~1.5 beschränkt
Als Ergebnis ist die Ladungsdichte ρ ist eine Variable und wird durch den Tunneleffekt und das Dotierstoff-Ion im Absorptionstunnel bestimmt. Bei dieser Gelegenheit wird Formel 1 in Formel 14 geändert und das elektrische Feld in der Multiplikationsschicht wird durch Formel 15 beschrieben. w Tunnel ist die effektive Sperrschicht des Tunnelprozesses [35]. Somit kann die Änderung des Lawinenfeldes durch Formel 16 beschrieben werden, und das Lawinenfeld nimmt bei der Multiplikation mit dem Tunneleffekt ab.
$$ \frac{d\xi}{dx}=\frac{\rho}{\varepsilon}=\frac{q\times \left(N+{G}_{btt}\right)}{\varepsilon}, {E}_p> 1.8\times {10}^5V/cm $$ (14) $$ \xi \left(x,{V}_{\textrm{bias}}\right)={\xi}_{ \max \left({V}_{\textrm{bias}}\right)}+\frac{q\times \left({N}_1\times \left|x\right|+{G}_{bbt }\times {w}_{\mathrm{tunnel}}\right)}{\varepsilon_{s1}}\left(0\ge x\ge {X}_m\right) $$ (15) $$ \delta \xi \left(x,{V}_{\textrm{bias}}\right)=\delta E=\frac{q\times {G}_{btt}\times {w}_{\textrm{tunnel }}}{\varepsilon_{\mathrm{s}3}} $$ (16)Die Elektronen- und Lochionisationskoeffizienten werden durch die Formeln 17 und 18 in [18] beschrieben. E ist das Lawinenfeld in der Multiplikation.
$$ \alpha ={a}_n{e}^{\raisebox{1ex}{$-{b}_n$}\!\left/ \!\raisebox{-1ex}{$E$}\right.} $$ (17) $$ \beta ={a}_p{e}^{\raisebox{1ex}{$-{b}_p$}\!\left/ \!\raisebox{-1ex}{$E$ }\rechts.} $$ (18)Der Effekt der Trägerlawine wird durch das Stoßionisationsmodell berücksichtigt. In Anbetracht der extrem niedrigen Ladungsträgerdichte der Vervielfachungsschicht im Vergleich zur Ladungsschicht ist es vernünftig anzunehmen, dass das elektrische Feld durch die Vervielfachungsschicht gleichmäßig ist. Daher ist der Multiplikationsfaktor (M n ) kann wie folgt ausgedrückt werden Gl. 19. Hier, w m ist die Multiplikationsschichtdicke und k ist das Verhältnis des Stoßionisationskoeffizienten definiert durch α/β . Seit k variiert sehr langsam mit dem elektrischen Feld, k ist ungefähr konstant für eine leichte Variation von w m [37].
$$ {M}_n=\frac{k-1}{k\times {e}^{-\alpha \left(1-\raisebox{1ex}{$1$}\!\left/ \!\raisebox{ -1ex}{$k$}\right.\right){w}_m}-1} $$ (19)Angenommen Konstante w m und Vorspannung, Differenzierung von M n bezüglich der Elektronenionisationskoeffizienten ist in den Formeln 20 und 21.
$$ \delta {M}_n\left|{}_{w=const\&V=const}\right.={M_n}^2{e}^{-\alpha \left(1-\raisebox{1ex} {$1$}\!\left/ \!\raisebox{-1ex}{$k$}\right.\right){w}_m}\times {w}_m\delta \alpha $$ (20) $$ \delta \alpha =\frac{\delta \alpha}{\delta E}={\alpha}_n{b}_n{e}^{\frac{-{b}_n}{E}}\frac{1 }{E^2} $$ (21)In den Formeln 20 und 21 ist δα/δE ist positiv. Es wird angenommen, dass 20 % einer gesamten Verarmungsabsorptionsschicht w . beträgt Tunnel und die Absorptionsschicht ist 400 nm dick. Durch Lösen von Formel 16 wird die Beziehung zwischen dem δE und das Absorptionsfeld mit verschiedenen γ ist in Abb. 6 dargestellt. Es ist zu erkennen, dass δE passt die gleiche Größenordnung für das Lawinenfeld bei der Multiplikation an. Somit hat der Tunneleffekt einen Einfluss auf das Lawinenfeld und die M n sinkt mit dem Tunneleffekt. Bei der Analyse haben wir angenommen, dass die negative Ladung bei der Multiplikation nicht multipliziert wird und das Modell nach Berücksichtigung strenger wird. Um den Einfluss des Tunneleffekts auf die praktische Struktur von APDs zu überprüfen und zu analysieren, haben wir die Beziehung zwischen dem Tunneleffekt und dem Multiplikations-Lawinenfeld detailliert im Abschnitt „Ergebnisse und Diskussion“ simuliert.

Die δE für unterschiedliche Felder in der Absorptionsschicht mit unterschiedlichen γ . Die Werte von γ ist 1,0 (schwarzer Stern), 1,1 (schwarzes nach unten zeigendes Dreieck), 1,2 (schwarze Raute), 1,3 (schwarzes Dreieck), 1,4 (schwarzes Quadrat), 1,5 (schwarzer Kreis). Zeigt die berechneten Ergebnisse von δE nach Formel 16. Wenn das Absorptionsfeld 19 kV/cm überschreitet, δE nimmt allmählich zu. Es kann auch festgestellt werden, dass δE passt die gleiche Größenordnung für das Lawinenfeld bei der Multiplikation an. Somit hat der Tunneleffekt einen Einfluss auf das Lawinenfeld mit dem Tunneleffekt
Struktur- und Simulationsmodell
Zur Simulation und Analyse wurde eine Halbleiterbauelement-Simulation von TCAD verwendet. Diese Simulationsmaschine definiert physikalische Modelle in der Simulation, und die Ergebnisse haben eine physikalische Bedeutung [20]. Die grundlegenden physikalischen Modelle wurden wie folgt präsentiert. Die Drift-Diffusions-Modelle, einschließlich der Poisson- und Ladungsträgerkontinuitätsgleichungen, wurden verwendet, um die elektrische Feldverteilung und den Diffusionsstrom IDIFF . zu simulieren . Für den Band-zu-Band-Tunnelstrom IB2B . wurde ein Band-zu-Band-Tunneling-Modell verwendet , und das Fallen-unterstützte Tunnelmodell wurde für den Fallen-unterstützten Tunnelstrom ITAT . verwendet . Der Generations-Rekombinations-Strom IGR wurde durch das Shockley-Read-Hall-Rekombinationsmodell und den Auger-Rekombinationsstrom IAUGER . beschrieben wurde durch das Auger-Rekombinationsmodell beschrieben. Der Dunkelstrom wurde durch diese Mechanismen eindeutig beschrieben [38]. Die Lawinenvermehrung wurde durch das Selberherr-Impaktionisationsmodell beschrieben. Andere grundlegende Modelle, einschließlich der Fermi-Dirac-Trägerstatistik, Trägerkonzentrationsabhängigkeit, Niedrigfeldmobilität, Geschwindigkeitssättigung und Ray-Tracing-Methoden, wurden für das Simulationsmodell verwendet und ein rigoroses Simulationsmodell erstellt.
Gerätestrukturen in der Simulation ähnelten den experimentellen Strukturen in [13]. Der schematische Querschnitt der von oben beleuchteten SAGCM-InGaAs/InAlAs-APD ist in Fig. 7 gezeigt. Die Strukturen von oben nach unten werden nacheinander als InGaAs-Kontaktschicht, InAlAs-Mantelschicht, InAlGaAs-Abstufungsschicht, InGaAs-Absorptionsschicht, InAlGaAs-Abstufung bezeichnet Schicht, InAlAs-Ladungsschicht, InAlAs-Multiplikationsschicht, InAlAs-Mantelschicht, InP-Kontaktschicht und InP-Substrat. Die Dicke und Dotierung jeder Schicht sind auch in Abb. 7 dargestellt. Um den Einfluss der Dicke auf die Simulationsergebnisse zu vermeiden, wählen wir zwei Simulationsstrukturen. Eine Simulationsstruktur wird als APD-1 bezeichnet (Multiplikations- und Absorptionsschichten sind 800 bzw. 1800 nm) und die andere Simulationsstruktur wird als APD-2 bezeichnet (Multiplikations- und Absorptionsschichten sind 200 bzw. 600 nm).
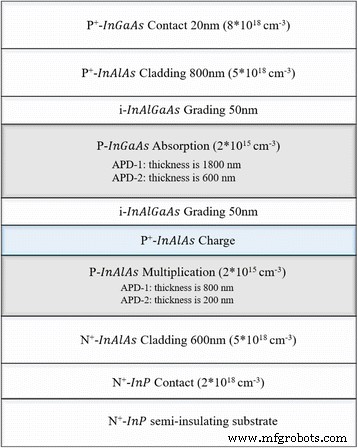
Simulationsstruktur und Parameter der APD. Zeigt den schematischen Querschnitt der von oben beleuchteten SAGCM InGaAs/InAlAs APD-1 und APD-2. Es umfasst Struktur, Materialien, Dotierung und Dicke
Um das Simulationsmodell zu testen, wurden die Versuchsdaten in [13] mit den Simulationsergebnissen verglichen. In dieser Simulation haben wir die gleiche Struktur in der Referenz verwendet, und die Strom-Spannungs-Kennlinien des Geräts wurden angegeben. Abbildung 8 zeigt unsere Simulationsergebnisse und die Experimentergebnisse in der Referenz. Sie haben die ähnliche Punch-Through-Spannung V pt und Durchbruchspannung V br . Außerdem stimmen die Simulations- und Versuchsergebnisse gut überein. Daher ist das Modell in unserer Simulation genau. Die oben genannten Parameter sind in Tabelle 1 aufgeführt.
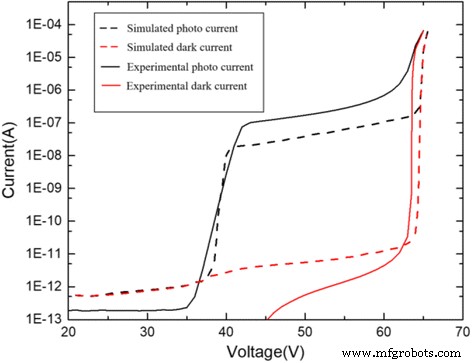
Simulationsergebnisse im Vergleich zu den Versuchsergebnissen (Photostrom und Dunkelstrom). Schwarze gestrichelte Linie:simulierter Fotostrom. Rote gestrichelte Linie:simulierter Dunkelstrom. Schwarze durchgezogene Linie:experimenteller Fotostrom. Rote durchgezogene Linie:experimenteller Dunkelstrom. Präsentiert den Vergleich der Simulationsergebnisse und Versuchsergebnisse. Das Simulationsmodell verwendet die gleichen Parameter aus dem Experiment in der Referenz
Ergebnisse und Diskussion
In diesem Abschnitt wurden die theoretische Analyse und die Schlussfolgerungen durch Simulation im Detail untersucht. Zunächst wurde der Einfluss der Ladungsschichtdicke auf die Dotierungsniveautoleranz in der Ladungsschicht im Abschnitt „Einfluss der Ladungsschichtdicke“ untersucht. Anschließend wurde die Beziehung zwischen dem Tunneleffekt und dem Multiplikations-Lawinenfeld analysiert und im Abschnitt „Tunneleffekt auf die Verteilung des elektrischen Felds“ verifiziert.
Einfluss der Ladungsschichtdicke
Aus [14] sollte eine geeignete Feldverteilung in InGaAs/InAlAs APD diesen Regeln entsprechen. Die Garantie V pt < V br und V br − V pt sollte eine Sicherheitsmarge für Verarbeitungsschwankungen bei Temperaturschwankungen und Betriebsbereich aufweisen. In der Absorptionsschicht sollte das elektrische Feld größer als 50–100 kV/cm sein, um eine ausreichende Geschwindigkeit für die photoinduzierten Ladungsträger sicherzustellen. Gleichzeitig muss das elektrische Feld weniger als 180 kV/cm betragen, um den Tunneleffekt in der Absorptionsschicht zu vermeiden. Die Verteilung des elektrischen Felds beeinflusst die Geräteleistung stark. Die Wahl des elektrischen Feldes in der Absorptionsschicht hat einen Ausgleich des Kompromisses zwischen kleiner Laufzeit, Dunkelstrom und hoher Ansprechempfindlichkeit für die praktischen Anforderungen.
In the simulation, we used the structure of APD-1 (multiplication is 800 nm thick) and adjusted the charge layer thickness from 50 to 210 nm to study the influence of charge layer thickness on doping level range and verify the theoretical conclusions in analytical model. In the simulation, we selected different doping level ranges in the charge layer so that the electric field distribution complies with the rules. The simulation results on the relationship between thickness and doping level range in the charge layer are presented in Fig. 9a. As the charge layer thickness increases, the suitable doping level range in charge layer decreases. A relatively large doping level range exists in the thin charge layer, and under this doping level range, the device will have a suitable electric field distribution. Apparently, the doping level range is determined by charge layer thickness. The simulation result of APD-2 (with a thickness of multiplication of 200 nm) is presented in Fig. 9b, which has a similar result. Moreover, it can be found that the calculated results of Fig. 2 and simulation results of Fig. 9b match well as shown in Fig. 9c. The small difference between the calculated results and simulation results is caused by the different values of avalanche field in the simulation and calculation. The avalanche field in simulation engine is used 6.4 × 10 5 V/cm, while in the calculation, we use the value of 6.7 × 10 5 V/cm from [27].

a Relationship between suitable doping level and thickness of charge layer (APD-1). The thickness of charge layer is 50 nm (black square), 90 nm (black circle), 130 nm (black triangle), 170 nm (black down-pointing triangle), 210 nm (black diamond). a presents the suitable doping level region for different thickness of charge layer. As the charge layer thickness increases, the suitable doping level range in the charge layer decreases. A relatively large doping level range exists in the thin charge layer, and under this doping level range, the device will have a suitable electric field distribution. Apparently, the doping level range is determined by charge layer thickness. b Relationship between suitable doping level and thickness of charge layer (APD-2). The thickness of charge layer is 50 nm (black square), 70 nm (black circle), 90 nm (black triangle), 110 nm (black down-pointing triangle), 130 nm (black diamond), and 150 nm (black pentagon). The figure description of b is similar to a . c Comparison of calculated results in Fig. 2 and simulated results in Fig. 9b. Dashed line:calculated results. Closed symbols:simulated results (black square). c presents the comparison of calculated results in Fig. 2 and simulated results in Fig. 9b. The calculated results and simulated results correspond well
The charge layer thicknesses of 210 and 50 nm (APD-1) were selected to show the simulation details and the influence of doping level on the electric field distribution. Figure 10a, c shows the current simulation results of different doping levels in thicknesses of 210 and 50 nm, respectively. Figure 10b, d shows the electric field distribution simulation results using the same structure. The simulation results show that thicknesses of 210 and 50 nm have doping level ranges of 1.0 × 10 17 –1.3 × 10 17 cm −3 and 3.9 × 10 17 –5.7 × 10 17 cm −3 , respectively.

a Photocurrent and dark current with different doping level (thickness of charge layer is 210 nm). Solid line:doping level in the charge layer is 1.3 × 10 17 cm −3 . Dashed line:doping level in charge layer is 1.15 × 10 17 cm −3 . Dashed dot line:doping level in charge layer is 1.0 × 10 17 cm −3 . a Presents the simulation results of currents with different doping level. The device with a charge layer thickness of 210 nm only has a relatively narrow and suitable doping level. A minimal change in the doping level has greatly influence the punch-through voltage, breakdown voltage, and current-voltage characteristic. b Avalanche field with different doping level (thickness of charge layer is 210 nm). Solid line:doping level in charge layer is 1.3 × 10 17 cm −3 . Dashed line:doping level in charge layer is 1.15 × 10 17 cm −3 . Dashed dot line:doping level in charge layer is 1.0 × 10 17 cm −3 . b Presents the simulation results of fields with different doping level. The device with a charge layer thickness of 210 nm only has a relatively narrow and suitable doping level. A minimal change in the doping level has greatly influenced the electric field distribution. c Photocurrent and dark current with different doping level (thickness of charge layer is 50 nm). Solid line:doping level in charge layer is 5.7 × 10 17 cm −3 . Dashed line:doping level in charge layer is 4.8 × 10 17 cm −3 . Dashed dot line:doping level in charge layer is 3.9 × 10 17 cm −3 . c Presents the simulation results of currents with different doping level. The device with a charge layer thickness of 50 nm has a relatively wide and suitable doping level. A minimal change in the doping level has a small influence on the current-voltage characteristic. d Avalanche field with different doping level (thickness of charge layer is 50 nm). Solid line:doping level in charge layer is 5.7 × 10 17 cm −3 . Dashed line:doping level in charge layer is 4.8 × 10 17 cm −3 . Dashed dot line:doping level in charge layer is 3.9 × 10 17 cm −3 . d Presents the simulation results of fields with different doping level. The device with a charge layer thickness of 50 nm only has a relatively wide and suitable doping level. A minimal change in the doping level has a small influence on the electric field distribution
Clearly, the device with a charge layer thickness of 210 nm only has a relatively narrow and suitable doping level. A minimal change in the doping level has greatly influence the current-voltage characteristic and electric field distribution. As a result, the performance of APD varies significantly via several percent deviations of doping concentrations in the thicker charge layer. This conclusion is the same as the theoretical analysis. Concurrently, when designing APD structures, choosing a thin charge layer will give a high level of doping tolerance, as well as confer APD with good controllability.
Finally, the relationship between charge layer and multiplication thickness was simulated. Figure 11a presents the avalanche field with multiplication region thicknesses of 100, 200, and 300 nm in the APD-2 structure (with a charge layer thickness of 70 nm). Figure 11b presents the charge layer doping range with different multiplication thicknesses at the suitable electric field distribution condition. The charge layer thicknesses are 50, 70, and 90 nm. Clearly, a high avalanche field exists in the thin multiplication layer. As the multiplication region thickness decreases, the electric field difference between multiplication and absorption layers increases. As a result, a thin multiplication layer needs a high product of the charge layer doping level and thickness to reduce the high avalanche field.

a Avalanche breakdown electric field with different multiplication thicknesses. Solid line:w m = 100 nm. Dashed line:w m = 200 nm. Dashed dot line:w m = 300 nm. a Presents the simulation results of electric field distribution with different w m . As the w m decreases, the avalanche field in the multiplication increase. b Relationship between multiplication thickness and charge layer. The thickness of multiplication is 300 nm (black square), 200 nm (black circle), 100 nm (black triangle). b Presents the relationship between multiplication thickness and charge layer. A thin multiplication layer needs a high product of the charge layer doping level and thickness to reduce the high avalanche field
Tunneling Effect on the Electric Field Distribution
The simulation in this part will study the tunneling effect on the electric field in the device. From the theoretical analysis, the tunneling effect has an influence on the avalanche field in multiplication. Thus, the simulation will design to study the influence of electric field in the absorption layer that exceeds the tunneling threshold value. First, group A, with the structure of APD-1, charge layer thickness of 90 nm, and different charge layer doping levels of 1.4 × 10 17 –2.4 × 10 17 cm −3 , was simulated for electric field distribution when the device avalanche breaks down. The result is shown in Fig. 12a. When the charge layer doping level exceeds 2.0 × 10 17 cm −3 , the field in the absorption layer becomes lower than the tunneling threshold field and the avalanche field in the multiplication layer reaches the same value. However, when the doping level is less than 2.0 × 10 17 cm −3 , the field in the absorption layer exceeds the tunneling threshold field and the avalanche field in the multiplication layer decreases with the decrease of the doping level in charge layer. Similar results were observed in the APD-2 structure (with a charge layer thickness of 90 nm and doping level of 2.2 × 10 17 –3.6*10 17 cm −3 ) (Fig. 12b). That is, if the electric field in the absorption layer exceeds the tunneling threshold value at or over the breakdown voltage, then the breakdown electric field in the multiplication will decrease.

a Avalanche breakdown electric field with different doping levels (APD-1). Thickness of charge layer is 90 nm. Red dashed lines:the field of absorption is larger than the tunneling threshold field. Black solid lines:the field of absorption is less than the tunneling threshold field. a Presents the simulation results of electric field distribution with different doping level while avalanche breakdown. When doping level of charge layer exceeds 2.0 × 10 17 cm −3 , the field in the absorption layer becomes lower than the tunneling threshold field, and the avalanche field in the multiplication layer reaches the same value with different doping level. However, when the doping level is less than 2.0 × 10 17 cm −3 , the field in the absorption layer exceeds the tunneling threshold field, and the avalanche field in the multiplication layer decreases with the decrease of the doping level. Thus, if the electric field in the absorption layer exceeds the tunneling threshold value at or over the breakdown voltage, then the breakdown electric field in the multiplication will decrease. Thus, the electric field in the absorption should be less than the tunneling threshold value to maintain the high field in the multiplication layer when the device avalanche breaks down. b Avalanche breakdown electric field with different doping levels (APD-2). Thickness of charge layer is 90 nm. Red dashed lines:the field of absorption is larger than the tunneling threshold field. Black solid lines:the field of absorption is less than the tunneling threshold field. The figure description of b is similar to a . c Relationship between field and bias voltage in multiplication and absorption (APD-1). Thickness of charge layer is 90 nm. Electric field of multiplication (black square). Electric field of absorption (red triangle). c Presents the relationship between the electric field and bias voltage in multiplication and absorption layers. When the electric field in the absorption layer reaches the tunneling threshold value, the avalanche breakdown electric field in the multiplication gradually decreases. Moreover, the absorption field slope increases when the electric field in the absorption layer exceeds the tunneling threshold. d Relationship between field and bias voltage in multiplication and absorption (APD-2). Thickness of charge layer is 90 nm. Electric field of multiplication (black square). Electric field of absorption (red triangle). The figure legend of d is similar to a
Groups B (APD-1 thickness of 90 nm, doping level of 2.4 × 10 17 cm −3 in charge layer and APD-2 thickness of 90 nm, doping level of 3.6 × 10 17 cm −3 ) were designed to demonstrate the relationship between the threshold electric field in the absorption layer and avalanche field in the multiplication layer. The multiplication and absorption electric fields vary with the bias voltage on the device. As shown in Fig. 12c, d, when the electric field in the absorption layer reaches the tunneling threshold value, the avalanche breakdown electric field in the multiplication gradually decreases. Moreover, when the absorption field exceeds the tunneling threshold, the avalanche breakdown electric field in the multiplication layer plummets. Furthermore, the absorption field slope increases when the electric field in the absorption layer exceeds the tunneling threshold.
The phenomenon in Fig. 12 can be explained by the theoretical analysis that tunneling has an influence on the charge density in the “Methods” section. When the electric field reaches the tunneling threshold value in the absorption layer, the charge density ρ becomes unequal to the dopant ion. The multiplication field will decrease as the negative ion increases, and the absorption field will increase as the positive ion increases. Concurrently, the absorption field slope will increase due to the tunneling effect. As a result, the electric field in the absorption should be less than the tunneling threshold value to maintain the high field in the multiplication layer and the low dark current when the device avalanche breaks down.
Schlussfolgerungen
In summary, we have presented a theoretical study and numerical simulation analysis involving the InGaAs/InAlAs APD. The mathematical relationship between the device parameters and electric field distribution in the device was built. And the tunneling effect was taken into consideration in the theoretical analysis. Through analysis and simulation, the influence of structure parameters on the device and the detailed relationship of each layer were fully understood in the device. Three important conclusions can be obtained from this paper. First, the doping level and thickness of the charge layer for different multiplication thicknesses can be calculated by the theoretical model in the “Methods” section. Calculated charge layer values (doping and thickness) are in agreement with the experiment results. Second, as the charge layer thickness increases, the suitable doping level range in charge layer decreases. Compared to the thinner charge layer, the performance of APD varies significantly via several percent deviations of doping concentrations in the thicker charge layer. When designing APD structures, choosing a thin charge layer will give a high level of doping tolerance, as well as confer APD with good controllability. Finally, the G btt of tunneling effect was calculated, and the influence of tunneling effect on the avalanche field was analyzed. We confirm that the avalanche field and multiplication factor (M n ) in the multiplication will decrease by the tunneling effect.
Abkürzungen
- 2D:
-
Two-dimensional
- APD:
-
Avalanche photodiode
- DCR:
-
Dark count rate
- SACM APDs:
-
Separate absorption, charge, and multiplication avalanche photodiodes
- SAGCMAPDs:
-
Separate absorption, grading, charge, and multiplication avalanche photodiodes
- SPAD:
-
Single-photon avalanche photodiode
- SPDE:
-
Single-photon detection efficiency
- SRH:
-
Shockley–Read–Hall
Nanomaterialien
- Advanced Atomic Layer Deposition Technologies für Mikro-LEDs und VCSELs
- Das Design der Emissionsschicht für Elektronenvervielfacher
- Photokatalytische Eigenschaften von Co3O4-beschichteten TiO2-Pulvern, hergestellt durch plasmaunterstützte Atomlagenabscheidung
- Theoretische Untersuchung von biaxial zugbelasteten Germanium-Nanodrähten
- Abstimmung der Oberflächenmorphologien und -eigenschaften von ZnO-Filmen durch das Design der Grenzflächenschicht
- Fermi-Level-Tuning von ZnO-Filmen durch Supercycling-Atomschichtabscheidung
- Untersuchung einer kristallinen Silizium-Solarzelle mit schwarzer Siliziumschicht auf der Rückseite
- Interband-Photoleitfähigkeit von metamorphen InAs/InGaAs-Quantenpunkten im 1,3–1,55-μm-Fenster
- Eine theoretische Simulation des Strahlungsverhaltens von Si-, Ge- und Si/Ge-Übergittern auf niederenergetische Bestrahlung
- Selbst gesätes MOCVD-Wachstum und dramatisch verstärkte Photolumineszenz von InGaAs/InP-Kern-Schale-Nanodrähten



