Untersuchung des Energiebandes an den Molybdändisulfid- und ZrO2-Heterojunctions
Zusammenfassung
Die Energiebandausrichtung am Multilayer-MoS2 /ZrO2 Schnittstelle und die Auswirkungen von CHF3 Plasmabehandlung auf dem Bandversatz wurden unter Verwendung von Röntgenphotoelektronenspektroskopie untersucht. Der Valenzband-Offset (VBO) und der Leitungsband-Offset (CBO) für das MoS2 /ZrO2 Probe etwa 1,87 eV bzw. 2,49 eV beträgt. Während die VBO für die Stichprobe mit 3 CHF . um etwa 0,75 eV vergrößert wurde Plasmabehandlung, die der Aufwärtsverschiebung des Zr-3d-Kernniveaus zugeschrieben wird. Die Berechnungsergebnisse zeigten, dass F-Atome starke Wechselwirkungen mit Zr-Atomen aufweisen und die Valenzband-Energieverschiebung für das d-Orbital von Zr-Atomen in Übereinstimmung mit dem experimentellen Ergebnis etwa 0,76 eV beträgt. Dieser interessante Befund ermutigt die Anwendung von ZrO2 als Gatematerialien in MoS2 -basierte elektronische Geräte und bietet eine vielversprechende Möglichkeit, die Bandausrichtung anzupassen.
Einführung
In den letzten Jahrzehnten wurde SiO2 /Si-basierte Materialien spielten die dominierende Rolle bei der Herstellung elektronischer Geräte, wie beispielsweise integrierte Logikschaltungen, nichtflüchtige Speicher und so weiter. Da die Größe der Bauelemente jedoch unaufhörlich von Mikrometern auf unter 10 nm verkleinert wurde, war es mit herkömmlichen Halbleitern schwierig, die Anforderungen an eine verbesserte spezifische Kapazität, einen geringen Gate-Leckstrom und eine hohe Trägermobilität zu erfüllen. Daher wird die Erforschung neuer Halbleiter als Gerätekanäle und der High-κ-Oxide als Isolatoren schwierig. Seit der Entdeckung von Graphen bietet die erfolgreiche Herstellung von zweidimensionalen (2D) Materialien, insbesondere von Halbleitern mit geeigneter Bandlücke, einen vielversprechenden Weg, diesen Nachteil zu überwinden.
Unter den 2D-Materialien ist Molybdändisulfid (MoS2 ) mit einstellbaren Eigenschaften, die sowohl auf der Schichtzahl als auch auf der Wahl des Substratmaterials basieren, hat nicht nur aufgrund seiner guten chemischen Stabilität und mechanischen Flexibilität, sondern auch aufgrund seiner hervorragenden optischen und elektrischen Eigenschaften zunehmende Aufmerksamkeit auf sich gezogen [1, 2]. Die Energiebandlücke der Monoschicht MoS2 beträgt etwa 1,80 eV, während 1,20 eV für die Masse beträgt. Die vielversprechende Leistung der elektronischen und optoelektronischen Bauelemente aus MoS2 Schichten, wie Feldeffekttransistoren [3,4,5], Sensoren [6] und Photodetektoren [7], erweist es sich als potentieller Ersatz für Si in der konventionellen Elektronik und für organische Halbleiter in tragbaren und flexiblen Systemen [8, 9,10,11]. Obwohl einlagiges MoS2 -basierte Feldeffekttransistoren (FETs) haben hervorragende Leistungen mit einem hohen Strom-Ein/Aus-Verhältnis von etwa 10 8 . gezeigt und einem niedrigen unterschwelligen Swing ~ 77 mV/Dekade [3], wurden seine umfangreichen Anwendungen durch die Synthese von großflächigem, hochqualitativem einschichtigem MoS2 . behindert und die Stabilität der Geräte [12,13,14]. Mehrschichtiges MoS2 könnte aufgrund der hohen Zustandsdichte attraktiver sein, was zu einem hohen Antriebsstrom im ballistischen Limit beiträgt [15]. Darüber hinaus ist die Trägermobilität von mehrschichtigem MoS2 können durch High-κ-Oxide aufgrund der dielektrischen Abschirmeffekte noch deutlich verbessert werden [16, 17]. Daher ist es wichtig und wichtig, das mehrschichtige MoS2 . zu untersuchen /hohe-κ-Oxide-Heteroübergänge.
In elektronischen Bauelementen mit Heteroübergang werden die Elektronentransporteigenschaften durch die Energiebandprofile an der Grenzfläche zwischen dem Halbleiter- und Isolatoroxid hinsichtlich des Valenzband-Offsets (VBO) und des Leitungsband-Offsets (CBO) präzise gesteuert. VBO und CBO sollten so groß wie möglich sein, um als Barriere zu wirken, um den durch die Injektion von Löchern und Elektronen gebildeten Leckstrom zu reduzieren, insbesondere spielt CBO eine zentrale Rolle bei der Auswahl geeigneter High-k-Oxide für ein Gate Klemme und sollte mindestens größer als 1 eV sein, um Kriechströme zu vermeiden [18,19,20]. Unterdessen haben die Grenzflächenladungen an Halbleitern/Oxiden einen wichtigen Einfluss auf das Band-Engineering und müssen durch Passivierungstechnologien wie SiH4 . optimiert werden Passivierung und 3 CHF Behandlung. In diesem Artikel haben wir die Bandausrichtung von mehrschichtigem MoS2 . untersucht / ZrO2 Systeme, da die Art der Schnittstelle einen direkten Einfluss auf die Eigenschaften der Geräte und die Wirkung von CHF3 . hat Plasmabehandlung am Bandversatz bei MoS2 /ZrO2 Schnittstelle wurde untersucht.
Methoden und Experimente
In den Experimenten wurde das mehrschichtige MoS2 Filme wurden auf SiO2 . gezüchtet /Si-Substrate durch chemische Gasphasenabscheidung (CVD)-Systeme mit MoO3 und Schwefelpulver als Mo-Quellen bzw. S-Vorläufer. Während des Wachstumsprozesses wurde Ar-Gas als Trägergas verwendet und die Wachstumstemperatur betrug 800°C für 5 Minuten. Dann die MoS2 /ZrO2 Proben wurden hergestellt, indem das großflächige mehrschichtige MoS2 Film auf das ZrO2 /Si-Substrate nach dem Polymethylmethacrylat (PMMA)-Verfahren. Das ZrO2 Oxid (15 nm) wurde auf Si bei 200 °C unter Verwendung eines Atomlagenabscheidungssystems (BENEQ TFS-200) mit Tetrakis Dimethyl Amido Zirconium (TDMAZr)-Vorstufe als Zirconiumquelle und Wasser (H2 .) abgeschieden O) als Sauerstoffquelle. Um die Auswirkungen von CHF3 . zu untersuchen Behandlung der Bandausrichtung bei MoS2 /ZrO2 Schnittstellen, für eine Probe das ZrO2 /Si-Substrat wurde mit CHF3 . behandelt Plasma mit einer HF-Leistung von etwa 20 W und einer Flussrate von etwa 26 sccm. In der Zwischenzeit beträgt die Plasmabehandlungszeit etwa 60 s und der Druck wurde während des Prozesses bei 1 Pa gehalten. Folglich beträgt die resultierende F-Dosis etwa 2,0 × 10 14 . Atome/cm 2 geschätzt durch Sekundärionen-Massenspektrometrie (SIMS)-Messungen. Während des Optimierungsprozesses der Plasmabehandlungszeit beträgt der CHF3 Plasma verschlechterte die Materialqualität ernsthaft durch die Einführung von Fluor, das in ZrO2 . eindiffundiert wurde vor allem, wenn die Zeit auf 70 s eingestellt wurde. Während die Plasmabehandlungszeit 50 s, also kleiner als 60 s, betrug, zeigten die SIMS-Ergebnisse keinen offensichtlichen F-Peak an der Oxidoberfläche. Für das andere Beispiel keine 3 CHF Plasmabehandlung durchgeführt wurde. Die Raman-Eigenschaften der Proben wurden in einem RENISHAW-System bei Raumtemperatur aufgenommen. Die Röntgenphotoelektronenspektroskopie (XPS) wurde unter Verwendung eines VG ESCALAB 220i-XL-Systems gemessen. Die Photonenenergie der monochromatisierten Al Kα-Röntgenquelle beträgt etwa 1486,6 eV. Bei den Messungen wurde die Durchgangsenergie auf 20 eV eingestellt, um die XPS-Spektren zu erhalten. Darüber hinaus wurde der C 1 s-Peak (284,8 eV) verwendet, um die Bindungsenergie auf Kernebene zu korrigieren, um den differentiellen Ladungseffekt der Probenoberfläche zu eliminieren.
Ergebnisse und Diskussionen
Die Raman-Spektren des gewachsenen und nachträglich übertragenen mehrschichtigen MoS2 wurden bei Raumtemperatur charakterisiert, wie in Abb. 1 gezeigt. Zwei prominente Raman-Modi, die als A . bezeichnet sind 1g und \( {\mathrm{E}}_{2g}^1 \) wurden im Spektrum beobachtet. Insbesondere ergibt sich die \( {E}_{2g}^1 \)-Mode aus der entgegengesetzten Bewegung von S-Atomen in der Ebene in Bezug auf das zentrale Mo-Atom im unteren Frequenzbereich, während A 1g ist relativ zu den Schwingungen außerhalb der Ebene von S-Atomen im höheren Frequenzbereich [21]. Es wurde beobachtet, dass die \( {\mathrm{E}}_{2g}^1 \) und A 1g Modi von MoS2 unterliegen einer Rotverschiebung bzw. Blauverschiebung von Monolayer- zu Bulk-Proben, was auf die unterschiedliche Van-der-Waals-Rückstellkraft zwischen den Schichten und den Einfluss von stapelungsinduzierten Strukturänderungen zurückzuführen ist [21]. Daher ist die Frequenzdifferenz (Δk) zwischen A 1g und \( {\mathrm{E}}_{2g}^1 \) wird häufig verwendet, um die Schichtanzahl oder -dicke von MoS2 . zu bewerten Film. Hierin ist Δk des gewachsenen MoS2 Film ist ungefähr 25,32 cm −1 , was darauf hinweist, dass der Film mehr als sechs Schichten umfasst. Darüber hinaus zeigte das im Einschub von Fig. 1 gezeigte Ergebnis der Querschnitts-Transmissionselektronenmikroskopie (TEM) die Schichtanzahl des gewachsenen MoS2 . betrug etwa 8, entsprechend der Dicke von etwa 4,5 nm. Darüber hinaus die Position des Raman-Peaks und die Halbwertsbreite (FWHM) von MoS2 ist vor und nach dem Transfer fast gleich, was darauf hindeutet, dass der Transferprozess einen geringen Einfluss auf die Qualität des Materials hat.
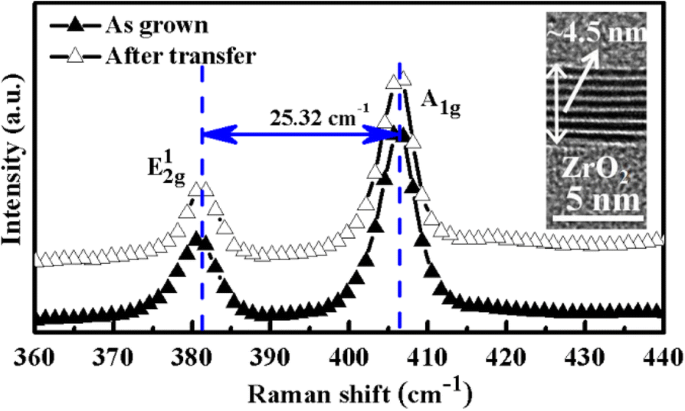
Die Raman-Spektroskopie des ultradünnen MoS2 Film vor und nach der Übertragung. Der Einschub ist die Querschnitts-Transmissionselektronenmikroskopie (TEM) des MoS2 auf ZrO2 /Si-Substrat, das die Schichten von MoS2 . zeigt
XPS hat sich als effiziente Methode zur Bestimmung des Band-Offsets an der Heterojunction-Grenzfläche erwiesen [22, 23]. In MoS2 /ZrO2 Heteroübergang wurde der VBO-Wert aus der Änderung der Valenzbandspektren des ZrO2 . erhalten zwischen denen des blanken Oxids und mit MoS2 Material [24]. Abbildung 2a, b zeigten das Kernniveau und die Valenzbandspektren von reinem ZrO2 und Multilayer-MoS2 /ZrO2 , bzw. Der Schnittpunkt zwischen der Basislinie und der Steigung der Vorderkante ergibt das Valenzbandmaximum (VBM) der Probe, wobei das Fermi-Niveau als Referenzniveau verwendet wird. Die Ergebnisse zeigten, dass die VBM von ZrO2 und Multilayer-MoS2 /ZrO2 Systeme sind etwa 1,88 eV bzw. 0,06 eV. Darüber hinaus ist das Zr-3d-Kernspektrum von nacktem ZrO2 weist gut getrennte Dublett-Peaks auf, die als Zr 3d5/2 . bezeichnet werden und 3d3/2 mit Energiewerten von 182,05 eV bzw. 184,45 eV, während die entsprechenden Werte für das MoS2 /ZrO2 Stichprobe sind 182,10 eV bzw. 184,50 eV. Die Änderung der Kernebene von Zr 3d5/2 oder 3d3/2 ~ 0,05 eV liegt im Bereich des Mess- und Datenverarbeitungsfehlers. Im Vergleich zu blankem ZrO2 Probe, mehrschichtiges MoS2 übten nur geringe Auswirkungen auf das Zr-3d-Spektrum aus, wie in Abb. 2b gezeigt. Dann wird die Energiedifferenz zwischen dem Zr 3d5/2 und VBM beträgt 180,17 eV und 182,04 eV für das bloße ZrO2 Probe und MoS2 /ZrO2 Probe bzw. Folglich ist der VBO-Wert für das Multilayer-MoS2 /ZrO2 Grenzfläche beträgt etwa 1,87 ± 0,05 eV, hauptsächlich aufgrund der VBM-Differenz zwischen dem bloßen ZrO2 und MoS2 /ZrO2 . Ähnlich für das Multilayer-MoS2 /ZrO2 Probe mit CHF3 Plasmabehandlung vor MoS2 Übertragung beträgt die VBM etwa 0,02 eV, wie in Abb. 2c gezeigt, fast identisch mit der Probe ohne CHF3 Behandlung. Das Zr-3d-Spektrum bewegt sich jedoch um etwa 0,75 eV in Richtung höherer Energie, Zr 3d5/2 ~ 182,85 eV und 3d3/2 ~185,25 eV, was darauf hinweist, dass der VBO-Wert nach dem Plasmaätzen um etwa 0,75 ± 0,04 eV erhöht war. Dann ist der CBO-Wert ∆E C kann nach der Formel erhalten werden
$$ \Updelta {\mathrm{E}}_{\mathrm{C}}={E}_{G, ZrO2}-{E}_{G, MoS2}-\Updelta {E}_V. $$ (1)wo E G , ZrO 2 und E G , MoS 2 sind die Bandlücke von ZrO2 und MoS2 , bzw. und ∆E V entspricht dem VBO-Wert. Normalerweise kann die Bandlückenenergie des Oxidisolators aus dem O 1 s-Verlustenergiespektrum erhalten werden [25]. Abbildung 3a zeigt das O 1 s-Verlustenergiespektrum von ZrO2 , und das E G , ZrO 2 beträgt etwa 5,56 eV, berechnet aus der Energiedifferenz durch Extrapolation der linearen Kantenbasislinie (535,95 eV), die an die Kernniveauenergie von Zr-O-Bindungen (530,39 eV) angepasst ist. Die Bandlücke von MoS2 in dieser Arbeit beträgt etwa 1,2 eV. Daher der CBO-Wert für die Stichprobe ohne 3 CHF Behandlung beträgt etwa 2,49 eV und 1,74 eV für die Probe mit 3 CHF Behandlung. Dann die schematischen Strukturen des Bandengineerings für die Samples ohne und mit CHF3 Plasmabehandlung sind in Abb. 3b dargestellt. Offensichtlich ist das Multilayer-MoS2 /ZrO2 Das System hat eine Typ-I-Ausrichtung, die Elektronen und Löcher im MoS2 . einschließt . Inzwischen ist das große ∆E C und ∆E V für MoS2 /ZrO2 Schnittstelle impliziert, dass ZrO2 könnte ein gutes Gate-Dielektrikum für n- oder p-Kanal-Mehrschicht-MoS2 . sein -basierte FETs-Anwendung im Hinblick auf die Unterdrückung von Gate-Leckströmen. Außerdem hat die Probe mit Plasmabehandlung einen höheren VBO ∆E V (unterer CBO ∆E C ) im Vergleich zur Probe ohne Plasmabehandlung, die bei der Anwendung von p-Kanal-FETs besser ist.
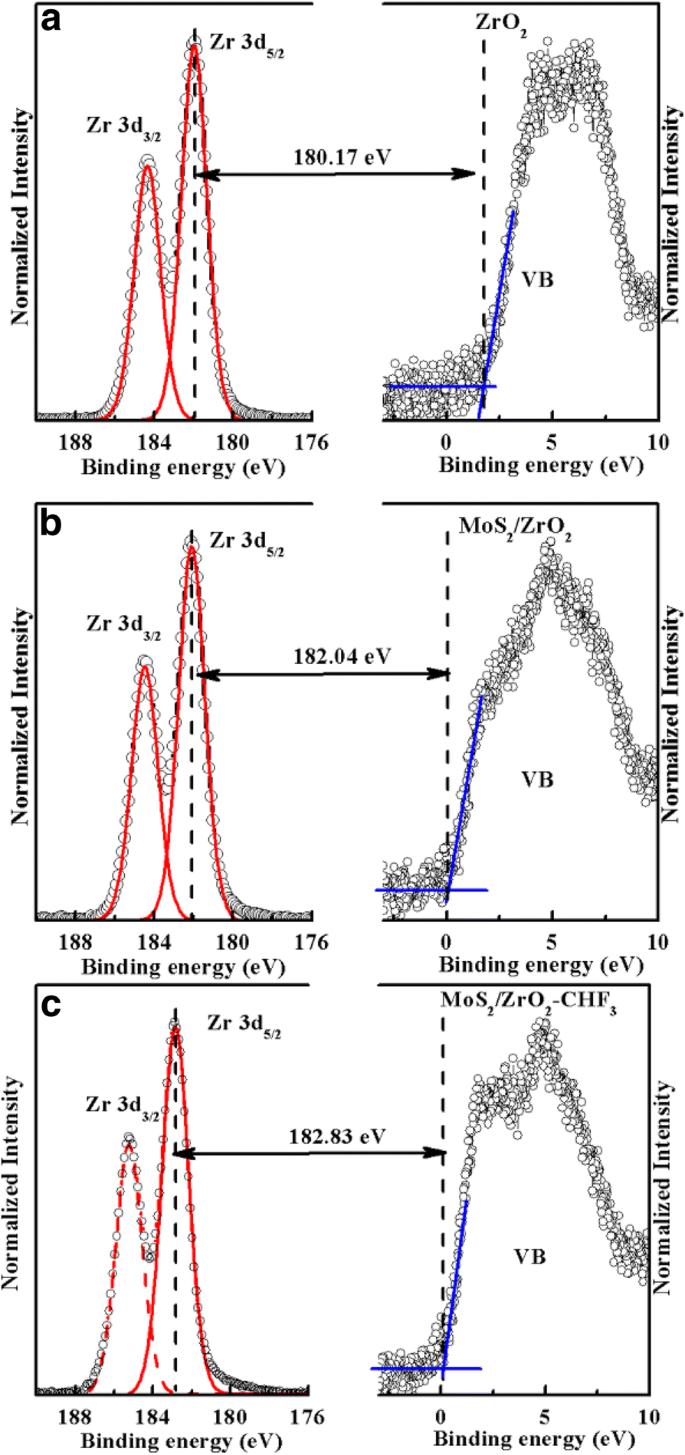
Die Zr-3d- und Valenzbandspektren auf Kernebene für a blankes ZrO2 Oxid, b Mehrschicht-MoS2 /ZrO2 Probe und c CHF3 plasmabehandeltes Multilayer-MoS2 /ZrO2 Probe

a O 1 s-Photoelektronen-Energieverlustspektren für das ZrO2 Oxid. b Die schematische Struktur der Energiebandausrichtung am MoS2 /ZrO2 Schnittstelle ohne (oben) und mit (unten) CHF3 Plasmabehandlung. c Die SIMS-Tiefenprofile (Si, Zr und F) für die Probe mit CHF3 Plasmabehandlung
Die Änderung der Bandausrichtung am mehrschichtigen MoS2 /ZrO2 Es wird angenommen, dass die Grenzfläche eng mit der F-reichen Grenzschicht verbunden ist, die durch das CHF3 . induziert wird Plasmabehandlung. Abbildung 3c zeigt das SIMS-Ergebnis der plasmabehandelten Probe für Zr-, F- und Si-Elemente mit einem offensichtlichen F-Ionen-Peak an der Grenzfläche. In der Zwischenzeit wurden einige F-Ionen in das darunterliegende ZrO2 . diffundiert Schicht aufgrund seiner geringen Größe. Beim MoS2 /ZrO2 Schnittstelle mit CHF3 Plasmabehandlung wird die Vergrößerung des VBO (Reduktion des CBO) hauptsächlich auf die in Abb. 2c gezeigte Aufwärtsverschiebung der Zr-3d-Kernniveaus zurückgeführt, was darauf hindeutet, dass F-Ionen eine starke Wechselwirkung mit Zr-Atomen haben. Dann die Auswirkungen von 3 CHF Behandlung der elektronischen Eigenschaften des ZrO2 Oxide wurden mit Material Studio in Kombination mit dem Cambridge Sequential Total Energy Package (CASTEP) auf Basis der Dichtefunktionaltheorie (DFT) untersucht [26]. Die von Perdew-Burk-Ernzerhof (PBE) [27] vorgeschlagene generalisierte Gradientennäherung für das Austausch- und Korrelationspotential wurde verwendet, um die Ion-Elektron-Wechselwirkungen zusammen mit dem Projektor-Augmented-Wave-Potential (PAW) [28] zu behandeln. Die Grenzenergie der ebenen Welle wird zu 750 eV gewählt, und ein Monkhorst-Pack-k-Mesh von 1 × 1 × 1 wird verwendet, um die Brillouin-Zone in der Strukturoptimierung und Gesamtenergieberechnung abzutasten [29]. Alle Atome wurden in ihre Gleichgewichtspositionen entspannt, bis die Gesamtenergieänderungen während der Optimierung schließlich auf weniger als 10 −6 . konvergierten eV/ Atom wurde die Kraft und Spannung an jedem Atom auf 0,003 eV/nm bzw. 0,05 GPa konvergiert, und die Verschiebung wurde auf 1 × 10 −4 . konvergiert nm. Abbildung 4a, b zeigen die totale und partielle Zustandsdichte (DOS) für beide MoS2 /ZrO2 Proben, wobei null eV dem Fermi-Niveau entspricht. Offensichtlich haben F-Ionen eine starke Wechselwirkung mit Zr-Atomen, wodurch ein Teil des d-Orbitals von Zr-Atomen, das auf das Valenzband projiziert wird, sich um 0,76 eV von − 0,06 auf − 0,82 eV unter das Fermi-Niveau nach unten bewegt, was mit übereinstimmt die Vergrößerung des Volantband-Offsets ∆E V ~ 0,75 eV. F-Atome neigen aufgrund der großen Elektronegativität (4.0) dazu, Elektronen anzuziehen, werden teilweise negativ geladen und bilden dann weitere Dipole mit Zr-Atomen, die schließlich zur Änderung des Bandversatzes beitragen. Daher ist die Bandänderung am MoS2 /ZrO2 Schnittstelle eingeführt durch die CHF3 Die Plasmabehandlung bietet eine vielversprechende Möglichkeit, die Bandausrichtung an den Heteroübergängen anzupassen, was das Design der entsprechenden Geräte erleichtert.

Die berechnete Gesamtzustandsdichte (TDOS) und Teilzustandsdichte (PDOS) für die Proben ohne CHF3 Behandlung (a ) und mit 3 CHF Behandlung (b )
Schlussfolgerungen
In diesem Artikel haben wir das Energieband-Engineering am mehrschichtigen MoS2 . untersucht /ZrO2 Schnittstelle und untersuchte die Auswirkungen von CHF3 Behandlung mit Röntgenphotoelektronenspektroskopie. Die Ergebnisse zeigten, dass am MoS2 . eine Typ-I-Ausrichtung gebildet wurde /ZrO2 Heteroübergangsschnittstelle mit CBO und VBO etwa 2,49 eV bzw. 1,87 eV. Während die CHF3 Plasmabehandlung erhöht die VBO um etwa 0,75 ± 0,04 eV hauptsächlich aufgrund der Aufwärtsverschiebung der Zr-3d-Kernenergie, was mit den Berechnungsergebnissen übereinstimmt. Diese Arbeit beweist die großen potentiellen Anwendungen von hoch-κ ZrO2 Oxid in mehrlagigem MoS2 -basierte Geräte und bietet eine Möglichkeit, die Ausrichtung des Grenzflächenenergiebands zu ändern.
Abkürzungen
- 2D:
-
Zweidimensional
- CASTEP:
-
Cambridge Sequentielles Gesamtenergiepaket
- CBO:
-
Leitungsband-Offset
- Lebenslauf:
-
Chemische Gasphasenabscheidung
- DFT:
-
Dichtefunktionaltheorie
- DOS:
-
Dichte der Zustände
- FETs:
-
Feldeffekttransistoren
- FWHM:
-
Volle Breite auf halbem Maximum
- MoS2 :
-
Molybdändisulfid
- PAW:
-
Projektor-verstärkte Welle
- PBE:
-
Perdew-Burk-Ernzerhof
- PMMA:
-
Polymethylmethacrylat
- SIMS:
-
Sekundärionen-Massenspektrometrie
- TDMAZr:
-
Tetrakis Dimethyl Amido Zirkonium
- TEM:
-
Transmissionselektronenmikroskopie
- TMDs:
-
Übergangsmetalldichalkogenide
- VBO:
-
Valenzband-Offset
- XPS:
-
Röntgenphotoelektronenspektroskopie
- ZrO2 :
-
Zirkoniumdioxid
Nanomaterialien
- Verwendung von Molybdän in der Stahlindustrie
- Verwendung von Molybdän in der chemischen Industrie
- Was sind die Arten und Verwendungen von Molybdänstäben?
- Anwendungen von Molybdän und Molybdänlegierungen
- Der Einfluss des Zustands auf die Effizienz und Zuverlässigkeit von Motoren
- Einsatz von Winkeln zur Verbesserung der Zukunft der Elektronik
- Ultraschmalbandiger perfekter Absorber und seine Anwendung als plasmonischer Sensor im sichtbaren Bereich
- Umstieg auf grün:Vor- und Nachteile der Windenergie
- Sicherung von OT im Energie- und Versorgungssektor
- Die Geschichte des Bandsägens und seiner innovativen Ideen



