Abstimmbare elektrische Eigenschaften von Doppelschicht-α-GeTe mit unterschiedlichen Abständen zwischen den Schichten und externen elektrischen Feldern
Zusammenfassung
Basierend auf First-Principle-Rechnungen werden Stabilität, elektronische Struktur, optische Absorption und modulierte elektronische Eigenschaften durch unterschiedliche Zwischenschichtabstände oder durch externe elektrische Felder von Doppelschicht-α-GeTe systematisch untersucht. Die Ergebnisse zeigen, dass das Van-der-Waals-(vdW)-Doppelschicht-α-GeTe eine indirekte Bandstruktur mit einem Lückenwert von 0,610 eV aufweist und α-GeTe eine attraktiv effiziente Lichtsammlung aufweist. Interessanterweise nimmt die Bandlücke von α-GeTe-Doppelschicht zusammen mit der Abnahme der Zwischenschichtabstände aufgrund der Verstärkung der vdW-Wechselwirkung zwischen den Schichten linear ab. Darüber hinaus entsteht der Bandlückenübergang durch das durch elektrische Felder induzierte Gas nahe freier Elektronen (NFEG) unter Anlegen positiver elektrischer Felder. Wenn jedoch die negativen elektrischen Felder angelegt werden, gibt es kein NFEG. Aufgrund dieser Eigenschaften von Doppelschicht-α-GeTe wurde ein möglicher Datenspeicher entwickelt. Diese Ergebnisse zeigen, dass zweischichtiges α-GeTe das Potenzial hat, in neuen elektronischen und optoelektronischen Geräten zu arbeiten.
Einführung
Der Erfolg von Graphen [1, 2] hat enorme Forschungen zu neuen zweidimensionalen (2D) Materialien angeregt, darunter hexagonales Bornitrid (h-BN) [3], Übergangsmetalldichalkogenide (TMDs) [4], Übergangsmetall- Carbide (MXene) und Nitride [5] sowie van der Waals (vdW) Heterostrukturen [6]. Diese 2D-Materialien können in elektronischen oder optoelektronischen Anwendungen eingesetzt werden [7, 8] aufgrund abstimmbarer elektronischer Eigenschaften [9] und überlegener Flexibilität unter Zugbelastung [10]. Bei 2D-Materialien gibt es jedoch mehr oder weniger Herausforderungen, wie den leichten Abbau von Phosphoren in Luft [11], die geringe Lochbeweglichkeit und die schwache Absorption des sichtbaren Lichts von Indiumselenid (InSe) [12] sowie die Null-Bandlücke von Graphen [7], Silicen [13] und Germanen [14]. Daher ist es notwendig, neue 2D-Materialien mit herausragender Stabilität, hoher Trägermobilität und gewünschter Bandlücke zu untersuchen.
In den letzten Jahren wurde Massen-α-GeTe in verschiedenen Bereichen eingesetzt, wie beispielsweise in nichtflüchtigen Phasenwechselspeichertechnologien [15, 16], neuromimetischen Computeranwendungen und Thermoelektrik [17, 18]. In jüngster Zeit wurde nanostrukturiertes α-GeTe in großem Umfang durch Atomlagenabscheidung (ALD) [17], Dampf-Fest-Flüssig-Methoden (VLS) [18] und chemische Methoden unter Verwendung von oberflächenstabilisierenden Polymeren [19] hergestellt. Nanostrukturierte α-GeTe-Phasen [20] haben eine höhere Kristallisationstemperatur und einen niedrigeren Schmelzpunkt als Bulk-α-GeTe [19]. Am wichtigsten ist, dass α-GeTe ein IV-VI-Halbleiter mit geknickten Atomschichten ist, in denen Ge- und Te-Atome gebunden sind. Es gibt eine schwache vdW-Kraft zwischen den Schichten von α-GeTe.
Vor kurzem wurden von Zhang et al. [21]. Allerdings konzentrieren sich nur wenige theoretische Studien auf die Modulation der elektronischen Eigenschaften von 2D-α-GeTe unter Verwendung externer elektrischer Felder und vertikaler Dehnung, die beide die effektivsten Methoden im Bandgap-Engineering sind [22]. In Anbetracht der Tatsache, ist die Mehrschichtstruktur in potentiellen Anwendungen besser verfügbar als die Monoschicht. Daher ist die Untersuchung von zweischichtigem α-GeTe, der typischsten Mehrschichtstruktur, von wesentlicher Bedeutung für die potenzielle Entwicklung von 2D-α-GeTe-Nanoblättern. In dieser Arbeit werden auf der Grundlage von First-Principle-Rechnungen Stabilität, Bandstrukturen, optische Absorption und modulierte elektronische Eigenschaften durch unterschiedliche Zwischenschichtabstände und durch externe elektrische Felder von Doppelschicht-α-GeTe systematisch untersucht. Unsere Studien beweisen, dass die vdW-Doppelschicht α-GeTe Potenzial für neue elektronische und optoelektronische Bauelemente bietet.
Rechenmethoden
Alle Berechnungen werden basierend auf der Spin-Polarized-Density-Funktional-Theory (DFT) unter Verwendung der Projected-Augmented-Wave-(PAW)-Methode durchgeführt, die im Vienna Ab initio Simulation Package (VASP) implementiert ist [23, 24]. Zur Beschreibung des Elektronenaustauschs und der Korrelation wird die generalisierte Gradientennäherung von Perdew-Burke-Ernzerhof (GGA-PBE) [25] gewählt. Die vdW-Interaktion wird mit einer semi-empirischen DFT-D3-Methode berücksichtigt [26]. Die Grenzenergie der ebenen Welle wird auf 500 eV eingestellt, um die Konvergenz der Gesamtenergie sicherzustellen, und 15 × 15 × 1 k-Punkt-Netze werden für die Brillouin-Zonenintegration ausgewählt. Um die Wechselwirkungen zwischen den periodischen Platten zu trennen, wird der Vakuumraum im z Richtung ist auf 30 Å eingestellt. Die Gittervektoren und Atompositionen sind vollständig entspannt, bis Kraft und Energie auf 0,01 eV/Å und 10 −5 . konvergiert sind eV bzw. Da die GGA-PBE-Methode normalerweise die Bandlücke von Halbleitern unterschätzt, wird die Heyd-Scuseria-Ernzerhof (HSE06) [27]-Methode verwendet, um Lückenwerte und Bandkanten für Halbleiter korrekt zu berechnen. Somit werden die elektronischen Strukturen und optischen Eigenschaften mit Hilfe des HSE06 berechnet. Die Phononenbandstruktur wird unter Verwendung der Dichtefunktionalstörungstheorie (DFPT) durchgeführt, wie sie in Phonopy [28] implementiert ist, die die quasiharmonische Näherungsmethode anwendet, um die potentielle Energiehyperfläche in der Umgebung der minimalen Energiestruktur zu analysieren.
Ergebnisse und Diskussion
Geometrische Struktur
Einschichtiges α-GeTe hat die hexagonale Struktur mit geknickten Atomschichten, in denen sich Ge-Atome in einer Schicht und Te-Atome in der anderen Schicht befinden. Die optimierten Gitterparameter, Bindungslängen und Winkel von einschichtigem α-GeTe sind a = b = 3.95 Å, L Ge-Te = 2,776 Å und θ =91,497° bzw. Auch der Gitterparameter Monolayer α-GeTe stimmt mit einem früheren Bericht überein [21]. Für zweischichtige α-GeTe-vdW-Heterostrukturen werden zwei Arten von möglicherweise hochsymmetrischen Stapelstrukturen betrachtet, nämlich AA- und AB-Stapelung, wie in Abb. 1 gezeigt. AA-Stapelung weist eine hexagonale Stapelanordnung auf. Das AB-Stapeln hat das Bernal-Stapelmerkmal als Struktur von Massen-α-GeTe. Die Gesamtenergien der beiden Stapelstrukturen werden jeweils berechnet, um die relative Stabilität zu bewerten. Das Ergebnis zeigt, dass die Gesamtenergie der AA-Stapelung 147 meV geringer ist als die der AB-Stapelung. Die stabilere Struktur des Doppelschicht-α-GeTe ist die AA-Stapelung, die sich von der seiner Masse unterscheidet. Außerdem beträgt der berechnete Gleichgewichtsabstand 2.920 Å für AA-Stapel-Doppelschicht-α-GeTe. Die berechnete Phononendispersion von AA-stapelnder Doppelschicht-α-GeTe, gezeigt in Fig. 2, zeigt an, dass AA-stapelnde Doppelschicht-α-GeTe aufgrund keiner imaginären Frequenz im Phononenspektrum stabil ist. Außerdem wurde im Experiment das stabile zweischichtige α-GeTe erhalten [21]. Daher wird hauptsächlich die AA-stapelnde Doppelschicht-α-GeTe im folgenden Abschnitt diskutiert.

Ansicht von oben (a ) und Seitenansicht (c ) von AA-Stapel-Doppelschicht-α-GeTe. Ansicht von oben (b ) und Seitenansicht (d ) von AB-stapelnder Doppelschicht α-GeTe

Phononenbanddispersion von AA-Stapeldoppelschicht α-GeTe
Elektronische Strukturen
Um die elektronischen Eigenschaften von Doppelschicht-α-GeTe klar zu verstehen, werden die Bandstruktur und die projizierte Zustandsdichte (PDOS) von Monoschicht-α-GeTe berechnet, wie in Abb. 3a dargestellt. Das Leitungsbandminimum (CBM) liegt zwischen M- und -Punkten, während das Valenzbandmaximum (VBM) am Γ-Punkt liegt, was darauf hinweist, dass einschichtiges α-GeTe ein Halbleiter mit indirekter Bandlücke mit einem Energielückenwert von 1.796 eV . ist , in guter Übereinstimmung mit früheren Ergebnissen [21]. Laut PDOS besteht die CBM im Wesentlichen aus den Zuständen Ge-s, Ge-p und Te-p, während die Zustände in der VBM den Zuständen Ge-p und Te-p zugeordnet werden. Für das Doppelschicht-α-GeTe ist die projizierte Bandstruktur in Abb. 3b aufgetragen, was ein indirektes Band mit dem Lückenwert von 0,610 eV anzeigt. Die CBM von Doppelschicht-α-GeTe wird von der unteren Schicht dominiert, die zwischen M- und -Punkten liegt, während die VBM hauptsächlich von den Zuständen aus der oberen Schicht beigesteuert wird, die sich zwischen Γ- und K-Punkten befindet. Interessant ist, dass die projizierte Bandstruktur von Doppelschicht-α-GeTe die Summe der Monoschichtkomponente zu sein scheint, was darauf hinweist, dass eine typische schwache vdW-Wechselwirkung in Doppelschicht-α-GeTe existiert. Um weitere Einblicke in die Doppelschicht-α-GeTe zu gewinnen, wird die bandzerlegte Ladungsdichte von VBM und CBM berechnet, wie in Abb. 3c gezeigt. Die bandzerlegte Ladungsdichte von CBM und VBM ist deutlich unterschiedlich. Die Zustände der Elektronen mit der niedrigsten Energie und der Löcher mit der höchsten Energie sind in der unteren bzw. oberen Schicht lokalisiert, was die effektive Trennung von Elektronen und Löchern mit Typ-II-Bandkantenausrichtungen bewirkt. Daher erfolgt die räumlich indirekte Exzitonenrekombination durch die gestaffelte Lücke der Doppelschicht, was für optoelektronische Anwendungen wichtig ist [12].

a Bandstruktur und partielle Zustandsdichte von einschichtigem α-GeTe. Projizierte Bandstruktur (b ) gekennzeichnet durch blaue Linien (untere Schicht) und rote Linien (obere Schicht) von Doppelschicht-α-GeTe. Bandzerlegte Ladungsdichte (c ) der VBM und CBM für Doppelschicht α-GeTe
Optische Eigenschaften
Es ist sehr wichtig, die optische Absorption in optoelektronischen Geräten zu untersuchen. Basierend auf der frequenzabhängigen dielektrischen Funktion ε (ω ), der optische Absorptionskoeffizient a (ω ) von Monolayer und Bilayer α-GeTe kann nach der Formel [12, 22] berechnet werden:
$$ \alpha \left(\omega \right)=\sqrt{2}\omega {\left[\sqrt{\omega_1^2\left(\omega \right)+{\omega}_2^2\left( \omega \right)}-{\omega}_1\left(\omega \right)\right]}^{\raisebox{1ex}{$1$}\!\left/ \!\raisebox{-1ex}{$2 $}\right.} $$wo ε 1 (ω ) und ε 2 (ω ) sind der Realteil bzw. der Imaginärteil der komplexen dielektrischen Funktion. In Abb. 4 werden die erhaltenen optischen Absorptionskoeffizienten von Monoschicht, Doppelschicht und Bulk-α-GeTe gezeigt. Einschichtiges α-GeTe weist drei Absorptionspeaks entsprechend seinen Übergängen zwischen dem Leitungsband und dem Valenzband des einschichtigen α-GeTe auf. Und es gibt eine offensichtliche Lichtabsorption im ultravioletten und tiefen ultravioletten Bereich. Doppelschicht-α-GeTe weist jedoch auch eine deutliche Lichtabsorption im sichtbaren und infraroten Bereich auf. Ähnlich wie Doppelschicht-α-GeTe weist massives α-GeTe eine breite optische Absorption im Bereich von tiefem Ultraviolett bis Infrarot auf, und die optische Absorptionsintensität kann die Größenordnung von 10 5 . erreichen cm −1 . Diese verstärkte optische Absorptionsintensität wird durch die erhöhte Schichtanzahl von Bulk-α-GeTe im Vergleich zu Monoschicht- und Doppelschicht-α-GeTe verursacht. Somit könnte α-GeTe aufgrund der Effizienz der Solarenergienutzung vielversprechende Materialien für optoelektronische Anwendungen sein.
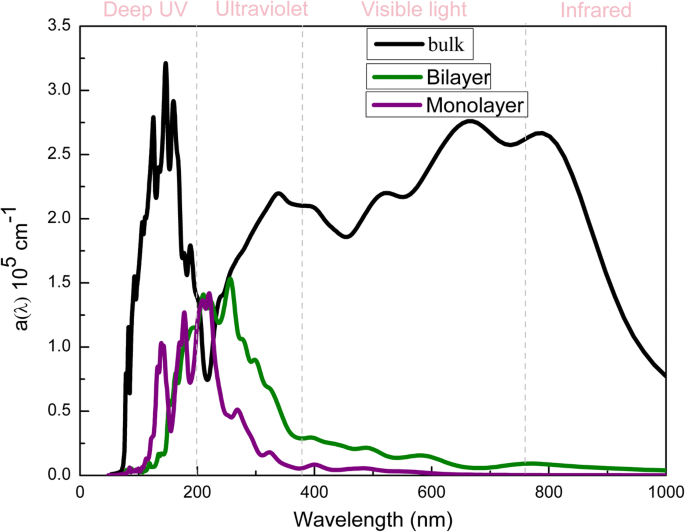
Absorptionskoeffizient von Monolayer und Bilayer α-GeTe
Auswirkung der vertikalen Dehnung
Das Anwenden vertikaler Dehnung ist ein effektiver Weg, um die elektronischen Eigenschaften von Doppelschichtmaterialien zu modulieren. Abbildung 5a zeigt die Bandlücke als Funktion der Abstände zwischen den Schichten. Die Bindungsenergie (E b ) wird durch die Gleichung [22] berechnet:
$$ {E}_{\mathrm{b}}={E}_{\mathrm{b}\mathrm{ilayer}}-2{E}_{\mathrm{monolayer}} $$wo E Doppelschicht und E Monoschicht sind die Gesamtenergien von Doppelschicht- bzw. Monoschicht-α-GeTe. Bei den Zwischenschicht-Abstandsvariationen von 2,420 bis 3,520 sind die Bindungsenergien alle negativ. Noch wichtiger ist die Entfernung mit d = 2.920 Å entspricht dem Minimalwert des E b , was auf die stabilste Struktur hinweist. Darüber hinaus kann die Bandlücke von Doppelschicht-α-GeTe durch die unterschiedliche Kopplung zwischen den Schichten kontinuierlich abgestimmt werden. Bandlücken nehmen monoton zu, aber die Form aller Bandstrukturen bleibt unverändert, wobei die Abstände von 2,420 bis 3,520 variieren. In Abb. 5b sind Bandstrukturen für Doppelschicht-α-GeTe mit 2,420 und 3,520 Zwischenschichtabständen aufgetragen. CBM1 und VBM1 entsprechen dem Zwischenschichtabstand 3,520 , und CBM2 und VBM2 beziehen sich auf den Zwischenschichtabstand 2,420 . Die CBM sinkt, während die VBM zusammen mit den abnehmenden Zwischenschichtabständen ansteigt. Die Bandlücke nimmt mit zunehmendem Zwischenschichtabstand für Doppelschicht-α-GeTe aufgrund der Verstärkung der vdW-Zwischenschichtwechselwirkung und der Orbitalüberlappung zu. Ähnliches Verhalten findet sich bei Doppelschicht-InSe [22].
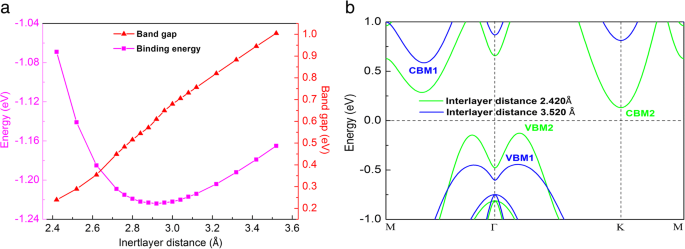
Variationen der Bindungsenergie und Bandlücke (a ) von Doppelschicht-α-GeTe als Funktion des Zwischenschichtabstands. Bandstrukturen (b ) von zweischichtigem α-GeTe mit 2.420 Å und 3.520 Å Zwischenschichtabständen
Auswirkung externer elektrischer Felder
Eine weitere effektive Möglichkeit, die elektronischen Eigenschaften von 2D-vdW-Doppelschichten abzustimmen, ist das Anlegen vertikaler externer elektrischer Felder. Um valide Ergebnisse zu erhalten, wird in der Mitte des Vakuumbereichs eine planare Dipolschicht ausgeführt und die Symmetrie bei allen Rechnungen unter Anlegen elektrischer Felder aufgehoben [29]. Darüber hinaus ist die positive Richtung so definiert, dass sie von der unteren Schicht zur oberen Schicht zeigt. In Abb. 6 ändert sich die Bandlücke des Doppelschicht-α-GeTe geringfügig, wenn die Werte des Anlegens elektrischer Felder (E App ) variieren von 0,01 bis 0,64 V/Å. Wenn E App kleiner (oder größer) als ein kritischer Wert ist (E c ) fällt die Bandlücke von Doppelschicht-α-GeTe sehr schnell und linear ab. Dann erfolgt der Halbleiter-zu-Metall-Übergang der Doppelschicht α-GeTe bis E App kleiner (oder größer) als ein typischer Wert ist (E t ). Diese Ergebnisse zeigen, dass die Hybridisierung zwischen den beiden Schichten umso stärker ist, je größer die angelegte elektrische Feldstärke ist.
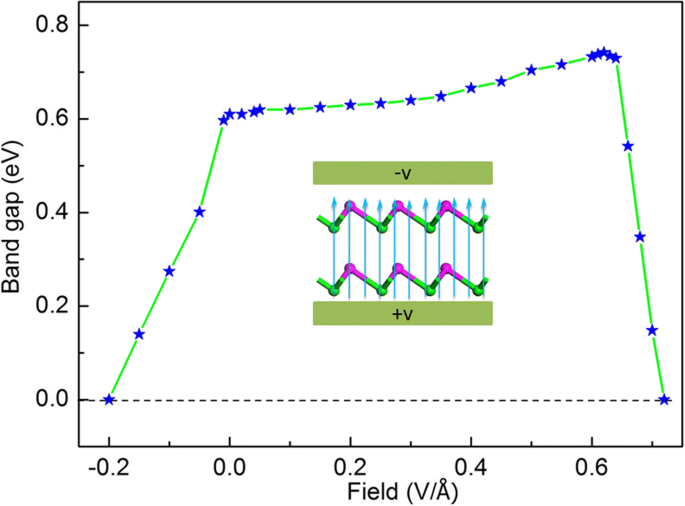
Variationen der Bandlücke von Doppelschicht-α-GeTe als Funktion des angelegten vertikalen elektrischen Felds. Die farbigen horizontalen gestrichelten Linien sind lückenlos verschoben
Insbesondere die Reichweite von E c –E t beträgt 0,01–0,20 V/Å bei Anlegen negativer elektrischer Felder, was deutlich größer ist als der Bereich von E c –E t (0,64–0,72 V/Å) mit den positiven angelegten elektrischen Feldern. Um den Bandlückenübergang unter den angelegten vertikalen elektrischen Feldern zu verstehen, wurden projizierte Bandstrukturen von Doppelschicht-α-GeTe unter den ausgewählten externen vertikalen elektrischen Feldern berechnet, wie in Abb. 7 gezeigt. Wenn E App = − 0,20 und E App =– 0,10 V/Å, die CBM und die VBM des Doppelschicht-α-GeTe werden auch von der unteren bzw. oberen Schicht beigetragen. Das Anlegen vertikaler elektrischer Felder bringt sowohl die CBM als auch die VBM näher an das Fermi-Niveau und erreicht schließlich einen Halbleiter-Metall-Übergang bei E App = − 0,20 V/Å. Andererseits wird mit einer Zunahme der positiven angelegten elektrischen Felder das Energieniveau der Bandstrukturen der unteren Schicht allmählich erhöht, und umgekehrt wird für die obere Schicht beobachtet. Als Ergebnis werden die obere und die untere Schicht der CBM bzw. der VBM des Doppelschicht-α-GeTe zugeschrieben, wenn E App ≥ 0,64 V/Å. Darüber hinaus erscheinen unter den angelegten positiven elektrischen Feldern zusätzliche Leitungsbänder, die durch die cyanfarbene Linie angezeigt werden. Diese Bänder werden nicht von der unteren oder oberen Schicht beigesteuert, was das Merkmal des nahen Freie-Elektronen-Gases (NFEG) zeigt [30]. Das Energieniveau des NFEG-Bandes sinkt sehr schnell mit einer Zunahme des angelegten elektrischen Feldes. Wenn E App ≥ E c ~ 0,64 V/Å, die CBM bestand aus dem NFEG-Band. Wenn E App ≥ E t ~ 0,72 V/Å, das NFEG-Band liegt nahe dem Fermi-Niveau und die VBM des unteren Schichtkontakts mit dem NFEG-Band, was auf das Merkmal der Metallbandstruktur hindeutet. Und die Tendenz zur Variation der Bandlücke von Doppelschicht-α-GeTe unter positiver Anlegung elektrischer Felder wird weiter analysiert. Für E App < E c , hängt die Bandlücke von der Energieniveaudifferenz zwischen dem CBM und dem VBM ab, die gegenüber dem Anlegen elektrischer Felder nicht empfindlich ist. Daher ist die Bandlücke relativ stabil. Für E c < E App < E t , übernimmt das NFEG-Band die CBM und dominiert die Bandlückenänderung. Die Bandlücke nimmt stark und linear ab, wenn das Energieniveau des NFEG-Bandes stark abfällt. Für E App < E t , das Energieniveau des NFEG-Bandes niedriger ist als das des VBM. Daher kommt der Halbleiter-Metall-Übergang von Doppelschicht-α-GeTe von dem durch ein elektrisches Feld induzierten NFEG. Darüber hinaus hat zweischichtiges α-GeTe mehr als das Doppelte des E t der Doppelschicht InSe [29], was darauf hinweist, dass der Halbleiter-Metall-Übergang der Doppelschicht α-GeTe mehr Spannung benötigt.

Projizierte Bandstruktur von Doppelschicht-α-GeTe, gekennzeichnet durch blaue Linien (untere Schicht) und rote Linien (obere Schicht) unter verschiedenen externen vertikalen elektrischen Feldern
Basierend auf den obigen Ergebnissen wurde ein möglicher Datenspeicher mit zweischichtigem α-GeTe entworfen, dessen schematische Struktur wie in Fig. 8 dargestellt aufgebaut ist. Zweischichtiges α-GeTe wird auf das dünne Si/SiO2 Substrate. Das gleiche Si/SiO2 Schicht wird auf der Doppelschicht α-GeTe bedeckt, um 2D-α-GeTe vor der Luft zu schützen. Der großflächige Graphenfilm wird übertragen und aufgrund seiner hohen optischen Transmission und Leitfähigkeit für die Source- und Drain-Elektroden verwendet [31]. Natives Doppelschicht-α-GeTe ist ein Halbleiter mit einem hohen elektrischen Widerstand im AUS-Zustand zwischen den Source- und Drain-Elektroden. Das durch ein elektrisches Feld induzierte NFEG kann das Doppelschicht-α-GeTe um E . so modulieren, dass es die Nulllücke ist App ≥ E t von unten nach oben Si, was den EIN-Zustand des elektrischen Widerstands Null zwischen den Source- und Drain-Elektroden impliziert. Sowohl der NFEG- als auch der EIN-Zustand können innerhalb dieser Feldeffekttransistor-(FET)-Vorrichtung gehalten werden, wenn das angelegte elektrische Feld weggenommen wird. Wenn das negative elektrische Feld angelegt wird, wird das NFEG im Doppelschicht-α-GeTe gelöscht. Daher können die AUS- und EIN-Zustände mit den Merkmalen der halbleitenden und metallischen Bandstruktur in Doppelschicht-α-GeTe-basierten Datenspeichervorrichtungen gespeichert werden.
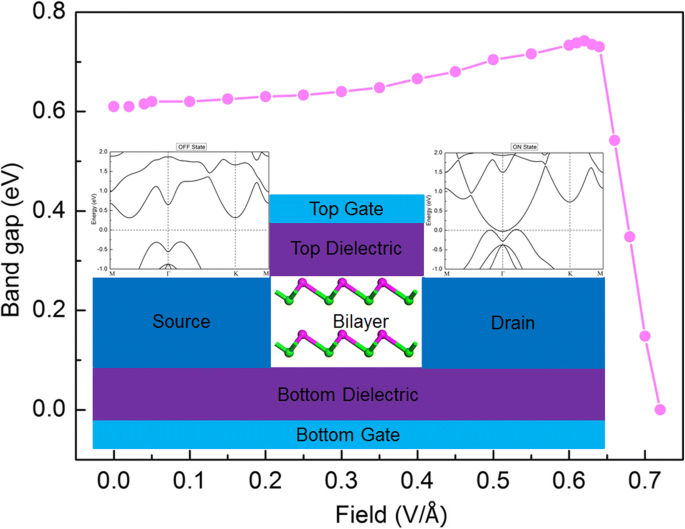
Bandlücke von Doppelschicht-α-GeTe als Funktion des angelegten elektrischen Felds. Einschub ist das schematische Modell
Schlussfolgerung
Zusammenfassend wird die Stabilität von Doppelschicht-α-GeTe untersucht, indem die Bindungsenergien und die Phononenbanddispersion basierend auf dem vdW-korrigierten First-Prinzip berechnet werden. Das vdW-Doppelschicht-α-GeTe hat eine indirekte Bandlücke mit einer typischen Typ-II-Bandausrichtung. Insbesondere hat α-GeTe einen verbesserten optischen Absorptionsbereich und eine verbesserte Intensität. Weiterhin kann die Bandlücke von Doppelschicht-α-GeTe durch das Anlegen einer vertikalen Spannung und das Anlegen externer vertikaler Felder abgestimmt werden. Nur wenn die positiven elektrischen Felder angelegt werden, existiert das NFEG. Und das durch ein elektrisches Feld induzierte NFEG kann die Bandlücke extrem schnell variieren lassen. Basierend auf diesen herausragenden Eigenschaften wird ein möglicher Datenspeicher basierend auf zweischichtigem α-GeTe vorgeschlagen. Diese Ergebnisse erklären den zugrunde liegenden Mechanismus des Bandlückenübergangs für Doppelschicht-α-GeTe. Insgesamt sorgen die effektive Ladungstrennung, das breite optische Absorptionsspektrum, die hohe optische Absorptionsintensität und die NFEG-Funktion dafür, dass das doppelschichtige α-GeTe-Potentialmaterial in 2D-materialbasierten elektronischen und optoelektronischen Geräten funktioniert.
Abkürzungen
- 2D:
-
Zweidimensional
- ALD:
-
Atomlagenabscheidung
- CBM:
-
Leitungsband-Minimum
- DFT:
-
Dichtefunktionaltheorie
- E App :
-
Werte der angelegten elektrischen Felder
- FET:
-
Feldeffekttransistor
- GGA-PBE:
-
Generalisierte Gradientenapproximation von Perdew-Burke-Ernzerhof
- h-BN:
-
Hexagonales Bornitrid
- HSE06:
-
Heyd–Scuseria–Ernzerhof
- InSe:
-
Indiumselenid
- MXenes:
-
Übergangsmetallkarbide
- NFEG:
-
Nahe bei Freie-Elektronen-Gas
- PAW:
-
Projizierte-erweiterte Welle
- PDOS:
-
Projizierte Zustandsdichte
- TMDs:
-
Übergangsmetalldichalkogenide
- VASP:
-
Wien Ab-initio-Simulationspaket
- VBM:
-
Valenzband-Maximum
- vdW:
-
van der Waals
- VLS:
-
Dampf-fest-flüssig
Nanomaterialien
- Elektrische Felder und Kapazität
- Struktur und elektronische Eigenschaften von übergangsmetalldotiertem Kaolinit-Nanoton
- Modulation der elektronischen und optischen Anisotropieeigenschaften von ML-GaS durch vertikales elektrisches Feld
- Elektrische Eigenschaften von Verbundmaterialien mit durch ein elektrisches Feld unterstützter Ausrichtung von Nanokohlenstoff-Füllstoffen
- Auswirkungen der Doppelschichtdicke auf die morphologischen, optischen und elektrischen Eigenschaften von Al2O3/ZnO-Nanolaminaten
- Optische und elektronische Eigenschaften von Femtosekundenlaser-induzierten Schwefel-hyperdotierten Silizium-N+/P-Photodioden
- Herstellung, Charakterisierung und biologische Aktivität von Avermectin-Nanoabgabesystemen mit unterschiedlichen Partikelgrößen
- Eigenschaften und Überlegungen zum Design von Leiterplatten in der Automobilindustrie
- Was ist der Unterschied zwischen elektronisch und elektrisch?
- Verschiedene Eigenschaften und Sorten von Werkzeugstahl



