Dielektrische Verstärkung von atomschichtbeschichteten Al2O3/ZrO2/Al2O3-MIM-Kondensatoren durch Mikrowellenglühen
Zusammenfassung
Für Metall-Isolator-Metall-(MIM)-Kondensatoren, die in den Bereichen HF, DRAM und integrierte Analog-/Mixed-Signal-Schaltungen verwendet werden, ist eine hohe Kapazitätsdichte bei der Verkleinerung der Bauelemente-Merkmalsgröße zwingend erforderlich. In dieser Arbeit wird die Mikrowellen-Glühtechnik untersucht, um die dielektrischen Eigenschaften von Al2 . zu verbessern O3 /ZrO2 /Al2 O3 basierend auf MIM-Kondensatoren. Die Ergebnisse zeigen, dass die Permittivität von ZrO2 wird auf 41,9 (~~40% verbessert) mit einer Mikrowellenausheilung bei 1400 W für 5 min erhöht. Die Substrattemperatur liegt unter 400°C, was mit dem Back-End-of-Line-Prozess kompatibel ist. Die Leckstromdichten betragen 1,23 × 10 –8 und 1,36 × 10 –8 A/cm 2 für eine Probe im abgeschiedenen Zustand bzw. eine Probe mit 1400 W, was anzeigt, dass die Leckageeigenschaft nicht verschlechtert ist. Der Leitungsmechanismus wird als feldunterstütztes Tunneln bestätigt.
Hintergrund
Metall-Isolator-Metall-(MIM)-Kondensatoren sind auf den Gebieten der Hochfrequenz (RF), des dynamischen Direktzugriffsspeichers (DRAM) und der integrierten Analog-/Mixed-Signal-Schaltungen weit verbreitet. Mit der Verkleinerung der Merkmalsgröße der Vorrichtung ist es wünschenswert, eine immer höhere Kapazitätsdichte zu erhalten. Beispielsweise muss die Kapazitätsdichte größer als 10 fF/μm 2 . sein gemäß dem Knoten 2020 der International Technology Roadmap for Semiconductors (ITRS) [1]. Als Konsequenz wurde eine große Anzahl von High-κ-Materialien untersucht, wie z. B. HfO2 [2,3,4,5,6], ZrO2 [7,8,9,10,11,12,13,14], Ta2 O5 [15,16,17,18] und TiO2 [19,20,21,22,23,24]. Unter diesen High--Materialien ist ZrO2 hat eine Dielektrizitätskonstante (κ) von 16~25 (monokline Phase) und eine Bandlücke von 5,8 eV. Der κ-Wert von ZrO2 kann auf 36,8 und 46,6 gesteigert werden, wenn es in die kubische bzw. tetragonale Phase kristallisiert wird [25]. Daher kann die Kapazitätsdichte weiter erhöht werden. Die Mikrowellen-Annealing-(MWA)-Technik wurde aufgrund ihrer niedrigeren Prozesstemperatur im Vergleich zu herkömmlichen thermischen Prozesstechniken enorm für die Dotierstoffaktivierung in Silizium [26,27,28] und die Silizidbildung [29, 30] erforscht. Außerdem haben Shih et al. [31] untersuchten die Wirkung von MWA auf die elektrischen Eigenschaften von TiN/Al/TiN/HfO2 /Si-MOS-Kondensatoren. Einige Schlüsselparameter wie äquivalente Oxiddicke, Grenzflächenzustandsdichte und Leckstromdichte wurden alle verbessert.
In dieser Arbeit wird der Einfluss von MWA auf die elektrischen Eigenschaften von TaN/Al2 O3 /ZrO2 /Al2 O3 /TaN (TaN/A/Z/A/TaN) MIM-Kondensatoren werden untersucht. Mit der Verwendung von MWA wird die Permittivität von ZrO2 wird merklich verbessert und die Leckstromdichte wird leicht erhöht. Darüber hinaus wird auch der zugrunde liegende Leitungsmechanismus untersucht.
Methoden
Erstens ein 500 nm dickes SiO2 Film wurde auf Si-Substrat durch PECVD gezüchtet, gefolgt von der Abscheidung von TaN (20 nm)/Ta (100 nm) Filmen, und TaN wurde durch Sputtern von Ta-Targets in N2&spplus; /Ar-Plasma. Anschließend wurde der mit den TaN/Ta-Filmen beschichtete Si-Wafer in die ALD-Kammer überführt und der Nanostapel aus Al2 O3 (2 nm)/ZrO2 (20 nm)/Al2 O3 (2 nm) wurden bei 250 °C abgeschieden. Al2 O3 und ZrO2 Filme wurden aus Al (CH3 )3 /H2 O und [(CH3 )2 N]4 Zr/H2 O bzw. Erwähnenswert ist, dass ein ultradünnes Al2 O3 Schicht zwischen der unteren TaN-Elektrode und dem ZrO2 Schicht wurde eingefügt, um die Bildung einer Grenzschicht während der ALD und des Glühens nach der Abscheidung zu verhindern. Anschließend wurden die Proben dem Mikrowellentempern unterzogen. MWA wurde in einer achteckigen DSGI-Kammer bei 5,8 GHz durchgeführt. Während des Temperns wurden die Proben in der Mitte der Kammer platziert, wo das elektromagnetische Feld am gleichmäßigsten ist. Die In-situ-Temperatur der Proben wurde mit einem Infrarotpyrometer der Raytek-XR-Serie überwacht, das der Rückseite der Proben zugewandt war. Die Leistung wurde von 700 W bis 1400 W mit einer festen Glühzeit von 5 min variiert. Schließlich wurde wiederum durch reaktives Sputtern, Lithographie und reaktives Ionenätzen eine 100 nm dicke obere TaN-Elektrode gebildet.
Die ALD-Filmdicken wurden mit einem Ellipsometer (SOPRA GES 5E) gemessen und durch ein Transmissionselektronenmikroskop (TEM) bestätigt. Kapazitätsspannung (C-V ) wurde mit einem Präzisionsimpedanzanalysator (Agilent 4294A) mit einer Amplitude von 50 mV AC gemessen. Strom-Spannung (I-V ) Messungen wurden mit einem Halbleiter-Device-Analysator (Agilent B1500) in einer Darkbox durchgeführt. Die Vorspannung wurde an die obere Elektrode angelegt.
Ergebnisse und Diskussion
Die schematischen Strukturen des A/Z/A-basierten MIM-Kondensators und der MWA-Kammer sind in Fig. 1a bzw. b gezeigt. Abbildung 1c zeigt das Querschnitts-TEM-Bild des A/Z/A-basierten MIM-Kondensators, der dem MWA bei 1400 W für 5 Minuten ausgesetzt ist. Es wird beobachtet, dass das ZrO2 Schicht ist vollständig kristallisiert und die gestapelten Schichten sind deutlich zu unterscheiden, siehe Einschub. Abbildung 2a zeigt das kumulative Wahrscheinlichkeitsdiagramm der Kapazitätsdichte bei unterschiedlicher Glühleistung. Die Ergebnisse zeigen, dass die Kapazitätsdichten der MIM-Kondensatoren 7,34, 8,87, 8,96 und 9,06 fF/μm 2 . betragen jeweils für 0, 700, 1050 und 1400 W mit einer kumulativen Wahrscheinlichkeit von 50%. Daher wird die Kapazitätsdichte unter der Einwirkung von Mikrowellen erhöht. Die sehr enge Verteilung der Kapazitätsdichte für die A/Z/A-Stack-MIM-Kondensatoren mit MWA weist auf eine sehr gute Glühgleichmäßigkeit hin. Der Einschub in Abb. 2a zeigt die typischen CV-Kurven aller Proben. Ausschluss der Wirkung von Al2 O3 (κ ≈ 8), die Dielektrizitätskonstanten von ZrO2 Filme werden als 28,3, 40,1, 41 und 41,9 für 0, 700, 1050 bzw. 1400 W extrahiert, wie in Abb. 2b gezeigt. Bezüglich der Mikrowellenleistung von 1400 W ist die Dielektrizitätskonstante von ZrO2 Film erhöht sich um 40% im Vergleich zu der Probe im abgeschiedenen Zustand. Die signifikante Verbesserung der Permittivität von ZrO2 kann auf die hochgradige Kristallisation während des Mikrowellenglühens zurückgeführt werden, wie in Abb. 1c gezeigt. Wie oben erwähnt, ist die Dielektrizitätskonstante von ZrO2 kann auf 36,8 und 46,6 gesteigert werden, wenn es in die kubische bzw. tetragonale Phase kristallisiert wird [25]. Daher wurde die XRD-Messung durchgeführt, um den Mechanismus der Erhöhung der Dielektrizitätskonstante weiter zu untersuchen. Wie im Einschub von Fig. 2b gezeigt, existierte ein Peak bei ~~30,7° nach der MWA-Verarbeitung bei 1400 W, was das Auftreten der tetragonalen Phase (111) in ZrO2 . anzeigt [32, 33]. Das Vorhandensein dieser tetragonalen Phase ist für die Erhöhung der Dielektrizitätskonstante von 28,3 auf über 40 verantwortlich.

a Der schematische Aufbau von Al2 O3 /ZrO2 /Al2 O3 -basierter MIM-Kondensator. b Der schematische Aufbau der MWA-Kammer. c TEM-Bild von Al2 O3 /ZrO2 /Al2 O3 -basierter MIM-Kondensator mit MWA bei 1400 W für 5 min

a Das kumulative Wahrscheinlichkeitsdiagramm der Kapazitätsdichte für verschiedene Stichproben; der Einschub zeigt die Kapazitätsdichte gegenüber der Vorspannung an. b Das kumulative Wahrscheinlichkeitsnetz der Permittivität von ZrO2 für verschiedene Proben; der Einschub zeigt die XRD-Muster der abgeschiedenen und 1400 W-Proben
Da die MIM-Kondensatoren im Back-End-of-Line (BEOL) integrierter Schaltungen hergestellt werden, muss die Prozesstemperatur unter 400 °C liegen [34]. Wie in Abb. 3 gezeigt, zeigen die Temperaturkurven von MWA, dass die höchsten Temperaturen des Substrats 260, 350 und 400°C für 700, 1050 bzw. 1400 W betragen. Daher ist MWA vom Standpunkt der Prozesstemperatur mit dem CMOS-Prozess kompatibel. Darüber hinaus wurde in der vorherigen Arbeit [13] Al2 O3 (2 nm)/ZrO2 (20 nm)-basierte MIM-Kondensatoren wurden einem schnellen thermischen Glühen (RTA) bei 420 °C für 10 min in N2 . unterzogen /H2 Umgebung und die resultierende Dielektrizitätskonstante von ZrO2 wurde mit 40 bewertet. Für RTA wurde die Temperzeit konstant bei 420°C für 10 min gehalten, so dass das thermische Budget im Vergleich zu MWA viel größer war. Für MWA [35, 36] wird angenommen, dass die Dipolpolarisation der wichtigste Mechanismus für den Energietransfer auf molekularer Ebene ist. Wenn Materialien in Kontakt unterschiedliche dielektrische Eigenschaften aufweisen, werden Mikrowellen selektiv mit den Materialien mit höherem dielektrischen Verlust gekoppelt. Im Gegensatz dazu überträgt konventionelles RTA die Wärme am effizientesten auf Materialien mit hoher Leitfähigkeit.
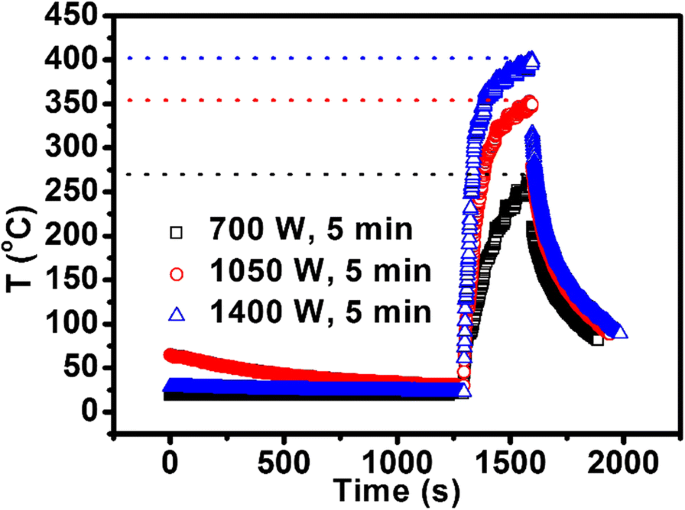
Die Kurven der Substrattemperatur für verschiedene Proben während des Mikrowellenglühens
Der Leckstrom ist ein weiterer wichtiger Parameter für MIM-Kondensatoren. Wie in Abb. 4a gezeigt, kann die Leckstromkurve für alle Proben in zwei Abschnitte unterteilt werden, da es einen offensichtlichen Wendepunkt gibt, der auf unterschiedliche Elektronenleitungsmechanismen hinweist. Bei den Proben mit MWA-Verarbeitung ist die dem Wendepunkt entsprechende Spannung im Vergleich zur abgeschiedenen Probe kleiner. Tabelle 1 listet die Leckstromdichte bei ± 4 V für alle Proben auf. Nehmen wir zum Beispiel 4 V, die Leckstromdichte wird von 1,06 × 10 –7 . erhöht bis 1,92 × 10 −5 A/cm 2 , d. h. eine Erhöhung der Amplitude um zwei Größenordnungen, wenn die Mikrowellenleistung von 0 auf 1400 W erhöht wird. Aufgrund einer hohen Kristallisation des ZrO2 Film erscheint eine große Anzahl von Korngrenzen, die als Leckpfad dienen, wodurch die Elektronenleitung unter einem hohen elektrischen Feld verbessert wird. Unter Berücksichtigung einer Arbeitsspannung von 2 V betragen die Leckstromdichten jedoch 1,23 × 10 –8 . und 1,36 × 10 –8 A/cm 2 für die Probe im abgeschiedenen Zustand bzw. die Probe mit 1400 W. Offensichtlich hat das Mikrowellenglühen einen geringen Einfluss auf die Streuleistung bei einem niedrigen elektrischen Feld. Außerdem wurde die Durchbruchspannung aus dem I . extrahiert -V Test und aufgetragen in Abb. 4b. Für die abgeschiedene Probe beträgt die Durchbruchspannung etwa 9,8 V bei einer kumulativen Wahrscheinlichkeit von 50%. Mit der Anwendung von MWA wird die Durchbruchspannung auf ~ 9 V reduziert. Diese Reduzierung der Durchbruchspannung könnte mit der Änderung des ZrO2 . zusammenhängen Mikrostruktur.
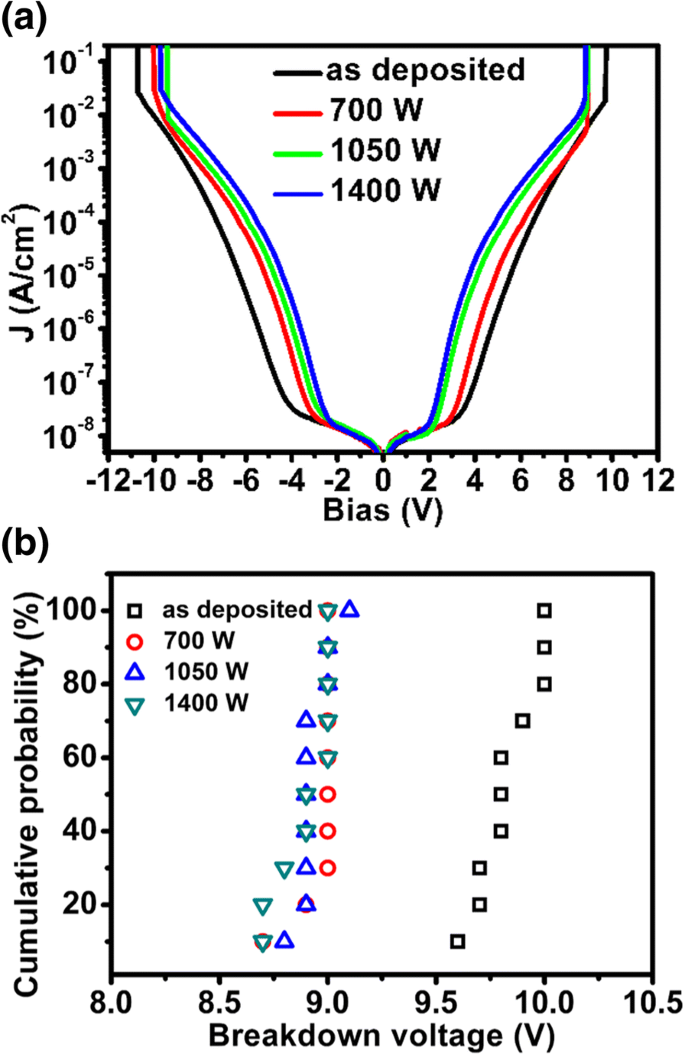
a Das Diagramm der Leckstromdichte (J ) vs Bias und b das kumulative Wahrscheinlichkeitsdiagramm der Durchbruchspannung für verschiedene Stichproben
Um den Einfluss von MWA auf den Leckstrom besser zu verstehen, werden die Leitungsmechanismen der MIM-Kondensatoren untersucht. Basierend auf früheren Untersuchungen zu Al2 O3 (2 nm)/ZrO2 (20 nm)-basierter MIM-Kondensator [13, 14], der dominante Leitungsmechanismus in einem hohen elektrischen Feld wurde als feldunterstütztes Tunneln (FAT) bestätigt. Bei der FAT, die ein Fallen-bezogenes Tunneln ist, werden Elektronen zuerst von den Fallen im Isolator eingefangen und dann direkt in das Leitungsband des Isolators getunnelt [37]. In der aktuellen Arbeit ist die Al2 O3 und ZrO2 Filme in den A/Z/A-basierten MIM-Kondensatoren wurden unter den gleichen Bedingungen abgeschieden, so dass der Leckstrom wahrscheinlich auch durch FAT vorherrscht. Das FAT-Modell kann durch Gl. (1) [37]
$$ J={AE}^2\exp \left(-\frac{8\pi\sqrt{2{m}^{\ast}q{\varphi}_t^3}}{3 hE}\right) $$ (1)wo A ist eine Konstante, E ist das elektrische Feld, q ist die elektronische Ladung, m * steht für die effektive Elektronenmasse (ca. 0,25 m 0 , wo m 0 ist die freie Elektronenmasse), k ist die Boltzmann-Konstante, φ t die Energiebarriere ist, die Fallen vom Leitungsband trennt, und h ist die Plancksche Konstante.
Hinsichtlich der gestapelten Dielektrika unterscheidet sich das an jede Schicht angelegte elektrische Feld aufgrund unterschiedlicher Permittivität und Dicke voneinander. Daher führt die Verwendung des durchschnittlichen elektrischen Felds über den gesamten Stapel zu schwerwiegenden Fehlern bei der Diskussion des Leitungsmechanismus. Als Folge wird das elektrische Feld über dem ZrO2 Schicht muss genau extrahiert werden. Die elektrischen Felder über ZrO2 sind 3,125 × 10 7 × V Stapel , 2,5 × 10 7 × V Stapel , 2,47 × 10 7 × V Stapel , und 2,44 × 10 7 × V Stapel bzw. für die Proben im abgeschiedenen Zustand mit 700 W, 1050 W und 1400 W gemäß dem Gauss-Gesetz und dem Kirchhoff-Spannungsgesetz [38, 39]:
$$ \left\{\begin{array}{c}{k}_A{E}_A={\kappa}_Z{E}_Z\\ {}{d}_A{E}_A+{d}_Z{E }_Z={V}_{stack}\end{array}\right. $$ (2)wo k A und κ Z repräsentieren die Dielektrizitätskonstanten von Al2 O3 und ZrO2 , bzw; E A und E Z bezeichnen die elektrischen Felder über Al2 O3 und ZrO2 , bzw; d A und d Z gleich der Dicke von Al2 O3 und ZrO2 , bzw; und V Stapel ist die an den Stapel angelegte Spannung. Dementsprechend ist Ln (J /E Z 2 ) gegen 1/E Z wurde willkürlich in Fig. 5 aufgetragen, wobei eine geradlinige Anpassung im Hochfeldbereich für jede Probe unter Elektroneneinspritzung von unten (siehe Fig. 5a) oder Elektroneneinspeisung von oben (siehe Fig. 5b) erreicht wurde. Dies bedeutet, dass der FAT-Mechanismus bei hohen elektrischen Feldern dominiert wird. Das extrahierte φ t beträgt 0,73, 0,51, 0,38 bzw. 0,35 eV für eine Probe im abgeschiedenen Zustand mit 700 W, 1050 und 1400 W unter Elektroneninjektion von unten. In Bezug auf die Elektronen-Top-Injektion ist das entsprechende φ t 0,82, 0,53, 0,47 bzw. 0,43 eV beträgt. Daher werden einige flache Fallen durch MWA induziert. Es wird berichtet, dass die flachen Fallen von den Korngrenzendefekten herrühren, die zusätzliche elektronische Zustände in der Nähe des Leitungsbandes einführen können [40]. Darüber hinaus ist der Leitungsmechanismus bei niedrigen Feldern höchstwahrscheinlich Trap-assisted Tunneling (TAT).
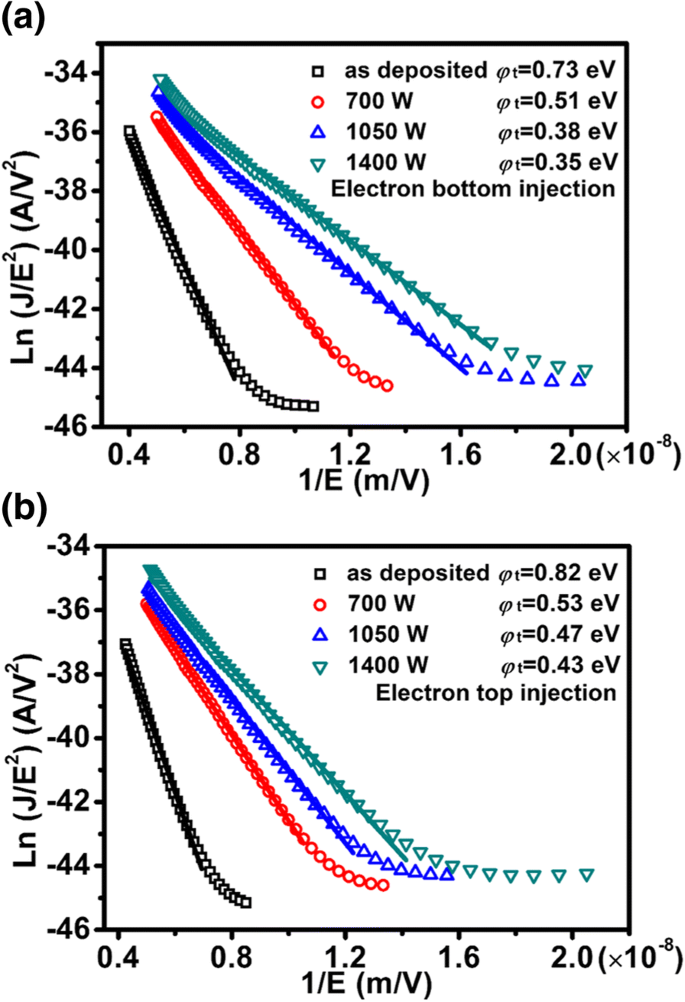
Die Handlung von Ln (J /E 2 ) vs 1/E für verschiedene Proben. a Elektronen-Boden-Injektion und b Elektronen-Top-Injektion
Schlussfolgerungen
Auf atomarer Schicht abgeschiedenes Al2 O3 /ZrO2 /Al2 O3 Nano-Stack wird als Isolator der MIM-Kondensatoren verwendet. Mit der Wirkung von MWA bei 1400 W für 5 min wird die Kapazitätsdichte auf 9,06 fF/μm 2 . erhöht , ungefähr 23,4% der Kapazität verbessert. Entkopplung des Einflusses von Al2 O3 , wird die Dielektrizitätskonstante auf 41,9 für 1400 W Probe abgeleitet (~~40% der Permittivität erhöht). Diese Erhöhung der Permittivität ist auf eine hohe Kristallisation des ZrO2 . zurückzuführen Film. Darüber hinaus liegt die Substrattemperatur unter 400°C, wodurch MWA mit dem BEOL-Prozess kompatibel ist. Diese niedrigere Substrattemperatur ist auf die selektive Erwärmung der Materialien von MWA zurückzuführen. Bezogen auf eine Arbeitsspannung von 2 V betragen die Leckstromdichten 1,23 × 10 –8 und 1,36 × 10 –8 A/cm 2 für die Probe im abgeschiedenen Zustand bzw. die Probe mit 1400 W. Der dominierte Leitungsmechanismus in den hohen elektrischen Feldern wird als FAT-Prozess bestätigt. Der Leckstrom in den niedrigen elektrischen Feldern wird wahrscheinlich durch TAT diktiert. Basierend auf den obigen Tatsachen ist das Mikrowellenglühen eine vielversprechende Technik, die im CMOS-Prozess verwendet wird, um die dielektrische Leistung der MIM-Kondensatoren zu verbessern.
Abkürzungen
- A/Z/A:
-
Al2 O3 /ZrO2 /Al2 O3
- ALD:
-
Atomlagenabscheidung
- BEOL:
-
Hinteres Zeilenende
- C-V :
-
Kapazität-Spannung
- DRAM:
-
Dynamischer Arbeitsspeicher
- FAT:
-
Feldunterstützter Tunnelbau
- ITRS:
-
Internationale Technologie-Roadmap für Halbleiter
- I-V :
-
Strom-Spannung
- MIM:
-
Metall-Isolator-Metall
- MWA:
-
Mikrowellenglühen
- PECVD:
-
Plasmaverstärkte chemische Gasphasenabscheidung
- RF:
-
Funkfrequenz
- RTA:
-
Schnelles thermisches Glühen
- TAT:
-
Trap-assisted Tunneling
- TEM:
-
Transmissionselektronenmikroskop
Nanomaterialien
- AVX veröffentlicht neue Ultraminiatur-Dünnschicht-Übertragungsleitungskondensatoren für Hochleistungs-Mikrowellen- und HF-Anwendungen
- Abbildung von Atomen auf 2D-Atomkristallen in Flüssigkeiten
- Ozeankohlenstoff auf atomarer Skala
- Compliance-freier ZrO2/ZrO2 − x /ZrO2 Resistiver Speicher mit steuerbarem Grenzflächen-Mehrzustands-Schaltverhalten
- Bildung und Lumineszenzeigenschaften von Al2O3:SiOC-Nanokompositen auf der Basis von durch Phenyltrimethoxysilan modifizierten Aluminiumoxid-Nanopartikeln
- Auswirkungen der Doppelschichtdicke auf die morphologischen, optischen und elektrischen Eigenschaften von Al2O3/ZnO-Nanolaminaten
- Plasmonischer Sensor basierend auf dielektrischen Nanoprismen
- Wellenlängengesteuerter Photodetektor basierend auf einem einzelnen CdSSe-Nanogürtel
- Auswirkung des postthermischen Temperns auf die optischen Eigenschaften von InP/ZnS-Quantenpunktfilmen
- Atomschicht-abgeschiedener HfAlOx-basierter RRAM mit niedriger Betriebsspannung für Computing-In-Memory-Anwendungen



