Germanium-Feldeffekttransistoren mit negativer Kapazität:Auswirkungen der Zr-Zusammensetzung in Hf1−xZrxO2
Zusammenfassung
Germanium (Ge) negative Kapazitäts-Feldeffekttransistoren (NCFETs) mit verschiedenen Zr-Zusammensetzungen in Hf1−x Zrx O2 (x = 0,33, 0,48 und 0,67) hergestellt und charakterisiert. Für jede Zr-Zusammensetzung zeigt der NCFET den plötzlichen Abfall in einigen Punkten des unterschwelligen Swings (SS), der durch den NC-Effekt induziert wird. Antriebsstrom I DS nimmt mit der Erhöhung der Glühtemperatur zu, was auf den verringerten Source/Drain-Widerstand und die verbesserte Trägermobilität zurückzuführen sein sollte. Die steilen SS-Punkte sind wiederholbar und stabil durch mehrere DC-Sweep-Messungen, die beweisen, dass sie durch den NC-Effekt induziert werden. Die Werte der Gatespannung V GS entsprechend steilen SS sind konsistent und im Uhrzeigersinn I DS -V GS werden durch die mehreren DC-Sweeps beibehalten. Bei fester Glühtemperatur NC-Gerät mit Hf0,52 Zr0,48 O2 erreicht das höhere I DS aber größere Hysterese verglichen mit den anderen Zusammensetzungen. NCFET mit Hf0,67 Zr0,33 O2 kann die hervorragende Leistung mit hysteresefreien Kurven und hohem I . erzielen DS .
Hintergrund
Der ferroelektrische Feldeffekttransistor mit negativer Kapazität (NCFET) mit einem in den Gate-Stapel eingefügten ferroelektrischen Film ist ein vielversprechender Kandidat für Anwendungen mit geringer Verlustleistung, da er die grundlegende Einschränkung des Unterschwellenhubs (SS) für konventionelle Metall- Oxid-Halbleiter-Feldeffekttransistor (MOSFET) [1]. Das Phänomen der negativen Kapazität (NC) in NCFETs wurde ausführlich in verschiedenen Kanalmaterialien untersucht, darunter Silizium (Si) [2, 3], Germanium (Ge) [4], Germanium-Zinn (GeSn) [5], III–V [6] und 2D-Materialien [7]. Außerdem wurden die NC-Eigenschaften in NCFETs mit verschiedenen Ferroelektrika wie BiFeO3 . demonstriert [8], PbZrTiO3 (PZT) [9], PVDF [10] und Hf1−x Zrx O2 [11]. Im Vergleich zu anderen Ferroelektrika ist Hf1−x Zrx O2 hat den Vorteil, dass sie mit der CMOS-Integration kompatibel ist. Experimentelle Studien haben gezeigt, dass die elektrische Leistung von NCFETs durch Variation der Dicke und Fläche von Hf1−x . optimiert werden kann Zrx O2 , was die Anpassung zwischen der MOS-Kapazität (C MOS ) und ferroelektrische Kapazität (C FE ) [12, 13]. Es wird erwartet, dass die Zr-Zusammensetzung in Hf1−x Zrx O2 hat auch einen großen Einfluss auf die Leistung von NCFETs, da es die ferroelektrischen Eigenschaften von Hf1−x . bestimmt Zrx O2 . Es fehlt jedoch noch an einer detaillierten Studie über die Auswirkungen der Zr-Zusammensetzung auf die elektrischen Eigenschaften von NCFETs.
In diesem Papier untersuchen wir umfassend die Einflüsse der Glühtemperatur und der Zr-Zusammensetzung auf die Leistung von Ge-NCFET.
Methoden
Wichtige Prozessschritte zur Herstellung von Ge-p-Kanal-NCFETs mit den verschiedenen Zr-Zusammensetzungen in Hf1−x Zrx O2 sind in Abb. 1(a) gezeigt. Nach der Pregate-Reinigung wurden n-Ge (001)-Substrate in die Atomlagenabscheidungskammer (ALD) geladen. Ein dünnes Al2 O3 (25 Zyklen) Film abgeschieden, gefolgt von der O3 Passivierung. Dann die Hf1-x Zrx O2 Filme (x = 0.33, 0.48 und 0.67) wurden in derselben ALD-Kammer unter Verwendung von [(CH3 )2 N]4 Hf (TDMAHf), [(CH3 .) )2 N]4 Zr (TDMAZr) und H2 O als Hf-, Zr- bzw. O-Vorläufer. Danach wurde das TaN-Metallgate unter Verwendung des reaktiven Sputterns abgeschieden. Nach der Gatestrukturierung und Ätzung werden Borionen (B + ) wurden in Source/Drain (S/D)-Regionen mit einer Energie von 20 keV und einer Dosis von 1 × 10 15 . implantiert cm −2 . Nicht selbstausgerichtete S/D-Metalle wurden durch den Abhebeprozess gebildet. Schließlich wurde ein schnelles thermisches Ausheilen (RTA) bei verschiedenen Temperaturen zur Dotierstoffaktivierung, S/D-Metallisierung und Kristallisation von Hf1−x . durchgeführt Zrx O2 Film. Gesteuerte pMOSFETs mit dem Al2 O3 /HfO2 Stapel wurde auch hergestellt.

(a ) Schlüsselprozessschritte zur Herstellung von Ge-NCFETs mit den unterschiedlichen Zr-Zusammensetzungen in Hf1−x Zrx O2 Ferroelektrika. (b ) Schema des hergestellten NC-Transistors. (c ) TEM-Bild des Gate-Stapels des NC-Geräts, das den 7 nm H0.52 . veranschaulicht Zr0,48 O2 Schicht und 2 nm Al2 O3 Schicht
Abbildung 1(b) zeigt das Schema des hergestellten NCFET. Das hochauflösende Transmissionselektronenmikroskop (HRTEM)-Bild in Abb. 1(c) zeigt den Gatestapel auf dem Ge-Kanal des Geräts mit Hf0,52 Zr0,48 O2 ferroelektrisch. Die Dicken von Al2 O3 und Hf0,52 Zr0,48 O2 Schichten sind 2 nm bzw. 7 nm.
Um die Stöchiometrien von Hf1−x . zu bestätigen Zrx O2 wurde die Messung der Röntgenphotoelektronenspektroskopie (XPS) durchgeführt. Abbildung 2(a) und (b) zeigen die Hf4f und Zr3d Photoelektronenkern-Niveau-Spektren für Hf0,67 Zr0,33 O2 , Hf0,52 Zr0,48 O2 , und Hf0,33 Zr0,67 O2 Filme. Die Materialzusammensetzungen wurden basierend auf dem Flächenverhältnis der Peaks und den entsprechenden Sensitivitätsfaktoren berechnet. Die beiden Gipfel von Zr3d 5/2 und Zr3d 3/2 haben eine Spin-Orbital-Aufspaltung von 2.4 eV, die aus Refs. [14, 15]. Mit der Zunahme der Zr-Zusammensetzung in Hf1−x Zrx O2 , Zr3d , und Hf4f Peaks verschieben sich in Richtung niedrigerer Energie.

(a ) Hf 4f und (b ) Zr 3d Spektren auf Kernebene für Hf1−x Zrx O2 Proben mit den verschiedenen Zr-Zusammensetzungen
Die ferroelektrischen Eigenschaften von Hf1−x Zrx O2 Filme (x = 0.33, 0.48 und 0.66) wurden durch die Polarisation P . gekennzeichnet vs. Antriebsspannung V Hystereseschleifenmessung. P -V Loops wurden auf den makellosen Geräten aufgenommen. Abbildung 3 zeigt die Kurven von P vs. V für TaN/Hf1−x Zrx O2 (10 nm)/TaN-Abtastungen in einer Reihe von Ansteuerspannungen. Wenn die Temperatur nach dem Glühen von 500 auf 550 °C ansteigt, wird der P -V Kurven der Hf1−x Zrx O2 neigen dazu, in einem Sub-Loop-Zustand gesättigt zu sein. Wenn die Zr-Zusammensetzung zunimmt, wird die Restpolarisation des Films offensichtlich verbessert, und es wird eine Ausdünnung der Hystereseschleife bei Nullvorspannung beobachtet, die phänomenologisch am besten als überlagerte antiferroelektrische Eigenschaften beschrieben werden kann [16, 17].
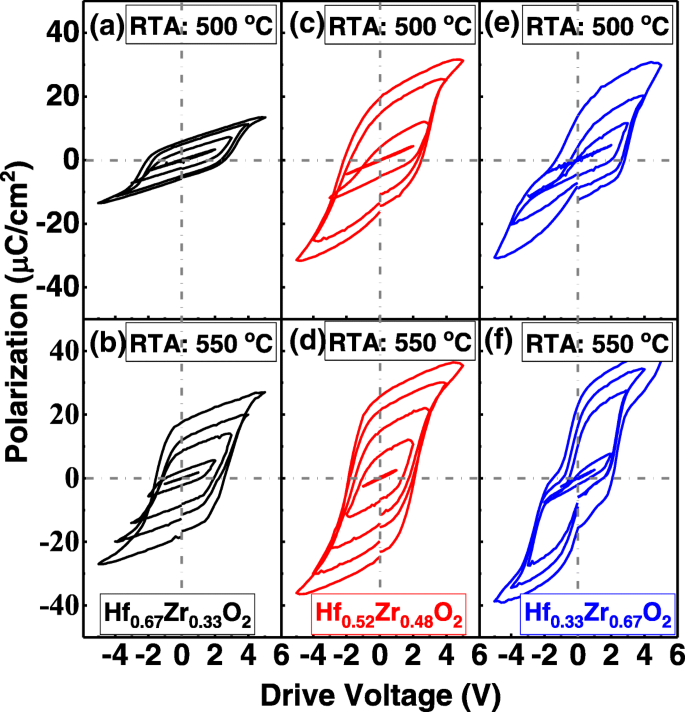
Gemessene P-V-Kurven des Hf1-x ZrxO2-Filme mit unterschiedlichen Zr-Zusammensetzungen getempert bei 500 und 550 o C. (a ) und (b ) sind die Hf0,67 Zr0,33 O2 Filmgeglüht bei 500 und 550 o C bzw. (c ) und (d ) sind die Hf0,52 Zr0,48 O2 Filmgeglüht bei 500 und 550 o C bzw. (e ) und (f ) sind die Hf0,33 Zr0,67 O2 Filmgeglüht bei 500 und 550 o C bzw. Mit dem Nachglühen steigt die Temperatur von 500 auf 550 o C, die P-V-Kurven von Hf1-x Zrx O2 neigen dazu, in einem Sub-Loop-Zustand gesättigt zu sein. Eine Entwicklung von ferroelektrischem zu antiferroelektrischem Verhalten wird mit erhöhter Zr-Zusammensetzung beobachtet
Ergebnisse und Diskussion
Abbildung 4(a) zeigt die gemessenen Übertragungseigenschaften von Ge-NCFETs mit Hf0,52 Zr0,48 O2 Ferroelektrika mit unterschiedlichen Glühtemperaturen und Kontrollgerät mit Al2 O3 /HfO2 Stapeldielektrikum. Die Kontrollvorrichtung wurde bei 500°C getempert. Alle Geräte haben eine Gate-Länge L G von 2 μm. Das Vorwärts- und Rückwärts-Wobbeln wird durch die offenen bzw. ausgefüllten Symbole angezeigt. Die NCFETs haben im Vergleich zum Steuergerät einen viel höheren Ansteuerstrom. Es ist ersichtlich, dass mit steigender Glühtemperatur von 450 auf 550 °C die Schwellenspannung V TH der NC-Geräte verschieben sich ins positive V GS Richtung. Die NCFETs weisen eine kleine Hysterese auf, die mit steigender RTA-Temperatur vernachlässigbar wird. Der Einfangeffekt führt auch zur Hysterese, aber das erzeugt das I . gegen den Uhrzeigersinn DS -V GS Schleife, im Gegensatz zu den Ergebnissen, die durch ferroelektrisches Schalten induziert werden [18]. Punkt SS vs. I DS Kurven in Abb. 4(b) zeigen, dass der NC-Transistor an einigen Punkten von SS einen plötzlichen Abfall zeigt, der der abrupten Änderung von I . entspricht DS induziert durch den NC-Effekt [19]. Es wird beobachtet, dass NCFETs im Vergleich zum Steuergerät die verbesserten SS-Eigenschaften erzielen. Wir haben festgestellt, dass die plötzlichen Abfallpunkte der Vorrichtungen bei den unterschiedlichen Glühtemperaturen konsistent sind. Das gemessene Ich DS -V DS Kurven der NCFETs mit Hf0,52 Zr0,48 O2 ferroelektrisch geglüht bei unterschiedlichen Temperaturen sind in Fig. 4(c) gezeigt. Ich DS -V DS Kurven des NC-Transistors zeigen das offensichtliche NDR-Phänomen, das ein typisches Merkmal von NC-Transistoren ist [20,21,22,23]. Abbildung 4(d) sind die Diagramme des I DS der Ge-NCFETs mit dem Hf0,52 Zr0,48 O2 ferroelektrische Schicht getempert bei 450, 500 bzw. 550 °C, bei V DS = − 0.05 V und − 0.5 V und |V GS − V TH | = 1.0 V. Hier ist das V TH ist definiert als das V GS bei ich DS von 10 −7 A/μm. Ich DS nimmt mit steigender RTA-Temperatur zu, was auf den verringerten Source/Drain-Widerstand und die verbesserte Trägermobilität bei der höheren Tempertemperatur zurückzuführen ist.
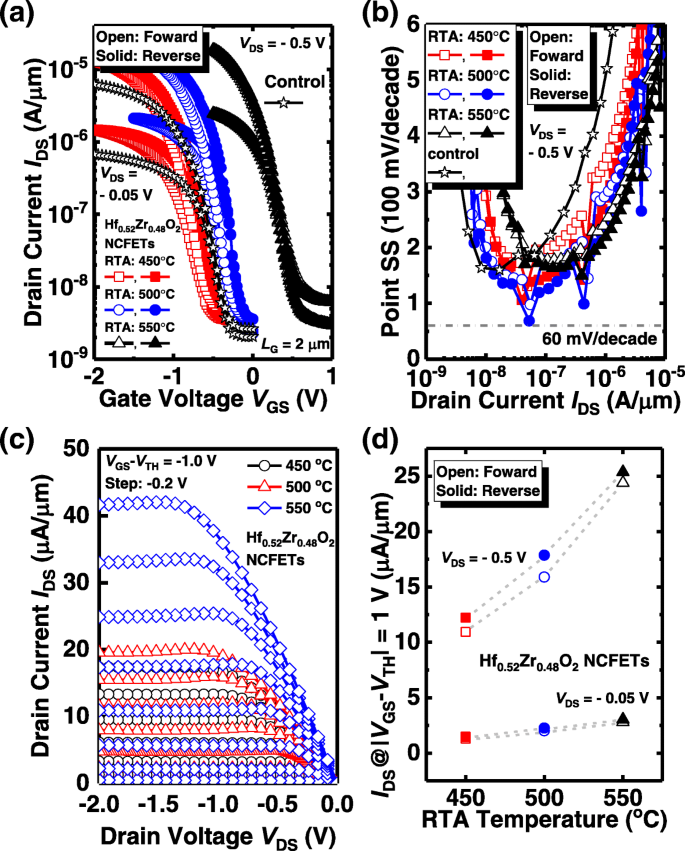
(a ) Gemessen I DS -V GS Kurven für NCFETs mit Hf0,52 Zr0,48 O2 Ferroelektrik und Steuergerät. (b ) Punkt SS vs. I DS Kurven zeigen, dass NCFETs im Vergleich zu Steuer-MOSFETs die steilere SS aufweisen. (c ) Ich DS -V DS Kurven für die NCFETs, die die typischen NDR-Phänomene zeigen. (d ) Vergleich des I DS für die NCFETs getempert bei verschiedenen Temperaturen bei einem Gate-Overdrive von 1 V
Zusätzlich zu Hf0,52 Zr0,48 O2 ferroelektrischen Transistor untersuchen wir auch die elektrischen Eigenschaften von Ge-NC-Transistoren mit dem Hf0.33 Zr0,67 O2 ferroelektrisch. Abbildung 5(a) zeigt das I DS -V GS Eigenschaften der Geräte mit Hf0.33 Zr0,67 O2 mit den unterschiedlichen Glühtemperaturen bei V DS = − 0.05 V und − 0.5 V. Im Vergleich zu Hf0.52 Zr0,48 O2 NC-Transistoren wird eine noch kleinere Hysterese erhalten. Ähnlich dem Hf0,52 Zr0,48 O2 NC-Transistoren, wenn die Glühtemperatur von 450 auf 550 °C ansteigt, V TH des Geräts steigt von − 0,63 V auf 0,51 V im Vorwärts-Sweep bei V DS = − 0.05 V Punkt SS als Funktion von I DS Eigenschaften für Hf0,33 Zr0,67 O2 ferroelektrische NCFETs sind in Fig. 5(b) dargestellt. Darüber hinaus erzielen Geräte mit 450°C und 500°C Glühtemperatur den deutlicheren plötzlichen Abfall des SS im Vergleich zu dem 550°C geglühten Transistor. Die plötzlichen Abfallpunkte bei unterschiedlichen Glühtemperaturen treten bei derselben Gatespannung auf. Abbildung 5(c) zeigt vorwärts und rückwärts I DS des Hf0,33 Zr0,67 O2 NCFETs bei V DS = − 0.05 V und − 0.5 V und |V GS –V TH | = 1.0 V. Ob für das Vorwärts- oder Rückwärts-Sweepen, das I DS steigt mit der Glühtemperatur, was mit der Charakteristik des Hf0,52 . übereinstimmt Zr0,48 O2 Gerät.
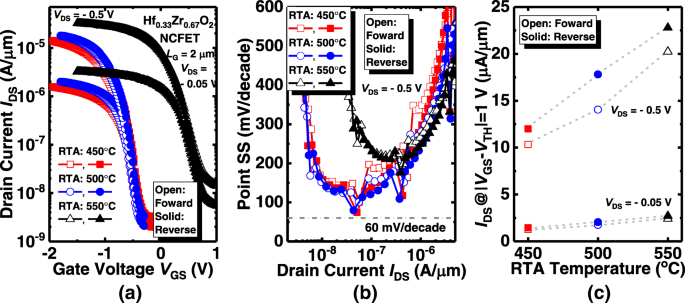
(a ) Gemessene Übertragungseigenschaften des Hf0,33 Zr0,67 O2 NC-Ge-pFETs getempert von 450 bis 550 °C. (b ) Punkt SS als Funktion von I DS für Hf0,33 Zr0,67 O2 Geräte. (c ) Ich DS für die ferroelektrischen NC-Transistoren mit unterschiedlichen Glühtemperaturen bei einem Gate-Overdrive von 1 V
Wir untersuchen auch die elektrische Leistung von Ge-NCFET mit der kleineren Zr-Zusammensetzung. Die Übertragungseigenschaften des Hf0,67 Zr0,33 O2 Bei unterschiedlichen Glühtemperaturen geglühte NCFETs sind in Fig. 6(a) dargestellt. Es wird kein Hysteresephänomen beobachtet. Im Vergleich zu Hf0,33 Zr0,67 O2 und Hf0,52 Zr0,48 O2 Geräte, die V TH Die durch unterschiedliche Glühtemperatur induzierte Verschiebung ist bei Hf0,67 . weniger ausgeprägt Zr0,33 O2 NCFETs. Punkt SS vs. I DS Kurven in Abb. 6(b) zeigen, dass Hf0,67 Zr0,33 O2 Der NC-Transistor zeigt den plötzlichen Abfall an einigen Punkten von SS des NC-Transistors bei V DS = − 0.05 V. Abbildung 6(c) zeigt das I DS von Hf0,67 Zr0,33 O2 Ge-NCFETs getempert bei 450°C, 500°C und 550°C, bei V DS = − 0.05 V und − 0.5 V und |V GS –V TH | = 1.0 V. Ebenso I DS erhöht sich, wenn die RTA-Temperatur steigt.
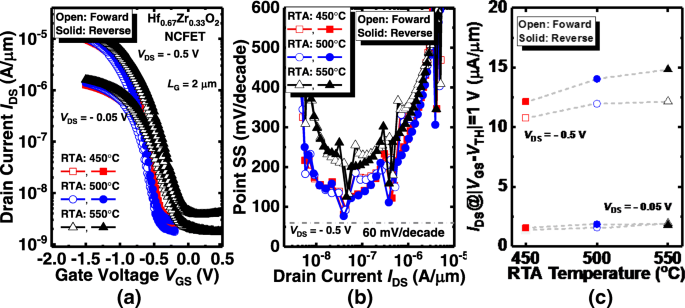
(a ) Gemessen I DS -V GS des Hf0,67 Zr0,33 O2 NC Ge pFETs getempert bei 450°C, 500°C und 550°C. (b ) Punkt SS vs. IDS Eigenschaften der Geräte. (c ) Ich DS für die ferroelektrischen NC-Transistoren mit unterschiedlichen Glühtemperaturen bei einem Gate-Overdrive von 1 V
Die Stabilität des durch die ferroelektrische Schicht des Hf0,52 . induzierten NC-Effekts Zr0,48 O2 NCFET wurde durch mehrere DC-Sweep-Messungen verifiziert. Das gemessene Ich DS -V GS Kurven über 100 Zyklen des DC-Wobbelns sind in Fig. 7(a) gezeigt. Es ist ersichtlich, dass die Werte von V GS entsprechenden steilen SS sind konsistent. Außerdem ist das im Uhrzeigersinn laufende I-V Schleifen werden durch die mehreren DC-Sweeps aufrechterhalten. Die steilen SS-Punkte sind über mehrere DC-Sweeps wiederholbar und stabil, was weiter beweist, dass sie durch den NC-Effekt induziert werden. Abbildung 7(b) zeigt den besten Punkt SS und den besten Treiberstrom über die Anzahl der Wobbelzyklen. Abbildung 7(c) zeigt die Hystereseeigenschaften als Funktion der Anzahl der DC-Sweepzyklen. Stabiles I-V Hysteresefenster von ~ 82 mV werden gesehen.
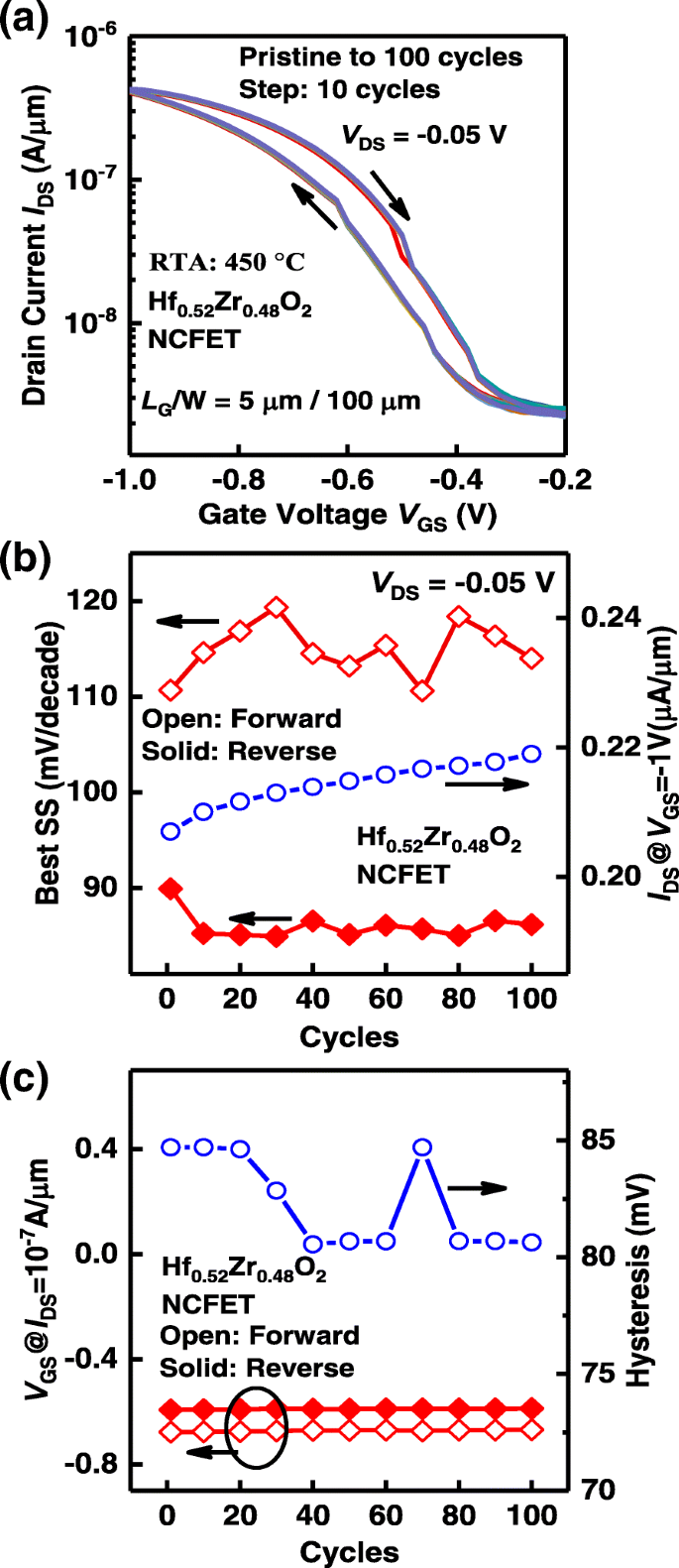
(a ) Gemessen I DS -V GS Kurven eines Hf0,52 Zr0,48 O2 NC Ge pFET über 100 Zyklen DC-Sweep. (b ) Bester Punkt SS und I DS vs. Zyklusnummer. (c ) Hysteresecharakteristik in Abhängigkeit von der Anzahl der DC-Sweepzyklen
Wir fassen die Hysterese- und Ansteuerstromcharakteristik von Ge-NCFETs mit unterschiedlichen Zr-Zusammensetzungen in Hf1−x . zusammen Zrx O2 in Abb. 8. Wie in Abb. 8(a) gezeigt, betragen die Hysteresewerte 70, 148 und 106 mV für Geräte mit x = 0,33, 0,48 bzw. 0,67 bei einem V DS von – 0,5 V. Mit zunehmender Zusammensetzung von 0,33 auf 0,48 erhöht sich die Hysterese der NC-Vorrichtung deutlich. Mit der weiteren Zunahme der Zr-Zusammensetzung nimmt die Hysterese schnell ab. Das Ich DS der bei 450°C getemperten NCFETs ist in Abb. 8(b) bei V . aufgetragen DS = − 0. 5 V und V GS − V TH = − 1. 0 V. Offen und durchgehend stehen für Vorwärts- bzw. Rückwärts-Sweep. Das NC-Gerät mit Hf0.52 Zr0,48 O2 erreicht das höchste I DS , aber seine Hysterese ist ernst. NCFET mit Hf0,67 Zr0,33 O2 kann mit hysteresefreien Kurven und hohem I . eine hervorragende Leistung erzielen DS . Mit zunehmender Zr-Zusammensetzung steigt die ferroelektrische Kapazität C fe (= 0,3849*P r /(E c *t fe ) [24]) steigt mit zunehmendem P r , und währenddessen die MOS-Kapazität (C MOS ) steigt ebenfalls aufgrund der wachsenden Permittivität des HZO-Films. Das Ich DS und Hysterese werden bestimmt durch |C fe | und C MOS des Transistors. Mit zunehmender Zr-Zusammensetzung von 0,33 auf 0,48 steigt die Zunahme von |C fe | wird spekuliert, dass es langsamer ist als das C MOS , was zur Verbreiterung der Hysterese führt. Trotzdem ist das größere C MOS erzeugt ein höheres Ich DS . Mit der weiteren Zunahme der Zr-Zusammensetzung wird die Zunahme von |C fe | ist schneller als C MOS , die |C . bereitstellen könnte fe | ≥ C MOS , wodurch die Hysterese des NCFET reduziert wird.
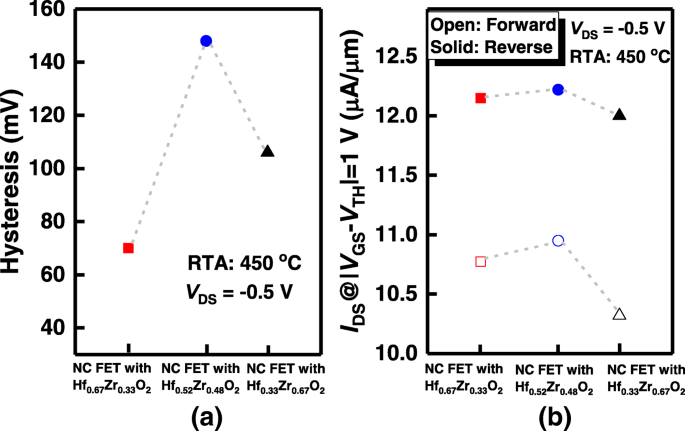
Statistische Diagramme von (a ) Hysterese und (b ) Ich DS von Ge-NCFET mit Hf1−x Zrx O2 (x = 0,33, 0,48 und 0,67)
Schlussfolgerungen
Die Auswirkungen der Glühtemperatur und der Zr-Zusammensetzung in Hf1–x Zrx O2 zur elektrischen Leistung der Ge-NCFETs experimentell untersucht. Die Stöchiometrien und ferroelektrischen Eigenschaften von Hf1−x Zrx O2 wurden von XPS und P-V bestätigt Messungen bzw. NCFETs demonstrieren den Steilpunkt SS und das verbesserte I DS im Vergleich zum Steuergerät aufgrund des NC-Effekts. Das V TH und ich DS des Hf1−x Zrx O2 NCFET werden stark von der Glühtemperatur beeinflusst. Mehrere DC-Sweep-Messungen zeigen, dass die Stabilität des durch die ferroelektrische Schicht induzierten NC-Effekts im NCFET erreicht wird. Hf0,67 Zr0,33 O2 NCFET kann die hysteresefreien Eigenschaften leichter erreichen als die Geräte mit einer höheren Zr-Zusammensetzung.
Abkürzungen
- Al2 O3 :
-
Aluminiumoxid
- ALD:
-
Atomlagenabscheidung
- BF2 + :
-
Borfluoridion
- DC:
-
Gleichstrom
- Ge:
-
Germanium
- GeOx :
-
Germaniumoxid
- HF:
-
Flusssäure
- HfO2 :
-
Hafniumdioxid
- HRTEM:
-
Hochauflösendes Transmissionselektronenmikroskop
- MOSFETs:
-
Metall-Oxid-Halbleiter-Feldeffekttransistoren
- NC:
-
Negative Kapazität
- Ni:
-
Nickel
- SS:
-
Schwung unter der Schwelle
- TaN:
-
Tantalnitrid
- TDMAHf:
-
Tetrakis (dimethylamido) hafnium
- TDMAZr:
-
Tetrakis (Dimethylamido) Zirkonium
Nanomaterialien
- Elektrische Felder und Kapazität
- Kapazitätsbeeinflussende Faktoren
- Digitale (EIN/AUS) Hall-Effekt-Geräte:Schalter und Verriegelungen
- Hall-Effekt-Positionserkennung:Antwortlinearität und Steigung für Slide-By-Konfigurationen
- Luftabstandshalter für 10-nm-Chips
- Ein Nanometersprung auf Billionen von Transistoren
- Auswirkung von UV-Bestrahlung auf die Eigenschaften von 4H-SiC-PiN-Dioden
- Auswirkung einer In-situ-Annealing-Behandlung auf die Mobilität und Morphologie von TIPS-Pentacen-basierten organischen Feldeffekttransistoren
- Wirkung von Polyethylenglykol auf die NiO-Photokathode
- Theoretische Untersuchung von biaxial zugbelasteten Germanium-Nanodrähten



