Ferroelektrische ZrO2-Feldeffekttransistoren, die durch die schaltbaren Sauerstoff-Leerstellen-Dipole ermöglicht werden
Zusammenfassung
In diesem Artikel werden die Auswirkungen von Post-Rapid Thermal Anneal (RTA) und die Dicke von ZrO2 . untersucht zur Polarisation P und elektrische Eigenschaften von TaN/ZrO2 /Ge-Kondensatoren bzw. FeFETs. Nach dem RTA im Bereich von 350 bis 500 °C, TaN/ZrO2 /Ge-Kondensatoren mit 2,5 und 4 nm dickem amorphem ZrO2 Film zeigen das stabile P . Es wird vermutet, dass das ferroelektrische Verhalten von der Wanderung der spannungsgesteuerten Dipole herrührt, die durch die Sauerstoffleerstellen und negativen Ladungen gebildet werden. FeFETs mit 2,5 nm, 4 nm und 9 nm ZrO2 demonstrieren das ordentliche Speicherfenster (MW) mit 100 ns Programmier-/Löschimpulsen. Ein 4 nm dickes ZrO2 FeFET hat im Vergleich zu Geräten mit 2,5 nm und 9 nm ZrO2 . deutlich verbesserte Ermüdungs- und Retentionseigenschaften . Die Retentionsleistung des ZrO2 FeFET kann mit der Erhöhung der RTA-Temperatur verbessert werden. Ein MW von ~ 0,46 V wird extrapoliert, um für das Gerät mit 4 nm ZrO2 . über 10 Jahre aufrechterhalten zu werden .
Hintergrund
Dotiertes Poly-HfO2 Ferroelektrische Feldeffekttransistoren (FeFETs) haben aufgrund ihrer CMOS-Prozesskompatibilität großes Interesse in den Anwendungen nichtflüchtiger Speicher (NVM) geweckt [1]. Obwohl die anständige elektrische Leistung in dotiertem HfO2 . nachgewiesen wurde, -basierten FeFETs [2], beeinträchtigen einige grundlegende Einschränkungen ihre praktische Anwendung noch immer, einschließlich des hohen thermischen Budgets von 500 °C Glühen, das zur Bildung orthorhombischer Kristallphasen erforderlich ist, und des unerwünschten Leckstroms entlang der Korngrenzen bei der Verkleinerung der ferroelektrischen Dicke. Ferroelektrizität wurde in vielen verschiedenen Materialien beobachtet, z. B. Sb2 S3 Nanodrähte [3], GaFeO3 Film [4], LaAlO3 -SrTiO3 Film [5] und amorphes Al2 O3 mit Nanokristallen [6, 7]. Kürzlich haben wir über FeFETs mit teilweise kristallisiertem ZrO2 . berichtet Gate-Isolator als NVM und analoge Synapse [8]. Obwohl das ZrO2 Transistoren zeigten eine anständige elektrische Leistung bei geringerer Dicke im Vergleich zu dem berichteten dotierten HfO2 , der zugrunde liegende Mechanismus für die Ferroelektrizität in ZrO2 Film bleibt unklar. Es ist kritisch und wichtig, den Ursprung der schaltbaren Polarisation P . aufzuklären zur Bewertung der Leistungsgrenze von ZrO2 FeFETs.
In dieser Arbeit wird TaN/ZrO2 /Ge-FeFETs mit 2,5 nm, 4 nm und 9 nm dicken Isolatoren werden hergestellt. Das umschaltbare P in TaN/ZrO2 Es wird vermutet, dass der /Ge-Kondensator aus der Wanderung von spannungsgesteuerten Sauerstoffleerstellen und negativen Ladungen stammt. Die Auswirkungen von ZrO2 Dicke und das Post-Rapid Thermal Annealing (RTA) auf der P von TaN/ZrO2 /Ge und das Speicherfenster (MW), die Lebensdauer und die Retentionseigenschaften von FeFETs werden untersucht.
Methoden
FeFETs mit ZrO2 Gate-Isolator wurden auf 4-in. n-Ge(001)-Substrat unter Verwendung eines ähnlichen Verfahrens in [8, 9]. Nach der Pre-Gate-Reinigung in der verdünnten HF-Lösung (1:50) wurden Ge-Wafer in eine Atomlagenabscheidungskammer (ALD) geladen. ZrO2 Filme mit Dicken von 2,5 nm, 4 nm und 9 nm wurden bei 250 °C unter Verwendung von TDMAZr und H2 . abgeschieden O als Vorläufer von Zr bzw. O. Durch reaktives Sputtern wurde eine 100 nm dicke TaN-Gate-Elektrode abgeschieden. Nach der Gateelektrodenbildung wurden die Source/Drain-(S/D)-Gebiete durch BF2 . implantiert + bei einer Dosis von 1 × 10 15 cm −2 und eine Energie von 20 keV. Insgesamt 15 nm Nickel (Ni) S/D-Kontakte wurden durch einen Abhebeprozess gebildet. Schließlich wurde die RTA bei 350, 450 und 500 °C für 30 s durchgeführt.
Abbildung 1 a zeigt das Schema des hergestellten Transistors. Abbildung 1b–d zeigt die Transmissionselektronenmikroskop(TEM)-Aufnahmen von TaN/ZrO2 /Ge-Proben mit 2,5, 4 und 9 nm dickem ZrO2 , bzw. Alle Proben wurden 30 Sekunden lang einer RTA bei 500 °C unterzogen. Das 2,5 nm ZrO2 Probe bleibt nach dem Tempern ein Isolatorfilm. Für die 4 -nm-Probe wurden zwar einige Nanokristalle beobachtet, ZrO2 bleibt eine amorphe Schicht. Während für das 9 nm ZrO2 . eine vollständige Kristallisation auftritt Film. Insbesondere eine Grenzschicht (IL) aus GeOx existiert zwischen dem ZrO2 und Ge-Kanalbereich, obwohl er zu dünn ist, um in den TEM-Bildern beobachtet zu werden.
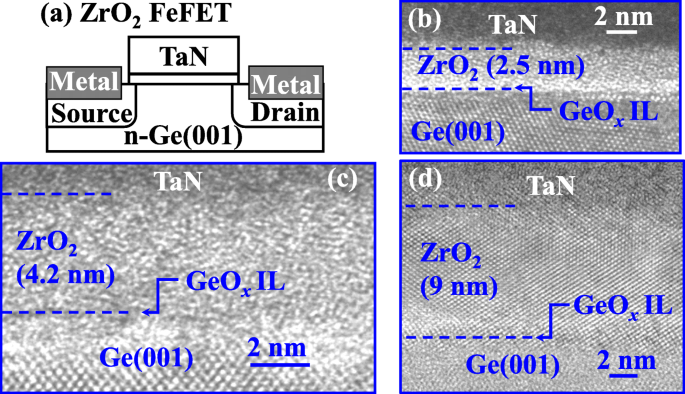
a Schema des hergestellten TaN/ZrO2 /GeFeFET. b , c , und d HRTEM-Bilder von TaN/ZrO2 /Ge-Stapel mit unterschiedlichem ZrO2 Dicken. Die Proben wurden 30 s lang einer RTA bei 500 °C unterzogen
Ergebnisse und Diskussion
Abbildung 2 zeigt das P vs. Spannung (V ) Kurven für TaN/ZrO2 /Ge-Kondensatoren mit unterschiedlichem ZrO2 Dicken und unterschiedliche Glühtemperaturen. Die durchgezogenen Linien mit unterschiedlichen Farben stellen die kleineren Schleifen mit verschiedenen Wobbelspannungsbereichen dar (V Bereich ). Die Messfrequenz beträgt 1 kHz. Die 2,5 nm und 4 nm ZrO2 Geräte können nach einem RTA bei 350 °C eine stabile Ferroelektrizität aufweisen. Abbildung 3 zeigt den Rest P (P r ) als Funktion des geschwungenen V Bereichskurven für Kondensatoren, die bei verschiedenen Temperaturen geglüht wurden.

Gemessener P vs. V Eigenschaften von TaN/ZrO2 /Ge-Kondensatoren mit unterschiedlichem ZrO2 Dicken und verschiedene Glühtemperaturen
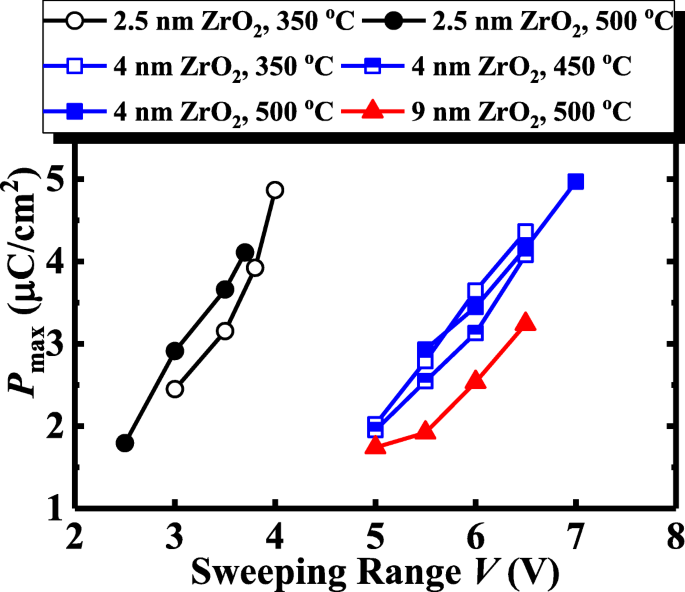
Vergleich von P max als Funktion von V Bereich für TaN/ZrO2 /Ge-Kondensatoren mit unterschiedlichem ZrO2 Dicken und verschiedene Glühtemperaturen
Abbildung 3 zeigt den Vergleich von P max als Funktion von V Bereich für TaN/ZrO2 /Ge-Kondensatoren mit den unterschiedlichen ZrO2 Dicken und die verschiedenen RTA-Temperaturen. Für das 4 nm ZrO2 Geräten, wenn die Glühtemperatur von 350 auf 450 °C ansteigt, wird ein größeres V Bereich ist erforderlich, um ein festes P zu erhalten max . Dies wird der Tatsache zugeschrieben, dass die höhere Glühtemperatur die dickeren Grenzflächenschichten (ILs) zwischen bei Ge/ZrO2 . erzeugt und ZrO2 /TaN-Schnittstellen, was zu einer größeren einheitlichen kapazitätsäquivalenten Dicke (CET) führt. Für das 2,5 nm ZrO2 Kondensatoren hat die Probe mit 500 °C Glühen eine niedrigere V Bereich als die 350 °C-Glühprobe mit dem gleichen P max . Obwohl die ILs mit der erhöhten RTA-Temperatur dicker werden, sind einige ZrO2 wurde durch das Einfangen von Sauerstoff und die Interdiffusion an der Grenzfläche verbraucht. Für das sehr dünne ZrO2 Gerät, letzteres ist dominant. Im Vergleich zu 2,5 nm ZrO2 Kondensator, ein viel größeres V Bereich ist erforderlich, um ein ähnliches P zu erreichen max . Das 9 nm ZrO2 Kondensator weist nicht die höhere V . auf Bereich im Vergleich zum 4 nm-Gerät. Dies liegt am Kristall ZrO2 das hat einen viel höheren κ Wert als der amorphe Film, was die CET des 9 nm-Bauelements erheblich reduziert.
Abbildung 4a zeigt die extrahierte Entwicklung des positiven und negativen P r , bezeichnet mit \( {P}_{\mathrm{r}}^{+} \) bzw. \( {P}_{\mathrm{r}}^{-} \) für die 4 nm- dickes ZrO2 Kondensatoren mit RTA bei verschiedenen Temperaturen über 10 6 Wobbelzyklen gemessen bei 1 kHz. Geräte, die bei 350 °C und 450 °C getempert wurden, zeigen den offensichtlichen Wake-up-Effekt. Für das 4 nm ZrO2 . wird kein Aufwachen oder Abdruck beobachtet Ferroelektrischer Kondensator wurde bei 500 °C geglüht. Abbildung 4b vergleicht das P r als Funktion der Sweep-Zyklen für die Geräte mit den unterschiedlichen ZrO2 Dicken. Das 4 nm ZrO2 ferroelektrischer Kondensator erreicht verbesserte Stabilität von P r Ausdauer im Vergleich zu den 2,5 nm- und 9 nm-Geräten während der 10 6 Dauertest.

a P r vs. die Anzahl der ms-Impuls-Sweep-Zyklen für 4 nm ZrO2 Kondensatoren mit unterschiedlichen RTA-Temperaturen. b P r vs. Anzahl der ms-Impuls-Sweep-Zyklen für das ZrO2 Kondensatoren nach dem Glühen bei 500 °C
Das Umschalten P wird in amorphem ZrO2 . beobachtet Kapazität, und es wird gefolgert, dass sich der Mechanismus von dem des berichteten dotierten Poly-HfO2 . unterscheiden muss ferroelektrische Filme. Wir schlagen vor, dass der zugrunde liegende Mechanismus für das ferroelektrische Verhalten mit den Sauerstoffleerstellendipolen zusammenhängt. Es ist allgemein bekannt, dass die Ta-Sauerstofffängerschichten beim Abscheiden von TaN-Metall die Sauerstoffleerstellenkonzentration im Inneren von ZrO2 . erhöhen [10]. Sauerstoff-Leerstellen treten auch am ZrO2 . auf /Ge-Schnittstelle. Abbildung 5 zeigt den Schaltplan des schaltbaren P in TaN/ZrO2 /Ge entsteht aus der Wanderung von Sauerstoffleerstellen und negativen Ladungen, um die positiven und negativen Dipole zu bilden. Es wird spekuliert, dass die negativen Ladungen in ZrO2 beziehen sich auf die Zr-Leerstelle [11], die denen in Al2 . ähnelt O3 Film [12]. Die Migration der spannungsgesteuerten Sauerstoffleerstellen wurde in resistiven Direktzugriffsspeicherbausteinen weithin demonstriert [13, 14]. Dies ist insbesondere die erste Demonstration von nichtflüchtigen Transistoren mit drei Anschlüssen, die von spannungsgesteuerten Sauerstoffleerstellen dominiert werden.
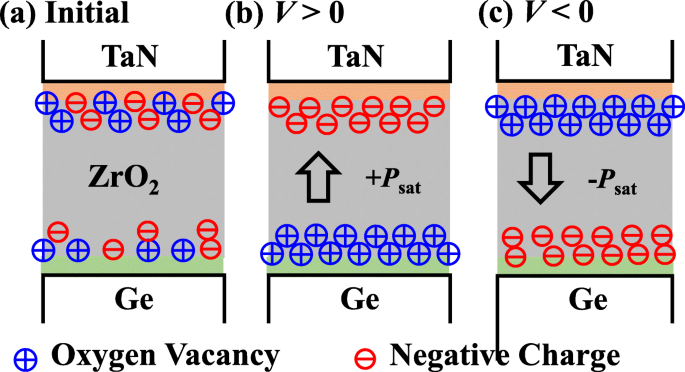
Schema des Mechanismus für schaltbares P in ZrO2 Kondensatoren, was auf die Wanderung von spannungsgesteuerten Sauerstoffleerstellen und negativen Ladungen zu Dipolen zurückgeführt wird
Die P-V Hysterese aktiviert das ZrO2 FeFETs, um ein großes und stabiles MW für eingebettete NVM (eNVM)-Anwendungen zu erhalten. Abbildung 6 zeigt das gemessene I DS -V GS Kurven von 2.5, 4 und 9 nm ZrO2 FeFETs für die beiden Polarisationszustände mit 1 μs Program/Erase (P/E) Bedingungen. Die Transistoren wurden bei 500 °C getempert. Der Programmier-(Lösch-)Betrieb wird durch Anlegen positiver (negativer) Spannungsimpulse an das Gate des ZrO2 . erreicht FeFETs, um ihre Schwellenspannung (V TH ). V TH ist definiert als V GS bei 100 nA·W/L, und MW ist definiert als die maximale Änderung von V TH . Alle FeFETs mit verschiedenen ZrO2 Dicken haben das MW über 1 V mit 1 μs P/E-Pulsen. Um ein ähnliches MW zu erreichen, wird eine höhere Löschspannung für das 9 nm ZrO2 . benötigt FeFET im Vergleich zu den anderen beiden Transistoren. Es ist zu sehen, dass ein größerer Betrag V . löscht GS ist erforderlich, um die ungefähr gleiche Verschiebung von I-V . zu erhalten relativ zur Ausgangskurve im Vergleich zum Programm V GS . Es wird spekuliert, dass die Sauerstoffleerstellen zum P . beitragen stammen hauptsächlich aus der Reaktion zwischen TaN und ZrO2 , wie der Ausgangszustand des Gerätes in Abb. 5a. Als positives V GS (Programm) angewendet wird, diffundieren die Sauerstoffleerstellen und reichern sich in der Schicht in der Nähe des ZrO2 . an /Ge-Grenzfläche (Abb. 5b), bei der sich die Verteilung der Sauerstoffleerstellendipole stark vom Ausgangszustand unterscheidet. So ist es einfach, das I-V . zu verschieben Kurve zu einem höheren |V TH | mit positivem V GS . Als negatives V GS (Erase) angewendet wird, bringt die Rückdiffusion von Sauerstoff-Leerstellen den Gate-Stack wieder in seinen ursprünglichen Zustand (Abb. 5c). Also die Größe der negativen Löschung V GS muss erhöht werden, um die äquivalente Verschiebung von I-V . zu erreichen zum positiven Programm V GS .
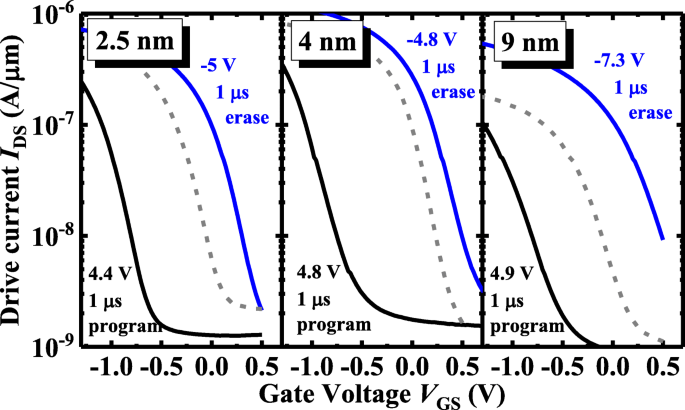
Gemessen I DS -V GS Kurven des 2,5, 4 und 9 nm dicken ZrO2 FeFETs für den Anfangs- und zwei Polarisationszustände mit 1 μs P/E-Pulsen
Wenn die P/E-Pulsbreite auf 100 ns reduziert wird, wird das ZrO2 FeFETs zeigen immer noch das ordentliche MW, wie in Abb. 7a gezeigt. Insbesondere der Transistor mit 2,5 nm ZrO2 getempert bei 350 °C erreicht ein MW von 0,28 V. Abbildung 7b zeigt MW vs. Zyklenzahl für die FeFETs mit verschiedenen ZrO2 Dicken mit 100 ns P/E-Pulsbedingung. Das 4 nm ZrO2 Gerät erreicht eine deutlich verbesserte Ausdauerleistung im Vergleich zu 2,5 nm und 9 nm ZrO2 FeFETs, die innerhalb von 10 3 . den offensichtlichen Weckeffekt und Ermüdung zeigen Zyklen.
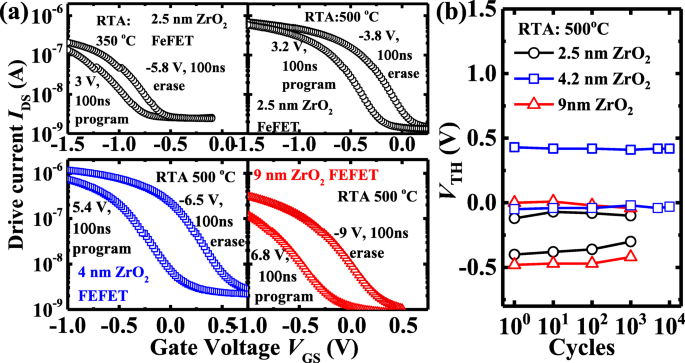
a Ich DS -V GS Kurven des 2,5, 4 und 9 nm dicken ZrO2 FeFETs für die beiden Polarisationszustände mit 100 ns P/E-Pulsen. Die Geräte wurden einem RTA bei 500 °C unterzogen. b FeFET mit 4 nm ZrO2 hat eine verbesserte Lebensdauer im Vergleich zu 2,5 und 9 nm ZrO2 Transistoren
Schließlich die Retentionsprüfung des ZrO2 FeFETs ist in den Fig. 1 und 2 charakterisiert und gezeigt. 8 und 9. Abbildung 8 a zeigt die Entwicklung von I DS -V GS Kurven für die beiden Polarisationszustände des 4 nm ZrO2 FeFETs durchliefen RTA bei 350, 450 und 500 °C. Das Charge Trapping führt mit der Zeit zur Verkleinerung der Geräte. Wie in 8b gezeigt, kann die Rückhalteleistung der Vorrichtungen mit der Erhöhung der RTA-Temperatur verbessert werden. Ein MW von ~ 0,46 V wird extrapoliert, um über 10 Jahre aufrechterhalten zu werden. Abbildung 9 vergleicht die Retentionseigenschaften der FeFETs mit verschiedenen ZrO2 Dicken. Das 4 nm ZrO2 Gerät hat eine verbesserte Retentionsleistung im Vergleich zu den Transistoren mit 2,5 und 9 nm dickem ZrO2 .
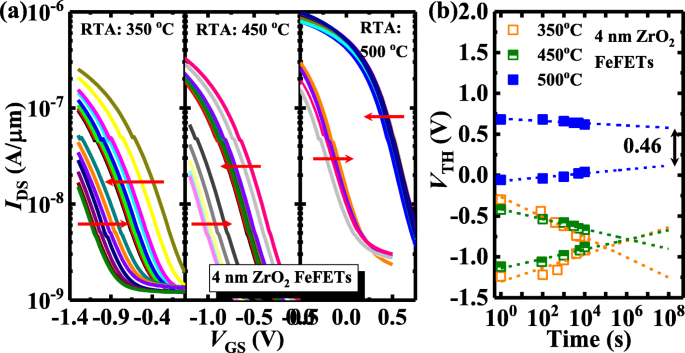
a Die Entwicklung von Ich DS -V GS Kurven für die beiden Polarisationszustände des 4 nm ZrO2 FeFETs mit unterschiedlichen RTA-Temperaturen. b Das 4 nm ZrO2 bei 500 °C getemperte Vorrichtung hat eine viel bessere Retentionsleistung im Vergleich zu den Transistoren mit RTA bei den niedrigeren Temperaturen
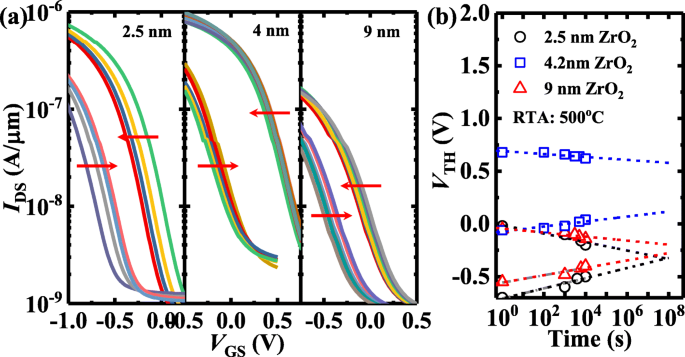
a Die Entwicklung von Ich DS -V GS Kurven für die beiden Polarisationszustände für das 2,5, 4 und 9 nm dicke ZrO2 FeFETs wurden einer RTA bei 500 °C unterzogen. b Das 4 nm ZrO2 Gerät hat eine verbesserte Retentionsleistung im Vergleich zu den Transistoren mit 2,5 und 9 nm dickem ZrO2
Schlussfolgerungen
Zusammenfassend lässt sich sagen, dass amorphes ZrO2 ferroelektrische Kondensatoren werden experimentell nachgewiesen, und es wird spekuliert, dass die Ferroelektrizität auf die Wanderung der spannungsgesteuerten Dipole zurückzuführen ist, die durch die Sauerstoffleerstellen und negativen Ladungen gebildet werden. FeFETs mit 2,5 nm, 4 nm und 9 nm ZrO2 haben das MW über 1 V mit 1 μs P/E-Pulsen. Die verbesserten Ermüdungs- und Retentionseigenschaften werden in dem 4 nm dicken ZrO2 . erreicht FeFET im Vergleich zu den Geräten mit 2.5 nm und 9 nm ZrO2 . Der Retentionstest zeigt, dass das 4 nm ZrO2 Transistor hält ein extrapoliertes 10-Jahres-MW von ~ 0,46 V.
Verfügbarkeit von Daten und Materialien
Die Datensätze, die die Schlussfolgerungen dieses Artikels unterstützen, sind im Artikel enthalten.
Abkürzungen
- RTA:
-
Schnelles thermisches Glühen
- IL:
-
Grenzschicht
- TaN:
-
Tantalnitrid
- FeFET:
-
Ferroelektrische Feldeffekttransistoren
- TDMAZr:
-
Tetrakis (Dimethylamido) Zirkonium
- Ge:
-
Germanium
- ZrO2 :
-
Zirkoniumdioxid
- ALD:
-
Atomlagenabscheidung
- HF:
-
Flusssäure
- BF2 + :
-
Borfluoridion
- MW:
-
Speicherfenster
- NVM:
-
Nichtflüchtiger Speicher
- P r :
-
Restpolarisation
- TEM:
-
Transmissionselektronenmikroskop
- Ni:
-
Nickel
- P max :
-
Maximale Polarisation
- RTA:
-
Vergütetes thermisches Glühen
- V Bereich :
-
Sweep-Spannungsbereich
Nanomaterialien
- Webfähiges DDS, das IoT und die Cloud
- Transistoren, Sperrschicht-Feldeffekt (JFET)
- Transistoren, Feldeffekt mit isoliertem Gate (IGFET oder MOSFET)
- Übergangs-Feldeffekttransistoren
- Feldeffekttransistoren mit isoliertem Gate (MOSFET)
- Einführung in Junction-Feldeffekttransistoren (JFET)
- Einführung in Feldeffekttransistoren mit isoliertem Gate
- Abstimmung der Toxizität reaktiver Sauerstoffspezies auf eine fortgeschrittene Tumortherapie
- Mehrschichtige SnSe-Nanoflake-Feldeffekttransistoren mit niederohmigen Au-Ohm-Kontakten
- Die Vorteile der Sauerstofferzeugung vor Ort



