Variation der Mikrostruktur und der mechanischen Eigenschaften von Ti-Al-N-Filmen, die durch eine HF-ICP-Ionenquelle mit verstärkter reaktiver Stickstoffplasmaatmosphäre induziert werden
Zusammenfassung
Das Erlangen der optimalen Wachstumsbedingungen von Ti-Al-N-Schichten, der Auswirkungen der Gasatmosphäre, insbesondere des reaktiven Plasmas auf die Materialmikrostrukturen, und der mechanischen Eigenschaften sind immer noch ein grundlegendes und wichtiges Thema. In dieser Studie werden Ti-Al-N-Filme reaktiv durch ein verbessertes Sputtersystem mit induktiv gekoppelter Hochfrequenz-Plasma-Ionenquelle (RF-ICPIS) abgeschieden. Es werden unterschiedliche Stickstoffgasströmungsraten beim Einlassen in die Ionenquelle verwendet, um Stickstoffplasmadichten zu erhalten und die Abscheidungsatmosphäre zu ändern. Es wurde festgestellt, dass der Gehalt an Stickstoffelementen in den Filmen stark von der Stickstoffplasmadichte beeinflusst wird und der Maximalwert bei hohen Gasströmungsbedingungen bis zu 67,8% erreichen kann. XRD-Spektren und FESEM-Bilder zeigen, dass eine niedrige Plasmadichte von Vorteil für die Filmkristallisation und dichte Mikrostruktur ist. Darüber hinaus werden die mechanischen Eigenschaften wie Härte und tribologische Leistung durch die Anpassung der Stickstoffatmosphäre gegenseitig verbessert.
Einführung
Aufgrund der respektablen mechanischen Eigenschaften wie hoher Härte, Korrosionsschutz und überlegener Oxidationsbeständigkeit hat Ti-Ai-N beim Trocken- und Hochgeschwindigkeitsschneiden als Oberflächenschutzfilme für Werkzeugmaschinen große Anziehungskraft auf sich gezogen [1,2,3]. Heutzutage wurden verschiedene Techniken zur Herstellung von Ti-Al-N-Filmen entwickelt, darunter chemische Gasphasenabscheidung [4], Lichtbogenverdampfung [5], Ionenplattierung [6] und reaktives DC/RF-Sputtern [7]. Während der Abscheidung des Ti-Al-N-Films ist die Gasatmosphäre ziemlich wichtig und komplex [8,9,10,11,12]. Bei der reaktiven Zerstäubungsabscheidung beispielsweise hängt das Nichtgleichgewichts-Stickstoffplasma nicht nur von der Argon- oder Stickstoffionenkonzentration ab, sondern auch von der Sekundärelektronendichte oder dem Gesamtgasdruck, die die Schwierigkeiten beim Verständnis der induzierten reaktiven Stickstoffatmosphäre erschweren die Variation der Ti-Al-N-Filmeigenschaften. Jeonget al. haben über die Wachstumsmorphologie von Ti-Al-N-Filmen berichtet, die von Stickstoffflussraten beeinflusst wurde [13]. Irudayarajet al. haben festgestellt, dass die Abscheidungsrate, die Korngröße und das Konzentrationsverhältnis von Ti zu Al der abgeschiedenen Ti-Al-N-Filme mit zunehmendem N2 . abnahmen Durchflussmenge [14]. Da es wichtig ist, wertvolles Wissen für die Auswahl optimaler Wachstumsbedingungen zu gewinnen, müssen die Auswirkungen der Stickstoffatmosphäre, insbesondere die reaktive Plasmadichte auf die Materialelementgehalte und die entsprechenden Mikrostrukturen und mechanischen Eigenschaften von Ti-Al-N noch weiter erforscht werden .
In unserer früheren Arbeit wurde verifiziert, dass eine induktiv gekoppelte Hochfrequenz-Plasma-Ionenquelle (RF-ICPIS) die Ti-Al-N-Abscheidung verbessert, indem die Argon-Ionisationstemperatur gesenkt und die Ionisationsraten erhöht werden [15]. In diesem Artikel ionisieren wir Stickstoffgas direkt in einem entladenen RF-ICPIS-Hohlraum, und ein dichter Stickstoffplasmastrahl wird direkt in die reaktive Kammer eingeleitet, um an der reaktiven Abscheidung teilzunehmen. Im Vergleich zu herkömmlichen HF/DC-Sputtersystemen kann die von HF-ICPIS bereitgestellte Stickstoffplasmadichte leicht durch Ändern der HF-Leistungen oder Gasflussraten gesteuert werden. Die Einflüsse der Stickstoffplasmavariation auf die Elementgehalte, Mikrostrukturen, Oberflächenmorphologien sowie die mechanischen Eigenschaften von Ti-Al-N-Filmen werden untersucht und diskutiert.
Methode
Filmdeposition
Ti-Al-N-Filme wurden auf Si (100) und hochglanzpoliertem Edelstahl durch ein RF-ICP-Ionenquellen-verstärktes Magnetron-Sputtersystem mit einer Wachstumstemperatur von 200°C abgeschieden. Die Substrate wurden auf einem rotierenden Probenhalter (20 rpm) platziert, der senkrecht zu einem Ti0.5 . stand Al0,5 Compound-Target mit einer Reinheit von 99,9 %. Nach dem Pumpen der Sputterkammer auf einen Basisdruck von weniger als 1,0 × 10 –4 Pa- und Targetoberflächenreinigung durch Argonionen, dann wurde die Pufferschicht aus Ti-Al auf Substraten durch DC-Sputtern abgeschieden. Anschließend wurde das aus RF-ICPIS erzeugte Stickstoffplasma in der Nähe der Substrate eingeführt, um die reaktive Abscheidung des Ti-Al-N-Films zu begleiten. Die RF-ICPIS-Leistung wurde auf 50 W gesteuert, und die Stickstoffgasströmungsraten beim Einlassen in die Ionenquelle wurden von 5 bis 25 sccm variiert, um die Stickstoffplasmadichten zu ändern und eine andere Sputter- und Abscheidungsatmosphäre zu erhalten. In der Zwischenzeit wurde der Sputter-Gleichstrom auf 0,4 festgelegt und der Gesamtgasdruck der Sputterkammer auf 0,5 Pa gehalten. Detaillierte Wachstumsparameter sind in Tabelle 1 aufgeführt.
Charakterisierung
Die Elementgehalte wurden durch energiedispersives Spektrometer (EDS, Oxford X-Max 50) charakterisiert und Kristallstrukturen von Ti-Al-N-Filmen wurden durch Röntgenbeugung (XRD, Bruker D8 Advance) mit einer Cu Kα-Strahlung (λ =1,54056 Å). Oberflächenmorphologien und Querschnittsmikrostruktur von Filmen wurden durch Feldemissions-Rasterelektronenmikroskopie (FESEM, ZEISS Ultra 55) gemessen. Rasterkraftmikroskopie (AFM, Asylum Research) wurde verwendet, um den Oberflächen-Effektivwert (RMS) zu messen. Für den Nano-Indentation-Test wurde eine pyramidenförmige Diamantspitze verwendet, und die Härte wurde mit dem MTS Nano Indenter XP gemessen und nach der Oliver-Pharr-Indentation-Methode berechnet. Jede Probe, zehn getrennte Punktmessungen, wurden genommen, um einen mittleren Härtewert zu erhalten. Zur Messung des Reibungskoeffizienten wurde ein konventionelles Kugel-auf-Scheibe-Verschleißgerät mit einer Gleitgeschwindigkeit von 0,2 m/s unter einer Last von 10 N verwendet
Ergebnisse und Diskussion
Abbildung 1 zeigt die Gehalte an Ti-, Al- und N-Elementen in Ti-Al-N-Filmen, die bei verschiedenen Stickstoffgasströmungsraten abgeschieden wurden. Der N-Gehalt in Ti-Al-N-Filmen wird mit der Zunahme der in die Ionenquelle eingelassenen Stickstoffgasströme monoton verbessert. Innerhalb des Bereichs mit niedrigem Stickstoffgasfluss (5–15 sccm) wird der N-Gehalt bei 45–50% gehalten, und die (Ti + Al)/N-Verhältnisse ähneln der (Ti, Al) N-Struktur. Wenn die Stickstoffgasströmungsraten von 15 auf 25 sccm weiter verbessert werden, werden die N-Gehalte in Ti-Al-N-Filmen schnell erhöht. Der Maximalwert von 67,8% wird bei 25 sccm erreicht, was im üblichen (Ti, Al) N oder Tix . über 50% liegt Al1-x N-Mikrostruktur, die Phasenübergänge anzeigt, treten in S4 und S5 auf. Ti- und Al-Gehalte in Ti-Al-N-Filmen zeigen beide einen entgegengesetzten Trend zum N-Element als Funktion der Stickstoffgasströmungsraten. Bei allen Filmen ist der Al-Gehalt höher als der von Ti, was den Ergebnissen von Ti-Al-N-Filmen ähnlich ist, die unter einer verbesserten Plasmaatmosphäre abgeschieden wurden. Der Gehaltsunterschied zwischen Al- und Ti-Elementen kann dem Unterschied der Sputterausbeute zwischen Al-Atom mit einer leichten Qualität und Ti-Atom zugeschrieben werden. Darüber hinaus sickern Al-Atome leicht in die Oberflächenbereiche des Films, was auch dazu führen könnte, dass die nachgewiesenen Al-Gehalte etwas höher sind als die tatsächlichen Werte im Inneren des Films [16].

Elementgehalt von Ti-Al-N-Filmen, die bei verschiedenen Stickstoffgasdurchflussraten hergestellt wurden
XRD wird für die auf Si(100)-Wafern abgeschiedenen Proben durchgeführt. Wie in Abb. 2 gezeigt, weisen S1–S5 die typische kubisch-flächenzentrierte (fcc) Struktur vom NaCl-Typ mit mehreren Beugungsplänen auf, die an (111), (200), (220) und (311) orientiert sind, mit Ausnahme von (311 .). ) für S4- und S5-Proben, die bei hohen Gasdurchflussraten abgeschieden wurden [17]. Für die f.c.c-Ti-Al-N-Struktur ist (111) die dicht gepackte Ebene mit der niedrigsten Oberflächenenergie, während (200) und (220) folgten. In S1–S5 weisen alle abgeschiedenen Ti-Al-N eher die (220)-Vorzugsorientierung als (111) auf. In unserer vorherigen Studie haben wir festgestellt, dass die Filmabscheidungsraten in einem RF-ICPIS-verstärkten Sputtersystem verbessert wurden. Dies führt zu einer verkürzten Migrationszeit von Adatomen auf Substraten und begünstigt das Wachstum von (220)-Kristallebenen mit höherer Oberflächenenergie, auf Kosten anderer aufgrund der höheren Leistendichte und der kürzeren Diffusionsstrecke zu den relativ niedrigeren Energiezentren [13 ]. Darüber hinaus trägt auch eine durch Al-Atome induzierte Gitterverzerrung mit hoher Konzentration zum bevorzugten Wachstum von (220) statt (111) bei [18]. Die Intensitäten und die FWHM der (220)-Peaks zeigen auch die Abhängigkeit der Kristallisation von den Stickstoffgasströmungsraten. Im niedrigen Gasflussbereich (5–15 sccm) werden Intensität und FWHM verbessert, wenn die Stickstoffflussrate erhöht wird, was die Ti-Al-N-Kristallkorngrößen in Filmen verringert und die Kristallisationsqualitäten der Filme verbessert [ 19]. Für S4 und S5 wirken sich die reduzierten Spitzenintensitäten und die vergrößerte FWHM, die hohe Gasflussraten (20–25 sccm) bestätigen können, nachteilig auf die Qualitäten der Ti-Al-N-Filme aus.
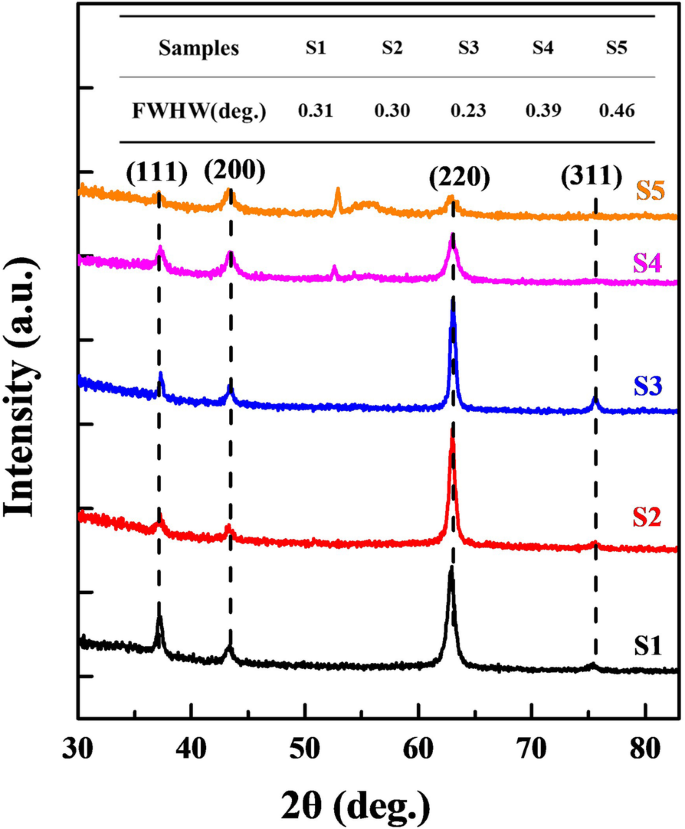
XRD-Spektren von S1–S5-Proben. Tabelle einfügen ist der FWHW-Wert von (220) für S1–S5
Eine degenerierte Ti-Al-N-Kristallqualität bei hohen Stickstoffgasflussraten ist das Ergebnis einer Stickstoffplasmavariation, die von RF-ICPIS herrührt. Es können mehr Stickstoffatome ionisiert werden, wenn die Stickstoffströmungsraten in die Ionenquelle erhöht werden, und die entsprechenden Plasmadichten in der Sputterkammer werden ebenfalls erhöht. Die Elektronenkonzentrationen in der Nähe der Substrate werden mit einer Langmuir-Sonde gemessen. Die berechneten Ergebnisse zeigen, dass die mittleren Elektronenkonzentrationen von 1,5 × 10 16 . variieren bis 2,7 × 10 16 cm −3 wobei die Stickstoffgasströmungsraten von 5 auf 25 sccm ansteigen. Die verbesserten Elektronenkonzentrationen zeigen an, dass die Plasmadichten während des Abscheidungsfortschritts verbessert werden. Außerdem betragen die Spannungen der Sputterquelle mit einem festen Sputterstrom von 0,4 A während der Abscheidung 482, 461, 443, 408 und 376 V für 5, 10, 15, 20 bzw. 25 sccm. Die Verringerung der Impedanz zwischen Substraten und Target spiegelt auch die verbesserte Plasmaatmosphäre wider. Eine hohe Plasmadichte verbessert die Kollisionen zwischen Atomen, die dazu führten, dass die mittlere freie Weglänge der gesputterten Metallatome und die Filmabscheidungsraten sinken. Anschließend haben die adsorbierten Atome auf den Substraten mehr Zeit, um zu wandern und Keime zu bilden und zu den Filmkristallisationen beizutragen. Wenn die Stickstoffströmungsraten einen bestimmten Schwellenwert überschreiten, würden zwar die Plasmadichten weiter verbessert, jedoch würden bei einer festen Ionenquellenleistung von 50 W nicht mehr Stickstoffatome vollständig ionisiert [20]. Im Vergleich zu vollständig ionisierten Stickstoffatomen befinden sich diese nicht vollständig ionisierten Atome näher am Substrat und würden direkt am Filmkeimbildungswachstum teilnehmen. Als Ergebnis liegen die Stickstoffgehalte in Ti-Al-N-Filmen weit über dem stöchiometrischen Verhältnis.
Abbildung 3 zeigt die durch FESEM beobachtete planare und querschnittliche Mikromorphologie von Ti-Al-N-Filmen. Die Ti-Al-N-Oberflächenmorphologien weisen die typischen dreiteiligen Kegelkörner auf [21]. Im Vergleich zu Fig. 3a, b können wir feststellen, dass der bei niedriger Stickstoffplasmadichte abgeschiedene Film (S3) kleinere Korngrößen und dichtere Oberflächen aufweist als S5, der bei hoher Plasmadichte abgeschieden wurde, was auch mit den XRD-Ergebnissen übereinstimmt. In einer Atmosphäre mit niedriger Plasmadichte fördern vollständig ionisierte Stickstoffatome und eine ausreichende Migrationszeit der Adatome das Wachstum und die Kristallisation von Ti-Al-N und tragen zu einer dichteren Oberfläche bei. Die Mikrostrukturen der Vergleichsprobe CS3, die durch das traditionelle Verfahren der Ionisierung von Argongas abgeschieden wird und die gleichen experimentellen Parameter wie S3 aufweist, werden ebenfalls untersucht (siehe Ergänzungsmaterial). Im Vergleich zu S3 zeigt CS3 eine lockerere und rauere ebene Oberfläche und viele Hohlräume erscheinen zwischen den Korngrenzen. Inzwischen hat CS3 die geringere Filmdicke als S3. Die Gründe werden hauptsächlich den Unterschieden der Abscheidungsatmosphäre zwischen diesen beiden Gasionisationsverfahren zugeschrieben. Durch direktes Ionisieren von Stickstoffgas in RF-ICPIS kann die Gasionisationstemperatur effizient gesenkt und ein Stickstoffplasma hoher Dichte erhalten werden. Folglich würden die Adatome auf den Substraten eine hohe Migrationsenergie aufweisen und für das Wachstum und die Kristallisation von Ti-Al-N-Filmen von Vorteil sein. In den FESEM-Querschnittsbildern sind deutlich säulenförmige Strukturen für Ti-Al-N-Filme zu erkennen, die bei 15 und 25 sccm abgeschieden wurden, und die Filme zeigen eine Dicke von 1,002 bzw. 1,561 µm. Unter Umständen hoher Plasmadichte wird die Filmabscheidungsrate um 50% erhöht. Die Ergebnisse unterscheiden sich von den durch die verstärkte Atomstreuung induzierten niedrigen Abscheidungsraten und resultieren hauptsächlich aus dem schnellen Wachstum von schwach gebundenem Nitrid, das mit diesen nicht vollständig ionisierten Stickstoffatomen verbunden ist. Inzwischen weisen die säulenförmigen Strukturen von S3 gekörnte und dichtere Nanostrukturen auf, und die S5-Probe zeigt die säulenförmigen Strukturen mit Hohlräumen und Grenzen im gesamten Film. Es ist ferner offensichtlich, dass eine hohe Stickstoffplasmadichte den Kristallisationseigenschaften der Ti-Al-N-Filme nachteilig ist 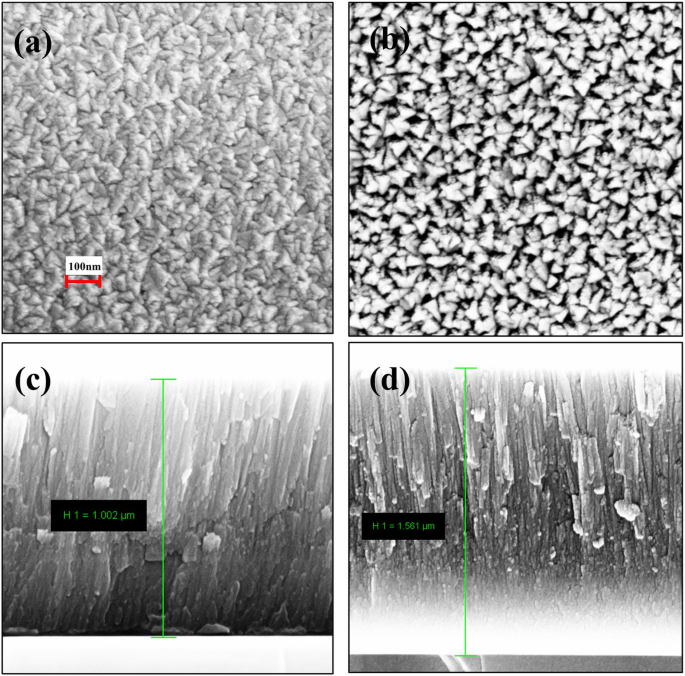
Planar- und Querschnitts-FESEM-Bilder von S3 (a , c; 15 sccm) und S5 (b , d; 25 sccm)
Außerdem wird die Rauheit von Ti-Al-N-Filmen, die bei verschiedenen Stickstoffgasströmungsraten abgeschieden wurden, durch AFM untersucht, und die quadratischen Mittelwert-(RMS)-Rauheitswerte sind in 4 aufgetragen. Die Rauheit wird zuerst reduziert und dann erhöht mit der Zunahme der Stickstoffgasströmungsraten, und der minimale Wert von 3,932 nm wird bei 15 sccm erhalten. In der Zwischenzeit können wir, wie in Abb. 4c gezeigt, die Filmoberfläche der S5-Probe finden, die mit aufgequollenen Partikeln gefüllt ist, und die Schlucht zwischen den Partikeln, die ziemlich tief sind. Die raueren Oberflächen von S5 sind auf die schlechten Kristallqualitäten und spärlichen Oberflächen zurückzuführen. In der Ti-Al-N-Kristallstruktur ist das Al/Ti-Verhältnis auch ein wichtiger Faktor dafür, dass Al-Atome Gitterplätze von Ti-Atomen besetzen und Gitterdefekte einführen, um die Mikrostruktur und die mechanischen Eigenschaften zu beeinflussen [18, 22]. Berechnete Al/Ti-Verhältnisse basierend auf EDS-Tests sind 1,66, 1,54, 1,43, 1,60 bzw. 1,85 für S1–S5. Die ausgezeichnete Kristallqualität und das niedrige Al/Ti-Verhältnis tragen zu der glattsten Oberfläche der Ti-Al-N-Probe bei, die bei 1 sccm abgeschieden wurde. Hohe Al/Ti-Verhältnisse verschlimmern Gitterverzerrungsstrukturdefekte in den S5-Filmen und verschlimmern die Oberflächenrauheit.

a RMS-Rauheitswerte von Ti-Al-N-Filmen als Funktion der Stickstoffgasströmungsgeschwindigkeiten. Die Einfügungstabelle enthält die Werte der Al/Ti-Verhältnisse; b und c sind die AFM-Bilder der S3- bzw. S5-Proben
Die Härte von Ti-Al-N-Filmen, die auf Edelstahlsubstraten unter verschiedenen Stickstoffgasströmungsraten abgeschieden wurden, ist in Fig. 5 gezeigt. Die Härte von Ti-Al-N-Filmen, die bei 5, 10, 15, 20 und 25 sccm erhalten wurden, beträgt 33,1, 33,3, 34,6, 29,1 bzw. 26,4 GPa. Im Bereich des niedrigen Stickstoffflusses ist die Härte von Ti-Al-N-Filmen ziemlich höher als die des traditionellen Ti-N-Materials. Die verbesserte Härte von Ti-Al-N ist hauptsächlich auf die Entwicklung der Mikrostruktur durch die Einführung von Al-Gehalten zurückzuführen, dass Al-Atome, die Teilgitterplätze von Ti-Atomen besetzen, eine Gitterzerstörung verursachen und die innere Spannung der Filme erhöhen. Darüber hinaus sind die Al/Ti-Verhältnisse von S1–S5-Proben höher als die von Ti-Al-N-Materialien, die mit herkömmlichen Sputtersystemen hergestellt werden, da die RF-ICPIS-Technik die Gasionisationstemperatur senken und die Ionisationsrate während des Reaktionssputterns erhöhen kann die Sputterausbeute von Metallpartikeln umrechnen [23]. Hohe Al/Ti-Verhältnisse, die eine Gitterverzerrung induzierten, verursachen auch einen Versetzungsbewegungswiderstand und eine schwierige Gleitbewegung, die gemeinsam zu der hervorragenden Härteleistung von Ti-Al-N-Filmen beitragen können, die bei niedrigen Stickstoffströmungsraten abgeschieden wurden. Unterdessen fördern die optimierte Kristallisation und die verringerten Korngrößen die Härte weiter auf das Maximum von 34,6 GPa bei 15 sccm.

Härte von Ti-Al-N-Filmen, die bei verschiedenen Stickstoffgasflussraten abgeschieden wurden
Die Reibungseigenschaften von Ti-Al-N-Filmen werden auch mit der Kugel-auf-Scheibe-Verschleißvorrichtung untersucht, und der mittlere Reibungskoeffizient von Ti-Al-N-Filmen ist in Fig. 6 aufgetragen. Die Variation der Reibungskoeffizienten in Abhängigkeit von Stickstoffgas Flussraten ist mit der RMS-Rauheit ähnlich. Offensichtlich sind die glatten Oberflächen und dichten Querschnittsnanostrukturen von Ti-Al-N-Filmen, die bei niedrigen Stickstoffgasströmungsraten abgeschieden wurden, für die tribologische Oberflächenleistung von Vorteil. Inzwischen weisen die S1–S3 einen kleineren mittleren Reibungskoeffizienten als CS3 auf (siehe Zusatzmaterial).

Mittlerer Reibungskoeffizient von Ti-Al-N-Filmen, die bei verschiedenen Stickstoffgasströmungsraten abgeschieden wurden. Einsätze sind die Reibungskoeffizientenkurve von S3 bzw. S5
Schlussfolgerung
Zusammenfassend werden die Mikrostruktur und die mechanischen Eigenschaften von Ti-Al-N-Filmen untersucht, die bei unterschiedlichen Stickstoffplasmaatmosphären abgeschieden wurden. Es hat sich herausgestellt, dass die Elementgehalte in den Ti-Al-N-Filmen stark durch die Stickstoffplasmadichte beeinflusst werden. Eine niedrige Plasmadichte ist ein Vorteil für die Filmkristallisationsqualitäten und die Mikrostruktur, was durch XRD-Spektren und FESEM unterstützt wird. Darüber hinaus können die Oberflächenrauheit und mechanische Eigenschaften wie Härte und Reibungskoeffizient bei einem geeigneten Plasmadichtebereich weiter optimiert werden. Bei hoher Plasmadichte kann der übermäßige Stickstoffgehalt in den Filmen eine metastabile Nitridphase induzieren und für die lockere Mikrostruktur und die verschlechterte mechanische Leistung verantwortlich sein. Unsere Ergebnisse wären ein effizienter Weg, um den mit der Abscheidungsatmosphäre zusammenhängenden Wachstumsmechanismus von Ti-Al-N-Filmen besser zu verstehen.
Verfügbarkeit von Daten und Materialien
Alle Daten sind uneingeschränkt verfügbar.
Abkürzungen
- RF-ICPIS:
-
Induktiv gekoppelte Hochfrequenz-Plasma-Ionenquelle
- DC:
-
Gleichstrom
- EDS:
-
Energiedispersives Spektrometer
- XRD:
-
Röntgenbeugung
- FESEM:
-
Feldemissions-Rasterelektronenmikroskopie
- AFM:
-
Rasterkraftmikroskopie
- FWHM:
-
Volle Breite auf halbem Maximum
- RMS:
-
Root-Mean-Square
Nanomaterialien
- Die Wirkung von Kontakt-Nichtgleichgewichtsplasma auf die strukturellen und magnetischen Eigenschaften von Mn Х Fe3 − X О4 Spinellen
- Einfluss von Wasser auf die Struktur und die dielektrischen Eigenschaften der mikrokristallinen und Nano-Cellulose
- Auswirkungen der Doppelschichtdicke auf die morphologischen, optischen und elektrischen Eigenschaften von Al2O3/ZnO-Nanolaminaten
- Abstimmung der Oberflächenmorphologien und -eigenschaften von ZnO-Filmen durch das Design der Grenzflächenschicht
- Synergetischer Effekt von Graphen und MWCNTs auf die Mikrostruktur und die mechanischen Eigenschaften von Cu/Ti3SiC2/C-Nanokompositen
- Einfache Synthese von Wurmloch-ähnlichem mesoporösem Zinnoxid durch verdunstungsinduzierte Selbstorganisation und die verbesserten Gassensoreigenschaften
- Untersuchung der Adhäsionskraft und des Glasübergangs dünner Polystyrolfolien durch Rasterkraftmikroskopie
- Herstellung und optische Eigenschaften von GeBi-Filmen unter Verwendung der Molekularstrahl-Epitaxie-Methode
- Untersuchung der strukturellen, elektronischen und magnetischen Eigenschaften von Ag n V (n = 1–12)-Clustern
- Morphologie, Struktur und optische Eigenschaften von Halbleiterfilmen mit GeSiSn-Nanoinseln und gespannten Schichten



