Morphologie, Struktur und optische Eigenschaften von Halbleiterfilmen mit GeSiSn-Nanoinseln und gespannten Schichten
Zusammenfassung
Die Abhängigkeiten der kritischen Übergangsdicke vom zweidimensionalen zum dreidimensionalen Wachstum (2D-3D) von der Zusammensetzung für GeSiSn-Filme mit einem festen Ge-Gehalt und einem Sn-Gehalt von 0 bis 16% bei einer Wachstumstemperatur von 150°С wurden ermittelt . Die Phasendiagramme der Überstrukturänderung während des epitaktischen Wachstums von Sn auf Si und auf Ge(100) wurden erstellt. Unter Verwendung der Phasendiagrammdaten wird es möglich, die Sn-Beschichtung auf der Si-Oberfläche zu identifizieren und die Sn-Segregation auf der Überstruktur zu kontrollieren, die auf dem hochenergetischen Reflexionselektronenbeugungsmuster (RHEED) beobachtet wird. Die Multilayer-Strukturen mit den pseudomorphen GeSiSn-Schichten und dem Insel-Array mit einer Dichte von bis zu 1,8 × 10 12 cm −2 wurden unter Berücksichtigung der Sn-Seigerungsunterdrückung durch die Abnahme der GeSiSn- und Si-Wachstumstemperatur gezüchtet. Die Doppeldomänen-Überstruktur (10 × 1) im Zusammenhang mit der Anwesenheit von Sn auf der Oberfläche wurde zuerst in den mehrschichtigen periodischen Strukturen während des Si-Wachstums auf der GeSiSn-Schicht beobachtet. Die periodischen GeSiSn/Si-Strukturen zeigten die Photolumineszenz im Bereich von 0,6–0,85 eV entsprechend dem Wellenlängenbereich von 1,45–2 μm. Die Berechnung des Banddiagramms für die Struktur mit dem pseudomorphen Ge0.315 Si0,65 Sn0,035 Schichten erlaubt die Annahme, dass die Photolumineszenz-Peaks den Interband-Übergängen zwischen den X Tal in Si oder die Δ4 -Tal in GeSiSn und das Teilband der schweren Löcher in der GeSiSn-Schicht.
Hintergrund
Die effektiven lichtemittierenden Bauelemente wurden nicht vorgestellt, da Si der Halbleiter mit der indirekten Bandlücke ist, obwohl die Silizium-Photonik-Bauelemente wie Wellenleiter [1], Fotodetektoren [2] und Modulatoren [3] erfolgreich hergestellt wurden.
Die Zugabe von Sn in die Matrix aus Ge-, Si- oder GeSi-Mischkristall ist einer der Ansätze zum Erhalten des Halbleiters mit direkter Bandlücke, der auf Materialien der IV-Gruppe basiert. Die Aufnahme von Sn in das Ge-Gitter verringert die Differenz zwischen den Minima von Г und L Täler, und GeSn kann ein Material mit direkter Bandlücke werden. Wie gezeigt wurde, ergibt sich die Direktheit für das kubische GeSn-Gitter bei einem Sn-Gehalt von etwa 9 % [4, 5]. Dieser Wert kann bei Zugbelastung kleiner als 6% sein, während bei Folien mit Druckdehnung der Übergang für den Sn-Gehalt von mehr als 11% zu erwarten ist [6]. Die Reduzierung der Bandlücke aufgrund des Einschlusses von Sn ermöglicht eine Erhöhung der Betriebswellenlänge vom nahen bis mittleren Infrarotbereich, was im Bereich optischer Verbindungen, in faseroptischen Kommunikationssystemen der neuen Generation, Sensoren, Signalverarbeitung, Energieumwandlung und wünschenswert ist optische Speichergeräte [7]. Daher ist in den letzten Jahren das Interesse an der Klasse der Ge-Si-Sn-Materialien deutlich gestiegen.
Große Anstrengungen werden gebündelt, um epitaktische GeSn-Filme von instrumenteller Qualität zu erhalten [8, 9]. Eines der schwerwiegenden Probleme ist die Bildung von Sn-Einschlüssen (Ausfällungen) während des Wachstums der GeSn-Schicht [10, 11]. Neben der Ausscheidung wird eine Sn-Segregation beim Prozess des GeSn-, GeSiSn-Schichtwachstums und der GeSn-Filmoxidation beobachtet [11, 12]. Nichtgleichgewichtswachstumstechniken, wie die Molekularstrahlepitaxie (MBE) und die chemische Gasphasenabscheidung (CVD), dienen zuverlässigen Methoden der Fällung und Entmischungsunterdrückung. Um den Effekt der Sn-Ausscheidung und -Segregation zu reduzieren, kann die Wachstumstemperaturabsenkung [13] oder der Verformungseinschluss oder die Zugabe des dritten Elements, beispielsweise Si, das die lokale Spannung um die Sn-Atome herum reduziert, durchgeführt werden.
Die Daten zur Morphologie und Oberflächenstruktur oder zu den Bildungsmechanismen einkristalliner GeSiSn-Filme sind in der Literatur praktisch nicht zu finden, obwohl die Materialien auf Basis von Gruppe-IV-Verbindungen viel versprechend sind. Diese Daten sind für die Erzeugung von Nanoheterostrukturen mit verspannten und relaxierten GeSiSn-Schichten notwendig. In diesem Beitrag werden zunächst die Daten zur Erzeugung von Mehrschichtstrukturen, Übergittern nicht nur mit pseudomorphen GeSiSn-Schichten, sondern auch mit GeSiSn-Nanoinseln, demonstriert, die keine Versetzungen enthalten und die Variation der Bandlückenbreite des Materials in einem weiten Bereich erlauben und decken den Infrarot-Wellenlängenbereich ab, der zuvor für GeSi nicht verfügbar war.
Der Zweck dieses Papiers besteht darin, das elastisch belastete pseudomorphe GeSiSn-Filmwachstum, die dreidimensionale Nanoinselbildung zu untersuchen und die mehrschichtigen periodischen Strukturen zu erhalten, die pseudomorphe GeSiSn-Schichten und Nanoinseln enthalten.
In unseren früheren Arbeiten [14,15,16] wurden die kinetischen Diagramme des morphologischen GeSiSn-Filmzustands für verschiedene Gitterparameter-Fehlanpassungen zwischen GeSiSn und Si im Sn-Gehaltsbereich von 0 bis 8% unter Verwendung der hochenergetischen Reflexionselektronenbeugung ( RHEED). Dieser Artikel enthält neue kritische Abhängigkeiten der Übergangsdicke vom zweidimensionalen zum dreidimensionalen Wachstum (2D-3D) von der GeSiSn-Filmzusammensetzung mit einem festen Ge-Gehalt im Bereich des Sn-Gehalts von 0 bis 16%. Die Phasendiagramme der Überstrukturänderung während des Wachstums von Sn auf Si und Ge(100) wurden erhalten. Trotz der Tatsache, dass in [17,18,19] Sn-Oberflächenrekonstruktionen auf Si an den verschiedenen Zinnabdeckungen untersucht wurden, zeigten unsere Daten neue Überstrukturen. Außerdem wurde das Phasendiagramm der Überstrukturänderung während des Sn-Wachstums auf Ge(100) nirgendwo früher präsentiert. Die optischen Eigenschaften von mehrschichtigen periodischen Strukturen einschließlich pseudomorpher GeSiSn-Schichten wurden zunächst mit der Photolumineszenz-Methode für Proben mit unterschiedlichen Sn-Gehalten untersucht. Die Banddiagrammberechnung von GeSiSn/Si-Heterostrukturen wurde mit dem Modellansatz der Festkörpertheorie durchgeführt [20].
Experimentell
Alle Proben mit pseudomorphen GeSiSn-Schichten und mit GeSiSn-Nanoinseln wurden unter Ultrahochvakuumbedingungen 10 −7 . gezüchtet –10 –8 Pa auf der Molekularstrahlepitaxie (MBE)-Ausrüstung „Katun C.“ Die Epitaxiekammer hat den Elektronenstrahlverdampfer für Si und die Knudsen-Effusionszellen für Ge und Sn. Die Wachstumsrate der GeSiSn-Schicht wurde von 0,015 bis 0,05 nm/s variiert. Das epitaktische Wachstum erfolgte auf Si(100)-Substraten im Temperaturbereich von 150–450 °С mit einem Sn-Gehalt von 0 bis 20 %. Es wurden nicht nur einzelne GeSiSn-Schichten, sondern auch mehrschichtige periodische Strukturen erhalten, die GeSiSn/Si-Heteroübergänge enthalten. Zunächst wurde die GeSiSn-Schicht abgeschieden, die dann bei einer Wachstumstemperatur von 400–500 °С mit einer 10-nm-Si-Schicht bedeckt wurde. Die Hauptmethode zur Kontrolle der Veränderungen der Morphologie und Oberflächenstruktur und zur Untersuchung der Wachstumsmechanismen war die Reflexion der hochenergetischen Elektronenbeugung (RHEED). Das RHEED-Muster wurde während des Wachstums mit einer Videokamera aufgezeichnet. Dann wurde ein Profil zusammen mit einer der kristallographischen Richtungen ausgewählt und die Intensitätsänderungen dieses Profils in Raum-Zeit-Koordinaten erstellt. Die RHEED-Raum-Zeit-Intensitätsverteilungsanalyse ermöglichte es uns, die Mechanismen des zweidimensionalen Wachstums, der Überstrukturänderungen und der dreidimensionalen Inselbildung zu untersuchen. Der Zeitpunkt des Übergangs vom zweidimensionalen zum dreidimensionalen Wachstum (2D-3D-Übergang) wurde aus der Zeitabhängigkeit der RHEED-Musterintensität zusammen mit einem der Stäbchen, in dessen Richtung der Volumenreflex auftritt, bestimmt. Die Abhängigkeiten der kritischen 2D-3D-Übergangsdicke vom GeSiSn-Gehalt bei festem Ge-Gehalt wurden auf Basis der Methode der 2D-3D-Übergangsbestimmung erstellt. Basierend auf diesen Abhängigkeiten wurde die pseudomorphe Schichtdicke von GeSiSn in Multilayer-Strukturen eingestellt und Schichten mit einem GeSiSn-Nanoisland-Array erzeugt. Die Morphologie und Oberflächenstruktur wurden durch Rastertunnelmikroskopie (STM) auf dem Ultrahochvakuumgerät Omicron-Riber analysiert. Die optischen Eigenschaften der Probe wurden durch Photolumineszenz(PL)-Spektroskopie mit einem ACTON 2300i-Monochromator und einem gekühlten OMA-V-Detektor basierend auf dem InGaAs-Photodiodenarray mit einem Empfindlichkeitsband von 1,1 bis 2,2 μm untersucht. Zur Anregung der Photolumineszenz wurde die Nd:YAG-Laserstrahlung (532 nm) verwendet.
Ergebnisse und Diskussion
Das dünne GeSiSn-Filmwachstum bei einer Temperatur von 150 °С im Bereich des Sn-Gehalts von 0 bis 16 % wurde untersucht. Die Spannungsakkumulation tritt während der Abscheidung der GeSiSn-Schicht auf, die durch die Fehlanpassung zwischen den Gitterparametern von GeSiSn und Si verursacht wird. Der Übergang vom 2D-3D-Übergang wird bei einer bestimmten Dicke beobachtet. Die Vorgehensweise zur Bestimmung des 2D-3D-Übergangs am Beispiel des Ge0.6 Si0,28 Sn0,12 Wachstum ist in Abb. 1 dargestellt. Es gibt die anfänglichen RHEED-Muster von der Si-Oberfläche vor dem Ge0,6 Si0,28 Sn0,12 Filmabscheidung (Fig. 1a), das endgültige RHEED-Muster (Fig. 1c), das durch das Ge0.6 . gebildet wird Si0,28 Sn0,12 Island-Array und der Benetzungsschicht, sowie die Raum-Zeit-Intensitätsverteilung des vertikalen Profils, angegeben durch den Pfeil in Abb. 1a und die Abhängigkeit der horizontalen Profilintensität (horizontales Profil, angegeben von der Raum-Zeit-Intensitätsverteilung in Abb. 1b) auf der Ge0.6 Si0,28 Sn0,12 Filmdicke (Abb. 1b). Das 2D-3D-Übergangsmoment wurde durch Auftragen der Tangente an das Intensitätsdiagramm über die Dicke (Abb. 1b) im Bereich eines starken Intensitätsanstiegs bestimmt. Ein solcher Ansatz wird allgemein akzeptiert [21].
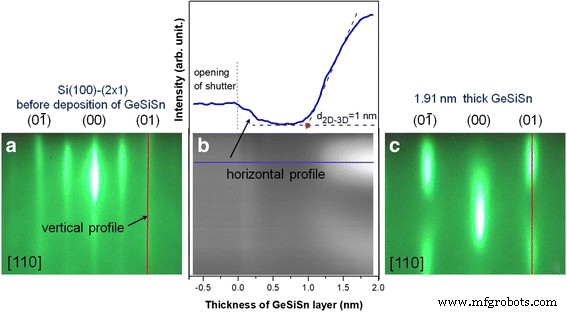
2D-3D-Übergangsmomentbestimmung während des GeSiSn-Filmwachstums:a RHEED-Muster von der Si(100)-(2 × 1)-Oberfläche vor dem Ge0,6 Si0,28 Sn0,12 Wachstum wird angezeigt, b die Raum-Zeit-Intensitätsverteilung des Vertikalprofils in der Grauskala und die Intensitätsabhängigkeit des Horizontalprofils vom abgeschiedenen Ge0,6 Si0,28 Sn0,12 Schichtdicke. Die Profile sind durch die Pfeile in (a ) und (b ) und c das endgültige RHEED-Muster nach dem 1,91 nm dicken Ge0,6 Si0,28 Sn0,12 Ablagerung
Die Abhängigkeiten der kritischen 2D-3D-Übergangsdicke von der Zusammensetzung für GeSiSn-Filme mit einem festen Ge-Gehalt und einem Sn-Gehalt von 0 bis 16 % werden unter Verwendung der oben beschriebenen 2D-3D-Übergangstechnik gebildet (Abb. 2). Zuvor wurden die kinetischen Diagramme für den morphologischen Zustand von GeSiSn-Filmen im Temperaturbereich von 150–450 °С bei einer anderen Gitterfehlanpassung zwischen GeSiSn und Si veröffentlicht [14]. Auf Basis der kinetischen Diagrammanalyse wurde die optimale Temperatur von 150 °С bestimmt, bei der die kritische 2D-3D-Übergangsdicke ihren maximalen Wert erreicht und die Sn-Seigerung unterdrückt wird. Der Wert der GeSiSn-Filmdicke unter der Kurve, die der kritischen 2D-3D-Übergangsdicke bei Temperatur und Zusammensetzung entspricht, bestimmt den Bereich der Existenz pseudomorpher Filme. Auf den Kurven ist die Abnahme der kritischen 2D-3D-Übergangsdicke mit Zunahme des Sn-Gehalts von 0 auf 16 % zu beobachten (Abb. 2). Dieses Verhalten wird durch den Dehnungseffekt erklärt. Die Erhöhung des Sn-Gehalts von 0 auf 16%, zum Beispiel der Ge0,6 Si0,28 Sn0,12 Wachstum, führt zu einem Anstieg der Gitterparameter-Fehlanpassung zwischen Ge0,6 Si0,28 Sn0,12 und Si von 2,5 bis 5,6%, und die Zeit und folglich die Übergangsdicke zu dreidimensionalen Nanoinseln reduzieren. Die Natur des Merkmals, das auf der Kurve mit dem 30% Ge-Gehalt erscheint und beim Sn-Gehalt von 3 bis 10% bis zum Ende beobachtet wird, ist völlig unklar. Wenn man die Größe der kritischen 2D-3D-Übergangsdicke kennt, ist es möglich, pseudomorphe GeSiSn-Filme zu erhalten und sie in den mehrschichtigen periodischen Strukturen mit dem GeSiSn/Si-Heteroübergang zu verwenden. In unseren Experimenten beträgt die Genauigkeit der Bestimmung der kritischen 2D-3D-Übergangsdicke 0,06 nm und wird hauptsächlich durch die Ungenauigkeit bei der Aufrechterhaltung der Si-Flussrate aufgrund der Instabilität des Quellenbetriebs bestimmt.
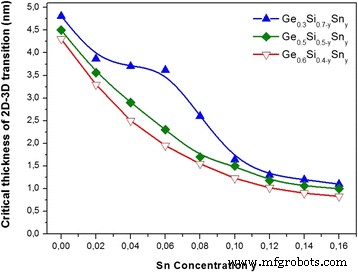
Die kritische 2D-3D-Übergangsdickenabhängigkeit von der GeSiSn-Filmzusammensetzung bei mehreren festen Werten des Ge-Gehalts, des Sn-Gehalts von 0 bis 16 % und der Wachstumstemperatur von 150 °С
Die Wahl der pseudomorphen Schichtdicke auf Basis der früher erhaltenen kinetischen Diagramme [16] und die Abhängigkeiten der kritischen 2D-3D-Übergangsdicke von der Zusammensetzung (Abb. 2) erlauben es, nicht nur einzelne GeSiSn-Schichten zu züchten, sondern auch diese Schichten zu verwenden in mehrschichtigen periodischen Strukturen. Bei der periodischen GeSiSn/Si-Struktur, bei der die GeSiSn-Schicht von der Si-Schicht bedeckt ist, tritt das Problem aufgrund der Sn-Segregation auf der Si-Oberfläche auf. Die Sn-Seigerung führt in Abhängigkeit von der Sn-Oberflächenkonzentration zur Oberflächenrekonstruktion und zum Erscheinen der ganzen Reihe von Überstrukturen. Die Untersuchung der Oberflächenrekonstruktion während des Sn-Wachstums auf Si(100) und Ge(100) war notwendig, um zu verstehen, welche Sn-Beschichtung der im RHEED-Bild beobachteten Überstruktur entspricht. Die Phasendiagramme der Veränderung des Überbaus wurden im Temperaturbereich von 100–750 °С erstellt. Ein ähnliches Diagramm für das Sn-Wachstum auf Si(100) wurde erstmals in [17] präsentiert. Ueda et al. abgeschiedenes Sn bei Raumtemperatur gefolgt von Tempern. Sie beobachteten den Überbau erst nach dem Tempern der Folie. In unseren Experimenten wurde Sn bei einer Temperatur von 100 °С abgeschieden und auf der rekonstruierten Si(100–(2 × 1)-Oberfläche erhalten. Der Temperaturanstieg auf 750 °С führte zur Bildung der Überstrukturreihe auf der Oberfläche (Abb. 3). Der Positionseffekt von adsorbierten Sn-Atomen auf der Si(100)-Oberfläche auf die Sn-Si-Bindungsenergie wurde durch Photoelektronenspektroskopie in [18] untersucht. Die Abnahme der Sn-Si-Bindungsenergie wurde mit Sn-Bedeckungszunahme.Damit können alle Rekonstruktionen, die beim Sn-Wachstum auf Si(100) auftreten, durch eine Abnahme der Oberflächensystemenergie erklärt werden.Der Übergang zum dreidimensionalen Wachstum ist mit der Akkumulation von Dehnungen aufgrund auf die Gitterparameter-Fehlanpassung zwischen Sn und Si von 19%.Das polykristalline Filmaussehen wurde in [17] bei einem 3.2 ML (monolayer)Sn-Dickfilm beobachtet. Die polykristalline Filmbildung wird durch eine niedrigeAbscheidungstemperatur des Sn-Films verursacht. Die gleiche Argumentation bezieht sich auf die Sn Wachstum auf der Ge(100)-Oberfläche. Beiträge zu den Sn-Überstrukturen auf Ge(100) sind in der Literatur bisher nicht bekannt.

Phasendiagramme der Veränderung des Überbaus während des Wachstums:a Sn auf Si(100) und b Sn auf Ge(100)
Die in den Diagrammen eingezeichneten Aufbauten treten sowohl bei Temperaturerhöhung als auch -abnahme auf. Diese Phasendiagramme helfen, die Sn-Konzentration an der Oberfläche beim Si-Wachstum über der GeSiSn-Schicht zu bestimmen. Die während des periodischen Strukturwachstums auf der Si-Oberfläche auftretenden Überstrukturen können bei Temperaturen beobachtet werden, die von den in den Phasendiagrammen dargestellten Temperaturen abweichen. Die Si-Schicht wird bei Temperaturen von 400–500 °С auf der GeSiSn-Oberfläche abgeschieden; es können jedoch die Aufbauten auftreten, die für den gesamten in Abb. 3 dargestellten Temperaturbereich charakteristisch sind. Die Erzeugung der Struktur mit GeSiSn/Si-Heteroübergängen erfordert die Verhinderung der Bildung der Zweidomänen-Überstruktur (5 × 1), die mit der Sn-Segregation und der Behinderung der mehrschichtigen periodischen Strukturbildung mit den pseudomorphen Schichten verbunden ist (Abb. 4a .). ). Der einfachste Weg, die Sn-Segregation beim Si-Wachstum über der GeSiSn-Schicht zu unterdrücken, ist das Si-Wachstum in zwei Stufen. Die erste Stufe beinhaltet die Abscheidung einer 1-2 nm dicken Si-Schicht bei Raumtemperatur. Das weitere Si-Wachstum setzt sich bei einer Temperatur von 400–500 °С fort. Diese Temperatur wird durch den Sn-Gehalt in der GeSiSn-Schicht bestimmt. Die während des Si-Wachstums auf der GeSiSn-Schicht in mehrschichtigen periodischen Strukturen auftretenden Hauptüberstrukturreihen bestehen aus (2 × 1) + (2 × N), c(8 × 4), (4 × 1), (6 × 1) , und (5 × 1). Außerdem wird die Zweidomänen-Überstruktur (10 × 1) auf der Si-Oberfläche beobachtet (Abb. 4b). Diese Überstruktur trat in den Experimenten beim Sn-Wachstum auf Si und Ge nicht auf, aber es kann gesagt werden, dass sie der minimalen Sn-Beschichtung entspricht, da sie während eines kurzen Glühens bei einer Temperatur von 400–500 °С verschwindet und die (2 × 1) Überstruktur tritt auf, die für die Si-Oberfläche charakteristisch ist.

Beim Si-Wachstum auf der GeSiSn-Schicht beobachtete Überstrukturen in der mehrschichtigen periodischen Struktur in azimutaler [110]-Richtung:a (5 × 1) und b (10 × 1)
Es wurden periodische Strukturen erhalten, die pseudomorphe Schichten oder ein GeSiSn-Nanoisland-Array enthalten. Unter Verwendung der kinetischen Diagramme des morphologischen Zustands des GeSiSn-Films wurde ein GeSiSn-Inselarray in der mehrschichtigen periodischen Struktur untersucht. Die STM-Bilder von Ge0.75 Si0,2 Sn0,05 Oberfläche mit dem Nanoisland-Array in der ersten (Abb. 5a) und in der fünften Periode (Abb. 5b) mit einer Scangröße von 400 nm × 400 nm dargestellt. Das Insel-Array wurde bei einer Wachstumstemperatur von 250 °С erhalten. Die Histogramme der Inselzahlverteilung in der Größe sind auch in Abb. 5 dargestellt. Die Inseln mit einer Dichte von 5.18 × 10 11 cm −2 und eine durchschnittliche Größe von 8,95 nm sind in Abb. 5c dargestellt. Das abgelagerte Ge0,75 Si0,2 Sn0,05 Die Filmdicke betrug 1,78 nm. Die durchschnittliche Inselgröße in der fünften Periode beträgt etwa 4 nm und die Inseldichte erreicht 1,8 × 10 12 sm −2 bei einer effektiven Dicke von Ge0,75 Si0,2 Sn0,05 Film 1,89 nm, und es folgt aus dem Histogramm in Abb. 5d. Eine Zunahme der Dichte um den Faktor 3,5 und eine Abnahme der Inselgröße um den Faktor 2 können mit dem zunehmenden Sn-Anteil an der Si-Oberfläche mit zunehmender Periodenzahl zusammenhängen. Diese Aussage wird durch die Veränderung der Überstrukturen, beobachtet durch das RHEED-Muster während des Si-Filmwachstums über der GeSiSn-Schicht, von (2 × 1) und (2 × N) zur c(8 × 4) Oberflächenstruktur bestätigt. Die Bildung der c(8 × 4)-Überstruktur erfolgt während des Prozesses des Sn-Wachstums auf Si, beginnend mit einer Bedeckungsdicke von 0,4 Monolagen (ML) bei einer Wachstumstemperatur von 400 °С. Mit der sinkenden Wachstumstemperatur auf 100 °С können wir die Inseldichte erhöhen, aber die Oberflächenqualität wird schlechter. Ein Anstieg der Wachstumstemperatur auf mehr als 250 °С verstärkt die Sn-Segregation. Der optimale Wachstumstemperaturbereich von GeSiSn-Schichten mit dem Inselarray beträgt also 150–250 °С, wobei spiegelnde Reflexionsoszillationen beim Wachstum der GeSiSn-Benetzungsschicht beobachtet werden, entsprechend dem 2D-Wachstumsmechanismus.

STM-Bilder von Ge0.75 Si0,2 Sn0,05 Oberfläche mit der Scangröße 400 nm × 400 nm:a die Ge0,75 Si0,2 Sn0,05 Oberfläche in der ersten Periode, b die Ge0,75 Si0,2 Sn0,05 Oberfläche in der fünften Periode; die Verteilungshistogramme für die Anzahl der Inseln auf der Größe der Basis für das Ge0,75 Si0,2 Sn0,05 Film:c in der ersten Periode (die Ge0,75 Si0,2 Sn0,05 Filmdicke gleich 1,78 nm) und d in der fünften Periode (die Ge0,75 Si0,2 Sn0,05 Filmdicke gleich 1,89 nm)
Die kristalline Perfektion der Mehrschichtstruktur wurde durch Transmissionselektronenmikroskopie (TEM) untersucht. Die TEM-Bilder für eine Mehrschichtstruktur mit dem Ge0,5 Si0,45 Sn0,05 /Si-Heteroübergang und eine 25-nm-Periode sind in Abb. 6 gezeigt. Aus den TEM-Daten kann geschlossen werden, dass unsere Proben keine Durchdringungsversetzungen enthalten und kristallin perfekt mit scharfen Grenzflächen sind. Der pseudomorphe GeSiSn-Filmzustand in einer mehrschichtigen periodischen Struktur, das Kristallgitter und die Spannungen werden in [14] auf der Grundlage der mit Hilfe von TEM gewonnenen Datenanalyse diskutiert. Die Zusammensetzung des GeSiSn-Films wurde unter Einstellung der Si-, Ge- und Sn-Flüsse bestimmt. Die Wachstumsraten von Si, Ge und Sn wurden mit einem Quarzdickenmesser gemessen. Die Zusammensetzung des GeSiSn-Films wurde durch Röntgendiffraktometrie identifiziert. Die Analyse zeigte die Übereinstimmung sowohl der eingestellten als auch der gemessenen Zusammensetzungen.
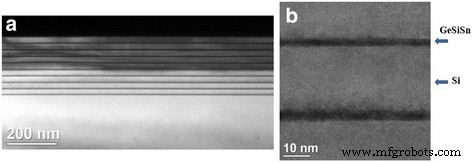
a TEM-Bild der mehrschichtigen Struktur einschließlich des Ge0,5 Si0,45 Sn0,05 Heteroübergang mit der 25-nm-Periode. b Hochauflösendes TEM-Bild derselben Struktur
Die optischen Eigenschaften von mehrschichtigen periodischen Strukturen mit GeSiSn-Schichten wurden durch Photolumineszenz für Strukturen mit unterschiedlichen Sn-Gehalten untersucht. Die Strukturen zeigten ihre Photolumineszenz im Bereich von 0,6–0,8 eV, was dem Wellenlängenbereich von 1,45–2 μm entspricht (Abb. 7). Die Photolumineszenzspektren mit den Intensitätsmaxima bei 0,78, 0,69 und 0,65 eV wurden erhalten. Sie entsprechen den Wellenlängen von 1,59, 1,8 und 1,9 μm und werden bei 3,5, 4,5 bzw. 6 % Sn beobachtet. Die Erhöhung des Sn-Gehalts in der GeSiSn-Schicht führt sowohl zu einer Energieabnahme der optischen Übergänge als auch zu einer Erhöhung der Photolumineszenzintensität. Die Intensitätszunahme kann durch die Tiefenzunahme des Quantentopfs für einen höheren Sn-Gehalt in der GeSiSn-Mischkristallschicht verursacht werden. Um in den Wellenlängenbereich über 2 μm vorzustoßen, ist eine Erhöhung des Sn-Gehalts in GeSiSn-Schichten erforderlich. Um die in den Lumineszenzspektren beobachteten optischen Übergänge zu bestimmen, war es notwendig, das Banddiagramm der GeSiSn/Si-Heterostruktur zu berechnen.

Die Photolumineszenzspektren von mehrschichtigen periodischen Strukturen mit 3,5, 4,5 und 6% Sn-Gehalt in den pseudomorphen GeSiSn-Schichten
Das GeSiSn/Si-Heterostruktur-Banddiagramm wurde mit dem Ansatz der Modellfestkörpertheorie berechnet [20]. Innerhalb dieses Modells müssen beide Halbleiter, die den Heteroübergang bilden, auf die einzelne „Energie“-Skala gestellt werden, um die Bandposition im Heteroübergang zu bestimmen. Der Wert der Valenzbandlücke für Ge/Si-Heterostrukturen im Heteroübergang ist bekannt [22] und beträgt 0,54 eV; außerdem liegt das Ge-Valenzband höher auf der Energie als das Si-Valenzband. Die Bandlücke zwischen Ge und Sn ist aus dem in [23] vorgestellten Modell bekannt und beträgt 0,69 eV [24]. Somit ist der Bandabstandswert an der Heterogrenzfläche für Si/Si 1-x-y Ge x Sn y Heterostruktur kann geschrieben werden als:
$$ {E}_{v, av}=0,54x+1,23y $$Da das Halbleiter-Valenzband durch die Teilbänder der schweren und leichten Löcher gebildet wird, und auch durch das Teilband, das durch die Spin-Bahn-Wechselwirkung abgespalten wird; dann die Position des Valenzbandes (E v,av ) wird in den drei Teilbändern gemittelt, um die Bandlücke und den Aufbau des Heterostruktur-Banddiagramms zu bestimmen. Um die Position der Teilbänder des schweren und des leichten Lochs sowie des durch die Spin-Bahn-Wechselwirkung abgespaltenen Teilbands zu bestimmen, werden die folgenden Ausdrücke verwendet:
$$ {\displaystyle \begin{array}{l}{E}_{\mathrm{HH}\left(\mathrm{LH}\right)}={E}_{v, av}+{\Delta} _0/3\\ {}{E}_{\mathrm{SO}}={E}_{v, av}-2/3{\Delta}_0\end{array}}, $$wobei die HH-, LH- und SO-Indizes die Schwer- und Leichtloch-Unterbänder sowie das Spin-Split-Unterband anzeigen. Die Δ0 Wert bezeichnet die Spin-Bahn-Aufspaltungsenergie im Halbleiter. Nach der Bestimmung der Valenzband-Teilbandposition im Heteroübergang werden die Positionen der entsprechenden Leitungsbandtäler unter Verwendung des Ausdrucks bestimmt:
$$ {E}^n={E}_{\textrm{Ge}}^n\left(1-xy\right)+{E}_{\textrm{Si}}^nx+{E}_{\ mathrm{Sn}}^ny-{b}_{\mathrm{Si}\mathrm{Ge}}^nx\left(1-xy\right)-{b}_{\mathrm{Sn}\mathrm{Ge }}^ny\left(1-xy\right)-{b}_{\textrm{Si}\textrm{Sn}}^n xy, $$wobei Indizes n = Γ , L , und X geben die entsprechenden Täler \({b}_{\textrm{SiGe}}^n\), \({b}_{\textrm{SnGe}}^n\) und \({b}_{\textrm {SiSn}}^n \)––„Bogen“-Parameter unter Berücksichtigung der Abweichung vom linearen Gesetz für die Bandlückenbreite, \( {E}_{\mathrm{Ge}}^n \),\( { E}_{\mathrm{Si}}^n\) und \({E}_{\mathrm{Sn}}^n\)––Ge-, Si- und Sn-Bandlücken im entsprechenden Tal. Fast alle Parameter sind aus [24] entnommen. Die Bogenparameter für Täler L und Г stammen aus [25].
Nachdem wir die Position aller interessierenden Bänder im Heteroübergang bestimmt hatten, haben wir deren Verschiebung unter dem Einfluss von Deformationen berücksichtigt. Der Einfluss von Verformungen auf die Bandlücke wurde durch Verformungspotentialkonstanten berücksichtigt [26]. Da die zweidimensionalen Schichten pseudomorph waren, wurde in unserem Fall der Standardansatz zur Bestimmung von Deformationen verwendet, der beispielsweise in [26] beschrieben ist:Dehnungen in einer Quantentopfebene lassen sich aus ε xx(yy) = ε ǀǀ = (a GeSiSn − a Si )/a Si , wobei a ––die Gitterkonstante des entsprechenden Materials. In der Richtung senkrecht zur Ebene des Quantentopfs ist der Dehnungswert ε zz = −2(С 12 /С 11 )ε xx kann durch das C . bestimmt werden 12 und C 11 elastische Module der kristallinen Verbindung. Die Gitterkonstante der Mischkristalle wurde aus der quadratischen Beziehung bestimmt:
$$ {a}_{\mathrm{Ge}\mathrm{SiSn}}={a}_{\mathrm{Ge}}\left(1-xy\right)+{a}_{\mathrm{Si} }x+{a}_{\mathrm{Sn}}y+{b}_{\mathrm{Si}\mathrm{Ge}}^{\hbox{'}}x\left(1-x\right)+{ b}_{\textrm{Sn}\textrm{Ge}}^{\hbox{'}}y\left(1-y\right), $$wo a Ge , a Si , a Sn ––Ge-, Si- und Sn-Gitterparameter [24], \( {b}_{\mathrm{SiGe}}^{\hbox{'}} \)= − 0.026 Å, \( {b}_{\ mathrm{SnGe}}^{\hbox{'}} \) = 0.166 Å––«Bogen»-Parameter, unter Berücksichtigung der Abweichung vom Vegard-Gesetz.
Basierend auf den Banddiagrammberechnungen entsprechen die PL-Peaks den Interband-Übergängen zwischen dem X-Tal von Si oder dem Δ4 -Tal von GeSiSn und das Heavy-Hole-Band in der GeSiSn-Schicht (Abb. 8).
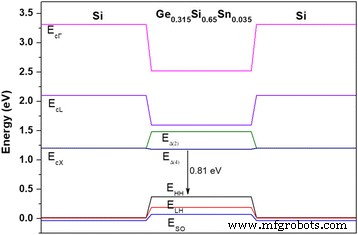
Das Si/Ge0.315 Si0,65 Sn0,035 /Si-Heterozusammensetzungsbanddiagramm
Schlussfolgerungen
Es wurden die kritischen 2D-3D-Übergangsdickenabhängigkeiten von der Zusammensetzung von GeSiSn-Schichten mit einem festen Ge- und Sn-Gehalt bestimmt, die von 0 bis 16 % bei einer Wachstumstemperatur von 150 °С variieren. Die Überstruktur-Phasendiagramme für das epitaktische Wachstum von Sn auf Si(100) und Ge(100) wurden erstellt. Die mehrschichtigen periodischen Strukturen mit pseudomorphen Schichten und mit einem GeSiSn-Inselarray mit einer Dichte von bis zu 1.8 × 10 12 sm −2 erhalten wurden. Erstmals wurde in der mehrschichtigen periodischen Struktur während des Si-Wachstums auf der GeSiSn-Schicht eine (10 × 1) Zweidomänen-Überstruktur beobachtet, die bei leichtem Tempern in eine (2 × 1) Überstruktur übergeht. Die periodischen GeSiSn/Si-Strukturen zeigten ihre Photolumineszenz im Bereich von 0,6–0,8 eV, was dem Wellenlängenbereich von 1,45–2 μm entspricht. Basierend auf den Banddiagrammrechnungen für die Struktur mit pseudomorphem Ge0.315 Si0,65 Sn0,035 Schichten entsprechen die PL-Peaks den Interband-Übergängen zwischen dem X-Tal von Si oder dem Δ4 -Tal von GeSiSn und das Heavy-Hole-Band in der GeSiSn-Schicht. Weitere Fortschritte im langwelligen Bereich erfordern eine Untersuchung der optischen Eigenschaften der Strukturen mit hohem Sn-Gehalt.
Abkürzungen
- CVD:
-
Chemische Gasphasenabscheidung
- MBE:
-
Molekularstrahlepitaxie
- ML:
-
Monoschicht
- PL:
-
Photolumineszenz
- RHEED:
-
Reflexion hochenergetische Elektronenbeugung
- STM:
-
Rastertunnelmikroskopie
- TEM:
-
Transmissionselektronenmikroskopie
Nanomaterialien
- Halbleiter-Nanopartikel
- Struktur und elektronische Eigenschaften von übergangsmetalldotiertem Kaolinit-Nanoton
- Modulation der elektronischen und optischen Anisotropieeigenschaften von ML-GaS durch vertikales elektrisches Feld
- Einfache Synthese und optische Eigenschaften kleiner Selen-Nanokristalle und -Nanostäbe
- Optische und elektrische Eigenschaften von Silizium-Nanodrähten, die durch stromloses Ätzen hergestellt wurden
- Einfluss von Wasser auf die Struktur und die dielektrischen Eigenschaften der mikrokristallinen und Nano-Cellulose
- Auswirkungen der Doppelschichtdicke auf die morphologischen, optischen und elektrischen Eigenschaften von Al2O3/ZnO-Nanolaminaten
- Abstimmung der Oberflächenmorphologien und -eigenschaften von ZnO-Filmen durch das Design der Grenzflächenschicht
- Optische und elektronische Eigenschaften von Femtosekundenlaser-induzierten Schwefel-hyperdotierten Silizium-N+/P-Photodioden
- Herstellung und optische Eigenschaften von GeBi-Filmen unter Verwendung der Molekularstrahl-Epitaxie-Methode



