Einfluss von Te-Doping auf katalysatorfreie VS-InAs-Nanodrähte
Zusammenfassung
Wir berichten über das Wachstum von Te-dotierten katalysatorfreien InAs-Nanodrähten durch Molekularstrahlepitaxie auf Silizium (111)-Substraten. Mit steigendem Dotierungsniveau wurden Veränderungen in der Drahtmorphologie, d. h. eine Abnahme der Länge und eine Zunahme des Durchmessers, beobachtet. Eine Kristallstrukturanalyse basierend auf Transmissionselektronenmikroskopie sowie Röntgenbeugung zeigt eine Verbesserung des Zinkblende/(Wurtzit+Zinkblende)-Segmentverhältnisses, wenn Te während des Wachstumsprozesses bereitgestellt wird. Darüber hinaus zeigen elektrische Zweipunktmessungen, dass eine erhöhte Te-Dotierung eine Erhöhung der Leitfähigkeit bewirkt. Zwei vergleichbare Wachstumsreihen, die sich nur im As-Partialdruck um etwa 1 × 10 −5 . unterscheiden Torr, während alle anderen Parameter konstant gehalten wurden, wurden auf verschiedene Te-Dotierungsniveaus analysiert. Ihr Vergleich legt nahe, dass die Kristallstruktur stark beeinflusst wird und die Leitfähigkeitszunahme bei Drähten, die bei einem vergleichbar höheren As-Partialdruck gewachsen sind, deutlicher ist.
Hintergrund
Nanodrähte (NWs) haben im letzten Jahrzehnt große Aufmerksamkeit auf sich gezogen, da sie als vielversprechender Baustein für neue und zukünftige Technologien gelten. Ihre technischen Anwendungen sind vielfältig und reichen von Feldeffekttransistoren über optische Bauelemente bis hin zu Solarzellen [1, 2]. Die breite Anwendbarkeit von NWs basiert auf ihren bemerkenswerten Eigenschaften, wie einem hohen Aspektverhältnis, extrem niedriger Verlustleistung und im Falle von InAs das Fehlen einer Schottky-Barriere an der Grenzfläche zu Metallkontakten [3,4,5] . Letzteres liegt daran, dass InAs eine oberflächliche Akkumulationsschicht aufweist, die eine ohmsche Kontaktierung ermöglicht [6]. Aus physikalischer Sicht weisen InAs-NWs herausragende Eigenschaften auf, d. h. eine hohe Elektronenbeweglichkeit [7], eine geringe effektive Masse [8], einen großen g-Faktor [9] und eine starke Rashba-Spin-Bahn-Kopplung [10, 11]. Aus diesem Grund wurden sie zu einem wichtigen Bestandteil der quanteninformationsbezogenen Forschung [5, 12, 13, 14].
InAs-NWs werden üblicherweise über ein Dampf-Flüssig-Feststoff-(VLS)-Wachstumsverfahren unter Verwendung von Goldtröpfchen als Katalysator gezüchtet. Die Verwendung von Au weist mindestens zwei Nachteile auf. Einerseits integriert es als ungewollte Verunreinigung in die NWs, die deren Materialeigenschaften verschlechtern [2, 15, 16], andererseits die Integration bereits demonstrierter wichtiger Anwendungen wie NW-Feldeffekttransistoren (FET) [17], Tunnel-FETs [18], Photodetektoren [19] usw. auf Silizium-Basis ist nicht möglich. Daher wurde in dieser Zuschrift ein zuvor entwickeltes katalysatorfreies Wachstum im Dampf-Feststoff(VS)-Modus angewendet [20]. Ein Teil der kubischen Zinkblende (ZB)-Phase, die die stabile Phase in Bulk-III-V-Materialien ist, ist die hexagonale Wurtzit (WZ)-Phase auch in Nanodrähten vorhanden. ZB-WZ-Polytypismus und andere Defekte wie Rotationszwillinge und Stapelfehler werden häufig gemeldet. Phasenreine, nahezu stapelfehlerfreie InAs-NWs können durch Au-unterstütztes VLS-Wachstum [21, 22] erhalten werden, jedoch nicht unter Verwendung der katalysatorfreien VS-Methode [23, 24, 25]. Diese Defekte wirken sich nachteilig auf den Transport [26, 27] und die optischen Eigenschaften [28] aus.
Eine Möglichkeit, dem verminderten Ladungstransport entgegenzuwirken, ist die Verwendung von Dotierung, d. h. der Einbau zusätzlicher Ladungsträger. Die etablierten Dotierungsverfahren für III-V-Verbindungshalbleiterschichten lassen sich jedoch nicht ohne weiteres auf die Drahtstrukturen übertragen. Die Nanodrähte weisen axiale und radiale Wachstumsfacetten mit unterschiedlicher Kristallorientierung und Oberflächenrekonstruktionen auf, was zu einem stark anisotropen Wachstum führt, das den Dotierstoffeinbau beeinflussen soll. Die Situation wird durch die unterschiedlichen Wachstumsmodi, Dampf-Flüssig-Feststoff (VLS) und VS, der beteiligten Facetten [29, 30] und den eigentümlichen Kristallphasen-Polytypismus [31] erschwert. All diese spezifischen Eigenschaften führen zu einer inhomogenen Dotierstoffverteilung, sowohl axial als auch radial [29, 32, 33]. Das Gruppe-IV-Element Si wurde allgemein als n-Typ-Dotierungsmittel für MBE-gewachsene III-V-Dünnfilme verwendet. Es ist jedoch bekannt, dass Si ein amphoteres Verhalten zeigt, d. h. je nach Substratorientierung und Wachstumsbedingungen können Si-Atome als Donoren auf Kationengitterplätzen oder Akzeptoren auf Anionengitterplätzen eingebaut werden [34, 35]. Dieses Verhalten wurde auch bei Nanodrähten beobachtet, da es mit den unterschiedlichen Kristallorientierungen der am Wachstum beteiligten Facetten, den Wachstumsmechanismen und der Wachstumstemperatur korreliert [29, 36, 37]. Andererseits ist das Gruppe-VI-Element Te ein sehr wirksames n-Dotierungsmittel in Epischichten [38], das kein Risiko für amphoteres Verhalten darstellt. Darüber hinaus hat Te einige andere Vorteile:eine niedrigere Ionisierungsenergie im Vergleich zu anderen n-Typ-Dotierstoffen, die üblicherweise in III-V-Materialsystemen verwendet werden, was möglicherweise zum Erreichen höherer Dotierungsniveaus führt [39]; einen niedrigeren Diffusionskoeffizienten [40] und einen schwächeren Memory-Effekt im Vergleich zu anderen Elementen der Gruppe VI, nämlich S und Se, die für abrupte Grenzflächen wichtig sind [41]. Das ausschließlich n-dotierte Dotierverhalten von Te wurde für Au-katalysierte [42] und selbstkatalysierte GaAs-Nanodrähte beschrieben, was das Potenzial für hohe Dotierungskonzentrationen, aber auch die Auswirkungen auf die Drahtmorphologie und Kristallstruktur zeigt [43, 44] .
In dieser Mitteilung untersuchen wir die Te-Dotierung in InAs-NWs und liefern Informationen über den Einfluss der Dotierung auf die NW-Morphologie und den Wechsel zwischen der ZB- und der WZ-Struktur innerhalb des VS-Wachstums in Gegenwart von Te. Untersuchungen mit Rasterelektronenmikroskopie (REM) ergaben einen starken Einfluss von Te auf die NW-Morphologie. Hochauflösende Transmissionselektronenmikroskopie (HR-TEM) [45] und Röntgenbeugungsmessungen (XRD) dienten zum Nachweis einer Veränderung des ZB/(WZ + ZB)-Verhältnisses und elektrische Zweipunktmessungen zeigten eine Erhöhung der Leitfähigkeit mit Erhöhung des Te-Doping-Niveaus.
Methoden/Experimental
InAs-NWs wurden im VS-Modus ohne Verwendung eines Fremdkatalysators auf n-Si-(111)-Substraten gezüchtet.
Substratvorbereitung
Vor dem Wachstum wurden die Substrate mit HF und DI-Wasser gereinigt. Eine aufeinanderfolgende Wasserstoffperoxidbehandlung für 45 s führt zur Bildung eines wenige Angström dicken SiO2-Films, der Pinholes enthält, die als Nukleationszentren für das NW-Wachstum dienen [20]. Nach der Oxidation wurden die Substrate sofort in die Schleuse überführt, in der sie 45 Minuten lang auf 200 °C erhitzt wurden. Darauf folgte ein Entgasungsschritt in der Präparationskammer, bei dem die Proben weitere 45 min auf 400°C erhitzt wurden.
Wachstum der InAs-Nanodrähte
Die NWs wurden bei einer Substrattemperatur von 475 °C für 1:20 h in einer Omicron Pro 100 Molekularstrahlepitaxie (MBE)-Kammer gezüchtet. Eine Wachstumsrate von 0,1 μmh −1 wurde für das NW-Wachstum verwendet. Arsen wurde über eine As-Cracker-Zelle bereitgestellt und der As4-Strahläquivalentdruck (BEP) wurde auf Werte von 2,3 × 10 –5 . eingestellt Torr und 3,3 × 10 –5 Torr. Die erste Probenserie (Serie A) wurde bei höherem As-Partialdruck im Vergleich zu einer zweiten Wachstumsserie (Serie B) (vgl. Tabelle 1) kultiviert, während alle anderen Parameter konstant gehalten wurden. Tellur wurde während des Wachstums mit stöchiometrischem GaTe zugeführt. Die Betriebstemperatur der Effusionszelle wurde zwischen 401 °C und 562 °C variiert, basierend auf Kalibrierungen, die an Te-dotierten GaAs-Schichten über Hall-Messungen durchgeführt wurden. Die GaTe-Zellentemperaturen von 401 °C, 447 °C, 500 °C und 561 °C entsprechen einer Ladungsträgerkonzentration von etwa 1 × 10 15 cm −3 , 4 × 10 16 cm −3 , 5 × 10 17 cm −3 , und 6 × 10 19 cm −3 jeweils in GaAs (100)-Schichten, die für die Kalibrierung verwendet werden.
Geräteverarbeitung
Um Zweipunktkontakte zu verarbeiten, wurden die NWs mechanisch auf ein vorstrukturiertes Si-Substrat übertragen, das mit 200 nm SiO2 bedeckt war. Eine schematische Darstellung der Schritte zur Kontaktaufnahme finden Sie in der zusätzlichen Datei 1:Abbildung S1. Vor der Metallabscheidung wurden die Drähte mit einem Dreischichtsystem aus 50 K (AR-P639.04), 50 K und 950 K (AR-P679.04) PMMA-Resist aufgeschleudert, auf dem die Kontaktform definiert wurde über Elektronenstrahllithographie. Nach der Entwicklung wurde die Kontaktfläche mit verdünntem 3,5 % Ammoniumpolysulfid (H2 .) passiviert O:(NH4)2 S3 , 34:1) bei 60 °C für 30 min. Die Elektroden, bestehend aus 100 nm Titan und 40 nm Gold, wurden über einen Elektronenstrahlverdampfer abgeschieden.
Die vollständige Liste der Proben, die durch REM-, TEM-, XRD- und elektrische Messungen untersucht wurden, ist in Tabelle 1 dargestellt. Hier bezeichnen die Buchstaben A, B und C die Probenserien, die jeweils bei unterschiedlichen As-Partialdrücken gezüchtet wurden, aber abgesehen davon unter gleichen Bedingungen. Eine GaTe-Temperatur von 0°C entspricht einem geschlossenen Zellenverschluss.
Ergebnisse und Diskussion
Morphologie
Die REM-Bildgebung wurde verwendet, um den Einfluss der Te-Dotierung auf die Drahtmorphologie zu untersuchen. Die Ergebnisse sind in Abb. 1 dargestellt. Jeder Datenpunkt in den Diagrammen stellt den Mittelwert von mindestens 40 Drähten und der Fehlerbalken ihre Standardabweichung dar.

Nanodraht-Morphologie. Mittlere Länge und Durchmesser von Nanodrähten bei verschiedenen GaTe-Zelltemperaturen. a Serie A wurde bei einem As-Partialdruck von etwa 3,3 × 10 –5 . gezüchtet Torr. b Serie B wurde bei einem As-Partialdruck von 2,3 × 10 –5 . angebaut Torr. Die gestrichelten Linien sind Orientierung für die Augen. Die im Einschub gezeigte REM-Aufnahme zeigt undotierte InAs-NWs, umgeben von während des Wachstums gebildeten Kristalliten. Der Maßstabsbalken beträgt 300 nm bzw. 120 nm
Abbildung 1a zeigt die Morphologie der Drahtserie A, die bei einem As-Partialdruck von etwa 3,3 × 10 −5 . gewachsen ist Torr. Die Temperatur der GaTe-Zellen reichte von 0°C bis 561°C. Unter Berücksichtigung des Fehlerbalkens wird bis zu einer Zelltemperatur von 500°C kein deutlicher Trend des NW-Durchmessers und der NW-Länge beobachtet. Bei 561 °C ist die Zufuhr von Te jedoch eindeutig nachteilig, was zu einer starken Zunahme des Durchmessers und einer Abnahme der NW-Länge führt. Wachstumsserie B, dargestellt in Abb. 1b, wurde bei einem vergleichsweise niedrigeren As-Druck von 2,3 × 10 –5 . gezüchtet Torr. Der Einschub zeigt eine beispielhafte REM-Seitenansicht einer gewachsenen Probe, die InAs-NWs und Cluster auf der Substratoberfläche aufweist. Weitere REM-Bilder der Serien A und B sind in der zusätzlichen Datei 1:Abbildung S2 zu sehen. Dabei wurde ein GaTe-Zell-Temperaturbereich von 0°C bis 462°C erforscht. Wir beobachten eine Längenverringerung, wenn Te während des Wachstums für Serie B bei einer Zelltemperatur von 401 °C zugegeben wird. Vergleicht man die Messungen der Serien A und B im gleichen Temperaturintervall, so fällt auf, dass insbesondere die Abnahme der NW-Länge bei vergleichsweise niedrigeren As-Drücken (Serie B) deutlicher ist. Es wird jedoch der gleiche Gesamttrend, d. h. eine Abnahme der NW-Länge für beide Serien und eine Zunahme des Durchmessers für die Serie A beobachtet.
Eine Si-Dotierung führt unabhängig von der Aufwachsmethode (MBE oder metallorganische Gasphasenepitaxie (MOVPE)) für InAs und GaAs ähnlich zu einem vergrößerten Durchmesser und einer verringerten Länge [46, 47]. Die gleiche Dimensionsänderung wurde bei der Te-Dotierung von katalysatorfreien GaAs-NWs beobachtet, die durch MBE gezüchtet wurden [44]. Es scheint, dass unabhängig vom verwendeten Materialsystem, dh IIIV-Materialien, die mit Gruppe IV (InAs/Si, GaAs/Si) oder Gruppe VI-Materialien (GaAs/Te, InAs/Te) dotiert sind, der gleiche Gesamttrend bezüglich der Morphologie beobachtet wird.
Te weist einen relativ großen kovalenten Radius zu den Wirtsgitteratomen auf und kann daher als Tensid wirken [48, 49]. Das beobachtete Verhalten könnte daher auf eine durch Te verursachte verminderte Diffusionsfähigkeit der In-Atome zurückzuführen sein. Dies wiederum könnte zu einer Zunahme des radialen Wachstums und einer Abnahme der Länge führen, da die In-Adatome auf ihrem Weg zur NW-Spitze behindert werden, wo sie das Wachstum kontrollieren [46]. Beim Vergleich von Abb. 1a (Reihe A) und Abb. 1b (Reihe B) stellen wir fest, dass der As-Druck beeinflusst, wie die Drahtmorphologie durch die Te-Zugabe beeinflusst wird. Die Ergebnisse legen nahe, dass es möglich sein könnte, dem abnehmenden Einfluss von Te auf die radiale und axiale Dimension des InAs-Drahts durch eine gewisse Erhöhung des As-Drucks entgegenzuwirken.
Kristallstruktur
Der Einfluss der Te-Dotierstoffe auf die Kristallstruktur wurde mit TEM und XRD untersucht. In Anlehnung an die Klassifikation von Caroff et al. [49] wurde eine Kristallstapelsequenz einem ZB- (vgl. Abb. 2a) oder einem WZ- (vgl. Abb. 2d) Segment zugeordnet, wenn die Stapelsequenz genau vier Atomdoppelschichten folgte. Das heißt, ...ABCA... wurde als ZB-Segment und ...ABAB... als WZ-Segment gezählt. Dies ist in Abb. 2b dargestellt, z. Hier repräsentiert jeder Buchstabe eine Doppelschicht von Atomen. Einige Drahtabschnitte werden durch Stapelfehler (SFs) unterbrochen, die aus einer fehlenden oder überschüssigen Schicht innerhalb der Kristallfolge bestehen, wie in Abb. 2c, f dargestellt. Obwohl selten beobachtet, gibt es auch in einigen Segmenten Rotationszwillinge (hier nicht gezeigt).
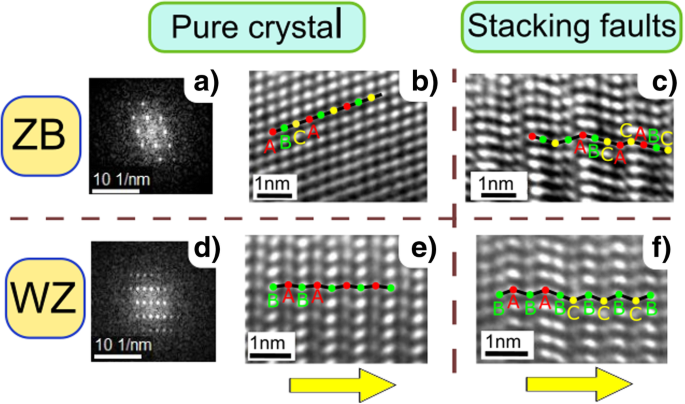
Kristallstrukturanalyse. HR-TEM-Bilder von InAs-NWs, die die ZB- und WZ-Kristallstrukturen mit und ohne Stapelfehler veranschaulichen. Die gelben Pfeile zeigen die [111]-Wachstumsrichtung an. Die farbigen Punkte und die schwarzen Linien dienen dem Auge als Orientierungshilfe, um die Stapelcharakteristik nachzuvollziehen. a FFT-Beugungsdiagramm für defektfreie ZB. b , c ZB-Struktur. d FFT-Beugungsdiagramm für defektfreies WZ und e –f WZ-Struktur
Kristallschnitte wurden nur dann als ZB- oder WZ-Segmente identifiziert, wenn eine vollständige Sequenz bestehend aus vier Doppelschichten von Atomen beobachtet wurde. Die restlichen Abschnitte wurden SFs oder Rotationszwillingen zugeschrieben.
Die Kristallstruktur bei drei verschiedenen Dotierungsniveaus, die gemäß den erläuterten Eigenschaften bewertet wurden, ist in Abb. 3 dargestellt. Verschiedene WZ- und ZB-Bereiche sind hervorgehoben. Für die Analyse wurden jedoch nur einzelne Segmente gezählt. Um den Einfluss der Te-Dotierung auf die NW-Kristallstruktur zu quantifizieren, wurde eine Gesamtlänge von ca. 150 nm an Segmenten aus 10 NWs für jede Dotierungsstufe analysiert und gemittelt (vgl. Abb. 3b–d). Das ZB/(WZ + ZB)-Segment-Verhältnis wurde durch Zählen der Anzahl der einzelnen ZB- und WZ-Segmente bestimmt. Die Proben B1, B3, C1 und A4 wurden bei 0 °C, 447 °C und 500 °C analysiert (vgl. Abb. 4). Wir beobachten eine Verbesserung des ZB/(WZ + ZB) Segmentverhältnisses mit steigender GaTe-Zelltemperatur. Dieser Trend ist in Abb. 4 dargestellt. Beim Vergleich der ersten beiden Datenpunkte (0 °C und 447 °C) ist das verbesserte Verhältnis auf einen stärkeren Anstieg der ZB-Segmente im Vergleich zum Anstieg der WZ-Segmente von den undotierten zu den zurückzuführen niedrigste Dotierungstemperatur (vgl. Einschub Abb. 4). Beide Strukturtypen werden verbessert und die Anzahl der SFs verringert. Beim dritten Punkt sieht der Trend jedoch anders aus. Vergleicht man das höchste mit dem niedrigsten Dotierungsniveau (500 °C und 447 °C), stellen wir fest, dass die Zahl der WZ-Segmente abnimmt und die Zahl der ZB-Segmente nahezu konstant bleibt (vgl. Einschub Abb. 4), während die Zahl der SFs steigt. Dies führt zu einem erhöhten Verhältnis. Dennoch wird der ZB-Abschnitt im Vergleich zum undotierten Fall gefördert. Schließlich zeigen die Ergebnisse, dass die Te-Dotierung tatsächlich das ZB/(WZ + ZB)-Segmentverhältnis verbessert. Es bleibt jedoch mehrdeutig, wenn die Bildung von ZB-Segmenten strikt durch den Te-Einbau gefördert wird.
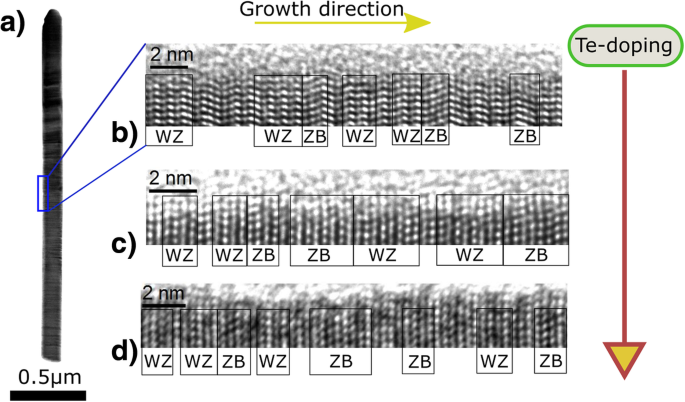
Einfluss der Te-Dotierung auf die Kristallstruktur. TEM-Bilder, die die Kristallstruktur in undotierten und Te-dotierten InAs-NWs zeigen. a Seitenansicht eines InAs NW. b –d HR-TEM-Bilder der InAs NW-Kristallstruktur (Bild um 90° im Uhrzeigersinn gedreht). Die Bereiche WZ und ZB sind gekennzeichnet. Folgende Proben und GaTe-Zelltemperaturen wurden gewählt:b B1 (As4 -BEP = 2.3 × 10 −5 Torr), undotiert, d. h. 0°C. c B3 (As4 -BEP = 2.3 × 10 −5 Torr), 447 °C. d C1 (As4 -BEP = 3.0 × 10 −5 Torr), 500°C

Verhältnis zwischen ZB- und WZ-Segmenten. Verhältnis der Anzahl der ZB-Segmente und der Gesamtanzahl der als WZ oder ZB identifizierten Segmente in Abhängigkeit von der GaTe-Zelltemperatur. Für die ersten beiden Messungen wurden B1 und B3 analysiert. Bei 500°C wurden die Ergebnisse der Drähte C1 und A4 zusammengeführt, während sie bei ähnlichem As-BEP gezüchtet wurden. Das Balkendiagramm im Einschub zeigt die akkumulierte Länge aller WZ- und ZB-Segmente, die im NW bei der angezeigten Zelltemperatur vorhanden sind.
Um die Beobachtungen von TEM zu ergänzen, wurden XRD-Messungen durchgeführt. Wir führten -Scans durch, die sich auf den kubischen (220) und den hexagonalen [10,11,12,13,14,15]-Reflex konzentrierten. Diese Reflexe lassen sich eindeutig der ZB- bzw. der WZ-Struktur zuordnen. Die Messung der jeweiligen Intensitäten ermöglichte die Extraktion des I ZB /(ich ZB + Ich WZ ) Intensitätsverhältnis. Die in Fig. 5a abgebildeten φ-Scans dienten dazu, die relativen Intensitäten der ZB- und WZ-Peaks bei jeder GaTe-Zellen-Dotierungstemperatur zu bestimmen. Beim ZB-Reflex treten sechs Peaks auf, obwohl das kubische Gitter nur zu einer 3-zähligen Symmetrie führen sollte. Wir weisen diese Peaks symmetrischen Zwillingen in der ZB-Struktur zu. Die im WZ-Scan auftretenden sechszähligen symmetrischen Peaks sind charakteristisch für die hexagonale Kristallstruktur und entsprechen unseren Erwartungen. Hier wird angenommen, dass die Signalintensität von InAs-Oberflächenkristalliten (vgl. Einschub in Abb. 1) um zwei Größenordnungen kleiner ist als das NW-Signal [50] und kann daher vernachlässigt werden. Das entsprechende Intensitätsverhältnis I ZB /(ich ZB + Ich WZ ) ist in Abb. 5b aufgetragen (farbige Dreiecke für Serie A). Es zeigt eine Zunahme des I ZB /(ich ZB + Ich WZ ) Intensitätsverhältnis mit steigender GaTe-Zelltemperatur, sichtbar nach 401 °C für Serie A. Dieses Ergebnis stimmt mit der bereits aus der TEM-Analyse erhaltenen Beobachtung überein. Beachten Sie, dass die angegebenen Intensitätsverhältnisse nicht das reale ZB/WZ-Verhältnis darstellen, sondern ein qualitatives Ergebnis darstellen. Dies liegt daran, dass unterschiedliche Reflexe unterschiedlich stark sind, je nach dem nicht explizit berücksichtigten Strukturfaktor. Der Vergleich zwischen den Datenpunkten bleibt jedoch gültig. Die gleiche reflexempfindliche Messung wurde für Serie B durchgeführt, die bei einem niedrigeren As-Druck als die oben dargestellte Serie A gezüchtet wurde. Die in Abb. 5b (schwarze Punkte) dargestellten Ergebnisse zeigen einen ähnlichen Trend wie die A-Reihe, d. h. eine Zunahme des Intensitätsverhältnisses ZB/(WZ + ZB) bei höheren Zelltemperaturen. Allerdings ist der Einfluss der Te-Atome auf die Kristallstruktur im Vergleich zu höheren As-Drücken weniger ausgeprägt und ein deutlicher Anstieg wird erst bei 462 °C beobachtet. Obwohl Serie B nur eine Verbesserung des ZB/(WZ + ZB)-Intensitätsverhältnisses im XRD für die höchste GeTe-Zelltemperatur von 462 °C zeigt, zeigt Serie A einen deutlichen Anstieg bei 447 °C und 500°C Zelltemperatur. Diese Beobachtung legt nahe, dass die As-Atome den Einbau von Te-Atomen erleichtern, was wiederum zu einer Veränderung der Kristallstruktur führt. Daher wird für den entsprechend höheren As-Druck ein stärkerer Einfluss auf das ZB/(WZ + ZB)-Verhältnis beobachtet. Die Abnahme des Intensitätsverhältnisses bei 447 °C in Abb. 5b könnte auf Schatteneffekte zurückzuführen sein, da die NW-Dichte für Probe B3 über dem Durchschnitt lag, obwohl dies noch nicht vollständig geklärt ist.

Röntgenanalyse der Gitterstruktur. a φ Scans, die durch Röntgenmessungen an InAs NWs A1-A4 erhalten wurden. b Resultierendes I ZB /(ich WZ + Ich ZB ) Intensitätsverhältnis vs. GaTe-Zellentemperatur. Die dreieckigen Datenpunkte werden aus den Messungen extrahiert, die in (a ) für die Proben A1–A4. Die schwarzen Punkte zeigen die Datenpunkte der Samples B1–B4 an
Aus den oben präsentierten TEM-Ergebnissen schließt man, dass die NWs, die unter Te-Angebot angebaut wurden, eine erhöhte Anzahl von ZB- und WZ-Segmenten und damit weniger SFs im Vergleich zum undotierten Fall aufweisen. Weiterhin zeigen die XRD-Messungen, dass das ZB/(WZ + ZB)-Intensitätsverhältnis mit steigendem Te-Dotierungsniveau (bei höheren Temperaturen) zunimmt, was qualitativ mit den TEM-Messungen übereinstimmt. Im Gegensatz zu üblichen Elementen, die zur Dotierung von III-V-Materialien wie Si (InAs/Si [30], GaAs/Si), C (GaAs/C) oder Be (GaAs/Be) verwendet werden, beeinflusst Te deutlich die Kristallstruktur des NW. Die Förderung der beobachteten ZB-Bildung könnte von einer Änderung der Oberflächenenergien herrühren, die die Energiebarriere für die ZB-Keimbildung senkt. Dies wurde auch bei Zink-dotierten InP-Nanodrähten [51] beobachtet, bei denen Au-katalysiertes VLS-Wachstum verwendet wurde. Es sind jedoch weitere Forschungen erforderlich, um den zugrunde liegenden Mechanismus zu klären.
Elektrische Messungen
Die Leitfähigkeit definiert durch σ = A·R·L −1 w wurde aus Zweipunktmessungen mit Ti/Au-Kontakten extrahiert. Hier ist A der sechseckige Querschnitt des Drahtes mit A = 3√3d 2 NW /8 wobei d NW ist der maximale Durchmesser, R der Widerstand und Lw der Abstand zwischen den elektrischen Kontakten. L w und d NW wurden für jeden Draht einzeln per REM-Bildgebung gemessen. Exemplarische I-V-Eigenschaften von undotierten und dotierten InAs-NWs sind in den Fig. 6a–d dargestellt. Die Grafiken zeigen das erwartete ohmsche Verhalten aufgrund der Oberflächenakkumulationsschicht von InAs [6, 52]. Die Leitfähigkeit in Abhängigkeit vom Dotierungsniveau wurde anhand der I–V-Messungen und der NW-Geometrie bestimmt. Die resultierende Abhängigkeit zwischen der Leitfähigkeit und der GaTe-Zellentemperatur ist in Abb. 6e dargestellt. Bei jeder Temperatur wurden für Serie A mindestens 20 NWs untersucht. Beim Vergleich von undotierten und dotierten Drähten wird eine Zunahme der durchschnittlichen Leitfähigkeit um etwa eine Größenordnung bei der höchsten Dotierung beobachtet. Bei einer GaTe-Zellentemperatur von 500°C wurde eine durchschnittliche Leitfähigkeit von ca. 80 S/cm ermittelt (im Vergleich zu ca. 8 S/cm bei 0°C). Obwohl die Streuung der Leitfähigkeit für höhere Dotierungsniveaus recht deutlich ist, zeigt unsere Beobachtung, dass der Einbau von Te tatsächlich einen starken Einfluss hat, was im Durchschnitt zu einer erhöhten Leitfähigkeit führt. Der Vergleich von XRD und Leitfähigkeitsmessung legt nahe, dass unterhalb von 401 °C der Einfluss von Te auf die Kristallstruktur und die Transporteigenschaften nur eine untergeordnete Rolle spielt. Die oben erwähnte große Varianz der Leitfähigkeit von InAs-NWs wurde in ähnlicher Weise in der Literatur beschrieben [53]. Hinsichtlich einer Änderung des NW-Durchmessers oder des Kontaktabstands wurde erwartungsgemäß kein Trend der Leitfähigkeit beobachtet [26]. Somit schließen wir das unterschiedliche Seitenverhältnis als Fehlerquelle aus. Wir identifizieren drei Hauptgründe, die für die starke Varianz der Leitfähigkeit verantwortlich sind:(i) Die Kontaktpassivierungsmethode mit Ammoniumpolysulfid könnte zu einer heterogenen Kontaktqualität führen. (ii) Die Drahtoberfläche wird nicht passiviert und Oberflächenzustände können durch eine inhomogene Sättigung der Dangling Bonds an den Drahtseitenfacetten über Wasser und Sauerstoff beeinflusst werden, was schließlich zu einer ungleichmäßigen Oberflächenoxidation führt. Dies wiederum hat einen starken Einfluss auf die Transporteigenschaften und führt zu großen Fehlern [54]. Eine Möglichkeit, diese heterogenen Oberflächenzustände zu verhindern, ist die Passivierung durch in-situ-Abscheidung von Al2 O3 [53, 55]. (iii) Eine inhomogene Dotierung entlang des NW, wie sie bei der Si-Dotierung beobachtet wurde [26], könnte ebenfalls die große Datenstreuung verursachen, obwohl wir versuchten, dies auszuschließen, indem wir die Kontakte für jeden Draht zentriert platzierten. Schließlich können Variationen der NW-Länge (vgl. Abb. 1) und der Dichte zu Schatteneffekten führen, die einen homogenen Te-Einbau über die Probe verhindern. Es sind jedoch systematischere Untersuchungen erforderlich, um den Ursprung der beobachteten großen Varianz zu identifizieren. Zusätzlich wurden Leitfähigkeitsmessungen für NWs der Serie B durchgeführt, die bei einem vergleichsweise niedrigeren As-Druck gewachsen waren. Dabei wurden für jede GaTe-Zelltemperatur mindestens sechs Drähte gemessen. Die in Abb. 6e dargestellten Ergebnisse zeigen ein ähnliches Verhalten wie die oben für Serie A diskutierten. Die Leitfähigkeit von InAs-NWs wird für höhere GaTe-Zellentemperaturen erhöht. Der Effekt ist jedoch im Vergleich zu Serie A, die bei einem höheren As-Druck gewachsen ist, weniger ausgeprägt. Vergleicht man die Leitfähigkeiten beider Serien bei 401 °C und 447 °C in Abb. 6e, so stellen wir fest, dass die Werte für Serie A etwa doppelt so groß sind wie die für B. Die oben dargestellten XRD-Ergebnisse (vgl. Abb. 5 ) veranschaulichen, dass die Kristallstruktur in Reihe A stärker durch den Te-Einbau beeinflusst wird als in Reihe B. Die Kombination beider Befunde weist darauf hin, dass die erhöhte Leitfähigkeit mit der Änderung der Kristallstruktur zusammenhängt, dh die erhöhte ZB/(WZ + ZB) Intensitätsverhältnis. Aus der Literatur ist bekannt, dass eine Modifikation der InAs-NW-Kristallstruktur von WZ-dominiert zu ZB-dominiert die Leitfähigkeit erhöht [50, 53, 56]. Basierend auf TEM-Untersuchungen zu InAs1 − x Sbx NWs, Sourribes et al. berichteten über einen Anstieg der Leitfähigkeit um 1,5 bei einer Zunahme des NW-ZB-Anteils von 20 auf 80 % [50]. Unsere TEM-Ergebnisse (vgl. Abb. 4) zeigen ein erhöhtes ZB/(WZ + ZB)-Verhältnis von 32 % (undotiertes NW) auf 43 % (maximal dotiertes NW), während der gemittelte Leitfähigkeitswert um etwa den Faktor 10 ansteigt. Dies Ein Vergleich legt nahe, dass die veränderte Kristallstruktur nicht der einzige Grund für die Leitfähigkeitserhöhung ist. Obwohl die Modifikation der Kristallstruktur den Ladungsträgertransport beeinflusst, ist der beobachtete Effekt wahrscheinlich ebenfalls auf eine erhöhte Ladungsträgerdichte zurückzuführen, die durch Te als Donor induziert wird.
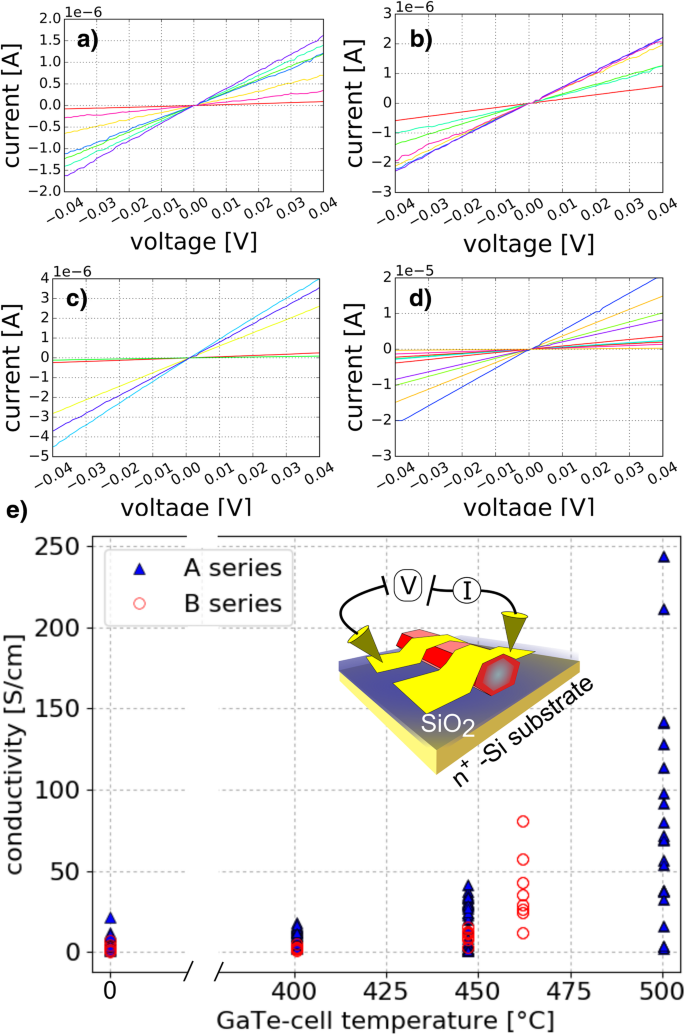
Elektrische Charakterisierung. a –d Exemplarische I–V-Messungen von InAs-NWs bei einer GaTe-Zelltemperatur von 0°C, 401°C, 447°C und 500°C (Serie A), gemessen über Zweipunktkontakte. e Ermittelte Leitfähigkeitswerte von Te-dotierten InAs NWs in Abhängigkeit von der GaTe-Zelltemperatur für die A (hohe As-BEP) und B (niedrige As-BEP) Serie. Der Einschub zeigt eine schematische Darstellung der elektrischen Messkonfiguration
Schlussfolgerung
Zusammenfassend haben wir Te-dotierte katalysatorfreie InAs-NWs auf Si(111)-Substraten über das Dampf-Feststoff-Wachstumsverfahren gezüchtet. Te wurde von einer GaTe-Zelle bereitgestellt, die das Wachstum von Te-dotierten InAs-NWs bei unterschiedlichen Dotierungsniveaus durch Anpassen der Zelltemperatur ermöglichte. Zwei Probenserien, die bei verschiedenen As-BEPs gezüchtet wurden, wurden durch SEM-, TEM-, XRD- und elektrische Messungen charakterisiert. Wir haben gezeigt, dass Te die NW-Morphologie verändert, was zu einem allgemeinen Trend einer erhöhten radialen und einer verringerten axialen Wachstumsrate führt. Die Wirkung ist bei vergleichsweise niedrigeren As-Partialdrücken stärker. TEM- und XRD-Messungen zeigten, dass die NW-Kristallstruktur durch die Zugabe von Te beeinflusst wird, was zu einer Erhöhung des ZB/(WZ + ZB)-Verhältnisses für beide Wachstumsreihen führt. Der Einfluss auf die bei vergleichsweise höherem As-BEP gewachsene NW-Kristallstruktur war stärker als bei NWs beobachtet, die bei niedrigerem As-BEP gewachsen waren. Elektrische Zweipunktmessungen zeigten eine Zunahme der durchschnittlichen Leitfähigkeit von Drähten, die unter Te-Zufuhr gewachsen waren. Dies wurde für zwei Wachstumsserien beobachtet, die bei unterschiedlichen As-Drucken kultiviert wurden. Der Vergleich zwischen den beiden Probenserien zeigte, dass die Kristall- und elektrischen Eigenschaften von InAs-NWs bei höheren As-Drucken stärker durch die Zugabe von Te beeinflusst werden. Das Ergebnis zeigt, dass die verbesserte durchschnittliche Leitfähigkeit stark mit der Änderung der Kristallstruktur zusammenhängt, d. h. der Zunahme des ZB/(WZ + ZB)-Verhältnisses. Wir führen die verbesserten Transporteigenschaften sowohl dem eingebauten Gruppe-VI-Element Te als Donor als auch einer veränderten Kristallstruktur zu. Diese Arbeit stellt einen wichtigen Beitrag dar, um die Möglichkeiten der NW-Dotierung zu erweitern, die von großem Interesse ist, um der Verschlechterung der Transporteigenschaften durch SF entgegenzuwirken.
Abkürzungen
- Als:
-
Arsen
- BEP:
-
Strahläquivalentdruck
- C:
-
Kohlenstoff
- GaAs:
-
Galliumarsenid
- Gate:
-
Galliumtellurid
- HR-TEM:
-
Hochauflösende Transmissionselektronenmikroskopie
- InAs:
-
Indiumarsenid
- MBE:
-
Molekularstrahlepitaxie
- MOVPE:
-
Metallorganische Gasphasenepitaxie
- NW:
-
Nanodraht
- SEM:
-
Rasterelektronenmikroskopie
- SF:
-
Stapelfehler
- Si:
-
Silizium
- Te:
-
Tellur
- VS:
-
Dampffest
- WZ:
-
Wurtzit
- XRD:
-
Röntgenbeugung
- ZB:
-
Zinkblende
Nanomaterialien
- Stützen des IoT-Wachstums
- Wachstum von CMMS für kleine Unternehmen
- Materialwissenschaftler bringen Nanodrähten das Tanzen bei
- Über halbleitende Nanopartikel
- Untersuchungen von Leerstandsstrukturen im Zusammenhang mit ihrem Wachstum im h-BN-Blatt
- Selbstkatalysiertes Wachstum von vertikalen GaSb-Nanodrähten auf InAs-Stämmen durch metallorganische chemische Gasphasenabscheidung
- Amorphe Silizium-Nanodrähte, die durch Glühen auf Siliziumoxid-Film gewachsen sind
- Theoretische Untersuchung von biaxial zugbelasteten Germanium-Nanodrähten
- Kontrollieren des Wachstums von Indiumselenid (In2Se3)-Nanodrähten mit hoher Gleichmäßigkeit durch den schnellen thermischen Glühprozess bei niedrigen Temperaturen
- Einfluss der elastischen Steifigkeit und Oberflächenhaftung auf das Prellen von Nanopartikeln



