Wachstum und selektives Ätzen von phosphordotierten Silizium/Silizium-Germanium-Mehrschichtstrukturen für vertikale Transistoranwendungen
Zusammenfassung
Vertikale Gate-Allround-Feldeffekttransistoren (vGAAFETs) gelten als potenzielle Kandidaten, um FinFETs für fortschrittliche Fertigungstechnologien für integrierte Schaltungen am/über 3-nm-Technologieknoten zu ersetzen. Eine Mehrschicht (ML) aus Si/SiGe/Si wird gewöhnlich aufgewachsen und verarbeitet, um vertikale Transistoren zu bilden. In dieser Arbeit wurde der P-Einbau in Si/SiGe/Si und das vertikale Ätzen dieser MLs gefolgt von einem selektiven Ätzen von SiGe in lateraler Richtung untersucht, um Strukturen für vGAAFET zu bilden. Für die Epitaxie wurden mehrere Strategien vorgeschlagen, wie beispielsweise die Wasserstoffspülung, um den Zugang von P-Atomen auf der Si-Oberfläche zu vermindern, und/oder das Einfügen eines Si oder Si0.93 Ge0.07 Abstandshalter auf beiden Seiten der P-dotierten Si-Schichten und als Ersatz für SiH4 von SiH2 Kl2 (DCS). Experimentelle Ergebnisse zeigten, dass die Segregation und Autodotierung auch durch Zugabe von 7% Ge zu P-dotiertem Si gelindert werden konnte. Die Struktur hatte eine gute Gitterqualität und hatte fast keine Dehnungsrelaxation. Das selektive Ätzen zwischen P-dotiertem Si (oder P-dotiertem Si0.93 Ge0.07 ) und SiGe wurde auch unter Verwendung von Nass- und Trockenätzen diskutiert. Die Leistung und Selektivität verschiedener Ätzverfahren wurden ebenfalls verglichen. Dieses Papier vermittelt Kenntnisse darüber, wie man mit den Herausforderungen oder Schwierigkeiten der Epitaxie und des Ätzens von n-Schichten in vertikalen GAAFETs-Strukturen umgeht.
Einführung
Da die Skalierung von komplementären Metalloxidhalbleitern (CMOS) an ihre physikalischen Grenzen stößt, schwächen die Kurzkanaleffekte die Leistung des Transistors erheblich. Eine Lösung für diese Probleme sind neue Transistordesigns, z. B. GAAFETs (Gate-all-around-Feldeffekttransistoren), die auch als vielversprechendster Kandidat für Nanotransistoren bis hinunter zum 3-nm-Technologieknoten gelten [1,2,3 ,4,5,6]. Laterale und vertikale Nanodrähte/Nanosheets sind laut International Roadmap for Device and Systems (IRDS) 2020 Hauptstrukturen, um FinFETs zu ersetzen [7]. Vertikale GAAFETs (oder vGAAFETs) haben eine freie Flexibilität beim Design der Gate-Länge und haben ein großes Potenzial zur Erhöhung der integrierten Dichte [4, 8]. Es gibt zwei Hauptkategorien, um vertikale Nanodrahtstrukturen zu implementieren:Bottom-Up und Top-Down. Bei der Bottom-up-Methode wurden Metallkatalysatoren eingeführt, die zu Problemen mit der Prozesskompatibilität führen können [9, 10]. Die Top-Down-Methode ist aufgrund ihrer besseren Kontrolle der Nanodrahtkonfiguration und ihrer Kompatibilität mit FinFET der Mainstream in der Branche [4, 11,12,13,14]. Die Top-Down-Methode zur Herstellung vertikaler GAAFETs zieht viel Aufmerksamkeit auf sich. Ein selbstjustierendes Gate mit genauer Steuerung der Gate-Länge war ein entscheidendes Thema [15, 16]. Um eine bessere effektive Steuerung der Gate-Länge zu erreichen oder die Variation zu reduzieren, könnte die Gate-Länge hauptsächlich durch die Dicke des auf einer unteren flachen Oberfläche epitaktisch aufgewachsenen Kanalmaterials wie Si/SiGe/Si bestimmt werden, und SiGe war das Kanalmaterial [17, 18,19,20]. Darüber hinaus liegt eine weitere kritische Integrationsherausforderung in der Dotierung zwischen Kanal- und S/D-Gebieten [16, 20, 21], insbesondere bei scharfer Übergangssteuerung [20]. Verglichen mit dem herkömmlichen Source/Drain-Implantationsprozess vereinfacht der Epitaxieprozess den Herstellungsprozess, reduziert Oberflächenschäden und erzielt ein gleichmäßiges Dotierungsprofil. Die Sandwichstruktur aus P-dotiertem Si/SiGe/P-dotiertem Si ist jedoch aufgrund der Segregations-, Autodotierungs- und Ausdiffusionsphänomene der gängigsten n-Dotierstoffe Phosphor schwierig epitaktisch zu wachsen [22, 23], Arsen [24, 25] und/oder Antimon [26, 27] an der Si/SiGe-Grenzfläche in Systemen zur chemischen Gasphasenabscheidung (CVD). Daher würden die segregierten Donatoratome, die sich an der Si/SiGe-Grenzfläche und der SiGe-Schicht sammeln, dotiert werden, was die Transistorleistung mit hoher Leckage verschlechtern kann.
Eine Strategie zum Verhindern der Dotierstoff-Segregation besteht darin, eine sehr niedrige Wachstumstemperatur anzuwenden. Es gibt eine Reihe von Berichten, in denen viele Versuche unternommen wurden, die n-Dotierung durch Molekularstrahlepitaxie (MBE) zu erhöhen [28]; inzwischen wurde dieses Verfahren nicht für CVD angewendet. MBE-Geräte sind meist Single-Chip-Design und erfordern ein hohes Vakuum und einen langsamen Durchsatz. Darüber hinaus ist die MBE-Ausrüstung nicht mit Wafergrößen über 8 Zoll in der Industrie kompatibel. Daher ist die MBE-Technologie für industrielle Massenproduktionsanwendungen nicht geeignet. Das RPCVD-System verfügt jedoch über eine starke Produktionskapazität und eine einfache Gerätestruktur, die für die IC-Industrie geeignet ist [29]. Die erste Idee für das RPCVD-Wachstum besteht darin, den Wasserstofffluss in der Kammer zu regulieren, da der Wasserstoff das Trägergas ist und die Kinetik von Vorläufergasen beeinflussen kann. Li et al. [23] berichteten, dass Wasserstoff die Bindungsstruktur von Wirtsatomen in der Oberfläche verändert und die Segregationsenergie durch Anwendung einer niedrigen Wachstumstemperatur in einem schnellen thermischen CVD-System (RTCVD) reduziert. Jedoch wurde die Wirkung von Wasserstoff an der Si/SiGe-Grenzfläche in einem CVD-System mit reduziertem Druck (RPCVD) nicht untersucht. Suvar et al. [30] fügte 30 nm undotierte Si-Abstandsschichten zwischen p-dotiertem Si und SiGe ein, um die P-Konzentration an der Grenzfläche um den Faktor 4 zu senken (von 8 × 10 19 cm −3 bis 2 × 10 19 cm −3 ), aber der P-Dotierungspeak kann nicht eliminiert werden. Bennett et al. [31] haben den Einfluss der Spannung auf die n-Dotierung in Si untersucht. Die Feststofflöslichkeit der Dotierung wurde durch Einführen einer Zugspannung in Si erhöht. Christensen et al. [32] fanden keine signifikante Abhängigkeit der P-Diffusion vom Ge-Gehalt in Si1-x Gex (0 ≤ x ≤ 0,22). Und die P-Diffusionskoeffizienten wiesen einen geringen Unterschied zwischen entspanntem Si und biaxial druckverformtem SiGe auf. Zangenberg et al. [33] beobachteten eine Erhöhung des Diffusionskoeffizienten um den Faktor 2 bei 825 °C für entspanntes Si0.88 Ge0,12 .
In dieser Veröffentlichung wurden mehrere Verfahren vorgeschlagen, um den P-Einbau in Si in einer Mehrschicht aus Si/SiGe/Si unter Verwendung von RPCVD zu verbessern. In den Experimenten wurden verschiedene Strategien wie Wasserstoffspülung, Einfügen undotierter Abstandsschichten, Austausch der Si-Vorstufe von SiH4 zu SiH2 Kl2 (DCS) und Modulieren des Dehnungsprofils durch Einführung von Si0.93 Ge0.07 Opferschicht auf beiden Seiten der SiGe-Schicht wurden vorgestellt. Darüber hinaus wurde das selektive Ätzen von SiGe diskutiert, um eine dünne SiGe-Schicht (als Kanalschicht gedacht) zu bilden [6, 34]. Die Ätzeigenschaften von Nass- und Trockenätzwerkzeugen wurden ebenfalls verglichen. Die endgültige Struktur soll in Zukunft für vGAAFETs für Sub-10-nm-Technologieknoten verwendet werden.
Methoden
Si/SiGe/Si-Mehrfachschichten (MLs) wurden mit einer RPCVD-(ASM Epsilon 2000)-Ausrüstung auf 200-mm-Si <100> -Wafern aufgewachsen. Die Si-Substrate wurden mit einer Mischlösung von H2 . gereinigt SO4 und H2 O2 , gefolgt von verdünnter HF, um natives Oxid zu entfernen, bevor es in die Schleusen der Epitaxiekammer eingeführt wird. Die Proben wurden in situ durch Glühen bei 1050 °C gereinigt, um das native Oxid zu entfernen, um eine hochwertige Si-Oberfläche zu erhalten. Die Vorläufer für Si, Ge und P waren SiH4 (oder SiH2 Kl2 ), 10 % GeH4 in H2 , und 2 % PH3 in H2 . Die Wachstumstemperatur betrug 650 °C, während der Kammerdruck während der Epitaxie bei 80 Torr gehalten wurde. In einigen Experimenten wurde der Kammerdruck auf 10 Torr reduziert, um P-dotiertes Si0.93 . wachsen zu lassen Ge0.07 Schicht in den Source/Drain-(S/D)-Regionen. Der Ge-Gehalt im SiGe-Kanal wurde konstant auf 0,22 gehalten. Um die selektiven Ätzeigenschaften zu untersuchen, wurde 50 nm Nitrid/30 nm Oxid als Hartmaske abgeschieden, um die unteren MLs zu schützen. Lithographie und trockenes anisotropes vertikales Ätzen wurden durchgeführt, um separate quaderförmige Muster zu bilden. Selektive Ätzexperimente wurden mit einem Nassätzwerkzeug von HF (6%):H2 . durchgeführt O2 (30 %):CH3 COOH (99,8%) = 1:2:4 und Trockenätzwerkzeug von CF4 :O2 :He = 4:1:5 [35].
Die Si/SiGe/Si MLs wurden durch die Techniken der hochauflösenden (Thermo Scientific Talos F200) Transmissionselektronenmikroskopie (HRTEM), der energiedispersiven Röntgenspektroskopie (EDX), der hochauflösenden Röntgenbeugung (HRXRD) charakterisiert. , und hochauflösende reziproke Gitterkarte (HRRLM) von Bruker JV Delta-x, Rasterelektronenmikroskopie (SEM) von Hitachi (Japan) und Sekundärionen-Massenspektroskopie (SIMS).
Ergebnisse und Diskussion
Epitaxie von P-dotierten Si/SiGe/Si-MLs
In dieser Studie wurde zunächst der Einbau von P in Si und SiGe untersucht. Die ML-Strukturen sind in Abb. 1a gezeigt. Ein ML von P-dotiertem Si/undotiertem Si mit steigendem PH3 flow gezüchtet, und die Schichtprofile wurden mit SIMS in Abb. 1b untersucht. Die Abbildung zeigt einen Anstieg der P-Konzentration und erreicht den höchsten Wert von 2,6 × 10 19 cm −3 . Zwei weitere Proben mit dem Profil von ‘P-dotiertem Si/Si0,72 Ge0,28 /P-dotiertes Si“ und „Si/P-dotiertes Si0,72 Ge0,28 /Si’ entworfen, und das P-Profil ist in Abb. 1c bzw. d dargestellt. In Fig. 1c wird eine P-Anhäufung an Grenzflächen von P-dotiertem Si/Si0,72 . beobachtet Ge0,28 mehrschichtig. Die Grenzflächen-P-Anhäufung nimmt mit zunehmender P-Konzentration von unten nach oben in den Multischichten zu, und die höchste Konzentration beträgt 1,6 × 10 20 cm −3 , was sechsmal so hoch ist wie die Konzentration in Abb. 1b (2,6 × 10 19 cm −3 ). In dotiertem Si0,72 Ge0,28 Schichten (Abb. 1d), sind die P-Konzentrationen deutlich höher und es gibt keine Peaks an der Grenzfläche. Aufgrund der Dotierung wird der Ge-Prozentsatz leicht erhöht. Dieses Verhalten hängt mit der verstärkten Adsorption von SiH4 . zusammen und GeH4 in Gegenwart von PH3 . Außerdem unterscheiden sich aufgrund der Dotierung die Schichtdicken zwischen den Fig. 1c, d, die die gleiche Wachstumszeit haben. Dies bedeutet, dass die P-Dotierung die Wachstumsrate von Si0,72 . erhöht Ge0,28 Schichten und die Absorption von GeH4 , während die Wachstumsrate von Si aufgrund von P-Adsorption verzögert wird. Diese Phänomene stimmen mit den Ergebnissen überein, die in Lit. [36,37,38]. Aus dem Obigen sind die P-Segregation und das Autodotierungsphänomen an der Si/SiGe-Grenzfläche schwerwiegend. Der P-Dotierungspeak an der Si/SiGe-Grenzfläche bewirkt eine unbeabsichtigte Dotierung in der SiGe-Schicht. Da SiGe als Kanalschicht in den Transistoren vorgesehen ist, würden das inhomogene Dotierungsprofil oder hohe Hintergrunddotierungsniveaus den Einsatz von Bauelementen einschränken [39]. Mehrere Verfahren zum Eliminieren des P-Peaks werden unten diskutiert. Zum besseren Vergleich sind alle SiGe-Schichten gedehnt und das Fließverhältnis von SiH4 (SiH2 Kl2 ) und GeH4 für die SiGe-Schicht wurde während aller Experimente nicht verändert.
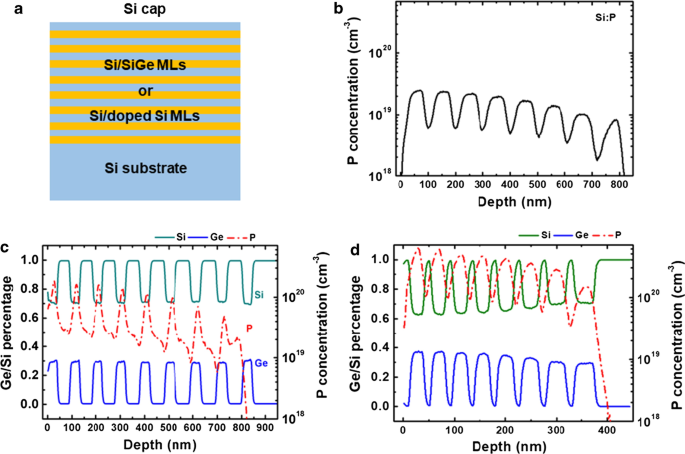
a Schematische Darstellung von P-dotierten Si/SiGe/Si-MLs. b P-Dotierungskonzentration von undotiertem Si/P-dotierten Si-MLs. Ge/Si-Prozentsatz und P-Konzentration von c undotiertes Si0,72 Ge0,28 /P-dotiertes Si, d undotiertes Si/P-dotiertes Si0,72 Ge0,28 ML. Keine Spülung und undotierte Abstandsschicht wurden berücksichtigt
Auswirkung von Abstandsschichten
Zwischen der unten dotierten Si-Schicht und der undotierten SiGe-Schicht wurden undotierte Si-Abstandsschichten eingefügt, um den Überschuss an P-Atomen zu absorbieren. Abbildung 2a zeigt das schematische Diagramm der entworfenen Struktur, und Abbildung 2b–d zeigt die Profilergebnisse von integrierten Si-Abstandshaltern mit Dicken von (b) 3 nm, (c) 5 nm und (d) 10 nm. Die Peaks der P-Anhäufung werden reduziert, während der Si/Ge-Prozentsatz und die P-Konzentration in den Si-Schichten konstant gehalten werden, wie in Abb. 2b–d. Der P-Anhäufungsgrad wird von 4 × 10 19 . um 82 % reduziert cm −3 in Abb. 2b bis 7 × 10 18 cm −3 in Abb. 2d, wenn die Abstandshalterdicke X b von 3 auf 10 nm erhöht. Eine Erhöhung der Dicke von undotierten Si-Abstandsschichten erhöht die Absorption von überschüssigen P-Atomen. In Fig. 2d die Steigung des P-Profils bei Si0,86 Ge0,14 /Si-Oberfläche beträgt 15,9 nm/dec, während bei Si/Si0,86 Ge0,14 Schnittstelle beträgt die Steigung 31,3 nm/Dez. Inzwischen ist eine zu dicke Si-Abstandsschicht keine geeignete Lösung, da der Schichtwiderstand zunimmt. Daher muss für Transistoren ein Kompromiss zwischen Schichtwiderstand und unkontrolliertem P-Profil eingegangen werden. Abbildung 2 zeigt auch den Einfluss der Abstandsschicht zwischen Si/Si0,86 Ge0,14 Ebenen (X b ) unterschied sich von der Schicht zwischen dem Si0,86 Ge0,14 /Si (X t ). In Fig. 2b, c sind die Abstandshalterdicken zwischen den Si0,86 Ge0,14 /Si waren 3 nm und 5 nm, während in Fig. 2d keine Abstandsschicht eingefügt wurde. Die Steigung des P-Profils bei Si0,86 Ge0,14 /Si ist gleich (ungefähr 15,9 nm/dec), obwohl in Fig. 2d die obere Abstandsschicht entfernt wurde, aber kein Einfluss auf das Dotierungsprofil beobachtet wurde. Aus den obigen Ergebnissen geht hervor, dass der P-Peak nur bei Si/Si0,86 . lag Ge0,14 Grenzfläche, was möglicherweise an der Löslichkeitsgrenze lag; der Überschuss an P-Atomen kann an der Oberfläche P-P-Dimere bilden und in die SiGe-Deckschicht eingebaut werden. Darüber hinaus gibt es eine Autodotierung von P während des SiGe-Wachstums nach P-dotiertem Si. Daher wurde nach Verfahren gesucht, um den Überschuss an P-Atomen zu beseitigen oder die Si-Löslichkeit zu verbessern.
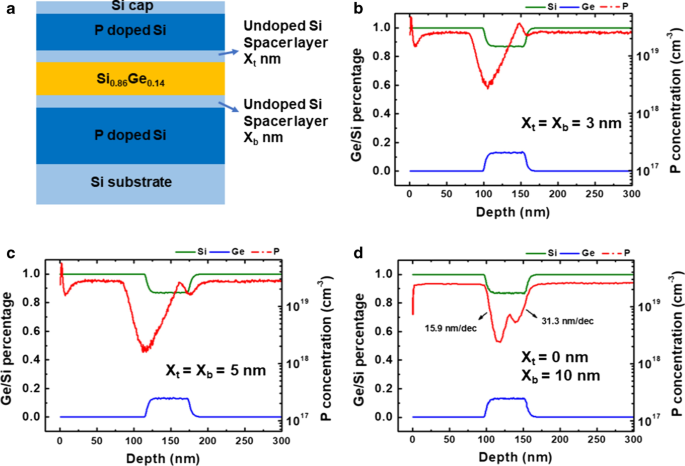
a Das Schema von experimentellen Proben mit verschiedenen undotierten Abstandsschichten. Und Ge-, Si- und P-Profile von P-dotiertem Si/Si0,86 Ge0,14 /P-dotierte Si-MLs mit undotierten Si-Abstandsschichten von b 3 nm, in beiden Schnittstellen, c 5 nm, in beiden Schnittstellen, d 10 nm, nur an einer Grenzfläche mit Si0,86 Ge0,14
Auswirkungen der Wasserstoffspülung an der Grenzfläche von Si/SiGe/Si-MLs
In diesem Abschnitt wurde die Si-Abstandsschicht bei 5 nm fixiert, und es wurde eine Wasserstoffspülung eingeleitet, um den Überschuss an P-Atomen nach dem Wachstum von P-dotiertem Si zu beseitigen. Aus Abb. 3c, d ist ersichtlich, dass eine Erhöhung des Wasserstoffflusses von 20 auf 60 sccm und der Spülzeit von 2 auf 10 min keine offensichtliche Auswirkung auf den P-Peak hat. Die Dotierungskonzentration in Si beträgt 3 × 10 19 cm −3 , das die gleiche ist wie im Abschnitt „Auswirkungen von Abstandsschichten“ beschrieben. Die P-Peakkonzentration an der Grenzfläche ist mit der Konzentration in Si aus Fig. 3d identisch. Die Schichtdicken sind bei unterschiedlichen Spülbedingungen gleich. Die P-Atome können nicht durch Wasserstoff geklärt werden; dies kann durch die Bildung stabiler P-Komplexe auf der Oberfläche erklärt werden. Durch Änderung von Parametern wie Temperatur, Druck, Spülzeit wäre hilfreich [24, 40], aber eine zu lange Spülzeit ist aus Zeitgründen nicht geeignet, und hohe Temperaturen (> 950 °C) verursachen eine Si-Ge-Interdiffusion [41] .
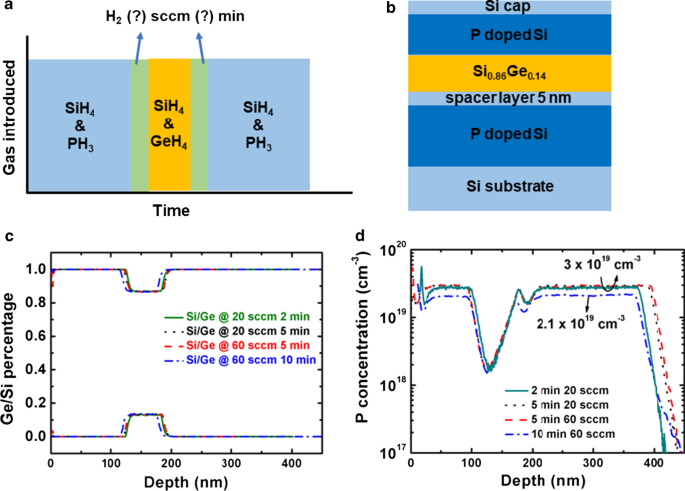
Schematische Darstellungen von a Dopingstrategie von H2 Spülbedingungen und b experimentelle Struktur von Si/SiGe/Si-MLs. c Ge/Si-Profil und d P-Konzentration von P-dotiertem Si/Si0,86 Ge0,14 /P-dotierte Si-MLs
Auswirkungen der Wachstumschemie auf den P-Einbau
In diesen Experimenten wurde die Si-Vorstufe SiH4 , wurde durch SiH2 . ersetzt Kl2 (DCS). In diesen Proben waren die Wachstumsparameter die gleichen wie zuvor, und die Strukturen enthalten eine 5-nm-Si-Abstandsschicht und die Spülzeit beträgt 5 min bei einem Fluss von 60 sccm. Die Idee dahinter ist zu untersuchen, ob eine Cl-basierte Chemie die überschüssigen P-Atome durch die Si-Oberfläche beseitigen könnte und Reaktionen von P-Cl, Si-Cl oder Ge-Cl ablaufen könnten [42]. Aus Abb. 4 verringert sich die P-Peakkonzentration um den Faktor 2 (von 2,6 × 10 19 cm −3 bis 1,3 × 10 19 cm −3 ) und die P-Konzentrationen in Si-Schichten betragen 2,6 × 10 19 cm −3 . Der geschätzte Ge-Gehalt beträgt 30 %, was höher ist als bei SiGe mit SiH4 . Der höhere Ge-Gehalt zeigt, dass Cl bei den Oberflächenreaktionen vorzugsweise die Si-Atome entfernt hat. Dieses Ergebnis kann auch durch die unterschiedliche Beziehung des Gasflussverhältnisses und der Ge-Konzentration mit SiH4 . erklärt werden und SiH2 Kl2 gasförmige Vorläufer [32, 43]. Eine andere Erklärung war, dass Ge-Atome die Wasserstoffdesorption erhöhten und dann die freien Nukleationsstellen [44]. Die P-Konzentrationssteigung von Si0,7 Ge0.3 /Si-Grenzfläche war 13,2 nm/dec, was etwas schärfer war als Si0,86 Ge0,14 /Si-Schnittstelle (15,9 nm/dez). Die Steigung des P-Profils bei Si/Si0,7 Ge0.3 Schnittstelle war 20 nm/dez. Daher wird durch Einführen von mehr HCl oder Erhöhen des Gasverhältnisses von SiH2 Kl2 und GeH4 , können die segregierten P-Atome an der dotierten Si-Oberfläche durch HCl geätzt werden, um P-Cl-Dimere zu bilden, und die P-Peakkonzentration bei Si/SiGe könnte niedriger sein [38, 45].
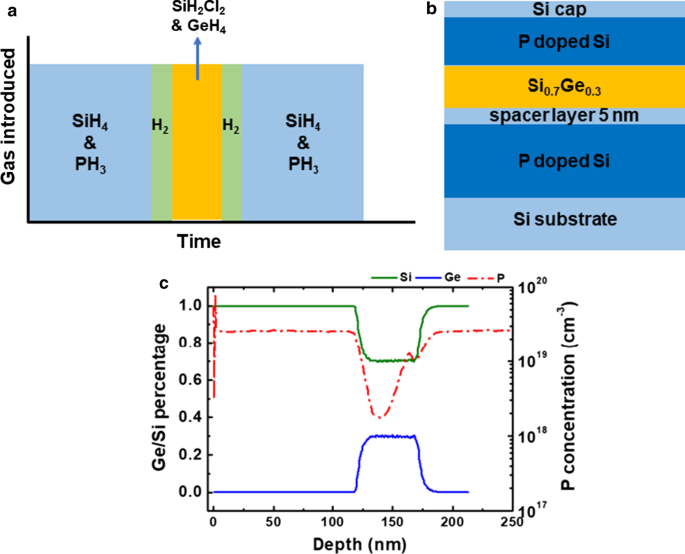
Schematische Darstellungen von a Dopingstrategie zur Veränderung der Wachstumschemie, b experimentelle Struktur von Si/SiGe/Si-MLs. Die SiGe-Schicht wurde mit DCS aufgewachsen. Die Spülzeit betrug 5 Minuten mit einem Fluss von 60 sccm nach dotiertem Si. Die undotierte Si-Abstandsschicht betrug 5 nm zwischen untendotiertem Si und undotiertem SiGe. c Ge/Si-Profil und P-Konzentration von P-dotiertem Si/Si0,7 Ge0.3 /P-dotierte Si-MLs
Auswirkungen von Ge-Inhalten auf das P-Profil
Wie bereits erwähnt, war der Einbau von P in SiGe bemerkenswert höher als in Si. Daher könnte dies die Idee aufwerfen, einige Prozentsätze von Ge (7%) in Si-Abstandshaltern (5 nm) hinzuzufügen, um den Einbau von P in Si zu verbessern. Es ist hier erwähnenswert, dass unser Ziel nicht darin besteht, den Charakter von P-dotiertem Si wesentlich zu ändern, sondern die Segregation von P in Si zu verhindern. In diesen Proben verringerte sich der Kammerdruck während des Wachstums der Abstandsschichten auf 10 Torr. Die dotierungsabhängige Wachstumsrate und der Ge-Prozentsatz wären unter dieser Bedingung wichtig. In Abb. 5b waren die obere und untere Schicht 110 nm Si0.93 . Ge0.07 mit einer P-Konzentration von 1 × 10 20 cm −3 , die mittlere Schicht war 40 nm Si0,78 Ge0,22 mit einer P-Konzentration von 3,5 × 10 19 cm −3 . Die P-Konzentrationssteigung von P-dotiertem Si0,93 Ge0.07 /Si0,78 Ge0,22 lag bei etwa 33 nm/dez. Die Steigung war nicht scharf, da der Ge-Prozentsatzunterschied zwischen den beiden Schichten nicht groß genug war. In Fig. 5d drei Schichten aus P-dotiertem Si0.93 Ge0.07 /Si0,78 Ge0,22 /P-dotiertes Si0,93 Ge0.07 MLs wurde gezüchtet, um die Gleichförmigkeit der Dotierung zu überprüfen, und ihr Strukturdiagramm wurde in Fig. 5c gezeigt. Es ist zu erkennen, dass die P-Konzentration von der unteren zur oberen Schicht abnimmt, was durch den Memory-Effekt von P erklärt werden kann. Die restlichen P-Atome in der Kammer oder diffundierte P-Atome reichern sich an der Filmoberfläche an und blockieren freie aktive Zentren auf die Oberfläche [38, 39]. Obwohl der P-Peak eliminiert wurde, war die Segregation zwischen Si0,78 Ge0,22 und Si0,93 Ge0.07 war immer noch ernst.
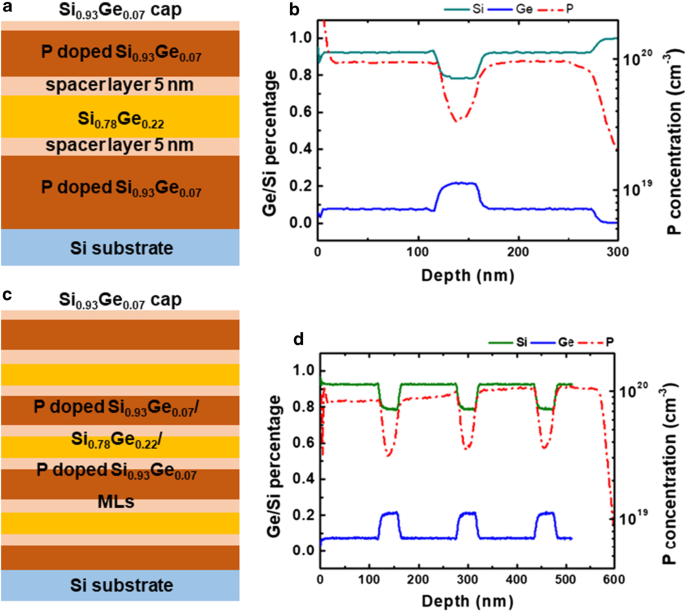
a Schematische Darstellung, b Ge/Si- und P-Profil in einer Schicht aus P-dotiertem Si0.93 Ge0.07 /Si0,78 Ge0,22 /P-dotiertes Si0,93 Ge0.07 ML. c Schematische Darstellung, d Ge/Si- und P-Profil in drei Schichten aus P-dotiertem Si0.93 Ge0.07 /Si0,78 Ge0,22 /P-dotiertes Si0,93 Ge0.07 ML
Selektive Ätzeigenschaften von Si/SiGe/Si-MLs
Wenn die ML-Struktur erfolgreich aufgewachsen ist (unter Verwendung der obigen Wachstumsstrategien), haben sich die NWs durch vertikales Ätzen unter Verwendung von SiO2 . gebildet /SiN als Hartmaske. Danach muss die SiGe-Schicht in lateraler Richtung selektiv zu Si geätzt werden, um die Kanalschicht mit einer vorgesehenen Breite zu bilden. In diesen Experimenten wurden zwei Arten von ML-Strukturen ausgewählt:P-dotiertes Si/SiGe/P-dotiertes Si (Probe-1, in Abb. 2c) und P-dotiertes Si0.93 Ge0.07 /Si0,78 Ge0,22 /P-dotiertes Si0,93 Ge0.07 (Beispiel-2, in Abb. 5b). Diese Entscheidungen werden gemäß den obigen Diskussionen getroffen, wobei die Ausdiffusion von P (teilweise) unterdrückt wurde, sowie die Perspektiven der Geräteanwendung berücksichtigt werden.
Die Ätzung in vertikaler Richtung erfolgte durch Trockenätzung, während bei der lateralen Ätzung eine selektive Trocken- oder Nassätzung angewendet wurde. Die Ätzprofile von Probe-1 sind in Abb. 6a, b gezeigt. Und das TEM-Bild und die EDS-Abbildung von Fig. 6a sind in Fig. 7 gezeigt. In diesen Experimenten ist die Hartmaske Oxid/Nitrid. Abbildung 6a zeigt nach 11,5 s Trockenätzung von CF4 /O2 /Er. Die Ätzselektivität von Si0,86 Ge0,14 und p-dotiertes Si beträgt 5,8. Abbildung 6b zeigt, dass nach 20 minütiger Nassätzung von HF (6 %)/H2 O2 (30 %)/CH3 COOH (99,8%). Durch die Nassätzung wurde die Hartmaske entfernt (SiO2 /SiN) und als Ergebnis wurde auch die Si-Deckschicht ~ 10 nm geätzt. Wie im Abschnitt „Einfluss von Abstandsschichten“ besprochen, gibt es eine P-Anhäufung an der P-dotierten Si/Si0,86 Ge0,14 Schnittstelle. Die Nassätzung ist empfindlich gegenüber dem Dotierungsniveau; daher wurde die erste Schnittstelle schneller geätzt. Als Ergebnis ist die vordere Ätzgrenzfläche nicht vertikal und sie ist facettiert oder abgewinkelt. Die durchschnittliche Selektivität betrug weniger als 4,2. Vergleicht man die beiden Ätzverfahren, so ist das Trockenätzen empfindlich gegenüber dem Ge-Prozentsatz mit einer besseren Selektivität für SiGe, während das Nassätzen gegenüber der Dotierstoffkonzentration empfindlich ist. Die Ätzungen von Probe 2 werden auch in Abb. 6c, d untersucht. Ähnliche Phänomene wurden in dieser Probe beobachtet, während die selektiv geätzten SiGe-Tiefen aufgrund des höheren Ge-Anteils tiefer waren (Abb. 6a, c). Beim Trockenätzen ist die Selektivität von Si0,78 Ge0,22 und P-dotiertes Si0,93 Ge0.07 betrug 6,3, während beim Nassätzen die durchschnittliche Selektivität weniger als 2,5 betrug. Daher war Trockenätzen im Hinblick auf die Gleichmäßigkeit und Selektivität des Ätzens die bessere Wahl.
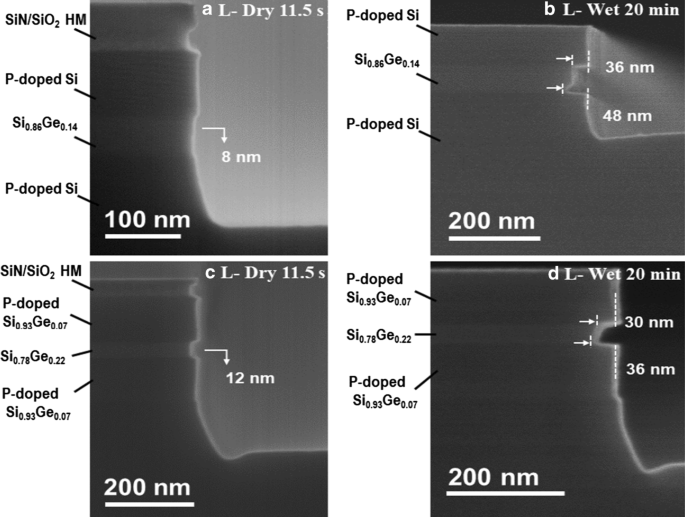
SEM-Bilder von P-dotiertem Si/Si0.86 Ge0,14 /P-dotiertes Si in Abb. 2c mit a 11,5 s Trockenätzen, b 20-Minuten-Nassätzen und P-dotiertes Si0.93 Ge0.07 /Si0,78 Ge0,22 /P-dotiertes Si0,93 Ge0.07 MLs mit c 11,5 s Trockenätzung, d 20 Minuten Nassätzen. Die Trockenätzung war CF4 :O2 :He = 4:1:5, und die Nassätzung war HF (6%):H2 O2 (30 %):CH3 COOH (99,8%) = 1:2:4
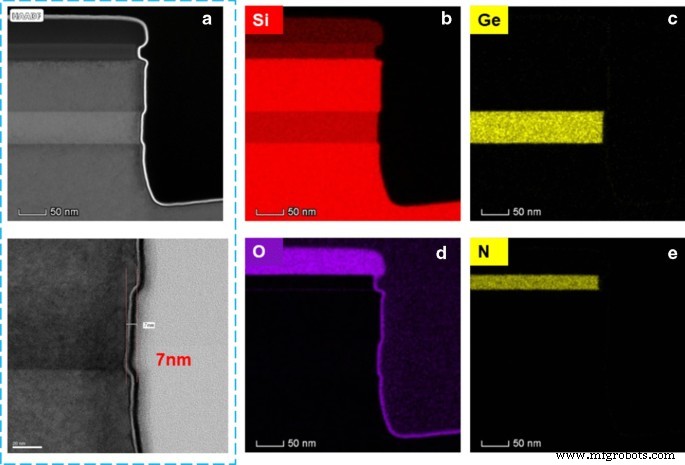
a TEM-Bilder, b –e EDS-Mapping von P-dotiertem Si/Si0,86 Ge0,14 /P-dotiertes Si in Abb. 6a mit 11,5-s-Trockenätzung. Die Elemente in b ist Si, in c ist Ge, in d ist O, und in e ist N
Weitere Analysen wurden durchgeführt, um die Dehnung nach Ätzschritten in Probe-1 und Probe-2 zu untersuchen. Abbildung 8a–h zeigt (004) Rocking Curves (RCs) von diesen Proben wie folgt:wie gewachsen, nach vertikaler Ätzung und seitlicher SiGe-Ätzung mit Nass- und Trockenätzung. Bei der RC-Analyse ist die Verbreiterung (Vollbreiten-Halbmaximum oder FWHM) ein Indikator für die Defektdichte, und die Position des SiGe-Peaks im Vergleich zu Si bestimmt den Dehnungsbetrag in der Schicht. Wir betonen hier, dass die Peakverbreiterung auch auf die dünne Schichtdicke zurückzuführen sein kann. Daher wird es schwierig sein, den Beitrag der Defektdichte von der RC-Analyse zu unterscheiden, aber wir können FWHM in diesen Analysen nur in einigen Erweiterungen vergleichen. In diesen RCs hat Probe-1 (Abb. 8a–d) eine einzelne SiGe-Schicht; währenddessen zeigt Probe-2 (Abb. 8e–h) zwei Peaks, die 7 % und 22 % Ge repräsentieren. Bei gewachsenen Proben wird eine Interferenz des Röntgenstrahls beobachtet, die Streifen der Dickenschicht verursacht. Das Auftauchen dieser Streifen zeigt eine hochwertige SiGe/Si-Grenzfläche. In RCs von Probe-1 und Probe-2 hat sich der Ge-Peak in Richtung des Si-Substrat-Peaks verschoben, was auf eine Spannungsrelaxation hindeutet. Nach seitlicher Trockenätzung von SiGe wurde keine weitere Verschiebung des Ge-Peaks festgestellt. Dies ist ein vielversprechendes Ergebnis für die Transistorleistung, da die Trägermobilität im Kanalgebiet von der Belastung abhängt. In der Zwischenzeit wurde die Spannung für das nassgeätzte SiGe entspannter, und es wurde eine stärkere Verschiebung in Richtung des Substratpeaks beobachtet. Dies zeigt, dass die Nassätzung für die laterale SiGe-Ätzung, die die Kanalschicht bildet, nicht geeignet ist.
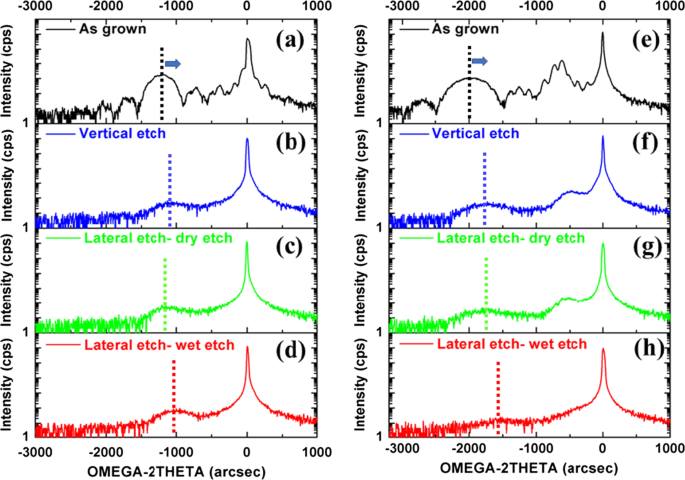
HRXRD Rocking Curve um (004) Reflexion von Probe-1, P-dotiertes Si/Si0,86 Ge0,14 /P-dotierte Si-MLs mit 5 nm Abstandsschicht in a –d und Probe-2, P-dotiertes Si0,93 Ge0.07 /Si0,78 Ge0,22 /P-dotiertes Si0,93 Ge0.07 MLs in e –h . Beide Proben haben vier Platten:wie aufgewachsen, nach vertikalem Ätzen, seitliche SiGe-Nassätzung von HF (6%)/H2 O2 (30 %)/CH3 COOH (99,8 %) 20 min und seitliches Trockenätzen von CF4 /O2 /Er 11,5 s
Weitere Röntgenanalysen wurden durchgeführt, um mehr Informationen über die Defektdichte in den Proben in Abb. 9a–h zu erhalten. HRRLMs, die auf zweidimensionalen Messungen basieren, wurden hier wie in Abb. 9a–h gezeigt durchgeführt. Der Indikator für die Defektdichte in HRRLMs ist die Verbreiterung der SiGe-Schicht entlang der -Richtung (ω ist der Einfallsstrahlwinkel). Die Position der Si- und SiGe-Peaks liefert die Dehnungskomponenten parallel und senkrecht zur Wachstumsrichtung. In Probe-1 und Probe-2 zeigen die gewachsenen SiGe-Schichten eine geringfügige ω-Verbreiterung, und die Schicht ist auf das Si ausgerichtet, das voll verspannte SiGe-Schichten zeigt (siehe Abb. 9a, e). Abbildung 9b zeigt die Probe nach der vertikalen Ätzung, der SiGe-Peak hat sich in ähnlicher Weise in Richtung des Si-Substrats in den RC-Ergebnissen in Abbildung 8b verschoben, was auf eine Spannungsrelaxation hindeutet. Aber überraschenderweise zeigt die seitlich trockengeätzte Probe (Abb. 9c) eine deutliche ω-Verbreiterung des SiGe-Peaks zusammen mit einer Verschiebung des reziproken Raums, die von der Ausrichtung mit dem Si-Peak weg ist. Die nassgeätzte Probe (in Fig. 9d) ist jedoch vollständig spannungsausgerichtet und hat eine geringere Schichtintensität als die trockengeätzte (in Fig. 9c). In diesem Fall wird erwartet, dass die erzeugten Defekte in diesen Proben unterschiedliche Ursprünge haben, da die Art des Ätzprozesses unterschiedlich ist. Probe-2 enthält zwei SiGe-Schichten; das Si0.93 Ge0.07 Peak wird nach dem Ätzen sowohl in vertikaler als auch in lateraler Richtung überlebt, während Si0,78 Ge0,22 verschwindet nach dem vertikalen Ätzen und zeigt eine vollständige Spannungsrelaxation (Abb. 8f–h). Die schlechte Prozessstabilität von Probe-2 könnte auf eine P-Dotierung zurückzuführen sein, die die Bildung von Fehlanpassungsversetzungen fördert.

HRRLMs aus P-dotiertem Si/Si0,86 Ge0,14 /P-dotierte Si-MLs mit 5 nm Abstandsschicht (Probe-1) in a –d , und P-dotiertes Si0.93 Ge0.07 /Si0,78 Ge0,22 /P-dotiertes Si0,93 Ge0.07 MLs (Beispiel-2) in e –h . Die beiden Abbildungen haben beide vier Felder:wie aufgewachsen, nach vertikalem Ätzen, seitliches Nassätzen von HF (6%)/H2 O2 (30 %)/CH3 COOH (99,8 %) 20 min und seitliches Trockenätzen von CF4 /O2 /Er 11,5 s
Schlussfolgerungen
In dieser Arbeit wurde die Epitaxie von P-dotierten Si/SiGe/P-dotierten Si-MLs zusammen mit dem Ätzen dieser MLs als Ausgangsstrukturen für vGAAFET untersucht. Zunächst wurde der Einbau von P in Si/SiGe/Si-MLs untersucht. Es wurden verschiedene Strategien für die Epitaxie und die ML-Struktur vorgeschlagen, um den P-segregierten Peak an der Grenzfläche der Si/SiGe-Heterostruktur zu eliminieren. Aus Experimenten geht hervor, dass das Einfügen einer undotierten Abstandsschicht den P-Peak verringern könnte. Eine Wasserstoffspülung zum Entfernen der überschüssigen P-Atome war nicht sehr hilfreich und stabile P-P-Dimere konnten nicht vollständig entfernt werden. Ersetzen von SiH4 mit SiH2 Kl2 als Si-Vorstufe zur Einführung von Cl-Chemie während des Wachstums verringerte den segregierten P-Peak aufgrund von Cl-aktiven Oberflächenreaktionen bemerkenswert. Die Auswirkungen von Si0.93 Ge0.07 Abstandsschichten nach P-dotiertem Si wurden ebenfalls untersucht. Die Ergebnisse zeigten, dass der P-Peak an der SiGe-Grenzfläche verschwand, während sich der P-Einbau in diese Schichten um eine Größenordnung verbesserte. Im zweiten Teil dieser Studie wurde das vertikale Ätzen von Si/SiGe/Si ML durchgeführt, um NWs zu bilden, und später wurde in diesen NWs das SiGe selektiv nass- oder trockengeätzt. Das Nassätzen war empfindlich gegenüber der Dotierstoffkonzentration; währenddessen war das Trockenätzen empfindlich gegenüber dem Ge-Gehalt. Trockenätzen war für n-Typ-Strukturen mit gleichmäßigem Ätzprofil und höherer Selektivität besser geeignet. Für p-dotiertes Si/Si0,86 Ge0,14 /P-dotierte Si-MLs betrug die Selektivität 5,8 beim Trockenätzen und 4,2 beim Nassätzen. Die Selektivität von P-dotiertem Si0.93 Ge0.07 /Si0,78 Ge0,22 /P-doped Si0.93 Ge0.07 MLs was 6.3 with dry etch and 2.5 with wet etch. The strain in SiGe was mostly preserved in Si/SiGe/Si after vertical and lateral etch; meanwhile, this strain in MLs with introduced Si0.93 Ge0.07 spacer layer had poor stability after etch process.
Verfügbarkeit von Daten und Materialien
The authors declare that the data supporting the findings of this study are available within the article.
Abkürzungen
- vGAAFET:
-
Vertical gate-all-around field-effect transistors
- ML:
-
Multilayer
- CMOS:
-
Complementary metal oxide semiconductor
- MBE:
-
Molekularstrahlepitaxie
- RPCVD:
-
Reduced pressure chemical vapor deposition
- RTCVD:
-
Rapid thermal chemical vapor deposition
- S/D:
-
Source/drain
- HRTEM:
-
Hochauflösende Transmissionselektronenmikroskopie
- HRXRD:
-
Hochauflösende Röntgenbeugung
- HRRLM:
-
High-resolution reciprocal lattice map
- SEM:
-
Rasterelektronenmikroskopie
- SIMS:
-
Secondary ion mass spectroscopy
- RC:
-
Rocking curve
- FWHM:
-
Full-width-half-maximum
- HM:
-
Hardmask
Nanomaterialien
- Verbesserung der Anwendungsleistung für Benutzer und Kunden bei CyrusOne
- Luftabstandshalter für 10-nm-Chips
- Direktes Wachstum von federartigen ZnO-Strukturen durch eine einfache Lösungstechnik für die Fotoerkennungsanwendung
- Bewertung von Graphen/WO3- und Graphen/CeO x -Strukturen als Elektroden für Superkondensatoranwendungen
- Eine wiederaufladbare Fluoreszenzsonde BHN-Fe3O4@SiO2 Hybrid-Nanostruktur für Fe3+ und ihre Anwendung in der Biobildgebung
- Auswahl einer Art von Roboterschweißprozess und -ausrüstung für Ihre Anwendung
- Unternehmen bereiten sich auf die großen technologischen Veränderungen und Herausforderungen des Jahres 2019 vor
- Karusselldrehmaschine für Gieß-, Schmiede- und Drehanwendungen
- Karusselldrehmaschine für Gieß-, Schmiede- und Drehanwendungen(2)
- VMC Machinery für Produktion und Effizienz



