Charakterisierung und Herstellung des CFM-JTE für 4H-SiC-Leistungsbauteile mit hocheffizientem Schutz und erhöhtem JTE-Dosistoleranzfenster
Zusammenfassung
Ein 13,5 kV 4H-SiC-PiN-Gleichrichter mit einer beträchtlichen aktiven Fläche von 0,1 cm 2 wird in diesem Papier hergestellt. Ladungsfeldmodulierte Sperrschichtabschlusserweiterung (CFM-JTE) wurde vorgeschlagen, um die Anforderung einer ultrahohen Sperrspannung zu erfüllen, die das JTE-Dosistoleranzfenster vergrößert und ungefähr das 2,8-fache des herkömmlichen Zweizonen-JTE beträgt. Außerdem kann das CFM-JTE durch den herkömmlichen Zweizonen-JTE-Prozess implementiert werden. Der gemessene Vorwärtsstrom beträgt bis zu 100 A @ V F = 5,2 V ohne Technologie zur Verbesserung der Ladungsträgerlebensdauer. Die CFM-JTE-Struktur erreicht 96 % der theoretischen Durchbruchspannung des Parallel-Plane-Übergangs mit einer relativ kleinen Anschlussfläche von 400 μm, was dazu beiträgt, die Gütezahl des Baliga von 58,8 GW/cm 2 . zu erreichen .
Einführung
Siliziumkarbid ist aufgrund seiner Eigenschaften höherer Spannung bei dünneren aktiven Schichten, erweiterter Leistungsdichte, höherer Schaltfrequenz, besserer Wärmeableitung, kleinerer Systemgröße und niedrigerer Systemkosten zu einer neuen Option zur Verbesserung von Leistungsanwendungen geworden [1, 2]. In den letzten Jahren wurden kommerzielle SiC-Gleichrichter und MOSFETs mit 1,2–1,7 kV bewertet. In repräsentativen Anwendungsbereichen wie Smart Grids, Elektrofahrzeugen, Impulsstromversorgungen und Ultrahochspannungs-Festkörperstromversorgungen besteht jedoch eine steigende Nachfrage nach Sperrfähigkeiten von über 10 kV und Durchlassstromfähigkeit von über 1000 A cm −2 .
Bisher konzentrierten sich die Hauptherausforderungen von 10 kV- und höherwertigen leistungselektronischen Bauelementen aus SiC auf die Leistung der Übergangsabschlusstechnologie, die Vereinfachung von Herstellungsprozessen, die hohe Qualität der dicken Epitaxieschicht und die Reduzierung von Oberflächenfehlern. Bei Ultrahochspannungs-SiC-Bauelementen beträgt die Länge der Anschlussstruktur meist das 6- bis 8-fache der Epitaxiedicke [3], was die Nutzungsrate des Wafers enorm reduziert und somit die Herstellungskosten erhöht. 4H-SiC-PiN-Gleichrichter haben sich aufgrund des Leitfähigkeitsmodulationseffekts zu den am besten geeigneten Kandidaten für Ultrahochspannungsanwendungen entwickelt. Für die feldbegrenzende Ringstruktur (FLR) kann durch analytische Berechnungen ein präzises Optimierungsdesign erhalten werden [4], während die aktuelle Photolithographie den genauen Raum und die genaue Breite der Ringe nicht erreichen kann. Der neuartige feldbegrenzende Ringanschluss für 10 kV-SiC-Bauelemente wurde verwendet, um eine hohe Verpolungsschutzeffizienz zu erreichen [5, 6], aber seine Anschlussfläche überschreitet 700 μm, was zu einem zusätzlichen Verbrauch des SiC-Wafers führt. Junction Termination Extension (JTE) ist eine weitere häufig verwendete hocheffiziente Endgeräteschutzstruktur, deren Effizienz jedoch äußerst empfindlich auf die Dosis von JTE reagiert. Für Ultrahochspannungspegel werden MZ-JTEs und CD-JTEs [7] verwendet, um das elektrische Feld kritisch zu modulieren und erfordern strenge Ionenimplantationsbedingungen und -zeiten, was wiederum die Herstellungskomplexität und die Kosten erhöht. Um die Leitfähigkeit zu verbessern, wurden Untersuchungen zu Eigenschaften der Barrierehöhe zwischen diversen Metallen und SiC durchgeführt [8, 9]. Normalerweise wird ein 50–100 nm dicker Ti/Al-Film für den ohmschen Kontakt der Anode bzw. ein Ni-Film für den ohmschen Kontakt der Kathode gebildet. Außerdem beeinflusst die Größe des aktiven Bereichs des 4H-SiC-Gleichrichters die Durchlassstromeigenschaften stark. Es wurde festgestellt, dass in der epitaktischen 4H-SiC-N-Typ-Schicht die Z 1/2 Zentrum (E C —0,65 eV), das Akzeptorniveau der Kohlenstoffmonovakanz, beeinflusst hauptsächlich die Ladungsträgerlebensdauer [10]. Die Implantation von Aluminiumionen führt zu einer großen Konzentration massiver tiefer Ebenen, an denen das Z . beteiligt ist 1/2 Zentrum in der Mesa-Peripherie und Übergangs-Terminierungsregion [11], was zu einer Verringerung der Ladungsträgerlebensdauer führt. Daher sind 4H-SiC-Gleichrichter mit großer aktiver Fläche (> 9 mm 2 ) sind bei Design und Herstellung erforderlich, da die Auswirkungen der reduzierten Trägerlebensdauer in der Mesa-Peripherieregion und der Abschlussregion relativ vernachlässigbar sind.
In diesem Artikel wird der 4H-SiC CFM-JTE PiN-Gleichrichter auf einer 100-μm-Epitaxieschicht von 5 × 10 14 . hergestellt cm −3 und erreicht eine beachtliche Sperrkapazität von 13,5 kV im ausgeschalteten Zustand und einen Durchlassstrom von 100A @ V F = 5,2 V im eingeschalteten Zustand. Der differentielle Einschaltwiderstand des CFM-JTE-PiN-Gleichrichters beträgt 3,1 mΩ cm 2 bei Raumtemperatur. Der CFM-JTE erreicht 96 % der theoretischen Durchbruchspannung durch das Konzept und die Analyse der Ladungsfeldmodulation, was das Toleranzfenster der Implantationsdosis günstig erweitert und zu einer akzeptablen Abschlusslänge von 400 μm führt.
Methoden
Gerätestrukturanalyse
Design, Optimierung und Analyse werden von Silvaco-TCAD durchgeführt. Abbildung 1 zeigt das Schema der 4H-SiC-PiN-Struktur mit Terminierung, die Folgendes umfasst:(a) ladungsfeldmodulierte (CFM-JTE), (b) Out-Ring-assisted JTE (ORA-JTE) und (c) Zweizonen-JTE (TZ-JTE). Im Sperrzustand hängt die Ionisationsrate der Elektron-Loch-Kollision eng mit der elektrischen Feldstärke zusammen. Ein Konzept der Ladungsmodulation des elektrischen Felds E q (r ) wird vorgeschlagen, um den Modulationsmechanismus des CFM-JTE durch die Vektorsuperpositionsmethode des durch das elektrische Ladungsfeld verursachten elektrischen Feldes E . aufzudecken q (r ) in Abb. 1a. Das CFM-JTE besteht aus der JTE1-Region, der JTE2-Region und drei Ringgruppen. Die mehreren Ringe teilen das Terminal äquivalent in fünf dotierte Zonen:R1 -R2 , R2 -R3 , R3 -R4 , R4 -R5 und R5 -R6 , wobei effektive Ladungen von Q 1 , Q 2 , Q 3 , Q 4 und Q 5 jeweils eingeführt werden. Basierend auf der Zerlegung und Überlagerung elektrischer Feldvektoren bei x und y Koordinaten, das gesamte elektrische Feld in R ich Punkt verursacht durch das angelegte Potentialfeld E p (r ) und das elektrische Ladungsfeld E Qi (r ) erzeugt von jedem Q ich kann analytisch im x . ausgedrückt werden und y Richtungen, wie in Gl. (1) bzw. (2).
$$E_{Ri, x} =E_{px} + \mathop \sum \limits_{j =1}^{i - 1} E_{Qjx} - \mathop \sum \limits_{j =i}^{5 } E_{Qjx}$$ (1) $$E_{Ri,y} =E_{py} + \mathop \sum \limits_{j =1}^{i - 1} E_{Qjy} + \mathop \sum \limits_{j =i}^{5} E_{Qjy}$$ (2)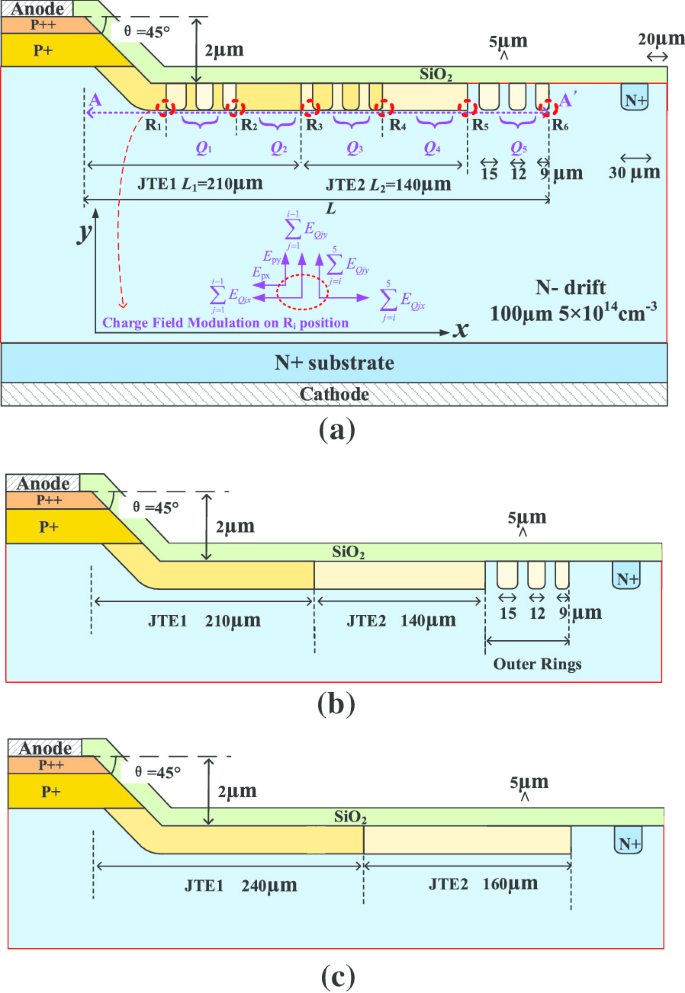
Schematischer Schnitt des 4H-SiC-PiN-Gleichrichters mit a CFM-JTE, b ORA-JTE, c konventioneller TZ-JTE
Im ausgeschalteten Zustand zieht sich der niedrig dotierte Verarmungsbereich vorzeitig zusammen und bricht aufgrund des Krümmungseffekts im PiN-Hauptübergang am Abschlussbereich ab. Somit ist das angelegte Potentialfeld E p (r ) ist vollständig an der Peripherie der Hauptverbindung konzentriert. Die Existenz von Q ich fördert die Verarmung entlang des CFM-JTE bis zur äußersten Epitaxieschicht. Die Stärke des elektrischen Ladungsfeldes E Qi ist mit der Menge von Q . verbunden ich . Die Abnahme von Q ich entlang der Anschlussaußenkante erreicht effektiv die Modulation des elektrischen Felds im Anschlussbereich. Folglich überwindet CFM-JTE durch den Mechanismus und die Wirkung der Ladungsmodulation des elektrischen Feldes den Mangel eines niedrigen Diffusionskoeffizienten von SiC, um den variablen lateralen Dotierungseffekt (VLD) zu bilden, der eine hochwirksame, robuste und ausgereifte Technologie zum Schutz von Sperrschichtanschlüssen ist für Si-Geräte [12, 13]. Die Ringbreite (w r ) jeder Gruppe wird auf 15 μm, 12 μm bzw. 9 μm verringert. Der Abstand jedes Rings entspricht dem gleichen Wert von 5 μm. Länge und Dosis der JTE1-Region und der JTE2-Region stehen beide in einem festen Verhältnis von 3:2. Die detaillierten Parameter des vorgeschlagenen Gleichrichters sind in Tabelle 1 aufgeführt.
Simulation und Optimierung
Um die durch die Empfindlichkeit der Bauelementstruktur und die Dotierungskonzentrationen verursachten Abweichungen zu verringern, wird die Verarbeitungskonfiguration Athena verwendet. Die Dotierungskonzentrationen des CFM-JTE werden durch mehrere Schritte der Simulation des Aluminiumimplantationsprozesses gebildet. Die Gesamttiefe der Dotierung erreicht fast 1 μm.
Abbildung 2 zeigt die Blockierungskapazitäten und die Toleranzen gegenüber der Implantationsdosis von CFM-JTE, ORA-JTE und konventionellem TZ-JTE. Die vier Abschlussstrukturen teilen sich einen Wert fester Länge von L = 400 μm, um ihre Effizienz zu vergleichen. Sowohl die Länge als auch die Dosis von JTE1 und JTE2 sind im Verhältnis 3:2 festgelegt. Die Simulation wird an der 2-D-Struktur durchgeführt, und das Durchschlagsbeurteilungskriterium ist, dass der Rückwärtsleckstrom 1 × 10 –9 . erreicht A. Die schwarze durchgezogene Linie stellt den theoretischen BV . dar die nach [10, 14] zu 14,1 kV berechnet wird, und die grau gestrichelte Linie zeigt 12 kV an. Die Designmarge von 20 % wird im Ziel für 10 kV unter Berücksichtigung der Prozesstoleranz und der Simulationsabweichung angewendet. Beim herkömmlichen TZ-JTE reagiert die Durchbruchspannung ziemlich empfindlich auf die Implantationsdosis und erreicht nur dann über 12 kV, wenn die Dosis zwischen 0,98 und 1,14 × 10 13 . variiert cm −2 . Die Empfindlichkeit von ORA-JTE gegenüber der JTE-Injektionskonzentration wird verringert und ein breiteres Toleranzfenster von 0,97–1,28 × 10 13 cm −2 erhalten wird, um die Zielspannung über 12 kV zu halten. Der CFM-JTE hat die größte Toleranz des Implantationsdosisfensters in einem Bereich von 0,86–1,30 × 10 13 cm −2 , das ungefähr 2,8-mal so hoch ist wie beim herkömmlichen TZ-JTE und 1,4-mal so hoch wie beim ORA-JTE. Somit zeigt der CFM-JTE eine bessere Robustheit gegenüber Prozessvariationen.
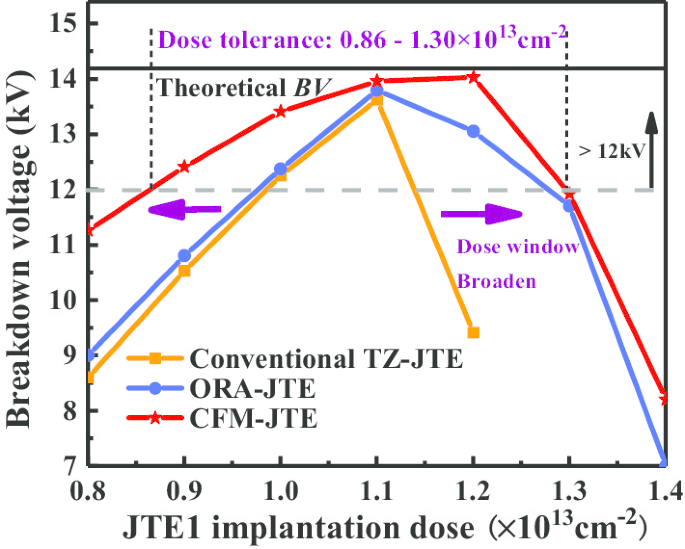
Vergleich der Durchschlagskapazitäten zum JTE-Dosisfenster für den 4H-SiC-PiN-Gleichrichter mit CFM-JTE, ORA-JTE und konventionellem TZ-JTE
Abbildung 3 zeigt den Vergleich der Verteilung des elektrischen Oberflächenfelds und der Intensität von CFM-JTE, ORA-JTE und TZ-JTE im Sperrzustand. Das elektrische Spitzenfeld konzentriert sich hauptsächlich auf die Hauptverbindung und die Terminalperipherie. CFM-JTE glättet die Verteilung des elektrischen Felds und fördert die elektrische Feldstärke entlang des Terminals, was letztendlich die Sperrkapazität effizient verbessert.
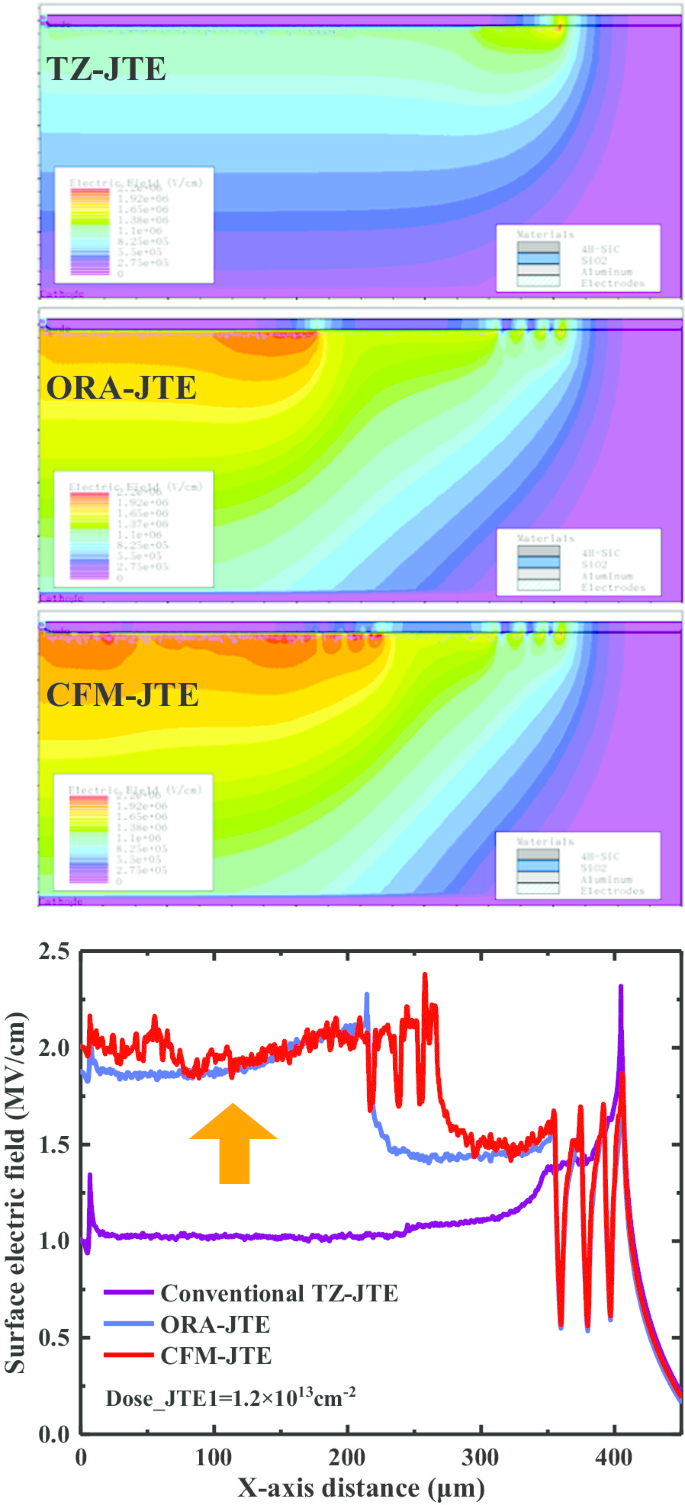
Umgekehrte Verteilung und Intensität des elektrischen Oberflächenfelds bei CFM-JTE, ORA-JTE und konventionellem TZ-JTE
Um den Mechanismus des CFM-JTE-modulierenden elektrischen Ladungsfeldes zu verstehen, sind die Verteilungen des elektrischen Durchschlagsfeldes entlang der AA'-Schnittlinie in Fig. 1a mit unterschiedlichen Implantationsdosen von JTE1 in Fig. 4 aufgetragen. Die Existenz von Q ich , insbesondere das hochdotierte Q 1 Zone neben dem Hauptübergang, verringert die Konzentration der elektrischen Feldlinien an der Mesa-Ätzecke immens. Das Q 5 Zone ist so eingestellt, dass die Ansammlung des elektrischen Felds bei R5 . verringert wird Punkt in Abb. 1a. Die Ergebnisse zeigen, dass die Gleichmäßigkeit der elektrischen Feldverteilung durch die Modulation des elektrischen Ladungsfeldes E . effektiv verbessert werden kann Qi (r ) im Terminal. Somit konnten die Fähigkeit der Sperrspannung und die Zuverlässigkeit des Geräts verbessert werden.

Verteilungen des elektrischen Oberflächenfeldes im Durchbruch entsprechend unterschiedlichen Implantationsdosen von JTE1
Die Größe der Anschlussfläche beeinflusst direkt die Effizienz der Chipnutzung. Im Sperrzustand gruppiert sich das angelegte Potentialfeld um die Peripherie des Hauptübergangs. Die JTE1-Region in der Nähe des Hauptübergangs muss mehr Ladungen einführen, um den Modulationseffekt des Ladungsfelds zu verstärken (E q ). Also, L 1 muss länger als L eingestellt werden 2 . Wenn das Verhältnis von L 1 zu L 2 ist auf 3:2 festgelegt, die Sperrkapazitäten unterschiedlicher Länge L auf dem Terminal werden in Abb. 5 vergleichend analysiert.

Blockierkapazitäten bei unterschiedlichen Klemmenlängen
Die entsprechenden Verteilungen des elektrischen Felds sind in Abb. 6 dargestellt. Die großräumige Fläche von CFM-JTE trägt dazu bei, die erforderliche Ladung Q . zu erhöhen ich und geben dem Modulationseffekt von E . volles Spiel Qi (r ), um ein größeres Implantationsdosis-Toleranzfenster (TW) zu erhalten. Wenn die CFM-JTE-Länge L auf 300 μm, 350 μm, 400 μm und 450 μm eingestellt ist, erhöht sich der TW-Bereich sequentiell, entsprechend 3 × 10 12 cm −2 , 3.2 × 10 12 cm −2 , 4,4 × 10 12 cm −2 und 4,7 × 10 12 cm −2 im Bereich unter der Bedingung, dass die BV über 12 kV liegt. Es ist zweckmäßiger, eine Klemmenlänge L . zu wählen von 400 μm in dieser Arbeit basierend auf dem Kompromiss zwischen Anschlussgröße, JTE-Dosistoleranzfenster, Modulation des elektrischen Felds des Anschlusses und Durchschlagsspannungsfähigkeit.
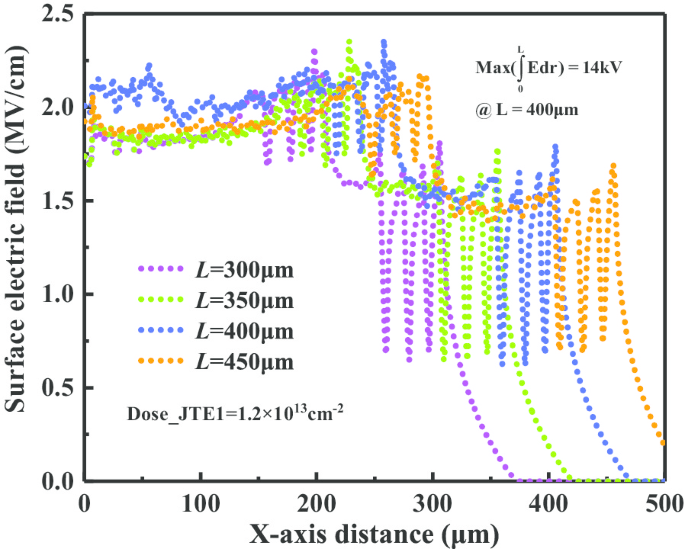
Verteilungen des elektrischen Oberflächenfeldes im Durchbruch entsprechend unterschiedlichen Anschlusslängen
Die Existenz von Oberflächenzuständen sollte bei der tatsächlichen Herstellung des 4H-SiC-PiN-Gleichrichters berücksichtigt werden. Diese Oberflächenzustände werden von Löchern abgeleitet, die in tiefen Grenzflächenzuständen gefangen sind, festen Oxidladungen von P-SiC (einschließlich P ++ Schicht und P-JTE-Region)/SiO2 Schnittstelle und der Implementierungsprozess [15,16,17,18]. Für die CFM-JTE-Terminierung ist die elektrische Feldmodulation an der Schnittstelle S 1 und S 2 durch positive Schnittstellenladungen (Q es ), effektive Ladungen (Q j ) und das angelegte Potential in Richtung der Vertikalen wird in Abb. 7 analysiert.
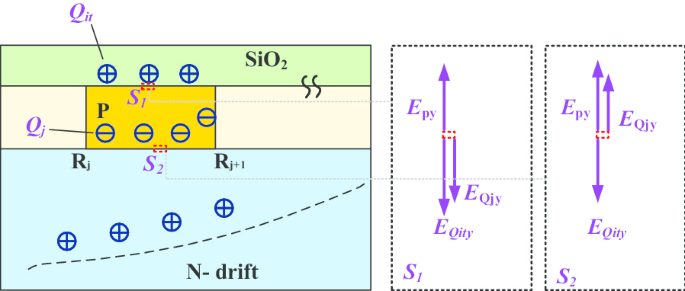
Modulation des elektrischen Felds bei S 1 und S 2 durch positive Schnittstellenladungen (Q es ), effektive Ladungen (Q j ) und angelegtes Potenzial
Positive Schnittstellengebühren (Q es ) erzeugen ein entgegengesetztes Ladungsfeld (E Qualität ) verglichen mit dem angelegten Potentialfeld (E py ), die dazu beiträgt, die elektrische Feldstärke in Richtung der vertikalen Grenzfläche abzuschwächen. Abbildung 8 zeigt die Verteilungen des elektrischen Felds in SiO2 /SiC-Schnittstelle S 1 unter Bedingungen unterschiedlichen Q es .

Elektrische Feldverteilungen in SiO2 /SiC-Schnittstelle mit verschiedenen Q es
Im Hinblick auf die Ladungsfeldmodulationsanalyse an der Schnittstelle S 2 , E Qualität ist entgegengesetzt zur Vektorrichtung von E py und E Qjy . Die Existenz von Q es hilft das elektrische Feld in S . zu reduzieren 2. In Anbetracht der Existenz der Schnittstellengebühr (Q es ), eine größere effektive Ionisationsladung Q j wird benötigt, um der vom Q . erzeugten elektrischen Feldstärke entgegenzuwirken es . Folglich, wenn die Menge von Q es erhöht, sollte die optimale Implantationsdosiskonzentration von JTE gleichzeitig erhöht werden, um die gleiche Blockierfähigkeit beizubehalten. Wie in Abb. 9 gezeigt, ist die BV-Dosis . insgesamt Kurve verschiebt sich in steigender Richtung mit der Zunahme von Q es .

Vergleich der Einflüsse auf das Sperrvermögen durch Grenzflächenladungen im 4H-SiC PiN-Gleichrichter
Ergebnisse und Diskussion
Der vorgeschlagene CFM-JTE 4H-SiC PiN-Gleichrichter wurde in einem 4-Zoll-N-Typ-Wafer mit 4° Achsversatz (0001) hergestellt. Der Wafer wird durch Epitaxie mit vier Schichten (N + , N − , P + , P ++ ) entsprechend der Konzentration von 1 × 10 18 cm −3 , 5 × 10 14 cm −3 , 1 × 10 18 cm −3 und 5 × 10 19 cm −3 . Der Hauptprozessfluss der CFM-JTE-Fertigung ist in Abb. 10 dargestellt. Die P ++ Die Schicht wird durch Epitaxie aufgewachsen, um eine gleichmäßige und hochdotierte Schicht zu erhalten, um die ohmsche Kontaktqualität zwischen SiC und Anodenmetall zu fördern. Die Mesa-Ätzstruktur wird in der ICP-RIE-Anlage durch die Mesa-Ätzmaske gebildet. Das Ätzgas besteht hauptsächlich aus SF6 und Sauerstoff. Mehrere Al-Ionenimplantationen werden bei einer maximalen Energie von 500 keV implementiert, um die CFM-JTE-Struktur zu bilden. Eine zweistufige Al-Ionenimplantation wird angewendet, um die fünf abnehmenden dotierten Zonen zu bilden. JTE1 und R2 -R3 Zonen werden durch die erste Implantationsmaske gebildet. JTE2, R1 -R2 , R3 -R4 , R4 -R5 und R5 -R6 Bereiche werden gleichzeitig durch die Al-Ionenimplantation durch die zweite Implantationsmaske konfiguriert. Wie allen bekannt ist, ist die Ionenaktivierungsrate in Siliziumkarbid nach Implantation mit hochenergetischen Ionen nicht hoch, begleitet von schweren Gitterschäden. Um die obige unerwünschte Situation zu verbessern, werden die Aluminiumionenimplantationen bei einer Temperatur von 500 °C durch eine Oxidmaske durchgeführt. Das Tempern nach der Implantation wurde in Argon-Umgebung bei einer Temperatur von 1800 °C für 10 Minuten mit einer Kohlenstoffkappe durchgeführt, um die durch die Hochenergie-Ionenimplantation verursachten Schäden weiter zu renovieren und die Genauigkeit der Dotierungskonzentration durch Erhöhung des effektiven Ions zu verbessern Aktivierungsrate. Der ohmsche SiC-Kontakt vom P-Typ wird unter Verwendung von Al/Ti gebildet. Der RTA-Prozess wird konsequent zwei Minuten lang in einer Inertgas-Stickstoff-Umgebung bei einer Temperatur von 1000 °C durchgeführt und geprüft. Hochwertige Passivierungsschichten (SiO2 Schicht, Si3 N4 Film und dicke Polyimidschicht) werden abgeschieden, um Oberflächenlecks und Funkenbildung in der Luft zu verhindern [5]. Der PiN-Gleichrichter CFM-JTE deckt eine aktive Fläche von bis zu 0,1 cm 2 . ab . Der Herstellungsprozess entspricht dem herkömmlichen Zweizonen-JTE-4H-SiC-PiN-Gleichrichter, ohne zusätzliche Masken oder Prozessschritte, was die Herstellungskomplexität und -kosten extrem reduziert.
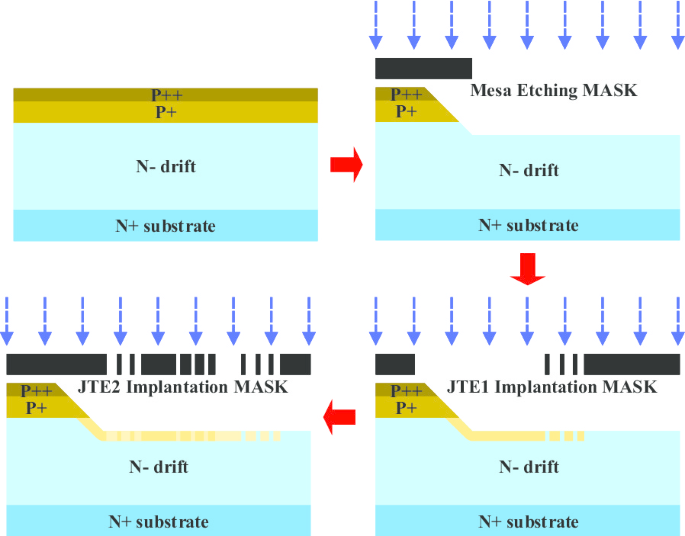
Prozessablauf des CFM-JTE
Die Durchlasseigenschaften des hergestellten CFM-JTE PiN-Gleichrichters werden auf dem Wafer mit dem CS-3200 Curve Tracer Instrument getestet. Der hergestellte CFM-JTE-PiN-Gleichrichter weist eine große Kapazität der Durchlassstromleitung ohne Technologie zur Verbesserung der Trägerlebensdauer auf. Der Durchlassstrom wird bis zu 100 A gemessen, was einer Durchlassspannung von 5,2 V entspricht, wie in Abb. 11 gezeigt. Der differentielle Einschaltwiderstand des vorgeschlagenen Gleichrichters wird mit 3,1 mΩ cm 2 . gemessen bei Raumtemperatur, entsprechend der Durchlassspannung von 3,6 V. Die Durchlassleitungseigenschaften bei verschiedenen Temperaturen sind auch im Einschub von Abb. 11 dargestellt. Die I–V Kurve zeigt die Besonderheit des negativen Temperaturkoeffizienten. Dies liegt daran, dass mit steigender Temperatur die Beweglichkeit des Materials abnimmt, während die schmalere Bandlücke des SiC-Materials das selbstgebaute Potenzial des P-N-Übergangs verringert und die Ladungsträgerlebensdauer der Driftzone mit zunehmendem verlängert wird Temperatur, was zu einer Erhöhung der Stromdichte führt. Die gemessene Einschaltspannung ist bei einer Durchlassstromdichte von 10 A·cm –2 . definiert . Sie reduziert sich allmählich von 3,14 auf 3,04 V, wenn die Umgebungstemperatur von 25 auf 150 °C ansteigt. Die maximale Verschiebung der Vorwärts-Einschaltspannung wurde in einem Bereich von 3 % festgehalten, was einem Wert von 0,1 V entspricht, was eine viel bessere Temperaturstabilität als Si-PiN aufweist.
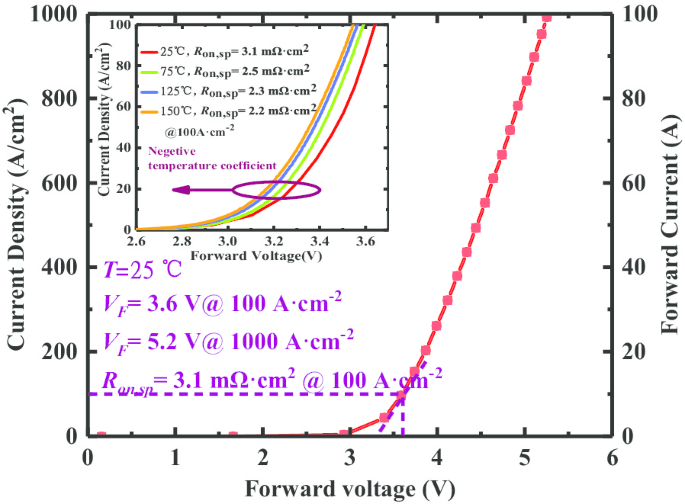
Weiterleiten I–V Kurve des CFM-JTE PiN-Gleichrichters und Eigenschaften bei unterschiedlichen Temperaturumgebungen im Einsatz
Die 4H-SiC-PiN-Gleichrichter mit CFM-JTE, ORA-JTE sowie konventionellem TZ-JTE werden auf dem 4-Zoll-Wafer hergestellt und ihre Anschlussschutzwirkungen sind in Abb. 12 dargestellt. Durchschlagspannungsmessungen werden durchgeführt und eingetaucht in fluorinertem Öl, um Lichtbögen in der Luft zu vermeiden. In experimentellen Messungen mit einer JTE1-Dosis von 1,2 × 10 13 cm −2 , erreichen die PiN-Gleichrichter mit ORA-JTE und die konventionelle TZ-JTE die Sperrkapazitäten von 12,5 kV bzw. 9,6 kV bei gleicher Anschlusslänge von 400 μm.
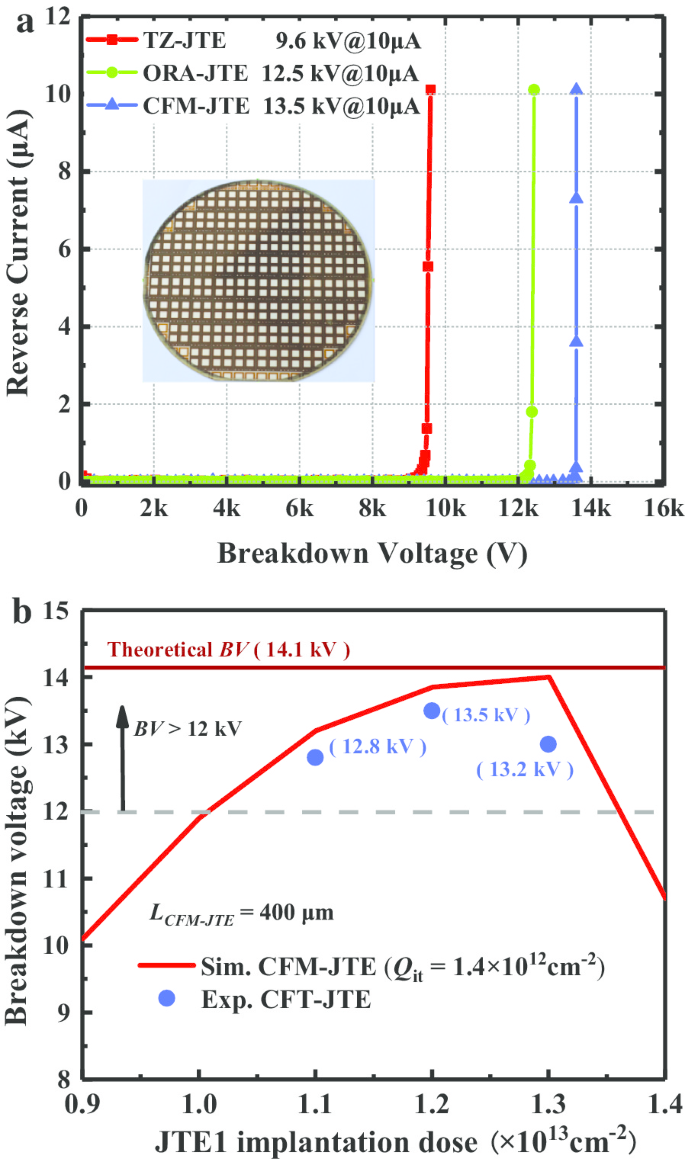
Durchschlagseigenschaften des hergestellten 4H-SiC-PiN-Gleichrichters. a Gemessener BV des CFM-JTE, ORA-JTE und TZ-JTE. b Gemessenes BV des CFM-JTE mit unterschiedlicher Implantationsdosis. Durchgezogene Markierungen sind die experimentellen Werte
Multi-Batch-Muster von CFM-JTE-PiN-Gleichrichtern konnten wiederholt die Durchbruchspannung von 13,5 kV bei einem Leckstrom von 10 μA erreichen. Die experimentelle Sperrspannung erreicht bis zu 96% des theoretischen Durchbruchwertes, was darauf hindeutet, dass der CFM-JTE eine höhere Anschlussschutzeffizienz aufweist. In der 100-μm-Driftschicht des 4H-SiC-PiN-Gleichrichters wurde eine Stehspannung von mehr als 130 V/μm erreicht. Die Verdienstzahl der Baliga (BFOM = BV 2 /R an,sp ) erreicht 58,8 GW/cm 2 bei Raumtemperatur. Die CFM-JTE-PiNs mit unterschiedlichen JTE1-Implantationsdosen wurden hergestellt. Die experimentellen und simulierten Werte der Durchbruchspannung sind in Abb. 12b dargestellt. Die experimentellen Werte stimmen mit dem Trend der Simulation überein und bestätigen, dass die CFM-JTE-Struktur das JTE-Dosistoleranzfenster effektiv erweitern kann. Tabelle 2 vergleicht die Eigenschaften der kürzlich berichteten Ultrahochspannungs-4H-SiC-Gleichrichter. Der in dieser Arbeit hergestellte CFM-JTE 4H-SiC-Gleichrichter zeigt eine hervorragende Leistung in Bezug auf die Ultrahochspannungs-Sperrkapazität, die ultrahohe Durchlassstromleitfähigkeit und die hohe Abschlusseffizienz.
Schlussfolgerungen
In dieser Arbeit wurde der 4H-SiC CFM-JTE PiN-Gleichrichter erfolgreich entwickelt und hergestellt. Die experimentelle Durchbruchspannung des CFM-JTE PiN beträgt 13,5 kV, was 96 % des theoretischen Sperrwertes entspricht. Der CFM-JTE weist im Vergleich zum ORA-JTE (BV = 12,5 kV, mit einer Schutzeffizienz von bis zu 88 %) und dem herkömmlichen TZ-JTE (BV = 9,6 kV, mit einer Schutzeffizienz von bis zu 68 %) eine deutlich verbesserte Anschlussschutzeffizienz auf. ). Der PiN-Gleichrichter CFM-JTE erreicht einen großen Durchlassstrom von 100 A @ V F =5,2 V ohne Verwendung der Technologie zur Verbesserung der Ladungsträgerlebensdauer und zeigt eine stabile Vorwärts-I–V Eigenschaften bei verschiedenen Temperaturen. Die Gütezahl des Baliga für den CFM-JTE PiN-Gleichrichter erreicht 58,8 GW/cm 2 bei Raumtemperatur. Die Toleranz des Implantationsdosisfensters für CFM-JTE wird basierend auf der Modulation des elektrischen Ladungsfelds vergrößert, die ungefähr 2,8-mal höher ist als bei der herkömmlichen TZ-JTE und 1,4-mal höher als bei ORA-JTE, was eine viel bessere Robustheit gegenüber Prozessschwankungen zeigt. Darüber hinaus entspricht der Herstellungsprozess für CFM-JTE dem herkömmlichen TZ-JTE-Prozess, ohne die Anzahl außergewöhnlich komplexer Prozesse oder Masken zu erhöhen, was zeigt, dass der CFM-JTE optimal für Ultra-High-Power-Anwendungen mit zufriedenstellender Terminaleffizienz und Prozesstoleranz.
Verfügbarkeit von Daten und Materialien
Alle Daten stehen uneingeschränkt zur Verfügung.
Abkürzungen
- SiC:
-
Siliziumkarbid
- JTE:
-
Erweiterung des Anschlussabschlusses
- CFM:
-
Ladungsfeldmoduliert
- TZ-JTE:
-
Anschlussverlängerung mit zwei Zonen
- FLR:
-
Feldbegrenzungsring
- MZ-JTE:
-
Anschlusserweiterung für mehrere Zonen
- CD-JTE:
-
Gegendotierte Sperrschicht-Abschlusserweiterung
- Ti:
-
Titan
- Al:
-
Aluminium
- E c :
-
Energieleitungsband
- V F :
-
Durchlassspannung
- ORA-JTE:
-
Out-Ring-assisted Junction Termination Extension
- E q :
-
Elektrisches Feld aufladen
- E p :
-
Angewandtes Potenzialfeld
- Q ich :
-
Effektive Ladung
- VLD:
-
Vielfältige seitliche Dotierung
- w r :
-
Ringbreite
- 2D:
-
Zweidimensional
- BV:
-
Durchbruchspannung
- TW:
-
Toleranzfenster
- Q es :
-
Schnittstellengebühr
- Q j :
-
Ionisationseffektive Ladung
- RTA:
-
Schnelles thermisches Glühen
- R an,sp :
-
Spezifischer Einschaltwiderstand
- BFOM:
-
Baligas Verdienstzahl
Nanomaterialien
- Überlegungen zum Schaltungsschutz, zur Steuerung und zum Sensordesign für Smart Home-Sicherheitsanwendungen
- Herstellung und Charakterisierung eines neuen anodischen Tio2-Kohlenstoff-Nanofaser-Verbundkatalysators für eine Direkt-Methanol-Brennstoffzelle mittels Elektrospinnverfahren
- Herstellung, Charakterisierung und biologische Aktivität von Avermectin-Nanoabgabesystemen mit unterschiedlichen Partikelgrößen
- Herstellung, Charakterisierung und Zytotoxizität von kugelförmigen, konjugierten Gold-Cockle-Shell-abgeleiteten Calciumcarbonat-Nanopartikeln für biomedizinische Anwendungen
- Die Herstellung und hocheffiziente Absorption elektromagnetischer Wellen von CoFe/C-Kern-Schale-strukturierten Nanokompositen
- Herstellung und Charakterisierung von ZnO-Nano-Clips durch das Polyol-vermittelte Verfahren
- Synthese und Charakterisierung von hierarchischen ZSM-5-Zeolithen mit hervorragender Mesoporosität und ausgezeichneten katalytischen Eigenschaften
- Maskenbasierte Beugungslithographie in einem Schritt zur Herstellung von schwebenden 3D-Strukturen
- Neues Gerät moduliert sichtbares Licht mit der kleinsten Stellfläche und dem niedrigsten Stromverbrauch
- Der Gas- und Flammensicherheitsansatz für die Energieerzeugungsbranche



