Untersuchung der Oberflächenpolarisation einer Al2O3-beschichteten GaN/AlGaN/GaN-Heterostruktur durch winkelaufgelöste Röntgenphotoelektronenspektroskopie
Zusammenfassung
Die Oberflächenpolarisation von Galliumnitrid auf der Ga-Seite (GaN) (2 nm)/AlGaN (22 nm)/GaN-Kanal (150 nm)/Puffer/Si mit Al2 O3 Deckschicht wird durch winkelaufgelöste Röntgenphotoelektronenspektroskopie (ARXPS) untersucht. Es hat sich herausgestellt, dass das Energieband im Grenzflächenbereich von einer Aufwärtsbiegung zu einer Abwärtsbiegung variiert, was vermutlich der Polarisationsvariation entspricht. Zwischen oberem GaN und Al2 . wird eine Grenzschicht gebildet O3 aufgrund des Auftretens von Ga-N-Bindungsbrüchen und Ga-O-Bindungsbildung während Al2 O3 Abscheidung über die Atomlagenabscheidung (ALD). Es wird angenommen, dass diese Grenzflächenschicht die GaN-Polarisation beseitigt, wodurch die durch Polarisation induzierten negativen Ladungen reduziert werden. Darüber hinaus spielt diese Grenzschicht eine Schlüsselrolle für die Einführung der positiven Ladungen, die das Energieband nach unten führen. Schließlich ein N2 Es wird beobachtet, dass das Tempern bei 400 °C das Wachstum der Grenzflächenschicht verstärkt und somit die Dichte positiver Ladungen erhöht.
Hintergrund
Galliumnitrid (GaN) gilt in vielen Bereichen von der LED-Industrie bis zur Leistungselektronikindustrie als eines der attraktivsten Halbleitermaterialien [1, 2]. Die Popularität ist auf eine Reihe von Vorteilen in Bezug auf Silizium zurückzuführen:hohes elektrisches Durchschlagsfeld, hohe Elektronenbeweglichkeit und ausgezeichnete thermische Stabilität [3, 4]. Der GaN-Transistor mit hoher Elektronenmobilität (HEMT) wird häufig für Hochleistungs- und Hochfrequenzanwendungen untersucht [1, 5, 6]. Im HEMT bringt diese Gate-Schnittstelle, wenn das Schottky-Gate verwendet wird, große Grenzflächenzustände, die den großen Leckstrom und das niedrige Durchbruchfeld verschlimmern [7]. Ein als Oberflächenpassivierungsschicht und Gatedielektrikum induzierter Isolator könnte dazu beitragen, die oben genannten Probleme zu mildern [8,9,10].
Al2 O3 wird für eine solche Isolatoranwendung aufgrund seiner großen Bandlücke, hohen Dielektrizitätskonstante und negativerer freier Gibbs-Energie im Vergleich zu Ga2 . bevorzugt O3 , daher wird angenommen, dass Al2 O3 könnten die Oberflächenzustände passivieren und das elektrische Durchbruchfeld verbessern [5]. Jedoch wird unvermeidlich eine Grenzflächenschicht am GaN/Al2 . gebildet O3 Schnittstelle nach der Abscheidung des Al2 O3 [11, 12]. Es wird angenommen, dass diese Grenzschicht mit der Zuverlässigkeit der Schwellenspannung und den Eigenschaften des zweidimensionalen Elektronengases (2DEG) korreliert und eine Schlüsselrolle bei der Kontrolle der Bandverbiegung spielt [2, 13,14,15,16].
Obwohl die Grenzschicht von mehreren Forschungsgruppen untersucht wurde, wurde die Rolle der Grenzschicht nicht eingehend untersucht [12, 17]. Daher verwenden wir in diesem Artikel die winkelaufgelöste Röntgen-Photoelektronenspektroskopie (ARXPS), um die allmählichen Änderungen der Bandverbiegung zu erkennen und die atomare Struktur der Grenzschicht zu erhalten [11]. Verschiedene Dicken von Al2 O3 werden durch Atomlagenabscheidung (ALD) auf GaN-Proben abgeschieden. ALD nutzt eine schichtweise Abscheidungstechnologie bei niedriger Temperatur, die die thermische Reaktion zwischen GaN und Al2 . begrenzt O3 . Daher wird ALD aufgrund seiner hohen Anpassungsfähigkeit und Gleichmäßigkeit, Genauigkeit bei der Dickensteuerung, hoher Filmqualität und geringer Defektdichte von der Industrie bevorzugt, um High-k-Dielektrika abzuscheiden [4]. Dies ermöglicht ein glattes und defektarmes Al2 O3 /GaN-Schnittstelle. Nach Al2 O3 Abscheidung wird auch eine Probe nach dem Abscheidungsglühen (PDA) bei 400 °C hergestellt, um die Zwischenschichtreaktion zu intensivieren und die Zwischenschichtbildung zu verbessern. Basierend auf den ARXPS-Ergebnissen wird festgestellt, dass sich das Band aufgrund der polarisationsinduzierten negativen Ladungen anfänglich vom GaN-Substrat zur nahen Grenzfläche nach oben biegt. Mit zunehmendem Erfassungswinkel θ , biegt sich das Band aufgrund der Bildung positiver Ladungen allmählich nach unten [5, 11,12,13].
Methoden
Der GaN/AlGaN/GaN-auf-Si(111)-Wafer mit Ga-Seite wurde von einer kommerziellen Firma (Enkris.com) gekauft. Die epitaktische Wurtzit-Struktur umfasst eine 2-nm-GaN-Schicht auf einer 22-nm-AlGaN-Schicht, und die beiden epitaktischen Schichten werden auf einer 150-nm-i-GaN-Schicht aufgewachsen. Eine Pufferschicht dient als Übergangsschicht, die die GaN-Epischicht und das Si-Substrat verbindet. Drei Proben, S1, S2 und S3, werden vorbereitet. Alle Proben wurden zuerst 5 min in Aceton eingetaucht, gefolgt von einem Eintauchen in Isopropylalkohol und einem Spülen in fließendem entionisiertem (DI) Wasser. Das native Oxid wurde dann durch Eintauchen in eine verdünnte HCl-Lösung (HCl:H2 O =1:10) für ~ 1 min, gefolgt von einer Spülung in DI-Wasser. Die Al2 O3 werden durch ALD auf GaN abgeschieden, mit Trimethylaluminium (TMA) und H2 O als Metallvorläufer bzw. Oxidationsmittel. Die Al2 O3 die Dicke beträgt 1 nm für die Probe S1 und 3 nm für die Proben S2 und S3. Die Dicke wird mit dem Ellipsometer gemessen. Darüber hinaus wurde S3 in N2 . einer PDA unterzogen bei 400 °C für 5 Min.
ARXPS-Messungen wurden in einem Thermo Fisher Scientific Theta-Probe-System durchgeführt, das mit einer monochromatischen, mikrofokussierten Al K&agr;-Röntgenquelle (1486,6 eV) und einem halbkugelförmigen Elektronenenergieanalysator ausgestattet war. Die Kalibrierung der Bindungsenergie (BE) wurde mit reinen Ni-, Au-, Ag- und Cu-Standardproben durch Einstellen der Ni-Fermi-Kante Au 4f . durchgeführt 2.07 , Ag 3d 5/2 , und Cu 2p 3/2 Peaks bei 0,00 ± 0,02, 83,98 ± 0,02, 368,26 ± 0,02 bzw. 932,67 ± 0,02 eV. Die FWHM eines gegebenen Komponentenspektrums durfte nur in einem engen Bereich (± 0,1 eV) variieren. Es wurde die niedrigste Anzahl von Komponentenspektren verwendet, um akzeptabel niedrige Restwerte zu erhalten [11]. Die XPS-Spektren wurden bei verschiedenen Detektionswinkeln (θ ), im Bereich von 27,5° bis 72,5° zur Probennormalen parallel ohne Verkippung der Probe. Um eine mögliche positive ladungsinduzierte BE-Verschiebung auszuschließen, wurden die erhaltenen XPS-Spektren auf die C 1s . bezogen Spitze bei 285,0 eV. Die quantitative Analyse, einschließlich der Bestimmung des Element/Bindungs-Verhältnisses, wurde mit relativen Sensitivitätsfaktoren und Algorithmen erreicht, die in die Avantage-Software eingebettet sind [11].
Ergebnisse und Diskussion
Der Ga 3d Kernniveauspektren für S1–S3 bei verschiedenen Photoelektronen-Detektionswinkeln sind jeweils in Abb. 1a–c dargestellt. Für S1 jedes Ga 3d Spektrum kann mit zwei Peaks ausgestattet werden, die den Ga-N- und Ga-O-Bindungen entsprechen. Die Ga-O-Bindungen sind auf die Oxidbildung als Ergebnis der Sauerstoffexposition in der ALD zurückzuführen, und der Sauerstoff ist in das anfängliche dünne Al2 . eingedrungen O3 Schicht [3]. Für S2 und S3 können drei Peaks identifiziert werden, die als Ga–N, Ga–O und O 2s bezeichnet werden , bzw. Die O 2s Peak wird den Ga-O- und Al-O-Bindungen zugeschrieben und wird deutlich, wenn der Detektionswinkel größer wird. Da sich dieser Artikel nicht auf diesen Gipfel konzentriert, wird er nicht weiter diskutiert. Abbildung 2 zeigt den BE von Ga-N-Peaks als Funktion von θ für S1–S3. Eine 0,2-eV-Abnahme ergibt sich aus θ =27,5° bis 72,5° für S1. Es deutet auf eine Bandkrümmung nach oben hin, was mit den Publikationen übereinstimmt [3, 11]. Für S2 zeigt BE eine Abnahme von 0.1 eV, was auf eine leichte Aufwärtsbiegung nahe der Grenzfläche im Vergleich zu S1 oder ein flaches Energieband ohne Bandbiegung unter Berücksichtigung experimenteller Fehler hinweist. Für S3 gibt es jedoch einen 0,2-eV-Anstieg im BE, was im Gegensatz zu den Proben S1 und S2 steht, was eine Abwärtsbiegung des Bandes empfiehlt. Abbildung 3 zeichnet das Al 2p . auf Spektren für alle Proben, und es gibt keine Änderung in den BEs. Darüber hinaus wird der Peak als Al-O-Bindung bezeichnet, und folglich hat die AlGaN-Schicht einen vernachlässigbaren Einfluss auf die Ga-N-BE-Variation. Tabelle 1 fasst die BEs von Ga 3d . zusammen und Al 2p bei unterschiedlichen Erfassungswinkeln für alle Proben mit einem Fehler von ± 0,1 eV.

Das XPS Ga 3d Kernspektren für a S1, b S2 und c S3

Die BE des Ga-N-Spektrumpeaks als Funktion des Detektionswinkels θ (relativ zum Normalwert) für S2. Der Fehlerbalken beträgt ± 0,1 eV

Das XPS Al 2p Kernspektren für a S1, b S2 und c S3, und der Peak zeigt die Al-O-Bindung an. Darüber hinaus gibt es keine signifikante BE-Variation
Die Verhältnisse des Ga-O- zu Ga-N-Peaks für alle Proben sind in Tabelle 2 angegeben. Das Verhältnis beträgt für die Proben S1 und S2 etwa 0,2, was mit früheren Ergebnissen übereinstimmt [3]. Nach der PDA-Behandlung steigt das Verhältnis jedoch auf ~ 0,3 und bedeutet eine Zunahme des GaO x Grenzflächenschicht. Darüber hinaus ist das Ga/N-Verhältnis auch in Tabelle 2 angegeben. Das Verhältnis wird berechnet, indem die integrierten Intensitäten von Ga 3d . verglichen werden und N 1s Peaks mit atomaren Sensitivitätsfaktoren [18]. Für die Proben S1 und S2 deutet das Verhältnis um 1,7 auf eine Ga-reiche Grenzschicht hin. Nach dem N2 beim Glühen sinkt das Verhältnis auf ~ 1,0. Darüber hinaus ist in Tabelle 2 auch die Probenahmetiefe für jeden Winkel angegeben. Aufgrund der exponentiellen Abschwächung von Photoelektronen stammen 63 bzw. 95 % der detektierten Elektronen aus einem Abstand von 1λ (d. h. λ steht für die inelastische mittlere freie Weglänge des Elektrons (IMFP)) bzw. 3λ von der Oberfläche. Daher wird die XPS-Probentiefe als 3λ Nanometer unter der Probenoberfläche definiert. In unserem Fall Al2 O3 ist die Deckschicht und das λ von Ga 3d Photoelektronen in Al2 O3 wird auf ~~3,4 nm geschätzt. Für eine grobe Schätzung wird die Abtasttiefe bei verschiedenen Winkeln als 3λcosθ . angegeben . Die tatsächliche Ga-N-BE-Probentiefe sollte jedoch die Dicke von Al2 . berücksichtigen O3 , daher wird die Sampling-Tiefe auf 3λcosθ . geschätzt abzüglich der Deckelung Al2 O3 Dicke. Da das GaO x Schicht auf der GaN-Heterostruktur liegt, ist das Signal dieser Schicht für jeden Detektionswinkel enthalten. Mit zunehmendem Detektionswinkel nimmt jedoch die Signalintensität der Ga-N-Bindung ab, was zu einer Zunahme des Ga-O/Ga-N-Verhältnisses führt. Vergleicht man S2 mit S3, deuten die Zunahme des Ga-O/Ga-N-Verhältnisses und die Abnahme des Ga/N-Verhältnisses darauf hin, dass die Ga-reiche Schicht oxidiert wurde, um GaO x . zu bilden .
Zur Veranschaulichung der hier präsentierten Experimentdaten wird in Abb. 4 schematisch ein Modell vorgeschlagen. Das Fermi-Energieniveau des GaN/AlGaN/GaN-Substrats wird während der XPS-Messung auf 0 eV kalibriert [19]. Das Leitungsbandmaximum (CBM), das Valenzbandmaximum (VBM) und das Kernniveau sind angegeben. Der BE ist die Energiedifferenz zwischen dem Kernniveau und dem Fermi-Niveau. Bei der ALD-Abscheidung könnte O aus dem Oxygenant N in der Ga-N-Bindung ersetzen, um das GaN zu oxidieren, und die umgebenden N-Atome könnten N2 . bilden Moleküle [20], was zur Bildung der Ga-reichen Schicht und des Galliumoxids (GaO x ) Grenzschicht [11, 18]. Dies wird durch das Ga/N-Verhältnis unterstützt, das in Tabelle 2 größer als 1 ist. Dieses Verhältnis zeigt die Änderung der GaN-Stöchiometrie an, und der intrinsische spontane Polarisationseffekt von GaN sollte verschwinden [21,22,23]. Als Ergebnis wird die Ga-reiche Schicht als GaN-zu-GaO x Übergangsschicht, eliminiert die polarisationsinduzierten negativen Ladungen und führt zu einem flachen Leitungsband [11], wie in Abb. 4 gezeigt.
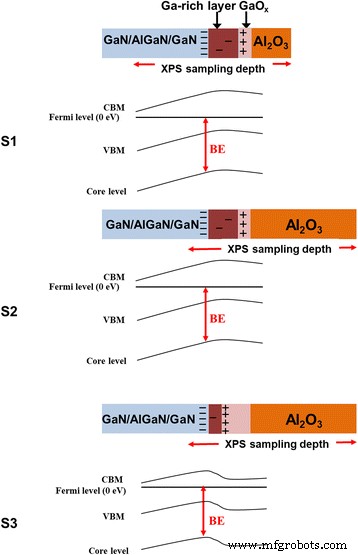
In der Grenzflächenregion führt O, das N in der Ga-N-Bindung ersetzt, zu einer Ga-reichen Schicht und einem GaO x Schicht. Die Ga-reiche Schicht wirkt als GaN-zu-GaO x Übergangsschicht. Die Ga-O-Bildung eliminiert die Polarisation von GaN und wirkt als positive Ladung. Als Ergebnis biegt sich das Leitungsband allmählich von oben nach unten und der BE variiert entsprechend
Darüber hinaus wird beim Glühprozess die Ga-reiche Oberfläche oxidiert, um ein dickeres GaO x . zu bilden Schicht. Da die Oxidation eine kinetisch begrenzte Reaktion ist und auf etwa zwei Oberflächenmonoschichten beschränkt ist, wird das Volumen nicht stark gestört [24]. Daher stammt das Signal der Ga-N-Bindung hauptsächlich vom nicht oxidierten darunterliegenden Volumen, was zu einem stöchiometrischen Ga/N-Verhältnis von 1 für S3 führt. Das GaO x Es wurde berichtet, dass die Schicht positive Ladungen einbringt, die feste Grenzflächenladungen mit Energiezuständen zwischen den Leitungsbandminima des nativen Oxids und GaN sein können, was das Band nach unten biegen würde [4, 11, 13, 14]. Daher beginnt das Leitungsband der Ga-reichen Schicht im Bereich nahe dem GaO x . abzunehmen Schicht. Ein dickeres GaO x Es wird erwartet, dass eine größere Dichte positiver Ladungen entsteht. In Bezug auf die Konstante BE von Ga–O und Al–O in S3 deutet dies darauf hin, dass sich die positive Ladung an der Grenzfläche Ga-reiche Schicht/GaO x . befinden sollte Schicht. Die positiven Ladungen und die polarisationsinduzierten negativen Ladungen bilden ein internes elektrisches Feld, das die Bandbiegung von einer Aufwärtsbiegung zu einer Abwärtsbiegung verändert, wie in Abb. 4 gezeigt. Aufgrund der Abwärtsbiegung steigt BE mit zunehmendem Erfassungswinkel .
Das GaO x Grenzschicht bringt positive Ladungen ein, die die Grenzschichthöhe erhöhen ɸb . ɸb ist definiert als die Energiedifferenz zwischen dem Fermi-Niveau und dem Leitungsbandminimum an der Oberfläche oder Grenzfläche [25]. Als Ergebnis nach dem A2 O3 Ablagerung wird die Mobilität des 2DEG erhöht und die Elektronendichte von 2DEG verringert [16, 25, 26].
Mit dem Anstieg des Al2 O3 Dicke reflektiert das XPS-Signal mehr auf dem Grenzflächenbereich zwischen dem bedeckten Al2 O3 und GaN/AlGaN/GaN, was durch die in Tabelle 2 gezeigte XPS-Abtasttiefe validiert wird. Dies erklärt, dass für S2 nur ein Teil des Bandkrümmungsprofils nachgewiesen werden konnte [27]. Als Ergebnis beträgt die BE-Variation 0,1 eV, kleiner als 0,2 eV von S1. Bei S3 mit einer dickeren Grenzschicht wird die Dichte der positiven Ladungen erhöht, was zu einer Abwärtsbiegung des Bandes führt.
Schlussfolgerungen
Zusammenfassend lässt sich sagen, dass die Grenzflächenpolarisation von Al2 O3 -capped GaN/AlGaN/GaN wird vom ARXPS untersucht. Die intrinsische Polarisation von GaN wird durch eine Ga-reiche Schicht und ein GaO x . eliminiert Schichtbildung. Darüber hinaus sind die Ga-O-Bindungen aus dem GaO x Schicht bringen positive Grenzflächen-Festladungen ein. Aufgrund dieser Polarisationsvariation variiert das Band von der Aufwärtsbiegung zu der Abwärtsbiegung im Grenzflächenbereich.
Nanomaterialien
- 5G und GaN:Innovationen der Zukunft
- Einfluss von Oberflächenzuständen und Aluminium-Molekülfraktion auf das Oberflächenpotential und 2DEG in AlGaN/GaN-HEMTs
- Infrarotreflexionsanalyse von epitaktischen n-dotierten GaN-Schichten, die auf Saphir gewachsen sind
- Zielgerichtete Endothelzellen mit multifunktionalen GaN/Fe-Nanopartikeln
- Abstimmung der Oberflächenmorphologien und -eigenschaften von ZnO-Filmen durch das Design der Grenzflächenschicht
- Optimale Silizium-Dotierungsschichten von Quantenbarrieren in der Wachstumssequenz, die ein weiches Einschlusspotential von In0,2Ga0,8N/GaN-Quantenquellen von Blau mit acht Perioden bilden LEDs
- Untersuchung einer kristallinen Silizium-Solarzelle mit schwarzer Siliziumschicht auf der Rückseite
- Verstehen des Wachstumsmechanismus von GaN-Epitaxieschichten auf mechanisch abgeblättertem Graphit
- Stammkontrollierte Rekombination in InGaN/GaN-Mehrfachquantenquellen auf Siliziumsubstraten
- Dickenabhängigkeit von Grenzflächen- und elektrischen Eigenschaften in Atomlagen-abgeschiedenem AlN auf c-Ebenen-GaN



