Experimentelle und theoretische Studien zum Mo/Au-Schottky-Kontakt an mechanisch abgeblätterten β-Ga2O3-Dünnschichten
Zusammenfassung
Wir haben den Rückstromemissionsmechanismus von Mo/β-Ga2 . untersucht O3 Schottky-Diode durch die temperaturabhängige Strom-Spannungs-(IV)-Kennlinie von 298 bis 423 K. Die Variation des Sperrstroms mit dem elektrischen Feld weist darauf hin, dass die Schottky-Emission der dominante Ladungsträgertransportmechanismus bei Sperrvorspannung ist und nicht der Frenkel-Poole Fallenunterstütztes Emissionsmodell. Darüber hinaus wurde eine Durchbruchspannung von 300 V in einer Fluorinert-Umgebung mit einem durchschnittlichen elektrischen Feld von 3 MV/cm in Mo/β-Ga2 . erhalten O3 Schottky-Diode. Die Auswirkungen der Oberflächenzustände auf die elektrische Feldverteilung wurden auch durch TCAD-Simulation analysiert. Mit zunehmenden negativen Oberflächenladungsdichten nimmt das elektrische Spitzenfeld monoton ab. Darüber hinaus wurde auch die Höheninhomogenität der Schottky-Barriere unter Vorwärtsspannung diskutiert.
Hintergrund
Kürzlich wurde der Halbleiter mit ultrabreiter Bandlücke β-Ga2 O3 hat aufgrund seiner hervorragenden Eigenschaften viel Interesse geweckt, wie z. B. hohe chemische Stabilität, große direkte breite Bandlücke von 4,8–4,9 eV, hohes theoretisches elektrisches Durchbruchsfeld BR ) von 8 MV/cm und eine hohe Baliga-Zahl von 3400, die etwa zehnmal größer ist als die von SiC und viermal größer als die von GaN [1,2,3]. Die Kombination all dieser Eigenschaften mit dem hochwertigen, großflächigen und kostengünstigen β-Ga2 O3 durch Schmelzwachstumstechniken gewachsenes Substrat macht β-Ga2 O3 ein bevorzugtes Material für Hochspannungs- und Hochleistungselektronikanwendungen [4,5,6,7,8,9]. Als vielversprechendes elektronisches Gerät ist β-Ga2 O3 Schottky-Dioden (SBD) wurden mit verschiedenen Anodenelektrodenmetallen hergestellt, darunter Cu [8], Pd [10], Pt [5, 6, 11,12,13], Au [10, 14], Ni [13, 15 ,16,17,18] und TiN [12], und seine elektrischen Vorwärts- und Rückwärtseigenschaften, wie der spezifische Durchlasswiderstand, I an /Ich aus Verhältnis, Barrierehöhen, Sperrleckstrom und Durchbruchspannung wurden umfassend untersucht. Die inhomogene Höhe der Schottky-Barriere und der nicht sättigende Sperrstrom wurden in β-Ga2 . angegeben O3 SBDs [6, 8, 11, 18, 19], während viel weniger Informationen über den Ladungsträgertransportmechanismus unter Sperrspannung bekannt waren, der für die Erhöhung der Durchbruchspannung wesentlich ist.
Darüber hinaus wurden keine Untersuchungen zur Analyse der Emissionsmechanismen von Mo/β-Ga2 . durchgeführt O3 Kontakt. Wenn es einige Fallen oder Defekte im β-Ga2 . gibt O3 Substrat, der Leckstrom stimmt mit dem Frenkel-Poole-Emissionsmodell überein, und der Sperrstrom ist die Emission von Elektronen aus einem eingefangenen Zustand in der Nähe der Metall-Halbleiter-Grenzfläche. Andernfalls wird der Hauptprozess im Sperrstrom von der Schottky-Emission dominiert, dass die Elektronen über der Schottky-Barriere zu einem Sperrstrom führen. β-Ga2 O3 Kristall hat auch eine einzigartige Eigenschaft, eine große Gitterkonstante von 12.23 Å entlang der [100]-Richtung, die eine leichte Spaltung in dünne Bänder oder Nanomembranen ermöglicht [9, 20]. In dieser Arbeit haben wir großflächiges β-Ga2 . mechanisch exfoliert O3 aus einem Bulk-Substrat mit niedriger Versetzungsdichte, und zum ersten Mal wurde das thermisch stabile Molybdän (Mo) als Anodenelektrodenmetall zur Herstellung von β-Ga2 . gewählt O3 vertikale Schottky-Dioden. Der elektrische Leitungsmechanismus unter Sperrspannung wurde im Temperaturbereich von 298 bis 423 K diskutiert. Diese Arbeit bietet Einblicke in Ladungsträgertransportmechanismen, die dazu beitragen können, die Funktionalität von β-Ga2 . zu verbessern O3 -basierte Geräte.
Methoden/Experimental
Wie in Fig. 1a, b gezeigt, wurde die Schottky-Diode auf dem β-Ga2 . hergestellt O3 (100) Film, mechanisch vom Sn-dotierten β-Ga2 . abgeblättert O3 Substrat mit einer Dicke von 15 μm und einer Elektronenkonzentration von 2 × 10 17 cm − 3 . Wie in Abb. 1d, e dargestellt, wurden die Halbwertsbreite (FWHM) und der quadratische Mittelwert (RMS) durch hochauflösende Röntgenbeugung (HRXRD) und atomare auf 51,9 Bogensekunden bzw. 0,19 nm geschätzt Kraftmikroskop (AFM) Messungen. Durch die Messung wurden eine ausgezeichnete Kristallqualität und eine glatte Oberfläche bestätigt. Nach der nasschemischen Reinigung wurde der Ti/Au (20 nm/100 nm)-Metallstapel mittels Elektronenstrahlverdampfung auf der Rückseite abgeschieden und anschließend bei 600 °C für 60 s unter einer Stickstoffatmosphäre bis bilden den Ohmschen Kontakt. Die kreisförmigen Schottky-Anodenelektroden mit Durchmessern von 100 μm wurden auf der Vorderseite durch Aufdampfen von Mo/Au-(40 nm/100 nm)-Metallen und Abhebeprozess gebildet. Abbildung 1c zeigt die Struktur des schematischen Querschnitts von β-Ga2 . O3 SBD in dieser Arbeit.
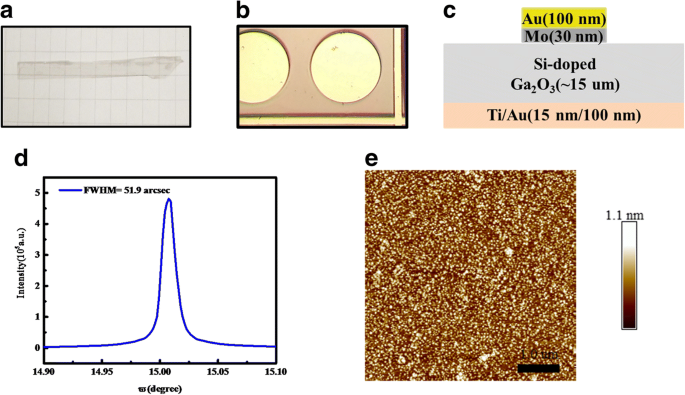
a Das Sn-dotierte β-Ga2 O3 Substrat mit einer Dicke von 300 μm. b Die auf der Vorderseite gebildeten Schottky-Anodenelektroden mit Durchmessern von 100 μm. c Die Struktur des schematischen Querschnitts des β-Ga2 O3 SBD. d XRD-Rocking-Kurve und e AFM-Bild des β-Ga2 O3 Driftschicht mechanisch abgeblättert von (100) β-Ga2 O3 Substrat
Ergebnisse und Diskussion
Die Strom-Spannungs-Eigenschaften (I-V) von Au/Mo/β-Ga2 O3 Schottky-Dioden wurden mit einem Keithley 4200-Halbleitercharakterisierungssystem zwischen 298 und 423 K untersucht. Wie in Abb. 2a gezeigt, ist das I an /Ich aus Verhältnis liegt nahe bei 10 10 bei 298 K, was auf ein gutes Korrekturverhalten hinweist. Für die Vorwärtsspannung von 0,1 bis 0,7 V sind die halblogarithmischen I-V-Kurven fast linear und zeigen ein starkes Temperaturabhängigkeitsverhalten. Mit zunehmender Durchlassspannung wird die Abweichung von der Linearität der IV-Kurven dem Serienwiderstand der Schottky-Diode zugeschrieben und die Beziehung zwischen der angelegten Spannung und dem Strom kann als \( I={I}_s\left \{\exp \left[\frac{q\left(V-{IR}_s\right)}{nkT}\right]-1\right\} \) [21,22,23], wobei V ist die angelegte Spannung, R s der Serienwiderstand, T die absolute Temperatur, k die Boltzmann-Konstante, n der Idealitätsfaktor und ich s ist der umgekehrte Sättigungsstrom. Die n und ich s kann aus der Steigung und dem Achsenabschnitt des ln . bestimmt werden I-V-Plots bzw. Für die ideale Schottky-Diode ist der Idealitätsfaktor n sollte gleich der Einheit sein. Je höher die n , desto größer ist die Abweichung vom Modell der thermischen Emission (TE). Außerdem gilt nach der Gleichung \( {\phi}_b=\frac{kT}{q}\ln \left[\frac{AA^{\ast }{T}^2}{I_s}\right]\ ) [21,22,23], die Werte von ϕ b bei unterschiedlichen Temperaturen wurden ebenfalls bestimmt, wie in Abb. 2b gezeigt, wobei ϕ b ist die Barrierehöhe, A ist die Diodenfläche und A * ist die effektive Richard-Konstante 40,8 A cm −2 K − 2 mit dem β-Ga2 O3 effektive Masse von m * = 0,34 m 0 [5, 24]. Mit einem Temperaturanstieg von 298 auf 423 K wird der ϕ b steigt während n sinkt, was auf einen anderen Transportmechanismus hinweist, der ebenfalls zum Stromtransport beiträgt und zu einer Abweichung der I-V-Charakteristik vom reinen TE-Modell führt, über die zuvor in β-Ga2 . berichtet wurde O3 Schottky-Dioden [25] und andere Bauelemente mit großer Bandlücke [26,27,28,29,30]. Die Barrierehöheninhomogenitätsanalyse kann durch eine Gaußsche Verteilung in Barrierehöhen beschrieben werden,
$$ {\phi}_b=\overline{\phi_{b0}}\left(T=0\right)-\frac{q{\sigma}_s^2}{2 kT} $$ (1)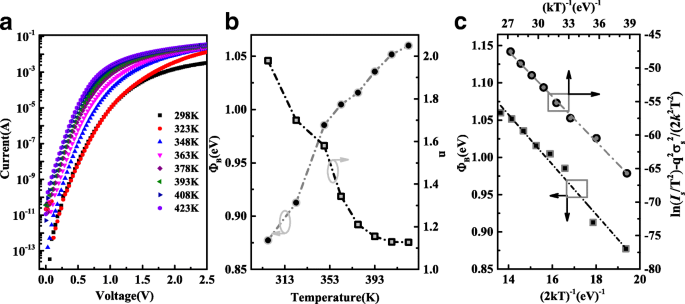
a Vorwärts-I-V-Eigenschaften von Mo/β-Ga2 O3 Schottky-Dioden bei verschiedenen Temperaturen. b Temperaturabhängigkeit des Idealitätsfaktors und der Schottky-Barrierehöhe von β-Ga2 O3 Schottky-Diode. c Plots von ϕ ap im Vergleich zu q/2k T und modifizierter Richardson-Plot gegen 1/k T für β-Ga2 O3 Schottky-Dioden
Die Werte der mittleren Barrierenhöhe \( \overline{\phi_{b0}} \) und der Standardabweichung σ s werden aus Fig. 2c zu 1,55 eV bzw. 0,186 eV extrahiert. Darüber hinaus wird der konventionelle Richardson-Plot unter Berücksichtigung der Barrierehöheninhomogenitäten wie folgt modifiziert:
$$ \ln \left(\frac{I_{\textrm{s}}}{T^2}\right)-\left(\frac{q^2{\sigma}_{\textrm{s}}^ 2}{2{k}^2{T}^2}\right)=\ln\left({AA}^{\ast}\right)-\frac{q\overline{\phi_{b0}}} {kT} $$ (2)Wie in Abb. 2c gezeigt, ist das modifizierte \(\ln\left({I}_{\mathrm{s}}/{T}^2\right)-\left({q}^2{\sigma}_ {\mathrm{s}}^2/2{k}^2{T}^2\right)\) versus 1/kT ist eine gerade Linie. Der Achsenabschnitt der Kurve wird verwendet, um das A . zu erhalten * von 44,7 A cm −2 K −2 , was dem theoretischen Wert von β-Ga2 . sehr nahe kommt O3 von 40,8 A cm −2 k −2 . Daher sind die Barriereninhomogenitäten an der Metall/Halbleiter-Grenzfläche für β-Ga2 O3 SBD kann durch TE mit der Gaußschen Verteilung der Barriere über die SBHs erklärt werden.
Die Reverse-Durchbruchsmessung bei Raumtemperatur wurde ebenfalls unter Verwendung des Hochspannungs-Halbleiteranalysatorsystems Agilent B1505A durchgeführt, wie in Abb. 3 gezeigt. Die Durchbruchsspannung betrug 260 V, während sie 300 V betrug, wenn die Probe in Fluorinert™ getaucht wurde, das von der Firma 3M hergestellt wurde die einen Luftdurchschlag bei hoher Sperrspannung verhindern kann. Um die Verteilung des elektrischen Feldes zu verstehen, wurde eine numerische Simulation mit der ATLAS-Software durchgeführt, wie in Abb. 4a, b gezeigt. Mit zunehmendem Abstand von der Grenzfläche zwischen dem Halbleiter und der Anode auf etwa 1 μm nimmt das elektrische Feld allmählich ab. An der Position von x = 4 μm, das durchschnittliche elektrische Feld beträgt 3 MV/cm, berechnet aus Abb. 4c. Auch in Fig. 4d gezeigt, an der Position von y = 1 nm betrug das maximale elektrische Feld bei der Durchbruchspannung etwa 8 MV/cm am Rand des Schottky-Kontakts, was etwa dem 2,7-fachen des durchschnittlichen elektrischen Felds entspricht. Wie von AJ Green et al. [31] und K. Zeng et al. [32] berichtet, betrugen das elektrische Spitzenfeld und das durchschnittliche elektrische Feld der Elektrodenkante 5,3, 3,8 MV/cm bzw. 6,1 , 4,4 MV/cm. und das elektrische Spitzenfeld von Mo/Ga2 O3 Schottky-Diode ist relativ hoch. Es wird angenommen, dass das β-Ga2 O3 Nanomembranen, die durch mechanisches Peeling erhalten werden, haben eine große Anzahl von freien Bindungen und Oberflächenzuständen, die Elektronen einfangen, um die Ladungsträger von der Anode zur Kathode unter umgekehrter Vorspannung zu verarmen [33]. Unter Berücksichtigung der negativen Oberflächenladung zeigte das Simulationsergebnis, dass das elektrische Feld am Rand des Schottky-Kontakts mit zunehmenden negativen Oberflächenladungsdichten von 0,5 × 10 13 . abnahm cm −2 bis 3 × 10 13 cm −2 , bzw. Besonders bei negativen Oberflächenladungsdichten von 3 × 10 13 cm −2 , beträgt das elektrische Spitzenfeld am Rand des Schottky-Kontakts etwa 5,2 MV/cm. Daher kann die Sperrdurchbruchspannung von 300 V auf dem β-Ga2 . erreicht werden O3 Nano-Membran mit N D = 3 × 10 17 cm −2 ohne Randabschlussstrukturen. Wie in Abb. 4d gezeigt, wegen der Existenz des Schnittstellenzustands bei X -Position unter 2 μm können die Elektronen eingefangen und die Verarmungsregion gebildet werden, was zu einem elektrischen Feld im Y . führt Richtung. Mit zunehmender Grenzflächenzustandskonzentration wird das elektrische Feld im Y Richtung nimmt zu, obwohl das elektrische Feld im X Richtung geht gegen Null. Das elektrische Feld nimmt also bei X . zu -Position unter 2 μm.
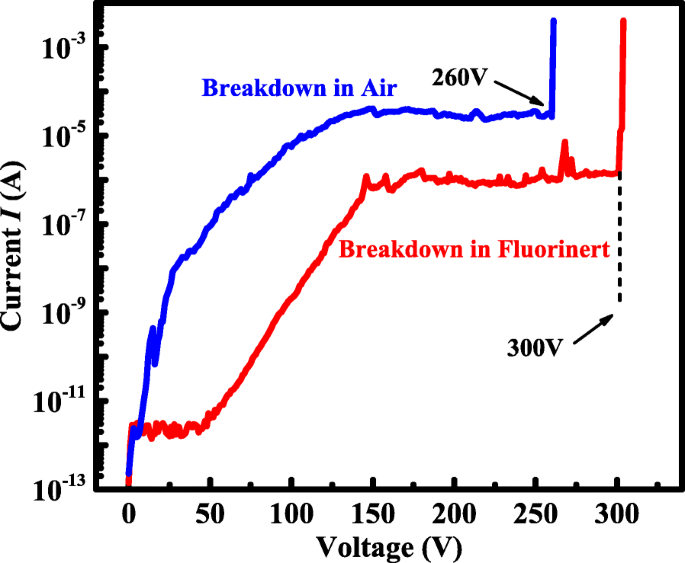
Die umgekehrten I-V-Eigenschaften von β-Ga2 O3 Proben bei Raumtemperatur bzw. in Fluorinert und Luft

a TCAD-Simulation des elektrischen Felds im ausgeschalteten Zustand der Schottky-Dioden unter − 300 V Vorspannung. b Die Simulation des elektrischen Felds der ausgewählten Regionen in grün gestrichelter Box. Das Potenzial entlang des y Achse bei x = 4 μm ist vorhanden in (c ) und das elektrische Feld am Rand des Schottky-Kontakts reduziert mit unterschiedlichen effektiven negativen Oberflächenladungsdichten sind in (d )
Andererseits mit der umgekehrten Vorspannung V wie steigt, der Leckstrom I wie für |V . steigt statt in die Sättigung |> 3 k B T/q , wie in Abb. 5a gezeigt, was nicht mit der TE-Theorie übereinstimmt. Daher wurde die durch das elektrische Feld verstärkte thermionische Emission betrachtet, um die Abhängigkeit von I . zu diskutieren wie auf V wie , einschließlich Poole-Frenkel-Emission und Schottky-Emission [34, 35]. Bei der Poole-Frenkel-Emission transportieren die Elektronen vom Metall über einen eingefangenen Zustand in den Halbleiter und das I wie wird gegeben durch
$$ {I}_{re}\propto E\exp \left(\frac{q}{kT}\sqrt{\frac{qE}{{\pi\varepsilon}_S}}\right) $$ (3 )während bei der Schottky-Emission die Elektronen genug Energie gewinnen, um die Barriere am Metall/Halbleiter zu überwinden, um den Strom und das I . zu bilden wie kann ausgedrückt werden durch
$$ {I}_{re}\propto {T}^2\exp \left(\frac{q}{2 kT}\sqrt{\frac{qE}{{\pi \varepsilon}_S}}\right ) $$ (4)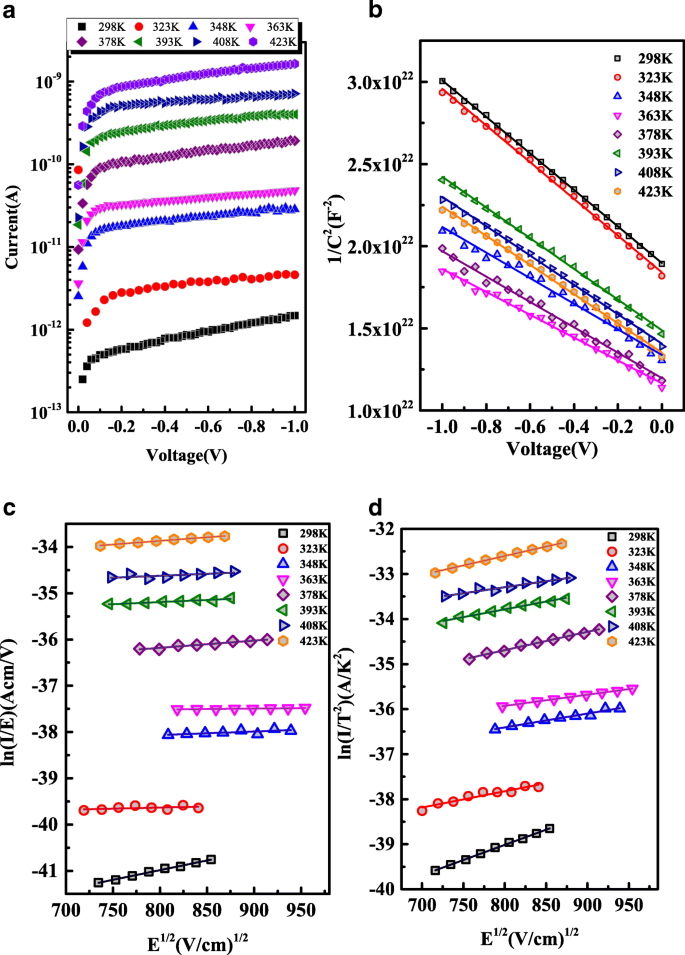
a Umgekehrte I-V-Eigenschaften von Mo/β-Ga2 O3 Schottky-Dioden bei unterschiedlicher Temperatur. b Temperaturabhängigkeit von 1/C 2 Eigenschaften des Mo/ β-Ga2 O3 Schottky-Dioden. Die elektrische Feldabhängigkeitsanalyse von Mo/β-Ga2 O3 Schottky-Kontakt mit unterschiedlichem Mechanismus. c Poole-Frenkel-Mechanismus (I /E ) gegen E 1/2 und d Schottky-Mechanismus ln (Ich /T 2 ) gegen E 1/2
wo ε s ist die Permittivität von β-Ga2 O3 (~ 10 ε0 ) und E ist das angelegte elektrische Feld, berechnet durch \( E\kern0.5em =\kern0.5em \sqrt{\frac{2{qN}_D}{\varepsilon_S}\left(V+{V}_{bi}-\frac {k_BT}{q}\right)} \), N D ist die Donordichte von β-Ga2 O3 , und V bi ist das eingebaute Potenzial. Wie in Abb. 5b gezeigt, N D und V bi kann aus der Steigung und dem Achsenabschnitt der inversen quadratischen Kapazität (1/C 2 ) gegen das V wie Plots mit dem folgenden Ausdruck
$$ \frac{1}{C^2}=\frac{2\left({V}_{\mathrm{bi}}-kT/qV\right)}{q{\varepsilon}_s{A}^ 2{N}_D} $$ (5)Wenn die Kurve von ln (I/T 2 ) gegen E 1/2 linear ist, dominiert der Schottky-Emissionsmechanismus. Und wenn die Handlung von ln (Ich /E ) gegen E 1/2 ist, dominiert die Poole-Frenkel-Emission den Rückstromtransport. Abbildung 5c, d zeigt die Diagramme von ln (Ich /E ) und ln (Ich /T 2 ) gegen E 1/2 , bzw. Beide Kurvensätze sind linear, was anzeigt, dass nicht nur die Poole-Frenkel-Emission, sondern auch die Schottky-Emission vorhanden ist. Um den dominanten Trägertransportmechanismus zu verdeutlichen, kann die Steigung der Kurven oder der Emissionskoeffizient als [34,35,36] ausgedrückt werden.
$$ S=\frac{q}{nkT}\sqrt{\frac{q}{\pi\varepsilon}} $$ (6)wo n = 1 ist für die Poole-Frenkel-Emission (S PF ) und n = 2 für die Schottky-Emission (S S ). Die experimentellen Werte von S werden als S . bezeichnet m-PF und S m-S für Poole-Frenkel- und Schottky-Emission, gegeben durch die Steigung der Kurven in Abb. 5c bzw. d. Die Verhältnisse des experimentellen Werts zum theoretischen Wert, N PF (=S m-PF /S PF ) und N S (=S m-S /S S ) sind in Abb. 6 dargestellt. Da die Werte von N S näher an der Einheit sind als die von N PF , wird der Sperrstrom von der Schottky-Emission dominiert.

Relative Koeffizientendiagramme der Poole-Frenkel-Emission N PF (=S m-PF /S PF ) und Schottky-Emission N S (=S m-S /S S ) gegen Temperatur
Schlussfolgerungen
Wir haben die elektrischen Eigenschaften von Mo/Au-Schottky-Dioden untersucht, die auf (100) β-Ga2 . hergestellt wurden O3 Film mechanisch vom Sn-dotierten β-Ga2 . abgeblättert O3 Substrat. Auf der Grundlage des TE-Modells wird das extrahierte ϕ b und n nimmt mit steigender Temperatur zu bzw. ab. Unter Annahme der Gaußschen Verteilung der inhomogenen Barrierenhöhe wurden die mittlere Barrierenhöhe von 1,55 eV und die Standardabweichung von 0,186 eV erhalten. Schließlich gemäß dem ln (Ich /T 2 ) und ln (Ich /E ) gegen E 1/2 Plots, der Parameter N S der Schottky-Emission liegt nahe Eins, was veranschaulicht, dass die Schottky-Emission der dominante Transportmechanismus des Rückstroms ist. Die Durchbruchspannung von 300 V mit Proben in Fluorinert wird in Mo/Au-Schottky-Dioden mit einem durchschnittlichen elektrischen Feld von 3 MV/cm erhalten, was auf das große Potenzial von β-Ga2 . hinweist O3 für leistungselektronische Anwendungen.
Abkürzungen
- I-V:
-
Strom-Spannung
- Mo:
-
Molybdän
- RTA:
-
Schnelles thermisches Glühen
- SBD:
-
Schottky-Diode
- TE:
-
Thermionische Emission
Nanomaterialien
- Experimentelle Forschung zur Stabilität und natürlichen Konvektion von TiO2-Wasser-Nanofluid in Gehäusen mit unterschiedlichen Rotationswinkeln
- Die Wirkung von Kontakt-Nichtgleichgewichtsplasma auf die strukturellen und magnetischen Eigenschaften von Mn Х Fe3 − X О4 Spinellen
- Experimentelle Studie zu den Strömungs- und Wärmeübertragungseigenschaften von TiO2-Wasser-Nanofluiden in einem spiralförmig geriffelten Rohr
- Herstellung von SrGe2-Dünnschichten auf Ge (100), (110) und (111) Substraten
- 5-Aminolävulinsäure-Squalen-Nanoanordnungen für die Tumorphotodetektion und -therapie:In-vitro-Studien
- Untersuchung der Adhäsionskraft und des Glasübergangs dünner Polystyrolfolien durch Rasterkraftmikroskopie
- Vorbereitung und thermoelektrische Eigenschaften von ITO/PtRh:PtRh-Dünnschicht-Thermoelementen
- TEM- und STEM-Studien zu den Querschnittsmorphologien von Dual-/Tri-Layer-Breitband-SiO2-Antireflexfolien
- Theoretische Studien zu InGaAs/InAlAs SAGCM Avalanche Photodioden
- Eine theoretische Simulation des Strahlungsverhaltens von Si-, Ge- und Si/Ge-Übergittern auf niederenergetische Bestrahlung



