Vergleichende Analyse von Defekten in Mg-implantierten und Mg-dotierten GaN-Schichten auf freistehenden GaN-Substraten
Zusammenfassung
Eine ineffiziente Mg-induzierte Dotierung vom p-Typ ist nach wie vor ein Haupthindernis bei der Entwicklung von GaN-basierten elektronischen Bauelementen für Festkörperbeleuchtungs- und Leistungsanwendungen. Diese Studie berichtet über eine vergleichende Strukturanalyse von Defekten in GaN-Schichten auf freistehenden GaN-Substraten, bei denen der Mg-Einbau über zwei Ansätze erfolgt:Ionenimplantation und epitaktische Dotierung. Die Rastertransmissionselektronenmikroskopie zeigte das Vorhandensein von Pyramiden- und Liniendefekten nur in der Mg-implantierten Probe, während die Mg-dotierte Probe das Vorhandensein dieser Defekte nicht zeigte, was darauf hindeutet, dass die Art der Defekte von der Einbaumethode abhängt. Bei der Sekundärionen-Massenspektrometrie wird eine direkte Übereinstimmung zwischen Mg-Konzentrationen und Ort und Art dieser Defekte beobachtet. Unsere Untersuchungen legen nahe, dass diese Pyramiden- und Liniendefekte Mg-reiche Spezies sind und ihre Bildung zu verringerten freien Lochdichten führen kann, was immer noch ein Hauptproblem für p-GaN-basierte Materialien und Geräte darstellt. Da freistehende GaN-Substrate eine Plattform für die Realisierung von vertikalen Bauelementen auf pn-Übergangsbasis bieten, wird eine vergleichende strukturelle Untersuchung von Defekten, die durch verschiedene Mg-Einbauprozesse in GaN-Schichten auf solchen Substraten entstanden sind, wahrscheinlich mehr Einblicke in das Verständnis der Mg-Selbstkompensationsmechanismen geben und dann Optimierung des Mg-Dotierungs- und/oder Implantationsprozesses für die Weiterentwicklung der GaN-basierten Gerätetechnologie.
Einführung
In den letzten drei Jahrzehnten hat sich GaN zu einem der am besten untersuchten Verbindungshalbleiter weltweit entwickelt. Dies liegt vor allem an seinem enormen Potenzial nicht nur in Festkörperbeleuchtungsanwendungen, sondern auch im Hochleistungs-, Hochfrequenz- und Hochtemperaturbetrieb [1,2,3,4,5,6,7,8]. Für den erfolgreichen Einsatz von Vorrichtungen auf Basis von GaN und verwandten Heterostrukturen in solchen Anwendungen und Operationen ist eine steuerbare n-Typ- und p-Typ-Dotierung die Schlüsselanforderung. In diesem Aspekt ist das Erreichen und Steuern der n-Dotierung in GaN-Epischichten oder -Einkristallen jetzt im Vergleich zu ihrem p-Typ-Gegenstück, das immer noch ein Flaschenhals für die Wissenschaft und die Industrie ist, in hohem Maße optimiert. Bis jetzt hat sich Mg trotz seiner hohen Aktivierungsenergie, die eine große Menge an Mg-Konzentrationen erfordert (etwa 10 19 cm −3 oder mehr) eingearbeitet werden, um vernünftige Konzentrationen freier Löcher nahe 10 18 . zu erreichen cm −3 . Jeder Anstieg der Mg-Atomkonzentration über 10 19 . hinaus cm −3 führen zu einer Abnahme der Konzentration freier Löcher [9,10,11]. Dieses Phänomen wird hauptsächlich der Bildung von N-Leerstellen [12,13,14], Mg-bezogenen Punktdefekten [10, 15] oder Mg-Leerstellen-bezogenen geladenen und/oder neutralen Komplexen zugeschrieben, die das Fermi-Niveau senken und freie Löcher sättigen Konzentrationen [16, 17]. Auf der Grundlage von Photolumineszenzmessungen, die zu einem Peak bei 2,9 eV führten, wurde ein tiefer Donordefektkomplex Mg-VN wurde auch als einer der Hauptgründe für den Selbstkompensationsmechanismus angesehen. [17,18,19]. Daher bleibt dieses Problem trotz der zahlreichen bedeutenden Forschungsversuche zum Verständnis des Mg-Einbaus in GaN noch unklar und es müssen weitere Analysen durchgeführt werden.
Die meisten der früheren Berichte über Defektanalysen mit mikroskopischen Untersuchungen im atomaren Maßstab basieren auf Mg-dotierten GaN-Schichten, die auf Saphir unter Verwendung von metallorganischer chemischer Gasphasenabscheidung (MOCVD) oder Molekularstrahlepitaxie (MBE) aufgewachsen sind. Nach unserem besten Wissen gibt es nur wenige Berichte über die Defektanalyse in Mg-dotierten freistehenden GaN-Substraten und es gibt keinen Bericht über die auf Transmissionselektronenmikroskopie basierende Defektanalyse in freistehenden GaN-Substraten, bei denen Mg durch Ionenimplantation eingebaut wird. Es ist mittlerweile allgemein anerkannt, dass freistehende GaN-Substrate aufgrund geringerer Versetzungsdichten und ihrer Anwendungen in effizienten vertikalen Bauelementen mehrere Vorteile gegenüber MOCVD/MBE-gewachsenen GaN-Schichten auf Fremdsubstraten aufweisen. Das Erreichen einer ausreichenden p-Typ-Dotierstoffaktivität in solchen Substraten durch Ionenimplantation muss für die Kommerzialisierung und Entwicklung von GaN-basierten Festkörperbeleuchtungs- und Hochleistungsbauelementen erforscht werden. Mit all diesen Aspekten als Hauptziel haben wir eine detaillierte Strukturanalyse von Mg-inkorporierten Defekten in freistehenden GaN-Schichten durchgeführt, bei denen der Mg-Einbau durch Dotierung sowie Ionenimplantation erreicht wird.
Experimentelle Methoden
In unserer Studie werden freistehende n-GaN-Substrate verwendet, die mittels Hydrid-Dampfphasenepitaxie gezüchtet wurden. Danach werden Epitaxieschichten durch MOCVD auf diesen Substraten aufgewachsen. Der Einbau von Mg erfolgt über zwei Ansätze:Ionenimplantation und epitaktische Dotierung. Im ersten Fall wird Mg in eine 4 µm dicke undotierte GaN-Epitaxieschicht implantiert, ohne dass eine Schutzschicht auf undotierten GaN-Schichten abgeschieden wird, während im zweiten Fall 1 µm dickes Mg-dotiertes GaN auf 4 µm . epitaktisch aufgewachsen wird -dicke undotierte GaN-Schichten kontinuierlich. Für einen zuverlässigen Vergleich wird der Mg-Einbau bei 4 × 10 19 . gehalten cm −3 in beiden Fällen. Die Mg-Implantation wird bei 500°C durchgeführt, gefolgt von einem Tempern bei 1350°C zur Aktivierung der Dotierstoffe. Die Implantationsenergien werden als 15, 30, 55, 95 und 180 keV mit entsprechenden Dosierungen von 3,0 × 10 13 . angenommen , 5,5 × 10 15 , 1,1 × 10 14 , 1,9 × 10 14 , und 8 × 10 14 cm −2 , um ein 200 nm tiefes Boxprofil zu erhalten. Hall-Messungen werden durchgeführt, um die elektrischen Eigenschaften von sowohl Mg-dotierten als auch Mg-implantierten GaN-Proben zu bewerten. Für eine Mg-dotierte GaN-Probe wurde eine Lochkonzentration und Mobilität von 3,4 × 10 17 . gefunden cm −3 und 9,5 cm 2 /V-s. Andererseits konnten die elektrischen Eigenschaften der Mg-implantierten Probe aufgrund ihrer hochohmigen Natur nicht richtig bewertet werden. Die Verteilung von Mg als Funktion der Tiefe wird mit Sekundärionen-Massenspektrometrie (SIMS) untersucht, während die Rastertransmissionselektronenmikroskopie (STEM) für Strukturuntersuchungen von Mg-induzierten Defekten verwendet wird. Dazu wurden STEM und elektronenenergiedispersive Röntgenspektroskopie (EDS) von JEOL JEM-ARM200F bei 200 und 80 kV betrieben. Für diese Studien wurden TEM-Proben durch fokussiertes Ionenstrahlfräsen unter Verwendung von Ga-Strahlen, gefolgt von einem mit flüssigem Stickstoff gekühlten, niederenergetischen Ar-Ionenfräsen hergestellt.
Ergebnisse und Diskussion
Fehleranalyse in Mg-implantierter GaN-Schicht
Abbildung 1(a) zeigt das Hellfeld(BF)-STEM-Bild von Mg-implantiertem GaN, während (b) das entsprechende SIMS-Profil zeigt. Der in Fig. 1(a) gezeigte Pfeil stellt eine positive [0001]-Richtung dar und Bilder werden entlang der [11\(\overline{2}\)0]-Zonenachse betrachtet. Es ist zu erkennen, dass Defekte als Funktion der Tiefe nicht gleichmäßig verteilt sind, tatsächlich wird eine direkte Korrelation zwischen den Konzentrationen von Mg und Defekten beobachtet. Die meisten Defekte sammeln sich in einer Entfernung von etwa 150 nm von der Oberfläche an, wo die Mg-Konzentration mehr als 10 19 . beträgt cm −3 wie aus SIMS-Messungen beobachtet. Zum besseren Verständnis von Defekten und ihrer Visualisierung aufgrund der Mg-Implantation in GaN wird die Bildgebung im Zustand außerhalb der Zonenachse durchgeführt, indem die Probe um 10° um die c-Achse von der [11\( \overline{2} \)0]-Achse gekippt wird . Diese Bedingung schwächt den Beugungskontrast aufgrund des perfekten Kristalls und erhöht den Defektkontrast, was eine bessere Visualisierung der Defekte im Vergleich zur Umgebung ermöglicht. BF-STEM-Bild einer Mg-implantierten GaN-Probe, die unter diesen Bedingungen außerhalb der Zonenachse aufgenommen wurde, ist in 1(c) gezeigt, wo einige Liniendefekte in einer Tiefe von etwa 200 nm von der Oberfläche gesehen werden. Das entsprechende Mg-SIMS-Profil ist in (d) im linearen Maßstab dargestellt, wobei eine direkte Übereinstimmung zwischen der Existenz dieser Liniendefekte und der Mg-Konzentration beobachtet wird. Diese Defekte befinden sich in einem engen Bereich, in dem die Mg-Konzentration etwa 10 19 . beträgt cm −3 Reichweite.
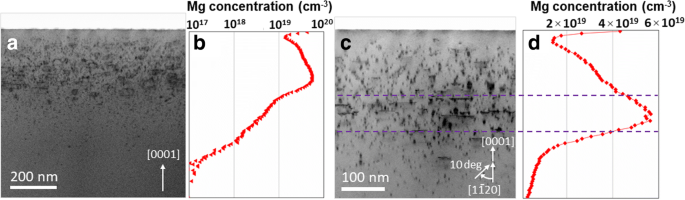
a Querschnitts-Hellfeld-STEM-Bild einer Mg-implantierten GaN-Probe, aufgenommen entlang der [11\( \overline{2} \)0]-Achse und b entsprechendes Tiefenprofil von Mg, das mit SIMS erhalten wurde. Zur besseren Visualisierung der Defekte und ihrer Beziehung zur Mg-Konzentration wird die Bildgebung unter Bedingungen außerhalb der Zonenachse durchgeführt, wie in c . gezeigt . Mg-Profil entsprechend c wird in d angezeigt im linearen Maßstab, wo Liniendefekte in einem schmalen Bereich mit der höchsten Mg-Konzentration beobachtet werden
Ferner wird eine BF-STEM-Bildgebung mit hoher Vergrößerung unter Bedingungen außerhalb der Zonenachse durchgeführt, wie in Fig. 2(a) gezeigt, wobei (b) den ausgewählten Bereich von (a) bei einer höheren Vergrößerung zeigt. Wie in (b) gezeigt, werden vier Arten von Strukturen beobachtet, die als A, B, C und D bezeichnet sind. Die mit „A“ gekennzeichneten Defekte sind pyramidenförmig, während „B“ als Liniendefekte erscheint.

a Querschnitt-Hellfeld-STEM-Bild einer Mg-implantierten GaN-Probe, die in einem Zustand außerhalb der Zonenachse erhalten wurde, um die Defektkontraste zu verstärken. Vergrößerte Ansicht des markierten Bereichs in (a ) wird in (b ), wo vier verschiedene Arten von Fehlern, die als A, B, C und D gekennzeichnet sind, beobachtet werden. Hochauflösendes TEM-Bild der Pyramidendomänen mit der Bezeichnung A in (b .) ) wird angezeigt in (c ) mit schematischer Darstellung rechts unten. Das verzerrte Gitter auf der Pyramidendomäne wird durch Zusammendrücken (c ) wie in (d . gezeigt ). Hochauflösendes TEM-Bild eines typischen C- oder D-Typ-Defekts wird in (e ) mit zusammengedrücktem Bild in (f ), zeigt den Spannungsfeldkontrast um den Defekt herum
Die strukturellen Beobachtungen dieser Defekte sind im Hinblick auf das Verständnis der Mg-Kompensationsmechanismen wichtig, und die nächsten Abschnitte des Manuskripts sind hauptsächlich der Strukturanalyse von Typ-„A“- und „B“-Defekten gewidmet. Die mit „A“ bezeichneten Strukturen sind pyramidenförmige Defekte mit positiver [0001] Richtung, die auf ihren Kopf zeigt, ihre Basis auf [0001] Ebene mit sechs Wänden auf [11\( \overline{2} \)3] Ebenen geneigt wie durch gezeigt hochauflösendes TEM-Bild eines solchen Defekts in Fig. 2(c). Die schematische Darstellung einer solchen Pyramidendomäne ist auch in Fig. 2(c) gezeigt. Abbildung 2 (c) ist senkrecht zur [0001]-Richtung gequetscht, wie in (d) gezeigt, wobei das Gitter in der Pyramidendomäne im Vergleich zur umgebenden GaN-Matrix verzerrt zu sein scheint, was auf eine Verschiebung zwischen den Ga- und N-Untergittern innerhalb und außerhalb dieser Pyramidendomänen hinweist. . Dies steht im Einklang mit den Ergebnissen von Vennegues et al. [20] wo ähnliche Typen von Pyramidendomänen beobachtet werden. Die ähnlichen pyramidenförmigen Defekte wurden früher in Mg-dotierten GaN-Filmen beobachtet und ihre Existenz wird normalerweise durch eine Modifikation der GaN-Atomstruktur aufgrund der Mg-Einführung erklärt [19,20,21,22,23,24]. Liliental-Weber et al. [25, 26] schlugen vor, dass solche Pyramidendefekte von Mg-reichen Clustern stammen, die sich in der Nähe des Kopfes dieser Pyramiden befinden. Die GaN-Struktur in der Wurtzit-Phase wird normalerweise durch hexagonale Stapelung von N-Ebenen beschrieben, wobei die Hälfte der N-Untergitter-Tetraederplätze mit Ga-Atomen gefüllt sind. Vennegueset al. [27] schlugen auf der Grundlage ihrer Untersuchungen vor, dass die Einführung eines höheren Mg-Gehalts in GaN zur Substitution von Ga durch Mg führt, wodurch Mg3 . gebildet wird N2 , eine Mg-N-Verbindung, von der berichtet wird, dass sie eine Antibixbyit-Struktur besitzt. Die Antibixbyte-Struktur von Mg3 N2 entspricht der Füllung der N-Untergitter-Tetraederplätze durch Mg, das drei von vier Plätzen einnimmt. Nach dem von Vennegues et al. [27] kann eine pyramidale Domäne als zwei GaN-Kristalle entgegengesetzter Polarität betrachtet werden, die durch eine Monoschicht aus Mg3 . getrennt sind N2 . Dies wird durch die Untersuchungen von Hansen et al. [28] wobei diese pyramidalen Domänen als Mg3 . vorgeschlagen wurden N2 Einschlüsse. Vennegueset al. [27] und Leroux et al. [23] berichteten auch, dass die Bildung solcher pyramidaler Domänen mit Nanometergröße auch einen Mg-Einbau von niedrigen bis mittleren 10 19 . erfordert cm −3 Palette. Dies stimmt mit unseren Ergebnissen überein, bei denen die Pyramidenformdefekte im unteren bis mittleren Bereich von 10 19 . beobachtet werden cm −3 Mg-Konzentrationen, wie aus der Korrelation zwischen dem STEM-Bild (Abb. 1(c)) und dem entsprechenden SIMS-Profil (Abb. 1(d)) ersichtlich ist. Daher wird angenommen, dass die pyramidenförmigen Defekte, die in Abb. 2 (b) unserer Studie als Strukturen "A" gekennzeichnet sind, Mg-reiche Pyramidendomänen sind und ihre Bildung direkt mit dem Mg-Kompensationsmechanismus in p-GaN-Schichten in Verbindung gebracht werden kann. Andere Arten von Defekten, wie in Fig. 2(b) gezeigt, sind Defekte vom Typ "C" und "D", die im Wesentlichen ähnliche Strukturen mit Variationen in ihren Abmessungen sind. Der Kontrast, der bei Betrachtung von der [11\(\overline{2}\)0]-Achse entlang der [0001]-Richtung verlängert zu sein scheint, ist wahrscheinlich auf eine Dehnung zurückzuführen. Um dies weiter zu verdeutlichen, ist ein hochauflösendes TEM-Bild eines solchen ähnlichen Defekts in Fig. 2(e) dargestellt, wobei (f) das gleiche Bild senkrecht zur [0001]-Richtung gequetscht zeigt. Das verzerrte Gitter entlang der [0001]-Richtung deutet auf unterschiedliche Gitterkonstanten aufgrund unterschiedlicher Dehnungsfelder entlang dieser Richtung hin. Da Mg im Vergleich zu Ga kleiner ist, wird erwartet, dass sein Einbau in die Ga-Stellen eine Spannung im Gitter erzeugt, die zu diesem Kontrast um diese Defekte herum führen kann.
Eine andere Art von Defekten, die in Abb. 2(b) als "B" bezeichnet sind, scheinen Liniendefekte senkrecht zur [0001]-Richtung zu sein, wenn sie von der [11\(\overline{2}\)0]-Achse aus betrachtet werden. Es ist wichtig anzumerken, dass diese Art von Defekten anscheinend in einem schmalen Bereich mit höheren Mg-Konzentrationen akkumuliert zu sein scheint (wie aus der Übereinstimmung zwischen dem BF-STEM-Bild und dem Mg-SIMS-Profil in Abb. 1(c) und (d)) ersichtlich ist, was legt nahe, dass ihre Bildung mit der übermäßigen Aufnahme von Mg verbunden ist. Eine weitere Beobachtung ist das Vorhandensein der pyramidalen Domänen an den Kanten dieser Liniendefekte, was darauf hindeutet, dass eine Anhäufung dieser Domänen zu ihrer Bildung führen kann. Es sollte jedoch nicht ausgeschlossen werden, dass es sich einfach um eine zufällige Überlappung von Pyramiden- und Liniendefekten handeln könnte und weitere Untersuchungen in diese Richtung erforderlich sind. Das BF-STEM-Bild, das diese Arten von Defekten zeigt, ist in Abb. 3(a) dargestellt. Zum besseren Verständnis dieser Defekte wird die Probe um etwa 10° um die Achse senkrecht zur [0001]-Richtung gekippt und das erhaltene BF-STEM-Bild ist in Fig. 3(b) gezeigt. Diese Neigung der Probe regt die Beugungsflecken entlang der Richtungen 1–100 stark an, was zu einem verbesserten Kontrast aus dem Spannungsfeld in der Richtung um den Defekt führt. Aus diesem Spannungsfeldkontrast geht hervor, dass der Defekt, der als Linie erschien (siehe Fig. 2(a) und (b)) tatsächlich aus einem Paar von Linien besteht, die um einige nm getrennt sind, tiefer in [0001]-Richtung.

a Querschnitts-Hellfeld-STEM-Bild einer Mg-implantierten GaN-Massivprobe zur Analyse von Typ-B-Defekten, die wie Pyramidenstümpfe oder Trapezform erscheinen. b stellt das Bild dar, das durch Neigen der Probe um 10° um die Achse senkrecht zu c . aufgenommen wurde -Achse, bei der an den Rändern dieser Defekte ein unterschiedlicher Kontrast beobachtet wird
Es könnte die Möglichkeit des Vorhandenseins von Mg in diesen Defekten geben, da sie im engeren Bereich erscheinen, wo die Mg-Konzentration höher als 10 19 . ist cm −3 wie aus der Korrespondenz zwischen STEM-Bild (Abb. 1(c)) und Mg-SIMS-Profil (Abb. 1(d)) hervorgeht. Um diese Annahme dieser Art von Defekten mit Mg zu bestätigen, führten wir Rastertransmissionselektronenmikroskopie-Energiedispersive-Spektroskopie (STEM-EDS)-Messungen mit einem EDS-Sondendurchmesser von weniger als 0,2 nm an zwei verschiedenen Regionen durch:„weg vom Defekt“ und „bei Defekt“ als Punkt 1 bzw. 2 gekennzeichnet, wie in Abb. 4(a) gezeigt. Die vergleichenden EDS-Spektren von den Punkten 1 und 2 im Energiebereich von 1,19 keV bis 1,35 keV, wo ein Mg-Peak erwartet wird, sind in Abb. 4(b) aufgetragen, wobei der Einschub die vollständigen EDS-Spektren zeigt. Das Vorhandensein von Mg ist am Defekt deutlich zu erkennen (Punkt 2). Um dies weiter zu rechtfertigen, haben wir STEM-EDS-Mapping an einer ähnlichen Mg-implantierten GaN-Probe durchgeführt. Abbildung 4 (c) zeigt ein STEM-Bild einer Mg-implantierten GaN-Probe mit Abwärtspfeilen, die diese Liniendefekte zeigen, und die entsprechende EDS-Karte von Mg ist in Abbildung 4 (d) gezeigt. Die Anwesenheit von Mg ist in diesen Defekten deutlich zu sehen. Daher enthalten diese Defekte Mg und ihre Bildung bei Mg-Konzentrationen von mehr als 10 19 cm −3 ist wahrscheinlich eine weitere Ursache für die Mg-Kompensation.

a STEM-Querschnittsbild einer Mg-implantierten GaN-Probe, die einen individuellen Typ „B“-Defekt zeigt. Die Punkte 1 und 2 stellen Regionen dar, in denen EDS-Messungen durchgeführt werden und die resultierenden EDS-Spektren sind in b . dargestellt . EDS-Spektren im Energiebereich von 1,19–1,40 keV sind in b . aufgetragen mit Einschub, der die vollständigen EDS-Spektren mit Ga- und N-Peaks zeigt. c und d präsentieren Sie ein STEM-Bild und eine entsprechende Mg-Karte einer ähnlichen Mg-implantierten Massenprobe, die das Vorhandensein von Mg in diesen Arten von Defekten zeigt
Fehleranalyse in Mg-dotierter GaN-Schicht
Als nächstes haben wir Strukturuntersuchungen an der GaN-Probe durchgeführt, bei der eine 1 µm dicke Mg-dotierte GaN-Schicht epitaktisch auf eine 4 µm dicke undotierte GaN-Epitaxieschicht aufgewachsen wurde. Es ist noch einmal erwähnenswert, dass das Mg-Niveau gleich gehalten wird, d. h. 4 × 10 19 cm −3 für einen aussagekräftigen Vergleich zwischen zwei Ansätzen des Mg-Einbaus:epitaktisch dotiert und Ionenimplantation. Abbildung 5(a) zeigt ein BF-STEM-Bild von Mg-dotiertem GaN, das epitaktisch auf freistehenden GaN-Substraten aufgewachsen ist, gesehen entlang [11\(\overline{2}\)0], während (b) das Mg-Profil als Funktion der GaN-Tiefe zeigt erhalten mit SIMS. Beachten Sie, dass die Mg-Konzentration bei etwa 4 × 10 19 . nahezu konstant bleibt cm −3 innerhalb des Sichtfelds von Abb. 5(a) (bis zu 700 nm) im Gegensatz zum früheren Fall von Mg-implantiertem GaN, bei dem festgestellt wurde, dass die Mg-Konzentration eine Funktion der GaN-Tiefe ist (siehe Abb. 1 (a)–(d )).
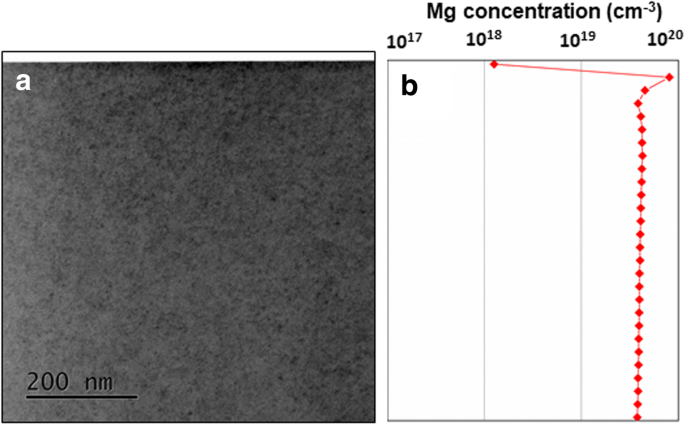
a Querschnitts-Hellfeld-STEM-Bild einer Mg-dotierten Bulk-GaN-Probe, aufgenommen entlang der [112 ̅0]-Achse und b entsprechendes Tiefenprofil von Mg, das mit SIMS erhalten wurde. Es wird festgestellt, dass punktförmige Defekte gleichmäßig über die Probe verteilt sind
Zur Durchführung von Defektanalysen in Mg-dotierten GaN-Proben, STEM-Bildgebung im Zustand außerhalb der Zonenachse durch Neigen der Probe um 10° um c -Achse von [11\( \overline{2} \)0]-Achse ausgeführt wird. Die Abbildungen 6 (a) und (b) stellen die BF-STEM- und DF-STEM-Bilder dar, bei denen punktförmige Defekte mit einer Größe von etwa 5 nm als gleichmäßig über die Probe verteilt beobachtet werden. Beachten Sie hier, dass das Mg-Profil auch in diesem Fall einheitlich zu sein scheint, wie aus dem SIMS-Profil hervorgeht (siehe Abb. 5(b)). Die gleichmäßige Verteilung von Mg und diesen Defekten in der GaN-Probe deutet auf eine direkte Korrelation zwischen diesen Defekten und dem Einbau von Mg hin. Diese punktförmigen Defekte von etwa 5 nm sind wahrscheinlich Ausscheidungen von Mg (und möglicherweise dadurch induzierte Stapelfehler). Aufgrund ihrer geringen Größe konnte die Mg-Präzipitation selbst nicht direkt durch EDS-Messungen bestätigt werden (Ga- und Mg-Peaks liegen ziemlich nahe beieinander, was die Kartierung kleiner Konzentrationsunterschiede extrem schwierig macht).
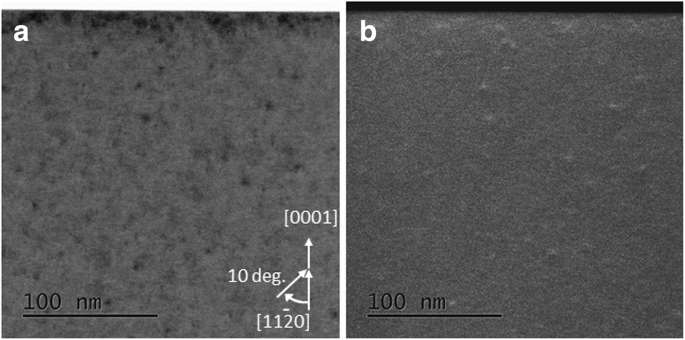
Querschnitt a STEM-BF und b STEM-ADF-Bilder einer Mg-dotierten Bulk-GaN-Probe, die in einem Zustand außerhalb der Zonenachse aufgenommen wurden, um die Defektkontraste zu verstärken
Diese Beobachtung unterscheidet sich vollständig von dem früheren Fall einer Mg-implantierten Probe, bei der festgestellt wurde, dass sich Defekte bei 200 nm von der Oberfläche entfernt ansammeln, wo die Mg-Konzentration maximal war. Darüber hinaus beobachteten wir im Gegensatz zur Mg-implantierten Probe keine Pyramiden- und Zweiliniendefekte (in Abb. 2(b) als A und B gekennzeichnet) in der Mg-dotierten GaN-Probe. Interessanterweise werden auch Pyramiden- und Liniendefekte in den GaN-Proben berichtet, bei denen Mg durch andere Techniken als Ionenimplantation eingebaut wurde. Khromov et al. [29] berichteten von pyramidalen Defekten in Mg-dotierten GaN-Proben, die durch MOCVD gezüchtet wurden. Sie beobachteten solche Defekte jedoch nur in höher dotierten GaN-Proben, bei denen die Mg-Konzentration etwa ~ 5 × 10 19 . betrug cm −3 . In Proben mit Mg ~ 2 × 10 18 cm −3 , wurden diese pyramidalen Domänen nicht beobachtet. Vennegueset al. [27] beobachteten auch solche pyramidalen Domänen in MOCVD-gewachsenen Mg-dotierten GaN-Proben mit Mg-Konzentrationen im mittleren Bereich von 10 19 cm −3 Palette. Sie beobachteten keine solchen Defekte in Proben mit Mg-Konzentrationen von weniger als 10 19 cm −3 . In unserer Arbeit, ähnlicher Mg-Wert ~ 4 × 10 19 cm −3 wird über Ionenimplantation und epitaktische Dotierung eingebaut, um das Vorhandensein dieser Defekte zu analysieren. Diese Defekte werden nur in Mg-implantierten Proben beobachtet, nicht in Mg-dotierten Proben, was nahelegt, dass auch die Mg-Verteilung zur Erklärung ihrer Existenz in Betracht gezogen werden sollte. Aus SIMS-Messungen wurde festgestellt, dass Mg in der Mg-implantierten Probe ungleichmäßig verteilt ist (Abb. 1(b) und (d)), während die Mg-dotierte Probe eine gleichmäßige Verteilung von Mg zeigte (Abb. 5 (b)). Darüber hinaus wurde in Mg-implantierten Proben festgestellt, dass diese Defekte nur in einem schmalen Fenster mit einer höheren Mg-Konzentration im Vergleich zur umgebenden Matrix vorhanden waren. Daher ist die Bildung dieser Defekte mit der Menge an eingebautem Mg und der Verteilung von Mg verbunden und sie werden wahrscheinlich in den Regionen gebildet, in denen Mg im Bereich von 10 19 . liegt cm −3 . Es scheint, dass ein ungleichmäßiges Mg-Profil in einer Mg-implantierten Probe zu einer ungleichmäßigen Verteilung von Defekten führt. Jedoch sollte man die Möglichkeiten wie ungleichmäßig verteilte Defekte, die eine ungleichmäßige Mg-Verteilung verursachen, oder die Abhängigkeit des Mg-Implantationsprofils von der Existenz solcher Defekte nicht leugnen; daher sind weitere Untersuchungen in dieser Richtung erforderlich. Unsere vergleichende Analyse von Defekten in Mg-inkorporiertem GaN legt nahe, dass die Art und Art der Defekte von der Inkorporationsmethode abhängen.
Schlussfolgerungen
Zusammenfassend haben rastertransmissionselektronenmikroskopische Strukturuntersuchungen von Defekten in Mg-implantierten und Mg-dotierten Epischichten auf freistehenden GaN-Substraten gezeigt, dass die Art der Defekte stark von der Methode des Mg-Einbaus abhängt. Mg-implantiertes GaN zeigte das Vorhandensein von Pyramidendomänen, die in Richtung [0001] zeigten, und zweizeilige Defekte mit Merkmalen, die einige Nanometer tiefer in [0001]-Richtung getrennt waren. Pyramidendomänen sind vermutlich Mg3 N2 -basierte Strukturen, wohingegen bei Liniendefekten auch Mg gefunden wird, wie durch energiedispersive Spektroskopie beobachtet. Diese Liniendefekte befinden sich in einer Tiefe von etwa 200 nm von der Oberfläche in einem schmalen Bereich mit einer Mg-Konzentration von etwa mittleren 10 19 . cm −3 was darauf hindeutet, dass ihre Bildung mit der Höhe der implantierten Mg-Konzentration zusammenhängt. Es wird erwartet, dass die Bildung dieser Defekte in GaN bei der Mg-Implantation signifikant zu den Mg-Selbstkompensationsmechanismen beiträgt, was zu einer ineffizienten p-Dotierung führt. Im Gegensatz dazu zeigte die Mg-dotierte GaN-Probe nur das Vorhandensein von punktförmigen Defekten, die gleichmäßig über die gesamte Probe verteilt gefunden wurden. Die vorliegende Studie, die die Abhängigkeit der Mg-Einbaumethode und ihrer Konzentrationen von der Art und Art der Defekte hervorhebt, kann sich als nützlich erweisen, um eine geeignete Menge an einzubauendem Mg auszuwählen, um eine hohe p-Leitfähigkeit in GaN-basierten Materialien für einen effizienten Gerätebetrieb zu erreichen.
Abkürzungen
- ADF:
-
Ringförmiges Dunkelfeld
- BF:
-
Hellfeld
- EDS:
-
Energiedispersive Spektroskopie
- MBE:
-
Molekularstrahlepitaxie
- MOCVD:
-
Metallorganische chemische Gasphasenabscheidung
- SIMS:
-
Sekundärionen-Massenspektrometrie
- MINT:
-
Rastertransmissionselektronenmikroskopie
Nanomaterialien
- Beispielschaltungen und Netzlisten
- Mesh aktuelle Methode und Analyse
- 5G und GaN:Der Wechsel von LDMOS zu GaN
- 5G und GaN:Innovationen der Zukunft
- Analyse der Aktin- und fokalen Adhäsionsorganisation in U2OS-Zellen auf Polymer-Nanostrukturen
- Infrarotreflexionsanalyse von epitaktischen n-dotierten GaN-Schichten, die auf Saphir gewachsen sind
- Elektrospinnen auf isolierende Substrate durch Kontrolle der Oberflächenbenetzbarkeit und -feuchtigkeit
- Herstellung von SrGe2-Dünnschichten auf Ge (100), (110) und (111) Substraten
- Eine Studie zu Kohlenstoffnanofasern und Aktivkohle als symmetrischer Superkondensator in wässrigem Elektrolyt:Eine Vergleichsstudie
- Morphologie, Struktur und optische Eigenschaften von Halbleiterfilmen mit GeSiSn-Nanoinseln und gespannten Schichten



