Ändern der optischen Eigenschaften von GaAsSb-bedeckten InAs-Quantenpunkten durch InAlAs-Zwischenschichten
Zusammenfassung
In dieser Arbeit untersuchen wir die optischen Eigenschaften von InAs-Quantenpunkten (QDs), die mit zusammengesetztem In0,15 . bedeckt sind Al0,85 As/GaAs0,85 Sb0,15 spannungsreduzierende Schichten (SRLs) mittels hochauflösender Röntgenbeugung (HRXRD) und Photolumineszenz (PL) Spektroskopie bei 77 K Thin In0.15 Al0,85 Als Schichten mit der Dicke t = 20 Å, 40 Å und 60 Å wurden zwischen den QDs und einem 60-Å-dicken GaAs0.85 . eingefügt Sb0,15 Schicht. Die für GaAs beobachteten Typ-II-Emissionen0,85 Sb0,15 -Capped InAs QDs wurden durch das Einfügen des In0.15 . unterdrückt Al0,85 Als Zwischenschicht. Außerdem war die Emissionswellenlänge um t . blauverschoben = 20 Å und rotverschoben für t ≥ 40 Å aufgrund des erhöhten Einschlusspotentials bzw. der erhöhten Dehnung. Die Energietrennung zwischen Grundzustand und angeregtem Zustand wird erhöht und erreicht 106 meV für t = 60 Å im Vergleich zu 64 meV für die QDs, die nur mit GaAsSb SRL gedeckelt sind. Darüber hinaus ist die Verwendung des In0.15 Al0,85 Da die Schichten die QD-Spektrallinienbreite von 52 auf 35 meV für die Proben mit 40- und 60-Å-dickem In0,15 . deutlich verengen Al0,85 Als Zwischenschichten.
Hintergrund
In den letzten Jahrzehnten haben selbstorganisierte Quantenpunkte (QDs), die mit der Stranski-Krastanov-Technik synthetisiert wurden, große Aufmerksamkeit erregt. Ihre optischen und elektronischen Eigenschaften wurden aufgrund ihrer möglichen Anwendungen in optoelektronischen Geräten intensiv untersucht [1]. Das umfassend untersuchte InAs/GaAs-QD-System wurde in einer Reihe von optoelektronischen Geräten als aktives Material verwendet. Während des Wachstums dieser Nanostrukturen kommt es während des Capping-Prozesses zu einer signifikanten Änderung der Größe und der Form der QDs. Dieser Prozess ist recht komplex und beinhaltet Vermischung, Segregation oder dehnungsverstärkte Diffusion [2]. Die Verwendung einer Deckschicht aus reinem GaAs begrenzt die QD-Emission auf weniger als 1300 nm. Um dieses Problem zu mildern, wurden spannungsreduzierende Schichten aus (Ga, In)(As, Sb, N) verwendet [2,3,4,5,6,7]. Insbesondere dem ternären GaAsSb wurde besondere Aufmerksamkeit geschenkt, da seine resultierende Bandausrichtung durch Änderung des Sb-Gehalts [8, 9] auf Typ I oder Typ II zugeschnitten werden kann und durch seine Fähigkeit, die Emissionswellenlänge über das C-Band hinaus zu erweitern [10]. Der Energieunterschied zwischen Grund- und angeregtem Zustand ist jedoch auf 60–75 meV begrenzt, wenn GaAsSb als spannungsreduzierende Schicht (SRL) verwendet wird [11]. Diese Energietrennung verhindert nicht, dass Ladungsträger thermisch aus den QDs entweichen. Für Anwendungen, die eine lange Ladungsträgerlebensdauer erfordern, ist das Einfügen einer dünnen Barriere zwischen den InAs-QDs und GaAsSb von Vorteil, da dies die Ladungsträgertrennung zwischen den QDs und dem GaAsSb-Quantentopf (QW) erhöht. Als Beispiel wurden GaAs-Zwischenschichten verwendet, die zu einer Verbesserung der Energieeffizienz von Solarzellen um einen Faktor von 23 % führten [12]. Die Verwendung von InAlAs-Schichten kann von Interesse sein, um die Art der Strahlungsrekombination zu entwickeln. Beim Typ-II-Übergang erhöht die Insertion von InAlAs die Ladungsträgerlebensdauer [13] und die Energietrennung zwischen dem Grundzustand und dem ersten angeregten Zustand [14,15,16]. Darüber hinaus wird erwartet, dass das Einfügen einer InAlAs-Schicht zwischen InAs-QDs und GaAsSb die In-Segregation verringert und die Vermischung von In- und Ga-Atomen zwischen den InAs-QDs und der GaAsSb-SRL unterdrückt und die QD-Spannung weiter reduziert [17]. InAlAs/InGaAs-Komposit-SRLs wurden verwendet, um InAs-QDs zu bedecken, was zu einer langwelligen Emission und einer günstigen Energietrennung zwischen dem Grund- und dem angeregten Zustand von bis zu 104 meV führt [16, 18].
In diesem Papier berichten wir über die erste Untersuchung der Wirkung der Verwendung eines In0,15 Al0,85 Als Zwischenschicht über die optischen Eigenschaften von InAs/GaAs0.85 Sb0,15 QDs mittels Photolumineszenz(PL)-Spektroskopie. Insbesondere die Variation der Emissionswellenlänge, die Art der optischen Emission, die spektrale Linienbreite und die Energietrennung zwischen dem Grund- und dem ersten angeregten Zustand wurden im Detail untersucht.
Methoden
Die in der vorliegenden Studie untersuchten Proben wurden auf epi-ready Quarter 2″ p-Typ GaAs (001) Substraten in einem Veeco Gen20A Molecular Beam Epitaxy System gezüchtet. Cracker mit Ventil wurden verwendet, um As2 . zu erzeugen und Sb2 dimere. Nach dem Wachstum einer GaAs-Pufferschicht bei 590 °C wurde die Substrattemperatur dann auf ~485 °C gesenkt, um nominell 2,5 ML dicke InAs-QDs zu züchten. Nach einer kurzen Pause unter As2 Flussmittel, ein zusammengesetztes In0,15 Al0,85 As/GaAsSb SRL wurde unmittelbar gefolgt von dem Aufwachsen eines 5 nm dicken GaAs bei der gleichen Temperatur abgeschieden, wonach die Aufwachstemperatur auf 570 °C erhöht wurde, um eine 38-nm-GaAs-Sperrschicht zu züchten. Die Dicke von GaAsSb wurde auf 60 festgelegt, während die Dicke von In0,15 Al0,85 Da wurde von 20 bis 60 Å variiert. Die 60-Å-dicke GaAsSb-SRL wurde unter Verwendung eines As2 . realisiert /Sb2 Flussverhältnis, das einen Sb-Gehalt von 15% ergibt, wie durch Röntgenbeugungsmessungen an einer Referenzprobe bestimmt. Für alle Schichten wurde eine feste Ga-Wachstumsrate von 0,5 ml/s verwendet. Vier Proben mit den Bezeichnungen A, B, C und D wurden gezüchtet, für die der In0,15 Al0,85 Als Dicke t wurde auf 0 Å, 20 Å, 40 Å bzw. 60 Å eingestellt. Basierend auf dem von Krijn [19] verwendeten Verfahren und unter Verwendung der Parameter in [20] wurde die relative Position der Leitungs- und Valenzbänder geschätzt und eine schematische Darstellung der gewachsenen Strukturen mit ihrem entsprechenden Banddiagramm ist in Abb. 1 dargestellt.
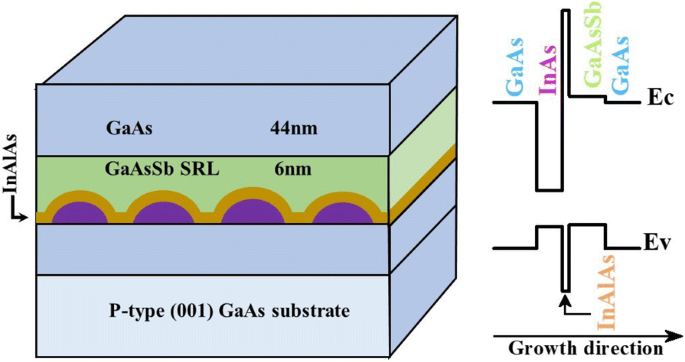
Schema der gewachsenen Strukturen und entsprechendes Energiebanddiagramm von InAs-QDs, die mit einem zusammengesetzten In0,15 . bedeckt sind Al0,85 As /GaAs0,85 Sb0,15 . Die In0.15 Al0,85 Als Dicke t = 0 Å, 20 Å, 40 Å und 60 Å für die Proben A, B, C bzw. D
Die Kristallqualität der Proben wurde durch hochauflösende Röntgenbeugung (HRXRD) unter Verwendung eines Panalytical Röntgendiffraktometers charakterisiert. Die optischen Eigenschaften der gewachsenen Proben wurden mittels PL-Spektroskopie bei 77 K unter Verwendung eines PL-Moduls, das an ein Vertex 80 Fourier Transform Infrared-Instrument (Bruker Optics GmbH) angeschlossen war, und unter Verwendung eines thermoelektrisch gekühlten High-Gain-InGaAs-Detektors bewertet [21]. Die Proben wurden mit einer CW 532-nm-Festkörperlaserquelle angeregt.
Ergebnisse und Diskussion
Die Kristallqualität der gewachsenen Proben wurde durch HRXRD unter Verwendung von Rocking-Curve-Scans charakterisiert, indem das Beugungsmuster von 004 Atomebenen aufgezeichnet wurde. Abbildung 2a zeigt die erhaltenen Beugungsmuster für die Proben A, B, C und D entsprechend einer InAlAs-Dicke von 0, 20, 40 bzw. 60 Å. Es werden deutliche Satellitenpeaks beobachtet, die aus InAs/InAlAs/GaAsSb resultieren, was die gute Kristallqualität der gewachsenen Proben zeigt. Die simulierten Röntgen-Rocking-Kurven sind in Abb. 2a neben den experimentellen Daten enthalten. Der erhaltene durchschnittliche Sb-Gehalt in der Referenzprobe A beträgt 13% und die Dicke von GaAsSb beträgt 66 Å. Diese Werte wurden in den Proben B, C und D verwendet, um den In-Gehalt und die Dicke der InAlAs-Zwischenschicht zu bestimmen. Die Simulation zeigte, dass der durchschnittliche In-Gehalt 13,5% und die Dicke der InAlAs-Zwischenschicht 22 , 44 bzw. 65 Å in den Proben B, C und D beträgt, was nahe an den Nenndicken liegt.

a Hochauflösendes ω /2θ sucht nach Proben A, B, C und D. b PL-Spektrum von Probe A, erhalten bei 77 K und 100 mW Anregung. c Leistungsabhängiger PL von Probe A bei 77 K. d Der entsprechende Energiepeak für die ersten beiden optischen Übergänge gegen Pex 1/3 bei 77 K
Die optischen Eigenschaften der Referenzprobe A wurden zunächst bei 77 K mit der leistungsabhängigen PL-Technik untersucht. Abbildung 2b zeigt das PL-Spektrum für eine Anregungsleistung von 100 mW. Das PL-Spektrum kann durch drei Gaußsche Peaks mit den Zentren 1004 meV, 1068 meV und 1113 meV angepasst werden, die als fundamentale und angeregte optische Übergänge identifiziert werden können. Die Halbwertsbreite (FWHM) des Grundzustands und des ersten angeregten Zustands beträgt 52 bzw. 58 meV. Um den Ursprung der beobachteten ersten beiden optischen Übergänge zu verstehen, wurde die Anregungsleistung von 1 bis 100 mW variiert und die entsprechenden PL-Spektren wie in Abb. 2c dargestellt aufgenommen. Für jede Anregungsleistung wurde die Energie der ersten beiden Peaks mittels Multi-Gauss-Funktionsanpassung extrahiert und als Funktion der Kubikwurzel der Anregungsleistung aufgetragen, wie in Abb. 2d gezeigt. Die Energie des Fundamentalübergangs nimmt mit abnehmender Anregungsleistung ab, was mit einem Typ-II-Übergang übereinstimmt, was darauf hindeutet, dass die Emission ein Ergebnis der Rekombination von Elektronen ist, die sich im Fundamentalelektronenzustand in der QD befinden (E0QD ) und Löcher im GaAsSb-QW (H0QW ). Bei der InAs/GaAsSb-Typ-II-Bandausrichtung induziert die Lokalisierung von Elektronen und Löchern in den QDs bzw. GaAsSb-SRL einen Bandbiegeeffekt, der aus dem elektrischen Feld resultiert, das hauptsächlich entlang der Wachstumsrichtung verläuft [22]. Es wird erwartet, dass die Übergangsenergie vom Typ II proportional mit der dritten Wurzel der Anregungsleistung ansteigt, wie von Jin et al. [22]. In ähnlicher Weise nimmt die Energie des ersten angeregten Zustandsübergangs mit Verringerung der Anregungsleistung ab, und dieser Übergang ist höchstwahrscheinlich das Ergebnis der Rekombination von Elektronen im ersten angeregten Elektronenzustand in der QD (E1QD ) und Löcher im GaAsSb-QW (H0QW ), da die Zustandsdichte im GaAsSb-QW viel größer ist als die Zustandsdichte in den QDs. Die ersten beiden optischen Übergänge sind in Fig. 3a veranschaulicht. Wir bemerken auch, dass der Energieabstand zwischen dem Grundzustand und dem ersten angeregten Zustand ΔE mit abnehmender Anregungsleistung bei 64 meV nahezu konstant bleibt, und dies ist ein Beweis dafür, dass das elektrische Feld, das aus dem Ladungsaufbau resultiert, senkrecht zur Wachstumsrichtung verläuft [22], dh die Löcher im GaAsSb sind über den QDs lokalisiert. In Probe A wird eine Typ-II-Emission erwartet, da der Sb-Gehalt im GaAsSb, der 13% beträgt, nahe der Zusammensetzung liegt, bei der ein Übergang von Typ I zu Typ II stattfindet [23, 24]. Für den betrachteten Sb-Gehalt sollte ein kleiner Valenzband-Offset zwischen den QDs und dem GaAsSb-QW existieren, der die Lokalisierung von Löchern im GaAsSb-QW und anschließend Typ-II-Emissionen begünstigt [25, 26].
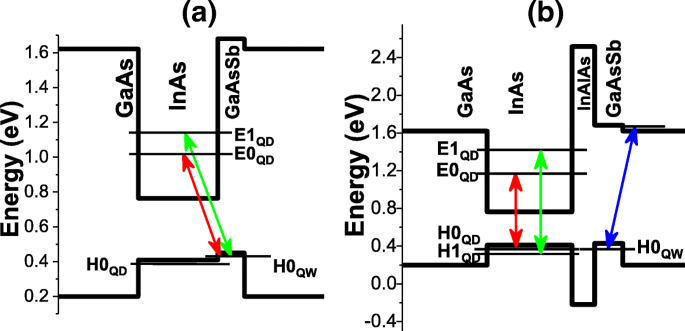
Bandprofile von Probe A (a ) und Proben B, C und D (b ) mit ihren entsprechenden Rekombinationskanälen
Abbildung 4a zeigt die PL-Emission entsprechend den Proben mit unterschiedlichem In0,15 Al0,85 B. Dicke mit Anregungsleistungen von 1 bis 100 µmW. Für alle Proben mit einem In0,15 . können drei Hauptpeaks identifiziert werden Al0,85 Als Zwischenschicht. Wir bemerken eine Änderung der Energiepeakpositionen der verschiedenen Strahlungskanäle in Bezug auf die Referenzprobe A. Bei einer Anregungsleistung von 100 mW wurden die Energie des fundamentalen Übergangs, FWHM, und der Energieabstand ΔE extrahiert und mit Probe . verglichen A. Die extrahierten Werte sind in Abb. 4b dargestellt.

a Leistungsabhängiger PL des InAs/In0,15 Al0,85 As/GaAsSb-QDs bei 77 K. b Die entsprechende Spitzenenergie, FWHM und ΔE gegenüber der InAlAs-Dicke und c die Variation der Spitzenenergie optischer Übergangskanäle als Funktion der Kubikwurzel der Anregungsleistung für die Proben B, C und D
Der Grundzustandsübergang von Probe A erfolgt bei 1004 meV mit einer FWHM von 52 meV und einem Energieabstand ΔE von 64 meV. Einfügen von 20 Å von In0,15 Al0,85 As (Probe B) induziert eine Blauverschiebung des Grundzustandsübergangs um 52 meV. Die Blauverschiebung stimmt mit dem überein, was beobachtet wurde, als ein Komposit InAlAs/InGaAs für QDs verwendet wurde, die bei nahezu derselben Wachstumstemperatur gewachsen waren [27]. Die Blauverschiebung der Grundzustandsübergangsenergie der InAs-QDs in Probe B resultiert aus dem erhöhten Einschlusspotential [15]. Wenn die Barriere für Elektronen und Löcher erhöht wird, sollte die Energieniveautrennung von Elektronen und Löchern zunehmen, was zu der beobachteten Blauverschiebung der Emission führt. Es ist bekannt, dass das Abdecken von InAs mit GaAs als Folge der In-Segregation und der In-Ga-Vermischung zu einer Verringerung der QD-Höhe führt [28]. Die Einführung von Sb in die GaAs-Deckschicht reduziert die QD-Zersetzung durch Hemmung der spannungsgetriebenen In-Ga-Vermischung [29]. Es wird erwartet, dass das Einfügen der InAlAs-Zwischenschicht die In-Segregation und die In-Ga-Vermischung, die aus der Inaktivität der Al-Adatome resultieren, weiter unterdrückt. Tatsächlich haben Jun et al. [17] haben mittels STEM gezeigt, dass die Verwendung einer InAlAs/InGaAs-Kombinationsschicht als Deckschicht die In-Segregation und die In-Ga-Vermischung entlang der Wachstumsrichtung während des Deckprozesses der InAs-QDs stark unterdrückt, was zu einem erhöhten Höhe der Nanostrukturen und eine höhere In-Konzentration in InAs-QDs nach dem Capping. In Anbetracht der niedrigen Wachstumstemperatur der QDs, d. h. 485 °C, wird erwartet, dass die Indium-Segregation und die Grenzflächenvermischung zwischen den QDs und der InAlAs-Zwischenschicht aufgrund der Inaktivität der Al-Adatome unbedeutend sind.
FWHM und ΔE werden reduziert und auf 39 meV bzw. 92 meV erhöht. Weitere Erhöhung der Dicke von In0,15 Al0,85 B. 40 und 60 (Proben C bzw. D) bewirken eine Rotverschiebung der Emissionswellenlänge. Diese Rotverschiebung wird wahrscheinlich durch die Veränderung der Dehnung in InAs-QDs getrieben, da die Gesamtdicke des zusammengesetzten InAlAs/GaAsSb-SRL mit zunehmender InAlAs-Dicke zunimmt [30]. Dies kann die strukturellen Abmessungen der QDs und damit die Energieniveaus von Elektronen und Löchern verändern. Es scheint, dass bei den Proben C und D (40 Å bzw. 60 Å) der Dehnungseffekt den Einschlusspotentialeffekt dominiert. Die niedrigste FWHM von 35 meV und der höchste Energieabstand ΔE von 35 meV bzw. 106 meV wurden für Probe D erhalten. Das große ΔE wird durch die Verwendung einer dickeren InAlAs-Schicht und möglicherweise einer erhöhten QD-Höhe verursacht [31, 32]. Die Energietrennung ist vergleichbar mit der bei Verwendung eines zusammengesetzten InAlAs/InGaAs-SRL (104 meV) [16, 33]. Die Reduzierung des FWHM kann als Reduzierung der Vermischung zwischen In0,15 . verstanden werden Al0,85 As und QDs und damit eine Erhaltung der QD-Verteilung. Die extrahierten Parameter sind in Tabelle 1 zusammengefasst.
Die PL-Intensität der Proben B und C war im Vergleich zu Probe A erhöht; jedoch wurde für Probe D eine starke Verringerung der PL-Intensität beobachtet, d. h. eine Verringerung um den Faktor 5 im Vergleich zu Probe C. Die verringerte PL-Intensität resultiert aus der Verringerung der Ladungsträgerinjektion von der GaAsSb-Schicht zu den QDs. Tatsächlich werden während der Beleuchtung zahlreiche Ladungsträger photogeneriert und das Einfügen des In0,15 Al0,85 Da eine Zwischenschicht eine Barriere für Ladungsträger bildet und deren Injektion in die QDs begrenzen kann. Träger können durch einen Tunnelprozess auf die QDs übertragen werden, und die PL-Intensität ist bei den Proben mit dünnerem In0,15 . höher Al0,85 Als Barrieren [34]. Probe D zeigte die niedrigste PL-Intensität beim Tunneln durch die 60 Å In0,15 Al0,85 As stark reduziert, und dies wird durch die erhöhte PL-Emission des GaAsSb-QW gezeigt, wie in Fig. 4a gezeigt. Die Reduzierung des Tunnelprozesses begünstigt und verbessert die strahlende Rekombination von Elektronen und Löchern im GaAsSb-QW.
Die Hauptbeobachtung des leistungsabhängigen PL bei 77 K für die Proben B, C und D in Abb. 4a sind die festen Energiepositionen der ersten beiden Peaks mit zunehmender Anregungsleistung im Gegensatz zu dem, was in Probe A beobachtet wurde ist ein Merkmal einer Typ-I-Emission, bei der sowohl Elektronen als auch Löcher innerhalb der QDs lokalisiert sind. Die ersten beiden Emissionspeaks resultieren aus der Rekombination von Elektronen und Löchern im fundamentalen und ersten angeregten Zustand in den QDs (E0QD -H0QD und E1QD -H1QD ). Wir glauben, dass der dritte Peak von einer Typ-II-Emission stammt, die aus der Rekombination von Elektronen in GaAs und Löchern, die in GaAsSb-QW lokalisiert sind, resultiert. Tatsächlich nimmt die diesem Übergang entsprechende Energie mit zunehmender Anregungsleistung zu, wie in Fig. 4a und Fig. 4c charakteristisch für einen Typ-II-Übergang gezeigt. Außerdem sehen wir, dass seine Intensität mit zunehmendem In0.15 . zunimmt Al0,85 B. Schichtdicke. Dies stimmt mit der Verringerung der PL-Intensität des fundamentalen Übergangs mit einem dickeren In0,15 . überein Al0,85 Die Schicht reduziert das Tunneln von Ladungsträgern von GaAsSb zu den QDs und begünstigt die Typ-II-Emission, die aus der Rekombination von Elektronen und Löchern in GaAs bzw. GaAsSb erhalten wird. Ein Schema der Rekombinationskanäle für die Proben B, C und D ist in Fig. 3b dargestellt. Die Unterdrückung der Emission vom Typ II kann wie folgt verstanden werden. Die Einfügung eines 20-Å In0.15 Al0,85 Wenn die Schicht die Ladungsträgertrennung zwischen den QDs und dem GaAsSb-QW erhöht, nimmt die Überlappung der Elektronen- und Lochwellenfunktion ab. Darüber hinaus ist die Tatsache, dass der Sb-Gehalt im GaAsSb-Gehalt nahe an der Typ-I-Typ-II-Überkreuzung liegt, der In0,15 Al0,85 Als Zwischenschicht bringt das begrenzte Niveau in das QW (H0QW ) unterhalb der ersten quantisierten Ebene in den QDs (H0QD ) wie in Fig. 3b gezeigt, und daher können in der QW eingefangene Löcher durch die InAlAs-Schicht tunneln, wodurch die Emission vom Typ II weniger wahrscheinlich wird. Für ein dickeres In0,15 Al0,85 Als Zwischenschicht (40 und 60 Å) wird das Tunneln weiter reduziert, aber die Überlappung der Elektronen- und Lochwellenfunktion wird wesentlich reduziert, was die Rekombination von Elektronen in GaAs mit Löchern in GaAsSb begünstigt [13]. Der optische Übergang von InAs/GaAsSb-QDs kann auf die Art der Anwendung zugeschnitten werden, die entweder kurze oder lange Lebensdauern erfordert. In unserer Studie haben wir einen Sb-Gehalt von 13% in GaAsSb berücksichtigt, was nahe am Übergang vom Typ I zum Typ II liegt. Das Einfügen einer InAlAs-Zwischenschicht unterdrückte die Typ-II-Emission und erhöhte die Energietrennung zwischen dem Grund- und dem ersten angeregten Zustand, was für Anwendungen wünschenswert ist, die eine kurze Ladungsträgerlebensdauer erfordern. Die vorliegende Studie kann auch auf Anwendungen zugeschnitten werden, die eine lange Trägerlebensdauer erfordern. Tatsächlich wird erwartet, dass die Kombination aus der Verwendung eines höheren Sb-Gehalts in der GaAsSb-Schicht und dem Einfügen einer InAlAs-Zwischenschicht die Typ-II-Emission für dünne InAlAs-Zwischenschichten beibehält, während die Ladungsträgerlebensdauer signifikant erhöht wird. Gleichzeitig verringert die erhöhte Energietrennung zwischen dem Grundzustand und dem ersten angeregten Zustand das Entweichen von Ladungsträgern.
Schlussfolgerung
InAs-QDs mit zusammengesetztem In0,15 Al0,85 As/GaAs0,85 Sb0,15 SRLs mit unterschiedlichem In0,15 Al0,85 B. Dicken gewachsen und charakterisiert wurden. Unsere Analyse zeigt, dass das Einfügen eines In0.15 Al0,85 Die As-Schicht unterdrückt die beobachtete Emission vom Typ II, die von InAs/GaAs0,85 . erhalten wird Sb0,15 QDs. Außerdem ist die Emissionswellenlänge um t . blauverschoben = 20 Å und rotverschoben für t ≥ 40 Å aufgrund des erhöhten Einschlusspotentials bzw. der erhöhten Dehnung. Ein großer Energieabstand ΔE von 106 meV wurde für die Probe mit einem 60-Å-dicken In0,15 . erhalten Al0,85 Als Zwischenschicht. Darüber hinaus ist die Einführung des In0.15 Al0,85 Da die Zwischenschicht die FWHM von 52 meV auf ein Minimum von 35 meV reduziert.
Abkürzungen
- FWHM:
-
Volle Breite auf halbem Maximum
- HRXRD:
-
Hochauflösende Röntgenbeugung
- PL:
-
Photolumineszenz
- QDs:
-
Quantenpunkte
- QW:
-
Quantenbrunnen
- SRLs:
-
Dehnungsmindernde Schichten
Nanomaterialien
- Die atomare Umlagerung von GaN-basierten mehreren Quantenquellen in H2/NH3-Mischgas zur Verbesserung der strukturellen und optischen Eigenschaften
- N,N-Dimethylformamid, das die Fluoreszenz von MXen-Quantenpunkten für die empfindliche Bestimmung von Fe3+ reguliert
- Erkennen von räumlich lokalisiertem Exziton in selbstorganisierten InAs/InGaAs-Quantenpunkt-Übergittern:ein Weg zur Verbesserung der Photovoltaik-Effizienz
- Auswirkungen der Doppelschichtdicke auf die morphologischen, optischen und elektrischen Eigenschaften von Al2O3/ZnO-Nanolaminaten
- Grüne Synthese von InP/ZnS-Kern/Schale-Quantenpunkten für die Anwendung in schwermetallfreien Leuchtdioden
- Synthese wasserlöslicher Antimonsulfid-Quantenpunkte und ihre photoelektrischen Eigenschaften
- Einfache sonochemische Synthese in einem Schritt und photokatalytische Eigenschaften von Graphen/Ag3PO4-Quantenpunkt-Kompositen
- Eliminierung der bimodalen Größe in InAs/GaAs-Quantenpunkten zur Herstellung von 1,3-μm-Quantenpunktlasern
- Interband-Photoleitfähigkeit von metamorphen InAs/InGaAs-Quantenpunkten im 1,3–1,55-μm-Fenster
- Material und optische Eigenschaften von fluoreszierenden Kohlenstoff-Quantenpunkten, die durch hydrothermale Reaktion aus Zitronensaft hergestellt werden



