Temperaturabhängige Strukturevolution der HfO2/Si-Grenzfläche und ihr Mechanismus
Zusammenfassung
In dieser Arbeit wird Hafniumoxid (HfO2 ) werden dünne Filme auf p-Typ-Si-Substraten durch Remote-Plasma-Atomschichtabscheidung auf p-Typ-Si bei 250 °C abgeschieden, gefolgt von einem schnellen thermischen Glühen in Stickstoff. Einfluss der Nachglühtemperatur auf die Kristallisation von HfO2 Filme und HfO2 /Si-Schnittstellen wird untersucht. Die Kristallisation des HfO2 Filme und HfO2 Die /Si-Grenzfläche wird durch Feldemissions-Transmissionselektronenmikroskopie, Röntgenphotoelektronenspektroskopie, Röntgenbeugung und Rasterkraftmikroskopie untersucht. Die experimentellen Ergebnisse zeigen, dass während des Glühens der Sauerstoff aus HfO2 . diffundiert zur Si-Schnittstelle. Bei einer Glühtemperatur unter 400°C beträgt der HfO2 Film und Grenzschicht sind amorph, letztere besteht aus HfO2 und Siliziumdioxid (SiO2 ). Bei einer Glühtemperatur von 450-550 °C wird das HfO2 Film wird mehrphasig polykristallin und ein kristallines SiO2 findet sich an der Schnittstelle. Schließlich wird bei einer Glühtemperatur über 550°C das HfO2 Film wird von einphasigem polykristallinem dominiert, und die Grenzschicht wird vollständig in kristallines SiO2 . umgewandelt .
Einführung
Hafniumoxid (HfO2 ) dünner Film ist ein interessantes Material für eine Vielzahl von Anwendungen. Es kann in mehrschichtigen optischen Beschichtungen [1], Schutzbeschichtungen [2], Gatedielektrikum [3], Passivierungsschichten [4,5,6] usw. aufgrund seiner hervorragenden Eigenschaften, wie hohe Dichte, hohe Brechkraft, verwendet werden Index, breite Bandlücke und relativ hohe thermische Stabilität. Zur Herstellung von HfO2 . wurden viele Methoden verwendet Dünnschicht, wie Elektronenstrahlverdampfung [7], chemische Lösungsabscheidung [8], reaktives Sputtern [9], metallorganische chemische Dampfabscheidung [10], Molekularstrahlepitaxie [11] und Atomlagenabscheidung (ALD). ALD ist ein vielversprechendes Verfahren zum Erhalten dünner Filme mit sowohl einer hochpräzisen Dickensteuerung als auch einer hochgenauen Gleichmäßigkeit. Es wurde festgestellt, dass das Nachglühen einen signifikanten Einfluss auf die ALD HfO2 . hat Filme [12,13,14,15]. Laut der Studie ist HfO2 dünne Filme können bei einer Glühtemperatur von mehr als 500°C kristallisieren [16,17,18]. Die kristalline Struktur von HfO2 beeinflusst stark die optischen und elektrischen Eigenschaften. Zum Beispiel die Strukturänderung von HfO2 von der amorphen zur monoklinen kristallinen Phase könnte zu Änderungen des Brechungsindex von 1,7 auf 2,09, der optischen Lücke von 5,75 auf 6,13 eV und der Dielektrizitätskonstante von 24,5 auf 14,49 führen [19, 20]. Für ALD HfO2 auf Siliziumsubstraten abgeschieden, wird normalerweise eine Oxidschicht bei HfO2 . beobachtet /Si-Schnittstelle [21, 22]. Es wird berichtet, dass das Vorhandensein dieser Grenzflächenschicht die Dielektrizitätskonstante verringert [22]. Darüber hinaus haben Kopani et al. [23] präsentierten die strukturellen Eigenschaften von 5-nm-HfO2 Filme nach Salpetersäureoxidation von n-dotierten Si-Substraten. Sie fanden heraus, dass eine hohe Glühtemperatur die Wachstumsrate von Kristallkeimen erhöht. Ihre Kristallisationseigenschaften, insbesondere HfO2 /Substrat-Schnittstelle wurden nur spärlich untersucht. Daher beeinflusst die Glühtemperatur die Kristallisationseigenschaften von HfO2 Durch ALD hergestellte dünne Filme waren eine weitere Untersuchung wert.
In dieser Arbeit wird das HfO2 Dünnfilme wurden durch eine Remote-Plasma-Atomschichtabscheidung (RP-ALD) auf Siliziumsubstraten vom p-Typ hergestellt. Das Nachglühen wurde mit einem Rapid Thermal Annealing (RTA)-System bei verschiedenen Temperaturen durchgeführt. Die strukturellen Veränderungen und Kristallisationseigenschaften von HfO2 Dünnfilme durch RTA wurden durch Rasterkraftmikroskopie (AFM), streifende Röntgenbeugung (GIXRD), Röntgenphotoelektronenspektroskopie (XPS) und hochauflösende Transmissionselektronenmikroskopie (HR-TEM) charakterisiert. Das temperaturabhängige HfO2 Die strukturelle Evolution der /Si-Grenzfläche und ihr Mechanismus werden ebenfalls untersucht.
Methode
Es wurden doppelseitig polierte (100)-orientierte p-Typ-2-Zoll-250-μm-Czochralski-Si-Wafer mit einem spezifischen Widerstand von 30 Ω cm verwendet. Vor der Abscheidung wurden Si-Wafer durch ein Standardverfahren der Radio Corporation of America gereinigt, gefolgt von einem Eintauchen in verdünnte Fluorwasserstoffsäurelösung (5%) für 2 min, um mögliche Streuoxide ohne abschließendes Spülen mit Wasser zu entfernen. Nach der Reinigung wurden alle Wafer mit reinem Stickstoff getrocknet (N2 ) Gas und auf den Substrathalter montiert. Ungefähr 15 nm HfO2 (168 ALD-Zyklen) dünne Filme wurden auf Si-Wafern durch RP-ALD (Picosun R-200, Finnland) unter Verwendung von Tetrakis (Ethylmethylamino) Hafnium (TEMAH) und Sauerstoff (O2 .) abgeschieden ) im Wechselpuls mit N2 Spülen der Reaktionskammer zwischen den Pulsen. Die TEMAH und O2 Plasma wurden in der folgenden Reihenfolge in den Reaktor gepulst:TEMAH-Puls 1,6 µs; N2 10 s spülen; O2 Plasmapuls 10 s und N2 12 s spülen. Nach dem Absetzen des HfO2 Dünnschichten wurde das schnelle thermische Tempern in N2 . durchgeführt Umgebung für 10 min. Die Glühtemperaturen wurden von 400 bis 600°C variiert, um die Wirkung von HfO2 . auf die Kristallisation zu untersuchen dünne Filme und HfO2 /Si-Schnittstelle. Tabelle 1 listet die typischen Bedingungen von RPALD und Post-Annealing auf.
AFM-Messungen wurden im Tapping-Modus durchgeführt, um die Oberflächenmorphologie des HfO2 . zu untersuchen dünne Filme. Die in dieser Arbeit gezeigten AFM-Bilder sind 2 μm × 2 μm Scans mit einer Auflösung von 256 Punkten × 256 Zeilen. Die Struktur von HfO2 Filme wurden durch streifende Röntgenbeugungsmessungen (GIXRD, Rigaku TTRAXIII, Japan) mit einer Cu-Röntgenröhre mit langem Feinfokus charakterisiert. Röntgenstrahlen mit einer Wellenlänge von 0,154 nm wurden bei einer Betriebsspannung von 50 kV und einem Strom von 300 mA erzeugt. Ein Einfallswinkel von 0,5° wurde gewählt, um Beugungsmuster über 2θ . zu erhalten Bereich von 20–60°. Röntgenphotoelektronenspektroskopie (XPS, Thermo Fisher K-alpha) wurde auch unter Verwendung von monochromatischer Al Kα-Röntgenstrahlung (hν = 1486.6 eV) durchgeführt. Für die XPS-Analyse wurde ein Spot mit 100 µm Durchmesser verwendet und Photoelektronen wurden bei einem Startwinkel von 45° gesammelt. Die Querschnitte des HfO2 Dünnschichten wurden durch eine fokussierte Ionenstrahl-Lift-Out-Technik in einem Hitachi NX2OOO-System hergestellt. Die Querschnittsbilder des HfO2 dünne Filme wurden mit einem hochauflösenden Feldemissions-Transmissionselektronenmikroskop (HR-TEM, JEM-2100F, USA) untersucht.
Ergebnisse und Diskussion
Abbildung 1 zeigt die AFM-Bilder für HfO2 Filme, die bei verschiedenen Temperaturen geglüht wurden. Der Effektivwert (RMS) und die durchschnittliche Oberflächenrauheit (Ra) werden zur Angabe der Oberflächenrauheit angezeigt. Der RMS-Wert beträgt 0,44 nm für den abgeschiedenen Film. Sie steigt leicht auf 0,47 nm an, wenn die Glühtemperatur auf 500 °C ansteigt. Eine weitere Erhöhung der Glühtemperatur auf 600 °C führt zu einer deutlichen Verbesserung der Oberflächenrauheit mit einem RMS-Anstieg auf 0,69 nm. Dieselbe Tendenz wird bei den Ra-Werten beobachtet. Die Zunahme der Oberflächenrauheit der getemperten Filme kann auf eine Strukturänderung schließen.
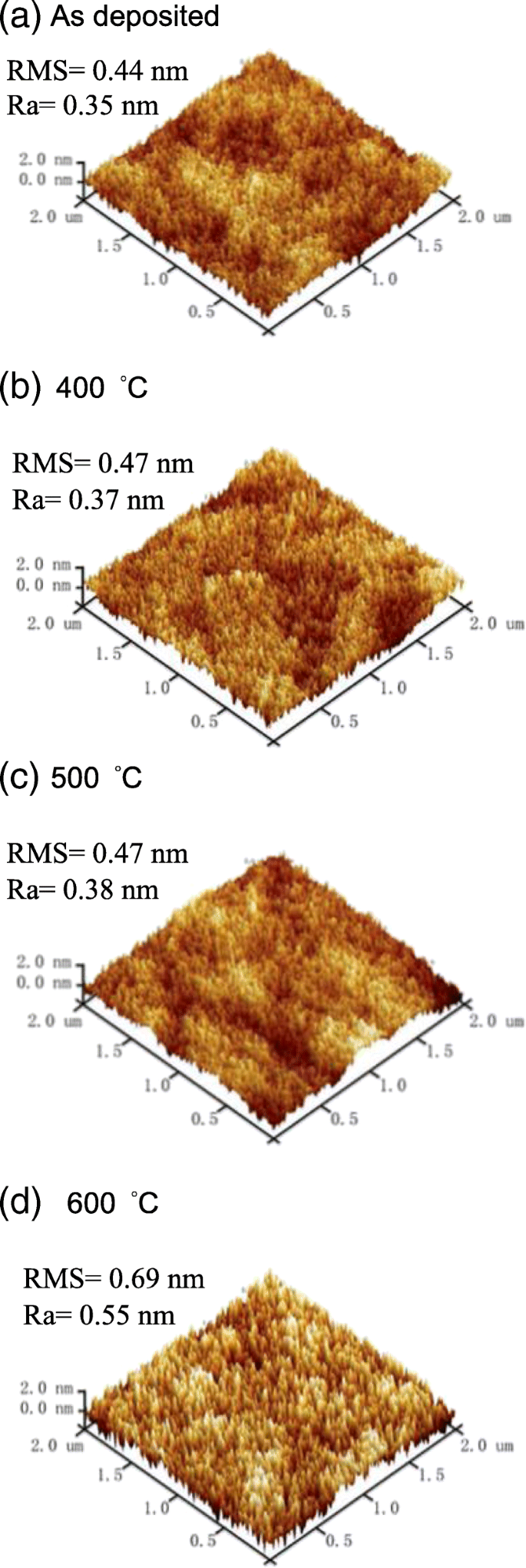
AFM-Bilder von a wie hinterlegt, b 400°C-geglüht, c 500°C getempert und d 600°C geglühtes HfO2 Filme
Abbildung 2 zeigt die temperaturabhängigen GIXRD-Spektren verschiedener HfO2 dünne Filme. Das abgeschiedene HfO2 Filme ist amorph und bleibt nach dem Tempern bei 400 und 450°C amorph. Bei einer Glühtemperatur über 500°C treten Beugungspeaks auf, die auf die Bildung von kristallinem HfO2 . hinweisen . Die Peaks bei 1/d = 0,319 und 0,354 Å −1 entsprechen den − 111- bzw. 111-Ebenen der monoklinen Phase (ICDD PDF#34-0104, Raumgruppe P21/c). Der Peak bei 1/d = 0.340 Å −1 entspricht der (111)-Ebene der orthorhombischen Phase (ICDD PDF#21-0904, Raumgruppe Pbcm). Andere Peaks in der Nähe von 1/d = 0,380~0,395 sind die 200-, 020- und 002-Ebenen der monoklinen und die 020-Ebene der orthorhombischen Phasen. Die Ergebnisse zeigen auch, dass mit der Glühtemperatur die monokline Phase abnimmt und die orthorhombischen Phasen zunehmen. Das orthorhombische HfO2 dominiert das kristalline Gefüge bei höheren Glühtemperaturen. Die Beugungspeaks von orthorhombischem HfO2 wurden bei einem geringeren 1/d (einem kleineren d-Abstand) im Vergleich zu dem in ICDD PDF#21-0904 beobachtet. Außerdem ist die Verschiebung von 1/d = 0,340 Å −1 zu einem höheren Wert zeigt an, dass der d-Abstand mit der Glühtemperatur abnimmt.
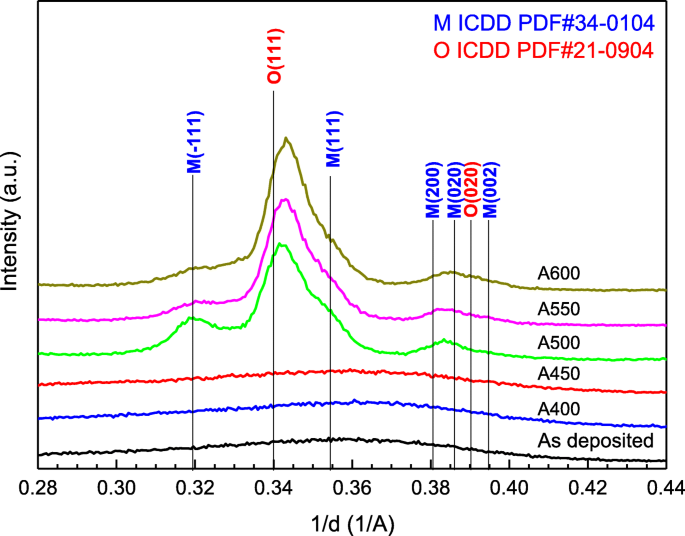
GIXRD-Spektren von HfO2 bei unterschiedlichen Temperaturen geglühte dünne Schichten
Die Konzentrationen von Hf und O im HfO2 Filme wurden unter Verwendung von tiefenprofiliertem XPS gemessen. Abbildung 3 zeigt das O/Hf-Zusammensetzungsverhältnis des abgeschiedenen und nachgetemperten HfO2 Filme. Das O/Hf-Verhältnis sinkt mit der Glühtemperatur von 1,60 auf 1,29. Aufgrund der Verwendung von N2 während des Glühens wird das HfO2 wird mit der Temperatur sauerstoffarm. Das sauerstoffarme HfO2 Film führt auch zu einem kleineren d-Abstand, wie bereits erwähnt.

Atomverhältnis von Sauerstoff zu Hafnium für HfO2 bei unterschiedlichen Temperaturen geglühte dünne Schichten
Abbildung 4a, b, c, d, e und f zeigen die hochauflösenden HR-TEM-Querschnittsbilder von 400 °C-, 450 °C-, 500 °C-, 550 °C- und im abgeschiedenen Zustand 600°C geglühtes HfO2 dünne Filme auf Si-Substraten bzw. Es ist ersichtlich, dass das HfO2 Schicht und Si-Substrat werden in diesen Bildern deutlich gezeigt. Zusätzlich eine dünne Schicht mit einer Dicke von 1–2 nm zwischen HfO2 und Si-Substrat könnte das SiO2 . sein Film. Wie in Abb. 4a gezeigt, gibt es im abgeschiedenen HfO2 . keine offensichtliche Gitteranordnung Film, was darauf hinweist, dass dieser Film amorph ist. Nach dem Tempern bei 400°C, obwohl die meisten Regionen von HfO2 Filme noch amorph sind, können wir beobachten, dass in diesem Film ein Bruchteil der Gitteranordnungen mit den d-Abstandswerten von 2,82 und 3,12 gebildet wird. Diese beiden d-Abstandswerte sind auf monoklines HfO2 . indiziert (111) und monoklines HfO2 (− 111) Ebenen, und der bei 400 °C getemperte Film zeigt die nanokristalline Struktur. Mit Erhöhung der Glühtemperatur von 400 auf 600°C wird die Kristallqualität von HfO2 Film wird nach und nach verbessert. Wenn das HfO2 Film wird bei 500–550 °C getempert, die Hauptgitteranordnungen bestehen aus monoklinem HfO2 (− 111), monoklines HfO2 (200) und orthorhombisches HfO2 (111) identifiziert werden. Durch eine weitere Erhöhung der Glühtemperatur auf 600°C wird die Gitterstruktur von orthorhombischem HfO2 . jedoch (111) existiert noch im Film, und die anderen beiden Gitteranordnungen verschwinden nach und nach. Andererseits sind die d-Abstandswerte von orthorhombischem HfO2 (111) Ebenen für das 500°C-, 550°C- und 600°C-geglühte HfO2 Filme werden mit 2,93, 2,90 bzw. 2,88 bestimmt. Dies stimmt gut mit dem XRD-Ergebnis überein, dass das orthorhombische HfO2 Der (111)-Beugungspeak verschiebt sich mit einer Erhöhung der Glühtemperatur von 500 auf 600°C in Richtung des großen Winkels. Das Ergebnis zeigt, dass der Sauerstoffgehalt von HfO2 Film verringert sich allmählich, wenn die Glühtemperatur erhöht wird. Das andere interessante Phänomen kann in den Veränderungen der Kristallstruktur und Dicke des SiO2 . gefunden werden Schicht. Im abgeschiedenen Zustand ist das SiO2 Schicht ist amorph. Selbst wenn die Probe bei 400°C getempert wird, reicht die thermische Energie nicht aus, um die Struktur von SiO2 . umzuwandeln Schicht von amorph bis kristallin. Durch die Erhöhung der Glühtemperatur von 450 auf 600°C wird das kristalline SiO2 . jedoch Schicht (mit dem kubischen SiO2 (220)-Struktur) gebildet wird und ihre Dicke von 1,0 auf 1,6 nm erhöht wird. Es kann beobachtet werden, dass das amorphe SiO2 Schicht wandelt sich vollständig in kubisches SiO2 . um Struktur nach dem Tempern der Probe bei 600°C. Mit einer Erhöhung der Glühtemperatur von 550 bis 600°C wird der d-Abstandswert von kubischem SiO2 (220) erhöht sich von 2,48 auf 2,56 Å. Dies bedeutet, dass der Sauerstoffgehalt von SiO2 Schicht nimmt durch Erhöhung der Glühtemperatur zu. Es kann vernünftigerweise spekuliert werden, dass die Zugabe des Sauerstoffgehalts im SiO2 Schicht wird der Diffusion von Sauerstoffatomen zugeschrieben, die aus dem HfO2 . stammen Film. Darüber hinaus nimmt die Gesamtdicke bei einer Glühtemperatur von 550 und 600°C ab und könnte mit der Zunahme der Filmdichte durch Kristallisation und Wasserstoffentfernung zusammenhängen.
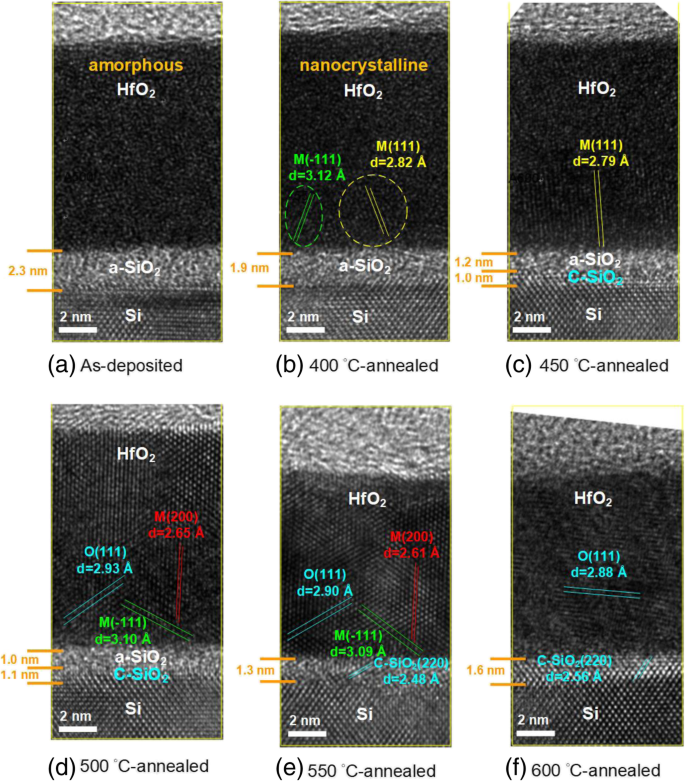
Querschnitts-TEM-Bilder von a wie hinterlegt, b 400°C-geglüht, c 450°C-geglüht, d 500°C-geglüht, e 550°C getempert und f 600°C geglühtes HfO2 /Si
Basierend auf den obigen Ergebnissen veranschaulicht Abb. 5 die Mechanismen des HfO2 . Folien mit unterschiedlichen Tempertemperaturen. Wenn man bedenkt, dass die Glühtemperatur kleiner als 400°C ist (Abb. 5a), ist der Film amorph, wobei Hf- und O-Atome zufällig angeordnet sind. Die Grenzschicht zwischen HfO2 und c-Si-Wafer ist ein Mischoxid bestehend aus a-SiO2 und a-HfO2 . Bei einer Glühtemperatur von 450–550 °C (Abb. 5b) wird das HfO2 Film erhält thermische Energie, was zu einer Strukturänderung von amorph zu polykristallin mit monoklinen und orthorhombischen Phasen führt. Die kristalline Orientierung und der d-Abstand werden gemäß den HR-TEM- und GIXRD-Ergebnissen angegeben. Ein kristallines SiO2 Schicht entsteht. Mehrere Arbeiten berichteten über eine geordnete Siliziumoxidschicht an der Grenzfläche von a-SiO2 und (100) c-Si, aber der Mechanismus und die Struktur auf atomarer Ebene blieben umstritten. Die thermische Oxidation von Silizium könnte als sequentielles Einfügen von Sauerstoffatomen in Si-Si-Bindungen angesehen werden, was eine starke Ansammlung von Druckspannungen in den oxidierten Bereichen induziert und möglicherweise eine strukturelle Umwandlung in geordnetes Oxid am SiO2<. verursachen könnte /sub> /c-Si-Schnittstelle [24]. Es wurde auch berichtet, dass sich eine kristalline sauerstoffhaltige Phase unter Bedingungen hoher Sauerstoffübersättigung von Si [25] oder geringer Grenzflächendefektdichte [26] bilden könnte. Aus den XPS- und TEM-Bildern in dieser Arbeit ist das HfO2 Schicht ist sauerstoffarm. Die signifikanten Mengen an Sauerstoff diffundieren aus HfO2 in Richtung Siliziumsubstrat, was zu einer Übersättigung von Sauerstoff an der c-Si-Grenzfläche und zur Bildung von kristallinem SiO2 . führen könnte . In diesem Temperaturbereich ist das kristalline SiO2 Schichtdicke würde zunehmen, aber der a-HfO2 + a-SiO2 Die Mischschichtdicke nimmt mit steigender Glühtemperatur ab. Bei einer Glühtemperatur von mehr als 550 °C (Abb. 5c) wird das HfO2 Struktur wird von polykristalliner orthorhombischer (111)-Einzelphase dominiert. Die Grenzschicht wird vollständig von kristallinem SiO2 . beherrscht . Der d-Abstand verringert sich für orthorhombisches HfO2 Schicht und Zunahmen für c-SiO2 . Obwohl das Tempern von HfO2 ist notwendig, um eine hohe Passivierung und Dielektrizitätskonstante des Si-Wafers zu erreichen, bei hohen Temperaturen die resultierende Kristallisation des HfO2 und die Grenzfläche SiO2 können die Filmeigenschaften beeinträchtigen. Es wurde festgestellt, dass eine Glühtemperatur von 500°C die beste Dielektrizitätskonstante von 17,2 erreicht. Eine weitere Erhöhung der Glühtemperatur führt zu einer Verringerung der Dielektrizitätskonstante, möglicherweise aufgrund der Änderung der kristallinen Phase. Tomidaet al. berichteten, dass die Dielektrizitätskonstante von HfO2 nimmt ab, wenn die Struktur von der polykristallinen in die monokline einphasig umgewandelt wird [27]. Die beste Passivierung von HfO2 /Si kann auch bei einer Glühtemperatur von 500°C erhalten werden, da höhere Temperaturen zu einem vollständigen c-SiO2 . führen können Grenzschicht und Dehydrierung an der Grenzfläche.
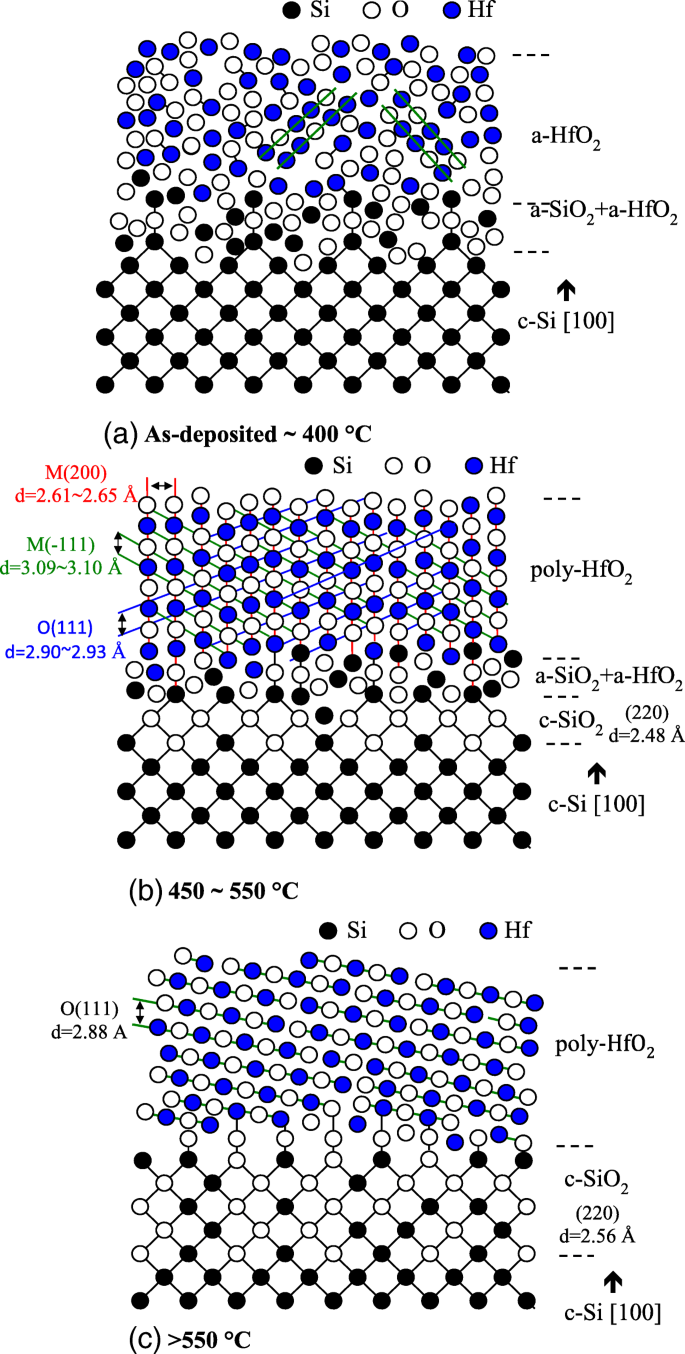
Diagramme des Kristallisationsmechanismus von HfO2 Folien und Zwischenschicht in den Temperaturbereichen a wie abgeschieden bis 400 °C, b 450 bis 550°C und c über 550°C. Der d-Abstandswert und die Kristallorientierung werden ebenfalls angezeigt
Schlussfolgerung
HfO2 Filme werden unter Verwendung von RP-ALD hergestellt, und der Einfluss der Glühtemperatur auf die kristalline Struktur des HfO2 wurde untersucht. Für HfO2 wie deponiert und das unter 400°C geglüht, das HfO2 und die Grenzschicht sind amorph. Mit steigender Glühtemperatur verringert sich der d-Abstand von orthorhombischen, während der von c-SiO2 Grenzschicht nimmt zu, was auf die Sauerstoffdiffusion von HfO2 . hinweist zur Si-Schnittstelle. Glühtemperaturen über 550 °C zeigen ein HfO2 Schicht mit polykristalliner orthorhombischer Einphase, und die Grenzschicht wandelt sich vollständig in c-SiO2 . um . Obwohl für HfO2 . Glühen erforderlich ist Bei vielen Anwendungen, wie zum Beispiel beim Erreichen einer hohen Passivierung von Si-Wafern und einer hohen Dielektrizitätskonstante, kann die Kristallisation die Filmeigenschaften beeinträchtigen. Die Glühtemperatur von 500°C kann die beste Passivierungsqualität und Dielektrizitätskonstante für Si-Wafer haben.
Abkürzungen
- AFM:
-
Rasterkraftmikroskopie
- a-HfO2 :
-
Amorphes Hafniumoxid
- ALD:
-
Atomlagenabscheidung
- a-SiO2 :
-
Amorphes Siliziumdioxid
- c-SiO2 :
-
Kristallines Siliziumdioxid
- GIXRD:
-
Beugung durch streifende einfallende Röntgenstrahlen
- HfO2 :
-
Hafniumoxid
- HR-TEM:
-
Hochauflösende Transmissionselektronenmikroskopie
- N2 :
-
Stickstoff
- O2 :
-
Sauerstoff
- RMS:
-
Root-Mean-Square
- RP-ALD:
-
Remote-Plasma-Atomschichtabscheidung
- RTA:
-
Schnelles thermisches Glühen
- TEMAH:
-
Tetrakis (ethylmethylamino) hafnium
- XPS:
-
Röntgenphotoelektronenspektroskopie
Nanomaterialien
- Bipolar-resistive Schalteigenschaften von HfO2/TiO2/HfO2-RRAM-Bauelementen mit dreischichtiger Struktur auf Pt- und TiN-beschichteten Substraten, die durch Atomlagenabscheidung hergestellt wurden
- Abstimmung der Oberflächenmorphologien und -eigenschaften von ZnO-Filmen durch das Design der Grenzflächenschicht
- Herstellung von Palladium(II)-ionengeprägten polymeren Nanokügelchen und deren Entfernung von Palladium(II) aus wässriger Lösung
- Leitungsmechanismus und verbesserte Ausdauer bei HfO2-basiertem RRAM mit Nitridierungsbehandlung
- Herstellung von SrGe2-Dünnschichten auf Ge (100), (110) und (111) Substraten
- Untersuchung der strukturellen, elektronischen und magnetischen Eigenschaften von Ag n V (n = 1–12)-Clustern
- Herstellung von helikalen CA/TPU-Nanofasern und deren Mechanismusanalyse
- Dickenabhängige Magnet- und Mikrowellenresonanzcharakterisierung kombinierter FeCoBSi-Filme mit Streifenmuster
- Eine theoretische Simulation des Strahlungsverhaltens von Si-, Ge- und Si/Ge-Übergittern auf niederenergetische Bestrahlung
- Kontrollierte Synthese und selektive Adsorptionseigenschaften von Pr2CuO4-Nanoblättern:eine Diskussion des Mechanismus



