Leitungsmechanismus und verbesserte Ausdauer bei HfO2-basiertem RRAM mit Nitridierungsbehandlung
Zusammenfassung
Eine Nitridierungsbehandlungstechnologie mit einer Harnstoff/Ammoniak-Komplex-Stickstoffquelle verbesserte die Widerstandsschalteigenschaft in HfO2 -basierter resistiver Direktzugriffsspeicher (RRAM). Die Nitrierungsbehandlung führte zu einem leistungsstarken und zuverlässigen Gerät, das zu einer überragenden Lebensdauer (mehr als 10 9 Zyklen) und einen Self-Compliance-Effekt. Somit änderte sich der Stromleitungsmechanismus aufgrund der Defektpassivierung durch Stickstoffatome im HfO2 dünner Film. In einem hochohmigen Zustand (HRS) ging es in HfO2 . auf die Schottky-Emission von Poole-Frenkel über -basierter RRAM. Im Zustand mit niedrigem Widerstand (LRS) war der Stromleitungsmechanismus nach der Nitridierungsbehandlung ein raumladungsbegrenzter Strom (SCLC), was darauf hindeutet, dass die Stickstoffatome Hf-N-Ox-Leerstellencluster (Vo + ), die die Elektronenbewegung durch die Schaltschicht begrenzen.
Hintergrund
Kürzlich wurde ein Widerstandsspeicher mit wahlfreiem Zugriff (RRAM), der aus einer Isolierschicht zwischen zwei Elektroden besteht, aufgrund seiner überlegenen Eigenschaften wie einfache Struktur, geringer Stromverbrauch, Hochgeschwindigkeitsbetrieb als vielversprechender Kandidat für nichtflüchtige Speicher der nächsten Generation untersucht (< 300 ps) und zerstörungsfreies Auslesen [1-9]. Obwohl die meisten RRAM-Geräte viele Eigenschaften haben, die nichtflüchtigen Speichern überlegen sind, sind der hohe Betriebsstrom von RRAM und die Leistungsverschlechterung die Hauptprobleme bei nichtflüchtigen Speichern im Hinblick auf die Anwendung tragbarer elektronischer Produkte.
Das Pt/HfO2 /TiN-Struktur kann einen Leitungspfad liefern, der ein resistives Schaltverhalten induziert [10–19]. Die Defekte von amorphem HfO2 wird die Anzahl der Leckpfade erhöhen, was zu einem Stromverbrauch und einer Verschlechterung der Joule-Erwärmung führt. In dieser Arbeit wird die resistive Schaltschicht von HfO2 wurde mit einer Lösung mit einer Harnstoff/Ammoniak-Komplex-Stickstoffquelle als Nitridierungsbehandlung behandelt, um seine elektrischen Schalteigenschaften zu verbessern.
Methoden
Das strukturierte TiN/Ti/SiO2 /Si-Substrat wurde mit einem standardmäßigen Abscheidungs- und Ätzprozess hergestellt, wonach Durchgangslöcher gebildet werden können (Einschub von Fig. 1a). Dann ein 23 nm dickes HfO2 Dünnfilm wurde in Durchgangslöchern auf dem Substrat durch HF-Magnetron-Sputtern unter Verwendung von reinem HfO2 . abgeschieden Ziel. Die Sputterleistung wurde auf eine HF-Leistung von 150 W festgelegt und in einer Argonumgebung (Ar = 30 sccm) mit einem Arbeitsdruck von 4 mTorr bei Raumtemperatur durchgeführt. Das HfO2 Ein /TiN-Halbzeug wurde in die Reaktionskammer eingebracht und in die Lösung mit einer Harnstoff/Ammoniak-Komplex-Stickstoffquelle zur Nitridierungsbehandlung eingetaucht. Während der Nitridierungsbehandlung wurde die Lösung in der Edelstahlkammer des Systems 30 Minuten lang auf 160 °C erhitzt. Dann wurde die 110 nm dicke obere Pt-Elektrode durch DC-Magnetron-Sputtern auf dem HfO2 . abgeschieden Dünnfilm zur Bildung elektrischer Geräte mit Pt/HfO2 /TiN-Sandwichstrukturen. Schließlich wurden alle elektrischen Eigenschaften mit dem Halbleiterparameteranalysator Agilent B1500 gemessen. Die Gleichstrom- und Puls-Sweep-Vorspannung wurden an die untere Elektrode (TiN) angelegt, während die obere Elektrode (Pt) während der elektrischen Messungen geerdet war. Darüber hinaus wurde Fourier-Transform-Infrarotspektroskopie (FTIR) mit einem Bruker VERTEX 70v-Spektrometer im mittleren Infrarotbereich gemessen.

a Die sich bildenden Stromkurven von HfO2 -basierte RRAM-Geräte. b Vergleich der DC-Sweep-Zyklen bei einem 5 mA-Compliance-Strom zwischen der anfänglichen und nach der Nitridierungsbehandlung von HfO2 -basierter RRAM. c DC-Sweep-Zyklen ohne externe Stromkonformität des HfO2 Gerät nach der Nitrierbehandlung. d Retentionszeit des HfO2 -basierte RRAM-Bauelemente bei 85 °C mit und ohne Compliance-Strom nach der Nitridierungsbehandlung
Ergebnisse und Diskussion
Ein Galvanoformungsprozess ist erforderlich, um alle RRAM-Bauelemente unter Verwendung einer DC-Vorspannung mit einem Compliance-Strom von 10 μA zu aktivieren, wie in Fig. 1a gezeigt. Nach dem Formgebungsprozess sind die elektrischen Strom-Spannungs-Eigenschaften (I-V) des HfO2 -basierte RRAM wurden zu Beginn und nach der Nitrierungsbehandlung verglichen. Bei LRS war der Strom im Vergleich zu unbehandeltem HfO2 . offensichtlich reduziert dünner Film, wie in Abb. 1b gezeigt. Die Stromreduzierung ist auf die durch das NH3 . passivierten Defekte zurückzuführen Molekül in der Behandlungslösung. Wir haben festgestellt, dass die HRS-Verteilung nach der Nitridierungsbehandlung viel stabiler ist, wie im Einschub von Abb. 1b. Die Widerstandszustände werden mit einer Lesespannung von 0,1 V während der 100 Sweep-Zyklen im Gleichstrombetrieb extrahiert (Einschub in Abb. 1b). Das Widerstands-Ein/Aus-Verhältnis wurde nach der Nitridierungsbehandlung leicht verringert. Interessanterweise wurde bei diesen HfO2 -basierte RRAM-Geräte nach der Behandlung, wie in Fig. 1c gezeigt. Nach mehr als 10 3 Sweep-Zyklen wurde eine wiederholbare Selbstschutzeigenschaft des Geräts ohne harten Ausfall beobachtet. Die Retentionszeit wurde bei 85 °C bewertet und blieb auch nach 10 4 . stabil s sowohl in HRS als auch in LRS.
Um die Geräteleistung weiter zu bewerten, werden die Dauertests von HfO2 -basierte RRAM wurden für die anfängliche und nach der Nitridierungsbehandlung durchgeführt, wie in Fig. 2 gezeigt. In der unbehandelten Vorrichtung nach 10 6 Sweep-Zyklen verschlechtert sich das HRS/LRS-Verhältnis signifikant von 100:1 auf 5:1, wie in Abb. 2a gezeigt. Nach der Nitrierbehandlung jedoch auch nach mehr als 10 9 Sweep-Zyklen zeigte das Gerät ein stabiles HRS/LRS-Verhältnis, wie in Abb. 2b. Diese Ergebnisse zeigen, dass der Nitridierungsprozess HfO2 -basierter RRAM mit überlegenen Schaltfunktionen und Zuverlässigkeit. Um diese Ergebnisse weiter zu untersuchen, wurde eine FTIR-Analyse verwendet, um die chemischen Veränderungen des HfO2 . zu beobachten dünner Film, wie in Abb. 3 gezeigt. Ein scharfer Peak bei 1589 und 1311 cm −1 trat nach der Nitridierungsbehandlung auf, entsprechend dem symmetrischen und asymmetrischen Streckschwingungspeak einer N-O-Bindung [20]. Außerdem ist die Spitzenintensität der N-H-Bindungen bei 1471 cm −1 [21] erhöht aufgrund des Nitridierungsprozesses durch eine Harnstoff/Ammoniak-Komplex-Stickstoffquelle (Einschub von Abb. 3). Daher können wir auf die Bildung stickstoffhaltiger Verbindungen nach der Nitridierungsbehandlung schließen.
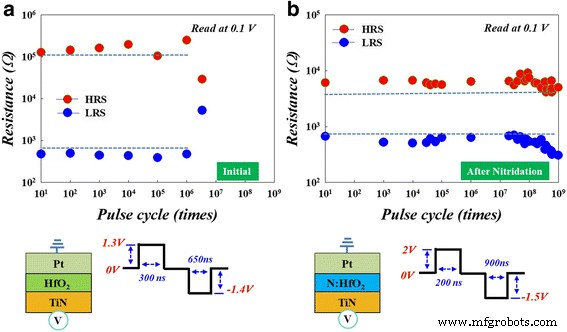
Vergleich der Ausdauerzeiten in HfO2 -basierter RRAM:a Anfangs- und b nach der Nitrierbehandlung. Die unteren Diagramme sind die entsprechenden Gerätestrukturen und Ausdauerpulsbedingungen

Der Vergleich von FTIR-Spektren von HfO2 dünne Schichten zwischen der anfänglichen und nach der Nitridierungsbehandlung
Um den resistiven Schaltmechanismus aufzuklären, haben wir den Stromleitungsmechanismus des HfO2 . analysiert Dünnfilm mit und ohne Nitridierungsbehandlung, gezeigt in Fig. 4a und d. Für das unbehandelte HfO2 Dünnfilm wurden die Elektronen durch die Defekte übertragen, so dass der Stromleitungsmechanismus von der Poole-Frenkel-Leitung gemäß der linearen Beziehung zwischen ln(I/V) und der Quadratwurzel der angelegten Spannung (V 1 /2 ) auf HRS, wie in Abb. 4b [22] gezeigt.
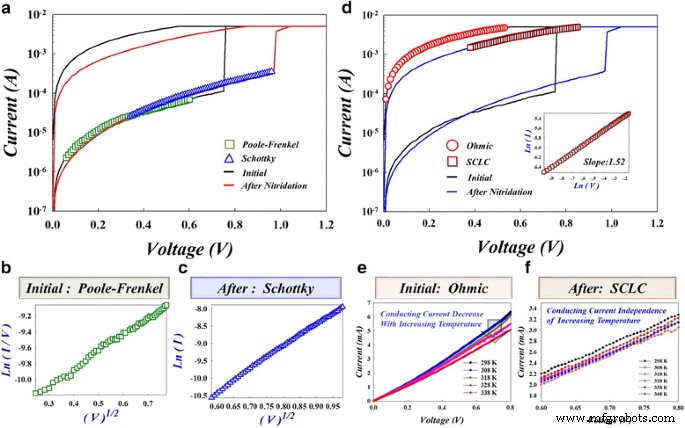
a Analyse des Stromleitungsmechanismus von HRS aus I-V-Kurven in HfO2 -basiertes RRAM zwischen der anfänglichen und nach der Nitridierungsbehandlung. b Der Poole-Frenkel-Stromleitungsmechanismus von HRS in HfO2 -basierter RRAM. c Der Schottky-Emissionsstromleitungsmechanismus von HRS in HfO2 -basiertes RRAM nach der Nitridierungsbehandlung. d Analyse des Stromleitungsmechanismus von LRS, der sich nach der Nitridierungsbehandlung in HfO2 . von ohmscher Leitung in SCLC umwandelt -basierter RRAM; die eingefügte Abbildung zeigt das aktuelle SCLC-Anpassungsergebnis. e Der ohmsche Leitungsmechanismus von LRS in HfO2 -basierter RRAM, der in der aktuellen negativen Korrelation mit der Temperatur charakteristisch ist. f Der SCLC-Mechanismus von LRS in HfO2 -basiertes RRAM, das nach der Nitrierbehandlung temperaturunabhängig ist
Im Gegensatz dazu HfO2 -basierter RRAM zeigte den Schottky-Emissionsmechanismus gemäß der linearen Beziehung zwischen ln(I/T 2 ) und die Quadratwurzel der angelegten Spannung (V 1/2 ) von HRS, wie in Abb. 4c gezeigt [23, 24]. Dies ist auf die Abnahme von Defekten und freien Bindungen zurückzuführen, da Bindungen nach der Nitridierungsbehandlung durch Stickstoffatome passiviert werden. Darüber hinaus haben wir auch den Stromleitungsmechanismus mit und ohne Behandlung am LRS in HfO2 . analysiert -basierter RRAM. Auf LRS, dem Trägertransportmechanismus des unbehandelten HfO2 -basierter RRAM wurde von ohmscher Leitung dominiert, wobei der Strom mit steigender Temperatur abnimmt, wie in Abb. 4e gezeigt. Nach der Nitridierungsbehandlung geht der Stromleitungsmechanismus auf raumladungsbegrenzten Strom (SCLC) mit einer Steigung von 1,52 über. Die I-V-Kurve ist nicht temperaturabhängig, mit einer linearen Beziehung zwischen ln(I) und dem Quadrat der angelegten Spannung V 2 auf LRS, wie in Abb. 4f [25] gezeigt.
Wir haben ein Modell vorgeschlagen, um die Eigenschaften des Stromleitungsmechanismus zu erklären, und es ist in Abb. 5 dargestellt. Somit gibt es zwei gegensätzliche Dipole, die mit N- und O-Atomen und einem Hf-Atom verbunden sind (dh die Sequenz O–Hf–O wird durch O–Hf–N–O ersetzt) nach der Dotierung von N-Atomen in HfO2 dünner Film. Da die Elektronennegativität von Stickstoff niedriger ist als die von Sauerstoff, ist der Dipol der Hf-N-Bindung niedriger als der der Hf-O-Bindung, was einen Bereich mit niedrigerer Dielektrizitätskonstante erzeugt. Wenn während des SET-Prozesses eine positive Vorspannung angelegt wird, wird aufgrund ihrer niedrigeren Dielektrizitätskonstante eine Reihe von Hf-N-Ox-Leerstellen gebildet, die dann Leerstellencluster (Vo + ). Der leitfähige Pfad bildet sich typischerweise zusammen mit den Hf-N-Ox-Leerstellenclustern (Vo + ), da Stickstoffatome Sauerstoffionen um die Cluster herum einfangen, wie in Abb. 5b gezeigt. Das Vorhandensein dieser isolierenden Hf-N-Ox-Leerstellencluster (Vo + ) führt zu einer Stromreduzierung und dem bei HfO2 . gefundenen Selbst-Compliance-Effekt -basiertes RRAM.

Ein Schema der Wanderung von Sauerstoffionen durch den Setzprozess in HfO2 -basiertes RRAM für a Anfangs- und b nach der Nitridierungsbehandlung, die Hf-N-Ox-Leerstellencluster bildet (Vo + )
Schlussfolgerungen
Zusammenfassend wurde in einem Pt/HfO2 . eine selbstkonforme Widerstandsschalteigenschaft beobachtet /TiN-RRAM-Bauelement nach der Nitridierungsbehandlung. Durchhaltezeit erreicht 10 9 Zyklen und eine Retentionszeit von mehr als 10 4 s wurde bei 85 °C erreicht. Aufgrund der geringeren Elektronennegativität des Stickstoffatoms im Vergleich zum Sauerstoffatom ist der Dipol der Hf-N-Bindung kleiner als der der Hf-O-Bindung, wodurch ein Bereich mit niedrigerer Dielektrizitätskonstante entsteht. Während des SET-Prozesses werden die Hf-N-Ox-Leerstellencluster (Vo + ) bilden die Leiterbahn. Die isolierenden Hf-N-Ox-Leerstellencluster (Vo + ) Schützen Sie das Gerät vor einem harten Ausfall und führen Sie eine Eigenständigkeitseigenschaft durch.
Abkürzungen
- FTIR:
-
Fourier-Transformations-Infrarotspektroskopie
- HRS:
-
Hochohmiger Zustand
- LRS:
-
Niedriger Widerstandszustand
- RRAM:
-
Resistiver Arbeitsspeicher
- SCLC:
-
Raumladungsbegrenzter Strom
Nanomaterialien
- Butter und Margarine
- Interview mit einem Experten:Spencer Wright von pencerw.com und nTopology
- Traktion gewinnen mit Markforged:3D-gedruckte Räder umspritzen und gießen
- Materialien:EPP-Schaum mit verbesserten Oberflächeneigenschaften und optimiertem Füllverhalten
- Intelligentes Nanomaterial und Nanokomposit mit fortschrittlichen agrochemischen Aktivitäten
- Retentionsmodell von TaO/HfO x und TaO/AlO x RRAM mit selbstrichtenden Schaltereigenschaften
- Resveratrol-beladene Albumin-Nanopartikel mit verlängerter Durchblutung und verbesserter Biokompatibilität für eine hochwirksame gezielte Pankreastumortherapie
- Verbesserte Antitumorwirksamkeit und Pharmakokinetik von Bufalin durch PEGylierte Liposomen
- Toxizität von PEG-beschichteten CoFe2O4-Nanopartikeln mit Behandlungseffekt von Curcumin
- Reduzierter Kontaktwiderstand zwischen Metall und n-Ge durch Einfügen von ZnO mit Argon-Plasmabehandlung



