Hochleistungs-a-InGaZnO-Dünnschichttransistoren mit extrem niedrigem Wärmebudget durch Verwendung eines wasserstoffreichen Al2O3-Dielektrikums
Zusammenfassung
Elektrische Eigenschaften von amorphen In-Ga-Zn-O (a-IGZO) Dünnschichttransistoren (TFTs) werden unter Verwendung von O2 . verglichen plasmaunterstützte Atomlagenabscheidung Al2 O3 Dielektrika bei verschiedenen Temperaturen. Hochleistungs-a-IGZO-TFTs werden erfolgreich mit einem Al2 . demonstriert O3 Bei Raumtemperatur abgeschiedenes Dielektrikum, das eine hohe Feldeffektbeweglichkeit von 19,5 cm 2 . aufweist V − 1 s − 1 , ein kleiner unterschwelliger Hub von 160 mV/dec, eine niedrige Schwellenspannung von 0,1 V, ein großes Ein/Aus-Stromverhältnis von 4,5 × 10 8 und überlegene negative und positive Gate-Bias-Stabilitäten. Dies wird dem wasserstoffreichen Al2 . zugeschrieben O3 Bei Raumtemperatur abgeschiedenes Dielektrikum im Vergleich zu höheren Abscheidungstemperaturen, wodurch die Grenzflächenzustände von a-IGZO/Al2 . effizient passiviert werden O3 und die Sauerstoffleerstellen und die Verbesserung der Leitfähigkeit des a-IGZO-Kanals durch Erzeugung zusätzlicher Elektronen aufgrund der verstärkten Wasserstoffdotierung während des Sputterns von IGZO. Solch ein extrem niedriges Wärmebudget für leistungsstarke a-IGZO-TFTs ist für flexible elektronische Anwendungen sehr attraktiv.
Hintergrund
Amorphe In-Ga-Zn-O (a-IGZO)-basierte Dünnschichttransistoren (TFTs) haben in den letzten zehn Jahren aufgrund ihrer hohen Mobilität, guten Gleichmäßigkeit, hohen Transparenz für sichtbares Licht und niedriger Prozesstemperatur viel Aufmerksamkeit auf sich gezogen [1, 2,3]. Diese Vorzüge machen es zu einem vielversprechenden Kandidaten für die Anwendung von Elektronik der nächsten Generation, wie beispielsweise transparente Displays, flexible Geräte oder tragbare Elektronik. Insbesondere für Anwendungen flexibler Elektronik werden TFTs im Allgemeinen auf Polymersubstraten mit geringer thermischer Stabilität hergestellt. Somit ist es notwendig, das thermische Budget der a-IGZO-TFT-Herstellung zu reduzieren. Zu diesem Zweck konzentrieren sich viele Forscher auf a-IGZO-TFTs mit bei Raumtemperatur hergestellten Gate-Isolatoren, wie Sputtern [4,5,6], Lösungsverfahren [7,8,9], Elektronenstrahlverdampfung [10] und Anodisierung [11]. Diese dielektrischen Filme leiden jedoch häufig unter einer hohen Fallendichte und einer starken dielektrischen/a-IGZO-Grenzflächenstreuung, was zu einer begrenzten Feldeffektmobilität, einem großen Unterschwellenhub und einem kleinen Ein-/Aus-Stromverhältnis führt [4,5,6 ,7,8,9,10,11].
Andererseits ist die Atomlagenabscheidung (ALD) eine vielversprechende Technik, die qualitativ hochwertige Filme, eine präzise Steuerung der Filmdicke, eine gute Gleichmäßigkeit über einen großen Bereich und eine niedrige Prozesstemperatur liefern kann [12,13,14]. Zhenget al. [15] berichteten, dass der a-IGZO-TFT mit ALD SiO2 Dielektrikum wies eine ausgezeichnete elektrische Leistung auf, ohne dass ein Nachglühen erforderlich war. Für die ALD von SiO2 . ist jedoch eine hohe Substrattemperatur von 250°C erforderlich Folien [15], die höher ist als die Glasübergangstemperatur der meisten flexiblen Kunststoffsubstrate. Interessanterweise wird berichtet, dass die ALD von Al2 O3 Filme können auch bei Raumtemperatur (RT) realisiert werden [16, 17]; inzwischen die Al2 O3 Bei RT abgeschiedener Film enthält eine große Menge an Wasserstoff(H)-Verunreinigungen [17]. Nach unserem besten Wissen ist jedoch das oben erwähnte H-reiche Al2 O3 Film wurde nie als Gate-Isolator in einem a-IGZO-TFT verwendet. Daher ist es wünschenswert, den a-IGZO-TFT mit einem RT-ALD Al2 . zu untersuchen O3 Torisolator.
In diesem Brief wurde ein Hochleistungs-a-IGZO-TFT erfolgreich mit einem bei Raumtemperatur abgeschiedenen Al2 . hergestellt O3 Gate-Dielektrikum. Durch Vergleich der Eigenschaften der a-IGZO-TFTs mit verschiedenen Al2 O3 Gate-Isolatoren, die bei verschiedenen Temperaturen abgeschieden wurden, wurde der zugrunde liegende Mechanismus untersucht.
Methoden
Hochdotierte Siliziumwafer vom p-Typ (<0,0015 Ω cm) wurden durch Standard-RCA-Prozesse gereinigt und dienten als Gate-Elektroden. Vierzig-Nanometer-Al2 O3 Filme wurden in einem kommerziellen ALD-System (Picsun Ltd.) unter Verwendung von Trimethylaluminium (TMA) und O2 . abgeschieden Plasma als Vorläufer bzw. Reaktant. Ein Wachstumszyklus bestand aus 0,1 s TMA-Puls, 10 s N2 Spülen, 8 s O2 Plasmapuls und 10 s N2 säubern. Das TMA wurde bei 18 °C für einen stabilen Dampfdruck und eine stabile Dosis gehalten, und das O2 Die Gasflussrate wurde mit einer Plasmageneratorleistung von 2500 W auf 150 sccm fixiert. Anschließend wurden 40-nm-a-IGZO-Filme durch HF-Sputtern unter Verwendung eines IGZO-Keramiktargets mit einem Atomverhältnis von In:Ga:Zn:O = 1 . abgeschieden :1:1:4. Beim Sputtern, Arbeitsdruck und Ar und O2 Gasflussraten wurden auf 0,88 Pa bzw. 48 und 2 sccm festgelegt. Der aktive Bereich wurde durch Photolithographie und Nassätzen gebildet. Danach wurden Source/Drain-Elektroden aus 30-nm-Ti/70-nm-Au-Doppelschichten durch Elektronenstrahlverdampfung und ein Abhebeverfahren hergestellt. Bei diesen Geräten wurden keine weiteren Glühprozesse angewendet.
Die elektrischen Eigenschaften von a-IGZO-TFTs wurden unter Verwendung eines Halbleitergeräteanalysators (Agilent Tech B1500A) in einer Darkbox bei Raumtemperatur charakterisiert. Die Gerätestabilitäten wurden unter positiven bzw. negativen Gate-Vorspannungsbelastungen gemessen. Die Tiefenprofile der Elemente und die chemische Zusammensetzung wurden durch Sekundärionen-Massenspektrometrie (SIMS) bzw. Röntgen-Photoelektronen-Spektroskopie (XPS) gemessen.
Ergebnisse und Diskussion
Abbildung 1a vergleicht die Dielektrizitätskonstanten von Al2 O3 Filme, die bei verschiedenen Temperaturen als Funktion der Frequenz abgeschieden wurden (d. h. von 10 Hz bis 10 5 Hz). Wenn die Abscheidungstemperatur von 100 auf 150°C ansteigt, zeigt der Film eine allmähliche Abnahme der Dielektrizitätskonstante. Ein ähnlicher Trend wurde auch in früheren Literaturstellen für die Änderung der Abscheidungstemperatur von RT auf 150°C berichtet [18, 19]. Dies liegt daran, dass der RT Al2 O3 Film enthält die höchste Konzentration an Wasserstoff (H) in Form von OH-Gruppen. Somit wird die entsprechende Dielektrizitätskonstante durch eine Rotation von mehr OH-Gruppen in einem elektrischen Feld erhöht [20]. In Bezug auf die Messfrequenz von 10 Hz, die extrahierten Dielektrizitätskonstanten für die RT, 100 °C und 150°C Al2 O3 Filme sind gleich 8,6, 7,9 bzw. 7,4, die für die Extraktion der Feldeffekt-Mobilität (μ FE ) und Grenzflächenfallendichte (D es ) des hergestellten TFT-Geräts. Abbildung 1b zeigt die Leckstromeigenschaften verschiedener Al2 O3 Filme. Es wurde festgestellt, dass die RT Al2 O3 Film weist eine kleine Leckstromdichte von 2,38 × 10 – 8 . auf A/cm 2 bei 2 MV/cm und einem elektrischen Durchschlagsfeld von 5,3 MV/cm. Außerdem nimmt das elektrische Durchschlagsfeld mit steigender Abscheidungstemperatur von 100 auf 150°C allmählich zu.
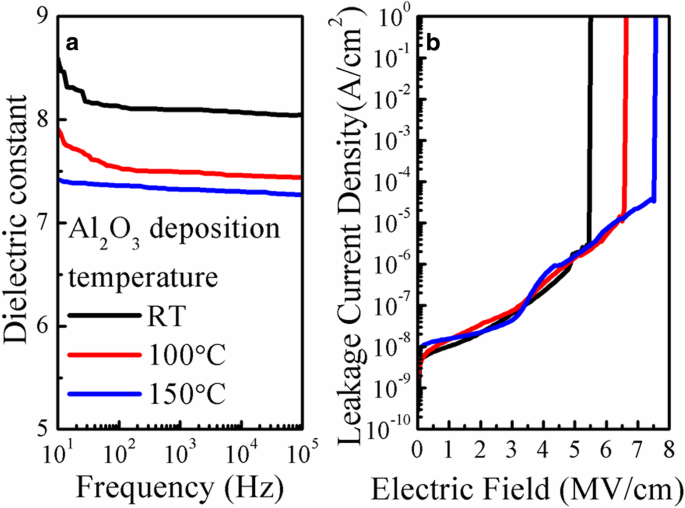
Elektrische Eigenschaften von Al2 O3 Filme, die bei unterschiedlichen Temperaturen abgeschieden wurden. a Dielektrizitätskonstante über der Frequenz. b Leckstromdichte versus elektrisches Feld
Abbildung 2 zeigt die typischen Übertragungskurven der a-IGZO-TFTs mit verschiedenen Al2 O3 Torisolatoren. Der RT Al2 O3 TFT weist die beste Leistung auf, z. B. hohe μ FE von 19,5 cm 2 V − 1 s − 1 , ein kleiner unterschwellenwert (SS) von 160 mV/dez, eine kleine Schwellenspannung (V T ) von 0,1 V und einem großen Ein/Aus-Stromverhältnis (I ein/aus ) von 4,5 × 10 8 . Die a-IGZO-TFTs mit Al2 O3 Gate-Isolatoren, die sowohl bei 100 als auch bei 150°C abgeschieden wurden, zeigen eine viel schlechtere Leistung, d. h. reduzierte Einschaltströme (10 − 7 und 3 × 10 − 9 A) und degradierte SS. Das D es an der Schnittstelle von Al2 O3 /a-IGZO kann nach folgender Gleichung [21] berechnet werden:
$$ {D}_{\textrm{it}}=\left(\frac{\textrm{SS}\times \lg e}{kT/q}-1\right)\frac{C_{ox}}{ q^2} $$ (1)wo e , k , T , und q repräsentieren die Eulersche Zahl, die Boltzmann-Konstante, die absolute Temperatur bzw. die Einheitselektronenladung. C Ochse ist die dielektrische Gate-Kapazität pro Flächeneinheit. Für den RT Al2 O3 TFT, das D es ist gleich 1,1 × 10 12 eV − 1 cm − 2 , was mehr als ein- oder zweimal niedriger ist als bei den TFTs mit Al2 O3 Gate-Isolatoren, abgeschieden bei 100 und 150°C.

Übertragungskurven der a-IGZO-TFTs mit ALD Al2 O3 Gate-Isolatoren, die bei verschiedenen Temperaturen zusammen mit den extrahierten Geräteparametern abgeschieden wurden
Die Gate-Bias-Stabilitäten der Bauelemente wurden ferner durch Anlegen negativer und positiver Spannungen gemessen. Abbildung 3 zeigt das V T Verschiebung als Funktion der Bias-Stress-Zeit für verschiedene TFTs. In Bezug auf negative Gate-Bias-Belastung (NGBS) ist der RT Al2 O3 TFT weist ein vernachlässigbares V . auf T Verschiebung von − 0.04 V nach Belastung bei − 10 V für 40 min. Al2 . mit höherer Temperatur O3 Gateisolatoren erzeugen größere V T verschiebt sich speziell für 150°C. Solch eine hohe NGBS-Stabilität für RT Al2 O3 sollte auf eine niedrige Konzentration von Sauerstoffleerstellen (V O ) im a-IGZO-Kanal [22]. In Bezug auf positive Gate-Bias-Belastung (PGBS) ist der RT Al2 O3 TFT zeigt ein V T Verschiebung von 1,47 V, was viel kleiner ist als die (8,8 V und 12,1 V) für 100 und 150 °C Al2 O3 TFTs. Darüber hinaus wurde der Einfluss der Lagerzeit auf die Geräteleistung untersucht, wie in Abb. 4 gezeigt. Obwohl keine Passivierungsschicht auf dem hinteren Kanal bedeckt ist, behält das Gerät nach der Aufbewahrung in einem Schrank (20% RH) immer noch eine hervorragende Leistung bei. 60 Tage bei 30 °C; inzwischen keine signifikanten Schwankungen in μ FE und SS werden beobachtet. Dies zeigt die RT Al2 . an O3 TFTs ohne Passivierungsschicht haben eine gute speicherzeitabhängige Stabilität in der aktuellen Umgebung.

V T Verschiebung als Funktion der Vorspannungszeit unter NGBS = − 10 V und PGBS = 10 V für die TFTs mit Al2 O3 bei unterschiedlichen Temperaturen abgeschiedene Isolatoren

Zeitabhängige Stabilität von RT Al2 O3 TFT nach Aufbewahrung in einem Schrank (20% RH) bei 30 °C. a Kurven übertragen. b Mobilität und unterschwelliger Schwung
Tabelle 1 vergleicht die Leistung unseres RT Al2 O3 TFT mit anderen Berichten. Es wurde festgestellt, dass unser Gerät ein V . nahe Null aufweist T , kleinere SS und größere I ein/aus bei vergleichbarer Mobilität [4, 23]. Obwohl ein Ta2 . verwendet wird O5 Gate-Isolator kann eine höhere Mobilität von 61,5 cm 2 . erreichen V − 1 s − 1 , sowohl SS als auch I ein/aus merklich verschlechtern [10]. Kurz gesagt, unser RT Al2 O3 TFT besitzt eine überlegene Gesamtleistung im Vergleich zu 100 und 150°C Al2 O3 TFTs. Da alle Verarbeitungsschritte bis auf den Abscheidungsschritt von Al2 . identisch sind O3 , sollten solche signifikanten Unterschiede in der elektrischen Leistung vom Al2 . herrühren O3 Torisolatoren.
Um den zugrunde liegenden Mechanismus zu verstehen, die Tiefenprofile der Elemente im a-IGZO/Al2 O3 gestapelte Filme wurden durch SMIS analysiert. Abbildung 5a zeigt die Abhängigkeit der H-Konzentration von der Tiefe in den Stapeln von IGZO/Al2 O3 , wobei das Al2 O3 Filme wurden bei RT bzw. 150°C abgeschieden. Zum Vergleich wurde auch ein auf einem blanken Si-Substrat abgeschiedener IGZO-Film analysiert. Der auf blankem Si abgeschiedene IGZO-Film enthält eine H-Konzentration von ~ 3 × 10 21 cm − 3 , das aus dem Restgas in der Sputteranlage stammt und absorbiertes H2 /H2 O-Moleküle auf der Si-Oberfläche. Beide auf dem Al2 . abgeschiedenen IGZO-Filme O3 Filme enthalten höhere H-Konzentrationen als auf dem blanken Si-Substrat. Dies weist darauf hin, dass die erhöhten H-Konzentrationen von der Freisetzung von H-Verunreinigungen in dem darunter liegenden Al2 . herrühren sollten O3 Filme beim Sputtern von IGZO. Darüber hinaus wird beobachtet, dass die H-Konzentration im IGZO-Film über dem RT Al2 O3 Der Film ist im grenzflächennahen Bereich höher als der bei 150°C, was eine effizientere Passivierung von Grenzflächenzuständen ermöglichen kann. Dies verbessert somit die SS- und PGBS-Stabilität des RT Al2 O3 TFT durch Reduzierung des Einfangens von Grenzflächenträgern. Zusätzlich die O 1s XPS-Spektren der a-IGZO-Filme nahe der Grenzfläche von IGZO/Al2 O3 wurden analysiert, wie in Abb. 5b gezeigt. Die angepassten Peaks liegen bei 530,2 ± 0,1 eV, 530,9 ± 0,1 eV und 531,6 ± 0,1 eV, entsprechend O 2− an Metall gebundene Ionen (O1), V O (O2) bzw. OH-Gruppen (O3) [13, 24]. Der Anteil von O2 beträgt 26,3% in der a-IGZO-Schicht auf dem blanken Si; bei 150°C und RT Al2 . sinkt sie jedoch auf 12,3 % und 6,8 % O3 zugrundeliegende Filme bzw. Dies weist darauf hin, dass mehr V O im IGZO-Kanal kann durch zusätzliche H-Verunreinigungen, die aus dem darunter liegenden Al2 . stammen, effektiv passiviert werden O3 Filme, speziell für die RT Al2 O3 Film mit einer höheren H-Konzentration. Es wird berichtet, dass wenn V O und H beide im a-IGZO-Film vorhanden sind, können sie sich zu einem stabilen Zustand verbinden, in dem H bei V . gefangen ist O (V O H) und das resultierende V O H ist ein Donor mit flachem Niveau [25,26,27]. Somit verstärkte H-Dotierung in den IGZO-Kanal über dem RT Al2 O3 verbessert die Kanalleitfähigkeit durch Bereitstellung zusätzlicher Elektronen. Außerdem ist das kleine V T Verschiebung unter der NGBS für die RT Al2 O3 TFT kann auch auf die effektive H-Passivierung von V . zurückgeführt werden O [28]. Wie in der Literatur beschrieben, stammt die Instabilität von TFT unter NGBS von der Ionisierung von neutralem V O (V O → V O 2+ +2e − ) [17, 29]. Darüber hinaus ist der O3-Prozentsatz des a-IGZO-Films auf dem RT Al2 O3 ist 6,9 %, was höher ist als die des 150°C Al2 O3 (5,3%) bzw. das blanke Si (4,6%). Die OH-Gruppe könnte aus der Reaktion O 2− . stammen + H → OH − + e − während der Abscheidung von IGZO-Filmen [30]. Somit ist die verstärkte H-Dotierung in den IGZO-Kanal über dem RT Al2 O3 Film erzeugt mehr OH-Gruppen und trägt auch zur Verbesserung der Kanalleitfähigkeit bei.

a SIMS-Profile der Wasserstoffkonzentration in Al2 O3 bei RT und 150°C abgeschieden. b Hochauflösende O1s XPS-Spektren des IGZO-Kanals, abgeschieden auf RT Al2 O3 , 150°C Al2 O3 , und blankes Si
Schlussfolgerungen
Ein hochleistungsfähiger a-IGZO-TFT wurde erfolgreich unter dem extrem niedrigen thermischen Budget von RT unter Verwendung eines H-reichen Al2 . hergestellt O3 Gatedielektrikum hergestellt durch O2 Plasma-verstärkte ALD. Dies wird darauf zurückgeführt, dass die Al2 O3 Bei RT abgeschiedenes Dielektrikum enthält mehr Wasserstoffverunreinigungen als die bei höheren Temperaturen abgeschiedenen. Somit erzeugten die freigesetzten H-Verunreinigungen während des Sputterns von IGZO mehr Elektronen und passivierten effizient die Grenzflächenzustände von a-IGZO/Al2 O3 und das V O im a-IGZO-Kanal.
Abkürzungen
- a-IGZO:
-
Amorphes In-Ga-Zn-O
- ALD:
-
Atomlagenabscheidung
- D es :
-
Grenzflächenfallendichte
- H:
-
Wasserstoff
- I ein/aus :
-
Ein/Aus-Stromverhältnis
- NGBS:
-
Negative Gate-Bias-Belastung
- PGBS:
-
Positive Gate-Bias-Belastung
- RT:
-
Raumtemperatur
- SIMS:
-
Sekundärionen-Massenspektrometrie
- SS:
-
Schwung unter der Schwelle
- TFT:
-
Dünnschichttransistor
- V O :
-
Sauerstoff-Stelle
- V O H:
-
Wasserstoff an Sauerstoffleerstelle eingeschlossen
- V T :
-
Schwellenspannung
- XPS:
-
Röntgenphotoelektronenspektroskopie
- μ FE :
-
Feldeffekt-Mobilität
Nanomaterialien
- 3D-Druckvorrichtungen mit Hochleistungsmaterialien
- Verwendung von Epoxidharz mit Kunstwerken
- Vollständige Terahertz-Polarisationskontrolle mit erweiterter Bandbreite über dielektrische Metaoberflächen
- Mehrschichtige SnSe-Nanoflake-Feldeffekttransistoren mit niederohmigen Au-Ohm-Kontakten
- Großartige Verbesserung der Wärmeleitfähigkeit von Silikonverbundstoffen mit ultralangen Kupfer-Nanodrähten
- Herstellung eines geordneten Nanomusters unter Verwendung von ABC-Triblockcopolymer mit Salz in Toluol
- UV-gehärtete, tintenstrahlgedruckte Silver Gate-Elektrode mit niedrigem spezifischen elektrischen Widerstand
- RGO und dreidimensionale Graphen-Netzwerke modifizierte TIMs mit hoher Leistung gemeinsam
- Atomschichtabscheidung von Indiumoxid-Nanoschichten für Dünnschichttransistoren
- Verbesserung der Leistung von a-IGZO-TFT-Geräten durch einen sauberen Schnittstellenprozess durch Ätzstopper-Nanoschichten



