Lokale VOC-Messungen durch Kelvin-Sondenkraftmikroskopie, angewendet auf P-I-N-Si-Nanodrähte mit radialem Übergang
Zusammenfassung
Diese Arbeit konzentriert sich auf die Extraktion der Leerlaufspannung (V OK ) auf photovoltaischen Nanodrähten durch Oberflächenphotospannung (SPV) basierend auf Kelvin-Sondenkraftmikroskopie(KPFM)-Messungen. In einem ersten Ansatz wurden P-I-N Radial-Junction (RJ) Silizium-Nanodraht-(SiNW)-Bauelemente unter Beleuchtung durch KPFM und Strom-Spannungs-(I-V)-Analyse untersucht. Innerhalb von 5 % korreliert das extrahierte SPV gut mit dem V OK . In einem zweiten Ansatz wurden lokale SPV-Messungen an einzelnen isolierten Radial-Junction-SiNWs durchgeführt, die auf Schatteneffekte von der AFM-Spitze hinwiesen, die die SPV-Bewertung stark beeinflussen können. Um diesen Effekt zu minimieren, wurden verschiedene Strategien in Bezug auf die Form der AFM-Spitze und die Ausrichtung der Beleuchtung eingeführt. Lokale SPV-Messungen an isolierten Radial-Junction-SiNWs steigen logarithmisch mit der Beleuchtungsleistung und zeigen ein lineares Verhalten mit der V OK . Die Ergebnisse zeigen insbesondere, dass berührungslose Messungen des V OK im Maßstab einzelner photovoltaischer SiNW-Geräte machbar.
Einführung
Halbleiter-Nanostrukturen ziehen aufgrund ihrer nanoskaligen Eigenschaften, die ein großes Potenzial zur Leistungssteigerung in bestehenden Geräten bieten, ein großes Forschungsinteresse auf sich. Auf Radial Junctions (RJs) basierende Nanodraht-Arrays sind aufgrund ihrer Lichteinfang- und Ladungsträgersammeleigenschaften [1, 2] vielversprechende Nanostrukturen für Photovoltaik (PV)-Anwendungen, die absichtlich kombiniert werden, um die Solareffizienz gegenüber herkömmlichen planaren Strukturen zu verbessern. Die Effizienz von Nanodraht-Solarzellen kann durch beschädigte Nanodraht-Übergänge im Array eingeschränkt sein; dennoch wurden für Silizium-Nanodraht (SiNW) RJs auf Basis der Si-Dünnschichttechnologie bereits Wirkungsgrade bis zu 9,6 % nachgewiesen [3]. Die Charakterisierung solcher Strukturen bleibt ein kritischer Punkt, und insbesondere die Möglichkeit, die photoelektrischen Eigenschaften einzelner Nanodrähte zu charakterisieren, ist ein Mehrwert für die Verbesserung des endgültigen Geräts.
In der vorliegenden Studie haben wir Kelvin-Sondenkraftmikroskopie (KPFM) verwendet, um die lokale Leerlaufspannung (V OK ) auf SiNW RJs. Die Analyse von V OK wurde von KPFM bei mehreren Arten von Photovoltaiktechnologien, meist planaren Strukturen, erfolgreich evaluiert [3, 4]. Die KPFM-Analyse von PV-Nanogeräten ist jedoch nicht einfach, insbesondere weil es erforderlich sein kann, Messungen sowohl bei Dunkelheit als auch bei Beleuchtung durchzuführen, um die Variation des Oberflächenpotentials zu extrahieren, die als Oberflächenphotospannung (SPV) bezeichnet wird.
Unser erster Ansatz zur Untersuchung des lokalen V OK von RJ SiNWs bestand darin, fertige Geräte zu analysieren. Der Begriff abgeschlossen bezieht sich auf RJ-SiNW-Solarzellen, die mit ITO als Frontelektrode finalisiert sind. Die folgenden fertiggestellten Geräte wurden nacheinander durch Strom-Spannungs-(I-V)- und KPFM-Messungen charakterisiert. Beide Messungen wurden unter Dunkel- und Beleuchtungsbedingungen mit dem Endziel durchgeführt, V . zu extrahieren und zu vergleichen OK und SPV. Unser zweiter Ansatz bestand darin, einzelne isolierte RJ-SiNWs zu analysieren, die nicht mit ITO beschichtet waren. Unser Ziel war es insbesondere, das KPFM-Signal unter Beleuchtung zu optimieren, um viele Artefakte zu vermeiden, die zu einer Unterschätzung des SPV-Werts führen könnten. Jeder einzelne isolierte RJ-SiNW wird als isoliertes Gerät bezeichnet.
Um die Ergebnisse zu vervollständigen, wurde schließlich auch die makroskopische Kelvin-Sondentechnik an einem fertigen RJ-Gerät und an einer Reihe isolierter Geräte angewendet. Dies geschah unter Beleuchtung bei verschiedenen Wellenlängen, um eine Oberflächen-Photospannungsspektroskopie (SPS) durchzuführen.
Materialien und Methoden
SiNW-Wachstums- und radiale P-I-N-Übergangsbauelementfertigung
Die RJ-SiNWs wurden auf einem Substrat aus ZnO:Al-beschichtetem Corning-Glas (Cg) hergestellt. Das SiNWs-Wachstum wurde bei einer Substrattemperatur von 500°C durch plasmaunterstützte chemische Gasphasenabscheidung (PECVD) durchgeführt und unter Verwendung von Sn-Nanopartikeln als Katalysatoren vermittelt. Der P-I-N RJ wurde durch Abscheidung dünner konformer Schichten aus intrinsischem (80 nm) und dann n-Typ (10 nm) hydriertem amorphem Si (a-Si:H) ebenfalls durch PECVD bei 175 °C auf dem p-Typ-SiNW-Kern erhalten. Die fertiggestellten Vorrichtungen wurden mit einer konformen Abscheidung von ITO fertiggestellt, die kreisförmige obere Kontakte mit einem Durchmesser von 4 mm bildete, die durch eine Maske während der Sputter-Abscheidung definiert wurden. Die vollständigen Details der Herstellung werden an anderer Stelle erklärt [1, 5,6,7].
Kelvin-Sonde und Oberflächenphotospannung
KPFM-Messungen können mit zwei verschiedenen Modi durchgeführt werden, Amplitudenmodulation (AM) und Frequenzmodulation (FM). Beide Modi ermöglichen es, den gleichen Eigenschaftswert der Kontaktpotentialdifferenz (CPD) zu erhalten, der zwischen der Spitze und der Oberfläche der Probe besteht. Der AM-Modus wurde in dieser Studie gewählt, da seine Messstabilität bei signifikanten Höhenunterschieden, wie sie am Rand der Nanodrähte der Probe beobachtet werden, größer ist.
KPFM- und SPV-Messungen wurden mit einem Rastersonden-Mikroskopiesystem von HORIBA/AIST-NT (TRIOS-Plattform) durchgeführt, das mehrere Vorteile bietet. Tatsächlich verwendet das laserstrahlbasierte Ablenksystem (LBBDS) für dieses Rasterkraftmikroskop (AFM) eine Laserwellenlänge von 1310 nm, die die möglichen photoelektrischen Wechselwirkungen mit der Probe minimiert [8,9,10] . Dies wird hier durch den Vergleich der mit dieser Plattform erfassten Daten mit denen eines AFM-Systems, das eine Wellenlänge von 690 nm für das LBBDS verwendet, hervorgehoben.
Die TRIOS-Plattform ist gut geeignet, um photoelektrische Eigenschaften von Materialien zu untersuchen, da sie drei Mikroskopobjektive enthält, die die Beleuchtung der Probe aus verschiedenen Richtungen (oben, seitlich und unten) ermöglichen. SPV-Messungen auf der Mikro-/Nanoskala werden hier durch Subtrahieren der CPD im Dunkeln von der CPD unter Beleuchtung erhalten. Diese Art von Messung wurde früher verwendet, um VOC . durchzuführen Messungen von Photovoltaikanlagen [5, 11]. Die Beleuchtung der Probe erfolgte unter Verwendung einer stabilisierten OXXUS-Laserdiode der Wellenlänge 488 nm mit einem variablen Leistungsmodul.
Für die angewandten Rastersondenmessungen wurden zwei Arten von leitfähigen AFM-Spitzen verwendet, das ARROW-EFM und das ATEC-EFM. Beide verfügen über einen dotierten Silizium-Cantilever und eine PtIr-Beschichtung. Ihr Unterschied liegt in ihrer Form mit einer konventionellen Spitzenform für den ARROW und einer geneigten Form für den ATEC.
Schließlich wurden SPV-Messungen im Nanobereich durch makroskopische Kelvin-Probe-Messungen mit der Möglichkeit der Variation der Beleuchtungswellenlänge ergänzt, um SPS-Messungen, also spektral aufgelöste SPV-Messungen, durchzuführen. Zu diesem Zweck wurde ein Kelvinsonden-Setup ASKP200250 von KPTechnology verwendet, das mit einer Stahlspitze von 2 mm Durchmesser ausgestattet war. Dieser Aufbau umfasst eine Beleuchtung von der Seite, die eine Halogenlampenquelle an einen Monochromator ankoppelt, der den Wellenlängenbereich von 400 nm bis 1000 nm abdeckt. Beachten Sie, dass diese Konfiguration keine SPV-Messungen bei konstantem Fluss erlaubt und aus diesem Grund nur qualitative Beobachtungen gemacht werden können.
Makroskopische I-V-Messungen kombiniert mit KPFM
Wie bereits erwähnt, bestand unser erster Ansatz darin, makroskopische I-V-Messungen an einem fertigen SiNW-RJ-Gerät durchzuführen. Zu diesem Zweck haben wir ein KEITHLEY 2450 SourceMeter und einen Mikropositionierer mit einer Wolframnadel verwendet, der es ermöglicht, das Gerät zu kontaktieren, während es sich unter dem AFM-Setup befindet, wie in Abb. 1 schematisiert.
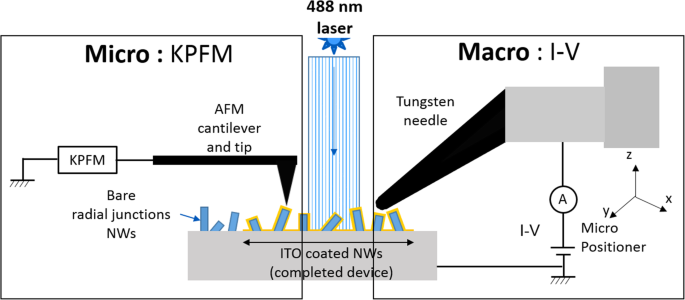
Schematische Darstellung des Messaufbaus sowohl für KPFM- als auch für makroskopische I-V-Messungen
I-V- und KPFM-Messungen wurden unter dunklen Bedingungen und dann unter Verwendung der gleichen Beleuchtung wie im vorherigen Unterabschnitt beschrieben, nämlich einer Laserquelle bei 488 nm mit einstellbarer Leistung, durchgeführt. Die Beleuchtung wurde von oben durch ein MITUTOYO 10X Objektiv realisiert und die Auflichtbeleuchtung im Bereich 70 -1000 µW kalibriert.
An den isolierten Geräten wurden außerdem KPFM-Messungen mit zwei Arten von AFM-Spitzen, ARROW und ATEC, durchgeführt. Die Beleuchtung der Probe während der Messung erfolgte aus zwei Richtungen, von oben und von der Seite, und mit der gleichen Nennleistung wie zuvor beim fertigen Gerät.
Ergebnisse und Diskussion
Vor Beginn der I-V- und KPFM-Messungen wurde der Einfluss des LBBDS des AFM untersucht. Tatsächlich wurde bereits gezeigt, dass die Wellenlänge des LBBDS eine signifikante Wechselwirkung mit photovoltaischen Proben haben kann [8,9,10] und so die Messungen der elektrischen Eigenschaften mit dem AFM beeinflussen kann. Abbildung 2 veranschaulicht die makroskopischen I‑V-Messungen eines abgeschlossenen SiNW RJ-Gerät unter dunklen Bedingungen (LBBDS ausgeschaltet) und bei eingeschaltetem LBBDS ausgeführt. Wie bereits erwähnt, wurden auch Messungen in einem anderen AFM-Aufbau mit einer Wellenlänge von 690 nm statt 1310 nm für das LBBDS durchgeführt. Die unter dunklen Bedingungen und mit dem LBBDS bei 1310 nm erhaltenen I-V-Kurven sind fast identisch. Nur beim Zoomen um den Ursprung kann man eine sehr kleine Verschiebung für die mit eingeschaltetem LBBDS durchgeführten Messungen beobachten, die durch sehr kleine Werte in Form von VOC . ausgedrückt werden kann (0,5 mV) und Kurzschlussstrom, ISC, (1 nA). Im Vergleich dazu zeigt die I-V-Kurve, die mit dem System mit einer Wellenlänge von 690 nm für das LBBDS gemessen wurde, einen signifikanten photovoltaischen Effekt mit Werten von VOC . und ISC von 545 mV bzw. 28 μA. Dies belegt deutlich die störende Wirkung eines LBBDS mit einer Laserwellenlänge im sichtbaren Bereich. Diese Ergebnisse zeigen die Schwierigkeiten, KPFM-Messungen unter realen Dunkelbedingungen durchzuführen, wenn insbesondere die LBBDS-Wellenlänge mit der Probe wechselwirken kann. Die nächsten illustrierten Ergebnisse wurden alle mit dem LBBDS des AFM bei 1310 nm durchgeführt, das im Unterabschnitt Kelvin-Sonde beschrieben ist.
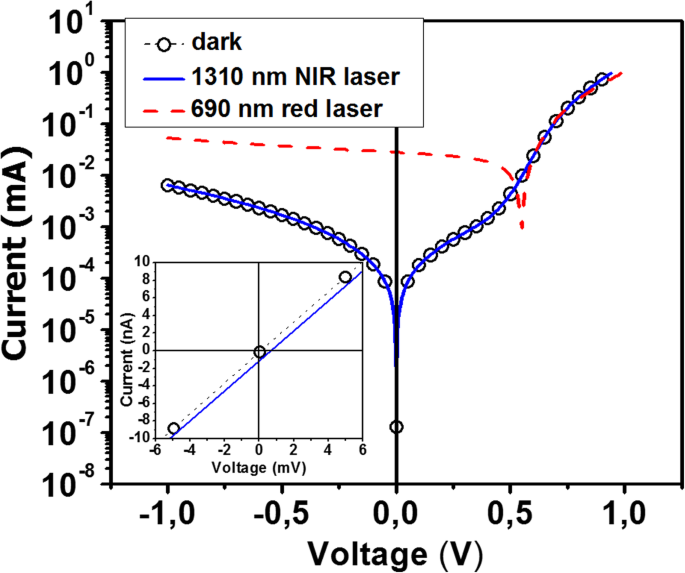
I-V-Kurven, erhalten an einem SiNW RJ-Gerät unter dunklen Bedingungen (schwarze Kreise), mit dem 1310-nm-Laserstrahl des TRIOS AFM (blaue durchgezogene Linie) und mit dem 690-nm-Laserstrahl des Enviroscope AFM (rote gestrichelte Linie). Das Hauptdiagramm veranschaulicht die log |I|-V-Kurven im Bereich − 1 V und + 1 V, und das Einfügungsdiagramm repräsentiert eine Vergrößerung der linearen I-V-Kurven zwischen − 5 mV und + 5 mV
Ein Beispiel einer photovoltaischen Messung in einem fertiggestellten SiNW RJ-Gerät ist in Abb. 3 dargestellt. Insbesondere makroskopische I-V-Messungen unter verschiedenen Beleuchtungsleistungen (70, 150, 270 und 560 μW) sind in Abb. 3.a dargestellt. Die I-V-Kurven zeigen ein typisches PV-Zellen-Betriebsverhalten, bei dem ISC und VOC mit der einfallenden Lichtleistung zunehmen. Abbildung 3.b zeigt ein Beispiel für ein KPFM-Mapping, das von links nach rechts die Topographie, die CPD bei Dunkelheit und die CPD bei 488 nm Beleuchtung darstellt. Der Topographie-Scan zeigt NWs mit Höhen von mehreren Hundert Nanometern und einer Dichte pro Flächeneinheit von etwa 10 9 cm -2 . Die CPD-Scans zeigen lokale Potentialschwankungen von etwa ±10 mV, die hauptsächlich an den NW-Rändern auftreten. Diese Variationen können aufgrund der schnellen Änderung der Topographie, die die AFM-Spitze während der Scanbewegung durchmacht, als Artefakte betrachtet werden, und insbesondere, wenn sie zwischen zwei NWs passiert. Die Orte, die von solchen Artefakten ausgenommen sind, sind die Spitzen der NWs, wo die Höhenänderung der Topographie vernachlässigbar bleibt. Alle im Folgenden dargestellten CPD-Werte wurden oben in den NWs extrahiert.
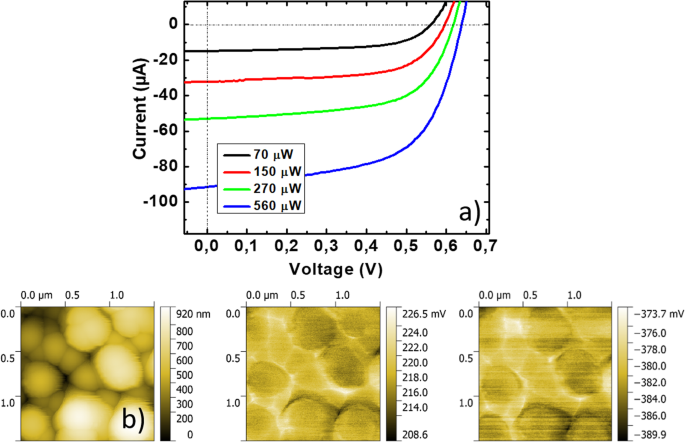
a Makroskopische I-V-Kurven, gemessen unter verschiedenen Beleuchtungsstärken (66, 5, 149, 268 und 555 µW bei 488 nm); b von links nach rechts:Topographie, CPD unter dunklen Bedingungen bzw. CPD unter Beleuchtung (270 μW bei 488 nm)
Abbildung 4 vergleicht die VOC und SPV-Werte, die aus den makroskopischen I-V- und den KPFM-Messungen als Funktionen der einfallenden Beleuchtungsleistung extrahiert wurden. Dieser Vergleich wurde für zwei verschiedene fertige Geräte durchgeführt und in einer halblogarithmischen Skala dargestellt. Der maximale Unterschied zwischen den Voc- und SPV-Kurven beträgt weniger als 5 % bei der niedrigsten Beleuchtungsleistung (~70 μW) und wird weniger als 2 % bei einer höheren Beleuchtungsstärke. Es ist wichtig zu beachten, dass der Fehlerbalken, der mit der experimentellen Bewertung der auftreffenden Lichtleistung verbunden ist, zunimmt, wenn die Beleuchtungsleistung abnimmt, was den Unterschied von 5 % zwischen VOC . erklären kann und SPV bereits erwähnt. Für beide Grafiken sind SPV und VOC Werte folgen einem logarithmischen Verhalten mit Werten im Bereich von 500-600 mV. Die Steigungen von Voc und SPV ergeben einen Idealitätsfaktor (n) von 1,5 ± 0,1 für Gerät 1 bzw. 1,75 ± 0,25 für Gerät 2. Diese Werte stimmen gut mit Werten überein, die in der Literatur für den a-Si:H-P-I-N-Übergang angegeben wurden und im Bereich von 1,5-2 liegen [12,13,14]. In Abb. 5 veranschaulichen wir Messungen von SPV im Vergleich zur Lichtleistung, die an isolierten SINW RJ-Geräten durchgeführt wurden. Der Begriff isoliert bezieht sich hier darauf, dass die Nanodraht-RJs nicht mit ITO bedeckt sind, also nicht durch die oberste leitfähige Schicht elektrisch verbunden sind. Als Anhaltspunkt wurde die zuvor für das fertige RJ-Gerät in Abb. 4.a erhaltene SPV-Kurve auch in Abb. 5 gezeigt. Die angegebenen SPV-Werte entsprechen einem Durchschnittswert aus mehreren NWs für Scangrößen von 3x3 µm². Die SPV-Messungen an isolierten Geräten wurden zuerst mit einer pfeilförmigen AFM-Spitze (ARROW-EFM) und einer Beleuchtung von oben durchgeführt, genau wie die SPV-Messung am fertigen Gerät. Die sehr niedrigen SPV-Werte dieser Kurve (Abb. 5.a, Quadrate) sowie ihre Steigung unter 1 (~0,4) deuten auf einen Abschattungseffekt durch die AFM-Spitze hin. Tatsächlich ermöglichte es uns, die gleiche Oberlichtbeleuchtung beizubehalten und die AFM-Spitze durch eine geneigte Sonde (ATEC-EFM) zu wechseln, einen Anstieg der SPV-Werte um 40 % für den gleichen Beleuchtungsleistungsbereich (Abbildung 5.b, Dreieck). Ähnliche Ergebnisse wurden erzielt, wenn die Beleuchtung von oben auf die Seite gewechselt und die AFM-Spitze ATEC durch die ursprüngliche AFM-Spitze ARROW ersetzt wurde (Abb. 5.c, blaue Punkte). Obwohl die SPV-Werte im Vergleich zu den Messungen mit Top-Beleuchtung und ARROW-EFM-Spitze deutlich angestiegen sind, bleiben sie unter dem Referenzwert bei ähnlichen Steigungen (~1.3-1.4). Beachten Sie, dass dieser Schatteneffekt bei fertigen Geräten nicht beobachtet werden konnte, da das SPV für diese Konfiguration die Photospannung des gesamten Geräts abbildet:Tausende von Nanodrähten, die durch den ITO-Frontkontakt miteinander verbunden sind.
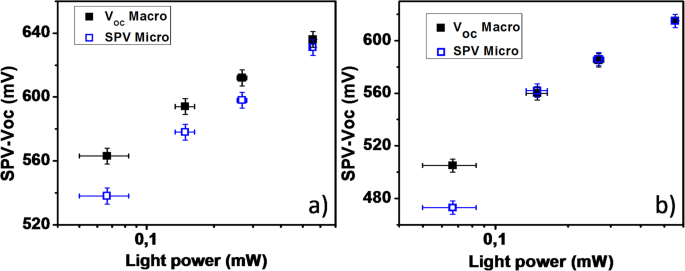
V OK und SPV versus Lichtleistung für zwei verschiedene Geräte:dev 1 (a ) und dev 2 (b )

SPV im Vergleich zur Lichtleistung, die an isolierten RJ-NWs erhalten wurde. Die Messungen wurden mit unterschiedlichen AFM-Spitzenformen (ARROW-EFM und ATEC-EFM) und unterschiedlichen Beleuchtungsrichtungen (oben und seitlich) durchgeführt. Das Referenz-RJ-Gerät bezeichnet das in Fig. 4a dargestellte Gerät 1 . Das AFM-Bild unten rechts zeigt ein Beispiel für die Topographie, die auf isolierten NWs gemessen wurde
Um diese Ergebnisse zu ergänzen, wurde eine qualitative SPS-Analyse über einer Reihe isolierter Geräte und dann über einem fertigen Gerät durchgeführt. Abb. 6.a zeigt die erhaltenen SPV-Spektren mit deutlichen Unterschieden über das gesamte Spektrum. Es ist interessant zu betonen, dass das fertige Gerät ein vernachlässigbares SPV (~10 mV) im nahen Infrarot (NIR) zeigt, wobei ein SPV-Schwellenwert bei etwa 800 nm liegt und unterhalb dessen der SPV schnell ansteigt und ein Maximum von 560 mV bei 630 erreicht nm. Umgekehrt zeigt das Bündel isolierter Geräte einen signifikanten SPV von 80–260 mV im NIR (800–1000 nm), der mit abnehmender Wellenlänge allmählich auf bis zu 435 mV für 665 nm ansteigt. Unterhalb von 665 nm und 630 nm nehmen beide SPV-Kurven mit abnehmender Wellenlänge ab, was mit der erwarteten Abnahme der Bestrahlungsstärke der in diesem Aufbau verwendeten Halogenlampe zusammenhängen kann (wie oben erwähnt, basiert der SPS-Ansatz hier auf qualitativen Messungen, da der Fluss nicht konstant gehalten werden). In einem zweiten Ansatz wurden SPS-Messungen an einem fertiggestellten Gerät durchgeführt und nach lokalem Entfernen des ITO-Oberkontakts mit 1%iger HF-Lösung als Tropfen auf das Gerät aufgetragen. Abbildung 6.b veranschaulicht diese Messungen, und die SPV-Spektren wurden speziell direkt nach dem Entfernen von ITO und 72 Stunden später gesammelt. Das Entfernen der ITO-Schicht hat im Vergleich zum fertigen Gerät einen großen Einfluss auf das SPV-Spektrum. Eine starke Abnahme des SPV-Signals wird im Bereich von 400-750 nm direkt nach der ITO-Entfernung beobachtet. Nach 72 Stunden stabilisiert sich das SPV-Signal auf einem höheren Niveau, das sich je nach Wellenlänge um mehr als den Faktor 2 unterscheiden kann. Es zeigt sich auch, dass das SPV-Signal bei längeren Wellenlängen (> 750 nm) leicht ansteigt. Ein Vergleich der SPV-Spektren von Abb. 6 zeigt, dass die NW-Bauelemente nach der in Abbildung 6.b dargestellten ITO-Entfernung und insbesondere nach 72-stündiger Stabilisierung einen ähnlichen Zustand aufweisen wie die in Abb. 6.a als Bündel isolierter NWs bezeichneten. letztere hatte noch nie eine ITO-Beschichtung. Eine weitere wichtige Beobachtung betrifft das bei 488 nm gemessene SPV-Signal, dessen Wert für eine Reihe isolierter NWs um den Faktor 1,7 niedriger ist als für ein fertiges Gerät. Diese Beobachtung unterstützt die SPV-Ergebnisse von Fig. 5, die von KPFM an isolierten NW-RJs mit einer Beleuchtung bei 488 nm durchgeführt wurden. Tatsächlich waren die gemessenen SPV-Werte trotz der Optimierung der AFM-Spitzenform und der Beleuchtungsbedingungen auch niedriger als die des fertigen Geräts, um einen Faktor, der je nach Beleuchtungsleistung zwischen 1,5 und 2 variierte.
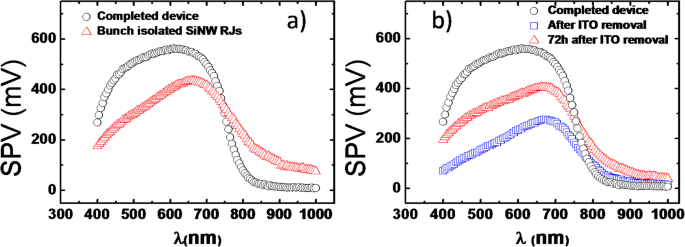
SPS-Messungen durchgeführt an a ein fertiges Gerät und eine Reihe isolierter SiNWs; b ein fertiges Gerät, direkt nach dem Entfernen von ITO und 72 Stunden später
Die Ergebnisse von Fig. 6 zeigen deutlich, dass der obere ITO-Kontakt erforderlich ist, um höhere SPV-Werte zu entwickeln (d. h. VOC ) und insbesondere bleibt der Kernpunkt die Schnittstelle (n) a‑Si:H/ITO. Diese Grenzfläche zeichnet sich durch eine sehr dünne n-leitende a-Si:H-Schicht (~ 10 nm) aus, um die optische Übertragung zu begünstigen. Das Dotierungsniveau dieser Schicht und die ITO-Austrittsarbeit können insbesondere die vollständige Verarmung der a-Si:H-Schicht bewirken. Somit kann ein plötzlicher Potentialabfall an der Grenzfläche stattfinden, bevor ein Flachbandpotential im ITO erreicht wird. Ein solcher Potentialabfall an der Grenzfläche zum ITO-Oberkontakt wurde bereits in P-I-N a-Si:H-Strukturen veranschaulicht, die durch SPV-Profiling analysiert wurden [12, 15]. Dieselben Grenzflächen mit ultradünnen a-Si:H-Schichten wurden auch in der Solarzellentechnologie des a-Si:H/kristallinen Si-Heteroübergangs untersucht, wobei noch einmal der Einfluss des Dotierungsniveaus und der Dicke der a-Si:H-Schicht auf die V . hervorgehoben wurde OK mit und ohne ITO [16, 17].
Die vorherigen Überlegungen deuten darauf hin, dass die lokale SPV-Analyse von KPFM an isolierten NW-RJs den optimalen Wert von VOC . nicht quantitativ widerspiegeln kann aufgrund des Fehlens von ITO. Das extrahierte lokale VOC wird hier durch die Oberflächenbandbiegung als Folge der vollständigen Verarmung der n-leitenden a-Si:H-Schicht und deren Oxidationsoberflächenzustand eingeschränkt. Der gemessene SPV beinhaltet nicht nur den VOC aber auch die photoinduzierte Bandkrümmungsänderung nahe der Oberfläche der n-Typ a-Si:H-Schicht [18].
Schlussfolgerung
Fertige Geräte auf Basis von RJ-SiNWs wurden gemeinsam unter Beleuchtung durch I-V- und KPFM-Messungen analysiert. Dieser erste Vergleich, der für verschiedene Beleuchtungsstärken durchgeführt wurde, zeigt, dass die aus KPFM extrahierten lokalen SPV-Werte sehr nahe am VOC . liegen Werte aus der I-V-Analyse erhalten. Lokale SPV-Messungen an isolierten RJ-SiNWs zeigen dagegen einen signifikanten Unterschied zum vorherigen VOC Werte. Es wurde ein Schatteneffekt der AFM-Spitze nachgewiesen und minimiert, indem sich die Spitzenform und/oder die Beleuchtungsorientierung änderten. Die optimierten SPV-Werte von isolierten RJ-SiNWs zeigen ein logarithmisches Verhalten mit der Beleuchtungsleistung, bleiben aber deutlich unter dem VOC Referenzwerte. SPS-Analysen, die an Bündeln isolierter SiNW-Bauelemente durchgeführt wurden, zeigen das Fehlen der Grenzfläche (n) a-Si:H /ITO als Ursache für den Potenzialverlust, und zwar insbesondere, weil die untersuchten isolierten SiNW-Bauelemente kein ITO als oberen Kontakt haben. Trotzdem zeigt das lokale SPV, das auf isolierten SiNW-Geräten unter verschiedenen Beleuchtungsbedingungen extrahiert wurde, eine lineare Übereinstimmung mit dem VOC an fertigen Geräten gemessen, was insbesondere bestätigt, dass das lokale SPV den VOC . spiegeln kann .
Verfügbarkeit von Daten und Materialien
Die in der aktuellen Studie verwendeten und/oder analysierten Datensätze sind auf begründete Anfrage beim entsprechenden Autor erhältlich.
Abkürzungen
- AFM:
-
Rasterkraftmikroskopie
- AM:
-
Amplitudenmodulation
- a-Si:H:
-
Hydriertes amorphes Silizium
- Cg:
-
Corning-Glas
- CPD:
-
Kontaktpotentialdifferenz
- FM:
-
Frequenzmodulation
- ITO:
-
Indium-Zinn-Oxid
- I-V:
-
Strom-Spannung
- KPFM:
-
Kelvin-Sondenkraftmikroskopie
- LBBDS:
-
Laserstrahlbasiertes Ablenksystem
- n:
-
Idealitätsfaktor
- NW:
-
Nanodraht
- PECVD:
-
Plasmaunterstützte chemische Gasphasenabscheidung
- PV:
-
Photovoltaik
- RJ:
-
Radialer Anschluss
- SiNW:
-
Silizium-Nanodraht
- SPS:
-
Oberflächen-Photospannungsspektroskopie
- SPV:
-
Oberflächenphotospannung
- V OK :
-
Leerlaufspannung
Nanomaterialien
- Abbildung von Atomen auf 2D-Atomkristallen in Flüssigkeiten
- Materialwissenschaftler bringen Nanodrähten das Tanzen bei
- Plasmonenverstärkte Lichtabsorption in (p-i-n) Junction-GaAs-Nanodraht-Solarzellen:Eine FDTD-Simulationsmethodenstudie
- Amorphe Silizium-Nanodrähte, die durch Glühen auf Siliziumoxid-Film gewachsen sind
- Theoretische Untersuchung von biaxial zugbelasteten Germanium-Nanodrähten
- Untersuchung der Adhäsionskraft und des Glasübergangs dünner Polystyrolfolien durch Rasterkraftmikroskopie
- Ultraviolettlicht-unterstützter Wasserstoff-Gassensor aus Kupferoxid-Nanodrähten
- Niedrigtemperatur-Reduktion von Graphenoxid:Elektrische Leitfähigkeit und Rasterkraftmikroskopie mit Kelvin-Sonde
- Potenzieller Einbruch in der organischen Photovoltaik, untersucht durch Kelvin-Querschnittskraftmikroskopie
- Was ist Radialkraft?



