Hochgeschwindigkeits- und richtungsgesteuerte Bildung von Silizium-Nanodraht-Arrays unterstützt durch ein elektrisches Feld
Zusammenfassung
Metallunterstütztes chemisches Ätzen (MaCE), ein kostengünstiges und vielseitiges Verfahren, wurde als vielversprechende Technik zur Herstellung von Silizium-Nanodrähten (SiNWs) angesehen, doch das Fehlen einer gut kontrollierten Bohrung in das Si könnte die Ätzrate reduzieren und die unerwünschte Seitenwand erzeugen Ätzen und verschlechtern die strukturelle Gleichmäßigkeit. Hier wurde in dieser Studie der vorspannungsmodulierte MaCE-Prozess durchgeführt, der die Ätzraten zeigt, die mehr als viermal höher sind als die von typischen vorspannungsfreien MaCE mit großflächiger Gleichmäßigkeit. Es zeigte sich, dass die feldvermittelte Lochgleichrichtung den Effekt der verzögerten Diffusivität von reaktiven Ionen überwältigt und somit die Dynamik des verteilten Ätzens auf das gerichtete Ätzverhalten übertragen wurde. Außerdem könnte die Ätzorientierung auch mit der externen Vorspannung manipuliert werden. Die Ergebnisse zeigten, dass die Ätzrichtung durch Variieren der elektrischen Polarisation in Richtung der schrägen Strukturen umgeschaltet wurde, wodurch die speziellen schrägen/vertikalen NW-Arrays erzeugt wurden, die überlegene Antireflexionseigenschaften aufwiesen als die herkömmlichen vertikal ausgerichteten Strukturen.
Einführung
Niedrigdimensionale Silizium(Si)-Nanostrukturen zeigten bemerkenswerte elektronische, mechanische und optoelektronische Eigenschaften, die als Bauelemente für funktionelle Geräte und Anwendungen dienen könnten [1,2,3], wie Feldeffekttransistoren, Biosensoren und Photovoltaikzellen [4 ,5,6,7,8,9]. Um die regelmäßigen Anordnungen von Si-Nanostrukturen zu bilden, wurde metallunterstütztes chemisches Ätzen als die vorherrschende Strategie angesehen, die sogar die Bildung von Si-Nanodraht-(SiNW)-Anordnungen auf planaren Substraten [10, 11], Pulvern [12, 13] und pyramidalen Strukturen ermöglichte [14]. Beim Ätzprozess erfolgten die Lochinjektionen über Metallkatalysatoren in Richtung darunterliegendes Si und anschließend die Auflösung von oxidiertem Si kontinuierlich, was zu den langen Ätzporen führte. Die erzeugten Löcher könnten jedoch innerhalb der Si-Matrix diffundieren, anstatt sich immer vertikal in Bezug auf die Substratebene zu bewegen; es verursachte normalerweise die Bildung zahlreicher Si-Nanoporen in der Nähe der primären Ätzstellen, was die unkontrollierbaren Ätzprofile hinterließ [15]. Diese Eigenschaft erwies sich als besonders offensichtlich, während die Lösungen eine hohe Viskosität aufwiesen.
Das Fehlen einer guten Kontrolle der injizierten Löcher in Si könnte die praktische Anwendung von Si-Nanostrukturen für den praktischen Gebrauch behindern.
Um dieses anspruchsvolle Thema zu meistern, schien der Einsatz des externen Bereichs erfolgversprechend. Liyi Li et al. zeigten, dass die regulären Loch- oder Streifenarrays mit hohem Aspektverhältnis (> 10:1) durch die Verwendung von elektrisch vorspannungsgedämpftem MaCE realisiert werden können, aber die Merkmalsabmessungen lagen im Mikromaßstab [16]. Inspiriert von dieser Arbeit haben wir in dieser Studie versucht, die Machbarkeit der Herstellung von SiNW-Arrays durch Anwendung von Bias während des MaCE-Prozesses zu untersuchen. Sowohl positive als auch negative Vorspannungen wurden untersucht, um die feldabhängige Ätzkinetik zu verstehen. Neben der Ätzrate stellten wir fest, dass die Ätzorientierung moduliert werden konnte, wobei die Dual-Segment-SiNWs in Form von schrägen/vertikalen Strukturen durch Abstimmung der Vorspannungsrichtung realisiert wurden. Der zugrunde liegende Ätzmechanismus und die Ätzkinetik in Gegenwart eines elektrischen Feldes wurden untersucht, und die überlegenen Antireflexionseigenschaften der einzigartigen schrägen/vertikalen SiNW-Arrays wurden sowohl in experimentellen als auch in simulierten Analysen präsentiert.
Methoden
Substratvorbereitung
Als Ausgangsmaterialien wurden die einkristallinen (100), einseitig polierten Si-Substrate mit einer Dicke von 525 µm verwendet. Die Si-Substrate wurden mehrere Zyklen lang in Isopropylalkohol, Aceton und entionisiertem Wasser ultraschallgereinigt und dann in SC-1-Lösung (1 Teil NH4 .) weiter gereinigt OH, 1 Teil H2 O2 , und 5 Teile entionisiertes Wasser) für 30 Minuten, um die Oberflächen zu reinigen, was zu hydrophilen Oberflächen führte.
Nanosphären-Lithografie
Um die hochgeordneten ausgerichteten Nanostrukturen herzustellen, wurde Nanosphärenlithographie (NSL) durchgeführt. Im Wesentlichen werden Polystyrol-Nanosphären (PSs) mit Durchmessern von 300 nm langsam dispergiert und in den hexagonal dicht gepackten Strukturen an den Luft/Wasser-Grenzflächen in der Petrischale angeordnet und dann direkt auf die Si-Substrate übertragen. Die Größenschrumpfung von großflächigen und einheitlichen PSs wurde durch den Einsatz von Sauerstoffplasma mit einer Leistung von 100 W unter einem Prozessdruck von 200 mTorr erreicht. Die Ätzzeit wurde auf 120 s eingestellt und der Sauerstofffluss wurde auf 12 sccm gehalten. Anschließend wurde ein 30-nm-Silberfilm unter Verwendung eines Elektronenstrahlverdampfers mit einer Geschwindigkeit von 0,3 /s unter einer Vakuumbedingung von 7,0 × 10 –6 abgeschieden Torr. Danach wurden die verbleibenden PSs durch 2 h Beschallung in Toluol vollständig entfernt, was zur Bildung eines gemusterten Silbergitters auf Si-Substraten führte.
Herstellung von Si-Nanodrähten
Die gereinigten Si-Substrate wurden mit Kupferbändern als Elektroden als Ober- und Rückseite beklebt und mit einer Stromversorgung zum Anlegen des elektrischen Feldes verbunden. Die angelegten Spannungen wurden innerhalb von 40 V bis 40 V eingestellt. Die Si-Substrate mit den Beladungen von entweder Ag-Nanopartikeln oder strukturierten Ag-Schichten wurden gebildet, wenn sie in eine Ätzmischung bestehend aus HF (49%), H2 O2 (30 %) und DI-Wasser mit den Konzentrationen von 4 M bzw. 0,28 M [17,18,19,20]. Nach Durchführung des Ätzprozesses wurden die restlichen Ag-Schichten mit dem konzentrierten HNO3 . entfernt (65%)
Charakterisierungen
Morphologien von Nanodrähten wie gebildet wurden durch Feldemissions-Rasterelektronenmikroskopie (REM, LEO 1530) charakterisiert. Die Kontaktwinkelanalyse wurde unter Verwendung eines Theta Lite (TL101) erhalten. Das Lumineszenzverhalten von SiNWs wurde durch ein photolumineszentes (PL)-System charakterisiert, das mit einer Leuchtdiodenlampe (Ausgangsleistung:780 mW) ausgestattet war und die Wellenlänge der Lichtquelle 365 nm betrug. UV/Vis-Reflexionsspektren wurden mit einem UV-vis-NIR-Spektrophotometer (Varian, Cary 5000, Australien) aufgezeichnet. Das optische Reflexionsvermögen wurde mit der Finite-Differenz-Zeitdomäne (FDTD) simuliert, wobei die perfekt angepasste Grenze entlang der Beleuchtungsrichtungen ausgewählt wurde.
Ergebnisse und Diskussion
Vergleiche von typischem MaCE und vorspannungsunterstütztem MaCE, das auf den Ag-beladenen Si-Substraten verwendet wird, sind in Abb. 1a dargestellt. Es konnte festgestellt werden, dass die H2 O2 Oxidationsmittel lieferten die Löcher, die in Richtung Si diffundierten, unterstützt durch die vorhandenen Ag-Katalysatoren. Die Injektion von Löchern erfolgte jedoch nicht immer in unidirektionaler Ausrichtung, sondern verteilte sich aufgrund der ungleichmäßigen Facetten von AgNPs in Kontakt mit Si, wie in Abb. 1a gezeigt. Diese Merkmale verursachten explizit den Verlust von Löchern, die nicht zur gerichteten Auflösung von Si für die NW-Bildung beitragen konnten, sondern stattdessen verteilt waren und leicht zur Bildung poröser Strukturen führen könnten. Im Gegensatz dazu könnte die Verwendung einer Vorwärtsspannung (+ 10 V) in vertikaler Anordnung in Bezug auf die Substratebenen die Ätzkinetik dramatisch verändern. Das korrelierte Design von feldangewandtem MaCE wurde schematisch in Zusatzdatei 1 dargestellt:Abbildung S1. Tatsächlich erzwang das beteiligte Polarisationspotential alle Löcher, die entlang der Orientierung des angelegten Feldes diffundierten, was auf die erhöhten Ätzraten (260 nm/min) (Abb. 1c) im Vergleich zum typischen MaCE-Prozess (220 nm/min) reagierte (Abb. 1b). Die Variation der positiven Vorspannung, die innerhalb des MaCE-Prozesses angelegt wird, könnte daher zu einer Änderung der Ätzraten führen, wie in Zusatzdatei 1:Abbildung S2 gezeigt, wo sie deutlich die Lochkorrektur von MaCE zeigt, da die positive Vorspannung beteiligt war.
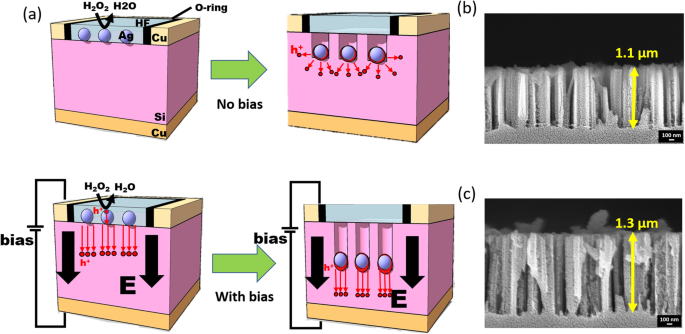
a Schematische Darstellungen der typischen MaCE (Abbildung oben) und der Bias-unterstützten MaCE (Abbildung unten). SEM-Querschnittsbilder von SiNWs von b typisches MaCE und c Bias-unterstützter MaCE (+ 10 V)
Andererseits war ein solcher feldunterstützter Effekt auch gültig, während der MaCE-Prozess der negativen Vorspannung ausgesetzt war. Abbildung 2a zeigte die entgegengesetzte Gleichrichtung der Lochdiffusion in Bezug auf den Lochinjektionspfad, die die effektive Auflösung von Si durch Einschränken der Löcher in mikroskopischen Ag-Elektroden verhinderte und zu einer verringerten Ätzrate (180 nm/min) führte. Darüber hinaus wurde der Gesamtbereich der angelegten Vorspannung auf die Ätzrate von MaCE-Reaktionen in 2b gezeigt. Es zeigte den Übergang der Ätzkinetik in Bezug auf die Polarisation der beteiligten Vorspannung. Die negative Vorspannung verursachte eindeutig die Verringerung der Ätzrate, während die positive Vorspannung bei + 10 V das wirksame Ätzen des Si-direktionalen Durchloch-Gleichrichtungseffekts erleichterte und die allmähliche Erhöhung der Ätzrate widerspiegelte. Bei größerer Vorspannung wurden zusätzlich zur Lochgleichrichtung möglicherweise die neu erzeugten Löcher eingeführt, die beim gerichteten Ätzen von Si beteiligt waren, was mit dem Anodisierungseffekt korreliert war [21, 22]. Ein solcher Effekt kontrollierte hauptsächlich die Ätzkinetik und steigerte somit die Ätzraten dramatisch um mehr als das Vierfache derjenigen eines typischen vorspannungsfreien MaCE. Wir konnten daher schlussfolgern, dass die kombinierten Effekte von Lochgleichrichtung und Anodisierung auf Si auftraten, die die Ätzkinetik und das korrelierte Verhalten modulieren könnten.
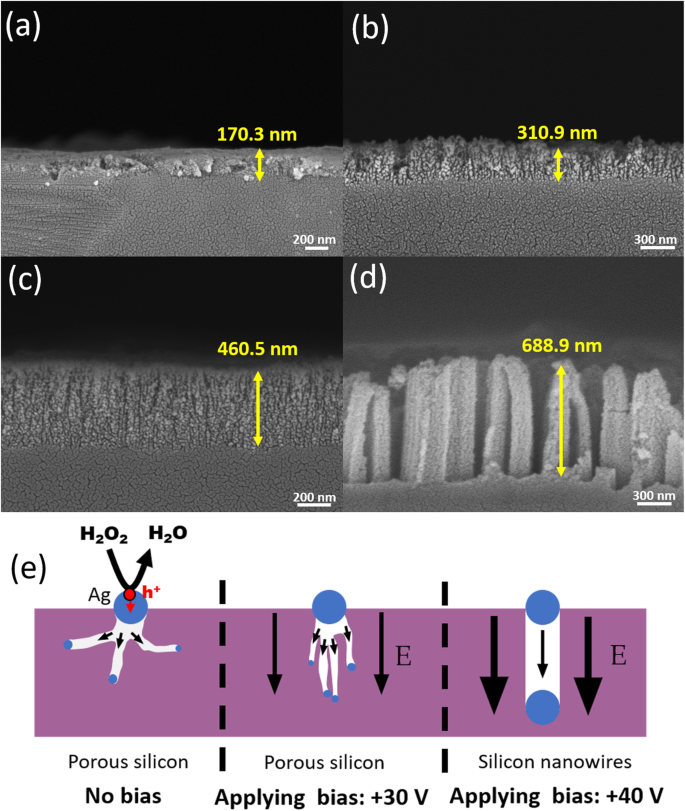
a SEM-Querschnittsbild von SiNWs, erhalten von einem vorspannungsunterstützten MaCE mit einem angelegten elektrischen Feld von − 10 V. b Zusammenhang von angelegter Spannung und entsprechender Ätzrate für die Bildung von SiNWs
Um die vorspannungsmodulierte Kinetik der MaCE-Reaktion weiter aufzuklären, wurden die vergleichsweise hochviskosen Lösungen verwendet. Dies wurde durch Mischen von Ätzreagenzien in 90% der IPA-Lösungsmittel erreicht. Die Beziehung zwischen dem Diffusionskoeffizienten und der Viskosität könnte wie folgt ausgedrückt werden [23],
$$ \mathrm{D}=\mathrm{AT}/{\upeta}^{\mathrm{p}} $$ (1)in denen D ist der Diffusionskoeffizient, A ist die empirische Konstante, T die Temperatur, η die Viskosität des Lösungsmittels und p der Viskositätsexponent. Dementsprechend beträgt die Viskosität des IPA-Lösungsmittels 2,1 mPa s bei 25 ° C, die mehr als 2,3 mal höher ist als die von Wasser (Viskosität =0,9 mPa s). Daher kann man erwarten, dass die Ionendiffusionsgrade von H2 O2 und F–-Ionen im IPA-Medium waren viel niedriger als im Wasserzustand. Wie in Fig. 3a angedeutet, wurden die dünnen porösen Strukturen mit einer Dicke von 170,3 nm unter einer 5-minütigen Ätzung erzeugt, wenn keine Vorspannung verwendet wurde. Dies wurde durch die Tatsache beigetragen, dass die beteiligten IPA-Lösungsmittel eine große Viskosität besaßen, die die Löcher in einer zufälligen Orientierung ausbreiten sollte, und somit wurden eher poröse Strukturen als eindimensionale Strukturen gebildet. Um die Ladungsakkumulation zum Einleiten des vertikalen Ätzens von Si zu erleichtern, wurden die verschiedenen positiven Vorspannungen eingeführt, wie in Abb. 3b–d gezeigt. Es sollte beachtet werden, dass bei geringer beteiligter Vorspannung, einschließlich + 20 V und + 30 V, die Filmdicke poröser Strukturen deutlich erhöht wurde, was zu erhöhten Ätzraten von 34,0 nm/min (0 V), 62,2 nm/min (+ 20 V) in Richtung 92,1 nm/min (+ 30 V).
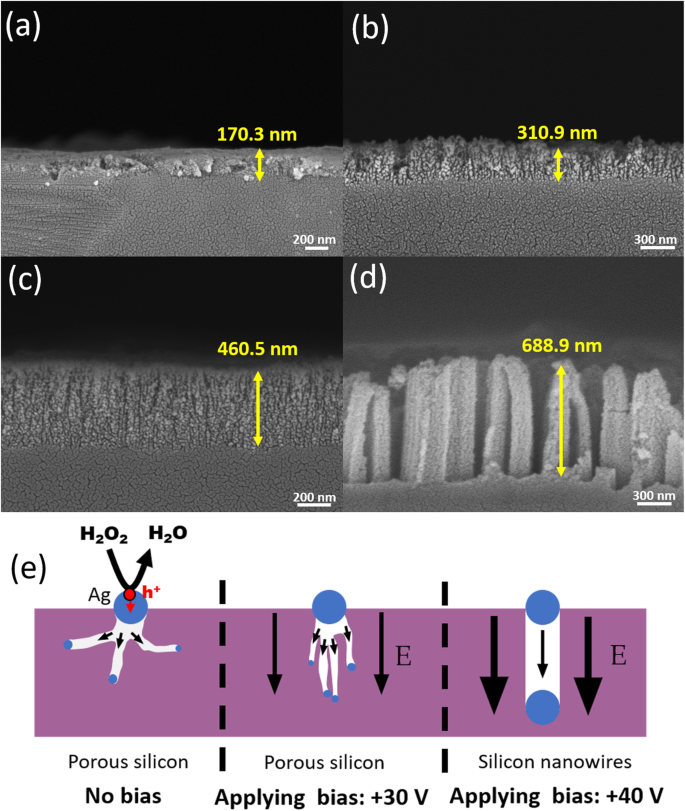
SEM-Querschnittsbilder von Si-Nanostrukturen von a MacE ohne Voreingenommenheit, b MaCE mit + 20 V, c MaCE mit + 30 V und d MaCE mit + 40 V. e Schematische Darstellungen der Nanostrukturbildung unter verschiedenen Vorspannungsbedingungen
Diese Ergebnisse bestätigten den Effekt der Vorspannung, der im Wesentlichen die Ätzkinetik dominiert, wobei angenommen wurde, dass die meisten der getrennten Löcher gesammelt und direkt unter den Stellen von Ag-Katalysatoren angesammelt wurden, wodurch die tieferen Ätzmorphologien initiiert wurden. Wenn die angelegte Vorspannung auf + 40 V erhöht wurde, stellte sich heraus, dass die feldvermittelte Lochgleichrichtung die Einflüsse auf die verzögerte Diffusivität reaktiver Ionen überwiegt, die Dynamik des zufälligen und verteilten Ätzens wurde daher auf das gerichtete Ätzverhalten übertragen; die vertikal ausgerichteten SiNW-Arrays wurden realisiert, die unter diesen vier Testbedingungen die höchsten Ätzraten bis zu 137,8 nm/min zeigten, wie in Abb. 3d dargestellt. Der unterschiedliche Bildungsmechanismus in Bezug auf die angelegte Vorspannung kann aus Fig. 3e verstanden werden. Es zeigte, dass die isotropen Diffusionswege von Löchern zur Bildung des dünnen porösen Films führten, wenn keine Vorspannung eingeführt wurde. Im Gegensatz dazu wurde der relativ anisotrope Lochtransport unter Beteiligung einer moderaten Vorspannung festgestellt, wobei sich die erzeugten Poren schließlich entlang der Vorspannungsorientierung bewegten und die Merkmale mehrerer Poren begründeten. Bei einer hohen Vorspannung wurden die injizierten Löcher gezwungen, sich an den Grenzflächen zwischen Katalysator und Si anzusammeln und sich dem Polarisationsfeld folgend synergistisch in das Si zu bewegen, wodurch die vertikal geätzten Profile erzeugt wurden.
Darüber hinaus wurde die Oberflächenbenetzbarkeit von präparierten Si-Texturen untersucht, wobei alle Proben sechsmal an verschiedenen Positionen gemessen wurden, wie in Abb. 4 dargestellt. Es wurde berichtet, dass der gemessene Kontaktwinkel mit der Rauheit von Nanostrukturen gemäß zu der unten gezeigten Gleichung [24, 25],
$$ \mathrm{cos}\uptheta ={\mathrm{Rfcos}\uptheta}_{\mathrm{e}}-\mathrm{R}\left(1-\mathrm{f}\right) $$ (2 )in denen θ und θ e sind die Kontaktwinkel von rauen bzw. flachen Si-Oberflächen und R stellt den Rauheitsfaktor dar. Außerdem f ist der Flächenanteil der Luft/Wasser-Oberflächen. Es konnte festgestellt werden, dass die durchschnittlichen Kontaktwinkel von vier verschiedenen Proben 109,8 0 . betrugen ± 10,8 0 beim Ätzen ohne Vorspannung 108.4 0 ± 9,2 0 mit + 20 V Vorspannung, 105,4 0 ± 7,6 0 mit + 30 V Vorspannung und 103,6 0 ± 1,6 0 mit + 40 V Vorspannung, wie in Abb. 4 gezeigt. Die stark reduzierte Abweichung beim gemessenen Kontaktwinkel von der Verwendung von + 40 V könnte auf die relativ gleichmäßige Topographie auf geätzten Oberflächen zurückgeführt werden, was darauf hindeutet, dass die Nutzung der Vorspannung in MaCE ermöglichte es nicht nur, die Ätzrate zu erhöhen, sondern konnte auch die für die praktische Anwendung wesentliche Gleichmäßigkeit des Ätzens aufrechterhalten.
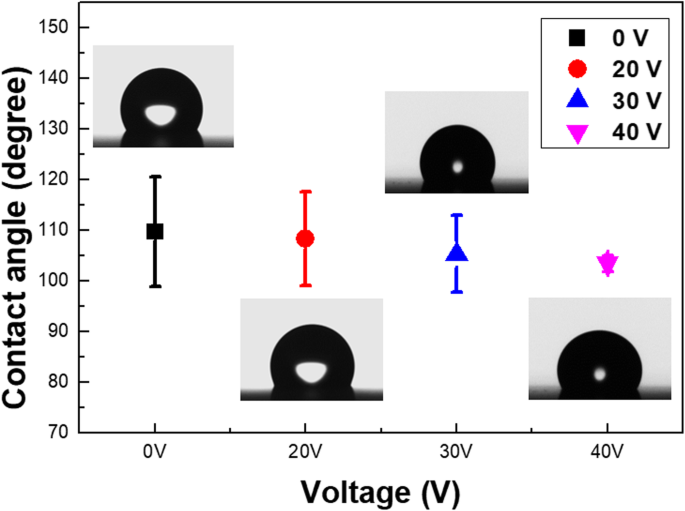
Kontaktwinkelmessergebnisse von Si-Oberflächen
Zusätzlich zur Modulation der Ätzraten könnte die Ätzorientierung auch mit der externen Vorspannung manipuliert werden, wie in Fig. 5a gezeigt. In diesem Test wurde die Kombination von MaCE mit Nanosphären-Lithographie durchgeführt, um die Ag-Muster durch selbstorganisierte Polystyrol-Nanosphären zu definieren [26]. Durch Anlegen der vertikalen Vorspannung relativ zu den Substratebenen während des MaCE-Prozesses wurde das gerichtete Ätzen entlang der Vorspannungsorientierung erzeugt, wo die vertikal regulierten SiNW-Arrays gebildet wurden, wie in 5b dargestellt. Das Umschalten der Ätzrichtung von der vertikalen Struktur zu einem schrägen Profil wurde durch Variieren der elektrischen Polarisation bei 60 ° . realisiert in Bezug auf die Richtung in der Ebene. Während die Vorspannung moduliert wurde, führte dies insgesamt zur Bildung von schrägen/vertikalen SiNW-Arrays aus zwei Segmenten, wie in Fig. 5c dargestellt.
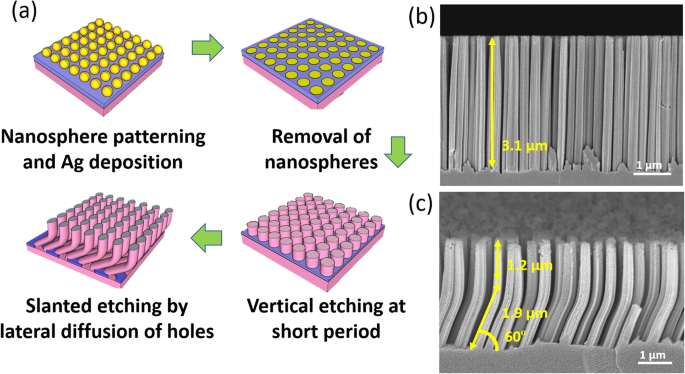
a Schematische Darstellung des Prozessablaufs zur Bildung von schrägen/vertikalen SiNW-Arrays. Querschnitts-REM-Bilder von b vertikale SiNWs und c schräge/vertikale SiNWs
Anders als bei der typischen Variation der NW-Orientierung durch die diffusionskontrollierte lokale Änderung der Ätzmittelkonzentration in der Ätzbedingung [27, 28] blieben hier sowohl die Konzentrationen der Oxidationsmittel als auch der Ätzmittel konstant und somit wurde hauptsächlich die Änderung der Ätzrichtung beigetragen von der externen Vorspannung. Daraus könnte sich die Realisierbarkeit einer dreidimensionalen Verarbeitungsfähigkeit ergeben. Schließlich wurde das sichtbare Reflexionsvermögen sowohl von vertikalen als auch von auf zwei Segmenten basierenden SiNW-Arrays untersucht, wie in Abb. 6 gezeigt. Reflexionsvermögen als das von alleinigen vertikalen SiNW-Arrays (durchschnittliches Reflexionsvermögen =5,4%), die die sichtbaren Bänder abdecken. Um die experimentelle Untersuchung weiter zu bestätigen, wurden auch die simulierten Reflexionsergebnisse verglichen, wie in Abb. 6 gezeigt. Es konnte festgestellt werden, dass die simulierten Ergebnisse gut mit den gemessenen Ergebnissen übereinstimmten, was auf die überlegenen Antireflexionseigenschaften von schrägen/vertikalen Nanostrukturen hinweist.
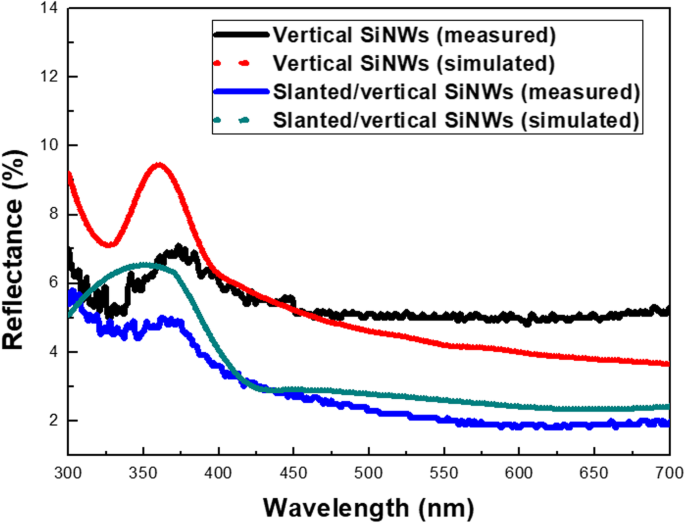
Gemessene und simulierte Reflexionsergebnisse von vertikalen bzw. geneigten/vertikalen SiNW-Arrays
Schlussfolgerung
Es wurde ein elektrisches Feld-unterstütztes MaCE-Verfahren zur Bildung von orientierungsgesteuerten SiNW-Arrays mit verbesserter Ätzrate vorgestellt. Der zugrunde liegende Mechanismus wurde durch die kombinierten Effekte von Lochkorrektur und Anodisierung aufgeklärt, die die Ätzmorphologien und -kinetik modulieren könnten. Darüber hinaus wurde die Oberflächenbenetzbarkeit untersucht, was darauf hinweist, dass die großflächige Gleichmäßigkeit bei einer Vorspannung von + 40 V erzeugt wurde. Durch Manipulation der Polarisation des angelegten elektrischen Felds wurde der Übergang der Ätzrichtung von der vertikalen Struktur zu einem schrägen Profil realisiert. Solche zweisegmentigen SiNWs in Form von schrägen/vertikalen Strukturen besaßen die stark verbesserten Antireflexionseigenschaften, die möglicherweise für optoelektronische Bauelemente, photonische Kristalle und andere multifunktionale Anwendungen nützlich sein könnten.
Verfügbarkeit von Daten und Materialien
Die Datensätze, die die Schlussfolgerungen dieses Artikels unterstützen, sind im Artikel enthalten.
Abkürzungen
- FDTD:
-
Zeitbereich mit endlicher Differenz
- MaCE:
-
Metallunterstütztes chemisches Ätzen
- NSL:
-
Nanosphären-Lithographie
- PL:
-
Nachleuchtend
- PSs:
-
Polystyrol-Nanokugeln
- SEM:
-
Rasterelektronenmikroskop
- SiNWs:
-
Silizium-Nanodrähte
Nanomaterialien
- Elektrische Felder und Kapazität
- Magnetfelder und Induktivität
- Grundsätze des Radios
- C++-Zeiger und Arrays
- Beziehung zwischen Arrays und Zeigern
- Konfigurierbarer induktiver Sensor unterstützt Hochgeschwindigkeits-Automobil- und Industrie-Elektromotoren.
- Modulation der elektronischen und optischen Anisotropieeigenschaften von ML-GaS durch vertikales elektrisches Feld
- Aufklärung der morphologischen Evolution und Ätzkinetik poröser Silizium-Nanodrähte beim metallunterstützten chemischen Ätzen
- Au-beschichtete GaAs-Nanopillar-Arrays, hergestellt durch metallunterstütztes chemisches Ätzen
- Laserätzen und Lasergravieren



