Herstellung hochwertiger und dehnungsarmer GeSn-Mikroscheiben durch Integration von selektivem epitaktischem Wachstum und selektiven Nassätzverfahren
Zusammenfassung
GeSn ist ein vielversprechendes Material für die Herstellung von photonischen und nanoelektronischen Geräten auf dem Chip. Auf diese Weise wurden Verarbeitungstechniken für GeSn entwickelt, einschließlich Epitaxie, Glühen, Ionenimplantation und Ätzen. In dieser Arbeit werden aufgehängte, spannungsentspannte und hochwertige GeSn-Mikroscheiben durch einen neuen Ansatz ohne Ätzen der GeSn-Legierung realisiert. Die GeSn-Legierung wurde auf einem vorstrukturierten Ge(001)-Substrat durch Molekularstrahlepitaxie bei niedrigen Temperaturen aufgewachsen. Zur Bestimmung der Mikrostrukturen der GeSn-Proben wurden die Transmissionselektronenmikroskopie und die Rasterelektronenmikroskopie durchgeführt. Die Mikroscheiben mit unterschiedlichen Durchmessern der Ge-Sockel wurden durch Steuerung der selektiven Nassätzzeit hergestellt, und Mikro-Raman-Ergebnisse zeigen, dass die Mikroscheiben mit unterschiedlichen Abmessungen der verbleibenden Ge-Sockel unterschiedliche Ausmaße der Spannungsrelaxation aufweisen. Die Druckspannung von Mikroscheiben wird unter geeigneten Bedingungen fast vollständig entspannt. Die in dieser Arbeit vorgestellte Halbleiterverarbeitungstechnologie kann eine alternative Methode zur Herstellung innovativer Mikro-/Nanostrukturen auf Basis von GeSn und anderen Materialien für eine Reihe von Si-kompatiblen Photonik-, 3D-MOSFETs und mikroelektromechanischen Bauelementanwendungen sein.
Einführung
Germanium-Zinn (GeSn), ein komplementäres Metall-Oxid-Halbleiter (CMOS)-kompatibles Material der Gruppe IV, hat in den letzten Jahren aufgrund seiner Anwendungen in der Elektronik und Optoelektronik große Aufmerksamkeit auf sich gezogen. Die Legierung von mehr Sn in Ge kann die Ladungsträgermobilität verbessern sowie die Bandlücke vom indirekten zum direkten Übergang ändern [1, 2]. Theoretische Arbeiten [3,4,5] und auf Photolumineszenz basierende experimentelle Studien [6,7,8] zeigen, dass der Übergang von indirekt zu direkt für eine entspannte GeSn-Legierung bei einem Sn-Gehalt von nicht weniger als 6,5 % auftritt. Die geringe (1%) Gleichgewichtslöslichkeit von Sn in Ge [9, 10] und die große Gitterfehlanpassung (~ 15%) zwischen Ge und α-Sn stellen jedoch enorme Herausforderungen an die Realisierung einer defektfreien GeSn-Legierung mit sogar a wenige Atom-% substituiertes Sn. Die Verwendung von Nichtgleichgewichtswachstumstechniken wie der Niedertemperatur-Molekularstrahlepitaxie (MBE) [11,12,13,14,15], der chemischen Gasphasenabscheidung (CVD) [16,17,18,19,20] und Festphasenepitaxie [21, 22] ist dringend erforderlich.
Im Fall einer GeSn-Legierung, die auf einem spannungsentspannten virtuellen Ge-Substrat oder einem Ge-Substrat aufgewachsen ist, wird erwartet, dass die höchste Qualität von GeSn im pseudomorphen oder vollständig gespannten Zustand erreicht wird, wodurch die Bildung von Fehlpassungen und Gewindeversetzungen vermieden werden kann. Nichtsdestotrotz wird eine solche GeSn-Legierung kompressionsverformt (~~0,15% pro 1% Sn) und diese durch Epitaxie induzierte Dehnung negiert den Effekt des Legierens von Sn mit Ge für die Bandlückenumwandlung. Als Ergebnis ist ein viel höherer Sn-Gehalt von 17% für die pseudomorphe GeSn-Epischicht auf Ge (001) [23] erforderlich, um die direkte Bandlücke zu erreichen, was zu extrem hohen Herausforderungen an die Epitaxie und einer geringen Materialqualität führt. Daher wird die Manipulation der Spannung ohne die Qualität des Kristalls der GeSn-Epi-Schichten zu opfern, ein sehr wichtiges Thema. Die selektive Entfernung des spannungsinduzierenden virtuellen Ge-Substrats oder Ge-Substrats unter den GeSn-Epischichten, um teilweise suspendierte Mikrostrukturen zu bilden, ist eine vielversprechende Technik, um die Druckspannung in den GeSn-Filmen zu überwinden. Beispielsweise wurden aufgehängte GeSn-Mikroscheiben mit einer tragenden Säule in der Mitte hergestellt [24,25,26,27,28]. Die Struktur kann nicht nur die Druckspannung in der GeSn-Schicht durch elastische Verformung an freien Oberflächen entspannen, sondern auch optische Modelle nahe dem Rand der Mikroscheibe aufgrund des starken Brechungsindexkontrasts zwischen dem GeSn und dem umgebenden Medium (Luft) eingrenzen, wie z. B. Flüstern -Galerie-Modus [16, 25]. Bisher wurde nur über eine Methode zur Herstellung von GeSn-Mikroplatten durch optische Lithographie nach dem Wachstum und Top-Down-Ätzen des zweidimensionalen GeSn-Films berichtet [16, 24, 29, 30]. Der Prozess kann jedoch während des Ätzprozesses nach dem Wachstum unter thermischen Fehlanpassungseffekten leiden, was zu einer verschlechterten Materialqualität von GeSn-Mikroscheiben führt. Kürzlich haben P. Ponath et al. berichteten über das selektive Flächenwachstum von hochkristallinem c -achsenorientiertes BTO [31], das uns zur Herstellung von GeSn-Mikrostrukturen inspiriert hat. Durch direktes Abscheiden von GeSn-Mikroscheiben im letzten Schritt auf einem vorstrukturierten SiO2 /Ge-Substrat und dann selektives Wegätzen des Ge-Substrats nach dem Opfer-SiO2 Schichtabtrag können suspendierte GeSn-Mikroscheiben ohne den konventionellen und aufwendigen Post-Growth-Ätzprozess hergestellt werden. Ein solches Verfahren kann, wenn möglich, die oben genannten Probleme vermeiden und somit eine qualitativ hochwertigere und spannungsentspanntere GeSn-Mikrostruktur erhalten. Darüber hinaus ist es auch ein sehr vielversprechendes Verfahren, mit dem beliebige Muster mit hoher Genauigkeit und einem guten Seitenverhältnis erzielt werden können, insbesondere für die dreidimensionale Integration komplexer Bauelementstrukturen, die eine genaue Dickensteuerung der Schichten erfordern.
In diesem Beitrag wurden GeSn-Mikroscheibenstrukturen erfolgreich mit einem neuen Verfahren hergestellt. Es ist das erste Mal, GeSn-Mikroscheiben herzustellen, indem selektives epitaktisches Wachstum mit einem einfachen Schritt des selektiven Nassätzens kombiniert wird. Die Dicke, die Sn-Konzentration und die Kristallqualität der GeSn-Epi-Schicht wurden durch hochauflösende Transmissionselektronenmikroskopie (HRTEM) und Sekundärionen-Massenspektrometrie (SIMS) charakterisiert. Durch Rasterelektronenmikroskopie (REM) und Mikro-Raman-Spektroskopie (μ-Raman) wurden Einblicke in die Mikrostrukturen der hergestellten GeSn-Mikroscheiben gewonnen. μ-Raman-Ergebnisse bei Raumtemperatur (RT) zeigen, dass die Mikroscheiben mit unterschiedlichen Abmessungen der verbleibenden Ge-Sockel unterschiedliche Ausmaße der Spannungsrelaxation aufweisen. Die Druckspannung von Mikroscheiben wird unter geeigneten Bedingungen fast vollständig entspannt. Dieses Verfahren zur Herstellung von Mikroscheiben, ohne dass das GeSn selbst geätzt werden muss, ist vorteilhaft, um entspannte und qualitativ hochwertige Nanostrukturen von GeSn und anderen Materialien zu erhalten.
Methoden
Materialien
Die Ge-Wafer wurden von der Firma AXT gekauft. Aceton, Isopropylalkohol, Fluorwasserstoffsäure, Ethylalkohol, Wasserstoffperoxid, wässriges Ammoniak und Kaliumhydroxid wurden von Sinopharm Chemical Reagent (China) geliefert. Entionisiertes H2 O (18,2 MΩ·cm) wurde aus einem Ultrafiltrationssystem (Milli-Q, Millipore, Marlborough, MA) erhalten
Vorbereitung des gemusterten Ge-Substrats
Ge(001)-Wafer (n-Typ, 0,025–0,031 Ωcm) wurden zuerst 3 min in Aceton und Isopropylalkohol getaucht und dann chemisch mit einer verdünnten Flusssäurelösung (HF:H2 .) gereinigt O =1:20) für 20 s bei RT. Es folgte eine Spülung in laufendem deionisiertem H2 O (DI–H2 Ö). Das Reinigungsverfahren ist von Bedeutung, insbesondere die HF-Behandlung, um die native Oxidschicht abzulösen und sicherzustellen, dass die Ge-Oberfläche sauber ist und engen Kontakt mit dem nächsten SiO2 . hat Schicht. In diesem Fall wird das Abhebeprofil durch die Abscheidung eines Si/SiO2 . erreicht zusammengesetzte Schicht. Dann wurden die Wafer durch Trockenblasen von N2 . getrocknet und schnell in die Ultrahochvakuum-(UHV)-Kammer der plasmaunterstützten chemischen Gasphasenabscheidung (PECVD) geladen und bei 300 °C für 20 Minuten geglüht, um vollständig auszugasen. Dann wird ein 300 nm SiO2 Schicht wurde bei der gleichen Temperatur durch PECVD abgeschieden, gefolgt von einer Abscheidung von 50 nm undotiertem polykristallinem Si durch Magnetron-Sputtern bei RT, wie in Fig. 1a gezeigt. Kreisförmige Öffnungen im Si/SiO2 Verbundschicht werden unter Verwendung von Standard-Photolithographietechniken (Abb. 1b) und zweistufigen Ätzprozessen (Abb. 1c, d) strukturiert.
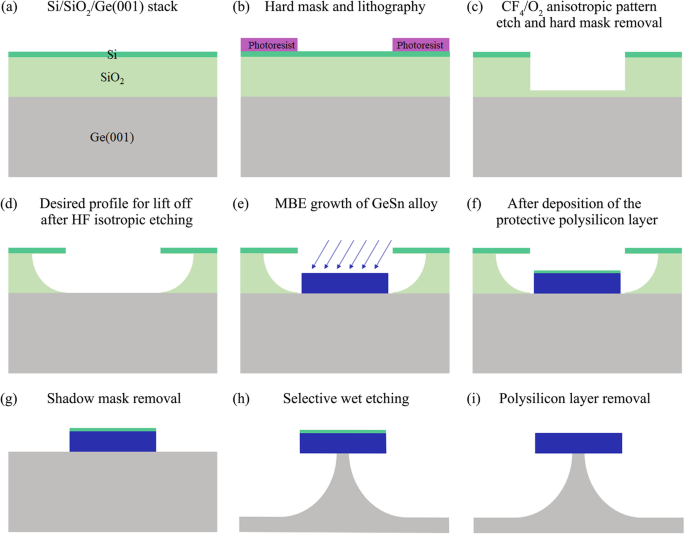
Die schematische Querschnittsdarstellung für die Herstellung der suspendierten GeSn-Mikroscheiben
Im Detail, vor dem Mustern des Si/SiO2 /Ge-Wafer, der Wafer wurde mit Aceton, Ethylalkohol und DI-H2 . gereinigt O, dann mit N2 . geföhnt und im Backofen bei 90 °C vorgebacken. Danach wurde es mit AZ5214-Photoresist unter Verwendung eines Schleuderbeschichters bei einer Geschwindigkeit von 4000 U/min 30 s lang aufgeschleudert und dann zum Weichbacken bei 90 °C für 2 Minuten auf eine Heizplatte gelegt. Die Plattenherstellungsmaschine (Heidelberg, uPG501) wurde dann verwendet, um kreisförmige Musteranordnungen auf dem Si/SiO2 . zu erzeugen /Ge-Stapel. Die kreisförmigen Muster sind in einem Abstand von 5 µm voneinander fixiert, während der Durchmesser im Bereich von 3 bis 5 µm liegt. Die Muster wurden dann auf das untere SiO2 . übertragen Schicht durch zweistufiges Ätzen. Das anisotrope Trockenätzen durch reaktives Ionenätzen mit einem Mischgas aus CF4 und O2 wurde zuerst zum Ätzen von Si/SiO2 . verwendet Schichten und gestoppt mit ca. 20 nm SiO2 links. Dann wurde das Auflösen des Photoresists und das Nassätzen mit verdünnter HF bei RT angeheuert, um das verbleibende SiO2 . zu entfernen Schicht, um sowohl das Germanium in den kreisförmigen Öffnungen freizulegen als auch seitlich unter die definierte Polysiliziumkante zu ätzen, um einen Überhang zu erzeugen, der das gewünschte Profil zum Abheben ist.
GeSn-Wachstum und Mikroplattenherstellung
Für die GeSn-Dünnschichtabscheidung ein Festquellen-MBE-System (Riber SSC) mit einem Basisdruck von 2 × 10 –10 Torr wurde verwendet [32]. Für die Ge- und Sn-Verdampfung im MBE-System sind ein Elektronenstrahlverdampfer und eine pyrolytische BN-Effusionszelle mit hochreinen Festkörperquellen ausgestattet. Ein Quarzkristallmonitor wurde verwendet, um die Abscheidungsrate zu kalibrieren. Vor dem Laden der strukturierten Substrate in das UHV-System wurden die Substrate mit O2 . gereinigt Plasma, um alle organischen Rückstände zu entfernen, die durch Trockenätzen induziert wurden. Nach dem Spülen in Aceton, Isopropylalkohol und verdünnter HF wurden die Substrate für das GeSn-Wachstum in die MBE-Kammer überführt. Nach 15-minütiger thermischer Desorption bei 450 °C wurden die Substrate für das Schichtwachstum der GeSn-Legierung mit einer Ge-Wachstumsrate von 0,5 Å s −1 . in situ auf 150 °C abgekühlt und einen gesteuerten Sn-Fluss als Dotierstoffquelle. Diese Wachstumstemperatur ist niedrig genug, um die Sn-Oberflächenseigerung wirksam einzuschränken. Um Oxidation zu verhindern, wurde schließlich eine 10 nm Ge-Deckschicht bei der gleichen Temperatur abgeschieden.
Nach dem Wachstum werden GeSn-Legierungen mit einer nominalen Sn-Konzentration von 4% und 10% für die Mikroplattenherstellung verwendet. Anschließend wurde eine zusätzliche 30 nm dicke Polysiliziumschicht auf der Oberseite der Proben bei RT mittels Magnetron-Sputtern abgeschieden, um die GeSn-Schicht vor dem folgenden Ätzen zu schützen. Dann wird das Opfer-SiO2 Schicht wurde mit verdünnter HF (1:1) entfernt, wodurch auch die darüberliegende Polysiliziumschicht und der darauf abgeschiedene GeSn-Film entfernt wurden. Wie in Abb. 2 zu sehen ist, wurden isolierte kreisförmige GeSn-Mesas entdeckt, nachdem die SiO2 Schicht entfernt wurde. Der Umfang der kreisförmigen Mesa ist jedoch nicht so glatt, was für optische Begrenzungseffekte schlecht ist. Die unerwartete Situation wird durch die GeSn-Abscheidung am Rand des unteren SiO2 . verursacht Schicht, die durch das unzureichende seitliche Ätzen des unteren SiO2 . entsteht und die Abscheidung außerhalb des normalen Winkels (30°). Anschließend unterschneidet ein einfacher Schritt des selektiven Nassätzens die kreisförmigen Mesas bei RT, was zu suspendierten GeSn-Mikroscheibenstrukturen führt. Das selektive Ätzmittel (APM) besteht aus H2 O2 (31 Gew.-%), NH4 OH (28 Gew.-%) und DI-H2 O mit einem Volumenverhältnis von 2:0,5:80 [30]. Schließlich wurde die obere schützende Polysiliziumschicht durch KOH entfernt. Eine schematische Darstellung der Prozessschritte ist in Abb. 1e–i dargestellt.
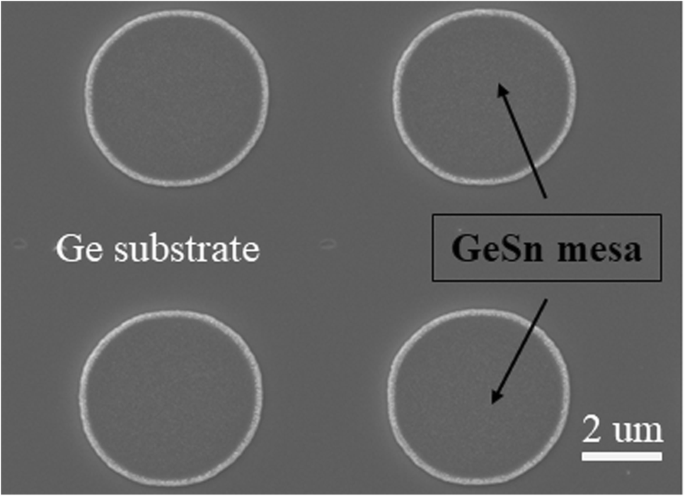
REM-Aufnahme von oben isolierter kreisförmiger GeSn-Mesas mit 5 μm Durchmesser nach Entfernen der Lochmaske
Bei unserem Verfahren zur Herstellung von GeSn-Mikroscheiben ist das abschließende selektive Nassätzen aufgrund der unterschiedlichen Ätzraten für die GeSn-Materialien mit unterschiedlichen Sn-Konzentrationen wichtig. Die Ätzselektivität von Ge gegenüber Ge1−x Snx wird auch mit der Sn-Konzentration variieren. Je höher die Konzentration von Sn in GeSn, desto höher die Oberflächenbedeckung von SnOy entwickelt werden [33]. Es reduziert die Nassätzrate von GeSn und führt zu einer höheren Ätzselektivität von Ge gegenüber GeSn. In der vorherigen Studie wurde berichtet, dass H2 O2 basierte Nassätzung (H2 O2 :NH4 OH:H2 O =2:0,5:80), das gleiche bei dieser Arbeit, erreicht eine Ätzselektivität von Ge gegenüber Ge0,928 Sn0,072 von 9:1 [30].
Ergebnisse und Diskussion
Abbildung 3a zeigt die Querschnitts-TEM-Aufnahme der kreisförmigen GeSn-Mesa mit 5 µm Durchmesser ohne die oberste Polysiliziumschicht. Abbildung 3b, c sind die hochauflösenden TEM (HRTEM)-Aufnahmen für die Regionen A und B, die der GeSn/Ge-Grenzfläche bzw. der mittleren Region der GeSn-Schicht entsprechen. Die Filmdicke der GeSn-Schicht liegt etwa 250 nm (Abb. 3a) unter der Dicke der Lochmaske. Wie in Abb. 3b zu sehen ist, sind Defekte hauptsächlich an der GeSn/Ge-Grenzfläche von 30 nm Dicke lokalisiert, was zum folgenden einkristallinen GeSn-Wachstum führt. Das HRTEM-Bild von Region B zeigt klare Gittersäume der GeSn-Schicht, was darauf hinweist, dass die Legierung hochkristallin ist und das Muster der schnellen Fourier-Transformation (FFT) von Region B gut mit dem Beugungsmuster von GeSn übereinstimmt, wie in 3c gezeigt. Um die Sn-Konzentration der GeSn-Legierung zu bestätigen, wurde außerdem die SIMS-Messung abgeschlossen, wie im Einschub von Fig. 3a gezeigt. Die Sn-Konzentration beträgt 9,8 ± 0,5 %, was dem Nennwert von etwa 10 % entspricht. Abgesehen davon ist die Verteilung der Sn-Atome im Tiefenprofil des gewachsenen GeSn-Films sehr gleichmäßig.
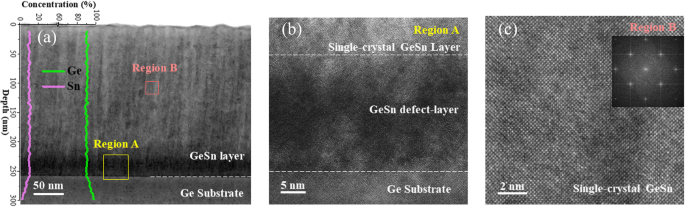
a TEM-Querschnittsbild der kreisförmigen GeSn-Mesa mit 5 µm Durchmesser ohne obere Polysiliziumschicht. Einschub:SIMS-Tiefenprofil der GeSn-Schicht. b Hochauflösendes TEM-Bild der GeSn/Ge-Grenzfläche (Region A). c Hochauflösendes TEM-Bild für den mittleren Bereich der GeSn-Schicht (Bereich B). Einschub:FFT-Muster der Region B
Die Oberflächenstruktur der Proben wurde mit REM untersucht. Abbildung 4a zeigt das REM-Bild der Draufsicht des Ge0.96 . mit einem Durchmesser von 5 µm Sn0,04 kreisförmige Mesas nach 510 s selektivem Nassätzen durch APM-Lösung bei RT. Es muss erwähnt werden, dass die Ätzmittel unmittelbar vor den Versuchen hergestellt werden, um die Auswirkungen der chemischen Alterung zu vermeiden. Das REM-Bild zeigt, dass nicht nur das Ge-Substrat, sondern auch ein Teil der GeSn-Mesa weggeätzt ist. Das Versäumnis, eine Plattenstruktur für Ge0.96 . zu bilden Sn0,04 Legierung ist auf die niedrige Konzentration von Sn zurückzuführen, die zu der geringen Ätzselektivität von Ge gegenüber GeSn führt. Im Gegensatz zum Ge0.96 Sn0,04 Proben wurde die kreisförmige Mesa-Probe aus GeSn mit einem Durchmesser von 5 µm und einer höheren Sn-Konzentration von 9,8% ebenfalls durch APM bei RT geätzt. Wie in Abb. 4b gezeigt, c. c, Mikroplattenstrukturen wurden erfolgreich für Ge0.902 . gebildet Sn0,098 Legierung nach 510 s Nassätzen. Zuvor haben Han et al. [30] berichteten, dass sie teilweise suspendiertes Ge0.928 . herstellten Sn0,072 Mikroscheiben (5 µm Abmessung) mit ca. 1,2 µm Unterschnitt unter Verwendung des H2 O2 basierte Nassätzung mit einer Selektivität von 7:1. Nach dem selektiven Nassätzen werden die Kanten ihrer Scheibe jedoch verbogen und brechen aufgrund starker anziehender Kapillarkräfte, die zwischen der suspendierten Struktur und dem Substrat entwickelt werden, wenn die Ätzflüssigkeit entfernt wird, wodurch die freigesetzte Mikroscheibenstruktur in Kontakt mit dem Substrat gezogen wird [ 24]. Dieses Phänomen tritt jedoch in unseren Experimenten nicht auf, selbst wenn das selektive Ätzen verlängert wird, um den darunter liegenden Ge-Sockel fast vollständig zu entfernen. Dies könnte durch die höhere Ätzselektivität und die dickere GeSn-Schicht von etwa 250 nm erklärt werden. Interessanterweise zeigen die Sockel unerwartete Facetten mit unterschiedlichen Orientierungen, die durch die orientierungsabhängige laterale Ätzrate während des selektiven Nassätzprozesses verursacht werden können.
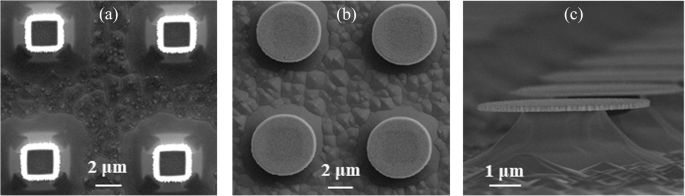
REM-Aufnahmen nach selektivem Nassätzen. a 5 μm Durchmesser Ge0.96 Sn0,04 kreisförmige Tafelberge nach 510 s Ätzung. b , c 5 μm Durchmesser Ge0.902 Sn0,098 kreisförmige Tafelberge nach 510 s Ätzung
Darüber hinaus wurden die Mikroscheiben mit Ge-Sockel unterschiedlichen Durchmessers durch Steuerung der selektiven Ätzzeit hergestellt. Abbildung 5a zeigt den Durchmesser des verbleibenden Ge-Sockels als Funktion der Ätzzeit in APM. Die Fehlerbalken stellen die Standardabweichung von den Daten von fünf verschiedenen Mikroplatten in derselben Stichprobe dar. Die ähnliche Linientendenz zeigt an, dass die Ätzrate von Ge ungefähr gleich für Ge0.902 . ist Sn0,098 Scheiben mit unterschiedlichen Durchmessern von 3 µm und 5 µm und stimmt mit dem Wert der Ätzrate aus Lit. [30]. Darüber hinaus beträgt der minimale Durchmesser des Ge-Sockels für eine stehende GeSn-Mikroplatte etwa 300 nm. Die aufgehängten GeSn-Mikroscheiben werden durch die starken anziehenden Kapillarkräfte nach unten gezogen, wenn die Ge-Sockel kleiner werden.
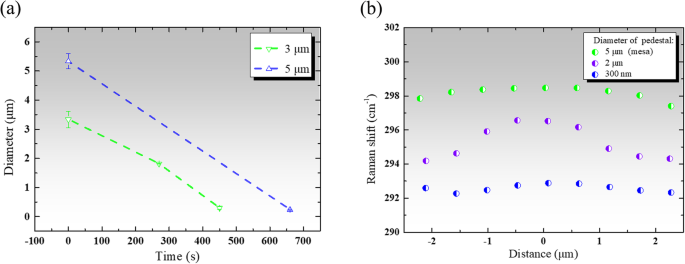
a Der Durchmesser des Ge-Sockels als Funktion der selektiven Nassätzzeit für 3 µm (grüne gestrichelte Linie) und 5 µm (blaue gestrichelte Linie) Durchmesser Ge0.902 Sn0,098 Festplatten. b Raman-Shift-Line-Scan-Messungen, die entlang des Durchmessers von 5 μm Ge0.902 . durchgeführt wurden Sn0,098 Mesa (grüner Punkt) und Mikrodisks mit 2 μm Durchmesser Ge-Sockel (lila Punkt) und 300 nm Durchmesser Ge-Sockel (blauer Punkt)
Um die elastische Dehnungsverteilung der GeSn-Mikroscheiben zu untersuchen, wurde μ-Raman bei RT auf Scheiben mit 5 μm Durchmesser unter Verwendung eines 633 nm Lasers zur Anregung mit einer Spotgröße von ca. 600 nm durchgeführt. Die Laserleistung beträgt nur 1% der maximalen Leistung (15 mw), um die thermischen Effekte zu minimieren [34] und die Eindringtiefe des Anregungslasers in die GeSn-Schichten beträgt ca. 50 nm [26]. Die Raman-Verschiebung wurde durch Anpassen der Spektren mit Lorentz-Funktionen gemessen.
Abbildung 5b zeigt die eindimensionalen Raman-Linienscans für Ge0.902 Sn0,098 Mikrostrukturen. Es ist deutlich zu erkennen (1), dass sich für die Mesa mit 5 μm Durchmesser ohne Unterschneidung der Raman-Peak, der mit der Ge-Ge-LO-Phononenmode verbunden ist, vom Zentrum zum Rand der Mesa unoffenbar zu niedrigeren Wellenzahlen verschiebt, und die große Raman-Verschiebung zeigt, dass es gibt eine große Druckspannung in der GeSn-Mesa; (2) Für die Mikroscheibe mit 5 μm Durchmesser und Ge-Sockel mit 2 μm Durchmesser verschiebt sich der Raman-Peak, der mit der Ge-Ge-LO-Phononenmode verbunden ist, offensichtlich zu niedrigeren Wellenzahlen vom Zentrum zum Rand der Scheibe, was einen Dehnungsgradienten aufgrund der Verankerung offenbart zum vergleichsweise großen Ge-Sockel. Und die 5 µm GeSn-Mikroscheibe mit 2 µm Durchmesser des Sockels behält an ihrer Peripherie immer noch eine gewisse Druckspannung; (3) die Ge-Ge-Peakpositionen, gemessen entlang des Durchmessers des 5 μm Ge0.902 Sn0,098 Mikrodisk mit 300 nm Durchmesser Ge-Sockel bleiben konsistent und haben eine deutlich reduzierte Raman-Verschiebung. Daher wird erwartet, dass die Scheiben mit schmalen Ge-Sockeln (ca. 300 nm Durchmesser) vollständig relaxiert sind.
In Abb. 6 präsentieren wir das typische Raman-Streuspektrum von 5 µm Durchmesser Ge0.902 Sn0,098 Mikrodisk mit 300 nm Durchmesser Ge-Sockel. Für die Scheiben zeigen die Raman-Spektren einen asymmetrischen Peak bei einer Frequenz von 292,4 cm −1 entsprechend dem Ge-Ge-LO-Modus. Die Raman-Spektren, die für die Mesa mit 5 &mgr;m Durchmesser und das Referenz-Bulk-Ge(001)-Substrat aufgezeichnet wurden, sind ebenfalls zum Vergleich aufgetragen. Beachten Sie, dass nach dem Unterschneiden die Raman-Verschiebung (− 6.3 cm −1 ) des Ge-Ge-Peaks kann für 9,8% Sn-Mikroscheiben beobachtet werden, da die Raman-Frequenzverschiebung in Halbleiterlegierungen hauptsächlich durch Dehnung und Zusammensetzung beeinflusst wird. Frühere Raman-Studien [33, 35,36,37] haben gezeigt, dass die Raman-Verschiebung der Ge-Ge-LO-Phononenmode in GeSn als Funktion der Sn-Konzentration x . ausgedrückt werden kann Sn und die biaxiale Dehnung in der Ebene ε ∥ nach Gl. (1):

Vergleich der Raman-Spektren des 5 μm Ge0.902 Sn0,098 Mikrodisk mit 300 nm Durchmesser Ge-Sockel, 5 μm Ge0.902 Sn0,098 Durchmessermesa und ein massives Ge-Substrat als Referenz. Einschub:vergrößerte Ansicht der Raman-Spektren. Die Ge-Sn-Peaks können auch um 260 cm −1 . beobachtet werden , und Herunterschalten mit abnehmendem Durchmesser der Ge-Sockel
$$ \Updelta \omega ={\omega}_{\mathrm{Ge}\mathrm{Sn}}-{\omega}_{\mathrm{Ge}}=\mathrm{A}\cdotp{x}_{ \mathrm{Sn}}+\mathrm{B}\cdotp{\varepsilon}_{\parallel} $$ (1)wo ω GeSn und ω Ge sind die Peakposition der Ge-Ge-LO-Phononenmode in GeSn bzw. in Bulk-Ge, während A und B Koeffizienten sind.
Die Ge-Ge-LO-Raman-Peaks für die Mesa und die Scheiben zeigen die Verschiebung von − 1.4 cm −1 und − 7,7 cm −1 verglichen mit dem Bulk-Ge-Peak (300,1 cm −1 .) ). Durch Verwenden der Koeffizienten aus früheren experimentellen Ergebnissen [37] wird der Wert der biaxialen Färbung in der Ebene ε ∥ berechnet sich zu − 1,18% für die gewachsene GeSn-Mesa. Bei den hergestellten Mikroscheiben ist die biaxiale Färbung in der Ebene ε ∥ ist ungefähr gleich 0, was die fast vollständige Spannungsrelaxation der Mikroscheiben bestätigt. Nach der aktuellen theoretischen Berechnung von Ge1-x Snx elektronische Bandstruktur [38], das gewachsene Ge0.902 Sn0,098 Schicht ist ein Material mit indirekter Bandlücke mit einer Bandlückenenergie von etwa 0,56 eV, während das vollständig entspannte Ge0.902 Sn0,098 microdisk ist ein Material mit direkter Bandlücke mit einer Bandlückenenergie von 0,50 eV.
Schlussfolgerungen
Zusammenfassend lässt sich sagen, dass die GeSn-Mikroscheiben erfolgreich hergestellt wurden, indem selektives epitaktisches Wachstum mit einem selektiven Nassätzprozess kombiniert wurde. HRTEM und SEM wurden durchgeführt, um zu bestätigen, dass die GeSn-Legierung hochkristallin ist und dass die GeSn-Mikroscheibenstruktur leicht durch einfaches selektives Nassätzen gebildet wird. Die μ-Raman-Messungen zeigen, dass die Spannungsrelaxation der GeSn-Mikroscheibe mit abnehmendem Durchmesser des Ge-Sockels aufgrund der gleichzeitig abnehmenden mechanischen Zwänge durch den kleineren Ge-Sockel größer wird. Und schließlich wurden durch dieses kostengünstigere Verfahren die qualitativ hochwertigen und vollständig spannungsrelaxierenden GeSn-Mikroscheiben erreicht. Der Herstellungsprozess ist auch eine sehr vielversprechende Methode, um eine kleinere GeSn-Mesagröße zu erreichen, bis der laterale Quantengrößeneffekt wichtig wird, und um andere GeSn-Nanostrukturen wie GeSn-Quantenpunkte, GeSn-Nanomesh und GeSn-Nanodrähte für zukünftige Si-kompatible photonische und elektronische . zu erhalten Geräteanwendungen.
Verfügbarkeit von Daten und Materialien
Die Daten, die die Ergebnisse dieser Arbeit stützen, sind auf begründete Anfrage beim entsprechenden Autor erhältlich.
Abkürzungen
- APM:
-
Ammoniakperoxid-Mischung (Nassätzmittel)
- FFT:
-
Schnelle Fourier-Transformation
- HRTEM:
-
Hochauflösende Transmissionselektronenmikroskopie
- MBE:
-
Molekularstrahlepitaxie
- PECVD:
-
Plasmaunterstützte chemische Gasphasenabscheidung
- RT:
-
Raumtemperatur
- SEM:
-
Rasterelektronenmikroskopie
- SIMS:
-
Sekundärionen-Massenspektrometrie
- μ-Raman:
-
Mikro-Raman-Spektroskopie
Nanomaterialien
- Abstrakte Java-Klasse und abstrakte Methoden
- Optische und elektrische Eigenschaften von Silizium-Nanodrähten, die durch stromloses Ätzen hergestellt wurden
- Herstellung von SrGe2-Dünnschichten auf Ge (100), (110) und (111) Substraten
- Herstellung, Charakterisierung und biologische Aktivität von Avermectin-Nanoabgabesystemen mit unterschiedlichen Partikelgrößen
- Neueste Fortschritte bei Synthesemethoden und Anwendungen von Silbernanostrukturen
- Herstellung und Charakterisierung von ZnO-Nano-Clips durch das Polyol-vermittelte Verfahren
- Herstellung von helikalen CA/TPU-Nanofasern und deren Mechanismusanalyse
- Herstellung und photokatalytische Eigenschaft neuartiger SrTiO3/Bi5O7I-Nanokomposite
- Verstehen des Wachstumsmechanismus von GaN-Epitaxieschichten auf mechanisch abgeblättertem Graphit
- Laserätzen und Lasergravieren



