Ferroelektrischer 2D-MoS2-Speichertransistor mit Niederspannung und Hf1-xZrxO2-Gate-Struktur
Zusammenfassung
Der ferroelektrische Feldeffekttransistor (FeFET) ist aufgrund seiner vielversprechenden Betriebsgeschwindigkeit und Lebensdauer eine faszinierende nichtflüchtige Speichertechnologie. Das Umkehren der Polarisation erfordert jedoch im Vergleich zum Lesen eine hohe Spannung, was den Stromverbrauch beim Schreiben einer Zelle beeinträchtigt. Hier berichten wir über eine CMOS-kompatible FeFET-Zelle mit niedriger Betriebsspannung. Wir entwickeln das ferroelektrische Hf1-x Zrx O2 (HZO)-Dünnfilm zur Bildung von Gatedielektrika mit negativer Kapazität (NC), die eine Gegentakthystereseschleife der Polarisationsdomäne in dem mehrschichtigen Molybdändisulfid (MoS2 .) erzeugt ) FeFET. Der unstabilisierte negative Kondensator unterstützt von Natur aus die subthermionische Schwingrate und ermöglicht somit das Umschalten der ferroelektrischen Polarisation mit einem Hysteresefenster von viel weniger als der Hälfte der Betriebsspannung. Der FeFET zeigt ein hohes Ein-/Aus-Stromverhältnis von mehr als 10 7 und ein Speicherfenster (MW) gegen den Uhrzeigersinn von 0,1 V bei einer minimalen Programm- (P)/Löschspannung (E) von 3 V. Robuste Ausdauer (10 3 .) Zyklen) und Retention (10 4 s) Eigenschaften werden ebenfalls demonstriert. Unsere Ergebnisse zeigen, dass HZO/MoS2 ferroelektrische Speichertransistoren können neue Möglichkeiten in größen- und spannungsskalierbaren nichtflüchtigen Speicheranwendungen eröffnen.
Hintergrund
Der Markt für eingebettete System-on-Chip (SoC)-Speicher befindet sich derzeit in einer Ära des enormen Wachstums, die erfordert, dass der Speicher in der Lage ist, einen schnelleren Betrieb, eine kleinere Zellengröße und einen geringeren Stromverbrauch zu erreichen [1,2,3,4,5,6 ]. Ferroelektrischer Speicher, einer der vielversprechendsten Kandidaten, wurde aufgrund der Entdeckung des ferroelektrischen Hafniumoxids im Jahr 2011 überdacht [7].
In den letzten Jahrzehnten hat FeFET in all diesen Aspekten keine gute Leistung erbracht, einschließlich niedriger Spannungsanforderungen für den Speicherbetrieb, Einfachheit des Prozessschritts und minimal komplementärem Metall-Oxid-Halbleiter (CMOS)-Integrationsprozess und begrenzte Kontaminationsprobleme [8,9,10, 11]. Um dies anzugehen, wurden vor kurzem umfangreiche Untersuchungen zu nichtflüchtigen 2D-FeFET-Speichern (NVM) auf der Grundlage verschiedener ferroelektrischer Materialien, einschließlich PbZrTiO3 ., durchgeführt (PZT) und [P(VDF-TrFE)] Polymer [12,13,14,15,16,17,18], was auf die vielversprechenden Eigenschaften von 2D-Material in der „mehr als Moore-Ära“ zurückzuführen ist. Beim FeFET werden die beiden stabilen spontanen Polarisationszustände eines in einen Transistor-Gate-Stapel eingebauten ferroelektrischen Materials über die steuerbare Schwellenspannung, die durch angelegte geschrumpfte P/E-Gate-Spannungen ermöglicht wird, zur Datenspeicherung genutzt. Es wird berichtet, dass das reproduzierbare Hystereseverhalten ein hohes Ein/Aus-Verhältnis von 10 4 , gute Retentionseigenschaften bis zu 10 4 s und stabiler Schaltbetrieb wurden in PZT/MoS2 . erreicht FeFET [19]. Spürbar, eine maximale Beweglichkeit von 625 cm 2 /V∙s, ein großes MW von 16 V für einen Gatespannungsbereich von ±26 V und ein hohes Ein/Aus-Verhältnis von 8 × 10 5 wurden auch durch ein n-Typ [P(VDF-TrFE)] Polymer/MoS2 . nachgewiesen FeFET [15]. Es gibt jedoch so viele grundlegende Probleme, die eine praktische Anwendung verhindern könnten, wie die CMOS-Kompatibilität, die Skalierungsfähigkeit und die Grenzflächenzustände zwischen Fe und 2D-Material. Ferroelektrisches Hafniumoxid, eine Art neuartiges ferroelektrisches Material, hat eine ausgezeichnete CMOS-Kompatibilität und Skalierungsfähigkeit, die in den nächsten 5-10 Jahren für den fortschrittlichen FeFET-NVM am Sub-5-nm-Technologieknoten dienen könnte [20]. Dementsprechend wird eine Charge HfO2 -basierte dielektrische Stapel wurden in 2D-FeFETs integriert, die darauf abzielen, Feldeffekttransistoren mit negativer Kapazität (NCFET) mit steilem EIN/AUS-Schalten über eine Steilheit von weniger als 60 mV/Dekade und hysteresefreie Eigenschaften zu erzielen [21,22,23 ,24,25,26], Obwohl Massenexperimente auf der Grundlage von NC-Dielektrikumstapeln mit alternativen 2D-Kanalmaterialien fantastische Schlussfolgerungen gezogen haben, haben sie die Stoßspannungsanforderungen hervorgehoben, um zwischen NCFETs und FeFETs zu unterscheiden. Es fehlt noch an systematischen Untersuchungen zur Physik und Realisierbarkeit der Bauelementetechnologie auf einem ferroelektrischen Ein-Transistor-Speicher auf Basis von MoS2 und ferroelektrisches HZO.
In dieser Arbeit wird ein FeFET mit einem mehrschichtigen HZO MoS2 Transistor vorgeschlagen. Es ist in der Lage, die P/E-Spannung über den NC-Effekt zu skalieren, der durch das Gate-Stack-Engineering unter einer geschrumpften P/E-Spannung induziert wird. Wir haben experimentell gezeigt, dass in HZO MoS2 . ein MW von 0,1 V gegen den Uhrzeigersinn mit einer Steigung von weniger als 60 mV/Dekade erreicht wurde FeFET, der einer lokalen Ladungsträgerdichtemodulation im 2D-Kanal durch schnelles Flippen des ferroelektrischen Dipols zugeschrieben werden kann. Wir haben die verringerte Hysterese des HZO/MoS2 . zugeschrieben FeFET als Drain-Spannungserhöhung bis zum negativen Drain-induzierten Barriere-Senkungseffekt (DIBL). Darüber hinaus wurden auch die Retention, die Lebensdauereigenschaften und die Abhängigkeit der Schwellenspannung von der Drainspannung von HZO MoS2 . systematisch untersucht FeFET eröffnet einen gangbaren Weg zum Design von HZO MoS2 FeFET NVM und seine praktischen Anwendungen.
Methoden
6 nm Hf1-x Zrx O2 Film und 2 nm Al2 O3 wurde am p + . hinterlegt Si-Substrat mit ALD bei 300 °C, mit [(CH3 )2 N]4 Hf(TDMAHf), [(CH3 .) )2 N]4 Zr(TDMAZr) und H2 O-Dampf als Hf-Vorläufer, Zr-Vorläufer bzw. Oxidationsmittel-Vorläufer. Anschließend wurde das Substrat einem schnellen thermischen Glühen (RTA) bei 450°C für 30 s in N2 . unterzogen Umgebungs. Danach mehrlagiges MoS2 Flocken wurden mechanisch abgeblättert und auf das Substrat übertragen. Der Durchmesser von p + Si-Substrat zur Abscheidung von HZO (6 nm)/AI2 O3 (2 nm) ist 6 Zoll. Wir verwendeten Elektronenstrahllithographie (EBL), um Kontaktpads in Poly(methylmethacrylat) (PMMA) A5-Resist zu strukturieren. Die Schleuderparameter, Backparameter und Bildgebungsparameter sind 500 r/min (9 s) + 4000 r/min (40 s), 170 °C (5 min), MIBK:IPA =1:3 (15 s) . Dann wurden die Source/Drain-Elektroden (Ti/Au, 5/65 nm Dicke) unter Verwendung eines Elektronenstrahlverdampfungssystems (EBE) aufgedampft und mit einer Acetonlösung geätzt. Nach dem Abheben wurde die Vorrichtung 2 h bei 300 °C getempert, um den Kontakt zu verbessern. Wir haben die elektrische Charakterisierung unseres hergestellten MoS2 . durchgeführt /HZO-Feldeffekttransistoren mit einer Sondenstation mit Mikromanipulator. Die Backgate-Spannung (V GS ) wurde auf das stark dotierte Si-Substrat vom p-Typ aufgebracht. Ein Halbleiter-Charakterisierungssystem (PDA) wurde verwendet, um die Source-Drain-Spannung (V DS ), die Back-Gate-Spannung (V GS ) und der Source-Drain-Strom (I DS ).
Ergebnisse und Diskussion
Wir haben ein paar Schichten MoS2 . vorbereitet durch mechanische Exfoliation von Bulk-Kristall und übertragen das MoS2 Nanoflocke auf dem 2 nm Al2 O3 /6 nm HZO/p + Si-Substrat (weitere Details finden Sie im Abschnitt „Experimentell“). Abbildung 1a und b zeigen eine schematische 3D-Ansicht und einen Querschnitt des HZO/MoS2 FeFET-Struktur bzw. Ein Rasterelektronenmikroskop (REM)-Bild von oben des HZO/MoS2 FeFET ist in Fig. 1c gezeigt. Die Breite und Länge des MoS2 Kanal sind 2 μm bzw. 12 μm. Wie in Fig. 1d gezeigt, ist die Dicke des MoS2 Kanal wurde mit Rasterkraftmikroskopie (AFM) bestätigt. Die gemessene Dicke von 1,57 nm zeigt das Vorhandensein von 4 Schichten MoS2 . an [26].
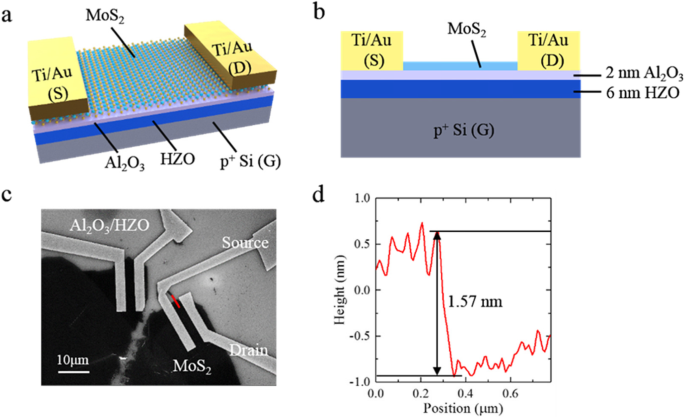
Geräteaufbau und grundlegende Eigenschaften des MoS2 /HZO-FeFET. a Dreidimensionale schematische Darstellung des MoS2 /HZO-FeFET. b Schematischer Querschnitt des MoS2 /HZO-FeFET. c REM-Aufnahme von oben des hergestellten MoS2 /HZO-FeFET mit Ti/Au-Source-/Drain-Elektroden, ferroelektrischen HZO-Gate-Isolatoren und MoS2 Kanäle. d Höhenprofil mit AFM im Kontaktmodus entlang der roten Linie in c , validiert die Höhe des MoS2 Kanal.
Wie in Abb. S1c und d gezeigt, wurde die Elementar- und Bindungszusammensetzung von HZO durch Röntgenphotoelektronen(XPS)-Messungen untersucht. Es werden Peaks von 19,05 eV, 17,6 eV, 185,5 eV und 183,2 eV gefunden, die dem Hf 4f5/2 . entsprechen , Hf 4f7/2 , Zr 3d3/2 , und Zr 3d5/2 , bzw. [27]. Die Atomkonzentration entlang des Tiefenprofils in Abb. S1e bestätigt weiter die Verteilung des Al2 O3 /HZO/p + Si-Dreischichtstruktur. All dies bestätigt, dass der über unser Atomlagenabscheidungssystem (ALD) gewachsene HZO-Film hochkristallin ist.
Vor der Untersuchung der Charakterisierung von HZO/MoS2 FeFET, das ferroelektrische Verhalten von Au/2 nm Al2 O3 /6 nm HZO/p + Der Si-Gate-Stapel mit Polarisationsspannungsmessung ist in Fig. 2a gezeigt. Unser fabriziertes 6 nm HZO/2 nm Al2 O3 Kondensatoren weisen Polarisationsspannungs-Hystereseschleifen auf (gemessen bei 1 kHz). Inzwischen ist die Restpolarisation P r und die Koerzitivspannung V c steigt mit zunehmender maximaler Wobbelspannung, was den P-V . impliziert Hystereseschleifen verwandeln sich von einer Nebenschleife in eine Hauptschleife. Wenn die maximale Wobbelspannung von 2 auf 4 V ansteigt, P r erreicht 0,66 μC/cm 2 , 0,86 μC/cm 2 , und 1,1 μC/cm 2 , bzw. und V c erreicht 1,12 V, 1,9 V bzw. 2,04 V. Extrahiertes P r und V c innerhalb von 10 5 Dauerhafte DC-Sweep-Zyklen sind in Abb. 2b und c gezeigt. Offensichtlich deutliche Aufwach- und Ermüdungseffekte innerhalb von 10 5 Zyklen werden im 6 nm HZO/2 nm Al2 . beobachtet O3 Kondensator. Das Aufwachen und die Ermüdung können auf die Diffusion und Umverteilung der Sauerstoffleerstellen unter dem elektrischen Feld zurückgeführt werden. Der Ermüdungseffekt ist im Allgemeinen mit Ladungseinfang an den Defektstellen im Zusammenhang mit Sauerstoffleerstellen verbunden [28]. Das Hystereseverhalten für die PR-Phase und schmetterlingsförmige Schlaufe für den PRampl mit Piezo-Response-Force-Mikroskopie (PFM) sind in Abb. S1b und c dargestellt, die eine Polarisationsumschaltung als Funktion der Sweep-Bias-Spannung anzeigen. Unter Berücksichtigung unterschiedlicher Übergangswiderstände zwischen Polarisationsspannungsmessung und Piezoantwort-Spannungsmessung beträgt die gemessene V c in Fig. S1b und c nicht so konsistent mit den in Fig. 2a erhaltenen Werten.

a PV-Hystereseschleifen für HZO (6 nm)/Al2 O3 (2 nm) Kondensator mit unterschiedlichen Spannungs-Sweep-Bereichen. Abhängigkeit von (b ) P r und c V c zum Radfahren für das HZO (6 nm)/Al2 O3 (2 nm) Kondensator mit ± 4 V/1 kHz Zyklen
Darüber hinaus wird beobachtet, dass ein Anstieg des MW mit einem erhöhten Wobbelspannungsbereich der Gatespannung (V GS, Reichweite ). Normalerweise existiert ein polykristalliner HZO-Film als Multidomänen-Status [29], und die Koerzitivfeldverteilung dieser Domänen genügt der Gaußschen Verteilung. Somit muss eine erhöhte Abhängigkeit vom erhöhten V . bestehen GS, Reichweite . Die Zwangsvollstreckung E C entspricht dem Wert des äußeren elektrischen Feldes, das die remanente Polarisation auf Null reduzieren kann. Daher ist das V GS ,Bereich zum Umschalten der Polarisation im HZO-Film wird mit höherer zugehöriger Koerzitivspannung V . größer C . Dies ist der Grund, warum Polarisationsspannungsschleifen von HZO-Filmen mit einem größeren V . verlängert werden GS, Reichweite , die in Abb. 2a demonstriert wurde. Mit anderen Worten, die verstärkte Polarisationsintensität und das ferroelektrische Schalten treten mit dem erhöhten V . auf GS, Reichweite , was zu den oben erwähnten Phänomenen des erweiterten MW gegen den Uhrzeigersinn führt, das durch das erhöhte V . erzeugt wird GS, Reichweite . Bei V GS, Reichweite =(−2, 2 V), sind die MW fast verschwunden und es treten nahezu hysteresefreie Charakteristiken auf, was die fast vollständige Kompensation zwischen den Effekten des ferroelektrischen Schaltens und des Ladungseinfangs/-detrappings bedeutet.
Um die Wirkung des ferroelektrischen Schaltens weiter zu untersuchen, wurde die V GS, Reichweite wurde kontinuierlich auf (−6, 6 V) und (−6.5, 6.5 V) erhöht. Das gemessene Ich DS -V GS Kurven des HZO MoS2 FeFET bei V GS, Reichweite =(−6, 6 V) und (−6.5, 6.5 V) sind in Abb. 3a dargestellt. Ebenso wird das Speicherfenster gegen den Uhrzeigersinn mit dem erweiterten V . vergrößert GS, Reichweite . Bei V GS, Reichweite =(−6.5, 6.5 V), das MW gegen den Uhrzeigersinn liegt über 4 V und das Ein/Aus-Verhältnis steigt ebenfalls auf 10 7 , was auf das verbesserte Polarisationsschalten bei einer größeren externen angelegten Spannung zurückzuführen ist. Im Allgemeinen ist der Mechanismus, der dem in I . gezeigten Hystereseverhalten zugrunde liegt, DS -V GS Kurven während des bidirektionalen Sweeps von V GS ist die Schwellenspannungsverschiebung, die durch die vorherrschenden Effekte der Polarisationsumschaltung modifiziert werden kann, d. h. den NC-Effekt [30,31,32], was zu einer Hysterese gegen den Uhrzeigersinn führt. Eine weitere Studie zu verbesserten unterschwelligen Eigenschaften wurde in dem anderen Gerät unter einem geschrumpften V . durchgeführt GS, Reichweite . Das gemessene Ich DS -V GS und extrahierter Punkt SS—I DS Kurven des anderen Geräts bei V GS, Reichweite =(−3, 3 V) sind in Abb. 3b aufgetragen. Es wird gezeigt, dass bei V GS, Reichweite =(−3, 3 V), HZO/MoS2 FeFET weist SSFür . auf =51,2 mV/Dekade und SSRev =66,5 mV/Dekade. Das heißt, in HZO/MoS2 . kann gleichzeitig ein SS von unter 60 mV/Dekade und ein MW von 0,48 V erreicht werden FeFET bei Raumtemperatur, was ein Hinweis zur Unterscheidung zwischen NCFET und FeFET ist.
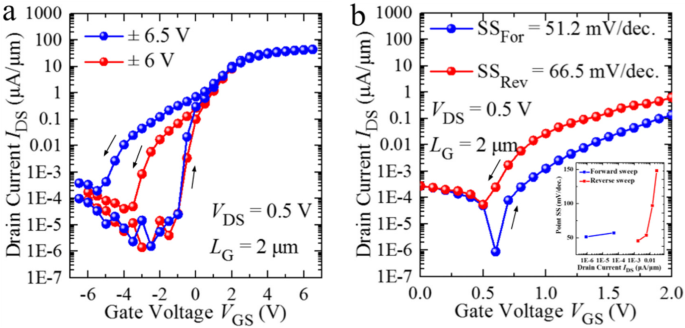
Der Gleichstromtest (DC) des HZO/MoS2 FeFET bei Drainspannung (V DS ) ist 0,5 V. a Der Vergleich zwischen Transferkurven mit 6 V und 6,5 V als Maximum der Backgatespannung. b Vergrößerte Ansicht der Übertragungskurven bei 0 bis −2 V Intervall von V GS, Reichweite =(−3, 3 V). Punkt unterschwellige Steigung (SS) als Funktion des Drainstroms (I DS ) des HZO/MoS2 FeFET ist (b ) eingefügt. Das Gerät weist SSFür . auf =51,2 mV/dez
Wie bekannt, kann bei NCFETs die SS bei Raumtemperatur aufgrund der Einbeziehung der negativen dielektrischen Gatekapazität (C ins ), die über das negative Steigungssegment von dP . erhalten werden kann /dE <0 durch ferroelektrischen Film induziert, was zum Gate-Stack-Faktor (m) <1 beiträgt. Der dem NC-Effekt zugrunde liegende Mechanismus [33] ist das durch den ferroelektrischen Film erzeugte Depolarisationsfeld [34,35,36,37,38]. Es wurde experimentell berichtet, dass aufgrund der unvollständigen Abschirmung an der Grenzfläche des ferroelektrischen Films [39] die verbleibende Polarisationsladung ein internes elektrisches Feld über dem ferroelektrischen Film erzeugen könnte, das der von außen angelegten Spannung entgegengesetzt ist, was zu einem erneuten Verteilung der Spannung über den Gate-Stapel und das verstärkte Kanaloberflächenpotential, als „Spannungsverstärkungseffekt“ bezeichnet [40,41,42]. Die Spannungsverstärkung kann normalerweise in zwei Teile unterteilt werden, die beschleunigte Variation des Kanaloberflächenpotentials und den anschließenden erhöhten Wert, was das steile EIN/AUS-Schalten und ein verbessertes I . ermöglicht EIN /Ich AUS , bzw. Für FeFET gibt es jedoch eine andere Geschichte. Nach dem Konzept der Kapazitätsanpassung zwischen ferroelektrischer Kapazität (C FE ) und Metalloxid-Halbleiterkapazität (C MOS ) [43,44,45], wenn |C FE |> C MOS , die theoretische Gesamtkapazität (C Gesamt ) positiv ist und das System stabil ist, was zu demselben Polarisationsverhalten während des bidirektionalen Wobbelns von V . führt GS und der stabile hysteresefreie NCFET. Eine gute Anpassung, die zu einer verbesserten SS und Steilheit führt, ist jedoch sehr schwierig zu erreichen, da sowohl C MOS und C FE sind sehr nichtlineare, vorspannungsabhängige Kondensatoren. Außerdem |C FE |> C MOS muss für den gesamten Betriebsspannungsbereich sichergestellt werden, um Hysterese zu vermeiden. Stattdessen einmal |C FE | <C MOS , das theoretische C Gesamt negativ ist und das System instabil ist, muss beim Bi-Switching von V . ein getrenntes Polarisationsverhalten auftreten GS um das C zu halten Gesamt positiv, was die Hysterese gegen den Uhrzeigersinn in FeFET für NVM-Anwendungen erzeugen könnte. Hier wird erwähnt, dass das Hystereseverhalten der Folgeeffekt der getrennten Polarisationsumschaltung ist, was bedeutet, dass die Breite des Hysteresefensters basierend auf dem Konzept der Kapazitätsanpassung leicht modifiziert werden kann, wie z i>V DS . Bei entsprechender Kapazitätsanpassung auch bei stark geschrumpften V GS, Reichweite =(−3, 3 V), HZO/MoS2 FeFET zeigt immer noch ein offensichtliches Hysteresefenster und das steile Umschalten von SSFor =51,2 mV/dec gleichzeitig, was weiter auf die Existenz des NC-Effekts (ferroelektrischer Polarisationseffekt) auch im Unterschwellenbereich hindeutet. Obwohl sich NCFET und FeFET unterscheiden, kann FeFET auch als Logikbaustein mit einem vergleichbar kleineren MW verwendet werden, wobei ein tiefer SS unter 60 mV/dec und ein höheres I . aufrechterhalten werden EIN /Ich AUS auch durch NC-Effekt.
Die Wirkung von V DS auf der Breite von MW wurde sorgfältig untersucht. Das Ich DS -V GS Kurven auf logarithmischen Skalen unter verschiedenen V DS sind in Abb. S3 gekennzeichnet. Es wird gezeigt, dass bei einem festen V GS, Reichweite =(−2, 2 V), die Werte von V GS extrahiert bei I DS =70 nA für das bidirektionale Sweepen von V GS alle verschieben sich in die negative Richtung. Inzwischen wurde auch gezeigt, dass die Variation des Vorwärts-Sweeps von V GS ist viel offensichtlicher als das des Rückwärts-Sweeps, was auf die signifikanten Phänomene eines negativen DIBL hinweist. Zu beachten ist, dass der negative DIBL-Effekt immer mit einem NC-Effekt auftritt [46, 47].
Nach obigem Gleichstromtest (DC) des HZO/MoS2 FeFET haben wir die gemessenen MWs für verschiedene P/E V GS Impulse mit einer Breite von 10 ms in Fig. 4a. MW ist definiert als die maximale Änderung ΔV TH nach P/E V GS Impulse. Während des gepulsten V GS Anwendung wurden die anderen Terminals auf V fixiert S =V D =0 V. Für die Leseoperation (R) V GS lag im Bereich von −1 V bis 1 V mit V D =0,5 V und V S =0 V. Wie in Fig. 4a gezeigt, werden die extrahierten MWs größer als P/E V GS Pulse steigen. Wenn das auferlegte KGV V GS Puls ist ± 3 V, das extrahierte MW beträgt 0,1 V. Wenn das auferlegte P/E V GS Puls ist ± 5,5 V, das extrahierte MW beträgt 0,275 V. Verglichen mit den MWs gegen den Uhrzeigersinn von 4 V und 0,48 V in Abb. 3a und b sind die extrahierten MWs nach P/E V GS Puls stark reduziert. Dies ist möglicherweise auf eine höhere Dichte von Einfangzuständen zurückzuführen, die durch hohe Luftfeuchtigkeit induziert wird [48]. Somit wird der Ladungseinfang-/Entfallmechanismus verbessert und die Hystereseschleife gegen den Uhrzeigersinn wird schließlich verringert. Darüber hinaus haben wir die Fahrradausdauer und die Datenspeicherung des HZO/MoS2 . untersucht FeFET unter P/E-Impulsen mit ± 5,5 V Höhe in Abb. 4b. Das Programm V GS Puls war 10 ms breit mit V S =V D =0 V. Abbildung 4b zeigt die gemessenen MWs als Funktion der Dauerzyklen. Der Dauerzyklus wird durch periodische P/R/E/R-Pulse der Back-Gate-Spannung gebildet. An das Backgate der Höhe von P, E, R angelegte Spannungen betrugen +5,5 V, –5,5 V bzw. 0 V. Und die Pulsbreite von P und E betrug 10 ms. Ein MW von 0,3 V kann eindeutig nach 10 3 . ohne nennenswerte Verschlechterung aufrechterhalten werden KGV-Zyklen. Mit zunehmender Anzahl der Dauerzyklen steigt das MW nach 10 Zyklen auf 0,38 V und fällt dann nach 600 Zyklen wieder auf 0,28 V ab. Das erste verbreiterte MW wird als Aufwacheffekt bezeichnet und das später geschrumpfte MW wird als Ermüdungseffekt bezeichnet. Der Wake-up-Effekt entspricht dem Depinning der Domänenwand, was zu einer Zunahme der schaltbaren Polarisationsdomänen des HZO-Films führt [49]. Der Ermüdungseffekt entspricht neu injizierten Ladungen, die die Domänenwände nach einer großen Anzahl von P/E-Zyklen festnageln [50]. Die Datenhaltung bei Raumtemperatur ist in Abb. 4c dargestellt. Hier ist die MW-Verschlechterung nach 10 4 . vernachlässigbar S. Daher kann aufgrund der gepunkteten Extrapolationslinien erwartet werden, dass ein MW von etwa 0,3 V über 10 Jahre haltbar ist. Wie in Fig. 4d dargestellt, ist das Gerät nach 10 3 . stabil Zyklen unter den P/E-Impulsen mit ± 3 V Höhen. Die Stabilität des HZO/MoS2 FeFET zeigt eine großartige Perspektive von Anwendungen in der nichtflüchtigen Speichertechnologie.

Speicherleistungen des HZO/MoS2 FeFET unter P/E-Impulsen. a Extrahierte MWs (MWs) unter P/E-Pulsen mit Höhen von ± 3 V, ± 4 V, ± 5 V, ± 5,5 V und ± 6 V. b Ausdauermessungen unter P/E-Pulsbedingungen. c Retentionscharakteristik des HZO/MoS2 FeFET. d Ausdauer des HZO/MoS2 FeFET für 10 3 Zyklen unter den P/E-Impulsen mit ± 3 V Höhen
Ein Vergleich der Gütezahl mit FeFET-basierten Geräten, die MoS2 . kombinieren und ferroelektrische Gatedielektrika sind in Tabelle 1 angegeben. Hier sind die Bauelementstruktur, die Restpolarisation, das elektrische Koerzitivfeld, die Hystereseschleifenrichtung, MW, die Arbeitsspannung, die Lebensdauerzyklen und die Retentionszeit aufgelistet. Es ist offensichtlich, dass das von uns hergestellte Gerät die dünnste ferroelektrische Schicht von 6 nm HZO und die niedrigste Arbeitsspannung im Vergleich zu anderen Arbeiten aufweist [12,13,14,15,16,17,18], was für die zukünftigen 2 nm . wichtig ist oder 3 nm-Prozessknoten des Back-End-of-Line-(BEOL)-Speichers. Durch Skalierung der Dicke der ferroelektrischen Schicht wurde bei einer niedrigen Arbeitsspannung von ± 3 V ein MW von etwa 0,1 V erreicht. Solch eine niedrige Arbeitsspannung kann auf die intrinsischen Eigenschaften der HZO-Schicht im Vergleich zu ihren Gegenstücken wie P . zurückgeführt werden (VDF-TrFE) oder HfO2 , die eine viel höhere Dicke hat. Darüber hinaus besitzt unser Gerät eine geringere Restpolarisation P r von 1,1 μC/cm 2 verglichen mit anderen berichteten FeFETs. Der schnelle Abfall des Retentionsverlustes in einem FeFET ist auf das Vorhandensein des Depolarisationsfeldes E . zurückzuführen ab , die von der unvollständigen Ladungskompensation aufgrund der Existenz des Al2 . kommt O3 Schicht. Hier, E ab ist direkt proportional zur remanenten Polarisation P r [51]. Somit ist das hohe E c und niedriges P r mach das Verhältnis E ab /E c in MoS2 /HZO-FeFET viel klein, was zu einem viel kleinen Retentionsverlust führt, der mit dem Depolarisationsfeldeffekt verbunden ist. Obwohl die Retentionsleistungen von MoS2 FeFETs basierend auf HZO und P(VDF-TrFE) liegen beide bei etwa 10 4 s muss der P(VDF-TrFE)-Film 150 nm betragen [17].
Schlussfolgerungen
Zusammenfassend haben wir MoS2 . mit wenigen Schichten untersucht -basierte ferroelektrische Speichertransistorbauelemente, die ein HZO-Backgate-Dielektrikum verwenden. Unsere hergestellten Bauelemente weisen eine durch ferroelektrische Polarisation induzierte Hysterese entgegen dem Uhrzeigersinn auf. Außerdem unser HZO/MoS2 ferroelektrischer Speichertransistor zeigte hervorragende Geräteleistungen:ein hohes Ein/Aus-Stromverhältnis von mehr als 10 7 und ein MW im Gegenuhrzeigersinn von 0,1 V bei einer P/E-Spannung von 3 V, was die Lebensdauer (10 3 Zyklen) und Retention (10 4 s) Leistung. Wir glauben daher, dass die Ergebnisse unserer MoS2 -basierte nichtflüchtige ferroelektrische Speichertransistoren bieten vielversprechende Perspektiven für die Zukunft von nichtflüchtigen 2D-Speicheranwendungen mit geringem Stromverbrauch.
Verfügbarkeit von Daten und Materialien
Die Autoren erklären, dass die Materialien, Daten und zugehörigen Protokolle den Lesern zur Verfügung stehen und alle für die Analyse verwendeten Daten in diesem Artikel enthalten sind.
Nanomaterialien
- Transistorbewertungen und -pakete (BJT)
- Einige Beispiele mit Wechselstromkreisen
- American Control Electronics:Niederspannungs-DC-Antrieb mit aufsteckbarer programmierbarer Platinenoption
- MoS2 mit kontrollierter Dicke für die elektrokatalytische Wasserstoffentwicklung
- Monodisperse Kohlenstoff-Nanosphären mit hierarchischer poröser Struktur als Elektrodenmaterial für Superkondensatoren
- UV-gehärtete, tintenstrahlgedruckte Silver Gate-Elektrode mit niedrigem spezifischen elektrischen Widerstand
- Frequenzmodulation und Absorptionsverbesserung von THz-Mikrobolometern mit Mikrobrückenstruktur durch spiralförmige Antennen
- Morphologie, Struktur und optische Eigenschaften von Halbleiterfilmen mit GeSiSn-Nanoinseln und gespannten Schichten
- Einwandige Kohlenstoff-Nanoröhrchen-dominierte mikrometerbreite Streifenmusterbasierte ferroelektrische Feldeffekttransistoren mit HfO2-Defektkontrollschicht
- Wachstum des Marktes für Niederspannungssteuerung



