Theoretische und experimentelle Studie über eine AlGaN/GaN-Schottky-Diode auf einem Si-Substrat mit Doppelheteroübergang
Zusammenfassung
Eine AlGaN/GaN-Schottky-Diode (SBD) mit Doppelheteroübergang wird theoretisch und experimentell auf dem GaN/AlGaN/GaN/Si-sub untersucht. Das zweidimensionale Lochgas (2DHG) und Elektronengas (2DEG) werden an der GaN-Oberseite/AlGaN- bzw. AlGaN/GaN-Grenzfläche gebildet. Im ausgeschalteten Zustand sind 2DEH und 2DHG teilweise erschöpft und verschwinden dann vollständig. Es verbleiben die festen positiven und negativen Polarisationsladungen, die den Polarisationsübergang bilden. Daher werden ein flaches elektrisches Feld im Driftbereich und eine hohe Durchbruchspannung (BV) erhalten. Darüber hinaus ist die Anode vertieft, um die Einschaltspannung (V EIN ). Der schadensarme ICP-Ätzprozess führt zu verbesserten Schottky-Kontakten, einem geringen Leckstrom und einem niedrigen V EIN erhalten wird. Die hergestellte SBD weist eine BV von 1109 V mit einem Anoden-Kathoden-Abstand (L AC ) von 11µm. Die hergestellten SBDs erreichen ein niedriges V EIN von 0,68 V mit guter Gleichmäßigkeit, einem hohen Ein/Aus-Stromverhältnis ∼ 10 10 bei Raumtemperatur ein niedriger spezifischer Einschaltwiderstand (R EIN,SP ) von 1,17 mΩ cm 2 , und eine hohe Baliga-Leistungszahl (FOM) von 1051 MW/cm 2 .
Einführung
Die laterale Diode auf AlGaN/GaN-Heterostrukturbasis ist aufgrund der hohen Elektronenbeweglichkeit des zweidimensionalen Elektronengases (2DEG), der hohen Elektronensättigungsgeschwindigkeit und des hohen elektrischen Durchbruchfeldes ein attraktives Bauelement [1, 2, 3]. Es wurden umfangreiche Anstrengungen unternommen, um eine niedrige Einschaltspannung (V EIN ), ein niedriger Sperrleckstrom und eine hohe Durchbruchspannung (BV) für die in Wandlern und Wechselrichtern verwendeten GaN-Dioden für Stromversorgungen und Leistungsfaktorkorrekturen [4,5,6,7,8,9,10,11,12] . Es wurden verschiedene Ansätze vorgeschlagen, um die ungleichmäßige Verteilung des elektrischen Felds zu lösen. Eine davon ist die Field-Plate (FP)-Technologie [5, 13]. Eine vollständig zurückgesetzte Anoden-SBD mit einer dualen Feldplatte erreicht eine hohe Durchbruchspannung von 1,9 kV mit 25 μm L AC [5]. Es kann auch die Einschaltspannung erheblich reduzieren, während eine hohe Durchbruchspannung aufrechterhalten wird. Darüber hinaus wurde das konventionelle REduced SURface Field (RESURF)-Konzept, das üblicherweise in der Siliziumtechnologie verwendet wird, in GaN HEMT demonstriert [14]. Darüber hinaus wird vorgeschlagen, dass der Polarisationsübergang (PJ), der aus dem zweidimensionalen Lochgas (2DHG) über dem 2DEG besteht, die Beziehung zwischen dem spezifischen Einschaltwiderstand (R EIN,SP ) und BV [15,16,17,18]. GaN-basierte Bauelemente basierend auf dem PJ-Konzept wurden auf Saphir- und SiC-Substraten demonstriert, während die hohen Kosten und kleinen Durchmesser von GaN auf SiC-Substraten einer kommerziellen Massenanwendung entgegenstehen. GaN-auf-Si mit großem Durchmesser gilt aufgrund der geringen Kosten als vielversprechende Wahl [19,20,21,22]. Daher ist die Leistung der PJ-Diode auf Siliziumsubstraten eine Untersuchung wert.
In dieser Arbeit haben wir eine GaN/AlGaN/GaN-auf-Si-Schottky-Diode mit Doppelheteroübergang (DJ) vorgeschlagen und experimentell demonstriert. Der Polarisationsübergangseffekt wird durch Simulationen und Experimente bestätigt. Das flache elektrische Feld (E-Feld) zwischen den Anoden- und Kathodenelektroden wird erreicht. Der ICP-Prozess zum Ätzen des Schottky-Grabens ist optimiert, um einen niedrigen Sperrleckstrom und ein niedriges V . zu erreichen EIN mit ausgezeichneter Ätzgleichmäßigkeit. Auch der ohmsche Kontaktprozess ist auf einen geringen Kontaktwiderstand (für 2DEG) basierend auf der angepassten Epitaxieschicht (mit 45 nm GaN-Top) optimiert. Daher wird für die SBDs mit 11 μm L . eine Durchbruchspannung von 1109 V erreicht AC und Baligas Leistungszahl (FOM) beträgt 1051 MW/cm 2 . Die Temperaturabhängigkeit und das dynamische R EIN,SP Auch die Leistung wird untersucht.
Methode und Experiment
Die Epitaxieschicht wurde durch metallorganische chemische Gasphasenabscheidung auf 6-in-Silizium vom p-Typ aufgewachsen, bestehend aus 3,5-μm-GaN-Pufferschicht, 150-nm-GaN-Kanalschicht, 1-nm-AlN-Zwischenschicht, 45-nm-Al 0,25 Ga0,75 N-Barriereschicht und 45-nm-GaN-Oberschicht von unten nach oben. Die obere GaN-Schicht umfasst eine 35-nm-p-GaN-Schicht und eine undotierte 10-nm-GaN-Schicht. Bei einer gegebenen AlGaN-Dicke von 45 nm steigt die 2DHG-Dichte mit der Zunahme der Dicke der GaN-Oberseite [22]. Die dicke GaN-Deckschicht ist entscheidend für das hochdichte 2DHG, während sie dem niedrigen ohmschen Übergangswiderstand (für 2DEG) entgegenwirkt. Die schematischen Ansichten der vorgeschlagenen Doppelheteroübergang-Schottky-Barriere-Diode (DJ SBD) sind in Fig. 1a gezeigt. Die SBD-Herstellung begann mit der Mesa-Isolation durch Cl2 /BCl3 -basiertes Ätzen mit induktiv gekoppeltem Plasma (ICP) bis zu einer Tiefe von 300 nm. Dann wurden der ohmsche Graben und der Schottky-Anodengraben mit dem ICP-Ätzprozess mit geringer Beschädigung gebildet. Die Tiefe des ohmschen Grabens und des Schottky-Anodengrabens betrug 50 nm bzw. 90 nm, was durch Rasterkraftmikroskopie (AFM) bestätigt wurde. Tetramethylammoniumhydroxid (TMAH)-Lösung bei 85 °C für 15 min wurde eingeführt, um die Nachätzrückstände zu entfernen und die Grabenseitenwand nach Beendigung des Ätzprozesses zu modifizieren [23]. Dann das Tempern bei 400°C für 10 min in N2 Umgebung durchgeführt wurde. Die ohmsche Kathode wurde anschließend durch Elektronenstrahl-verdampftes Ti/Al/Ni/Au (20/140/55/45 nm) gebildet, das bei 870 °C für 35 s in N2 . geglüht wurde Umgebung, mit einem Übergangswiderstand (R C ) von 0,49 ·mm. Schließlich wurden Anodenmetall und die Verbindungen durch Ni/Au abgeschieden, um den Herstellungsablauf zu vervollständigen. Die Geräte verfügten über verschiedene L AC von 7 bis 11µm. Abbildung 1b zeigt das hochauflösende TEM-Querschnittsbild der Anode nach ICP und Metallabscheidung, und die Schichtstruktur wurde deutlich beobachtet.
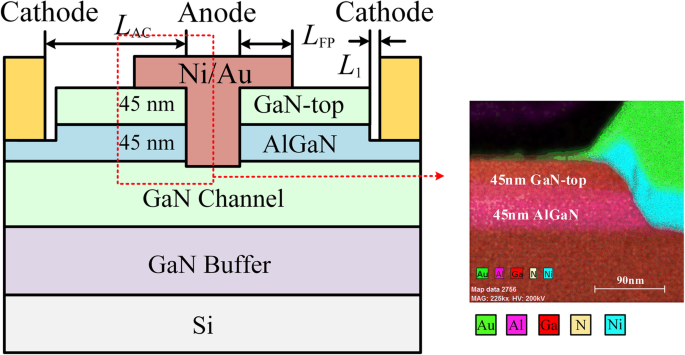
a Querschnitt des vorgeschlagenen Doppelheteroübergangs-AlGaN/GaN-SBD und des Hauptherstellungsprozesses. L AC ist die Länge von Anode zu Kathode. L FP und L 1 sind 1 µm bzw. 2 µm. b HR-TEM-Bild der Anode nach ICP und Metallabscheidung
Das 2DEG wird durch die positiven Polarisationsladungen entlang der AlGaN/GaN-Grenzfläche induziert. Die obere GaN/AlGaN-Grenzfläche weist negative Polarisationsladungen auf und erzeugt daher 2DHG an der oberen Grenzfläche [15]. Die Lücke zwischen der Driftregion und der Kathode (L 1 ) wird verwendet, um den Lochstrompfad zu reduzieren, wie in Abb. 2 gezeigt. Wir haben nur den Einfluss von L . untersucht 1 von 2 bis 3 µm auf die Vorwärts- und Rückwärtssperreigenschaften aufgrund der Grenzen des ursprünglichen Layoutdesigns. Das V EIN und R EIN,SP keine Änderung anzeigen, weil L 1 beeinflusst nicht den Schottky-Kontakt und den Elektronenstrompfad. Außerdem nimmt der BV mit der Zunahme von L . leicht ab 1 wegen der verkürzten Driftzone. Der Betriebsmechanismus der DJ-SBDs unter Vorwärtsspannung ist fast der gleiche wie bei den herkömmlichen SBDs, was bedeutet, dass 2DHG den Elektronenstrompfad von der Kathode zur Anode kaum beeinflusst. Mit zunehmender Sperrspannung werden 2DEG und 2DHG vollständig aufgebraucht. Es verbleiben feste positive und negative Polarisationsladungen, die den Polarisationsübergang bilden. Als Ergebnis wird eine flache E-Feldverteilung zwischen Kathode und Anode erhalten (Abb. 3).
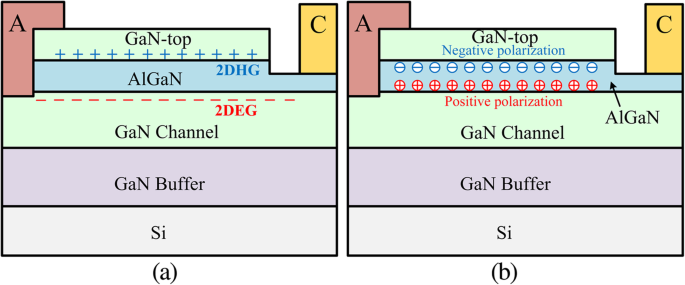
Analyse der Funktionsweise von DJ-SBDs a Null-Bias und b umgekehrte Vorspannung

Elektrische Feldverteilung entlang der AlGaN/GaN-Kanal-Heterogrenzfläche durch TCAD-Simulation. Der Al-Anteil ist als 0,25 definiert. Die Nettoakzeptordichte (tiefes Niveau) in der Pufferschicht wird auf 1,5 × 10 16 . eingestellt cm −3 und das Energieniveau liegt 0,45 eV unter dem Leitungsbandminimum. Die Akzeptordichte der AlGaN/GaN-Grenzfläche wird auf 6 × 10 12 . eingestellt cm −3 und das Energieniveau liegt 0,23 eV unter dem Leitungsbandminimum
Wie in Fig. 3 gezeigt, wurden die Durchbruchscharakteristik und der Polarisationsübergangsmechanismus durch 2-D Sentaurus TCAD von Synopsys bestätigt. Wir hatten mehrere wichtige physikalische Phänomene in der Simulation berücksichtigt, darunter Bandlückenverengung, Polarisation, Elektronen-/Loch-Mobilität, Stoßionisation und SRH-Rekombination.
Zur Bestimmung der Dichte- und Mobilitätswerte von 2DHG oder 2DEG wurde eine Hall-Effekt-Messung verwendet [22]. Die Messungen wurden nach der Van-der-Pauw-Methode bei Raumtemperatur durchgeführt. Zur Messung von 2DHG gemäß Ref. [17] wurden Hall-Messproben mit ohmschen Ni/Au-Kontakten hergestellt. Die Dichte und Mobilität des 2DHG betrug 9 × 10 12 cm −2 und 15 cm 2 /V s bzw. Der 2DEG wurde von den Proben mit vertiefter GaN-Oberseite und teilweise AlGaN, hergestellt mit ohmschen Ti/Al/Ni/Au-Kontakten (für 2DEG), gemessen. Die Dichte und Mobilität des 2DEG betrug 8,5 × 10 12 cm −2 und 970 cm 2 /V s bzw. Die Hall-Messungen zeigten, dass die Lochmobilität über 100 cm 2 . immer noch viel geringer war als die Bulk-Mobilität /V s. Die Verschlechterung der Mobilität wurde der Diffusion von Mg vom p-GaN zum undotierten GaN während des MOCVD-Wachstums zugeschrieben.
Ergebnisse und Diskussion
Das gemessene I-V Vorwärtscharakteristik der SBDs mit verschiedenen L AC sind in Abb. 4a und b aufgetragen. Die Einschaltspannung (V EIN ) beträgt 0,68 V mit einer kleinen Abweichung von 0,02 V. Der Idealitätsfaktor und die Barrierehöhe der SBDs werden zu 1,44 ± 0,15 bzw. 0,76 ± 0,04 eV berechnet. Abbildung 4a zeigt, dass die hohe Durchlassstromdichte von 183 mA/mm und 144 mA/mm (bei einer Vorwärtsspannung von 2,5 V) und der Einschaltwiderstand von 0,642 und 1,17 mΩ cm 2 werden bei L . erreicht AC =7 bzw. 11 μm. Darüber hinaus ein ausgezeichnetes Ein-/Aus-Stromverhältnis ∼ 10 10 wird wie in Fig. 4b gezeigt erhalten. Die Subthreshold-Steigung (SS) beträgt 63,0 mV/dec, was nahe am idealen SS liegt (59,6 mV/dec).
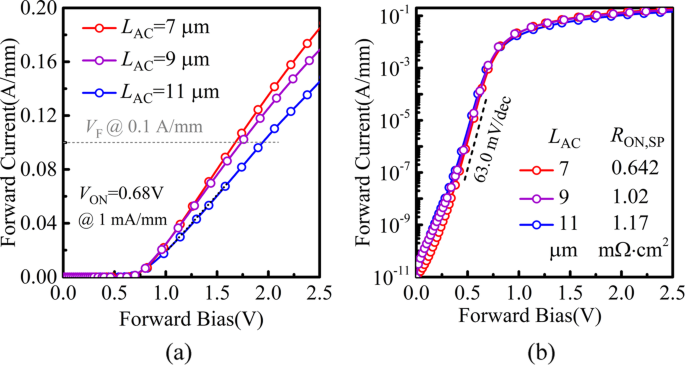
Gemessene Vorwärtsspannung I-V Eigenschaften von DJ-SBDs in a linear und b halblogarithmischer Maßstab mit unterschiedlichem L AC
Abbildung 5a zeigt die gemessene Rückwärtsblockierung I-V Eigenschaften der SBDs mit verschiedenen L AC bei 300 K Die Durchbruchspannung der Geräte mit unterschiedlichem L AC 803 V, 940 V bzw. 1109 V bei einem Leckstrom von 1 mA/mm beträgt. Die Dichten von 2DEG und 2DHG werden während der Simulation als gleich angenommen. Die experimentellen Ergebnisse zeigen jedoch, dass die Dichten von 2DHG (9 × 10 12 cm −2 ) sind etwas höher als die von 2DEG (8,5 × 10 12 cm −2 ). Der Unterschied zwischen den festen positiven und negativen Polarisationsladungen während des Sperrzustands beeinflusst den Ladungsausgleich und verschlechtert somit die Durchbruchspannung. Der Einfluss des L AC über die BV und die R EIN,SP ist in Fig. 5b gezeigt. Eine nahezu lineare Beziehung zwischen BV und L AC erhalten, was das relativ flache seitliche E-Feld im Driftbereich impliziert. Aufgrund des Polarisationsübergangseffekts weist das Gerät eine hohe Baliga-Leistungszahl auf (FOM =BV 2 /R EIN,SP ) von 1051 MW/cm 2 (@ L AC =11 μm).
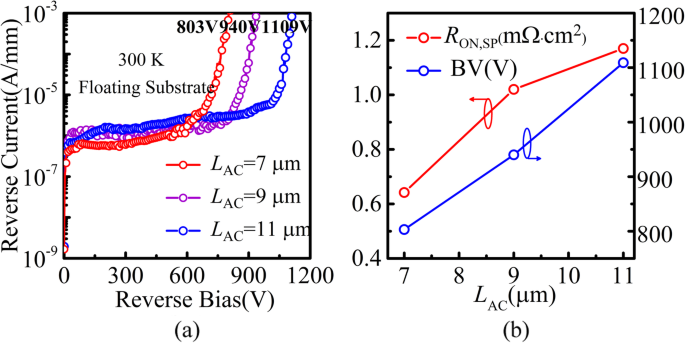
a Gemessene Rückwärtssperrung I-V Eigenschaften von DJ-SBDs mit unterschiedlichen L AC (b ) R EIN,SP und BV als Funktionen von L AC
Der Ätzprozess ist entscheidend für die hochwertige Schottky-Schnittstelle und den ohmschen Kontakt. Abbildung 6a zeigt die Oberflächenmorphologie des vertieften Grabens nach dem ICP-Ätzen (bei 5°C) und der TMAH-Lösung. Die Ätzrate beträgt ungefähr 4,9 nm/min und das endgültig ausgewählte Rezept ist mit einem Cl2 von 4 sccm, eine ICP-Leistung von 50 W und eine HF-Leistung von 15 W. Der Effektivwert der Rauheit (RMS) beträgt 0,244 nm mit einer Scanfläche von 2 × 2 μm 2 .
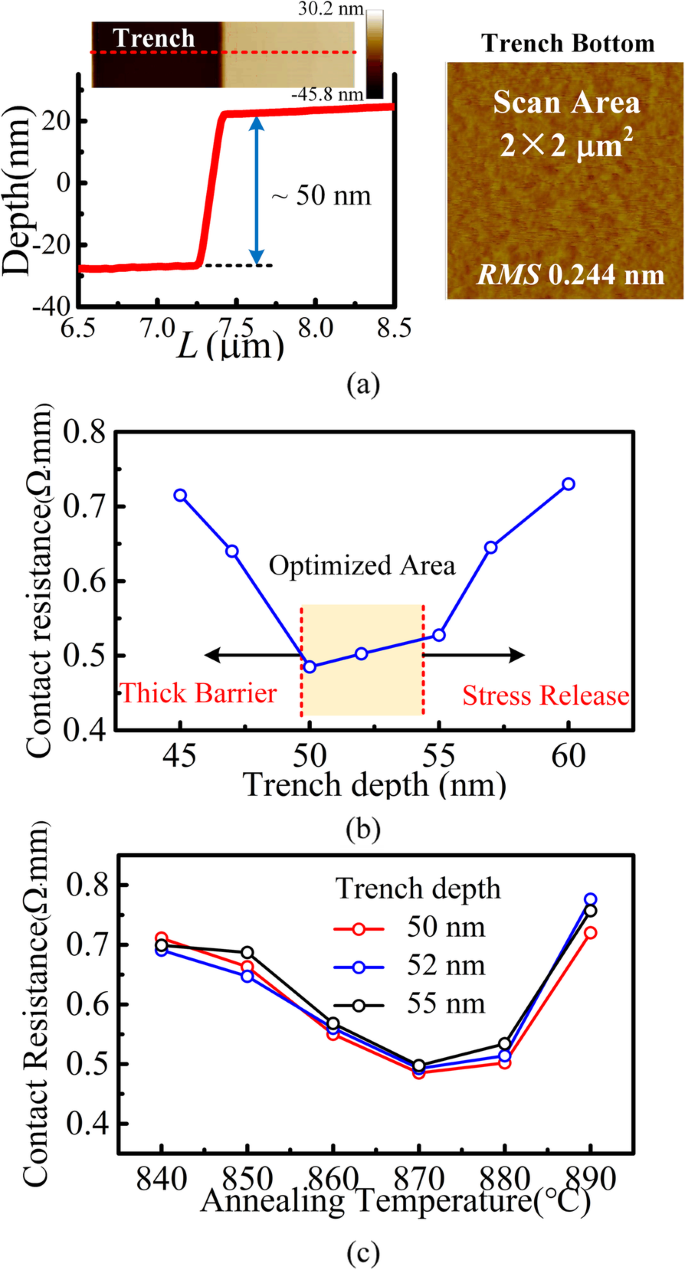
a AFM-Morphologie des Grabens nach dem ICP-Ätzen. b Einfluss der Ätztiefe auf den ohmschen Kontaktwiderstand durch TLM-Test. c Kontaktwiderstand als Funktion der Glühtemperatur bei einer Grabentiefe von 50 bis 55 nm. Die Temperzeit betrug 35 s
Da die angepasste Epitaxieschicht eine 45-nm-GaN-Oberschicht und eine 45-nm-AlGaN-Schicht umfasst, unterscheidet sich der Ohmsche Kontaktprozess (für 2DEG) von den herkömmlichen SBDs. Ohne Vertiefung sowohl der GaN-Oberseite als auch der AlGaN-Barriereschichten ist ein niedriger Kontaktwiderstand durch Tempern aufgrund der Potentialbarriere zwischen dem ohmschen Metall und dem 2DEG schwierig zu erreichen. Ist die Barriere jedoch zu stark vertieft, führt der Stressabbau zu einer Verringerung der 2DEG-Konzentration. Die zusätzlichen Prozesse werden verwendet, um den ohmschen Kontaktwiderstand zu reduzieren. Die Oberflächen der Proben werden mit der HCl-Lösung behandelt, um die native Oxidschicht vor der Abscheidung zu entfernen. Darüber hinaus wird die Plasmaoberflächenbehandlung angewendet (ICP-Leistung 50 W BCl3 10 sccm 3 min), um Oberflächendonatorzustände einzuführen [24]. Abbildung 6b zeigt die Abhängigkeit des Kontaktwiderstands von der Grabentiefe. Die optimierte Tiefe wird von 50 bis 55 nm erreicht. Das schnelle thermische Glühen (RTA) bei hoher Temperatur für den Ti/Al/Ni/Au-Kontakt wird in Abb. 6c untersucht. Die Glühtemperatur beträgt 840 bis 890 °C, und die 870 °C ergeben den niedrigsten Kontaktwiderstand. Glühen bei hoher Temperatur, d. h. 870 °C, fördert die Bildung von TiN an der Grenzfläche Ti/Nitrid. Eine höhere Temperatur (z. B. 890 °C) erhöht jedoch die Interdiffusion von Au und Al, was für die Bildung guter ohmscher Kontakte nachteilig ist.
Abbildung 7a–c zeigen die statistischen Diagramme der statischen Eigenschaften einschließlich V EIN , V F und BV. Die Daten werden aus 72 SBDs mit L . extrahiert AC von 7, 9 und 11 µm, hergestellt in 3 separaten Prozessläufen. Die Geräte zeigen ein stabiles Vorwärtseinschaltverhalten und die V EIN ist unabhängig mit L AC , weil V EIN wird hauptsächlich durch den Schottky-Kontakt bestimmt. Der schadensarme ICP-Ätzprozess, die präzise kontrollierte Grabentiefe und die hochwertige Schottky-Grenzfläche tragen zur hervorragenden Gleichmäßigkeit des V . bei EIN und V F . Mit der Zunahme von L AC (von 7 auf 11 µm) wird in den vorgeschlagenen Strukturen ein monotoner Anstieg (∼ 100 µV/µm) der BV beobachtet. Abbildung 7d zeigt die Histogrammstatistik des V EIN für 72 Geräte, und der Mittelwert beträgt 0,68 V mit einer kleinen Standardableitung von 0,02 V.

Statistische Diagramme von a Einschaltspannung, b Durchlassspannung und c Durchbruchspannung extrahiert aus 72 SBDs mit L AC von 7, 9 und 11 µm, hergestellt in 3 separaten Prozessläufen. d Verteilung von V EIN für 72 Geräte
Die Temperaturabhängigkeit der Rückwärts- und Vorwärtscharakteristik wird in Abb. 8 bewertet. Wie in Abb. 8a gezeigt, führt eine Erhöhung der Umgebungstemperatur von 300 auf 475 K zu einer Erhöhung des R EIN,SP um den Faktor 1,94.
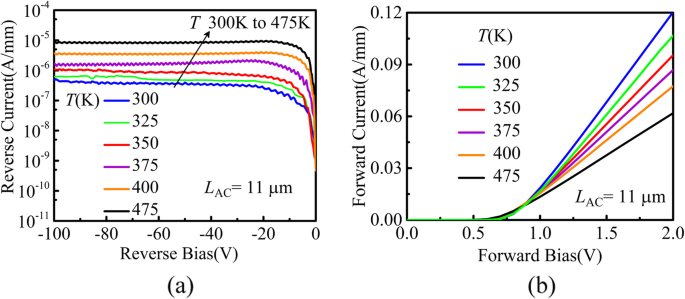
a Rückableitstrom und b Vorwärtscharakteristik der DJ SBDs bei unterschiedlichen Temperaturen
Die dynamischen Eigenschaften der DJ SBDs werden mit dem Agilent B1505A Power Device Analyzer gemessen. Die Ruhe-Vorspannungspunkte des Anodenpulses werden auf – 10 V, – 20 V, – 30 V, – 40 V, – 70 V und – 100 V mit der Anodenpulsbreite und -periode von 0,5 ms/500 ms eingestellt. Abbildung 9b zeigt das dynamische R EIN,SP als Funktion der Belastungsspannung. Das dynamische R EIN,SP selbst bei 100 V beträgt die Reservespannung nur das 1,18-fache derjenigen ohne Rückspannung, vergleichbar mit Ref. [8]. Der begrenzte Anstieg des dynamischen R EIN,SP trägt zur Reduzierung des Schnittstellenzustands bei. Die Verschlechterung des dynamischen R EIN,SP braucht weitere Arbeit.
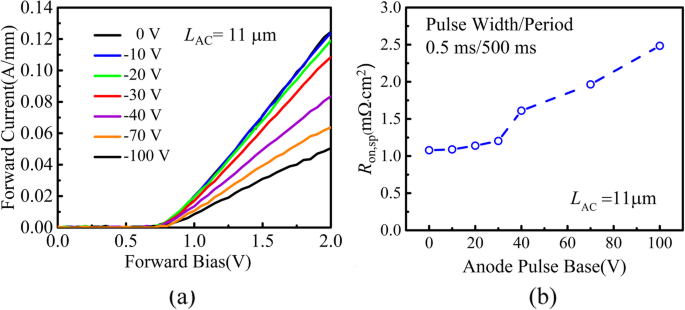
a I-V Eigenschaften bei der Pulsmessung. b Extrahiertes R EIN,SP gegen Anodenpulsbasis mit Pulsbreite/Periode =0,5 ms/500 ms
Abbildung 10 zeigt die Benchmark-Darstellung von BV gegen R EIN,SP für GaN-Leistungsdioden auf Si/SiC/Saphir-Substraten [8, 10, 22, 25,26,27,28,29,30,31]. Das vorgeschlagene Gerät mit L AC von 11 μm zeigt eine BV von 1109 V mit einem entsprechenden R EIN,SP von 1,17 mΩ cm 2 , was zu einem hohen FOM von Baliga von 1051 MW/cm 2 . führt . Dieser Wert ist das beste Ergebnis unter den seitlichen GaN-Leistungsdioden auf einem Si-Substrat.
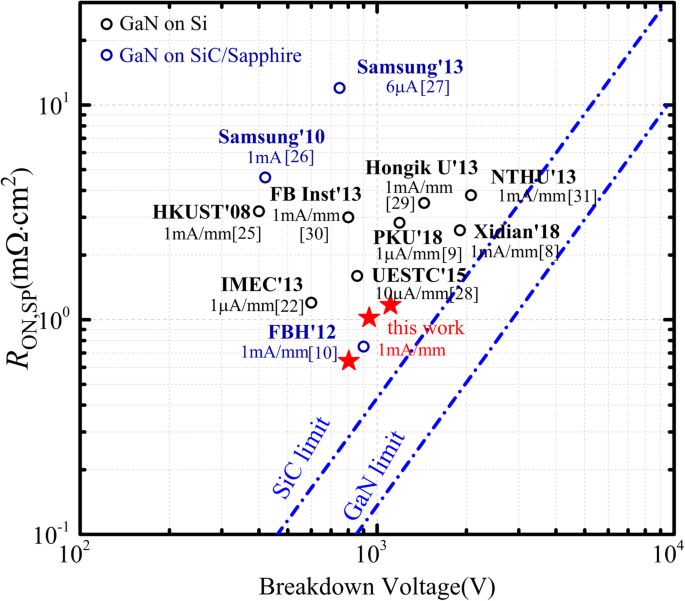
Benchmark-Diagramm von BV gegen R EIN,SP einer GaN-Leistungsdiode auf SiC/Saphir/Si-Substraten. Die zur Definition der Aufschlüsselung verwendete umgekehrte Leckage ist ebenfalls angegeben
Schlussfolgerung
Es wird eine Doppelheteroübergangs-GaN/AlGaN/GaN-auf-Si-SBD mit einem hohen Gütefaktor hergestellt. Der ICP-Ätzprozess mit geringer Beschädigung führt zu optimierten ohmschen und Schottky-Kontakten für das vorgeschlagene Gerät. Daher ist ein niedriges V EIN von 0,68 V mit guter Gleichmäßigkeit und niedrigem R EIN,SP von 1,17 mΩ cm 2 erhält man im Gerät mit L AC von 11 μm. Ein hoher FOM von Baliga von 1051 MW/cm 2 wird durch den Polarisationsübergangseffekt erreicht. Die hohe Leistung zusammen mit der kostengünstigen GaN-on-Si-Technologie bietet großes Potenzial für zukünftige Leistungsanwendungen.
Verfügbarkeit von Daten und Materialien
Alle während dieser Studie generierten oder analysierten Daten sind in diesem Artikel enthalten.
Abkürzungen
- SBD:
-
Schottky-Diode
- 2DEG/2DHG:
-
Zweidimensionales Elektron/Loch-Gas
- MOCVD:
-
Metallorganische chemische Gasphasenabscheidung
- ICP:
-
Induktiv gekoppeltes Plasma
- TEM:
-
Transmissionselektronenmikroskop
- AFM:
-
Rasterkraftmikroskop
- BV:
-
Durchbruchspannung
- R EIN,SP :
-
Spezifischer Einschaltwiderstand
- V EIN :
-
Einschaltspannung
- FOM:
-
Verdienstzeichen
Nanomaterialien
- Einfluss von Oberflächenzuständen und Aluminium-Molekülfraktion auf das Oberflächenpotential und 2DEG in AlGaN/GaN-HEMTs
- Experimentelle Forschung zur Stabilität und natürlichen Konvektion von TiO2-Wasser-Nanofluid in Gehäusen mit unterschiedlichen Rotationswinkeln
- Untersuchung der Oberflächenpolarisation einer Al2O3-beschichteten GaN/AlGaN/GaN-Heterostruktur durch winkelaufgelöste Röntgenphotoelektronenspektroskopie
- RGO und dreidimensionale Graphen-Netzwerke modifizierte TIMs mit hoher Leistung gemeinsam
- Experimentelle Studie zu den Strömungs- und Wärmeübertragungseigenschaften von TiO2-Wasser-Nanofluiden in einem spiralförmig geriffelten Rohr
- Graphen/Polyanilin-Aerogel mit Superelastizität und hoher Kapazität als hochkompressionstolerante Superkondensatorelektrode
- Experimentelle Studie von in 5-Fluorouracil eingekapselten Ethosomen in Kombination mit CO2-fraktioniertem Laser zur Behandlung hypertropher Narben
- Ein Überblick über die Ga2O3-Halbleiter-basierte Schottky-Diode mit ultrabreiter Bandlücke für Anwendungen in der Leistungselektronik
- Experimentelle und theoretische Studien zum Mo/Au-Schottky-Kontakt an mechanisch abgeblätterten β-Ga2O3-Dünnschichten
- Vor- und Nachteile von hohen und niedrigen Schrägungswinkeln



