Ein neuartiger dopingfreier, flossenförmiger SiGe-Kanal-TFET mit verbesserter Leistung
Zusammenfassung
In dieser Arbeit wird ein dotierungsfreier flossenförmiger SiGe-Kanal-TFET (DF-TFET) vorgeschlagen und untersucht. Um einen hocheffizienten, dotierungsfreien Leitungstunnelübergang zu bilden, werden ein flossenförmiger SiGe-Kanal und eine Gate/Source-Überlappung induziert. Durch diese Methoden kann der DF-TFET mit hohem Durchlassstrom, Schaltverhältnis von 12 Größenordnungen und ohne offensichtlichen ambipolaren Effekt erhalten werden. Hohe κ Materialstapelgate-Dielektrikum wird induziert, um die Leckage im Sperrzustand, die Schnittstelleneigenschaften und die Zuverlässigkeit des DF-TFET zu verbessern. Darüber hinaus können durch die Verwendung der dotierungsfreien Kanal- und Finnenstruktur die Schwierigkeiten des Dotierungsprozesses und der Bildung einer asymmetrischen Gate-Überlappung gelöst werden. Als Ergebnis kann die Struktur des DF-TFET eine gute Anwendbarkeit bei der Herstellung aufweisen und den Platzbedarf erheblich reduzieren. Der physikalische Mechanismus des Geräts und der Einfluss von Parametern auf die Leistung werden in dieser Arbeit untersucht. Schließlich wird der Durchlassstrom (I EIN ) von 58,8 μA/μm, minimaler unterschwelliger Swing von 2,8 mV/dec (SSmin ), durchschnittlicher unterschwelliger Swing (SSavg ) von 18,2 mV/dec erreicht werden. Mit verbesserten Kapazitätseigenschaften kann eine Grenzfrequenz von 5,04 GHz und ein Verstärkungsbandbreitenprodukt von 1,29 GHz erhalten werden. Mit verbesserter Leistung und Robustheit kann DF-TFET ein sehr attraktiver Kandidat für Ultra-Low-Power-Anwendungen sein.
Einführung
Mit der Verkleinerung von MOSFETs werden Schaltgeschwindigkeit, Hochfrequenzleistung, Dichte, Kosten und Funktionalität integrierter Schaltungen (ICs) stark verbessert[1]. Mit fortschreitender Spannungsabsenkung wird der inakzeptable hohe Stromverbrauch jedoch zu einem ernsthaften Problem für moderne ICs [1, 2]. Profitieren Sie vom Band-zu-Band-Tunneling-Mechanismus, Tunnel-FET (TFET) mit steilem SS und geringem Stromverbrauch bringen eine neue Lösung für dieses Problem und erregten viel Aufmerksamkeit [3,4,5,6,7,8,9 ]. Die Einsatzmöglichkeiten konventioneller siliziumbasierter TFETs sind jedoch durch den sehr geringen Durchlassstrom (I EIN ), niedriges Schaltverhältnis, starker ambipolarer Effekt und großer durchschnittlicher unterschwelliger Swing (SS) [1, 7]. Um die Leistung von TFETs zu verbessern, wurden in den letzten Jahren Anwendungen neuer Strukturen und neuer Materialien auf TFETs vorgeschlagen. Beispielsweise wurden in den letzten Jahren TFETs mit einer Schicht mit erhöhter Tunnelrate vorgeschlagen [5, 10, 11]. Mit dieser Schicht wird die effektive Länge des Tunnelwegs reduziert und führt zu einer offensichtlichen Verbesserung der Tunnelrate. Darüber hinaus werden TFETs mit verbesserter Gate-Struktur von vielen Forschungsgruppen untersucht [12,13,14,15,16,17,18,19,20]. Das Konzept des Leitungstunnelns wird in L-TFET eingeführt [17,18,19]. Als Ergebnis SSDurchschn. von 42,8 mV/Dekade und I EIN von 10 −6 A/μm kann durch L-TFET erreicht werden. Um die Leistung von TFETs weiter zu verbessern, wird über einen verbesserten TG-TFET mit T-förmiger Überlappung und dualer Source berichtet [20, 21]. Als Ergebnis ist das Ich EIN des TG-TFET erreicht 81 μA/μm. Um die Leistungsfähigkeit der Vorrichtung weiter zu verbessern, sind hohe Anforderungen an das Dotierungsprofil des Tunnelübergangs erforderlich. Gießereiingenieure müssen eine sehr steile, abrupte Verbindung herstellen, die nur einige Nanometer dick ist, und dies ist sehr schwierig zu erreichen. Um diese Schwierigkeit zu vermeiden, wird von Forschungsgruppen über den dotierungsfreien TFET (DL-TFET) auf einem dünnen intrinsischen Halbleiterfilm unter Verwendung des Ladungsplasmakonzepts berichtet [22, 23]. Bei DL-TFET können die Herstellungsschwierigkeiten durch Entfernen des ultrasteilen abrupten Übergangs erheblich reduziert werden. Die durch zufällige Dotierstoffschwankungen induzierte Leistungsverschlechterung kann vermieden werden. Darüber hinaus erfordert die Herstellung des DL-TFET keine hohen thermischen Budgets zum Erzeugen von Source und Drain, was die Möglichkeit eröffnet, TFETs auf anderen Substraten wie beispielsweise einkristallinem Silizium auf Glas zu realisieren. Als Ergebnis wurde die SS von DL-TFET stark verbessert. Aufgrund der geringen Effizienz des Punkttunnelübergangs ist der Strom des DL-TFET jedoch nicht hoch genug, was es schwierig macht, die ständig steigenden Anforderungen moderner Schaltungsanwendungen zu erfüllen.
In diesem Beitrag wird ein neuartiger dotierungsfreier flossenförmiger SiGe-Kanal-TFET (DF-TFET) vorgeschlagen und untersucht. Um die Leistung und Robustheit des Bauelements zu verbessern, werden ein Leitungstunnelübergang und SiGe-Material auf den DF-TFET aufgebracht. Inzwischen wird die Gate-Metallaustrittsarbeit optimiert, um die Tunnelrate weiter zu verbessern. Darüber hinaus verringerte der dotierungsfreie Kanal die Schwierigkeit des Herstellungsprozesses, während die Finnenstruktur die asymmetrische Gate/Backgate-Herstellung anwendbar macht. Dadurch wird der Durchlassstrom (I EIN ) von 58,8μA/μm, Leckstrom im Sperrzustand (I AUS ) in der Nähe von 10 −11 μA/μm, durchschnittlicher unterschwelliger Swing (SSavg ) von 18,2 mV/dez und minimaler unterschwellenwert (SSmin .) ) von 2,8 mV/dez kann mit DF-TFET erreicht werden. Bei relativ kleiner Gate-Kapazität (C gg ) und Gate-zu-Drain-Kapazität (C gd ) kann eine gute analoge/HF-Leistung erzielt werden. Schließlich wird die Grenzfrequenz (f T ) erreichte 5,04 GHz und das Bandbreitenprodukt (GBW) erreichte 1,29 GHz.
Der Aufbau dieser Arbeit ist wie folgt:Der Abschnitt „Gerätestruktur und Simulationsverfahren“ zeigt die TCAD-Simulationsmethoden dieser Arbeit. Die Struktur und die Parameter von DF-TFET werden eingeführt. Die Unterschiede und Vorteile von DF-TFET gegenüber DL-TFET und TG-TFET werden aufgezeigt. Der Mechanismus, die Charakteristik und die analoge/HF-Leistung von DF-TFET werden im Abschnitt „Ergebnisse und Diskussion“ besprochen. In diesem Abschnitt wird ein Leistungsvergleich zwischen DF-TFET, DL-TFET und TG-TFET durchgeführt. Darüber hinaus werden in diesem Abschnitt der Einfluss der Geräteparameter auf die Leistung und die typischen HF-Parameter von DF-TFET untersucht. Um das Potenzial von DF-TFETs in Ultra-Low-Power-Anwendungen besser zu verstehen, wurden Vergleiche der elektrischen Eigenschaften verschiedener TFETs und DF-TFETs unter Niederspannungsvorspannung durchgeführt.
Gerätestruktur und Simulationsverfahren
Die vorgeschlagene Struktur des DF-TFET ist in Abb. 1a dargestellt. Um die Geräteleistung zu verbessern, wird ein Linientunnelübergang auf den dotierungsfreien flossenförmigen SiGe-Kanal durch das Ladungsplasmakonzept angewendet [24, 25]. Es ist bekannt, dass die Dicke des Gatedielektrikums den Tunnelstrom signifikant beeinflussen kann. Dies liegt daran, dass im Ergebnis der WKB-Näherung [26], wie in Gl. (1) hängt die Tunnelwahrscheinlichkeit von der effektiven Screening-Länge ab (λ ), effektive Trägermasse (m * ), Energiebandlücke (E g ) und effektives Screening-Energiefenster (ΔΦ ).
$$T_{{{\text{WKB}}}} \approx \exp \left( { - \frac{{4\lambda \sqrt {2m^{ * } } \sqrt {E_{{\text{g}} }}^{3} } }}{{3q\hbar (E_{{\text{g}}} + \Updelta \Phi)}}} \right)$$ (1)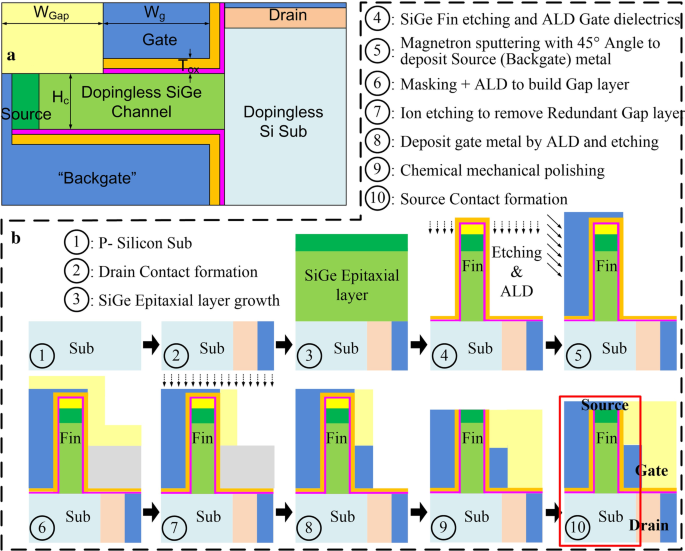
a Struktur und b Fertigungsablauf von DF-TFET
Reduzierung der Dicke des Gate-Dielektrikums oder Verwendung eines hohen κ Dielektrikum reduziert λ und Φ . erhöhen , was eine exponentielle Zunahme der Tunnelwahrscheinlichkeit bewirken wird. So verwenden Sie hohe κ Dielektrika und die Verringerung der Dicke des Dielektrikums können den Durchlassstrom des TFET erheblich erhöhen. Aber die geringe Dicke des Dielektrikums und die Schnittstellenqualität bei hohen κ Dielektrika führen zu ernsthaften Zuverlässigkeitsproblemen. Somit ist ein Stack-Gate-Dielektrikum von 0,5 nm aus Al2 O3 und 2,0 nm HfO2 soll eine gute Schnittstellenqualität garantieren [27,28,29], die den Leckstrom deutlich reduzieren und die Zuverlässigkeit des Gatedielektrikums verbessern kann. Die Source-Elektrode befindet sich auf der Oberseite der Finnenstruktur. Gleichzeitig befindet es sich auch neben einer Seite der Finne und fungiert als „Backgate“, um einen Null-Bias anzulegen. Durch die Verwendung von Gate- und Source-Elektroden mit unterschiedlichen Metallaustrittsarbeiten kann durch das Ladungsplasmakonzept ein Linientunnelübergang in dem dotierungsfreien rippenförmigen SiGe-Kanal gebildet werden. Die Band-zu-Band-Tunnelrichtung (BTBT) ist senkrecht zur Kanal-/Gate-Oberfläche. Dies kann dazu beitragen, I . zu erhöhen EIN durch Verbesserung des effektiven Tunnelübergangsbereichs.
Hohes Schaltverhältnis (I EIN /Ich AUS ) kann aufgrund des großen Durchlassstroms (I EIN ) und kleiner Sperrstrom (I AUS ) durch den Tunnelbauknoten bereitgestellt. Darüber hinaus kann die Anwendung einer Finnenstruktur in DF-TFETs den Footprint im Vergleich zu Planer-Line-Tunneling-TFETs deutlich reduzieren [30, 31]. Abbildung 1b zeigt einen verfügbaren Fertigungsablauf zum Bilden der Struktur des DF-TFET. Tabelle 1 zeigt die wichtigsten Prozessparameter von DF-TFET. Schließlich kann ohne die Schwierigkeit, einen steilen und gleichmäßigen abrupten p-n-Übergang herzustellen, eine gute Geräteleistung und Robustheit erreicht werden.
Um die Unterschiede und Vorteile von DF-TFET, DL-TFET und TG-TFET besser zu verstehen, zeigt Abb. 2 die Struktur dieser drei Bauelemente. Mit dem Leitungstunnelübergang sollen L-TFET und TG-TFET einen hohen Durchlassstrom erzielen. Experimentelle Ergebnisse zeigen jedoch, dass die tatsächliche Leistung von L-TFET nicht so hoch ist wie erwartet [18, 19]. Einer der wichtigsten Gründe ist die Schwierigkeit, einen steilen und gleichförmigen abrupten p-n-Übergang mit perfekten Grenzflächeneigenschaften zu bilden. Basierend auf der Struktur von L-TFET macht TG-TFET eine große Verbesserung gegenüber I EIN . Aber TG-TFET steht immer noch vor der Schwierigkeit, einen perfekten abrupten p-n-Übergang zu bilden. Um die wünschenswerte gute Leistung zu erzielen, sollte daher ein steiler und gleichförmiger abrupter p-n-Übergang erhalten werden, der nur einige Nanometer dick ist, aber dies ist im Herstellungsprozess sehr schwierig zu realisieren. Durch die Verwendung eines dotierungsfreien Kanals kann der DL-TFET dieses Problem vermeiden und eine bessere Schnittstellenqualität in der Nähe des Tunnelübergangs erzielen. Im Vergleich zu Line-Tunneling-TFETs [16,17,18,19,20,21] mit abrupten p-n-Übergängen zeigt das Simulationsergebnis jedoch, dass die I EIN von DL-TFET ist relativ gering [22, 23]. Zur weiteren Verbesserung wird der DF-TFET in dieser Arbeit vorgeschlagen und untersucht.
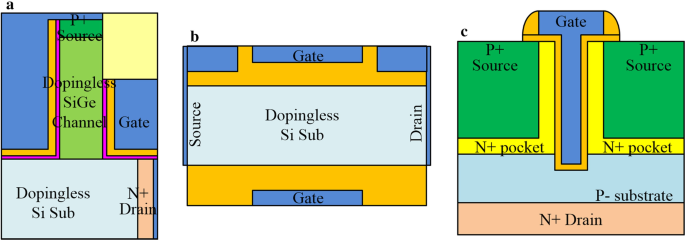
Struktur von a DF-TFET, b DL-TFET, c TG-TFET
Die Simulation von DF-TFET wird in den TCAD-Tools von Silvaco Atlas durchgeführt. In dieser Simulation wird ein nicht-lokales BTBT-Modell eingeführt, um die räumliche Variation des Energiebandes zu berücksichtigen, was dazu beitragen kann, die Genauigkeit des BTBT-Tunnelprozesses zu verbessern. Es wird davon ausgegangen, dass das Lombardi-Mobilitätsmodell die Kanalmobilität genau macht. Das Bandlücken-Verengungsmodell wird berücksichtigt, um die stark dotierten ohmschen Kontaktregionen anzupassen, und das Shockley-Read-Hall-Rekombinationsmodell wird in diesem Papier ebenfalls berücksichtigt.
Ergebnisse und Diskussion
Mechanismus und Vergleich von DF-TFET, DL-TFET und TG-TFET
Abbildung 3a zeigt den Vergleich der Übertragungseigenschaften von DF-TFET, DL-TFET und TG-TFET. Profitieren Sie vom Leitungstunnelübergang im flossenförmigen SiGe-Kanal, der DF-TFET erreicht einen Durchlassstrom (I EIN ) von 58,8 μA/μm und erreicht ein großes Schaltverhältnis von über 12 Größenordnungen, bei dem kein offensichtlicher ambipolarer Effekt auftritt. Darüber hinaus ist ein minimaler unterschwelliger Swing (SSmin ) von 2,8 mV/dec und durchschnittlicher unterschwelliger Swing (SSavg .) ) von 18,2 mV/dec erhalten. Als Ergebnis hat DF-TFET eine deutliche Verbesserung in I EIN im Vergleich zu DL-TFET und Subthreshold-Swing im Vergleich zu TG-TFET. Ich EIN von DF-TFET ist mehr als eine Größenordnung größer als DL-TFET bei V DS = V GS = 1 V. Abbildung 3b zeigt den Energiebandzustand des DF-TFET und veranschaulicht die Bildung eines Tunnelfensters in einem flossenförmigen Kanal. Die rote gestrichelte Linie im Einschub von Abb. 3b zeigt die Position, an der die Energiebandkurve erhalten wird.
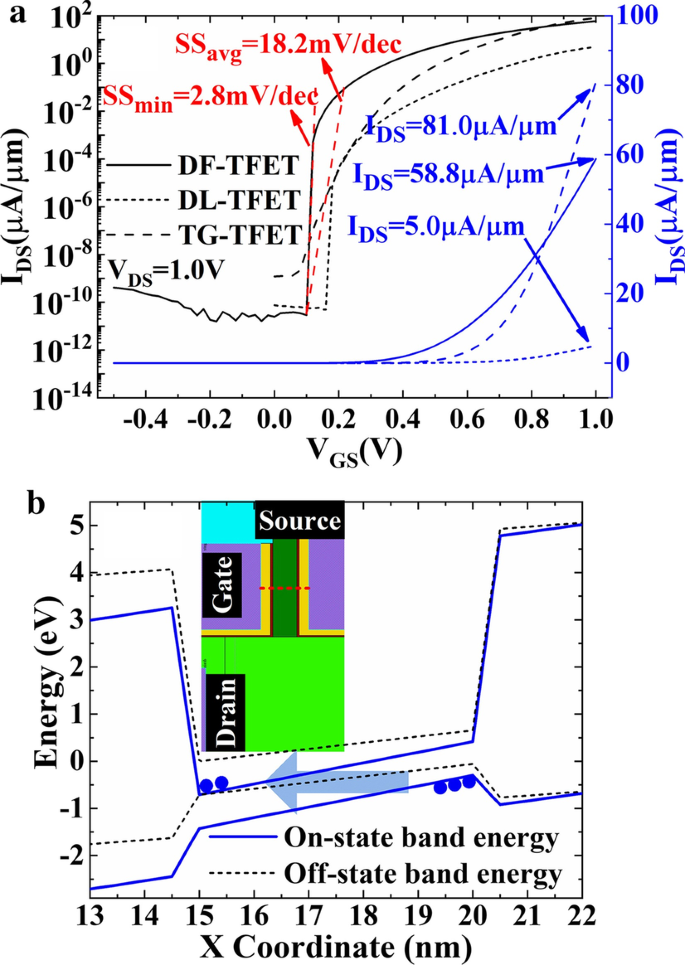
a Übertragungseigenschaften von DF-TFET, DL-TFET und TG-TFET. b Energiebandzustand des DF-TFET unter verschiedenen Arbeitsbedingungen (der Einschub zeigt die Position der Schnittlinie)
Die Verteilung einer wichtigen physikalischen Größe im Tunnelprozess des DF-TFET ist in Abb. 4 gezeigt, die die Verteilung von (a) Potenzial, (b) e-Tunnelrate, (c) Gesamtstromdichte und (d) Rekombinationsrate in an . umfasst staatliche Arbeitsbedingung. In Abb. 4a ist ein deutlicher Potentialgradient senkrecht zur Gate/Kanal-Grenzfläche zu erkennen. Somit wird im flossenförmigen Kanal eine große Potentialdifferenz erzeugt und dies wird die Konzentration von Elektronen und Löchern auf beiden Seiten des Flossenkanals modulieren. Gleichzeitig kann im rippenförmigen Kanal eine steile Energiebandbiegung gebildet werden. Als Ergebnis kann ein Leitungstunnelübergang parallel zur Gate/Kanal-Schnittstelle gebildet werden. Abbildung 4b zeigt die E-Tunneling-Rate im Finnenstrukturkanal. Der Spitzenwert der e-Tunneling-Rate ist gleichförmig nahe der Gate/Kanal-Grenzfläche und parallel zur Oberfläche verteilt. Dies beweist, dass der Leitungstunnelübergang parallel zur Gate/Kanal-Schnittstelle ist. Abbildung 4c zeigt den Strompfad im DF-TFET. Die Valenzbandelektronen von der Backgate-/Kanalseite tunneln in das Leitungsband nahe der Gate-/Kanalseite. Unter dem Einfluss von Gatespannung und Drainspannung bewegen sich Elektronen entlang des Finnenkanals zur Drainelektrode. Auf diese Weise wird im DF-TFET ein Tunnelstrompfad gebildet. Abbildung 4d zeigt die Rekombinationsratenverteilung in DF-TFET; dies kann die Lage des Tunnelübergangs deutlicher veranschaulichen. Der violette Streifen im SiGe-Rippenkanal kann die Position des Tunnelübergangs darstellen.
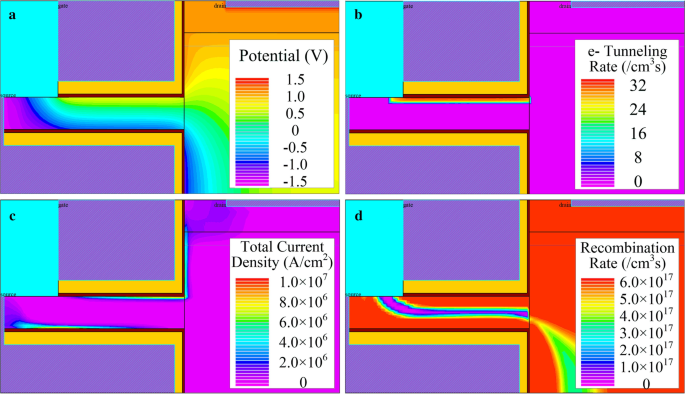
Verteilung von a Potenzial, b e Tunnelrate, c Stromdichte und d Rekombinationsrate von DF-TFET
DC-Eigenschaften mit unterschiedlichen Parametern und Analog-/HF-Leistung
Abbildung 5a, b zeigen die Eingangs- und Ausgangseigenschaften des DF-TFET unter verschiedenen Vorspannungen. Die Erhöhung von V DS hat wenig Einfluss auf die unterschwelligen Schwungeigenschaften, aber I EIN wird ein lineares Wachstum haben, während V DS steigt von 0,2 auf 1,2 V (bei V GS = 1,0 V). Abbildung 5c zeigt die Grenzfrequenz (f T ) und das Gewinnbandbreitenprodukt (GBW), berechnet nach Gl. (2) und (3). Das Ergebnis zeigt, dass eine Grenzfrequenz von 5,04 GHz und ein Verstärkungsbandbreitenprodukt von 1,29 GHz erhalten werden können.
$$f_{{\text{T}}} =\frac{{g_{{\text{m}}} }}{{2\pi C_{{{\text{gs}}}} \sqrt {1 + 2C_{{{\text{gd}}}} /C_{{{\text{gs}}}} } }} \approx \frac{{g_{{\text{m}}} }}{{2 \pi \left( {C_{{\text{gs}}}}} + C_{{{\text{gd}}}}} \right)}} =\frac{{g_{{\text{m} }} }}{{2\pi C_{{{\text{gg}}}} }}$$ (2) $${\text{GBW}} =g_{{\text{m}}} /2 \pi 10C_{{{\text{gd}}}}$$ (3)
a Eingabe, b Ausgabe und c Hochfrequenzeigenschaften von DF-TFET
Abbildung 6a zeigt die Wirkung der Gate-Arbeitsfunktion (φ Tor ) und Austrittsarbeitsfunktion (φ Ablassen ) zu den Übertragungseigenschaften von DF-TFET. Mit zunehmender Austrittsarbeit verschiebt sich die Übertragungskennlinie in positive Richtung. Da die Austrittsarbeit zwischen 3,7 und 4,2 eV variiert, ist die V te steigt linear von 0 auf 0,5 V an, während das I EIN nimmt linear von 93,4 auf 18,6 μA/μm ab. Dadurch kann V . angepasst werden te auf unterschiedliche Bewerbungsvoraussetzungen anwenden. Abbildung 6b zeigt die Wirkung des Zusammensetzungsverhältnisses X von Si1−X GeX . Die Zunahme der Germaniumzusammensetzung führt zu einer Abnahme der Energiebandlücke und einer Zunahme des Tunnelfensters, wie im Einschub von Fig. 6b gezeigt. Schließlich ergibt sich das I EIN Anstiegs- und Übertragungskennlinie übersetzt in die negative Richtung. Wenn jedoch X> 0,7, sowohl die Übertragungskennlinie als auch der I EIN mit zunehmendem X . wenig ändern . Dies liegt daran, dass die Kanalenergiebandstruktur gegenüber X . unempfindlich wird wenn X> 0,7, wie in Abb. 6b Einschub gezeigt. Abbildung 6c, d zeigt den Einfluss der Gate-Länge (W g ) und Kanaldicke (H c ) zu den Übertragungseigenschaften. Der Einschub in Abb. 6c zeigt die Abmessungen des Gerätekanals unter verschiedenen W . g . Aus Abb. 6d ist nicht schwer zu erkennen, dass der DF-TFET unter I . leidet EIN abnehmen, wenn H c wird sowohl zu klein als auch zu groß. Somit ist ein richtiges H c wird der Geräteleistung zugute kommen.

Übertragungseigenschaften mit unterschiedlichen a Gate-Arbeitsfunktion (φ Tor ) und Austrittsarbeitsfunktion (φ Ablassen ), b SiGe-Zusammensetzungsverhältnis, c Gate-Länge (W g ) und d Kanaldicke (H c )
Um das Potenzial von DF-TFET in Ultra-Low-Power-Anwendungen zu verstehen, zeigt Tabelle 2 einen Leistungsvergleich verschiedener TFETs mit DF-TFET. Im Vergleich zu TFETs mit einem traditionellen stark dotierten p-n-Tunnelübergang [6, 20, 32, 33, 34, 35] hat DF-TFET offensichtliche Vorteile in Bezug auf SS und Schaltverhältnis. Dies liegt an den Eigenschaften von DF-TFET durch die Verwendung elektrostatischer Dotierung. Im Vergleich zu anderen dotierungsfreien TFETs [22, 23, 36, 37] hat DF-TFET offensichtliche Vorteile bei ION . Dies liegt an der verbesserten Tunnelrate durch die Verwendung von Linientunnelübergang und SiGe-Material. Durch die Kombination der Vorteile des p-n-Tunnelübergangs und des dotierungsfreien Tunnelübergangs kann der DF-TFET einen hohen Betriebsstrom und einen geringen statischen Stromverbrauch in Anwendungen mit extrem niedrigem Stromverbrauch bieten.
Schlussfolgerung
In dieser Arbeit wird ein neuartiger DF-TFET vorgeschlagen und die elektrischen Eigenschaften werden durch Simulationsverfahren analysiert. Die Strukturcharakteristik, der physikalische Mechanismus, die Leistung mit verschiedenen Parametern und die analoge/HF-Leistung von DF-TFET werden diskutiert und untersucht. Profitieren Sie von dem dotierungsfreien Finnenstrukturkanal, dem Stack-Gate-Dielektrikum, dem SiGe-Kanalmaterial und dem hocheffizienten Leitungstunnelübergang, eine gute Leistung bei den Schalteigenschaften und den analogen/HF-Eigenschaften kann erzielt werden. Darüber hinaus kann durch Vermeidung der Bildung des abrupten p-n-Übergangs im Herstellungsprozess eine gleichmäßige Dotierung mit hoher Konsistenz und hoher Robustheit gegenüber Prozessschwankungen erreicht werden. Das Simulationsergebnis zeigt, dass ich EIN von 58,8 μA/μm, Schaltverhältnis von 12 Größenordnungen, kein offensichtlicher ambipolarer Effekt, SSmin von 2,8 mV/dec und f T von 5,04 GHz kann durch DF-TFET erreicht werden. Mit dem großen Betriebsstrom, dem hohen Schaltverhältnis, dem steilen SS, der guten Zuverlässigkeit, dem stabilen Herstellungsprozess und der guten Herstellbarkeit kann er als einer der vielversprechenden Kandidaten für zukünftige Low-Power-ICs und empfindliche Sensoranwendungen erwartet werden.
Verfügbarkeit von Daten und Materialien
Nicht zutreffend (Dieses Manuskript ist eine rein theoretische Studie zur analogen/HF-Leistung von TFET. Die Simulationsdaten wurden in diesem Manuskript angegeben und sollen hier nicht beschrieben werden).
Abkürzungen
- DF-TFET:
-
Dotierungsfreier flossenförmiger SiGe-Kanal-TFET
- ICs:
-
Integrierte Schaltungen
- TGTFET:
-
T-T-Gate-Dual-Source-TFET
- DL-TFET:
-
Dopingfreier TFET
- I EIN :
-
Einschaltstrom
- I AUS :
-
Ruhestrom
- SSmin :
-
Minimaler unterschwelliger Swing
- SSavg :
-
Durchschnittlicher Swing unter der Schwelle
- C gg :
-
Gate-Kapazität
- C gd :
-
Gate-zu-Drain-Kapazität
- f T :
-
Grenzfrequenz
- GBW:
-
Bandbreitenprodukt gewinnen
- λ :
-
Effektive Sieblänge
- m * :
-
Effektive Trägermasse
- E g :
-
Energiebandlücke
- ΔΦ :
-
Effektives Screening-Energiefenster
- W g :
-
Torlänge
- W Lücke :
-
Länge der Lücke
- T Ochse :
-
Stack-Gate-Oxiddicke
- H c :
-
Kanaldicke
- φ Tor /φ Ablassen :
-
Gate- und Drain-Arbeitsfunktion
- V DS :
-
Drain-zu-Source-Spannung
- V GS :
-
Gate-Source-Spannung
Nanomaterialien
- Neuer Ansatz bringt verbesserte PUF-Stabilität
- Verbessern Sie die Leistung durch automatisiertes Schweißen
- Blog:Medizinische Wearables mit großer Leistung
- Ein neuartiger Bi4Ti3O12/Ag3PO4-Heteroübergang-Photokatalysator mit verbesserter photokatalytischer Leistung
- Verbesserte Leistung eines neuartigen anodischen PdAu/VGCNF-Katalysators für die Elektrooxidation in einer Glycerin-Brennstoffzelle
- Leitungsmechanismus und verbesserte Ausdauer bei HfO2-basiertem RRAM mit Nitridierungsbehandlung
- Herstellung hierarchischer ZnO@NiO-Kern-Schale-Heterostrukturen für verbesserte photokatalytische Leistung
- Kanal-Plasmon-Nanodraht-Laser mit V-Groove-Hohlräumen
- Auswirkungen von Ätzvariationen auf die Ge/Si-Kanalbildung und die Geräteleistung
- 6 Möglichkeiten, wie wir Protocase Designer mit Version 4.6 verbessert haben



