Analyse des Ätzens von Perowskitoxid mit induktiv gekoppelten Argonplasmen für Photonikanwendungen
Zusammenfassung
Wir analysierten das Trockenätzen von Perowskitoxiden mit Argon-basierten induktiv gekoppelten Plasmen (ICP) für Photonikanwendungen. Anhand von Z-Schnitt-Lithiumniobat (LN) wurden verschiedene Kammerbedingungen und deren Auswirkungen auf die Ätzraten demonstriert. Die gemessenen Ergebnisse sind vorhersehbar und wiederholbar und können auf andere Perowskitoxide wie X-cut LN und Bariumtitanoxid (BTO) angewendet werden. Die Oberflächenrauheit ist sowohl bei geätztem LN als auch bei BTO besser als bei ihren Gegenstücken im abgeschiedenen Zustand, wie durch Rasterkraftmikroskopie (AFM) bestätigt wurde. Sowohl die energiedispersive Röntgenspektroskopie (EDS) als auch die Röntgenphotoelektronenspektroskopie (XPS) wurden für qualitative und quantitative Oberflächenchemiekomponentenvergleiche verwendet, und gemäß den gemessenen Ergebnissen werden keine offensichtlichen Änderungen des Oberflächenzustands beobachtet. Ein optischer Wellenleiter, der mit dem optimierten Argon-basierten ICP-Ätzen hergestellt wurde, hat einen Verlust von -3,7 dB/cm bei einer Wellenlänge von 1550 nm für Z-Schnitt-LN, was diese Art von Methode zum Ätzen von Perowskitoxiden in Photonikanwendungen validiert.
Einführung
Die Siliziumphotonik hat in den letzten Jahrzehnten aufgrund ihrer geringen Kosten und ihrer großen Integrierbarkeit eine große Entwicklung erfahren [1]. Das Fehlen eines Pockels-Effekts schränkt jedoch einige seiner Anwendungen aufgrund seiner zentrosymmetrischen Kristallstruktur ein [2]. Perowskitoxide wie LiNbO3 (LN) und BaTiO3 (BTO) haben daher aufgrund ihrer großen Pockels-Effekte große Aufmerksamkeit für Photonikanwendungen erhalten [3,4,5,6,7,8,9,10]. Für verschiedene LN- und BTO-basierte photonische Geräte wurde eine überlegene Leistung nachgewiesen [3,4,5,6,7,8,9,10]. Für eine solche Anwendung ist ein Wellenleiter mit einem hohen Brechungsindexkontrast die Grundkomponente für die Lichteingrenzung [11]. Traditionell wurden Wellenleiter in LN durch Ionendiffusion gebildet [12], was nur einen geringen Brechungsindexkontrast und eine schlechte resultierende optische Begrenzung ermöglichte. Der Durchbruch von LN-basierten integrierten Bauelementen beruht auf dem direkten Trockenätzen von LN-Dünnschichten [3, 6,7,8,9,10]. Es gibt jedoch noch keine umfassende Analyse von LN-Trockenätzverfahren, über die bisher berichtet wurde. Auf der anderen Seite hat BTO einen noch höheren Pockels-Koeffizienten von 1640 pm/V als LN (~ 30 pm/V) [2], was viel bessere photonische Geräte unterstützen kann. Direkt geätzte photonische Bauelemente auf BTO-Basis wurden jedoch noch nicht demonstriert, was wahrscheinlich daran liegt, dass sie schwierig zu ätzen sind. Das in der Literatur am häufigsten verwendete Verfahren zum Erzeugen von Wellenleitern mit höherem Index in diesen Materialien besteht darin, zuerst eine Schicht aus leicht zu ätzendem Material abzuscheiden und dann das Muster durch Trockenätzen auf diese Schicht zu übertragen. Der resultierende optische Modus überlappt nur teilweise mit der unteren ungeätzten BTO-Schicht, wodurch seine Leistung verschlechtert wird; eine solche Methode kann ihren Pockels-Effekt nicht maximieren [4, 5]. Obwohl Plasmaätzen von BTO auf Fluor- und Chloridbasis für Halbleiterspeicheranwendungen vorgeschlagen wurde [13,14,15], reduzieren Reaktionsprodukte, die während des Ätzprozesses auf den Oberflächen und Seitenwänden wieder abgeschieden werden können, die Eignung solcher Ätzchemien für Photonikanwendungen.
Daher wird in diesem Manuskript das Argonplasma-basierte induktiv gekoppelte Plasma (ICP)-Ätzen von Perowskitoxiden LN und BTO umfassend analysiert. Sowohl für LN als auch für BTO werden verschiedene Faktoren und deren Einfluss auf die Ätzraten verglichen. Die Oberflächenrauheit vor und nach dem Ätzen wird durch Atomkraftmikroskopie (AFM) analysiert. Die Methoden der energiedispersiven Röntgenspektroskopie (EDS) und der Röntgenphotoelektronenspektroskopie (XPS) werden zur Charakterisierung von chemischen Zustandsänderungen der Oberfläche verwendet. Es wird beobachtet, dass die Oberfläche viel glatter ist, ohne dass Ätzrückstände sowohl in geätzten LN- als auch in BTO-Proben nachgewiesen wurden. Basierend auf optimierten Ätzbedingungen werden optische Wellenleiter auf eine Z-geschnittene LN-Probe mit einem gemessenen Verlust von -3,7 dB/cm geätzt, was die Eignung der Argon-basierten ICP-Methode für das allgemeine Ätzen von Perowskitoxiden in Photonikanwendungen bestätigt.
Experiment und Ergebnisse
Methoden
Für das argonbasierte ICP-Ätzexperiment wird eine 13,56 MHz Oxford PlasmaPro 100c Cobra verwendet, und eine schematische Struktur der Ätzung ist in Abb. 1a gezeigt. Das Eingangsgas wird unter zeitlich veränderlichen elektromagnetischen Feldern ionisiert, die von einer induktiv gekoppelten Spule unter der ersten Hochfrequenzquelle (RFICP .) erzeugt werden ). Die erzeugten Plasmaionen beschleunigen vertikal zum unteren Wafer unter einer Vorspannung, die von der zweiten HF-Quelle (RFbias ) mit dem Substrathalter/der Elektrode verbunden. Die flüchtigen Ätzgasprodukte werden durch eine Entlüftung abgelassen. Z-cut LN wird als Beispiel zur Demonstration der Beziehung zwischen unterschiedlichen Prozessbedingungen und Ätzrate verwendet; die epitaktische LN-Struktur ist in Fig. 1b gezeigt. Die Dicke der oberen Lithiumniobatschicht und des Siliziumoxids beträgt 700 nm bzw. 2 µm. Zur Erleichterung der Lithographie wird zunächst eine 50 nm große Chromschicht (Cr) durch Elektronenstrahlverdampfung (E-Beam) auf der Probe abgeschieden. Dann wird etwa 1 &mgr;m ma-N 1400-Fotoresist auf die Oberfläche durch Fotolithografie unter Verwendung eines Laserschreibers aufgeschleudert. Nach der Entwicklung und anschließenden Cr-Nassätzung dient die strukturierte Struktur als Schattenmaske für das Trockenätzen. Nach dem ICP-Ätzen wird diese Maske in heißem N-Methyl-2-pyrrolidon und Cr-Ätzmittel abgezogen. Strukturtiefen vor dem Ätzen, nach dem Ätzen und nach dem Entfernen der Schattenmaske werden durch einen Oberflächenprofiler an festen Punkten aufgezeichnet und die Ätzraten des Fotolacks und des Z-Schnitt-LN werden entsprechend berechnet.

a Schematischer Aufbau des ICP-Prozesses. Die Epitaxiestrukturen und REM-Bilder von b Z-Schnitt LN und c Im Experiment verwendetes BTO (Pt und Cr werden als Schutzschichten für das FIB-Schneiden abgeschieden)
Ätzratenanalyse
Vier Faktoren werden während des Experiments validiert:Kammerdruck, Gasflussrate, Bias-Leistung und ICP-Leistung. Vor jeder Ätzung wird eine 5-minütige Plasmabehandlung mit reinem Sauerstoff zur Kammerreinigung durchgeführt. Während des Ätzens wird nur Argongas verwendet, und die Basisätzbedingungen sind:5 mTorr Kammerdruck, 20 sccm Gasfluss, 150 W Vorspannungsleistung und 500 W ICP-Leistung. Die gemessenen Ätzraten von Z-Schnitt-LN und Fotolack in Bezug auf verschiedene kombinierte Bedingungen sind in Fig. 2 gezeigt. Aus Fig. 2a ist ersichtlich, dass die Ätzgeschwindigkeit von Z-Schnitt-LN zunimmt, wenn der Kammerdruck verringert wird, und der Anstieg der Z-Schnitt-LN-Ätzrate ist relativ linear (die Steigung beträgt etwa 0,95 nm/min pro mTorr-Druckabnahme) und vorhersehbar. Es sollte beachtet werden, dass die Oberflächenprofiltiefenmessung von Z-Schnitt-LN genauer ist als mit dem Fotolack, da der Oberflächen-Fotolack nach dem Ätzen nicht so flach ist wie der Z-Schnitt-LN. Wenn der Kammerdruck niedriger ist, wird die zufällige Kollisionsbewegung reduziert und die Argonionen werden geordneter transportiert, was erklären kann, warum bei niedrigerem Kammerdruck höhere Ätzraten beobachtet werden. Die Ätzrate steigt für Z-Schnitt-LN in Bezug auf die Gasflussbedingungen linear an, wie in Fig. 2b gezeigt, was bedeutet, dass mehr Argonplasma aktiviert wird, wenn der Gasfluss größer ist. Die Steigung der Z-Schnitt-LN-Ätzrate beträgt etwa 0,11 nm/min pro Einheits-sccm-Gasflusszunahme, wie aus Fig. 2b geschlossen werden kann. Sowohl die Ätzrate des Z-Schnitt-LN als auch des Photoresists nehmen zu, wenn die Vorspannung und die ICP-Leistung zunehmen, wie aus Fig. 2c, d ersichtlich. Wenn die ICP-Leistung nur 100 W beträgt, werden wenige Argonatome ionisiert und die Ätzrate von Z-Schnitt-LN ist ziemlich klein, wie in Fig. 2d gezeigt. Wenn die ICP-Leistung erhöht wird, werden mehr Argonatome ionisiert, und somit ergeben sich höhere Ätzraten. Mit einer Erhöhung der Vorspannung wird auch die Ionenbeschleunigungsgeschwindigkeit größer, wenn das elektrische Feld stärker ist. Sowohl eine Erhöhung der Plasmadichte als auch eine Ionenbeschleunigung führen zu höheren Ätzraten, die in Abb. 2c, d zu finden sind. Die Steigungen betragen etwa 0,072 nm/min pro Watt Vorspannung bzw. ICP-Leistung. Die nichtlineare Kurve der Ätzrate des Fotolacks in Abhängigkeit von der Vorspannungsleistung ist wahrscheinlich auf den Messfehler zurückzuführen, der sich aus einer nicht ebenen Oberfläche ergibt.
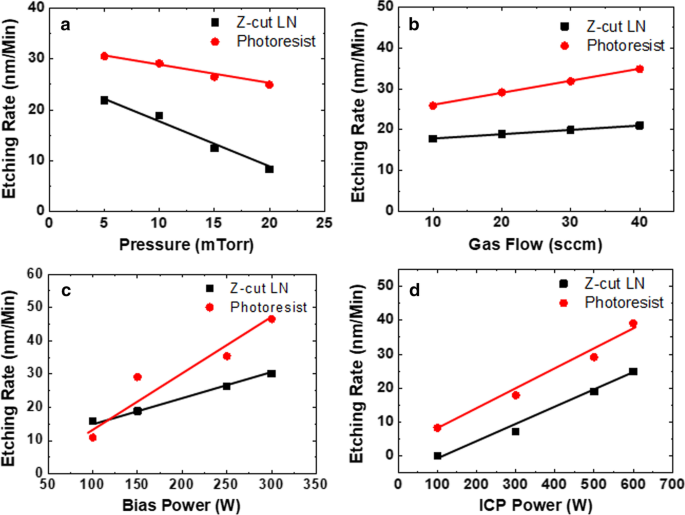
Ätzraten von Z-cut LN und Photoresist unter verschiedenen a Druck, b Gasfluss, c Bias-Power und d ICP-Leistung
In Abb. 2a wird die Ätzrate von 21,87 nm/min unter den Bedingungen von 5 mTorr Kammerdruck, 20 sccm Gasfluss, 150 W Vorspannungsleistung und 500 W ICP-Leistung erhalten. Etwa 37 nm/min Ätzrate wird unter Bedingungen von 10 mTorr Kammerdruck, 30 sccm Gasfluss, 300 W Vorspannungsleistung und 700 W ICP-Leistung gemessen, was sehr gut mit den berechneten Ergebnissen (40,4 nm/s) basierend auf Messdaten übereinstimmt gezeigt in Abb. 2. Daher kann gefolgert werden, dass die Ätzrate von Z-Schnitt-LN regelmäßig und vorhersehbar ist.
Basierend auf den gleichen Basisbedingungen (5 mTorr Kammerdruck, 20 sccm Gasfluss, 150 W Vorspannungsleistung und 500 W ICP-Leistung) wird ein ähnliches Ätzexperiment mit X-cut LN und BTO durchgeführt, um die Wirkung des Kammerdrucks zu untersuchen (als Beispiel für verschiedene Bedingungen) und die gemessenen Daten sind in Abb. 3 gezeigt. Der hier verwendete X-Schnitt-LN ist ein Volumenkristall, während das BTO eine epitaktische Schicht ist, die auf einem Dysprosium-Scandat-(DSO)-Substrat unter Verwendung von gepulstem gewachsen ist Laserabscheidung (PLD), mit der in Fig. 1c gezeigten Struktur. Wenn der Kammerdruck verringert wird, nehmen sowohl die Ätzrate von BTO als auch X-Schnitt-LN zu, was gut mit den Z-Schnitt-LN-Ergebnissen übereinstimmt. Die leicht unterschiedliche beobachtete Steigung kann auf die kleinen Unterschiede in der Kristallqualität zurückgeführt werden. Daraus kann geschlossen werden, dass die Ätzparameter in Fig. 2 auch für Perowskitoxid-Typ X-cut LN und BTO allgemein geeignet sind.

Vergleichsergebnis der Ätzraten in Bezug auf den Kammerdruck für BTO, Z-Schnitt und X-Schnitt LNs
Analyse der Oberflächenmorphologie
Um mögliche Änderungen der Oberflächenmorphologie durch Ätzen zu bewerten, wird hier AFM mit der Scanfläche \(1\times 1 {\mathrm{\mu m}}^{2}\) verwendet. AFM-Bilder von wie abgeschieden und nach dem Ätzen für Z-Schnitt-LN, X-Schnitt-LN und BTO sind in Abb. 4 gezeigt. Aus Abb. 4a, b ist ersichtlich, dass das geätzte Z-Schnitt-LN fast eine Ordnung hat untere Oberflächen-Root-Mean-Square (RMS) Rauheit im Vergleich zu der Probe im abgeschiedenen Zustand. Für X-cut LN und BTO ist die gleiche glattere Oberfläche nach dem Ätzen aus Abb. 4c–f zu finden. Die etwas größere RMS-Rauheit für BTO im abgeschiedenen Zustand ist auf die ursprüngliche Wachstumsqualität zurückzuführen, da die LN-Probe ein kommerzielles Produkt ist und der BTO-Film in unserem Labor auf einem Substrat (DSO) gezüchtet wird, das selbst möglicherweise keine minimierte Oberflächenrauheit aufweist. Die geringere RMS-Rauheit der geätzten Probe kann auf die physikalische Ätzeigenschaft von Argonplasma-basiertem ICP zurückgeführt werden, die den Ätzprozess ein bisschen wie Schleifen/Polieren macht.
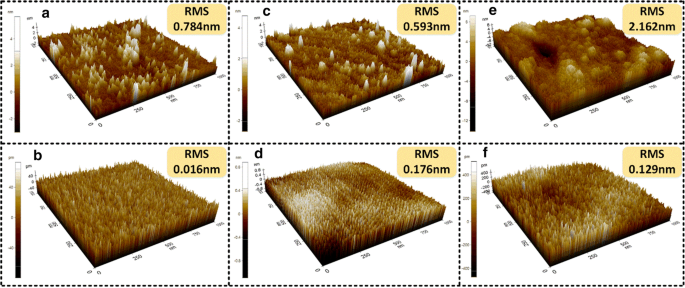
Die 3D-Ansicht der Oberflächenmorphologien von Z-Schnitt-LN, X-Schnitt-LN und BTO, gemessen mit AFM. a Wie hinterlegt und b geätzter Z-Schnitt LN. c Wie hinterlegt und d geätzter X-Schnitt LN. e Wie hinterlegt und f geätztes BTO
Oberflächenzustandsanalyse
Für die abgeschiedenen und geätzten Z-Schnitt-LN-, X-Schnitt-LN- und BTO-Proben wird eine EDS-Analyse durchgeführt, um mögliche Veränderungen der Oberflächenkomponenten qualitativ zu analysieren, und die Messergebnisse sind in Abb. 5 dargestellt. Während der Messung wird Lithium (Li), Niobate (Nb), Sauerstoff (O), Kohlenstoff (C), Argon (Ar) und Chrom (Cr) werden für Z-Schnitt und X-Schnitt LN aufgezeichnet, wie in Abb. 5a–d gezeigt, während für die BTO-Probe werden Barium (Ba), Titan (Ti), O, C, Ar und Cr analysiert, wie in Abb. 5e, f gezeigt. Im Vergleich zu den Proben im abgeschiedenen Zustand ist aus Abb. 5 kein signifikanter Unterschied in den elementaren Bestandteilen zu erkennen. In keiner der geätzten Proben gibt es Restargon im geätzten Bereich, was zeigt, dass Argonplasma-basiertes ICP ein rein physikalischer Prozess ist verursacht keine unerwarteten sekundären chemischen Veränderungen und es werden keine Ätzreaktanten produziert.

Die gemessenen EDS-Ergebnisse. a Wie hinterlegt und b geätzte Z-Schnitt-LN-Proben; c als Anzahlung und d geätzte LN-Proben mit X-Schnitt; e als Anzahlung und f geätzte BTO-Proben
Zur weiteren Analyse jeglicher Änderungen der chemischen Oberflächenzusammensetzung wurde eine XPS-Analyse durchgeführt. Die Messungen wurden in einem Thermo Fisher Scientific Theta Probe-System durchgeführt, das mit einer monochromatischen, mikrofokussierten Al K \(\alpha\)-Röntgenquelle (1486,6 eV) ausgestattet war, und XPS-Spektren wurden bei einem Erfassungswinkel (q) von 50 . aufgenommen , bezogen auf die Probenoberfläche. Der Basisdruck der Analysekammer beträgt \(5\times {10}^{-10}\) mbar. Abbildung 6 zeigt die XPS-Übersichtsspektren von Z-Schnitt-LN-, X-Schnitt-LN- und BTO-Proben im Bereich von 0 bis 1000 eV Bindungsenergie (BE). Es gibt Li 1 s, Nb 3p1/2 , Nb 3p3/2 , Nb 3d5/2 , Nb 4p3/2 , O 1 s und C 1 s für Z-Schnitt-LN und X-Schnitt-LN, wie in Fig. 6a, b gezeigt. In Fig. 6c gibt es Ba 4d, Ba 4p3/2 , C 1 s, Ti 2p, O 1 s, Ba 3d5/2 und Ba 3d3/2 für BTO. Die hier berichteten XPS-Spektren beziehen sich auf den BE des C–C/C-H-Komponentenpeaks der C 1 s-Spektren bei 285,0 eV [13, 16]. Aus Abb. 6 ist ersichtlich, dass es keinen großen Unterschied in den Untersuchungsspektren für abgeschiedene und geätzte Proben gibt. Einige kleine Peaks nach dem Ätzen werden durch die geringfügige Kontamination während der Probenverarbeitung und -lagerung verursacht.

XPS-Spektren von a Z-Schnitt LN, b X-Schnitt LN und c BTO vor und nach dem Ätzen. Untere (rot) und obere (schwarze) Linien repräsentieren die abgeschiedenen und geätzten Proben
Um den chemischen Zustand jedes Elements im Detail zu identifizieren, wurden die hochauflösenden Spektren aller auf der Oberfläche präsentierten Elemente aufgenommen und nach einer Sekundärelektronen-Hintergrundsubtraktion vom Shirley-Typ angepasst [13]. Die Anpassungsergebnisse sind in Abbildung 7 dargestellt. Abbildung 7a bis d sind Li 1 s, Nb 3d5/2 , O 1 s und Ar für Z-Schnitt LN. Es gibt keine offensichtlichen Änderungen für den Peak von Li 1 s, wie in Abb. 7a gezeigt. Verglichen mit der Probe im abgeschiedenen Zustand sind die Peaks von Nb 3d5/2 und O 1 s ändern sich im geätzten Fall um 0,1 bzw. 0,2 eV zu höheren BEs, wie in Fig. 7b, c gezeigt. Solche kleinen Änderungen liegen nahe am Messfehler und weisen darauf hin, dass es keine offensichtliche Änderung des chemischen Zustands für Nb und O gibt. Es sei darauf hingewiesen, dass es zwei Komponentenpeaks für die Anpassung des O 1-Spektrums gibt und der Hauptpeak bei 530,2 eV von Nb . stammt –O Anleihen. Der andere Subpeak um 532,5 eV ist auf eine Kontamination zurückzuführen, da er durch die physikalische Beule in der Vakuumkammer entfernt wird und somit zu einer schwächeren Signalstärke führt [13]. Sowohl bei den abgeschiedenen als auch bei den geätzten Proben wird kein offensichtlicher Argonpeak beobachtet, was bestätigt, dass das ICP-Ätzen auf Argonbasis zu keinen Ätzrückständen führte.

Hochauflösende Spektren für abgeschiedene und geätzte Z-Schnitt-LN-, X-Schnitt-LN- und BTO-Proben. a bis d repräsentieren Li, Nb, O, Ar für Z-Schnitt-LN. e –h repräsentieren Li, Nb, O, Ar für LN im X-Schnitt. ich zu l repräsentieren Ba, Ti, O, Ar für BTO. Die untere (rote) und obere (schwarze) Linie repräsentiert die Ergebnisse der Abscheidung und der Ätzung in jedem einzelnen Bild
Die Abbildungen 7e–h zeigen Li 1 s, Nb 3d5/2 , O 1 s und Ar für X-Schnitt-LN. Die Schlussfolgerung ist ähnlich wie bei Z-Schnitt LN. Alle Peaks von Li 1 s, Nb 3d5/2 und O 1 s verschieben 0,2 eV zu höheren BEs für die geätzten Proben im Vergleich zu den wie abgeschiedenen. Für das Ar 2p-Spektrum gibt es einen kleinen Peak in der geätzten Probe bei etwa 239,0 eV, der auf das restliche Argon zurückgeführt werden kann. Obwohl Ar mit dem geätzten Material nicht chemisch reagiert, wird das hochenergetische Ion während des Ätzprozesses in die geätzte Oberfläche implantiert. In unserem Experiment wird erwartet, dass eine solche Implantation schwach ist, da das Signal so klein ist und keine signifikanten Auswirkungen auf die Leistung der photonischen Geräte hat.
Abbildung 7i–l zeigen Ba 3d-, Ti 2p-, O 1 s- und Ar 2p-Spektren, die für BTO erhalten wurden. In Abb. 7i, Ba 3d5/2 der abgeschiedenen Probe (untere rote Linie) können an zwei Peaks bei BEs von 778,7 und 780,0 eV mit einem Verhältnis von 47 %:53 % angepasst werden. Nach dem Ätzen Ba 3d5/2 wird an zwei Peaks bei BEs von 778,8 und 780,1 eV mit einem Verhältnis von 80 %: 20 % angepasst. Nach Berücksichtigung des Experimentfehlers (± 0,2 eV) wurde keine BE-Verschiebung beobachtet. Das Oberflächenoxid wurde jedoch aufgrund des Ätzprozesses von der Änderung des Spitzenverhältnisses entfernt. Für Ti 2p sind die BEs von Ti 2p3/2 vor und nach dem Ätzprozess betragen 458,1 bzw. 458,2 eV, was ebenfalls innerhalb des experimentellen Fehlers liegt. Für O 1 s-Spektren kann es vor dem Ätzen mit zwei Peaks mit BEs von 529,4 und 531,4 eV angepasst werden, die BTO und Oberflächenkontamination zugeordnet sind, mit einem Verhältnis von 45 %:55 %. Nach dem Ätzen betragen die BEs der Peaks 529,6 und 531,5 eV mit einem Verhältnis von 60 %:40 %, was zeigt, dass die Oberflächenkontamination entfernt wurde. Nach dem Ätzen in BTO wird kein offensichtlicher XPS-Peak von Ar beobachtet, was gut mit den Z-Schnitt- und X-Schnitt-LN-Fällen übereinstimmt.
Charakterisierung und Diskussion der optischen Leistung
Basierend auf dem optimierten Argon-basierten ICP-Verfahren werden als Beispielanwendung Z-cut LN-Wellenleiter realisiert. Der Wellenleiter wird teilweise mit einer Ätztiefe von 420 nm aus einer Gesamtdicke von 700 nm geätzt und seine Breite ist für eine einfache Lithographie auf 4 µm ausgelegt. Die geometrischen Abmessungen des Wellenleiters werden basierend auf der 3D-Finite-Differenz-Zeitdomänen-(FDTD)-Methode [17] unter Berücksichtigung sowohl der Übertragungsdämpfung als auch der Prozesstechnologie bestimmt. Die obere LN-Schicht und das Substrat sind durch 2 µm Siliziumoxid isoliert, um einen hohen Brechungsindexunterschied zu bilden (die Brechungsindizes von LN und SiO2 sind 2,3 bzw. 1,44) für die optische Eingrenzung, wie die Epitaxie, die in Fig. 1b gezeigt ist. Ungefähr -3,7 dB/cm Ausbreitungsverlust wird unter Abzug des Kopplungsverlusts (Cutback-Methode) in der Nähe der Designwellenlänge von 1550 nm für transversal magnetisch (TM) polarisiertes Eingangslicht gemessen, wie in Fig. 8a gezeigt. Der Einschub zeigt Licht, das gut innerhalb des Wellenleiters eingeschlossen ist. Es ist erwähnenswert, dass es andere Methoden gibt, um den Wellenleiterverlust zu charakterisieren, wie Gleitprisma, Fabry-Perot-Resonanzen und Streulichtmethoden [18]. Hier wird die Cutback-Methode verwendet. Abbildung 8b zeigt ein Rasterelektronenmikroskop (REM)-Bild des geätzten Wellenleiters. Klare Seitenwände bestätigen das Hochleistungsätzergebnis. Der Seitenwandwinkel beträgt etwa 50 Grad, wie das in Fig. 8c gezeigte Bild des Fokusionenstrahls (FIB) zeigt. Der gemessene Verlust ist für die TM-Polarisation angemessen (wo das Feld richtig ausgerichtet ist, um den Pockels-Effekt für die Z-Schnitt-Orientierung zu maximieren); und größer als typische Verlustwerte für transversal elektrisch (TE) polarisiertes Licht in X-geschnittenem Lithiumniobat [3, 6] aufgrund der üblichen Anisotropie der Seitenwandrauhigkeit. Ein solcher Verlust kann durch die Verwendung einer dünneren oberen LN-Dicke [19] und einer optimierteren Struktur [3, 6, 20] verbessert werden. Es ist erwähnenswert, dass es keine Nachbearbeitung oder zusätzliche Ummantelung des gemessenen Wellenleiters gibt. Der Verlust kann daher durch Optimierung einer solchen Verarbeitung reduziert werden, wie dies bei der Zugabe von thermischer Oxidation in Siliziumwellenleitern [20, 21] oder bei der Verwendung von Gascluster-Ionenstrahlglättung der Fall ist [22]. Im BTO-Fall würde ein verringerter Indexkontrast zwischen dem DSO-Substrat und der oberen BTO-Schicht (der Brechungsindex von BTO bzw ist tiefer; der Verlust kann nicht direkt mit dem in LN verglichen werden.

a Gemessener Verlust des geätzten Z-Schnitt-LN-Wellenleiters. (Das eingefügte Bild zeigt das während der Messung innerhalb des gebogenen Wellenleiters übertragene Licht.) b REM-Aufnahme des geätzten Wellenleiters. c FIB-Bild des Wellenleiterquerschnitts
Verglichen mit der typischen Ionendiffusionsmethode [12] für Perowskitoxide in Photonikanwendungen kann das in diesem Manuskript demonstrierte Argon-basierte ICP kompakte und leistungsstarke integrierte Bauelemente realisieren. Da es bei diesem Verfahren keine Ätzreaktionsprodukte gibt, wird die optische Leistung des Perowskitoxid-Kristalls überhaupt nicht beeinträchtigt. Daher ist es wahrscheinlich besser als das ICP-Ätzen auf Fluor- oder Chloridbasis [13,14,15], das für andere Arten von Anwendungen wie Feldeffekttransistoren demonstriert wurde. ICP-Maschinen sind in der Industrie weit verbreitet, daher ist die Ausbeute des vorgeschlagenen Verfahrens hoch, wenn jeder Prozessschritt mit einer kleinen Fehlerspanne kontrolliert wird.
Schlussfolgerungen
Zusammenfassend wird in diesem Manuskript das argonbasierte ICP-Ätzen für Perowskitoxide detailliert demonstriert. Die Ätzraten und ihre Beziehungen zu Kammerdruck, Gasfluss, Bias und ICP-Leistung werden in Z-cut LN, X-cut LN und BTO analysiert. Die gemessenen Ergebnisse sind regelmäßig und vorhersehbar, was für das Benchmarking aller Perowskit-basierten Oxidätzungen, insbesondere für Photonikanwendungen, nützlich sein wird. Die gemessenen AFM-Ergebnisse zeigen, dass die Oberflächenrauhigkeit nach dem Argon-basierten ICP-Ätzen besser ist als zuvor. Sowohl die EDS- als auch die XPS-Ergebnisse zeigen, dass ein solches Ätzverfahren ein rein physikalischer Prozess ist und keine Ätzrückstände auf der geätzten Oberfläche gefunden werden. Einige vernünftige kleine Spitzenverschiebungen nach dem Ätzen werden beobachtet, aber während des Experiments wird keine signifikante Leistungsverschlechterung der photonischen Vorrichtungen erhalten. Ein gemessener TM-Verlust von -3,7 dB/cm bei 1550 nm für einen LN-Wellenleiter mit Z-Schnitt bestätigt auch die Eignung von Argon-basiertem ICP für das Ätzen von Perowskitoxiden in der Herstellung von Photonikgeräten.
Verfügbarkeit von Daten und Materialien
Alle Daten sind uneingeschränkt verfügbar.
Abkürzungen
- ICP:
-
Induktiv gekoppelte Plasmen
- LN:
-
Lithiumniobat
- BTO:
-
Bariumtitanoxid
- AFM:
-
Rasterkraftmikroskopie
- EDS:
-
Energiedispersive Röntgenspektroskopie
- XPS:
-
Röntgen-Photoelektronen-Spektroskopie
- Cr:
-
Chrome
- E-Strahl:
-
Elektronenstrahl
- DSO:
-
Dysprosium-Scandate
- PLD:
-
Gepulste Laserabscheidung
- RMS:
-
Root-Mean-Square
- BE:
-
Bindungsenergie
- Pt:
-
Platin
- Li:
-
Lithium
- Anz:
-
Niobat
- O:
-
Sauerstoff
- C:
-
Kohlenstoff
- Ar:
-
Argon
- Ba:
-
Barium
- Ti:
-
Titan
- SEM:
-
Rasterelektronenmikroskopie
- FIB:
-
Ionenstrahl fokussieren
- TM:
-
Quermagnetisch
- TE:
-
Quer elektrisch
Nanomaterialien
- Einstieg mit CNC-Maschinen für den Anhängerbau, Dachträger und Aluminiumprofilanwendungen
- Verwendung einer Schwingungsanalyse zur Prüfung auf Lagerverschleiß
- Fortschritte und Herausforderungen fluoreszierender Nanomaterialien für die Synthese und biomedizinische Anwendungen
- Zellbasierte Arzneimittelabgabe für Krebsanwendungen
- Fortschritte bei eisenoxidbasierten Nanostrukturen für Anwendungen in der Energiespeicherung
- Graphen- und Polymerverbundstoffe für Superkondensatoranwendungen:ein Rückblick
- Mesoporöse Nickeloxid (NiO)-Nanoblätter für die hochempfindliche Glukosemessung
- Die Vorteile des Einsatzes von Robotic Vision für Automatisierungsanwendungen
- 5 großartige Vorteile der Verwendung von Edelstahlventilen für industrielle Anwendungen
- Nachrichtenverwaltungsbibliothek für SPS-Anwendungen mit IEC-61131 und eHMI



