Entwerfen von blinden/vergrabenen Vias in digitalen Hochgeschwindigkeitsschaltkreisen
Mit den zunehmenden Anwendungen von hochintegrierten und superhochintegrierten Schaltungen in Schaltungssystemen zeigen Leiterplatten einen Entwicklungstrend hin zu mehreren Schichten und Komplexität aufgrund des zunehmenden Integrationsmaßstabs von Chips, Volumenschrumpfung, Pin-Eskalation und Zunahme der Geschwindigkeitsrate. Die meisten mehrschichtigen Hochgeschwindigkeits-Leiterplatten implementieren Verbindungen zwischen Schichten durch Durchgangslöcher. Bei den nicht von oben nach unten umlaufenden elektrischen Anschlüssen erfolgt jedoch möglicherweise ein redundantes Durchgangsloch über Stub, so dass die Übertragungsqualität der Leiterplatte negativ beeinflusst wird. Daher kann bei einigen digitalen Hochgeschwindigkeitssystemen mit hoher Leistung und hohen Anforderungen der Einfluss von redundanten Stichleitungen niemals vernachlässigt werden. Basierend auf den Versuchen, Kosten und Leistung in Einklang zu bringen, entwickelt sich das Design von Blind/Buried Vias, um redundante Stichleitungseffekte effektiv zu vermeiden und die Übertragungsqualität von Systemen zu erhöhen.
Mit Blind- und Buried-Via-Design als Forschungsobjekten und durch Modellierungssimulation analysiert dieser Artikel hauptsächlich den Einfluss von Parametern bezüglich Via-Durchmessern von Blind-/Buried-Vias, Pad und Antipad auf Signalmerkmale wie S-Parameter und Impedanzkontinuität und gibt praktische Anweisungen zu hohen -Geschwindigkeit PCB blind/vergraben via Design.
Hauptparameter und Leistungsindex von Blind/Buried Vias
Für mehrschichtige Hochgeschwindigkeits-Digitalschaltungs-PCBs sind Durchgangslöcher für eine Hochgeschwindigkeits-Signalverbindung zwischen Verbindungsleitungen in einer Ebene und Verbindungsleitungen in einer anderen Ebene erforderlich. Vias sind eigentlich elektrische Leiter, die Routings zwischen verschiedenen Ebenen verbinden. Basierend auf Unterschieden im PCB-Design können Durchkontaktierungen in Durchgangsloch-Durchkontaktierungen, Blind-Durchkontaktierungen und vergrabene Durchkontaktierungen klassifiziert werden, wie in Abbildung 1 dargestellt.
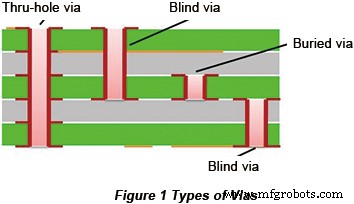
• Thru-Hole-Vias, die durch die gesamte Leiterplatte zirkulieren, werden für verbundene Routings zwischen Schichten oder als Positionierungs-Vias für Komponenten verwendet.
• Blind-Vias, die nicht durch die gesamte Leiterplatte verlaufen, sind für die Verbindung zwischen den internen Lagen der Leiterplatte und dem Routing auf der Oberflächenebene verantwortlich.
• Buried Vias sind nur für die Verbindung zwischen den internen Lagen der Leiterplatte verantwortlich. Sie sind nicht direkt am Aussehen der Leiterplatten zu erkennen.
Vias können nicht als elektrische Verbindung angesehen werden und ihr Einfluss auf die Signalintegrität muss berücksichtigt werden. Daher ist ein besseres Verständnis des Einflusses des Architekturdesigns von Durchkontaktierungen auf die Leistung digitaler Hochgeschwindigkeitsschaltungen für die hervorragende Lösung zur Signalintegrität von Vorteil, so dass das Design eines digitalen Hochgeschwindigkeitssystems und die Übertragungsqualität von Hochgeschwindigkeitssignalen optimiert werden können verbessert werden kann.
In Hochgeschwindigkeitsschaltungen kann das äquivalente elektrische Modell von Vias als Abbildung 2 angegeben werden, in der C1 , C2 und L bezieht sich jeweils auf die parasitäre Kapazität und Induktivität von Vias.
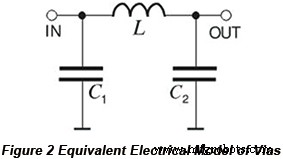
Basierend auf diesem Modell erzeugen alle Durchkontaktierungen in Hochgeschwindigkeitsschaltkreisen eine parasitäre Kapazität gegen Masse. Die parasitäre Kapazität kann anhand der folgenden Formel berechnet werden:

In dieser Formel ist die parasitäre Kapazität von Vias gleich dem Durchmesser des Antipads zur Masse, dem Durchmesser der Pads von Vias, der Dielektrizitätskonstante des Substratmaterials und der Dicke der PCB. In digitalen Hochgeschwindigkeitsschaltungen führt die parasitäre Kapazität von Durchkontakten dazu, dass die Anstiegszeit des Signals langsam oder abnimmt, und verlangsamt die Schaltungsgeschwindigkeit. Für eine Übertragungsleitung, deren charakteristische Impedanz Z0 ist , kann die Beziehung zwischen parasitärer Kapazität und der Anstiegszeit von Signalen als Formel unten angegeben werden.

Wenn Hochgeschwindigkeitssignale Vias durchlaufen, wird auch eine parasitäre Induktivität erzeugt. In digitalen Hochgeschwindigkeitsschaltungen ist der Einfluss, der durch die parasitäre Induktivität von Durchkontaktierungen hervorgerufen wird, größer als die parasitäre Kapazität. Die parasitäre Induktivität kann gemäß der nachstehenden Formel berechnet werden.

In dieser Formel ist die parasitäre Induktivität von Vias gleich der Länge von Vias und dem Durchmesser von Vias. Darüber hinaus kann die durch parasitäre Induktivität verursachte äquivalente Impedanz niemals vernachlässigt werden, und die Beziehung zwischen äquivalenter Impedanz und parasitärer Kapazität und Anstiegszeit von Signalen kann durch die folgende Formel angegeben werden.

Basierend auf den oben erwähnten Formeln ändert sich die elektrische Leistung von Vias mit Designparametern. Die Änderungen von Via-Durchmesser, -Länge, -Pad und -Antipad führen zu Impedanzsprüngen in Hochgeschwindigkeitsschaltungen, wobei die Signalintegrität stark beeinflusst wird. Die Analyse von Signalmerkmalen in diesem Artikel liegt in den Indizes von S11 (Rückflussdämpfung) und S21 (Einfügungsdämpfung). Wenn der Dämpfungsgrad der Einfügungsdämpfung weniger als -3 dB beträgt, wird die effektive Bandbreite angewendet, um die Signalübertragungsleistung von Blind-/Buried-Vias zu beurteilen und zu analysieren. Darüber hinaus kann die TDR-Simulation angewendet werden, um die durch Impedanzsprünge verursachte Reflexion zu analysieren.
Modellierungssimulation und Ergebnisanalyse von Blind/Buried Vias
Um den Einfluss von blinden/vergrabenen Durchkontaktierungen auf Hochgeschwindigkeits-PCB-Signalmerkmale zu untersuchen, entwirft dieser Artikel ein 8-Layer-PCB-Modell mit HFSS-Software, das in Abbildung 3 unten dargestellt ist.

In dieser Leiterplatte sind die Schichten 1 bis 2, 4 bis 5 und 7 bis 8 alle Signalschichten; die dritte Schicht ist eine Leistungsschicht; die sechste Schicht ist Grundschicht; die Dicke jeder Schicht beträgt 0,2 mm (8 mil); dielektrisches Material ist FR4; Die Dielektrizitätszahl beträgt 4. Die Leitungsbreite der Signalleitungen beträgt 0,1 mm (4 mil), die Dicke 0,13 mm (1,1 mil). In der Simulation ist die Anstiegszeit der Signale auf 20 ps und die höchste Sweep-Frequenz auf 100 GHz eingestellt.
• Vergleich des Einflusses von Signalmerkmalen, die von Blind/Buried Vias und Thru-Hole Vias stammen
Wenn eine Signalleitung von der ersten Schicht zur fünften Schicht zirkulieren muss, kann Blindvia für die Verbindung verwendet werden. Der Radius der Sacklochbohrung ist auf 0,1 mm (4 mil) und die Länge auf 0,81 mm (32 mil) eingestellt.
Zum Vergleich ist die Durchgangsloch-Via-Verbindung ebenfalls mit dem Durchgangsloch-Via-Radius von 0,1 mm ausgelegt. Unter dieser Bedingung beträgt die Länge des Stubs des Durchgangslochs 0,6 mm.
Basierend auf dem Simulationsergebnis wird, wenn die Frequenz im Bereich von 40 GHz bis 80 GHz liegt, der Parameter der Rückflussdämpfung des blinden Vias (S11 ) beträgt nur 4dB bis 7dB. Wenn jedoch die Frequenz im Bereich von 40 GHz bis 80 GHz liegt, ist der Parameter der Rückflussdämpfung des Durchgangslochs (S11 ) beträgt nur 4dB bis 10dB. Wenn die Frequenz 76 GHz beträgt, ist der Parameter der Einfügungsdämpfung von Blind Via (S21 ) ist der grösste. Wenn jedoch die Frequenz 52 GHz beträgt, ist der Parameter der Einfügungsdämpfung des Durchgangslochs (S21 ) ist der grösste. Wenn die Einfügungsdämpfung garantiert weniger als -3 dB beträgt, beträgt die Betriebsbandbreite von Blind Via 22 GHz, während die Betriebsbandbreite von Thru-Hole Via nur 15 GHz beträgt.
In Bezug auf die charakteristische Impedanz liegt die Änderungskategorie der charakteristischen Impedanz von Blind-Vias im Bereich von 46 bis 52, während die Änderungskategorie der charakteristischen Impedanz von Durchgangslöchern von 42 bis 53 liegt, was bedeutet, dass Blind-Vias eine bessere Übertragungsleitung haben Impedanz Kontinuität. Daher kann basierend auf der Stabilität der S-Parameter und der Änderung der charakteristischen Impedanz TDR gezeigt werden, dass blinde Durchkontaktierungen eine bessere Übertragungsqualität als Durchkontaktierungen in Bezug auf die Signalleitungsverbindung zwischen der oberen Schicht und der inneren Schicht oder zwischen der unteren Schicht und der inneren Schicht aufweisen Schicht.
Wenn eine Signalleitung von der zweiten Schicht zur fünften Schicht zirkulieren muss, kann eine vergrabene Durchkontaktierung für die Verbindung aufgebracht werden. Der Radius der vergrabenen Vias ist auf 0,1 mm und die Länge auf 0,57 mm eingestellt. Zum Vergleich wird auch ein Durchgangsloch mit einem Radius von 0,1 mil angewendet, und die Länge der redundanten Stichleitung zwischen der ersten Schicht und der zweiten Schicht beträgt 0,23 mm, während die Länge der redundanten Stichleitung zwischen der fünften Schicht und der achten Schicht 0,6 mm beträgt /P>
Basierend auf dem Simulationsergebnis, wenn die Frequenz im Bereich von 40 GHz bis 80 GHz liegt, ist der Parameter der Rückflussdämpfung der vergrabenen Durchkontaktierung (S11 ) beträgt nur 4 dB bis 8 dB mit relativ sanfter Änderung. Wenn jedoch die Frequenz im Bereich von 40 GHz bis 80 GHz liegt, ist der Parameter der Rückflussdämpfung des Durchgangslochs (S11 ) beträgt nur 4dB bis 10dB. Insbesondere bei einer Frequenz von 32 GHz ändert sich die Dämpfung sofort auf 13 dB, was die Stabilität der Übertragung beeinflusst. Wenn die Frequenz 77 GHz beträgt, ist der Parameter der Einfügungsdämpfung der vergrabenen Durchkontaktierung (S21 ) ist der grösste. Wenn die Frequenz jedoch 54 GHz beträgt, ist der Parameter der Einfügungsdämpfung des Durchgangslochs (S21 ) ist der grösste. Wenn die Einfügungsdämpfung garantiert weniger als -3 dB beträgt, beträgt die Betriebsbandbreite der vergrabenen Durchkontaktierung 32 GHz, während die Betriebsbandbreite der Durchkontaktierung nur 20 GHz beträgt.
Darüber hinaus liegt die Änderung des charakteristischen TDR des vergrabenen Vias im Bereich von 41,8 bis 52, während die Änderung des charakteristischen TDR des Durchgangslochs im Bereich von 37,5 bis 52 liegt, was bedeutet, dass das vergrabene Via eine bessere Kontinuität der Übertragungsleitungsimpedanz aufweist als Durchgangsloch über. Daher kann basierend auf der Stabilität der S-Parameter und der Änderung der charakteristischen Impedanz TDR gezeigt werden, dass vergrabene Durchkontaktierungen eine bessere Übertragungsqualität als Durchkontaktierungen in Bezug auf die Signalleitungsverbindung zwischen internen Schichten aufweisen.
• Einfluss von Blind/Buried Via Diameter, Pad und Antipad auf die Signaleigenschaften
Um den Einfluss von Blind-/Buried-Via-Durchmesser, Pad und Antipad auf Signalmerkmale zu untersuchen, kann die Größe von Pad und Antipad von Blind-/Buried-Vias festgelegt werden. Der Anfangswert des Radius von Blind/Buried Vias ist auf 0,1 mm eingestellt und ändert sich innerhalb der Kategorie von 0,1 mm bis 0,175 mm.
Basierend auf dem Ergebnis der Simulation kann angegeben werden, dass, wenn sich der Radius des blinden Vias innerhalb der Kategorie von 0,1 mm auf 0,175 mm ändert, die Änderung der Impedanz in der Kategorie von 6 bis 13,5 liegt, wobei der Grad der Impedanzdiskontinuität, die dies verursacht, erhöht wird die Erhöhung in Bezug auf den Bereich der Einfügungsdämpfung S21 . Wenn die Frequenz im Bereich von 20 GHz bis 60 GHz liegt, erreicht die größte Dämpfung 1,7 dB. Wenn sich dagegen der Radius des vergrabenen Vias innerhalb der Kategorie von 4 mil auf 7 mil ändert, liegt die Impedanzänderung in der Kategorie von 10 auf 17, wobei der Grad der Impedanzdiskontinuität erhöht wird, was die Erhöhung des Bereichs der Einfügungsdämpfung S21 . Wenn die Frequenz im Bereich von 20 GHz bis 60 GHz liegt, erreicht die größte Dämpfung 1,6 dB.
Bei unverändertem Durchmesser von Blind Via und Antipad wird der Anfangswert des Radius von Blind/Buried Via Pad auf 0,2 mm gesetzt und ändert sich innerhalb der Kategorie von 0,2 mm auf 0,28 mm.
Basierend auf dem Ergebnis der Simulation kann angegeben werden, dass, wenn sich der Radius des Blind-Via-Pads innerhalb der Kategorie von 0,2 mm auf 0,28 mm ändert, die Änderung der Impedanz in der Kategorie von 6,5 auf 10,5 liegt, die die Reichweitenerhöhung verursacht der Einfügungsdämpfung S21 . Außerdem erhöht sich die größte Dämpfung um 2dB. Wenn sich der Radius des vergrabenen Via-Pads innerhalb der Kategorie von 0,2 mm auf 0,28 mm ändert, liegt die Impedanzänderung in der Kategorie von 10,5 auf 15,5, wobei der Grad der Impedanzdiskontinuität erhöht wird, was die Erhöhung des Bereichs der Einfügungsdämpfung verursacht S21 . Außerdem erhöht sich die größte Dämpfung um 3,2 dB.
Bei unverändertem Blind-/Buried-Via-Durchmesser und unveränderter Pad-Größe wird der Anfangswert von Antipad auf 0,3 mm gesetzt und ändert sich innerhalb der Kategorie von 0,3 mm auf 0,375 mm.
Auf der Grundlage des Simulationsergebnisses kann angegeben werden, dass, wenn sich die Größe des blinden Via-Antipads innerhalb der Kategorie von 0,3 mm auf 0,375 mm ändert, die Änderung der Impedanz in der Kategorie von 6,5 auf 5,5 liegt, die die graduelle Abnahme verursacht der Impedanzdiskontinuität und Bereich der Einfügungsdämpfung S21 . Außerdem erhöht sich die größte Dämpfung um 3,2 dB. Wenn sich die Größe des vergrabenen Via-Antipads innerhalb der Kategorie von 0,3 mm auf 0,375 mm ändert, liegt die Änderung der Impedanz in der Kategorie von 10 bis 7,5, was die Abnahme des Grades der Impedanzdiskontinuität und des Bereichs der Einfügungsdämpfung S verursacht 21 . Außerdem erhöht sich die größte Dämpfung um 3dB.
Schlussfolgerung
Anhand einer 8-Lagen-Leiterplatte mit Blind- und Buried-Vias-Modell, das durch HFSS erstellt wurde, vergleicht dieser Artikel die S-Parameter und die charakteristische Impedanz TDR von Blind-/Buried-Vias und Durchgangsloch-Vias. Daraus kann geschlossen werden, dass blinde/vergrabene Durchkontaktierungen eine geringere Einfügungsdämpfung und eine bessere Impedanzdiskontinuität aufweisen als Durchkontaktierungen. Unter der Bedingung, dass die Einfügungsdämpfung weniger als -3 dB beträgt, haben blinde/vergrabene Durchkontaktierungen eine größere Betriebsbandbreite als Durchkontaktierungen.
Dieser Artikel analysiert auch den Einfluss von Parametern einschließlich Via-Durchmesser, Pad und Antipad auf blinde/vergrabene Signalmerkmale. Mit zunehmendem Durchmesser von Blind-/Buried-Vias und Pad-Größe schrumpft die Dämpfung der Einfügungsdämpfung des Signals entsprechend und der Grad der Impedanzdiskontinuität nimmt zu. Mit zunehmender Antipad-Größe von Blind-/Buried-Vias schrumpft jedoch die Dämpfung der Signal-Einfügungsdämpfung und entsprechend auch die Impedanz-Diskontinuität.
Wenn die Einfügungsdämpfung weniger als -3 dB beträgt und die effektive Betriebsbandbreite 20 GHz erreicht, sollte der Radius von Blind-Vias nicht größer als 0,175 mm und der Radius von vergrabenen Vias nicht größer als 0,23 mm sein; das Pad von Blind Vias sollte nicht größer als 0,25 mm sein und das Pad von Buried Vias sollte nicht größer als 0,275 mm sein; das Antipad von Blind Vias sollte nicht kleiner als 0,25 mm sein und das Antipad von Buried Vias sollte nicht kleiner als 0,23 mm sein.
Wenn der Änderungsbereich der Impedanz innerhalb von ±10 % gesteuert wird, sollte der Radius von Blind- und Buried-Vias nicht größer als 0,125 mm sein; das Pad von Blind Vias sollte nicht größer als 0,25 mm sein und das Pad von Buried Vias sollte nicht größer als 0,175 mm sein; das Antipad von Blind Vias sollte nicht kleiner als 0,275 mm sein und das Antipad von Buried Vias sollte nicht kleiner als 0,4 mm sein.
PCBCart ist in der Lage, Leiterplatten mit Blind-Vias, Buried-Vias und Thru-Hole-Vias herzustellen.
Benötigen Sie Leiterplatten mit Blind Vias, Buried Vias und Thru-Hole Vias? PCBCart hat Sie abgedeckt! Alles, was wir verlangen, ist die fertige PCB-Designdatei, um die Produktion zu planen. Wenn Sie die Designdatei in Händen halten, geben Sie bitte Ihre PCB-Preise an, indem Sie auf die Schaltfläche unten klicken. Der Preis wird innerhalb von Sekunden angezeigt!
Hilfreiche Ressourcen:
• Vergleich zwischen Blind Via und Buried Via
• PCBCart bietet PCB-Fertigungsservice mit vollem Funktionsumfang
• Mit Ausnahme der PCB-Fertigung bietet PCBCart auch einen erweiterten schlüsselfertigen PCB-Montageservice
• Anforderungen an PCB-Designdateien für ein schnelles Angebot und eine schnelle Produktion von PCB-Bestückungen
• 3 wichtige Elemente, die Sie nicht über Buried und Blind Via in starrflexiblen HDI-PCBs wissen
Industrietechnik
- Einführung in digitale integrierte Schaltungen
- Vias auf BGA-Pads
- Kupferfüllung von Blind-Microvias
- So starten Sie den Digitalisierungsprozess eines Unternehmens
- Wie kann ich den digitalen Reifegrad meines Unternehmens messen?
- Was ist Lean Digital und wie wird es integriert?
- Wie kann die Leistung der Mitarbeiter verbessert werden?
- Alles Wissenswerte über blinde und vergrabene Vias
- Hochgeschwindigkeits-Layout-Tipps
- So optimieren Sie das HDI-Design in der Elektronik



