Großer seitlicher photovoltaischer Effekt bei MoS2/GaAs-Heterojunction
Zusammenfassung
Molybdändisulfid (MoS2 .) ) nanoskalige Filme werden auf GaAs-Substraten mittels Magnetron-Sputter-Technik abgeschieden, und MoS2 /GaAs-Heteroübergänge werden hergestellt. Der laterale photovoltaische Effekt (LPE) des hergestellten MoS2 /GaAs-Heteroübergänge untersucht. Die Ergebnisse zeigen, dass im MoS2 . ein großes LPE erhalten werden kann /n -GaAs-Heteroübergang. Das LPE zeigt eine lineare Abhängigkeit von der Position der Laserbeleuchtung und die beachtlich hohe Empfindlichkeit von 416,4 mV mm − 1 . Diese Sensitivität ist viel größer als die Werte in anderen berichteten MoS2 -basierte Geräte. Im Vergleich dazu ist die LPE im MoS2 /p -GaAs-Heteroübergang ist viel schwächer. Die Mechanismen des LPE werden enthüllt, indem die Energiebandausrichtung des MoS2 . konstruiert wird /GaAs-Heteroübergänge. Die hervorragenden LPE-Eigenschaften machen MoS2 Filme kombiniert mit GaAs-Halbleitern vielversprechende Kandidaten für die Anwendung von hochleistungsfähigen positionsempfindlichen Detektoren.
Hintergrund
Aufgrund seiner hervorragenden Eigenschaften ist Molybdändisulfid (MoS2 ) wird als eine typische Art von zweidimensionalen Materialien untersucht, um mikroelektronische und optoelektronische Bauelemente der nächsten Generation zu entwickeln [1,2,3,4,5]. Im Gegensatz zu Graphen ist MoS2 hat eine offensichtliche Bandlücke und ihre Bandlücke nimmt mit steigender Schichtzahl ab [6]. Das Vorhandensein der offensichtlichen Bandlücke ermöglicht die Herstellung des MoS2 Transistoren mit einem Ein/Aus-Verhältnis von mehr als 10 8 und die Photodetektoren mit hoher Empfindlichkeit [7, 8]. Vor kurzem MoS2 in Kombination mit anderen Halbleitern hat großes Interesse geweckt, wie GaAs, Si und GaN [9,10,11,12,13]. Diese entworfenen Heterostrukturen liefern eine machbare technische Route für MoS2 -basierte Materialien zur Entwicklung praktisch anwendbarer optoelektronischer Geräte. Unter all diesen Volumenhalbleitern hat GaAs eine geeignete direkte Bandlücke von ~ 1.42 eV und eine hohe Elektronenmobilität (~ 8000 cm 2 V −1 s −1 ). Linet al. fabriziertes MoS2 /GaAs-Solarzellen mit einer Leistungsumwandlungseffizienz von über 9,03 % [9]. Außerdem haben Xu et al. einen MoS2 gemeldet /GaAs selbstgesteuerter Photodetektor mit der extrem hohen Detektivität von 3,5 × 10 13 Jones [10]. In früheren Berichten wurden die Studien zu MoS2 /GaAs-Heterostrukturen haben sich hauptsächlich auf die Anwendung im Bereich von Solarzellen und Photodetektoren konzentriert. Allerdings ist der MoS2 /GaAs als positionsempfindlicher Detektor (PSD) basierend auf dem lateralen Photovoltaikeffekt (LPE) wurde selten beschrieben. Anders als der gewöhnliche longitudinale photovoltaische Effekt entsteht der LPE aus der lateralen Diffusion und Rekombination der photonenerzeugten Ladungsträger in der Inversionsschicht an der Grenzfläche [14,15,16,17,18]. Beim LPE-Effekt kann eine laterale Photospannung (LPV) erhalten werden, die sich linear mit der Laserpunktposition auf dem aktiven Bereich der Geräteoberfläche ändert. Diese Eigenschaften machen LPE sehr nützlich bei der Entwicklung von Hochleistungs-PSDs und wurden in den Bereichen Robotik, biomedizinische Anwendungen, Prozesssteuerung, Positionsinformationssysteme usw. umfassend untersucht.
In dieser Arbeit wird MoS2 auf der Oberfläche von n . werden dünne Schichten unterschiedlicher Dicke abgeschieden -/p -GaAs-Substrate mittels Magnetron-Sputter-Technik. Im hergestellten MoS2 . wird ein großes LPE beobachtet /n -GaAs-Heteroübergang, und die Empfindlichkeit erreichte 416,4 mV mm −1 . Unsere Ergebnisse zeigen weiterhin, dass das LPE eine offensichtliche Abhängigkeit von den Trägertypen der GaAs-Substrate und der Dicke des MoS2 . aufweist Filme. Durch die Konstruktion des Energiebandabgleichs an der Schnittstelle werden die Mechanismen zum LPE in den Geräten vorgeschlagen.
Methoden
MoS2 Dünnfilme wurden auf (100)-orientierten GaAs-Substraten unter Verwendung der DC-Magnetron-Sputtertechnik abgeschieden. Das MoS2 Pulver (Reinheit ~~99%) wurden unter einem Druck von 20,0 MPa zu einer Scheibe kaltgepresst. Die so hergestellte Scheibe (Φ60,0 mm × 4,5 mm) wurde während des Sputterns als Target verwendet. Die n- /p -GaAs-Substrate wurden jeweils in unseren Experimenten verwendet. Vor der Abscheidung wurden die Substrate nacheinander mit Alkohol, Aceton und entionisiertem Wasser mit Ultraschall gereinigt. Anschließend wird MoS2 dünne Filme mit unterschiedlicher Dicke (d MoS2 =~ 10, 30, 50, 90 nm) wurden jeweils bei einer Temperatur von 400 °C auf den GaAs-Substraten aufgewachsen. Während der Abscheidung wurden der Arbeitsdruck und die Leistung bei 1,0 Pa bzw. 10,0 W gehalten. Als Referenz:MoS2 Dünnschichten wurden auch auf intrinsischem GaAs (i -GaAs)-Substrate unter den gleichen Bedingungen. Schließlich wurden ca. 300 µm In-Pads mit einem Durchmesser von 0,5 mm als Elektroden auf das MoS2 . gepresst filmen.
Das MoS2 Filme wurden mit Raman-Spektroskopie (HORIBA, HR800) mit einer Anregungswellenlänge von 488 nm charakterisiert. Die Oberfläche der Probe wurde mit einem Rasterkraftmikroskop (AFM) abgetastet. Röntgenphotoemissionsspektroskopie (XPS) wurde mit einem Kratos Axis ULTRA Spektrometer mit einer monochromatischen Al Kα Röntgenquelle durchgeführt. Die Abscheidungsrate wurde durch die Dicke aus dem Querschnittsrasterelektronenmikroskop (REM) (Zusatzdatei 1:Abbildung S1) und die Abscheidungszeit erhalten, dann wurde jede Filmdicke durch die Abscheidungsrate und jede Abscheidungszeit bestimmt. Die Transmissionsspektren wurden mit einem Shimadzu UV-3150-Spektrophotometer gemessen. Ultraviolett-Photoelektronenspektroskopie (UPS) wurde unter Verwendung einer ungefilterten He-I-(21,22 eV)-Gasentladungslampe durchgeführt. LPVs wurden unter Verwendung eines Keithley 2000 Voltmeters und eines dreidimensionalen elektrisch motorisierten Tisches mit einem Laser mit einer Wellenlänge von 650 nm als Beleuchtungsquelle gemessen. Die Strom-Spannung (I -V ) Kurven wurden mit einem Keithley 2400 SourceMeter gemessen.
Ergebnisse und Diskussion
Abbildung 1 zeigt das Raman-Spektrum des MoS2 Film auf dem GaAs-Substrat. Neben dem Peak des GaAs-Substrats bei ~ 287,1 cm −1 , zwei charakteristische MoS2 Raman-Spitzen sind zu sehen, die A1g Modus bei ∼ 406,7 cm −1 und E 1 2g Modus bei ∼ 378,9 cm −1 . Die beiden rechten Einschübe zeigen die Darstellung der Atomschwingung in MoS2 . Die A1g -Modus entspricht der gegenphasigen Oszillation der S-Atome entlang der Richtung außerhalb der Ebene, und die E 1 2g Modus entspricht den S- und Mo-Atomen, die gegenphasig parallel zur Kristallebene schwingen. Wie in der Abbildung gezeigt, entspricht der Raman-Peak dem A1g Modus wird bevorzugt für den Film aufgeregt. Laut unseren Messungen beträgt das Intensitätsverhältnis von A1g /E 1 2g ist ungefähr 2.1. Diese Raman-Eigenschaften ähneln anderen berichteten Ergebnissen zu MoS2 dünne Filme [19]. Der linke Einschub zeigt ein topografisches AFM-Bild des 40-nm-MoS2 Film, der auf dem GaAs-Substrat aufgewachsen ist. Aus der Abbildung können wir sehen, dass die Oberfläche des Films aus dichten kegelförmigen Körnern besteht. Gemäß den Messungen beträgt der quadratische Mittelwert (RMS) der Rauhigkeit des Films etwa 1,7 nm und die durchschnittliche Korngröße beträgt etwa 76,3 nm im Durchmesser. Diese Körner auf der Oberfläche könnten die Oberflächenreflexion für das externe Licht verringern und die Lichtabsorption des hergestellten Geräts verbessern.

Raman-Spektrum des MoS2 Film über GaAs. Die beiden rechten Einschübe zeigen die schematische Darstellung des Schwingungsmodus von E 1 2g und A1g , bzw. Atom-Farbcode:hellblau-grün, Mo; gelb, S. Der linke Einschub zeigt das Oberflächenmorphologiebild des gewachsenen MoS2 Filme
Abbildung 2 zeigt die XPS-Spektren des MoS2 Film. Wie in Abb. 2a gezeigt, beziehen sich die Peaks bei 229,3 und 232,5 eV auf das Mo 3d5/2 und Mo 3d3/2 Orbitale bzw. Wie in Fig. 2b gezeigt, S 2p3/2 und S 2p1/2 Orbitale zweiwertiger Sulfidionen (S 2− ) werden bei 162,2 bzw. 163,3 eV beobachtet. Die Ergebnisse stimmen gut mit den berichteten Werten für MoS2 . überein Kristall [17, 18].

XPS-Spektren des MoS2 Film für a Mo und b S-Elemente bzw.
Abbildung 3a zeigt das longitudinale I -V Kurve des hergestellten MoS2 /n -GaAs-Heteroübergänge. Auf die Oberfläche des MoS2 . wurden zwei In-Elektroden mit einem Durchmesser von ca. 0,5 mm gepresst Film bzw. die Rückseite des GaAs. Der Einschub zeigt den Schaltplan für die Längsmessungen. Die Durchlassspannung ist als positive Vorspannung definiert, die an die obere In-Elektrode angelegt wird. Wie in der Abbildung gezeigt, ist das hergestellte MoS2 /n -GaAs-Heteroübergang zeigt ein offensichtliches Gleichrichtungsverhalten. Das Gleichrichtungsverhältnis (I + /Ich − ) gemessen bei ± 1,0 V beträgt etwa 520. In unseren Experimenten wurden sowohl In/MoS2 und In/GaAs gehören zu ohmschen Kontakten und deren I -V Kurven sind fast linear. Somit ist das berichtigende Ich -V Charakteristik in der Heterojunction stammt hauptsächlich vom MoS2 /GaAs-Kontakt. Abbildung 3b zeigt das transversale I -V Kurve des hergestellten MoS2 /n -GaAs-Heteroübergänge. Auf die Oberfläche des MoS2 . wurden zwei In-Elektroden mit einem Durchmesser von ca. 0,5 mm gepresst Film. Der obere Einschub zeigt den Schaltplan für die Quermessungen. Aus der Figur das Ich -V Kurve zeigt einen leicht nichtlinearen Anstieg der Ströme mit steigenden Spannungen. Dies deutet darauf hin, dass eine Inversionsschicht am MoS2 /n -GaAs-Grenzfläche wird gebildet [18]. Der untere Einsatz zeigt das I -V Kurven des einzelnen MoS2 Filme auf dem intrinsischen GaAs-Substrat. Aus der Abbildung ergibt sich ein fast lineares I -V Es ist eine Kurve zu sehen, die weiter auf die ohmsche Natur des In/MoS2 . hindeutet Kontakt. Bei einer Spannung von + 0,5 V ist der Strom des einzelnen MoS2 ist ungefähr 3,1 × 10 −2 μA, viel kleiner als der Wert im MoS2 /n -GaAs, etwa 2,3 µA. Im Vergleich zum MoS2 Film, die Inversionsschicht am MoS2 /n -GaAs-Schnittstelle liefert einen Pfad mit einem viel niedrigeren spezifischen Widerstand für den Ladungsträgertransport während der transversalen Messungen des MoS2 /n -GaAs-Heteroübergang.

a Längs I -V Kurve des hergestellten MoS2 /n -GaAs-Heteroübergänge. Der Einschub zeigt den Schaltplan für die Längsmessungen. b Quer I -V Kurven des hergestellten MoS2 /n -GaAs-Heteroübergänge. Der obere Einschub zeigt den Schaltplan für die Quermessungen. Der untere Einsatz zeigt das I -V Kurven des MoS2 Filme auf dem intrinsischen GaAs-Substrat
Abbildung 4a zeigt die schematische Schaltung zur Messung des LPE des hergestellten MoS2 /GaAs-Heteroübergang. Auf die Oberfläche des MoS2 . werden zwei In-Elektroden mit einem Durchmesser von 0,5 mm gepresst Film, um die Messungen des LPE durchzuführen. Die Entfernung (2L ) zwischen den Elektroden beträgt ~ 1,0 mm. Während unserer Messungen wurden die Elektroden A und B mit den positiven bzw. negativen Sonden eines Keithley 2000 Voltmeters verbunden. Abbildung 4b zeigt die LPE-Kurven des MoS2 /n -GaAs und MoS2 /p -GaAs-Heterojunctions bzw. Die Dicke des MoS2 Filme ist ~~30,0 nm. Wenn die Oberfläche des MoS2 Film teilweise von einem Laserspot mit einem Durchmesser von ca. 0,1 mm beleuchtet wird, kann ein großes LPE im MoS2 . beobachtet werden /n -GaAs-Heteroübergang. Wie in der Abbildung gezeigt, zeigt der LPE eine ungefähr lineare Abhängigkeit von der Laserspotposition, wenn sich der Laserspot zwischen den Elektroden A und B auf dem MoS2 . bewegt Oberfläche. Aus der Abbildung können wir sehen, dass der LPV von der Position des Laserspots abhängt. Dies kann mit der Diffusionstheorie [16],
$$ \mathrm{LPV}={K}_0\Big[\exp \left(-\frac{\left|Lx\right|}{d}\right)-\exp \left(-\frac{\left |L+x\rechts|}{d}\rechts) $$wo K 0 , 2L , d , und x repräsentieren einen Proportionalitätskoeffizienten, den Abstand zwischen zwei Elektroden, die Trägerdiffusionslänge bzw. die Laserpunktposition. Die gut angepassten Ergebnisse in der Abbildung legen eindeutig nahe, dass die LPE im MoS2 /n -GaAs-Heteroübergang entsteht aus dem seitlichen diffusen Fluss und der Rekombination der angeregten Ladungsträger weg von der Laserposition. Wie in der Abbildung gezeigt, ist der LPV-Wert Null, wenn sich der Lichtfleck in der Mitte zwischen zwei Elektroden befindet, was auf die Diffusionssymmetrie der Ladungsträger zurückgeführt werden kann. Wenn sich die Lichtposition nahe der A-Elektrode befindet, ist der LPV positiv und umgekehrt. Dies weist darauf hin, dass das LPE im MoS2 /n -GaAs-Heteroübergang wird durch photoangeregte Ladungsträger vom Lochtyp verursacht. Der maximale LPV wird erreicht, wenn die Laserbeleuchtung den Elektroden am nächsten ist. Nach unseren Messungen beträgt die maximale seitliche Photospannung (LPVmax ) beträgt etwa 208,2 mV im linearen Bereich des MoS2 /n -GaAs-Heteroübergang. Im Vergleich dazu ist der LPV des MoS2 /p -GaAs-Heteroübergang ist viel kleiner und sein LPVmax beträgt nur 7,3 mV, wie in der Abbildung gezeigt. Aus der Abbildung können wir sehen, dass der LPE des MoS2 /p -GaAs-Heteroübergang wird durch die photoangeregten Ladungsträger vom Elektronentyp bestimmt. Darüber hinaus nichtlineare LPE-Eigenschaften des MoS2 /p -GaAs-Heteroübergang ist aus der Abbildung ersichtlich, wenn sich der Laserfleck zwischen den Elektroden A und B bewegt.
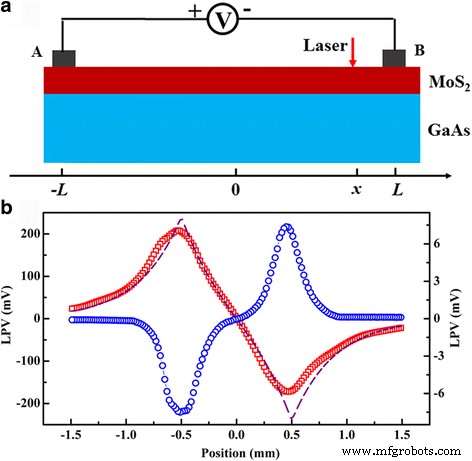
a Schematische Schaltung zur Messung des LPE. b LPE-Kurven des MoS2 /n -GaAs und MoS2 /p -GaAs-Heteroübergänge bzw.
Abbildung 5 zeigt die LPE-Empfindlichkeit des MoS2 /n -GaAs-Heteroübergang als Funktion der Laserleistung und der Dicke (d MoS2 ) des MoS2 Film. Die Empfindlichkeit wird durch S . definiert =LPVmax /L . Offensichtlich ist das S steigt mit zunehmender Laserleistung anfangs drastisch an, wird dann aber langsam gesättigt, wenn die Leistung weiter ansteigt. Diese Sättigung könnte durch die schnell ansteigende Rekombinationsrate der photoangeregten Löcher mit zunehmender Laserintensität im beleuchteten Bereich verursacht werden [20]. Wie in der Abbildung gezeigt, können selbst bei schwacher Laserbeleuchtung von 100,0 µW ein deutlicher LPE und eine hohe Empfindlichkeit erzielt werden. Aus der Abbildung ist eine signifikante Abhängigkeit der Empfindlichkeit von der Dicke des MoS2 Filme zu sehen sind. Wenn d MoS2 =~ 10.0 nm, S =165,4 mV mm −1 unter der Laserbeleuchtung von 100,0 μW. Mit zunehmender Filmdicke S nimmt allmählich zu. Wenn d MoS2 =30,0 nm, S erreicht 416,4 mV mm −1 . Diese Sensitivität ist viel größer als der berichtete MoS2 /Si-Geräte [17, 18]. Nach d MoS2> 30,0 nm, S nimmt mit weiter steigendem MoS2 . ab Dicke. Wenn d MoS2 =90,0 nm, S = 283,3 mV mm −1 . Um den größten LPE und die größte Empfindlichkeit zu erzielen, gibt es daher eine optimale Dicke des MoS2 Film im hergestellten MoS2 /n -GaAs, etwa 30,0 nm.

Abhängigkeit von positiven und negativen Empfindlichkeiten des hergestellten MoS2 /n -GaAs-Heteroübergang jeweils bei Laserleistungen
Abbildung 6a zeigt die USV-Spektren des MoS2 Film auf dem Si-Substrat. Die Austrittsarbeit (W ) des Films lässt sich aus der Differenz zwischen dem Cut-off der höchsten Bindungsenergie und der Photonenenergie der anregenden Strahlung berechnen. Aus der Abbildung, W =5,24 eV erhalten werden. Die Entfernung (∆E ) zwischen dem Valenzband (E V ) und das Fermi-Niveau (E F ) von MoS2 Film kann aus der Onset-Energie extrahiert werden, wie im Einschub gezeigt. Das ∆E für das MoS2 Film ist ungefähr 0,51 eV. Verwendung der Daten aus dem Transmissionsspektrum des MoS2 Film auf Quarzsubstrat, (αhν ) 2 aufgetragen als Funktion der Photonenenergie hν , wobei h ist die Planck-Konstante und ν ist die Photonenfrequenz. Die α ist der Absorptionskoeffizient, berechnet aus αd =ln(1/T ) [21], wobei d und T sind die Dicke bzw. die Durchlässigkeit des Films. Die Bandlücke (E g ) des Films kann aus dem Schnittpunkt der Linie auf dem hν . bestimmt werden Achse, E g =1,54 eV, wie in Abb. 6b gezeigt. Basierend auf diesen Energiebandparametern wird der p -Typisches Verhalten des MoS2 Film bestimmt werden, was durch Hall-Messungen weiter nachgewiesen werden kann. Die Hall-Ergebnisse zeigen, dass die Konzentration des Lochträgers und die Mobilität etwa 3,8 × 10 15 . betragen cm −3 und 11,2 cm 2 V −1 s −1 , bzw.

a USV-Spektren des MoS2 Film auf GaAs, der das Fermi-Niveau der Filme und den Abstand zwischen dem Fermi-Niveau und der Oberkante des Leitungsbandes zeigt. b (αhν ) 2 ~hν Kurve aus dem UV-Spektrum des MoS2 Film auf Quarzsubstrat unter den gleichen Abscheidungsbedingungen
Um die Mechanismen der LPE im MoS2 . aufzuklären /GaAs-Heteroübergänge werden die Energiebanddiagramme an der Grenzfläche basierend auf den Ergebnissen in Abb. 6 erstellt. Hier gilt E g =1,42 eV und E F =4,17 eV für n -GaAs werden beim Aufbau der Bandstruktur berücksichtigt [22]. Wenn der MoS2 Film auf dem GaAs-Substrat abgeschieden wird, fließen die Elektronen vom GaAs in das MoS2 Film an der Schnittstelle aufgrund des höheren E F des GaAs. Der Fließprozess stoppt, wenn die Fermi-Werte gleich sind und das MoS2 /GaAs p -n Verbindung hergestellt wird, wie in Fig. 7a gezeigt. Folglich ist ein eingebautes Feld (E bi ) entsteht an der Grenzfläche des MoS2 /GaAs-Heteroübergang. E bi =[E F (n -GaAs) − E F (MoS2 )]/e =1,07 V und zeigt vom GaAs zum MoS2 Film. Somit ist das asymmetrische longitudinale I -V Kurve ist in Fig. 3a gezeigt. Aufgrund der Existenz eines starken E bi , große Mengen von lochartigen Ladungsträgern werden nahe der Grenzfläche angesammelt und eine Inversionsschicht wird im n . gebildet -GaAs-Substrat nahe der Grenzfläche, wie in Fig. 7b gezeigt. Ähnlich wie beim zweidimensionalen Lochgas (2DHG) [23] könnte die Inversionsschicht aufgrund der hohen Schichtkonzentration der Löcher (p+ ). Aus Abb. 3b können wir sehen, dass die Leitfähigkeit der Inversionsschicht viel größer ist als die des MoS2 Film. Somit ist die Leitung zwischen zwei Elektroden auf derselben Seite des MoS2 Film wird eher von der Inversionsschicht als von MoS2 . dominiert Film. Wenn der Übergang teilweise vom Laser beleuchtet wird, wird das Licht absorbiert und die Elektron-Loch-Paare im MoS2 Film bzw. GaAs können induziert werden, wie in Fig. 7c gezeigt. Es kann jedoch erwartet werden, dass der größte Teil des Lasers von den GaAs-Substraten aufgrund seiner viel größeren Dicke und kleineren Bandlücke absorbiert wird. Bei der Laserbeleuchtung können die Elektron-Loch-Paare nur im beleuchteten Bereich und räumlich getrennt durch das E . angeregt werden bi . Aufgrund der Ausrichtung des E bi zeigt von GaAs auf MoS2 fließen die photoangeregten Löcher zur Grenzfläche und treten in die Inversionsschicht im GaAs ein, wie in Fig. 7c gezeigt. Die photoangeregten Löcher in der Inversionsschicht diffundieren seitlich vom beleuchteten Fleck weg zu den beiden Elektroden. Die Konzentration der von den beiden Elektroden gesammelten angeregten Löcher ist für unterschiedliche Entfernungen vom beleuchteten Fleck unterschiedlich. Somit wird ein großes LPV zwischen den Elektroden gebildet und das LPE wird im Heteroübergang beobachtet. Dies stimmt mit den angepassten Ergebnissen aus Abb. 3b überein, und der LPE im MoS2/n -GaAs-Heteroübergänge stammen hauptsächlich aus der Trägerdiffusion. Wenn der MoS2 Film wird auf den p aufgebracht -GaAs-Substrat, ein p -p Heteroübergang wird gebildet, wie in Fig. 7d gezeigt. E F (p -GaAs) =5,32 eV wird im Banddiagramm verwendet [22]. Das E bi der p -p Heteroübergang kann berechnet werden, 0,08 V, und seine Richtung zeigt vom Film zum Substrat. Aufgrund des E bi werden Ladungsträger vom Elektronentyp in der Nähe der Grenzfläche des Heteroübergangs akkumuliert und die Inversionsschicht wird gebildet. Somit wird die durch die Diffusion der photoangeregten Elektronen induzierte LPE im MoS2 . erhalten /GaAs p -p Heteroübergang, wie in Abb. 4 gezeigt. Die Konzentration der akkumulierten Ladungsträger in der Inversionsschicht könnte jedoch aufgrund des schwachen V . geringer sein bi von nur 0,08 V im p -p Heterojunction im Vergleich zum p -MoS2 /n -GaAs-Kreuzung. Dies erhöht die Schwierigkeiten des Transports der photoangeregten Elektronen in der Inversionsschicht. Ernsthaft, die Schottky-Barrieren können zwischen den n -Typ-Inversionsschicht und die p -MoS2 Film, wie in Fig. 7e gezeigt. Diese Eigenschaften des p -MoS2 /p -GaAs-Übergang unterdrückt das Sammeln der photoangeregten Elektronen an den Elektroden. Dadurch konnte die LPE stark reduziert werden. Wie in Abb. 4b gezeigt, ist der LPVmax für die p -p Junction beträgt nur 7,3 mV, während sie im p . 208,2 mV erreicht -n Kreuzung.

a Energieband-Ausrichtung des MoS2 /n -GaAs-Heteroübergang und b die entsprechende Abbildung der elektrischen Kontaktierung an der Schnittstelle. c Mechanismus der LPE im MoS2 /n -GaAs-Heteroübergang. d Energieband-Ausrichtung des MoS2 /p -GaAs-Heteroübergang und e die entsprechende Darstellung der elektrischen Kontaktierung an der Schnittstelle
Bei den beschriebenen PSDs vom Heteroübergangstyp kommt es normalerweise vor, dass die LPE durch Ändern der Dicke der Deckschichten eingestellt werden kann [20]. Dies kann gut verstanden werden, wenn man die Rekombination der photoangeregten Träger im Film und die Entwicklung des eingebauten Feldes betrachtet. Im MoS2 /GaAs p -n Durch den langen Transportweg im dicken MoS2 . kann die Rekombination von photonengenerierten Ladungsträgern verbessert werden Film, bevor sie von den Elektroden gesammelt werden. Dies verringert die LPE der Heteroübergänge. Umgekehrt kann ein dünnerer Film die Rekombination stark verringern, was zu einer Erhöhung des LPE führt. Wenn jedoch der MoS2 Dicke kleiner als der kritische Wert ist, das E bi an der Grenzfläche nimmt mit weiter abnehmendem MoS2 . ab Dicke [24]. Dies kann die Trennung von durch Photonen erzeugten Elektron-Loch-Paaren verringern, und der LPE nimmt ab. Somit gibt es eine optimale Dicke des MoS2 Film zum Erzielen des höchsten LPE, etwa 30 nm.
Schlussfolgerungen
Zusammenfassend lässt sich sagen, dass MoS2 Dünnfilme wurden auf der Oberfläche des GaAs-Substrats mittels Magnetron-Sputtertechnik abgeschieden. Im hergestellten MoS2 . wurde ein großes LPE erhalten /n -GaAs-Heteroübergang und die Abhängigkeit des LPV von der Position der Laserbeleuchtung zeigten eine gute Linearität. Durch die Ausbildung des starken eingebauten Feldes an der Grenzfläche wird das MoS2 /n -GaAs-Heteroübergang zeigte eine hohe Empfindlichkeit von 416,4 mV mm −1 , während der Wert nur 7,3 mV mm −1 . betrug für das MoS2 /p -GaAs. Unsere Ergebnisse zeigten außerdem, dass das LPE eine offensichtliche Abhängigkeit von der Dicke des MoS2 . aufwies Filme und etwa 30,0 nm war die optimale Dicke des MoS2 Film, um den höchsten LPE im hergestellten MoS2 zu erhalten /n -GaAs-Heteroübergänge. Die Mechanismen der LPE im MoS2 /GaAs-Geräte wurden anhand der Energiebandausrichtung an der Grenzfläche geklärt.
Abkürzungen
- ∆E :
-
Entfernung zwischen E V und E F
- d MoS2 :
-
Dicke des MoS2 Film
- E bi :
-
Eingebautes Feld
- E C :
-
Leitungsbandpegel
- E F :
-
Fermi-Energieniveau
- E g :
-
Energiebandlücke
- E V :
-
Valenzbandebene
- I -V :
-
Strom-Spannung
- LPE:
-
Seitlicher photovoltaischer Effekt
- LPV:
-
Seitliche Photospannung
- LPVmax :
-
Maximale seitliche Photospannung
- MoS2 :
-
Molybdändisulfid
- PSD:
-
Positionsempfindlicher Detektor
- USV:
-
UV-Photoelektronenspektroskopie
- W :
-
Arbeitsfunktion
Nanomaterialien
- Photovoltaische Eigenschaften von GaSe/MoSe2-Heterojunction-Bauelementen
- MoS2 mit kontrollierter Dicke für die elektrokatalytische Wasserstoffentwicklung
- Temperaturabhängige Kristallisation von MoS2-Nanoflocken auf Graphen-Nanoblättern für die Elektrokatalyse
- MoS2/Acetylene Black Composite mit wenigen Schichten als effizientes Anodenmaterial für Lithium-Ionen-Batterien
- Vorspannungsabhängige Photoempfindlichkeit von mehrschichtigen MoS2-Phototransistoren
- Sehr verbesserte H2-Erfassungsleistung von MoS2/SiO2/Si-Heterojunctions mit wenigen Schichten durch Oberflächendekoration von Pd-Nanopartikeln
- Auswirkung verschiedener CH3NH3PbI3-Morphologien auf die photovoltaischen Eigenschaften von Perowskit-Solarzellen
- Optimierung von GaAs-Nanodraht-Pin-Junction-Array-Solarzellen durch Verwendung von AlGaAs/GaAs-Heterojunctions
- Verbesserte photovoltaische Eigenschaften in einer Sb2S3-Planar-Heterojunction-Solarzelle mit einem schnellen Selenylierungsansatz
- Trägertransporteigenschaften des asymmetrischen MoS2-Gassensors unter Ladungstransfer-basierter Barrieremodulation



