Untersuchung des Energiebandes an einer Atomschicht mit abgeschiedenen AZO/β-Ga2O3 (\( \overline{2}01 \)) Heteroübergängen
Zusammenfassung
Die Al-dotierten Effekte auf die Bandversätze von ZnO/β-Ga2 O3 Grenzflächen werden durch Röntgenphotoelektronenspektroskopie charakterisiert und durch First-Principle-Simulationen berechnet. Die Leitungsband-Offsets variieren von 1,39 bis 1,67 eV, die Valenzband-Offsets verringern sich von 0,06 auf – 0,42 eV, was eine fast lineare Abhängigkeit in Bezug auf das Al-Dotierungsverhältnis zeigt, das von 0 bis 10 % variiert. Folglich bildet sich eine Typ-I-Bandausrichtung an der Grenzfläche von ZnO/β-Ga2 O3 Heteroübergang und das AZO/β-Ga2 O3 Schnittstelle hat eine Typ-II-Bandausrichtung. Dies liegt daran, dass der Einbau von Al in das ZnO die Bandlücken aufgrund der starken Al- und O-Elektronenmischung öffnen würde und sich die Leitungs- und Valenzbandkanten folglich zu einem niedrigeren Niveau verschieben.
Hintergrund
Vor kurzem wurde ein Oxidhalbleiter Ga2 O3 hat aufgrund seiner einzigartigen Eigenschaften wie der großen Bandlücke, der hohen Sättigungselektronengeschwindigkeit und der hohen Temperaturbeständigkeit breites Interesse auf sich gezogen [1]. Es gibt fünf Arten von Isomeren für Ga2 O3 :α, β, γ, δ und ε, wobei β-Ga2 O3 kann einfacher angebaut werden und wurde umfassend untersucht [2]. Insbesondere β-Ga2 O3 hat ein größeres elektrisches Durchschlagsfeld als das herkömmlicher Halbleitermaterialien der dritten Generation, wie SiC und GaN [3]. Die n-leitenden Eigenschaften können durch Dotieren von Sn [4] oder Si [5] moduliert werden. Also β-Ga2 O3 -basierte Geräte [6, 7] haben breite Anwendungsperspektiven in den Bereichen Informationstechnologie, Energieeinsparung und Emissionsreduzierung. β-Ga2 O3 -basierte Geräte haben eine gemeinsame Einschränkung:den Kontakt zwischen β-Ga2 O3 und die meisten Metalle neigen wegen der großen Barriere, die durch die große Bandlücke und die endliche Ladungsträgerkonzentration induziert wird, dazu, Schottky zu sein. In den letzten Jahren wurde das Einfügen einer Zwischenschicht wie ITO [8] und AZO [9] zwischen Ga2 O3 und Metallen hat sich als eine gültige Methode erwiesen, um die Energiebarriere zwischen β-Ga2 . zu reduzieren O3 und Metall.
Al-dotiertes Zinkoxid (ZnO) hat aufgrund des geringen spezifischen Widerstands und der geringeren Herstellungskosten als ITO viel Aufmerksamkeit erlangt [10]. Insbesondere die hohe thermische Stabilität, hohe Mobilität und Ladungsträgerkonzentration machen es zu einem vielversprechenden Kandidaten für die Zwischenhalbleiterschicht (ISL) [11]. Bisher können Al-dotierte ZnO-Filme durch die folgenden Techniken gezüchtet werden:Molekularstrahlepitaxie (MBE) [12], Magnetronsputtern [13], chemische Gasphasenabscheidung (CVD) [14] und Atomlagenabscheidung (ALD) [ fünfzehn]. Insbesondere ist ALD eine bekannte Methode zur Herstellung von Filmen mit Nanodicke, die aufgrund der selbstbegrenzenden Oberflächenreaktion einschließlich der selbstbegrenzenden chemischen Adsorption und der selbstbegrenzenden sequentiellen Reaktion eine großflächige ausgezeichnete Gleichmäßigkeit und eine einheitliche Wachstumsrate pro Zyklus aufweisen [16]. Darüber hinaus kann ALD die Grenzflächenstörung reduzieren und die Al-Dotierungskonzentration genauer modulieren, indem die Verhältnisse der Wachstumszyklen geändert werden.
Beachten Sie, dass der Leitungsbandversatz (CBO) die Energiebarriere für den Elektronentransport bestimmt, sodass ein kleinerer CBO vorteilhaft ist, um einen ohmschen Kontakt zu bilden. Basierend auf unseren früheren Arbeiten [17] ändert sich durch Erhöhung der Al-Dotierungskonzentration der Al-dotierte ZnO-Film von polykristalliner zu amorpher Natur, und auch seine Bandlücke wird größer. Die Bandversätze von verschiedenen Al-dotierten ZnO/β-Ga2 O3 Heterojunctions wurden nicht umfassend untersucht. In dieser Arbeit wurden die ZnO-Filme mit unterschiedlichen Al-Dotierungsverhältnissen jeweils auf β-Ga2 . abgeschieden O3 Substrate von ALD. Die Ergebnisse zeigen, dass VBO und CBO fast linear vom Al-Dotierungsverhältnis abhängig sind.
Methoden
Die Substrate sind Bulk-β-Ga2 O3 (\( \overline{2}01 \)) und die Dotierungskonzentration beträgt etwa 3 × 10 18 /cm 3 . Der Reinigungsprozess für Ga2 O3 Die Substrate wurden dreimal in Aceton und Isopropanol alle 10 Minuten mit Ultraschall gewaschen. Anschließend wird das Ga2 O3 Substrate wurden mit entionisiertem Wasser gespült. Danach wurden die Al-dotierten ZnO-Filme auf dem Ga2 . aufgewachsen O3 Substrat von ALD (Wuxi MNT Micro Nanotech Co., LTD, China). Es wurden drei Arten von Proben hergestellt. Zuerst wurden die undotierten ZnO-Filme durch ALD mit den Vorläufern von Zn (C2 H5 )2 (DEZ) und H2 O um 200 o C. Zweitens wurden die Al-dotierten ZnO-Filme durch Zugabe eines Impulses von Trimethylaluminium (TMA) und H2 O jeden 19. Zyklus von DEZ und H2 O-Pulsen (als 5 % Al-Dotierung bezeichnet) bei einer Substrattemperatur von 200 o C während ALD. Drittens wurden auch die Al-dotierten ZnO-Filme mit einem Verhältnis von 9:1 (bezeichnet als 10% Al-Dotierung) hergestellt. Die Wachstumsrate von ZnO und Al2 O3 betrug 0,16 bzw. 0,1 nm/Zyklus. Jede Filmart umfasste zwei unterschiedliche Dicken, d. h. 40 nm und 10 nm für den dicken bzw. dünnen Film. Darüber hinaus ist das β-Ga2 O3 Substrat wurde verwendet, um das Schüttgut zu untersuchen. Ga 2p , Zn 2p CLs und das Valenzbandmaximum (VBM) wurden durch Röntgenspektroskopie (XPS) (AXIS Ultra DLD, Shimadzu) gemessen und der Auflösungsschritt der XPS-Spektren beträgt 0,05 eV. Um die Oberflächenkontamination der Probe während des Transferprozesses von der ALD in die XPS-Kammer zu vermeiden, wurde vor der XPS-Messung eine Ar-Ionenätzung durchgeführt. Beachten Sie, dass der Ladungseffekt das XPS-Spektrum und den BE von C 1s . verschieben kann Peak wird auf 284,8 eV kalibriert, um das Problem zu lösen.
Ergebnisse und Diskussionen
Der Valenzband-Offset (VBO) von Al-dotiertem ZnO/β-Ga2 O3 Heteroübergang kann durch die Formel wie folgt erhalten werden [18]:
$$ \Updelta {E}_V=\left({E}_{\mathrm{Ga}\ 2p}^{{\mathrm{Ga}}_2{\mathrm{O}}_3}-{E}_{ \mathrm{VBM}}^{{\mathrm{Ga}}_2{\mathrm{O}}_3}\right)-\left({E}_{\mathrm{Zn}\ 2p}^{\mathrm{ AZO}}-{E}_{\textrm{VBM}}^{\textrm{AZO}}\right)-\left({E}_{\textrm{Ga}\ 2p}^{{\textrm{Ga .) }}_2{\textrm{O}}_3}-{E}_{\textrm{Zn}\ 2p}^{\textrm{AZO}}\right) $$ (1)wobei\({E}_{\textrm{Ga}\ 2p}^{{\textrm{Ga}}_2{\textrm{O}}_3}\) sich auf die Bindungsenergie (BE) von Ga 2p Kernebene (CL) in Bulk-β-Ga2 O3 , \( {E}_{\mathrm{VBM}}^{{\mathrm{Ga}}_2{\mathrm{O}}_3} \) bezieht sich auf den BE von VBM im Volumen β-Ga2 O3 , \( {E}_{\textrm{Zn}\ 2p}^{\textrm{AZO}} \) bezieht sich auf die BE von Zn 2p CL in dicken Al-dotierten ZnO-Filmen, \({E}_{\mathrm{VBM}}^{\mathrm{AZO}}\) bezieht sich auf den BE von VBM in dicken Al-dotierten ZnO-Filmen. Letztere \({E}_{\textrm{Ga}\ 2p}^{{\textrm{Ga}}_2{\textrm{O}}_3}\) und \({E}_{\textrm{Zn }\ 2p}^{\mathrm{AZO}} \) beziehen sich auf die BE von Ga 2p und Zn 2p CLs in dünnen Al-dotierten ZnO-Filmen.
Anschließend basierend auf dem E g und ∆E V , das CBO am Al-dotierten ZnO/β-Ga2 O3 Schnittstelle kann durch die folgende Gleichung berechnet werden:
$$ \Updelta {E}_C={E}_g^{{\mathrm{Ga}}_2{\mathrm{O}}_3}-{E}_g^{\mathrm{AZO}}-\Updelta {E }_V $$ (2)wobei\( {E}_g^{{\mathrm{Ga}}_2{\mathrm{O}}_3} \) die Bandlücke von Ga2 . ist O3 und \({E}_g^{\mathrm{AZO}}\) ist die Bandlücke von Al-dotiertem ZnO. Die Bandlücken für undotiertes, 5% Al-dotiertes ZnO, 10% Al-dotiertes ZnO und β-Ga2 O3 sind 3,20 eV, 3,25 eV, 3,40 eV bzw. 4,65 eV [17, 19]. Die Bandlücke nimmt mit einem höheren Al-Dotierungsverhältnis zu und stimmt gut mit der Simulation im nächsten Teil überein.
Abbildung 1 zeigt die Ga- und Zn-Elemente CLs und VBM von β-Ga2 O3 , dicke undotierte und 5 % und 10 % Al-dotierte ZnO-Filme. Die Anpassung des linearen Bereichs und der flachen Bandzone aus dem VBM-Spektrum kann auf das VBM schließen [20]. Abbildung 2 zeigt Ga 2p und Zn 2p CL aus verschiedenen dünnen Al-dotierten ZnO/β-Ga2 O3 Heterojunctions. Die BE-Unterschiede von Ga 2p und Zn 2p CLs für das undotierte, 5% Al-dotierte ZnO/β-Ga2 O3 , und 10 % Al-dotiertes ZnO/β-Ga2 O3 ergeben sich zu 96,12 eV, 96,16 eV bzw. 95,94 eV. Dann werden die VBOs an den Grenzflächen zu 1,39 eV, 1,52 eV und 1,67 eV für das undotierte, 5 % Al-dotierte ZnO/β-Ga2 . bestimmt O3 , und 10 % Al-dotiertes ZnO/β-Ga2 O3 Proben.
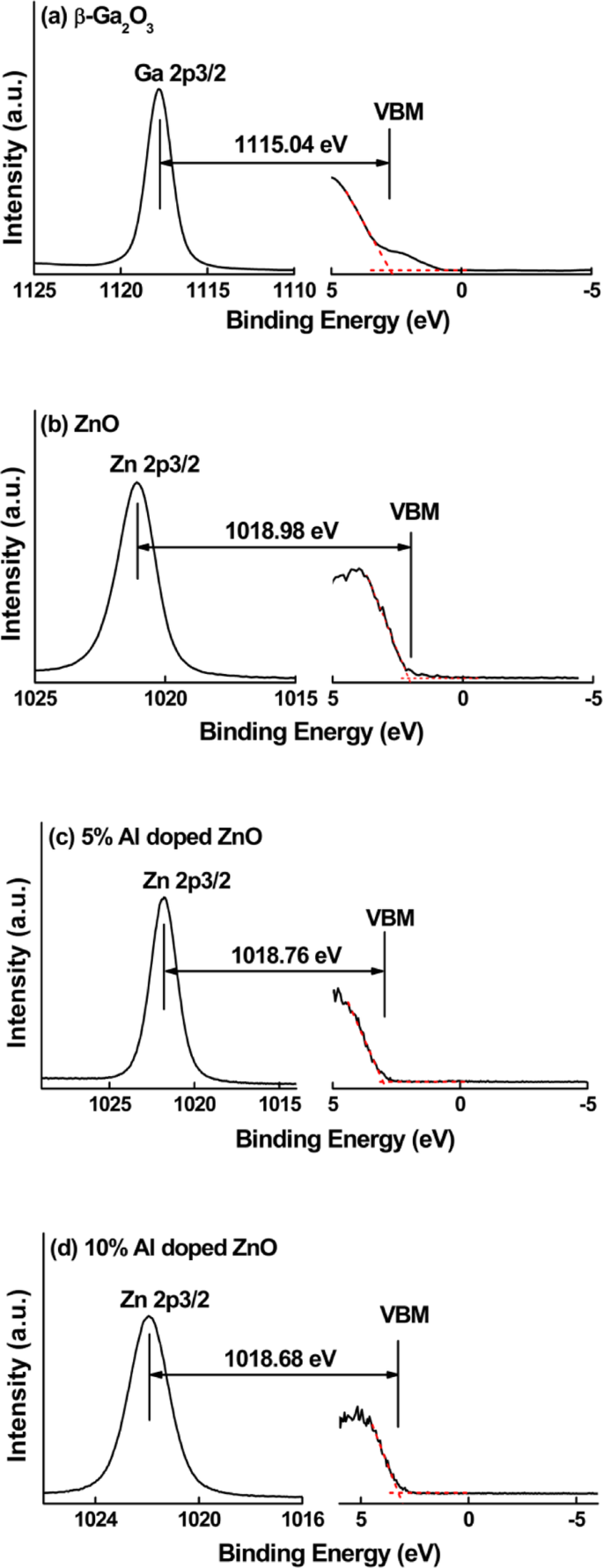
Hochauflösende XPS-Spektren für Kernebene und Valenzbandmaximum (VBM) von a Ga 2p Core-Level-Spektrum und VBM von bloßem β-Ga2 O3 , b Zn 2p Kernniveauspektrum und VBM aus dickem reinem ZnO/β-Ga2 O3 , c Zn 2p Kernniveauspektrum und VBM aus dickem 5% Al-dotiertem ZnO/β-Ga2 O3 , und d Zn 2p Kernniveauspektrum und VBM aus dickem 10 % Al-dotiertem ZnO/β-Ga2 O3

Die Kernspektren von Ga 2p und Zn 2p erhalten aus hochauflösenden XPS-Spektren von a dünnes ZnO/β-Ga2 O3 , b dünnes 5% Al-dotiertes ZnO/β-Ga2 O3 , und c dünnes 10 % Al-dotiertes ZnO/β-Ga2 O3
Die systematische Bandausrichtung für das 0 %, 5 % und 10 % Al-dotierte ZnO/β-Ga2 O3 Heteroübergänge werden durch die obigen Gleichungen berechnet, wie in Abb. 3 gezeigt. Der Bandversatz von undotiertem ZnO/β-Ga2 O3 Heteroübergang gehört zum Typ I. Während sowohl 5% als auch 10% Al-dotiertes ZnO/β-Ga2 O3 Heterojunctions haben Typ-II-Band-Offsets. Abbildung 4 zeigt die Bandausrichtungen von Al-dotiertem ZnO/β-Ga2 O3 Grenzflächen haben eine ähnliche lineare Beziehung zur Al-Dotierungskonzentration. Das CBO variiert von 1,39 bis 1,67 eV, wobei die Al-dotierte Konzentration von 0 bis 10 % ansteigt. Während sich die VBO von 0,06 auf – 0,42 eV verringert, wobei die Al-dotierte Konzentration von 0 auf 10 % steigt. Es wird darauf hingewiesen, dass CBO und VBO für gesputtertes AZO/β-Ga2 O3 sind 0,79 eV bzw. 0,61 eV [9]. Sowohl das Leitungs- als auch das Valenzband verschieben sich in dieser Arbeit nach unten, was auf das unterschiedliche Zusammensetzungsverhältnis und die kristalline Struktur zurückzuführen sein könnte, die durch abgeschiedene Methoden eingeführt wurden.

Schematische Darstellung der Bandausrichtung von a reines ZnO/β-Ga2 O3 , b 5% Al-dotiertes ZnO/β-Ga2 O3 , und c 10 % Al-dotiertes ZnO/β-Ga2 O3

Die Leitungs- und Valenzband-Offsets von atomschichtabgeschiedenem AZO/β-Ga2 O3 Heteroübergänge, die mit unterschiedlichen Al-Dotierungsverhältnissen hergestellt wurden
Darüber hinaus wurden First-Principle-Simulationen mit dem Vienna Ab-initio Simulation Package (VASP) [21,22,23,24] durchgeführt, um die elektronische Bandstruktur und die Bandausrichtung von Al-dotiertem ZnO/Ga2 . zu untersuchen O3 Heterojunctions. Bei der Berechnung wurden die Elektron-Ion-Wechselwirkungen durch die ultraweichen Pseudopotentiale behandelt und die Wellenfunktionen und Potentiale um die Ebene-Wellen-Basis erweitert [25]. Außerdem wurde die von Perdew, Burke und Ernzerhof (PBE) vorgeschlagene generalisierte Gradientenapproximation (GGA) implementiert, um die Austauschkorrelationsenergien zu beschreiben [26]. Vor Beginn der Simulation wurden Konvergenztests durchgeführt. Es zeigte sich, dass die Grenzenergie von 450 eV für die ebene Wellenbasis und k-Raum-Gitter von 3 × 3 × 3 mit dem Monkhorst-Pack-Schema die gut konvergenten Ergebnisse lieferte. Bei der Strukturoptimierung wurde eine konjugierte Gradientenmethode verwendet und die Restkraft bis auf weniger als 0,01 eV/Å abgebaut. Darüber hinaus wurden die hybriden Dichtefunktionen basierend auf der semilokalen PBE-Approximation implementiert. Um die unterschätzte Bandlücke zu korrigieren, wurden 35 % des PBE-Austauschs durch den exakten ersetzt [27]. Um die Bandkantenverschiebung mit der Änderung des Al-Dotierungsniveaus zu identifizieren, wurde das durchschnittliche elektrostatische Potential (AEP) berechnet und auf das auf 0 V skalierte Vakuumniveau ausgerichtet. Die VBM und das Leitungsbandminimum (CBM) wurden folglich auf . ausgerichtet die AEP basierend auf dem Banddiagramm [28]. In dieser Arbeit wurde Bulk-ZnO mit 16 O-Atomen und 16 Zn-Atomen in der Superzelle verwendet. Um die Al-Dotierung einzuführen, wurden ein oder zwei Zn-Atome in der Superzelle durch die Al-Atome ersetzt, wodurch die Al-dotierte Struktur mit einer Dotierungskonzentration von 3,21% bzw. 6,25 % erzeugt wurde.
Abbildung 5 a–c zeigt die berechneten Banddiagramme der undotierten, 3.21% Al-dotierten ZnO- bzw. 6.25% Al-dotierten ZnO-Strukturen. Es zeigt deutlich, dass ZnO ein Halbleiter mit direkter Bandlücke mit einer Bandlücke von 3,42 eV ist und sich sowohl die CBM als auch die VBM am Γ-Punkt der Brillouin-Zone befanden. Diese theoretischen Simulationsergebnisse stimmen recht gut mit dem experimentellen Wert überein [29]. Bei der Al-Dotierung konnte festgestellt werden, dass sich die Fermi-Niveaus nach oben ins Leitungsband verschoben, was das reine ZnO in einen n-Halbleiter umwandelt. In der Zwischenzeit stiegen die Bandlücken auch auf 4,83 eV und 5,42 eV für 3,21% Al-dotiertes ZnO bzw. 6,25% Al-dotiertes ZnO. Obwohl die Bandlücken hier für das dotierte ZnO höher sind als unsere experimentellen Ergebnisse; dies könnte jedoch auf die Vernachlässigung von Grenzflächendefektzuständen sowie anderen Kristalldefekten zurückgeführt werden.
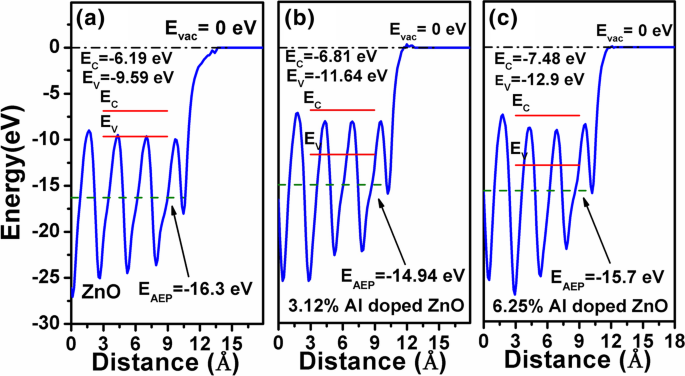
Das berechnete Banddiagramm von a undotiertes ZnO, b 3,21% Al-dotiertes ZnO und c 6,25% Al-dotierte ZnO-Struktur. Die Fermi-Werte wurden auf 0 eV gesetzt
Abbildung 6 a–c zeigt die Bandausrichtungen von undotiertem, 3,21% Al-dotiertem ZnO und 6,25% Al-dotiertem ZnO auf Vakuumniveau. Für die Leitungsbänder der Materialien konnte aufgrund der starken Elektronenmischung zwischen dem Al- und O-Element festgestellt werden, dass das Energieniveau von − 6,19 eV des ZnO auf − 6,81 eV für das 3,21% Al-dotierte ZnO ( ΔE = 0,62 eV ) und sinkt weiter auf − 7,48 eV für das 6,25% Al-dotierte ZnO (ΔE = 1,29 eV ). In der Zwischenzeit konnte aufgrund der Öffnung der Bandlücke auch festgestellt werden, dass sich die Valenzbandkante von − 9,59 eV für das ZnO nach unten bewegt auf − 11,64 eV für 3,21% Al-dotiertes ZnO (ΔE = 2,05 eV ) und − 12,9 eV für das 6,25% Al-dotierte ZnO (ΔE = 3,31 eV ). Alles in allem könnte man aufgrund der starken Al- und O-Elektronenmischung verstehen, dass der Einbau von Al in das ZnO die Bandlücken öffnen würde. Darüber hinaus würde es sowohl das Leitungsband als auch die Valenzbandkante in Richtung des niedrigeren Energieniveaus verschieben, wenn es auf das Vakuumniveau ausgerichtet wird.
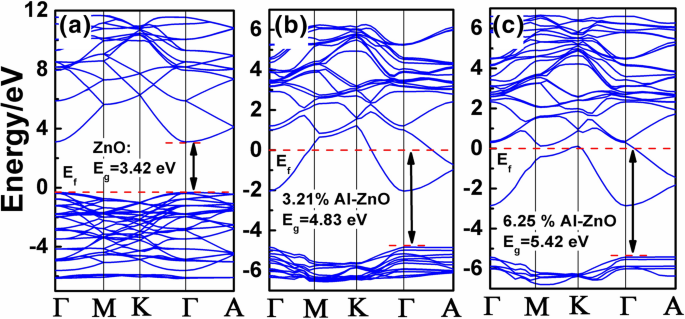
Die Bandausrichtung von AZO/β-Ga2 O3 Heterojunctions mit a undotiert, b 3,21% und c 6,25% Al-dotiertes ZnO. Die Vakuumwerte wurden auf 0 eV skaliert
Schlussfolgerungen
Zusammenfassend lässt sich sagen, dass die Bandausrichtungen verschiedener Al-dotierter ZnO/β-Ga2 O3 (\( \overline{2} \)01) Schnittstellen wurden von XPS untersucht. An der Grenzfläche von ZnO/β-Ga2 . bildet sich eine Typ-I-Bandausrichtung O3 Heteroübergang. Während AZO/β-Ga2 O3 Schnittstelle hat eine Typ-II-Bandausrichtung. Die CBOs variieren von 1,39 bis 1,67 eV und die VBOs verringern sich von 0,06 auf – 0,42 eV, wobei die Al-dotierte Konzentration von 0 auf 10 % ansteigt. Darüber hinaus zeigen die Berechnungen der Dichtefunktion, dass sich Bandverschiebungen aufgrund einer starken Al- und O-Elektronenmischung ändern, wenn Al in ZnO eingebaut wird. Diese Ergebnisse legen nahe, dass reines ZnO eine gültige ISL ist, um die Barrierehöhe zu reduzieren und den Elektronentransport zu fördern.
Verfügbarkeit von Daten und Materialien
Die Datensätze, die die Schlussfolgerungen dieses Manuskripts unterstützen, sind im Manuskript enthalten.
Abkürzungen
- AEP:
-
Durchschnittliches elektrostatisches Potenzial
- ALD:
-
Atomlagenabscheidung
- BE:
-
Bindungsenergie
- CBM:
-
Leitungsband-Minimum
- CBO:
-
Leitungsband-Offset
- CL:
-
Kernstufe
- CLs:
-
Kernstufen
- Lebenslauf:
-
Chemische Gasphasenabscheidung
- DEZ:
-
Zn (C2 H5 )2
- Ga2 O3 :
-
Galliumoxid
- GaN:
-
Galliumnitrid
- GGA:
-
Verallgemeinerte Gradienten-Approximation
- ISL:
-
Halbleiterzwischenschicht
- PBE:
-
Perdew, Burke und Ernzerhof
- SiC:
-
Siliziumkarbid
- TMA:
-
Trimethylaluminium
- VASP:
-
Wien Ab-initio-Simulationspaket
- VBM:
-
Valenzband-Maximum
- VBO:
-
Valenzband-Offset
- XPS:
-
Röntgenspektroskopie
- ZnO:
-
Zinkoxid
Nanomaterialien
- Bandtheorie von Festkörpern
- Advanced Atomic Layer Deposition Technologies für Mikro-LEDs und VCSELs
- Grenzflächen-, elektrische und Bandausrichtungseigenschaften von HfO2/Ge-Stapeln mit in situ gebildeter SiO2-Zwischenschicht durch plasmaunterstützte Atomlagenabscheidung
- Photokatalytische Eigenschaften von Co3O4-beschichteten TiO2-Pulvern, hergestellt durch plasmaunterstützte Atomlagenabscheidung
- Fermi-Level-Tuning von ZnO-Filmen durch Supercycling-Atomschichtabscheidung
- Untersuchung einer kristallinen Silizium-Solarzelle mit schwarzer Siliziumschicht auf der Rückseite
- Dickenabhängigkeit von Grenzflächen- und elektrischen Eigenschaften in Atomlagen-abgeschiedenem AlN auf c-Ebenen-GaN
- Untersuchung des Energiebandes an Atomlagen-abgeschiedenen ZnO/β-Ga2O3 (\( \overline{2}01 \)) Heteroübergängen
- Untersuchung des Energiebandes an den Molybdändisulfid- und ZrO2-Heterojunctions
- Plasmaunterstützte Niedertemperatur-Atomschichtabscheidung von SiO2 mit Kohlendioxid



