Plasmaunterstützte Niedertemperatur-Atomschichtabscheidung von SiO2 mit Kohlendioxid
Zusammenfassung
In dieser Arbeit berichten wir über das erfolgreiche Wachstum von hochwertigem SiO2 Filme durch plasmaunterstützte Atomlagenabscheidung bei niedriger Temperatur unter Verwendung eines Oxidationsmittels, das mit feuchtigkeits-/sauerstoffempfindlichen Materialien kompatibel ist. Das SiO2 Filme wurden bei 90°C unter Verwendung von CO2 . gezüchtet und Bis(tertiär-butylamino)silan als Verfahrensvorläufer. Wachstum, chemische Zusammensetzung, Dichte, optische Eigenschaften und Eigenspannung von SiO2 Filme untersucht wurden. SiO2 Filme mit einem gesättigten Wachstum pro Zyklus von ~ 1,15 Å/Zyklus zeigten eine Dichte von ~ 2,1 g/cm 3 , einen Brechungsindex von ~ 1,46 bei einer Wellenlänge von 632 nm und eine niedrige Zugeigenspannung von ~ 30 MPa. Darüber hinaus wiesen die Filme mit Massenkonzentrationen von ~ 2.4 und ~ 0.17 at geringe Verunreinigungsgehalte auf. % für Wasserstoff bzw. Stickstoff, während der Kohlenstoffgehalt unterhalb der Messgrenze der elastischen Rückstoßerkennungsanalyse während der Flugzeit lag. Diese Ergebnisse zeigen, dass CO2 ist ein vielversprechender oxidierender Vorläufer für feuchtigkeits-/sauerstoffempfindliche Materialien im Zusammenhang mit plasmaunterstützten Atomlagenabscheidungsprozessen.
Hintergrund
SiO2 ist ein weit verbreitetes Material für Anwendungen wie Mikroelektronik [1, 2], mikroelektromechanische Systeme [3, 4], Photovoltaik [5, 6] und Optik [7, 8]. Während SiO2 Dünnschichten können durch verschiedene Methoden wie thermische Oxidation, plasmaunterstützte chemische Gasphasenabscheidung (PECVD) oder physikalische Gasphasenabscheidung (PVD) gezüchtet werden , und Konformität [9,10,11].
Viele ALD-Prozesse mit verschiedenen Si-Vorstufen (Chlorsilane oder Aminosilane) und Oxidationsmitteln (H2 O, H2 O2 , oder O3 ), wurden für das Wachstum von SiO2 . entwickelt . Diese Prozesse erfordern normalerweise relativ hohe Temperaturen (> 150°C) [12,13,14,15,16]. Für Prozesse, die mit thermisch empfindlichen Materialien wie organischen, biologischen und polymeren Materialien kompatibel sind, wurden die katalysierte ALD [17,18,19] und die plasmaunterstützte Atomlagenabscheidung (PEALD) [9, 20, 21, 22] als eine effektive Lösung bei Prozesstemperaturen unter 100°C. Das häufig verwendete H2 O und O2 -basierte Oxidationsmittel können bei feuchtigkeits-/sauerstoffempfindlichen Materialien zu Materialabbau führen. Im Vergleich zu H2 O und O2 , bei niedriger Temperatur, CO2 ist chemisch nicht reaktiv. In diesem Fall mit CO2 als Oxidationsmittel kann den Abbau von feuchtigkeits-/sauerstoffempfindlichen Materialien minimieren, indem unnötige Oxidation vermieden wird. Darüber hinaus CO2 wurde von King [23] als brauchbares Oxidationsmittel für das Wachstum von PEALD SiO2 . beschrieben Filme bei Verwendung von SiH4 als Si-Vorstufe. Die Wachstumstemperaturen dieser PEALD-Prozesse, die im Bereich von 250–400 °C lagen, sind jedoch nicht mit hochtemperaturempfindlichen Materialien kompatibel.
In dieser Arbeit berichten wir über die Entwicklung eines CO2 -basierter PEALD-Prozess für SiO2 Filme bei 90°C. Die Abhängigkeit des Schichtwachstums von den Prozessparametern (Vorläuferpuls/Spülzeit und Plasmaleistung) wird untersucht. Wir berichten auch über die chemische Zusammensetzung, die strukturellen und optischen Eigenschaften sowie die Eigenspannungsanalyse der Filme.
Methoden
Filmvorbereitung
PEALD SiO2 Filme wurden auf Si(100)- und Saphir-Substraten bei 90°C unter Verwendung von CO2 . gezüchtet (99,5%, Air Products) Plasma als Sauerstoffquelle und Bis(tertiär-butylamino)silan (BTBAS) (97%, Strem Chemicals) als Si-Vorstufe [22]. Die Prozesse wurden in einem Beneq TFS 200-Reaktor mit einem Remote-Plasmasystem unter Verwendung einer kapazitiv gekoppelten 13,56 MHz-Hochfrequenz (RF)-betriebenen Quelle durchgeführt. Die N2 (99,999 %, AGA) wurde als Träger- und Spülgas mit einem Reaktordurchfluss von 600 sccm verwendet, während ein Mischgas aus N2 (200 sccm) und CO2 (75 sccm) durch das Plasmasystem geflossen. Die gewählten Plasmaleistungen in dieser Studie basierten auf der Stabilität des Plasmasystems. Die Quellentemperatur von BTBAS wurde auf 21 °C und ein N2 . eingestellt Booster wurde während des Vorläuferpulses angewendet. Die Details der Prozessparameter sind in Tabelle 1 aufgeführt. Während der PEALD-Prozesse betrug der Reaktordruck etwa 1 hPa.
Filmcharakterisierung
Die Dicke von PEALD SiO2 Filme wurde mit einem SENTECH SE400adv Ellipsometer unter Verwendung eines HeNe-Lasers bei einer Wellenlänge von 632,8 nm und einem Einfallswinkel von 70° bestimmt. Das Wachstum pro Zyklus (GPC) wurde unter Verwendung der erhaltenen Filmdicke dividiert durch die Anzahl der ALD-Zyklen berechnet. Die Abweichung des GPC basierte auf der Ungleichmäßigkeit der Filmdicke.
Die chemische Zusammensetzung wurde durch optische Glimmentladungs-Emissionsspektroskopie (GDOES), Flugzeitanalyse (TOF-ERDA) und Fourier-Transform-Infrarotspektroskopie mit abgeschwächter Totalreflexion (ATR-FTIR) gemessen. GDOES-Messungen wurden auf einem Horiba GD-Profiler 2 durchgeführt. Es wurden eine Anode mit 4 mm Durchmesser und eine HF-Leistung von 35 W im gepulsten Modus verwendet. Die Elementarintensitäten wurden als über die gesamte Filmdicke integrierte Werte angegeben, wie in Lit. beschrieben. [22]. Für TOF-ERDA-Messungen wurden Br-Ionen mit einer Energie von 40 MeV, die von einem 5MV-Tandembeschleuniger erhalten wurden, auf die gemessenen Proben gerichtet. Der Erfassungswinkel betrug 40°. ATR-FTIR-Messungen wurden unter Verwendung eines Thermo Electron Corporation Nicolet 380 ATR-FTIR-Spektrometers mit einem Diamantkristall als internes Reflexionselement durchgeführt. Das Verfahren umfasste eine Hintergrundsammlung aus dem Si-Substrat und eine Datensammlung aus den Proben. 2 cm −1 Auflösung über 800–4000 cm −1 Wellenzahlbereich wurde verwendet.
Röntgenreflexionsanalysen (XRR) wurden mit einem Philips X’Pert Pro Diffraktometer unter Verwendung von Cu-Kα1 . durchgeführt Strahlung. Die Filmdichte wurde aus den Messdaten mit einer selbst entwickelten Anpasssoftware ermittelt [24]. Eine Grenzflächenoxidschicht zwischen dem Siliziumsubstrat und dem PEALD SiO2 Film wurde als Teil des XRR-Anpassungsschichtmodells simuliert. Unter Verwendung eines PerkinElmer Lambda 900 Spektrometers, Transmissionsspektrum des PEALD SiO2 Der Film wurde im Wellenlängenbereich von 360–800 nm nach dem Wachstum auf einem Saphirsubstrat aufgezeichnet. Der Brechungsindex (n ) und Extinktionskoeffizient (k ) wurden mit Cauchy-Anpassung aus dem Transmissionsspektrum bestimmt. Um eine gute Passgenauigkeit zu gewährleisten, wird für diese Messung 150 nm dickes SiO2 . verwendet Filme wurden auf Saphirsubstraten gezüchtet.
Die Eigenspannung von 50 nm dickem PEALD SiO2 Filme wurde mit der Wafer-Curvation-Methode [25] und der Stoney-Gleichung [26] bestimmt. Die Waferkrümmung wurde vor und nach dem Filmwachstum mit einem TOHO FLX-2320-S-Gerät gemessen. Die Wafer wurden biaxial mit einer Scanlänge von 120 mm gescannt. Messergebnisse wurden mit maximaler Messunsicherheit dargestellt [25].
Ergebnisse und Diskussion
Filmwachstum
Die Abhängigkeit des SiO2 Film-GPC auf dem BTBAS-Puls und die Spülzeit wurden während des Oxidationsschritts mit einer festen Plasmaleistung von 180 W, einem CO2 Plasmaexpositionszeit von 3 s und einer CO2 Plasmaspülzeit von 2 s. Abbildung 1a und b zeigen GPC-Werte als Funktion des BTBAS-Pulses bzw. der Spülzeit. Für die Abhängigkeit von der Pulszeit wurde die BTBAS-Spülzeit auf 3 µs eingestellt, während für die Abhängigkeit von der Spülzeit die BTBAS-Pulszeit auf 0,3 µs eingestellt wurde. Wie in Abb. 1a gezeigt, wird die niedrigste GPC mit einem BTBAS-Puls von 0,05 s erhalten, während sich eine Pulszeit von 0,1 s als ausreichend herausstellt, um ein selbstlimitierendes Wachstum mit einem GPC von ~ 1,15 Å/Zyklus zu erreichen. Darüber hinaus wird bei Verwendung eines festen BTBAS-Pulses von 0,3 s und einer abnehmenden Spülzeit von 3 auf 0,5 s (Fig. 1b) keine Änderung der GPC beobachtet. Dies zeigt an, dass die angewandte kurze Spülzeit von BTBAS ausreichend ist, um CVD-Komponenten zu verhindern. Beachten Sie jedoch, dass die Gleichmäßigkeit der Filmdicke mit zunehmender Spülzeit verbessert wurde.

GPC von PEALD SiO2 auf Si-Substraten gewachsene Filme in Abhängigkeit von BTBAS a Pulszeit und b Spülzeit. Die angelegte Plasmaleistung betrug 180 W
Das SiO2 das Wachstum während des Oxidationsschrittes wurde mit einem festen BTBAS-Puls und einer Spülzeit von 0,3 bzw. 3 s untersucht. Abbildung 2a und b zeigen die GPC von PEALD SiO2 auf Si-Wafern gewachsene Filme als Funktion des CO2 Plasmaexposition bzw. Spülzeit. Während der Untersuchung der Auswirkungen der Plasmaexpositionszeit wurden Plasmaleistungen von 50, 180 und 300 W angewendet. Als allgemeine Beobachtung wird der höchste GPC-Wert von 1,15 Å/Zyklus, der als gesättigter GPC bei 90 °C angesehen werden kann [27], bei allen Plasmaleistungsbedingungen beobachtet. Für den Prozess mit einer Plasmabelichtungszeit von 1 µs deuten unabhängig von der eingesetzten Leistung GPC-Werte unter 1,15 µ/Zyklus auf ein unvollständiges Filmwachstum hin. Dies weist darauf hin, dass die Plasmaexpositionszeit von 1 s nicht lang genug ist, um eine ausreichende Menge an O-Radikalen zu erzeugen. Diese für eine vollständige Oberflächenreaktion notwendigen Radikale entstehen durch CO2 Plasmadissoziationsreaktionen [28]. Bei einer Plasmaleistung von 50 W nimmt der GPC mit steigendem CO2 . zu Plasmaexpositionszeit bis 6 s, danach erreicht die GPC den Sättigungswert von 1,15 /Zyklus. Dieser Wert bleibt bis zu einer Belichtungszeit von 15 s konstant. Bei Filmen, die mit höherer Leistung (180 und 300 W) gewachsen sind, wird jedoch ein inverser V-Trend des GPC für eine Plasmaexpositionszeit zwischen 1 und 6 s beobachtet. Gemäß unseren früher berichteten Wachstumsstadien von PEALD-Filmen [27] und der in dieser Arbeit erzielten höchsten GPC von 1,15 /Zyklus wird eine Wachstumssättigung bei 180 und 300 W mit einer Plasmaexpositionszeit von 3 s erreicht. Bei einer Plasmaexpositionszeit von 6 s ist die verringerte GPC wahrscheinlich eine Folge der Filmverdichtung, ähnlich der, die wir zuvor für PEALD von Al2 . berichtet haben O3 dünne Filme [27]. Beachten Sie, dass diese beiden Kurven (die die Abhängigkeit des GPC von CO2 Plasmaexpositionszeit für 180 und 300 W) vollständig überlappen. Die beobachtete Überlappung der GPC-Kurven deutet darauf hin, dass das Wachstum des SiO2 Filme mit 180 und 300 W beinhalten identische Mechanismen, die mit einer vergleichbaren Menge an Ionen- und Radikalflüssen in Verbindung gebracht werden könnten, die durch Hochleistungsplasma erzeugt werden [29]. Im Vergleich zu hohen Leistungen ist das Wachstumsverhalten von SiO2 Dünnfilme mit einer Plasmaleistung von 50 W unterscheiden sich, da keine Filmverdichtung auftritt. Dies ist höchstwahrscheinlich auf die relativ geringen Ionen- und Radikalflüsse zurückzuführen, die sich aus der geringen Leistung von 50 W ergeben [29].

GPC von PEALD SiO2 auf Si-Substraten gewachsene Filme in Abhängigkeit von CO2 Plasma a Belichtungszeit mit unterschiedlichen Plasmaleistungen von 50, 180 und 300 W und b Spülzeit mit einer Plasmaleistung von 180 W
Die Wirkung von CO2 Die Plasmaspülzeit auf dem GPC ist in Abb. 2b gezeigt. Wie im Fall der BTBAS-Spülzeitabhängigkeit bleiben die GPC-Werte konstant, wenn CO2 Die Spülzeit wird zwischen 0,5 und 3 s variiert. Daraus kann geschlossen werden, dass die angewendete Spülzeit beider Vorläufer einen vernachlässigbaren Einfluss auf die GPC unseres SiO2 . hat dünne Filme. Dies unterscheidet sich von einem früher berichteten PEALD-Prozess mit SAM.24, einem verwandten Aminosilane von BTBAS, und O2 Plasma [9], wo Spülschritte mit einer Spülzeit von weniger als 2 s einen signifikanten Einfluss auf das Filmwachstum haben. Hier könnte die Unabhängigkeit zwischen unserer angewandten Precursor-Spülzeit und der GPC der effektiven Entfernung von restlichen Precursoren und Nebenprodukten zugeschrieben werden, die teilweise vom Design der Reaktionskammer mit Cross-Flow profitieren könnten. Eine solche Konfiguration macht die Gasaustauschzeit zwischen Vorläuferpulsen relativ kurz. Trotzdem kann die Klebrigkeit von Vorstufen nicht ausgeschlossen werden. Basierend auf den in Abb. 2a gezeigten Ergebnissen, unter Verwendung der BTBAS-Impuls-/Spülzeit von 0,3 s/3 s und CO2 Plasmabelichtungs-/Spülzeit von 3 µs/2 µs, die höchste Abscheidungsgeschwindigkeit während des gesättigten Wachstums beträgt 50 µm/h. Dies impliziert, dass durch Anlegen einer hohen Plasmaleistung und Verwendung einer BTBAS-Puls-/Spülzeit von 0,1 µs/0,5 µs und CO2 Plasmabelichtungs-/Spülzeit von 3 s/0,5 s, eine Abscheidungsgeschwindigkeit von bis zu 100 nm/h ist erreichbar.
Filmeigenschaften
Die Dichte des SiO2 Filme wurden durch XRR untersucht und die Ergebnisse sind in Abb. 3 gezeigt. Die gemessenen Proben wurden auf Si-Substraten unter Verwendung verschiedener Plasma-Expositionszeiten mit einer Plasmaleistung von 180 W, einer BTBAS-Pulszeit von 0,3 s, einer BTBAS-Spülzeit von 3 . gezüchtet s und ein CO2 Plasmaspülzeit von 2 s. Die untersuchten Proben sind als „SiO1“, „SiO3“ und „SiO6“ für eine Plasmaexpositionszeit von 1, 3 bzw. 6 s gekennzeichnet. Obwohl die Werte innerhalb der Messfehlerspanne liegen, werden die niedrigsten und höchsten Mittelwerte in „SiO1“ bzw. „SiO6“ angezeigt, was darauf hindeutet, dass die Filmdichte mit zunehmender Plasmabelichtungszeit leicht erhöht wird. Dies unterstützt unsere Hypothese der Filmverdichtung während des Prozesses mit einer Plasmaleistung von 180 W und einer Belichtungszeit von 6 s. Bei gesättigtem Wachstum, obwohl unsere Filmdichte von 2,11 g/cm 3 stimmt gut mit Werten überein, die in früheren Studien für O2 . berichtet wurden -basierte PEALD SiO2 Filme mit kommerziellen ALD-Reaktoren mit Wachstumstemperaturen zwischen 50 und 300 °C [9, 21, 30], liegt er unter dem Wert (2,3 g/cm 3 .). ) berichtet von King, der das PEALD SiO2 . demonstrierte Prozess bei 400°C in einem modifizierten PECVD-Reaktor [23].

Dichte von SiO2 Filme, die mit einer Plasmabelichtungszeit von 1, 3 und 6 s gewachsen sind
Die chemische Zusammensetzung von PEALD SiO2 wurde von GDOES gemessen. Da die Messungen nicht für das Zusammensetzungstiefenprofil kalibriert wurden, d. h. die elementabhängige Emissionsrate nicht berücksichtigt wurde, können nur die Intensitäten desselben Elements zwischen verschiedenen Proben verglichen werden und kein Vergleich zwischen verschiedenen Elementen ist möglich. Daher liefern die GDOES-Messungen in diesem Fall eher qualitative Informationen über die chemische Zusammensetzung. Die detektierten Elemente, Si, O, H, N und C, sind in Abb. 4 dargestellt. Wie in der Abbildung dargestellt, ist die Intensität von H in „SiO1“ jedoch unter Berücksichtigung des Fehlers etwas geringer als in den anderen Proben Rändern werden keine signifikanten Auswirkungen der Plasmaexpositionszeit auf die Si-, O- und H-Gehalte beobachtet. Dieses Ergebnis ähnelt den Plasmaleistungseffekten, über die in unserer früheren Arbeit zu PEALD SiO2 . berichtet wurde angebaut mit BTBAS und O2 Plasma [22]. Beim N-Gehalt sind die Intensitäten für „SiO1“ und „SiO3“ eher konstant, während für „SiO6“ eine geringere Intensität gemessen wird. Dies legt nahe, dass die Entfernung von N-Verunreinigungen während der Filmverdichtung effektiver ist. Beachten Sie, dass unabhängig von den Wachstumsbedingungen der Probe alle gemessenen Proben die gleiche Intensität für den C-Gehalt aufweisen.

Qualitative chemische Zusammensetzung von SiO2 Filme, die mit einer Plasmaexpositionszeit von 1, 3 und 6 s, gemessen durch GDOES, gewachsen sind. Die Messung hat eine Genauigkeit von ± 15% und der elementübergreifende Vergleich der Intensitäten ist in dieser Arbeit nicht möglich (kein Kalibrierfaktor vorhanden)
Eine weitere Bewertung der chemischen Zusammensetzung des Films wurde unter Verwendung von TOF-ERDA- und ATR-FTIR-Messungen durchgeführt. Da bei ALD-Prozessen normalerweise gesättigtes Wachstum angestrebt wird, konzentrieren wir unsere Untersuchung im Folgenden auf Proben, die mit einer Plasmaleistung von 180 W, einer BTBAS-Pulszeit von 0,3 s, einer BTBAS-Spülzeit von 3 s, einer CO 2 Plasmaexpositionszeit von 3 s und einer CO2 Plasmaspülzeit von 2 s. Das TOF-ERDA-Tiefenprofil und die Elementzusammensetzung sind in Abb. 5a dargestellt. Beachten Sie, dass die im Filmtiefenprofil gezeigte Abwärtsneigung von O durch den Effekt des Si-Substrats verursacht wird, das mit der Tiefenauflösung von TOF-ERDA für unser SiO2 . korreliert /Si-Beispielstruktur. Bei den Elementzusammensetzungsanalysen wurde der Substrateffekt berücksichtigt. Die untersuchte Probe weist mit Schüttkonzentrationen von ~ 2,4 und ~ 0,17 at geringe Verunreinigungsgehalte auf. % für Wasserstoff bzw. Stickstoff, während die Gesamt-C-Konzentration im gesamten Film unterhalb der Messgrenze von TOF-ERDA liegt. Basierend auf den Informationen des Tiefenprofils werden die Kohlenstoffzahlen hauptsächlich von der Filmoberfläche gesammelt. Daher vermuten wir, dass der durch GDOES-Messungen nachgewiesene und in Abb. 4 gezeigte C-Gehalt auf die Probenkontamination während der Lagerung oder aus der Testumgebung zurückzuführen sein könnte. Es ist erwähnenswert, dass die H-Konzentration auch an der Oberfläche höher ist als in der Masse. Außerdem wurde festgestellt, dass die Filme eine leicht sauerstoffreiche Zusammensetzung mit einem Si/O-Verhältnis von ~~0,48 aufweisen. Dieses Ergebnis stimmt mit dem von Dingemans et al. für PEALD SiO2 angebaut mit SAM.24 und O2 Plasma in einem Temperaturbereich zwischen 100 und 300°C [9]. Diese sauerstoffreiche Zusammensetzung ist höchstwahrscheinlich auf den Beitrag restlicher –OH-Spezies in den Filmen zurückzuführen.
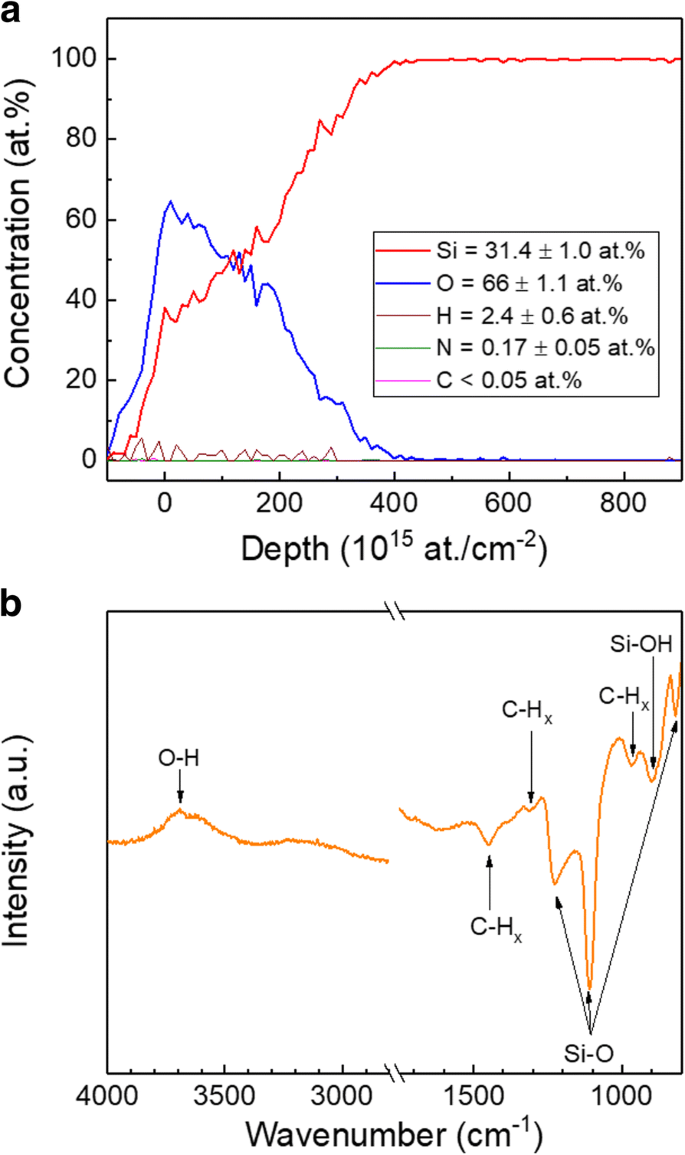
a TOF-ERDA-Tiefenprofil und b ATR-FTIR-Transmissionsspektrum des SiO2 Film. Die angestrebte Filmdicke betrug 50 nm
Abbildung 5b zeigt das ATR-FTIR-Spektrum, das an derselben Probe gemessen wurde. Die Breitbandfunktionen befinden sich im Bereich von 3200–3800 cm −1 Region, kann der O-H-Strecke von Si-OH und Wasser zugeordnet werden, erstere ist jedoch weniger wahrscheinlich [14, 31]. Eine weitere Bande, die ebenfalls typisch für die Si-OH-Streckung ist [31], ist bei ~ 900 cm −1 . sichtbar . Das Vorhandensein von –OH-Gruppen, das mit den oben gezeigten TOF-ERDA-Ergebnissen übereinstimmt, impliziert, dass verbrennungsähnliche Reaktionen, die die Verbrennung von –NH . beinhalten, t Bu Liganden und die Bildung von –OH-Gruppen dominieren den Oxidationsschritt. Ein ähnlicher Mechanismus wurde bereits während des Wachstums von Al2 . beschrieben O3 aus Trimethylaluminium und O2 Plasma [32] und SiO2 von SAM.24 und O2 Plasma [9]. Zusätzlich zu den –OH-Gruppen wird die Si-O-Si-Bindungsstreckung um 1108 und 1226 cm −1 . nachgewiesen [14, 33] während die Bindungsbiegung bei ungefähr 820 cm −1 . beobachtet wird [34, 35]. Beachten Sie, dass im Vergleich zu Literaturwerten [14, 34, 35] die Si-O-Si-Streckfrequenz in dieser Arbeit relativ hoch ist. Dies könnte durch die Änderung der Si-O-Bindungslänge verursacht werden, die durch die Filmeigenspannung beeinflusst werden kann. Jutarosagaet al. berichteten, dass die Si-O-Si-Streckfrequenz umso niedriger ist, je höher die Druckspannung ist [36]. Die Banden bei ~ 970, 1301 und 1450 cm −1 werden dem CH3 . zugeordnet Schaukeln, CH3 symmetrische Verformung und CH2 Schere bzw. [14]. Der Befund von C-H-Oberflächengruppen stimmt mit dem Ergebnis von TOF-ERDA überein und ist höchstwahrscheinlich auf die Oberflächenkontamination zurückzuführen.
Aus den Daten in Abb. 5 und basierend auf bereits in der Literatur veröffentlichten Ergebnissen [37] können unsere Prozessoberflächenreaktionen während des ersten ALD-Halbzyklus wie folgt betrachtet werden:
$$ \mathrm{Si}-{\mathrm{OH}}^{\ast}+{\mathrm{H}}_2\mathrm{Si}{\left[{NH}^t Bu\right]}_2\ zu \mathrm{Si}-\mathrm{O}-{\mathrm{SiH}}_2{{\left[{NH}^t Bu\right]}_{2-x}}^{\ast}+{ xH}_2{N}^t Bu $$ (1)wobei Oberflächenarten durch das Sternchen (*) gekennzeichnet sind. In der ersten Halbreaktion wird nur ein (x = 1) oder beides (x = 2) von -NH t Bu Liganden können mit der Oberfläche reagieren –OH-Gruppen bilden t -Butylaminmoleküle.
Die O-Radikale sind die wichtigsten aktiven Spezies, die während des CO2 . erzeugt werden Plasmadissoziationsreaktionen [28] und dominieren folglich die Oxidationsreaktionen. Daher sind im zweiten Halbzyklus die vorgeschlagenen verbrennungsähnlichen Reaktionen [9]:
$$ {\mathrm{SiH}}_2{{\left[{NH}^t Bu\right]}_{2-x}}^{\ast}+\mathrm{O}\to \mathrm{Si} -{\mathrm{OH}}^{\ast}+{\mathrm{H}}_2\mathrm{O}+{\mathrm{CO}}_2+\mathrm{N}-\mathrm{enthaltend}\ \mathrm {Spezies} $$ (2)Aufgrund der Unsicherheit der tatsächlichen Reaktionsprodukte wird die vorgeschlagene Oberflächenreaktion bewusst nicht bilanziert. Um diese Reaktion vollständig bestimmen zu können, wären In-situ-Analysen während des Filmwachstums, wie z. B. Nebenproduktgasanalysen, erforderlich.
Die optischen Eigenschaften von SiO2 Auf einem Saphirsubstrat gewachsener Film wurde spektrometrisch untersucht. Abbildung 6a zeigt die gemessene Transmission als Funktion der Wellenlänge zusammen mit der Cauchy-Anpassung der Kurve. Die aus dem Transmissionsspektrum simulierte Brechungsindexdispersion ist in Abb. 6b dargestellt. Aus der Anpassung, bei einer Wellenlänge von 632 nm, einem Brechungsindex von 1,456 und null k Wert erhalten wurden. Dieser Brechungsindexwert stimmt gut mit dem überein, was zuvor für PEALD SiO2 . bei niedriger Temperatur berichtet wurde [9, 21] und relativ niedrig im Vergleich zu Werten, die für Hochtemperaturprozesse berichtet wurden [23]. Tatsächlich ist bekannt, dass die Wachstumstemperatur die –OH-Konzentration in den gewachsenen Filmen und damit ihren Brechungsindex beeinflusst [38]. Außerdem ist die erhaltene Null k Wert stimmt mit dem niedrigen Kohlenstoffgehalt in den Filmen überein. Eine ähnliche Korrelation zwischen den k -Wert und die C-Konzentration wurde zuvor von Putkonen et al. für SiO2 durch ALD gewachsene dünne Filme [21].
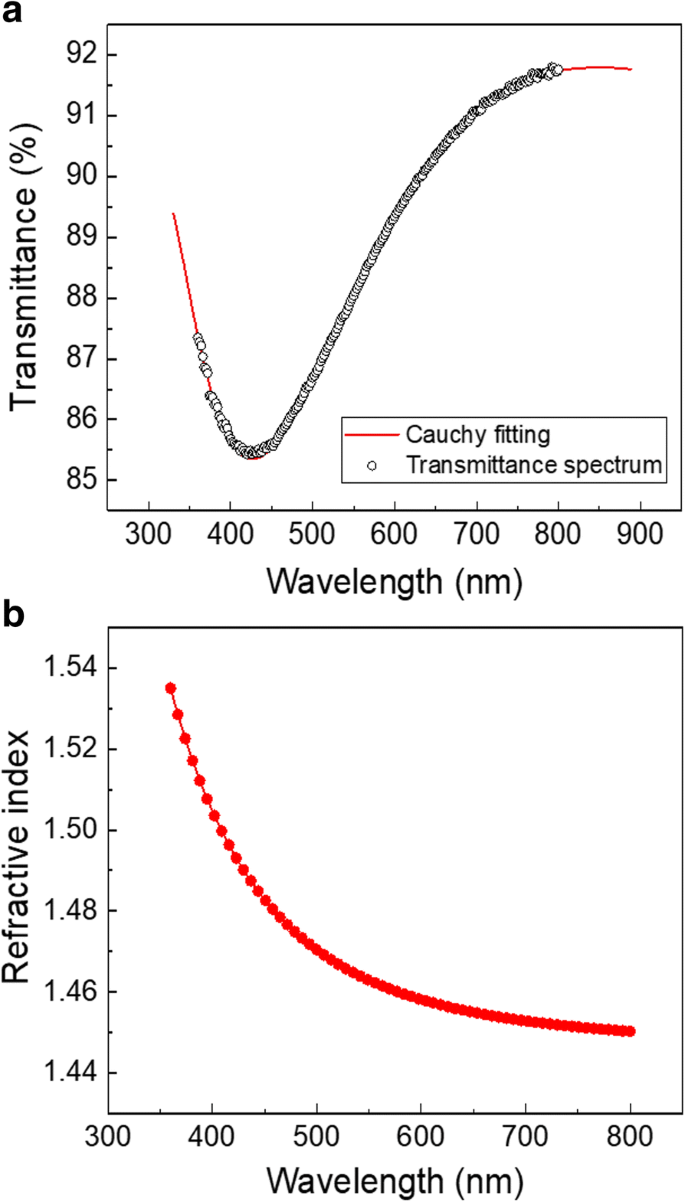
a Transmissionsspektrum und Cauchy-Anpassung und b Brechungsindexdispersionen des SiO2 auf einem Saphirsubstrat gewachsener Film mit einer Plasmaleistung von 180 W, einer BTBAS-Pulszeit von 0,3 s, einer BTBAS-Spülzeit von 3 s, einem CO2 Plasmaexpositionszeit von 3 s und einer CO2 Plasmaspülzeit von 2 s. Die angestrebte Filmdicke betrug 150 nm
Die Restspannung von ALD-Filmen umfasst die Beiträge von thermischer Spannung und intrinsischer Spannung. Die thermische Belastung resultiert aus dem Unterschied in der thermischen Ausdehnung zwischen dem Film und dem Substrat. Der intrinsische Stress ist definiert als der während des Filmwachstums erzeugte innere Stress, abhängig von den Vorläufern, der Wachstumstemperatur und der ALD-Methode [30, 39]. Abbildung 7 zeigt die Restspannung von SiO2 Filme als Funktion der Wachstumstemperatur. Der höchste Spannungswert, 150 MPa (Kompression) [23], wurde von der bei 400 °C gewachsenen Probe erhalten; in dieser Arbeit wird jedoch bei 90°C eine niedrige Zugspannung von 30 ± 10 MPa erhalten. Putkonenet al. und Shestaeva et al. zeigte eine deutliche Abhängigkeit von SiO2 Filmspannung auf Wachstumstemperatur [21, 30]:höhere Temperatur führt zu höherer Druckspannung. Der Beitrag der thermischen Spannung ist bei höheren Temperaturen größer. Sie berichteten auch über Restspannungswerte von nahezu „null“ für PEALD SiO2 . bei niedriger Temperatur Filme [21, 30]. Unter Berücksichtigung des hier und in der Literatur angegebenen Restspannungswertes ist die Spannung nahe „Null“ höchstwahrscheinlich eine Folge der Eigenspannung und nicht der thermischen Spannung. Die Eigenspannung von PEALD SiO2 Filme könnten dann durch den Plasmaeffekt verursacht werden. Andere Faktoren wie der Gasfluss, der Prozessdruck oder der verwendete Precursor können jedoch nicht ausgeschlossen werden [40].

Eigenspannung von SiO2 Filme als Funktion der Wachstumstemperatur. Unsere Probe wurde mit einer Plasmaleistung von 180 W, einer BTBAS-Pulszeit von 0,3 s, einer BTBAS-Spülzeit von 3 s, einem CO2 . gezüchtet Plasmaexpositionszeit von 3 s und einer CO2 Plasmaspülzeit von 2 s. Referenzen umfassen Putkonen et al. [21], Shestaeva et al. [30] und König [23]. Die angestrebte Filmdicke unserer Probe betrug 50 nm
Schlussfolgerungen
Diese Arbeit zeigt das Potenzial von CO2 als Oxidationsmittel für das Wachstum von Niedertemperatur-PEALD SiO2 auf feuchtigkeits-/sauerstoffempfindlichen Materialien. SiO2 Filme mit geringen Verunreinigungen und geringer Zugeigenspannung wurden bei 90 °C durch PEALD unter Verwendung von CO2 . gezüchtet und BTBAS als Vorläufer. Die Filme zeigten eine gesättigte GPC von ~ 1.15 Å/Zyklus zusammen mit einer Dichte von ~ 2.1 g/cm 3 . Diese Studie zeigt auch die Möglichkeit, mit einer sehr kurzen ALD-Zykluszeit von etwa 4 s ein gesättigtes Wachstum der Filme zu erreichen, was für hohe Durchsätze und damit industrielle Anwendungen sehr wünschenswert ist.
Abkürzungen
- ALD:
-
Atomlagenabscheidung
- ATR-FTIR:
-
Abgeschwächte Totalreflexion Fourier-Transformations-Infrarotspektroskopie
- BTBAS:
-
Bis(tertiär-butylamino)silan
- GDOES:
-
Optische Glimmentladungsspektroskopie
- GPC:
-
Wachstum pro Zyklus
- PEALD:
-
Plasmaunterstützte Atomlagenabscheidung
- PECVD:
-
Plasmaunterstützte chemische Gasphasenabscheidung
- PVD:
-
Physikalische Gasphasenabscheidung
- rf:
-
Funkfrequenz
- TOF-ERDA:
-
Analyse der elastischen Rückstoßerkennung während der Flugzeit
- XRR:
-
Röntgenreflexionsvermögen
Nanomaterialien
- Ozeankohlenstoff auf atomarer Skala
- Advanced Atomic Layer Deposition Technologies für Mikro-LEDs und VCSELs
- Enthüllung der atomaren und elektronischen Struktur von gestapelten Kohlenstoff-Nanofasern
- Bipolar-resistive Schalteigenschaften von HfO2/TiO2/HfO2-RRAM-Bauelementen mit dreischichtiger Struktur auf Pt- und TiN-beschichteten Substraten, die durch Atomlagenabscheidung hergestellt wurden
- Grenzflächen-, elektrische und Bandausrichtungseigenschaften von HfO2/Ge-Stapeln mit in situ gebildeter SiO2-Zwischenschicht durch plasmaunterstützte Atomlagenabscheidung
- Die antibakteriellen hierarchischen Polyamid-6-ZnO-Nanofasern, hergestellt durch Atomlagenabscheidung und hydrothermales Wachstum
- Photokatalytische Eigenschaften von Co3O4-beschichteten TiO2-Pulvern, hergestellt durch plasmaunterstützte Atomlagenabscheidung
- Zweistufige Abscheidung von Al-dotiertem ZnO auf p-GaN zur Bildung ohmscher Kontakte
- Festkörper-Kohlendioxidsensor
- Messung der Schichtdicke mit einem Mikroskop



