Spannungspolaritätsabhängiges Programmierverhalten von amorphen In-Ga-Zn-O-Dünnschichttransistorspeichern mit einer auf Atomlagen abgeschiedenen ZnO-Ladung Tra Ebene
Zusammenfassung
Amorphe In-Ga-Zn-O-(a-IGZO)-Dünnschichttransistor-(TFT)-Speicher ziehen viele Interessen für zukünftige System-on-Panel-Anwendungen auf sich; jedoch weisen sie gewöhnlich eine schlechte Löscheffizienz auf. In diesem Artikel untersuchen wir das spannungspolaritätsabhängige Programmierverhalten eines a-IGZO-TFT-Speichers mit einer auf Atomlagen abgeschiedenen ZnO-Ladungsfallenschicht (CTL). Die makellosen Bauelemente zeigen elektrisch programmierbare Eigenschaften nicht nur unter positiven Gate-Vorspannungen, sondern auch unter negativen Gate-Vorspannungen. Insbesondere letzteres kann eine viel höhere Programmiereffizienz erzeugen als ersteres. Beim Anlegen eines Gate-Bias-Impulses von +13 V/1 μs zeigt das Gerät eine Schwellenspannungsverschiebung (ΔVth ) von 2 V; und das ΔVte ist so groß wie –6,5 V für einen Gate-Vorspannungspuls von –13 V/1 μs. Im Fall von 12 V/1 ms Programmierung (P) und −12 V/10 μs Löschen (E) kann ein Speicherfenster von bis zu 7,2 V bei 10 3 . erreicht werden von P/E-Zyklen. Durch Vergleich der in O2 . getemperten ZnO-CTLs oder N2 mit dem abgeschiedenen wird geschlossen, dass die Sauerstoffleerstelle (VO )-bezogene Defekte dominieren die bipolaren Programmiereigenschaften der TFT-Speicherbauelemente. Zur Programmierung bei positiver Gatespannung werden Elektronen aus dem IGZO-Kanal in die ZnO-Schicht injiziert und vorzugsweise in tiefen Ebenen der einfach ionisierten Sauerstoffleerstelle (VO + ) und doppelt ionisierte Sauerstoffleerstelle (VO 2+ ). Was die Programmierung bei negativer Gatespannung betrifft, so werden Elektronen aufgrund der flachen Donatoren leicht aus neutralen Sauerstoffleerstellen abgefangen und tunneln zurück zum Kanal. Dies führt somit zu einer hocheffizienten Löschung durch die Bildung zusätzlicher ionisierter Sauerstoff-Leerstellen mit positiven Ladungen.
Hintergrund
Ein Dünnschichttransistor (TFT) basierend auf amorphem Indium-Gallium-Zink-Oxid (a-IGZO) wurde für die Anwendung in flexiblen und transparenten elektronischen Systemen ausführlich untersucht [1,2,3,4,5,6,7 ,8,9,10,11,12]. Dies wird auf einige spezifische Eigenschaften von a-IGZO-Filmen wie gute Gleichmäßigkeit, niedrige Verarbeitungstemperatur, Transparenz für sichtbares Licht und hohe Elektronenmobilität zurückgeführt [13]. Abgesehen davon wurden auch nichtflüchtige a-IGZO-TFT-Speicher vorgeschlagen, und ihre nichtflüchtige Datenspeicherfähigkeit erweitert den Anwendungsbereich der a-IGZO-TFT-Vorrichtung. Als typische Architektur nichtflüchtiger Speichervorrichtungen wurde in den letzten Jahren ein a-IGZO-TFT-Speicher mit Floating-Gate intensiv untersucht. Bisher wurden verschiedene Materialien als Floating Gate (dh Ladungsspeichermedium) erforscht, wie Dielektrika [14, 15], Metallnanokristalle [16, 17] und halbleitende Materialien [18, 19, 20, 21] . Da a-IGZO ein natürlicher Halbleiter vom n-Typ ist und eine Lochinversion in einem a-IGZO-TFT unter einer negativen Gate-Vorspannung kaum realisiert wird, haben daher die a-IGZO-TFT-Speicher gewöhnlich eine schlechte Löscheffizienz. Mit anderen Worten, die meisten a-IGZO-TFT-Speicher können nicht durch Lochinjektion aus dem Kanal elektrisch gelöscht werden [14,15,16]. Trotzdem haben Zhang et al. [21] stellten einen TFT-Speicher her, bei dem a-IGZO sowohl als Ladungseinfangschicht (CTL) als auch als Kanalschicht verwendet wurde, der elektrisch programmierbare und löschbare Eigenschaften sowie eine gute Datenerhaltung aufwies. Inzwischen haben Yun et al. untersuchten auch die Eigenschaften der a-IGZO-TFT-Speicher mit unterschiedlichen IGZO-CTL-Zusammensetzungen und zeigten ein abnehmendes Speicherfenster mit zunehmendem O2 Partialdruck (PO2 ) während der Sputter-Abscheidung der CTL [18]. Außerdem haben Bak et al. berichteten über die Leistung von a-IGZO-TFT-Speichern mit ZnO-CTLs unterschiedlicher Leitfähigkeit und schlossen daraus, dass die optimierte elektronische Natur der Bandlückenstruktur für ZnO-CTLs einer der wichtigsten Faktoren sein könnte, um hochfunktionelle Oxid-TFT-Speicher zu realisieren [20]. Obwohl die oben erwähnten CTL-basierten a-IGZO-TFT-Speicher auf Oxidhalbleiterbasis überlegene elektrische Programmier-/Löschgeschwindigkeiten aufweisen, wurden die bipolaren Programmiereigenschaften der oben erwähnten Vorrichtungen nicht berichtet, und die entsprechenden Einfangprozesse unterschiedlicher Ladungen in der CTL von Oxidhalbleitern sind nicht bekannt noch klar, insbesondere zum Einfangen positiver Ladungen.
In dieser Arbeit wurde ein bipolarer programmierbarer a-IGZO-TFT-Speicher unter Verwendung eines atomarschichtabgeschiedenen ZnO-Films als CTL hergestellt. Durch Vergleichen der bipolaren Programmiereigenschaften der TFT-Speicherbausteine mit den abgeschiedenen, O2 - oder N2 -getemperten ZnO-CTLs wurden die Einfangprozesse unterschiedlicher Ladungen in der ZnO-Schicht diskutiert. Es zeigt sich, dass Sauerstoffleerstellen-bezogene Defekte die bipolaren Programmiereigenschaften der a-IGZO-TFT-Speicherbausteine dominieren.
Methoden
P-Typ-Si (100)-Wafer mit einem spezifischen Widerstand von 0,001–0,005 cm wurden mit dem Standard-RCA-Reinigungsverfahren gereinigt und als Backgate des Geräts verwendet. Dann 35-nm-Al2 O3 und 20-nm-ZnO-Filme wurden nacheinander durch Atomlagenabscheidung (ALD) bei 250 °C und 200 °C abgeschieden, die als Sperrschicht bzw. CTL des TFT-Speichers dienten. Es ist erwähnenswert, dass der ZnO-Film einen quadratischen Mittelwert (RMS) von 0,553 nm hat. Anschließend wurden Photolithographie und Nassätzen durchgeführt, um die CTL von ZnO zu definieren. Danach wird ein 8-nm-Al2 O3 Tunnelschicht wurde durch ALD gezüchtet. Die Vorstufen von Diethylzink (DEZ)/H2 O und TMA/H2 O wurden für das Wachstum von ZnO und Al2 . verwendet O3 Filme bzw. Danach wurde ein 40-nm-a-IGZO-Film durch Hochfrequenz-Magnetron-Sputtern als Kanalschicht bei Raumtemperatur unter Verwendung eines InGaZnO4&sub2; Ziel. Anschließend wurde der aktive Kanal mit einer Breite (W)/Länge (L) von 100/10 µm durch Photolithographie und verdünnte HCl-Ätzung definiert. Source- und Drain-Kontakte aus Ti/Au (30 nm/70 nm) wurden durch Elektronenstrahlverdampfung gefolgt von einem Abhebeprozess gebildet. Schließlich wurden alle hergestellten Bauelemente bei 250 °C in O2 . getempert 5 Minuten lang, um die Leistung zu verbessern. Die elektrischen Charakterisierungen wurden unter Verwendung eines Halbleiterparameteranalysators (Agilent B1500A) bei Raumtemperatur durchgeführt. Die Schwellenspannung (Vth ) ist definiert als die Gatespannung, bei der der Drainstrom gleich W/L×10 –9 . ist A. Die Trägerkonzentration von ZnO-Filmen wurde aus Hall-Effekt-Messungen (Ecopia HMS-3000) bei Raumtemperatur extrahiert.
Ergebnisse und Diskussion
1 zeigt die schematischen Diagramme der hergestellten a-IGZO-TFT-Speichervorrichtung unter positiver bzw. negativer Vorspannungsprogrammierung. Während der elektrischen Programmierung wird ein elektrischer Impuls an das Backgate angelegt und die Source- und Drain-Elektroden werden geerdet. Abbildung 2 zeigt die Programmiereigenschaften der unberührten Speicherbausteine unter verschiedenen Bedingungen. Für das makellose Speichergerät weist es ein Ein-/Aus-Stromverhältnis (I an /Ich aus ) von 1,5 × 10 7 , Feldeffektmobilität von 7,1 cm 2 V −1 s −1 , und eine unterschwellige Schwingung (SS) von 0,67 V/dez. In Bezug auf die 80-ms-Programmierung bei verschiedenen positiven Vorspannungen ist das I d –V g Kurve bewegt sich allmählich in Richtung einer positiven Vorspannung als Funktion der Programmierspannung, z. B. der resultierenden Vth Verschiebung relativ zum unberührten Gerät (ΔVth ) steigt von 1,3 auf 4,8 V mit steigender Programmierspannung von 8 auf 13 V an und zeigt eine Programmiersättigung bei 12 V, wie in Fig. 2a gezeigt. So ein signifikantes ΔVth legt nahe, dass beträchtliche Elektronen aus dem n-Typ a-IGZO-Kanal in die ZnO-CTL injiziert werden. Darüber hinaus, wenn die Programmierspannung auf 13 V festgelegt ist, wird der ΔVth steigt langsam von 2 auf 3,1 V mit Verlängerung der Programmierzeit von 1 µs auf 30 ms, wie in Abb. 2c gezeigt. Interessanterweise wird der Vth zeigt eine bemerkenswerte Verschiebung in Richtung einer negativen Vorspannung, wie in Fig. 2b gezeigt. Bei einer konstanten Programmierzeit von 80 ms beträgt der ΔVth vergrößert sich von –5,2 auf –7,4 V mit zunehmender Programmiervorspannung von –8 auf –13 V. Selbst wenn der unberührte Speicherbaustein bei -13 V für 1 μs programmiert wird, kann er auch ein ΔVth . demonstrieren so groß wie −6,5 V, in Abb. 2d gezeigt. Dies bedeutet, dass eine sehr große Anzahl von Elektronen von der CTL abgefangen wird, wodurch viele positive Ladungen übrig bleiben.
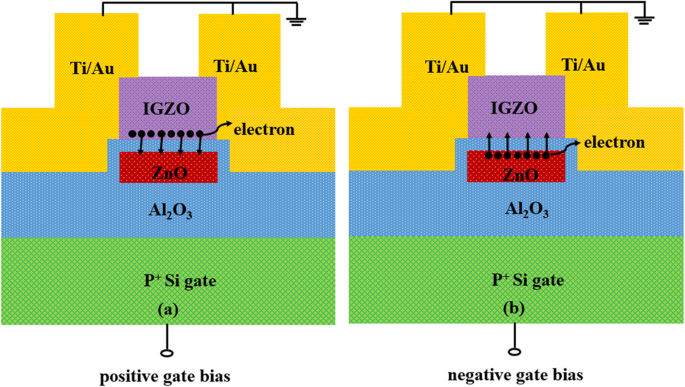
Die schematischen Querschnittsdiagramme des a-IGZO-TFT-Speicherbauelements, das unter einer positiven Gate-Vorspannung (a ) und eine negative Gate-Vorspannung (b ) bzw.
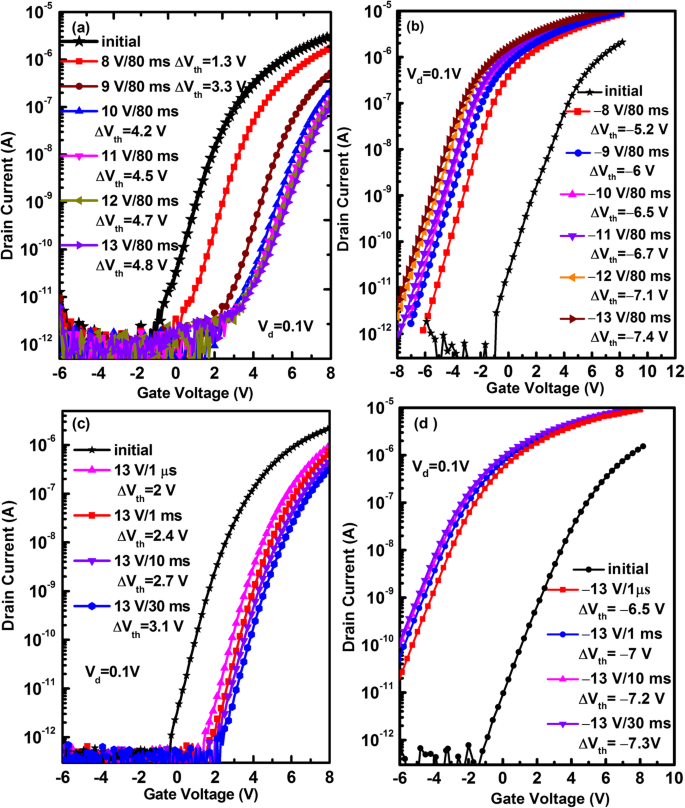
Die Übertragungskurven des a-IGZO TFT-Speichergeräts und die programmierten a bei verschiedenen positiven Gate-Vorspannungen für eine konstante Zeit von 80 ms, b bei verschiedenen negativen Gate-Vorspannungen für eine konstante Zeit von 80 ms, c bei 13 V für verschiedene Programmierzeiten und d bei −13 V für verschiedene Programmierzeiten. Alle Übertragungskurven für jede Figur wurden auf demselben Gerät gemessen und alle Programmiervorgänge wurden nacheinander ausgeführt.
Um den Ladungseinfangeffekt der ZnO-Schicht zu verstehen, werden zum Vergleich auch a-IGZO-TFTs ohne ZnO-CTL als Kontrollvorrichtungen hergestellt. Abbildung 3 zeigt die Übertragungseigenschaften der Steuergeräte, wenn sie unter unterschiedlichen positiven bzw. negativen Vorspannungen programmiert werden. Es zeigt sich, dass das Gerät kein erkennbares ΔVth . aufweist unabhängig von Polarität und Amplitude der Programmierspannung. Dies weist darauf hin, dass die oben erwähnten unterschiedlichen ΔVth für die Speichergeräte ist der ZnO-CTL zuzuschreiben. Andererseits ist anzumerken, dass IGZO ein natürlicher n-Typ-Halbleiter ist, sodass Elektronen im IGZO-Kanal unter einer positiven Gate-Vorspannung (z. B. . .) leicht in die ZnO-CTL injiziert werden können , +9 V). Wenn jedoch eine negative Programmiervorspannung an die Gate-Elektrode der Vorrichtung angelegt wird, neigt der a-IGZO-Kanal dazu, verarmt zu werden, und die Lochleitung wird kaum erreicht [15]. In diesem Fall kann die Vorrichtung nicht über Lochinjektion aus dem Kanal programmiert werden, und somit soll die einzigartige Möglichkeit der elektrischen Programmierung durch das Entfallen intrinsischer Elektronen in der reinen ZnO-CTL realisiert werden. Tatsächlich zeigen unsere experimentellen Ergebnisse, dass die Vorrichtung unter negativen Gate-Vorspannungen leicht programmiert werden kann, siehe Abb. 2d. Abbildung 4 zeigt die Haltbarkeitseigenschaften des Speichers als Funktion der Programmier-/Löschzyklen (P/E). Das Gerät hat ein Speicherfenster von 3,7 V für 10 3 von P/E-Zyklen bei 11 V/1 ms Programmierung und −9 V/10 μs Löschen. Darüber hinaus kann ein Speicherfenster von bis zu 7,2 V bei 10 3 . erreicht werden von P/E-Zyklen in Bezug auf 12 V/1 ms Programmierung und −12 V/10 μs Löschen. Tabelle 1 vergleicht die Programmier- und Löscheigenschaften verschiedener a-IGZO-TFT-Speicher [14, 22, 23]. Im Vergleich zu anderen Geräten weist unser Gerät eine viel höhere Löscheffizienz selbst bei einer niedrigeren Vorspannung (-12 V) und eine viel kürzere Zeit (10 μs) auf, trotz nicht bemerkenswerter Überlegenheit in der Programmiereffizienz.
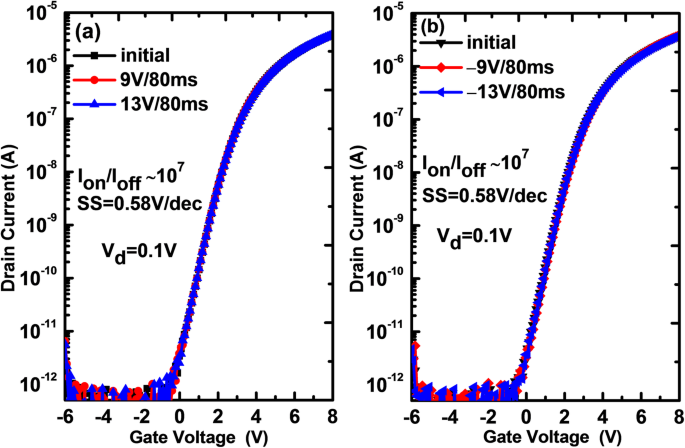
Die Übertragungskurven des a-IGZO TFT-Geräts und die programmierten a bei unterschiedlichen positiven Gate-Vorspannungen für eine konstante Zeit von 80 ms und b bei unterschiedlichen negativen Gate-Vorspannungen für eine konstante Zeit von 80 ms
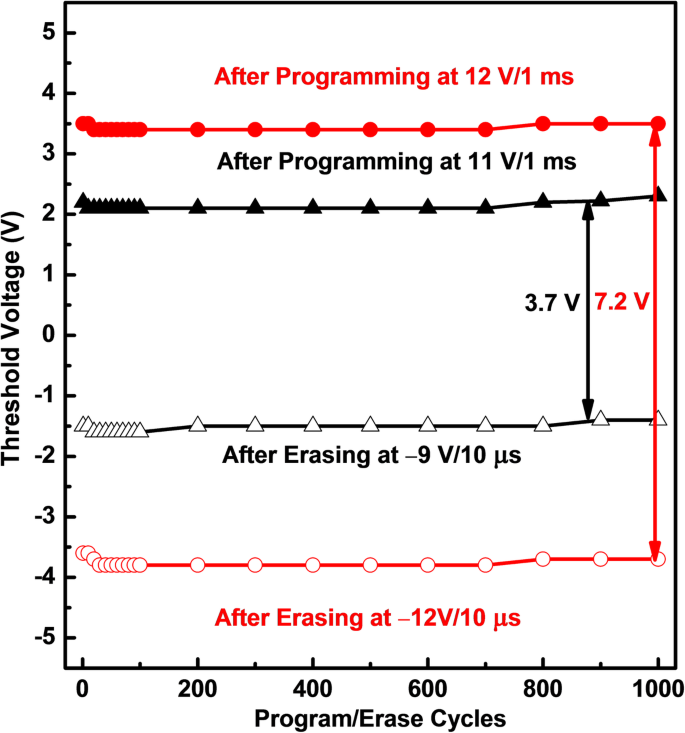
Die Lebensdauereigenschaften des a-IGZO TFT-Speicherbausteins als Funktion der P/E-Zyklen
Um den Ursprung der aus dem unberührten ZnO-CTL abgefangenen Elektronen zu klären, werden verschiedene verarbeitete ZnO-CTLs in den a-IGZO-TFT-Speicherbauelementen verglichen. Abbildung 5 zeigt die Abhängigkeit der Programmierspannung von △Vth für die Geräte mit unterschiedlichen ZnO-CTLs. Es ist zu beachten, dass für die Speichervorrichtungen mit dem hinterlegten und N2 -geglühte ZnO-CTLs, das resultierende ΔVth zeigt trotz Spannungspolaritäten eine ähnliche steigende Tendenz mit steigender Programmierspannung. Für das Speichergerät mit dem O2 -geglühtes ZnO CTL, der Absolutwert von ΔVth zeigt eine signifikante Abnahme unter den gleichen Programmierbedingungen, z. B. der Absolutwert von ΔVth sinkt um 2 bzw. 3 V bei 13 V/80 ms und –12 V/1 μs Programmierpulsen. Darüber hinaus wird ein gesättigtes Programmierverhalten für die O2 . beobachtet -geglühte ZnO-CTL bei positiven und negativen Gate-Vorspannungen. Dies ist auf begrenzte Traps in der CTL zurückzuführen. Kurz gesagt, das Nachglühen in O2 bei 250 °C verringert die Anzahl der Fallenzentren im ZnO-Film, was zu einer Verringerung der Ladungseinfangkapazität führt.

Die Schwellenspannungsverschiebungen der a-IGZO-TFT-Speicherbausteine mit unterschiedlich verarbeiteten ZnO-Ladungsfallenschichten als Funktion von a positive Programmierspannung für konstante Programmierzeit von 80 ms und b negative Programmierspannung für konstante Programmierzeit von 1 μs. Für jede Bedingung wurden fünf Geräte gemessen.
Um den Einfluss des Nachglühens auf die Eigenschaften des ZnO-Films zu untersuchen, werden die abgeschiedenen und verarbeiteten ZnO-Filme durch Hall-Effekt-Messungen und XPS charakterisiert. Wie in Fig. 6 gezeigt, wurde der in N2 . getemperte ZnO-Film bei 250 °C zeigt eine Trägerkonzentration von 4,4×10 19 cm −3 , was dem sehr nahe kommt (4,5 × 10 19 cm −3 ) des abgeschiedenen ZnO-Films; jedoch der ZnO-Film in O2 . getempert bei 250 °C zeigt eine bemerkenswerte Abnahme der Trägerkonzentration, die 1,8 × 10 18 . beträgt cm −3 . Es wird berichtet, dass die intrinsischen Donatoren in ZnO-Halbleiterfilmen vom n-Typ Sauerstoffleerstellen sind [24]. Kwon et al. berichteten auch, dass das O/Zn-Atomverhältnis im ALD-ZnO-Film allmählich von 0,90 auf 0,78 abnahm, wenn die Abscheidungstemperatur von 70 auf 130 °C erhöht wurde [25]. Dies zeigt die Existenz von Sauerstoffleerstellen in ALD-ZnO-Filmen. Daher ist die O2 – Die durch Glühen induzierte Abnahme der Ladungsträgerkonzentration (Elektronenkonzentration) sollte mit der Verringerung von Sauerstoffleerstellen im ZnO-Film zusammenhängen. Darüber hinaus hochauflösende O1s-XPS-Spektren des abgeschiedenen ZnO-Films und der in N2 . getemperten oder O2 werden analysiert, wie in Abb. 7 gezeigt. Die entfalteten drei Peaks sind bei 530,0, 531,6 und 532,4 eV zentriert, entsprechend O 2− Ionen gebunden an Zn 2+ (O1), Sauerstoffleerstellen (O2) bzw. chemisorbiertes Sauerstoffelement (–OH usw.) (O3) [26]. Verglichen mit dem abgeschiedenen ZnO-Film ist das Nachglühen in O2 erzeugt einen Rückgang des relativen O2-Anteils um 2,1%. Für den in N2 . getemperten ZnO-Film , der relative O2-Anteil ist nahezu unverändert. Diese Ergebnisse zeigen, dass die O2 Tempern kann Sauerstoffleerstellen im ZnO-Film passivieren, aber das N2 Glühen kann nicht. Dies bestätigt weiter die Korrelation zwischen Sauerstoffleerstellen und Trägerkonzentration.

Die Ladungsträgerkonzentrationen des abgeschiedenen ZnO-Films und der unter verschiedenen Bedingungen getemperten.
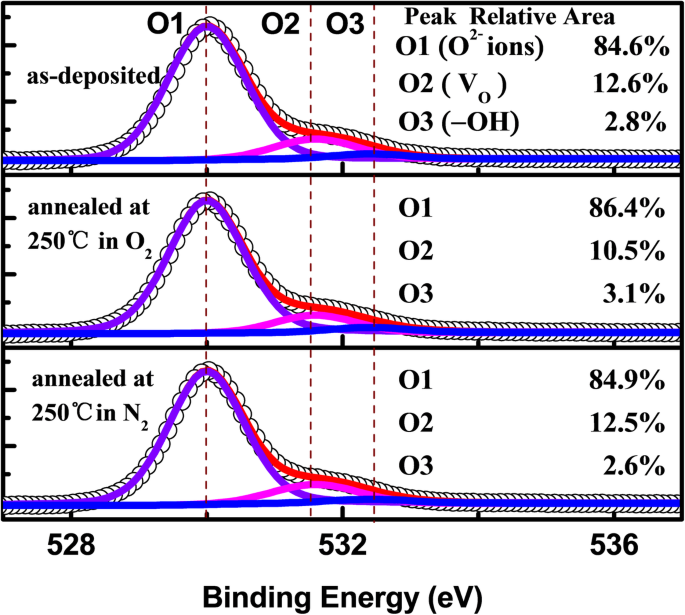
Hochauflösende O1s XPS-Spektren des abgeschiedenen ZnO-Films und der bei 250 °C in O2 . getemperten und N2 , bzw. O1 und O2 entsprechen O 2− Ionen gebunden an Zn 2+ bzw. Sauerstoff-Leerstellen. O3 wird dem chemisorbierten Sauerstoffelement (–OH usw.) zugeschrieben. Um unbeabsichtigte Oberflächenverunreinigungen zu entfernen, wurden alle Proben mit in situ Ar-Ionenbeschuss geätzt
Basierend auf den zuvor genannten experimentellen Ergebnissen kann gefolgert werden, dass die Programmiereigenschaften der makellosen Speichervorrichtungen von der Konzentration von Sauerstoffleerstellen-bezogenen Defekten in der ZnO-CTL dominiert werden. Anders ausgedrückt dienen Sauerstoffleerstellen im ZnO-Film hauptsächlich als Fallenzentren zum Einfangen positiver und negativer Ladungen. Es wird berichtet, dass Sauerstoffleerstellen-bedingte Defekte in ZnO eine neutrale Sauerstoffleerstelle (VO ), einfach ionisierte Sauerstoffleerstelle (VO + ) und doppelt ionisierte Sauerstoffleerstelle (VO 2+ ), deren Energieniveaus bei 0,02–0,04, 0,3–0,45 bzw. 0,61 eV unterhalb des Leitungsbandminimums von ZnO liegen [27, 28]. Da der abgeschiedene ZnO-Film in unserem Fall eine hohe Elektronenkonzentration aufweist, sollte die Konzentration von neutralen Sauerstoffleerstellen, die als flache Donatoren dienen, viel höher sein als die von ionisierten Sauerstoffleerstellen (VO + und VO 2+ ). Bei der Programmierung bei einer positiven Gate-Vorspannung werden Elektronen in der Akkumulationsschicht des a-IGZO-Kanals durch den Fowler-Nordheim (FN)-Tunnelmechanismus in die ZnO-Schicht injiziert, was durch ein inkrementelles ΔVth<. demonstriert wird /sub> mit Erhöhung der Programmierspannung in Fig. 2a. In der Zwischenzeit wird erwartet, dass diese Elektronen vorzugsweise auf tiefen Niveaus von VO . gefangen werden + und VO 2+ , wie in Abb. 8a dargestellt. Dies verursacht eine Verschiebung von Vth in Richtung einer positiven Tendenz. Natürlich können neben Sauerstoffleerstellen, die Elektronen einfangen, auch andere Defekte Elektronen einfangen. Unsere experimentellen Daten zeigen jedoch, dass Sauerstoffleerstellen eine entscheidende Rolle beim Elektroneneinfang sowie beim Einfangen positiver Ladungen spielen, wie in Abb. 5 gezeigt. Unter negativer Programmierspannung spenden die neutralen Sauerstoffleerstellen in der reinen ZnO-CTL aufgrund der flachstes Energieniveau [27, 28], und die freigesetzten Elektronen tunneln vom ZnO-CTL in den Kanal, was zur Bildung von positiv geladenen Sauerstoff-Leerstellen (z. B. VO + ), wie in Abb. 8b gezeigt. Dies verursacht eine Verschiebung von Vth in Richtung der negativen Vorspannung, wie in Fig. 2b angegeben. Aufgrund einer höheren Konzentration an Neutralsauerstoff-Leerstellen (VO ) in der abgeschiedenen CTL aus ZnO zeigt die makellose Speichervorrichtung eine viel höhere Programmiereffizienz unter der negativen Gate-Vorspannung als unter der positiven Gate-Vorspannung. Zum Beispiel der Absolutwert von ΔVth ist nach Programmierung bei −13 V für 1 μs bis zu 6,5 V groß (siehe Abb. 2d); jedoch die ΔVte gleich 2 V nach Programmierung bei 13 V für 1 µs (Abb. 2c). Dies liegt daran, dass erstere hauptsächlich durch die Konzentration von VO . bestimmt wird , und letztere wird von den Konzentrationen von VO . dominiert + und VO 2+ .
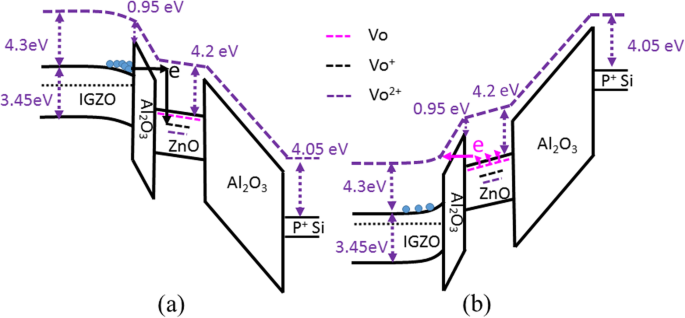
Energiebanddiagramme der bei a . programmierten a-IGZO TFT-Speicherbausteine eine positive Gate-Vorspannung und b jeweils eine negative Gate-Vorspannung. Vo , Vo + , und Vo 2+ bezeichnen neutrale Sauerstoff-Leerstellen, einfach ionisierte Sauerstoff-Leerstellen bzw. doppelt ionisierte Sauerstoff-Leerstellen
Schlussfolgerungen
Zusammenfassend haben wir einen bipolaren programmierbaren a-IGZO-TFT-Speicher mit einer atomarschichtabgeschiedenen ZnO-CTL hergestellt. Verglichen mit der Programmierung unter einer positiven Gate-Vorspannung kann die Programmierung unter einer negativen Gate-Vorspannung eine viel höhere Effizienz erzeugen. Dies liegt daran, dass während der spannungspolaritätsabhängigen Programmierung verschiedene Sauerstoffleerstellendefekte wirksam werden. Das heißt, tiefe Defekte von VO + und VO 2+ spielen eine Schlüsselrolle für das Einfangen von Elektronen während der Programmierung mit positiver Vorspannung und flache Defekte von VO spenden hauptsächlich Elektronen während der Programmierung mit negativer Vorspannung, was zur Erzeugung von positiv geladenen Sauerstoffleerstellen führt.
Verfügbarkeit von Daten und Materialien
Die Datensätze, die die Schlussfolgerungen dieses Manuskripts unterstützen, sind im Manuskript enthalten.
Abkürzungen
- a-IGZO:
-
Amorphes Indium-Gallium-Zink-Oxid
- ALD:
-
Atomlagenabscheidung
- CTL:
-
Ladungseinfangschicht
- TFT:
-
Dünnschichttransistor
- XPS:
-
Röntgenphotoelektronenspektroskopie
Nanomaterialien
- Abstimmung der Oberflächenmorphologien und -eigenschaften von ZnO-Filmen durch das Design der Grenzflächenschicht
- Fermi-Level-Tuning von ZnO-Filmen durch Supercycling-Atomschichtabscheidung
- Hocheffiziente invertierte Perowskit-Solarzellen mit CdSe-QDs/LiF-Elektronentransportschicht
- Untersuchung einer kristallinen Silizium-Solarzelle mit schwarzer Siliziumschicht auf der Rückseite
- Verbesserung der Leistung von a-IGZO-TFT-Geräten durch einen sauberen Schnittstellenprozess durch Ätzstopper-Nanoschichten
- Reduzierter Kontaktwiderstand zwischen Metall und n-Ge durch Einfügen von ZnO mit Argon-Plasmabehandlung
- Auswirkung von CeO2−x/ZnO- und ZnO/CeO2−x-Doppelschichten-Heterostrukturen und Galvanoformungspolarität auf die Schalteigenschaften von nichtflüchtigem Speicher
- Untersuchung des Energiebandes an Atomlagen-abgeschiedenen ZnO/β-Ga2O3 (\( \overline{2}01 \)) Heteroübergängen
- Lateraler, doppelt diffundierter Metall-Oxid-Halbleiter-Transistor mit extrem niedrigem spezifischen On-Widerstand mit verbessertem Dual-Gate und partieller P-vergrabener Schicht
- Python - Erweiterungsprogrammierung mit C



