Leistungsstarker anodischer Vulkanisationsvorbehandelter P+–π–M–N+ InAs/GaSb-Übergitter-Langwellen-Infrarotdetektor
Zusammenfassung
Der InAs/GaSb-Übergitter-Infrarotdetektor wurde mit enormem Aufwand entwickelt. Ihre Leistung, insbesondere von langwelligen Infrarotdetektoren (LWIR), ist jedoch immer noch durch die elektrische Leistung und die optische Quanteneffizienz (QE) begrenzt. Erzwingen, dass die aktive Region p . ist -Typ durch geeignete Dotierung kann die QE stark verbessern, und die Gating-Technik kann verwendet werden, um die elektrische Leistung stark zu verbessern. Die Sättigungsvorspannung ist jedoch zu hoch. Das Verringern der Sättigungsvorspannung hat breite Aussichten für die zukünftige Anwendung von Gatespannungs-Steuerungsvorrichtungen. In diesem Papier berichten wir, dass die gated P + –π –M–N + InAs/GaSb-Übergitter-Langwellen-Infrarotdetektoren weisen unterschiedliche Dotierungsniveaus im π-Bereich auf, die eine reduzierte minimale Sättigungsvorspannung bei – 10 V mit einem 200-nm-SiO2 . aufweisen Schicht nach einer einfachen und effektiven anodischen Vulkanisationsvorbehandlung. Die Sättigungs-Gate-Vorspannung ist viel niedriger als – 40 V, die bei der gleichen Dicke eines 200-nm-SiO2 . berichtet wurde Passivierungsschicht und ähnliche Struktur. Die optische und elektrische Charakterisierung zeigt, dass die elektrische und optische Leistung der Vorrichtung durch eine zu hohe Dotierungskonzentration geschwächt würde. Bei 77 K beträgt die 50 %-Cutoff-Wellenlänge des Geräts etwa 8 µm, die Cutoff-Wellenlänge von 100 % beträgt 10 µm, die maximale Quanteneffizienz 62,4 %, die maximale Empfindlichkeit 2,26 A/W bei 5 µm und das Maximum Die RA des Geräts beträgt 1259,4 Ω cm 2 . Außerdem weist die spezifische Detektivität des mit Be 780 °C dotierten Detektors ohne Gate-Elektrode eine Spitze von 5,6 × 10 10 . auf cm Hz 1/2 /W bei 5 µm mit einer 70-mV-Sperrvorspannung, die mehr als dreimal so hoch ist wie die eines mit Be 820 °C dotierten Detektors. Darüber hinaus konnte die Peak-spezifische Detektivität weiter auf 1,3 × 10 11 . erhöht werden cm Hz 1/2 /W bei 5 µm mit einer 10-mv-Reserve-Vorspannung, die eine Vorspannung von - 10 V an der Gate-Elektrode hat.
Einführung
Seit Sai-Halasz et al. [1] schlug seine Konzeption vor. Hochleistungs-Infrarotdetektoren können durch sorgfältiges Design der Bandstruktur und Dehnung von T2SLs erzeugt werden [2]. InAs/GaSb-Übergitter, ein gut untersuchtes Mitglied von T2SLs, ist ein ausgezeichnetes Materialsystem mit breiten Perspektiven im Infrarotdetektor [3]. Der InAs/GaSb-Übergitter-Infrarotdetektor wurde mit enormem Aufwand entwickelt. Ihre Leistung, insbesondere von langwelligen Infrarotdetektoren (LWIR), ist jedoch immer noch durch die elektrische Leistung und die optische Quanteneffizienz (QE) begrenzt [4]. Die entsprechende Umgebungstemperatur (bodenbasiert) des LWIR-Detektors beträgt etwa 300 K, was der Peakwellenlänge von 9,6 µm (der Mitte des atmosphärischen LWIR-Transmissionsfensters) entspricht und hat ein breites Anwendungsspektrum [5]. Es ist weit verbreitet in verschiedenen Bereichen wie Gasdetektion, Nachtsicht, Infrarot-Frühwarnung, Infrarot-Fernerkundung und Infrarot-Führung, nicht nur für militärische Zwecke, sondern auch für das Leben der Menschen. Es ist äußerst sinnvoll und anspruchsvoll, leistungsstarke langwellige Infrarot-Detektoren herzustellen.
Das strukturelle Design und die Prozessvorbereitung des Detektors haben einen erheblichen Einfluss auf die Leistung des LWIR-Detektors. Die Erhöhung der Dicke der aktiven Region schien der direkteste und effektivste Weg zur Verbesserung der QE zu sein. Mit der Zunahme der Dicke werden jedoch mehr Fallenzentren eingeführt, was zu einer Verringerung der elektrischen Eigenschaften des Detektors führt. Bei LWIR- und sehr langwelligen Infrarotdetektoren (VLWIR) neigt die InAs-Schicht dazu, dicker zu sein als die GaSb-Schicht. Somit ist das Material n -Typ (die Minoritätsträger sind Löcher). Erzwingen, dass die aktive Region p . ist -Typ durch geeignete Dotierung kann die QE stark erhöhen, ohne dass sich die Bereichsgröße des Bauelements ändert [6]. Je höher die Dotierungskonzentration ist, desto stärker ist jedoch die Verbesserung der Leistungsfähigkeit der Vorrichtung. Insbesondere die elektrische [7] und die optische Leistung des Geräts könnten durch eine zu hohe Dotierungskonzentration geschwächt werden.
Neben der Änderung der Dotierungskonzentration im π Region wurde die Gating-Technik in letzter Zeit bei Mittelwellenlängen-Infrarotdetektoren (MWIR) und LWIR-Detektoren [8] angewendet, um die Geräteleistung zu verbessern. Es erfordert jedoch eine sehr hohe Gate-Vorspannung. Die Gate-Vorspannung kann durch Gl. (1).
$$\sigma =\varepsilon \varepsilon_{0} V/d,$$ (1)wobei \(\varepsilon\) die relative Dielektrizitätskonstante der dielektrischen Schicht bezeichnet, \(\varepsilon_{0}\) die Dielektrizitätskonstante des Vakuums darstellt, V bezieht sich auf die Sättigungs-Gate-Vorspannung, d die Dicke der dielektrischen Schicht ist und σ steht für die Ladungsdichte an der Grenzfläche. Der Gate-Bias wurde nach der Formel mit großem Aufwand abgeschwächt; die Mittel zur Verwendung eines High-k-Dielektrikums wie Y2 O3 [9] zu passivieren oder die Schichtdicke zu reduzieren [10] ist wirksam. Es gibt jedoch wenig Forschung, die die Ladungsdichte reduziert. In diesem Artikel wird zuerst eine Anodisierung durchgeführt, um die Sättigungsabweichung signifikant zu reduzieren. Eine Mischung aus NaS2 ·5H2 Als Vulkanisierlösung wird O und Ethylenglykol verwendet. Während des anodischen Härtungsprozesses schließt die Kombination von Schwefelatomen und baumelnden Bindungen auf der Oberfläche des Geräts die leitenden Kanäle auf der Oberfläche des Geräts [11], verringert die Oberflächenrekombination des Geräts und schwächt die Oberflächenladungsdichte des Gerät. Dann wird eine Schicht aus dichtem und gleichförmigem elementarem Schwefel auf der Oberfläche der Vorrichtung erhalten. Als nächstes wird die Oberfläche der elementaren Schwefelschicht mit einer Schicht aus 200 nm SiO2 . bedeckt . Die Gate-Elektrode wird auf dem SiO2 . platziert Schicht. Die Sättigungs-Gate-Vorspannung wird verringert, wenn die Ladungsdichte an der Grenzfläche abnimmt.
In dieser Studie wurde anodisch vulkanisationsvorbehandeltes LWIR P + –π –M–N + Detektoren werden unter einer Gate-Vorspannung mit niedriger Sättigung basierend auf InAs/GaSb T2SLs mit unterschiedlicher Dotierung hergestellt π Regionen. Die Ergebnisse zeigen, dass die Verbesserung der Leistungsfähigkeit der Vorrichtung nicht umso größer ist, je höher die Dotierungskonzentration ist. Insbesondere würde die elektrische und optische Leistung der Vorrichtung durch eine übermäßige Dotierungskonzentration geschwächt. Außerdem kann eine anodische Vulkanisationsvorbehandlung die Gate-Vorspannung bei – 10 V deutlich reduzieren, die viel niedriger ist als die, die bei der gleichen Dicke eines 200-nm-SiO2 . berichtet wurde Passivierungsschicht mit ca. 40 V in ähnlicher Struktur.
Methoden
Materialien und Struktur
Die Materialien werden von einem Solid Source GEN 20 MBE-System auf dem 2-Zoll-n . hergestellt -Typ GaSb (001)-Substrate. Der Hochleistungs-LWIR-Detektor basiert in dieser Arbeit auf dem P + –π –M–N + Struktur. Eine schematische Darstellung der Geräte, hochauflösender Röntgenbeugungsmuster (HRXRD) und der Rasterkraftmikroskopie (AFM) ist in den Fig. 1 und 2 dargestellt. 1 und 2. Abbildung 1 zeigt, dass die Struktur aus einem 1300 nm dicken P + . besteht GaSb-Puffer, gefolgt von einem 500 nm dicken 8-ML-InAs/12-ML-GaSb (Be:ca. 1 × 10 18 cm −3 )P + Bereich, ein 2000 nm leicht P-dotiertes 12-ML InAs (Be:780 °C 800 °C 820 °C)/7-ML GaSb π Bereich, ein 500 nm undotierter 18-ML InAs/3-ML GaSb/5-ML AlSb/3-ML GaSb M-Bereich, ein 500 nm dicker 18-ML InAs/3-ML GaSb/5-ML AlSb /3-ML GaSb (Si:ungefähr 1 × 10 18 cm −3 ) N + Region und ein 30-nm-N + InAs Cap-Schicht. Und es zeigt auch die Ausrichtung des Simulationsbandes mit der Struktur. Wenn man bedenkt, dass die Leistung des P + –π –M–N + LWIR-Detektor würde durch die Dotierung des π . erheblich beeinflusst Region stellen wir drei Proben mit unterschiedlichen Be-Dotierungstemperaturen her, die von 780 bis 820 °C variieren.
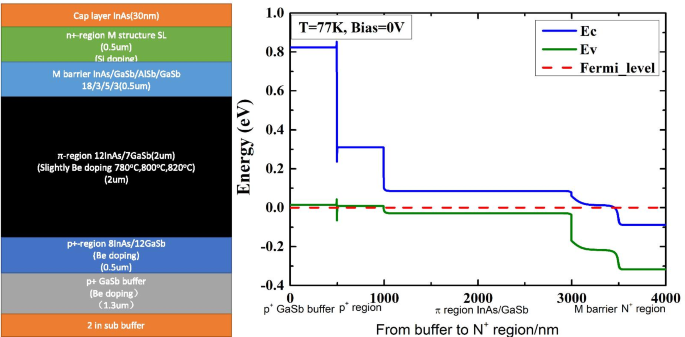
Die epitaktische Struktur und Bandausrichtung der Materialien mit unterschiedlichen Dotierungsniveaus der π-Region

HRXRD-Rocking-Kurven für Proben mit unterschiedlichen Dotierungsniveaus im π-Bereich
Die Übergitterperioden von 59,3 Å, 58,4 Å und 89,5 Å für das p -Kontakt, p -aktiver Bereich und M-Struktur-Schicht mit Gitterfehlanpassungen von 60 Bogensekunden, 0 Bogensekunden und 0 Bogensekunden entsprechend sind in Fig. 2 dargestellt. Die Halbwertsbreite für die SLs in jedem Bereich beträgt 32 Bogensekunden, 25 Bogensekunden und 12 Bogensekunden, was darauf hinweist, dass das Material an den Grenzflächen eine hohe Qualität aufweist.
Abbildung 3 zeigt, dass atomare Stufen mit dem quadratischen Mittelwert (RMS) der Rauheit mit 1,87 über eine Fläche von 10 × 10 µm auftreten.
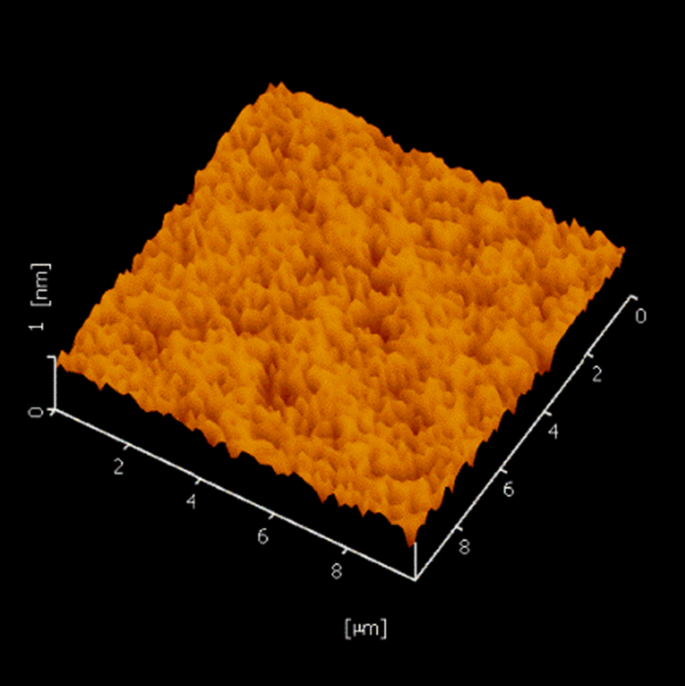
AFM von 10 × 10 µm 2 Bereich einer Probe
Gerätestruktur und -herstellung
Der Prozess ist ähnlich dem in Referenz [12]. Zuerst wird der Wafer mit SiO2 . bedeckt als Hark-Maske. Dann werden entsprechende Standardlithographieschritte übernommen. Dann öffnen wir die Hartmaske durch ein induktiv gekoppeltes Plasma (ICP)-System. Als nächstes wird die Mesa unter Verwendung eines induktiv gekoppelten Plasmasystems (ICP) mit einem CH4 . erhalten /Cl2 /Ar-Mischung. Konkret werden die Wafer von der obersten Schicht bis zum P + . geätzt Kontakt [12]. Danach wird das verbleibende SiO2 Schicht entfernt wird. Dann tauchen wir eine Seite des Wafers in eine gemischte Lösung aus Natriumsulfid und Ethylenglykol und legen dann einen konstanten Strom an den Wafer und stellen eine Schwellenspannung ein. Auf der Oberfläche des Films bildet sich eine Schwefelatomschicht und der Widerstand ändert sich. Die Spannung auf dem Wafer wird allmählich ansteigen, bis sie die Schwellenspannung erreicht, und dann ist die Vulkanisation abgeschlossen. Dann wird die elementare Schwefelschicht mit einer Schicht aus 200 nm SiO2 . bedeckt . Außerdem wird erneut Photolithographie durchgeführt, um das Fenster durch die Schicht aus SiO2 . zu öffnen und elementarer Schwefel als Metallkontaktbereiche der oberen und unteren Metallelektroden. Außerdem wird eine weitere Photolithographie mit zwei Elektrodenformen durchgeführt; eine Elektrodenform ist für die Gate-Diode (GD) und die andere für die ungegatete Diode (UGD). Ti (50 nm)/Pt (50 nm)/Au (300 nm) wird durch Elektronenstrahlabscheidung für die Metallelektroden abgeschieden. Schließlich werden die obere, untere und Gate-Elektrode durch Metallabheben erfasst.
Abbildung 4 veranschaulicht den Aufbau des GD. Wie wir wissen, kann der Neigungswinkel der Materialätzung durch Ändern der ICP-Leistung, der HF-Leistung, des Gasflusses und des Kammerdrucks eingestellt werden. In dieser Studie liegt der tatsächliche Neigungswinkel der Seitenwand zwischen 80 Grad und 85 °, um den Kontakt mit dem Abscheidetor an der Seitenwand zu erleichtern. Die Gate-Elektrode wird an der Seitenwand des SiO2 . platziert Schicht.
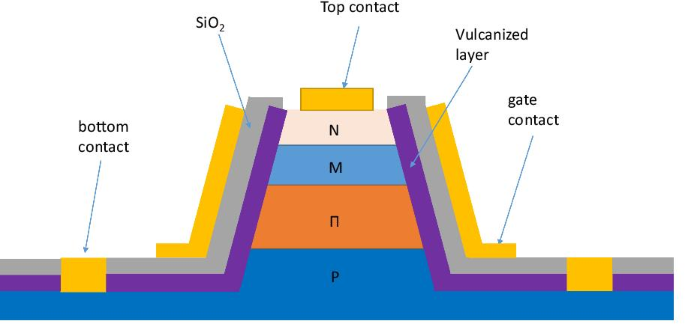
Das Gerätestrukturdiagramm von GD
Abbildung 5 zeigt, dass Halbdioden als GDs in den drei Chips (780 °C, 800 °C und 820 °C Be-Dotierung) abgeschieden werden. Dann können sowohl die Gate-Diode (GD) als auch die ungegatete Diode (UGD) erhalten werden. Schließlich Probe A (780 °C GD), Probe B (780 °C UGD), Probe C (800 °C GD), Probe D (800 °C UGD), Probe E (820 °C GD) und Probe F (820 °C UGD) kann erworben werden.

Bild des Geräts unter einem optischen Mikroskop
Ergebnisse und Diskussion
Bei Infrarotdetektoren ist eine spezifische Detektivität (D *) wird normalerweise verwendet, um die Detektorleistung zu charakterisieren, die nach Gl. (2).
$$D^{*} =\frac{Ri}{{\sqrt {2qJ + 4\frac{kT}{{RA}}} }}$$ (2)wo q bezeichnet den Betrag der elektronischen Ladung; K bezieht sich auf die Boltzmann-Konstante; T ist die Kelvin-Temperatur; Ri bezieht sich auf die Ansprechempfindlichkeit des Infrarotdetektors; J die Dunkelstromdichte des Geräts unter einer bestimmten Vorspannung ist; und RA bezieht sich auf das Produkt aus Widerstandswert und Matrizenfläche. J und RA charakterisieren die elektrische Leistung des Geräts. Und Ri kann mit der Formel in QE umgewandelt werden:
$$QE =\frac{hC}{{q\lambda}}Ri$$ (3)wobei \(h\) die Planck-Konstante ist, \({ }C\) die Lichtgeschwindigkeit ist, q bezeichnet die Menge der elektronischen Ladung, \({}\lambda\) ist die spezifische Wellenlänge und QE und Ri charakterisieren die optische Leistung des Geräts. Abbildung 6 zeigt die optischen Eigenschaften der Proben mit unterschiedlichen π Bereichs-Dotierungsniveaus bei 77 K. Alle Proben haben eine ähnliche Cutoff-Wellenlänge von 50 % von 8 µm und eine Cutoff-Wellenlänge von 100 % von 10 µm bei 77 K. Obwohl die QE und die Ansprechempfindlichkeit des Bauelements erhöht werden können, indem der Dotierungstyp geändert wird p -Typ der π Je höher die Temperatur, desto höher die QE und die Ansprechempfindlichkeit. Allerdings werden die QE und das Ansprechvermögen mit der Erhöhung der Dotierungskonzentration deutlich verringert. Für Typ-II-Übergitter mit verspannten Schichten (T2SLs) ist die Dotierungstemperatur während des Wachstums entscheidend für die Dotierungskonzentration. Je höher die Temperatur, desto höher die Dotierungskonzentration. Die QE von 780 °C erreicht ihren Maximalwert von 62,4 % und ist damit 1,5-mal größer als die QE von 820 °C. Dies liegt daran, dass mit der Erhöhung der Dotierungskonzentration zu viele Verunreinigungen eingeführt werden, was zu einer Verringerung der Überschussträgerlebensdauer/Diffusionslänge und einer Verringerung der QE und des Ansprechvermögens führt [6]. Außerdem verursachen sie die spektroskopische Rotverschiebung in Abb. 6a. Abbildung 6a und b zeigen, dass 780 °C die beste Dotierungstemperatur der Materialien für die optische Charakterisierung ist, mit einer Spitzenempfindlichkeit von 2,26 A/W bei 5 µm und einer Spitzen-QE von 62,4 %.
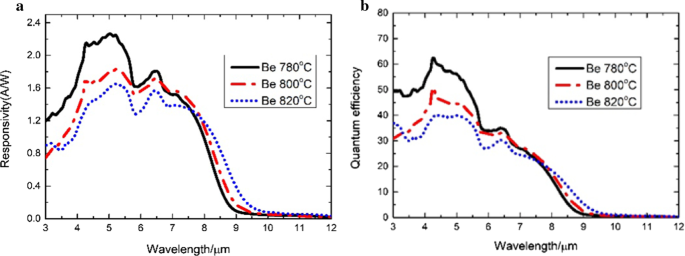
Die optischen Eigenschaften der Proben mit unterschiedlichen Dotierungsniveaus im π-Bereich bei 77 K
Abbildung 7 zeigt die elektrischen Eigenschaften der UGD-Proben mit verschiedenen π Bereichs-Dotierung bei 77 K. Die elektrische Leistung des Geräts würde durch verschiedene π . stark beeinflusst Bereichsdotierungskonzentrationen [7]. Mit der Zunahme des Dotierungsniveaus des π-Bereichs wird das Produkt aus Widerstandswert und Chipfläche (RA) bei einer bestimmten Vorspannung kleiner, und die Dunkelstromdichte wird entsprechend größer. Ähnlich wie in Referenz [6] erreicht RA sein Maximum bei fast 0 V mit einem weichen Durchbruch, wenn die Sperrspannung ansteigt, was darauf hindeutet, dass das Gerät einen Tunnel-Dunkelstrommodus hat. Wir erreichen das Maximum einer RA von 1259,4 Ω cm 2 mit Be dotiert mit 780 °C bei − 200 mv das ist fast das 40fache von Be dotiert mit 820 °C. Abbildung 7b zeigt, dass die Dunkelstromdichte bei negativer Vorspannung im Bereich von − 0.1 bis 0 V ähnlich ist und die Dunkelstromdichte bei Be-dotiert mit 780 °C etwas geringer ist als bei anderen. Der Dunkelstrom beträgt 4,9 × 10 −3 A/cm 2 für das Gerät mit Be dotiert mit 780 °C bei − 70 mv.
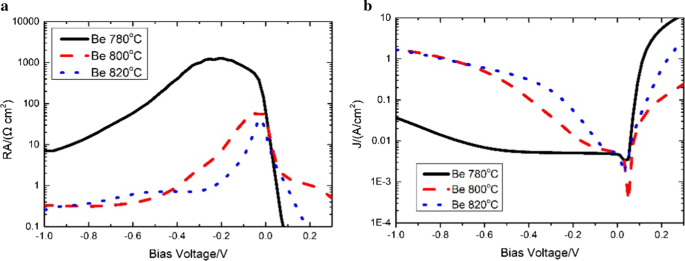
Die elektrischen Eigenschaften der UGD-Proben mit unterschiedlichen π Bereichs-Dotierungsniveaus bei 77 K
Das entsprechende D * kann berechnet werden, indem das spezifische Ri, J . genommen wird , und RA-Werte unter verschiedenen Vorspannungen bei 77 K. Abbildung 8 zeigt die Detektivität der UGD-Proben mit unterschiedlichen π Regionen. Bei − 30 mv beträgt die Spitzendetektivität 5,6 × 10 10 cm Hz 1/2 /W bei 5 µm mit Be-dotiert mit 780 °C, während es 3,8 × 10 10 . beträgt cm Hz 1/2 /W mit Be dotiert mit 820 °C. Die Spitzendetektivität von Be, das mit 780 °C dotiert ist, ist das 1,5-fache der von Be, das mit 820 °C dotiert ist. Daher ist die geeignete Dotierungskonzentration äußerst wichtig. Eine zu hohe Dotierungskonzentration würde jedoch die Geräteleistung schwächen.

Korrelation zwischen der spezifischen Detektivität bei 77 K von UGD-Proben mit π Dotierungsniveaus und Wellenlänge der Region
Abbildung 9 zeigt die elektrischen Eigenschaften der GD-Probe mit Be-dotiert mit 760 °C bei 77 K. Anders als bei herkömmlichen Gate-Spannungssteuergeräten wird in dieser Studie zuerst eine anodische Vulkanisationsvorbehandlung durchgeführt, um die Sättigungs-Gate-Vorspannung bemerkenswert zu reduzieren. Außerdem eine Mischung aus NaS2 ·5H2 Als Vulkanisierlösung wird O und Ethylenglykol verwendet. Das Anodenvulkanisations-Passivierungsverfahren wird verwendet, um eine Schicht aus dichtem und gleichförmigem elementarem Schwefel auf der Oberfläche der Vorrichtung zu bilden. Während der elektrochemischen Reaktion werden Schwefelatome mit den Dangling-Bindungen auf der Geräteoberfläche kombiniert, was zum Schließen der durch die Dangling-Bonds erzeugten elektronischen Kanäle und zur Isolierung des Elektron-Loch-Rekombinationsmechanismus der Geräteoberfläche beiträgt [11]. Dann wird die Oberfläche der elementaren Schwefelschicht mit einer Schutzschicht aus 200 nm SiO2 . bedeckt , und die Gate-Elektrode wird auf der Seitenwand des SiO2 . platziert Schicht. Wie in früheren Untersuchungen berichtet, ist die Korrelation zwischen der Sättigungsvorspannung und der Dicke der dielektrischen Schicht der Vorrichtung nahezu linear. Abbildung 9 legt nahe, dass die Sättigungsvorspannung der Vorrichtung bei etwa – 10 V durch eine einfache und wirksame Vulkanisationsvorbehandlung reduziert werden kann; dieser reduzierte Wert beträgt in anderen Untersuchungen etwa 40 V und ist bei Geräten ähnlicher Struktur mit gleicher Dicke viermal größer SiO2 Schicht [10]. Außerdem erreicht RA sein Maximum von 25 Ω cm 2 bei nahe 0 V. Der Abwärtstrend hat sich deutlich verlangsamt, wenn wir eine negative Vorspannung von etwa – 10 V anlegen. Wenn wir eine Vorspannung von – 10 V an die Gate-Elektrode anlegen, beträgt RA 10 Ω cm 2 bei − 0,3 V, was dem 40-fachen des Wertes ohne angelegte Vorspannung entspricht. Außerdem ist er fast zwei Größenordnungen niedriger als ohne Vorspannung bei − 0,6 V. Abbildung 9b zeigt, dass der Dunkelstrom sein Minimum von 2 × 10 –4 . erreicht A/cm 2 nahe 0 V, und sie wird bei − 0,3 V um eine Größenordnung reduziert. Wie wir wissen, würde sich die IV-Kurve mit der Gate-Vorspannung bei 0 V nicht ändern, wenn die Vorspannung positiv ist. Außerdem nimmt der RA des Bauelements signifikant zu, wenn die Vorspannung von 0 auf – 10 V ansteigt; währenddessen sinkt der Dunkelstrom des Gerätes entsprechend. Wenn die Vorspannung von – 10 bis – 20 V variiert, nimmt der RA des Bauelements leicht ab und der Dunkelstrom des Bauelements steigt entsprechend an. Bei hoher Reservevorspannung (z. B. – 1 V) zwischen oberen und unteren Elektroden nimmt der Dunkelstrom mit der Gate-Vorspannung ab und steigt dann geringfügig über – 12 V an. Dies ist hauptsächlich für die Gate-Vorspannungscharakteristik. Eine weitere Einführung ist in Abb. 10 gezeigt. Bei niedriger Sperrspannung (z. B. − 0,1 V) scheint der Dunkelstrom mit zunehmender Gate-Vorspannung zuzunehmen, was sich völlig von der bei − 1 V unterscheidet. Für unterschiedliche Sperrspannungen vermuten wir, dass der Hauptleckmechanismus ist anders. Bei niedriger Reservevorspannung zeigt eine hohe Gate-Vorspannung einen negativen Einfluss, da sie die Oberflächenstreuung von Elektronen und heißen Elektronen beeinflusst. Und bei hoher Sperrvorspannung nimmt der Leckstrom ab, da sein Oberflächenleckstrom abnimmt. Es ist also anders.

Die elektrischen Eigenschaften von GD-Proben mit 780 °C Be dotiert mit unterschiedlichen Gate-Vorspannungen und der Vorspannung an der oberen und unteren Elektrode
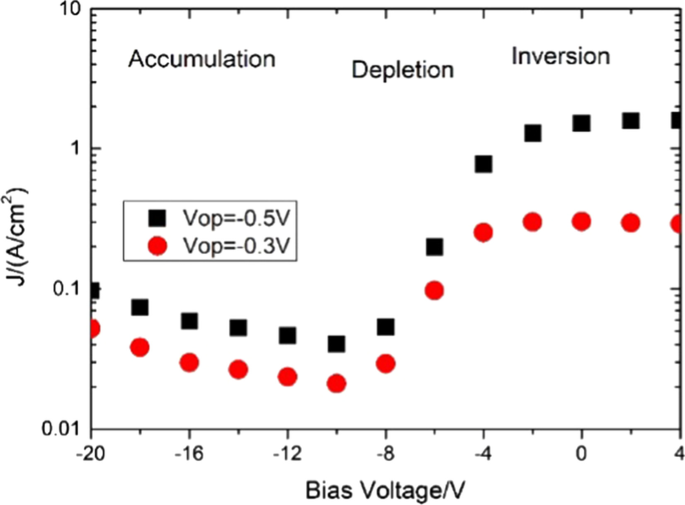
Korrelation zwischen der Sperr-Dunkelstromdichte und der Gate-Vorspannung einer GD-Probe mit 780 °C Be-dotiert bei verschiedenen Diodenbetriebsvorspannungen
Wie in 10 dargestellt, nimmt bei hoher Reservevorspannung (z. B. – 1 V) zwischen der oberen und unteren Elektrode der Dunkelstrom mit der Gate-Vorspannung ab und steigt dann geringfügig über – 12 V hinaus an; Wir können sehen, dass das Gerät in drei Stufen mit der Änderung der Vorspannung bei 77 K existiert [10]. Laut Referenz [13] ist das P + und N + Regionen für P + –π–M–N + Strukturbauelemente sind stark dotiert, und die M-Region ist eine größere Bandregion mit einer größeren effektiven Masse im Vergleich zu der π und P + Region; daher hat die Gate-Vorspannung viel mehr Einfluss auf das π Region im Vergleich zu anderen [13]. Unter Verwendung einer ähnlichen Methode mit Chen [10] werden drei Phasen während des Prozesses des Anlegens einer hohen negativen Vorspannung (– 20 bis – 10 V) an die Gate-Elektrode analysiert; die Ergebnisse zeigen, dass die Mesa-Seitenwand im flachen Zustand oder unter Akkumulation ist [8] und die Dunkelstromdichte aufgrund der Vulkanisationsgrenzfläche mit der Gate-Vorspannung leicht zunimmt. Vermute eine leichte Dichteinhomogenität der Vulkanisationsgrenzfläche, irgendwo eine ungenügende Dichte leicht zusammenbrechen. Wenn eine negative Vorspannung (– 10 bis – 2 V) angelegt wird, verarmt die Mesa-Seitenwand und der Dunkelstrom steigt sanft an. Außerdem erreicht die feldinduzierte Verarmungsbreite ihr Maximum und die Inversionsschichtbildung, wenn die Vorspannung bei – 2 V an eine positive Gate-Vorspannung angelegt wird; somit bleibt die Dunkelstromdichte konstant. Gemäß Lit. [14] wird erklärt, warum der Oberflächengenerations-Rekombinationsstrom (G-R) bei − 0.5 V größer ist als der bei − 0.3 V.
Abbildung 11 zeigt, dass bei einer Gate-Vorspannung von − 10 V der D * für GD-Probe mit 780 °C Be-dotiert erreicht seine Spitzendetektivität von 1,3 × 10 11 cm Hz 1/2 /W bei 5 µm, das ist mehr als das Doppelte derjenigen ohne Vorspannung mit 780 °C Be-dotiert und mehr als das Dreifache davon ohne Vorspannung mit 820 °C Be-Dotierung bei 77 K. Dies zeigt an, dass das Anlegen einer geeigneten negativen Vorspannung kann die Geräteleistung erheblich verbessern.
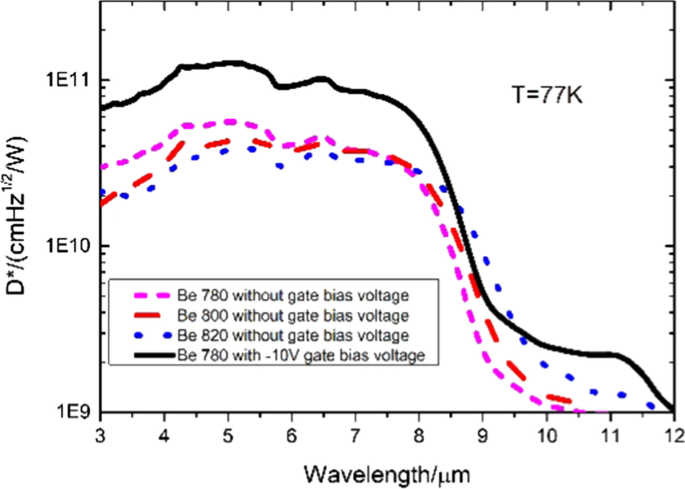
Korrelation zwischen der Detektivität der GD-Probe mit 780 °C Be-dotiert und UGD-Proben mit unterschiedlichen Dotierungsniveaus im π-Bereich und der Wellenlänge bei 77 K
Schlussfolgerungen
2017 Northwestern University berichtete über langwellige Infrarot-(LWIR)-nBn-Photodetektoren basierend auf InAs/InAs1−x Sbx Typ-II-Übergitter. Das Gerät wies eine Grenzwellenlänge von 10 µm bei 77 K mit einer Spitzenempfindlichkeit von 2,65 A/W auf, was einer Quanteneffizienz von 43% und einem RA von 664 Ω cm 2 . entspricht und eine Dunkelstromdichte von 8 × 10 5 A/cm 2 , unter 80 mV Vorspannung bei 77 K; der Photodetektor wies eine spezifische Detektivität von 4,72 × 10 11 . auf cm Hz 1/2 /W[5]. Die Spitzenempfindlichkeit dieses Geräts beträgt 1,3 × 10 11 cm Hz 1/2 /W bei 5 µm und 0 V mit − 10 V Gate-Vorspannung, die mit dem nBn-Bauelement vergleichbar ist. Der Schwachpunkt ist jedoch die Einheitlichkeit der Geräte-RA, die die Geräteleistung beeinflusst.
Zusammenfassend lässt sich sagen, dass die aktive Region gezwungen wird, p . zu sein -Typ durch Doping in der π Region kann die Leistung für LWIR InAs/GaSb-Übergitter P + . effektiv verbessern –π –M–N + Detektor [6]. Je höher die Dotierungskonzentration ist, desto stärker ist jedoch die Verbesserung der Leistungsfähigkeit der Vorrichtung. Insbesondere die elektrische und optische Leistung der Vorrichtung könnte durch eine zu hohe Dotierungskonzentration verringert werden. Die optische Charakterisierung bei 77 K zeigt, dass wir ein QE-Maximum von 62,4 % bei 4,26 µm und ein Maximum von 2,26 A/W bei 5 µm mit Be-dotiert mit 780 °C erhalten. Die elektrische Charakterisierung legt nahe, dass das Maximum einer RA 1259,4 Ω cm 2 . beträgt mit Be dotiert mit 780 °C erhalten. Die spezifische Detektivität erreicht ihr Maximum von 5,6 × 10 10 cm Hz 1/2 /W bei 5 µm mit Be dotiert mit 780 °C. Darüber hinaus kann der Sättigungsbias der Vorrichtung durch eine einfache und effektive Vorbehandlung der anodischen Vulkanisation drastisch reduziert werden. Die Vulkanisationsvorbehandlung zeigt ihr Potenzial, die Gate-Vorspannung zu reduzieren. Die elektrische Charakterisierung zeigt, dass die Sättigungsvorspannung nur – 10 V beträgt, während sie in anderen Untersuchungen ohne Vulkanisationsvorbehandlung in einer ähnlichen Struktur mit der gleichen Dicke des SiO2 . 40 V beträgt Schicht. Darüber hinaus kann die Leistungsfähigkeit der Vorrichtung durch Anlegen einer geeigneten negativen Vorspannung an die Gate-Elektrode erheblich verbessert werden. Maximal 1,3 × 10 11 cm Hz 1/2 /W wird bei 5 µm und 0 V mit − 10 V Gate-Vorspannung mit Be dotiert mit 780 °C bei 77 K erreicht. Begrenzt durch experimentelle Ausrüstung und experimentelle Bedingungen wählen wir SiO2 als dielektrische Schicht, aber in der Folge wird erwogen, Hi-K-Medium für weitere Experimente zu verwenden. Theoretisch kann die Gate-Vorspannung weiter reduziert werden.
Verfügbarkeit von Daten und Materialien
Die Autoren erklären, dass die Materialien und Daten dem Leser ohne unangemessene Einschränkung für Materialtransfervereinbarungen unverzüglich zur Verfügung stehen. Alle während dieser Studie generierten oder analysierten Daten sind in diesem Artikel enthalten.
Abkürzungen
- LWIR:
-
Langwellige Infrarotdetektoren
- QE:
-
Quanteneffizienz
- T2SLs:
-
Typ-II-Übergitter mit verspannten Schichten
- VLWIR:
-
Sehr langwellige Infrarotdetektoren
- MWIR:
-
Infrarotdetektoren mittlerer Wellenlänge
- HRXRD:
-
Hochauflösende Röntgenbeugung
- AFM:
-
Rasterkraftmikroskopie
- ICP:
-
Induktiv gekoppeltes Plasma
- GD:
-
Gated Diode
- UGD:
-
Ungegatterte Diode
- D*:
-
Spezifische Detektivität
- RA:
-
Produkt aus Widerstandswert und Matrizenfläche
- Ri:
-
Ansprechempfindlichkeit des Infrarotdetektors
- G–R:
-
Generation–Rekombination
Nanomaterialien
- Experteninterview:Scott DeFelice von Oxford Performance Materials zur Entwicklung von Hochleistungspolymeren für den 3D-Druck
- Einfache Synthese von heterostrukturiertem WS2/Bi2MoO6 als Hochleistungs-Photokatalysatoren, die durch sichtbares Licht angetrieben werden
- Selbstkatalysiertes Wachstum von vertikalen GaSb-Nanodrähten auf InAs-Stämmen durch metallorganische chemische Gasphasenabscheidung
- Erhöhte Biokompatibilität in anodischen TaO x Nanotube-Arrays
- Durch sichtbares Licht angetriebene photokatalytische Leistung von N-dotierten ZnO/g-C3N4-Nanokompositen
- Herstellung und photokatalytische Leistung von Hohlstruktur-LiNb3O8-Photokatalysatoren
- Ein neuartiger Bi4Ti3O12/Ag3PO4-Heteroübergang-Photokatalysator mit verbesserter photokatalytischer Leistung
- Verbesserte Leistung eines neuartigen anodischen PdAu/VGCNF-Katalysators für die Elektrooxidation in einer Glycerin-Brennstoffzelle
- Hochleistungs-UV-Detektor mit eigener Stromversorgung auf Basis von SnO2-TiO2-Nanomace-Arrays
- Automatische Bewertung der Röntgendetektorleistung



