Detektoren-Array für die In-Situ-Elektronenstrahl-Bildgebung mit 16-nm-FinFET-CMOS-Technologie
Zusammenfassung
Ein Roman in situ Bildgebungslösung und Detektor-Array für den fokussierten Elektronenstrahl (E-Beam) werden erstmals vorgeschlagen und demonstriert. Das vorgeschlagene In-Tool-On-Wafer-E-Beam-Detektor-Array bietet volle FinFET-CMOS-Logikkompatibilität, kompakte 2 T-Pixelstruktur, schnelle Reaktion, hohe Empfindlichkeit und einen großen Dynamikbereich. Das E-Beam-Bildgebungsmuster und die Detektionsergebnisse können im Erfassungs-/Speicherknoten ohne externe Stromversorgung weiter gespeichert werden, was eine Offline-Elektroablesung ermöglicht, die verwendet werden kann, um schnell eine zeitnahe Rückmeldung der Schlüsselparameter des E-Beam-Ein zu geben die projizierten Wafer, einschließlich Dosierung, Beschleunigungsenergie und Intensitätsverteilungen.
Einführung
Der fokussierte Elektronenstrahl (E-Beam) kann in verschiedenen Anwendungen eingesetzt werden, ein spezielles Beispiel sind Beschleuniger und Freie-Elektronen-Laser (FEL), die die Beteiligung von E-Beam erfordern [1, 2]. Andererseits spielt E-Beam eine wichtige Rolle im Halbleiterherstellungsprozess; In früheren Berichten wurde eine Elektronenstrahlbehandlung für die Grenzflächenmodifikation der Damaszener-Zwischenverbindung vorgeschlagen, die elektrische Leistung von Kupfer und Dielektrikum mit niedrigem verbessert werden, ohne deren Filmqualität oder Dielektrizitätskonstante zu beeinträchtigen [3]. Außerdem ist bewiesen, dass bestimmte Arten von EUV-Fotolacken unter E-Beam-Belichtung ohne chemische Mittel hergestellt werden können [4]. Darüber hinaus wurde die Elektronenstrahltechnologie entwickelt, um Muster direkt auf den Wafer zu schreiben [5], wodurch Transistoren [6, 7], Polymerstrukturen [8], Nanodrähte [9] und andere Nanostrukturen [10] erzeugt werden. Darüber hinaus hat sich die Photomaskenherstellung unter Verwendung von Elektronenstrahlen zu einer der gebräuchlichsten Methoden für Nanometer-CMOS-Technologien entwickelt [11,12,13,14]. Alle oben genannten Anwendungen können jedoch fehlschlagen, wenn der Elektronenstrahl nicht präzise gesteuert werden kann, um sicherzustellen, dass die Beschleunigungsenergie, die Dosierung und die Gleichmäßigkeit des Elektronenstrahls konsistent sind.
Um die Beschleunigungsenergie und Dosierung des Elektronenstrahls in der Bearbeitungskammer weiter zu überwachen, ist ein werkzeuginterner Elektronenstrahldetektor auf dem Wafer erforderlich. Eine frühere Studie über einen Elektronenstrahldetektor mit Dünnschicht-Thermoelement [15] kann die Verteilung hochenergetischer Elektronen und den Mangel an Empfindlichkeit aufgrund der Beschränkung des Thermoelements selbst nicht direkt messen. Es gibt auch optische Nachweisverfahren mit Fasern [16] und anderen Geräten wie der Pockels-Zelle [17]. Andererseits wird die Mikrokanalplatte (MCP) häufig für die Detektion von Einzelpartikeln und Strahlung verwendet [18, 19]; Bei geeignetem Instrumentendesign und gut abgestimmten Parametern können die Ergebnisse der Elektronenstrahldetektion mit optischen Methoden und MCP durchaus zufriedenstellend sein. Ihre Integration in einen kleinen Chip stellt jedoch eine Herausforderung dar, was sie nicht zum besten Kandidaten für die werkzeuginterne Elektronenstrahlerkennung auf dem Wafer macht. Herkömmliche CMOS-Bildsensor(CIS)-Methoden mit aktivem Pixelsensor (APS) können hilfreich sein [20, 21], da die Elektronen direkt gesammelt werden können und das Rauschen durch das sorgfältig konzipierte Ausleseschema reduziert werden kann, was zu einer höheren Signalstärke führt. Rauschabstand (SNR); Allerdings ist während der Erfassung eine externe Stromversorgung zum Ansteuern des herkömmlichen APS-Chips erforderlich, was seine Durchführbarkeit verringert und die Komplexität des Designs der Elektronenstrahlkammer erhöht.
In dieser Studie wird ein werkzeuginterner On-Wafer-Ansatz zur E-Beam-Erkennung ohne externe Stromversorgung vorgeschlagen und verifiziert. Der vorgeschlagene E-Beam-Detektor/-Recorder verwendet Floating Gate als Sensorknoten, der mit dem 16-nm-FinFET-CMOS-Logikprozess kompatibel ist, mit Speicherfähigkeit der Erkennungsergebnisse, kompaktem 2-Transistor-(2 T)-Pixel, schneller Reaktion, großem Dynamikbereich und hohe Reaktionsfähigkeit. Nach der Inline-Elektronenstrahlbestrahlung können die Schlüsselmerkmale der Elektronendosis und der Beschleunigungsenergie dann einfach und schnell durch elektrische Offline-Messungen, wie z
Pixelstruktur und -methodik
Der experimentelle Aufbau und das grundlegende Funktionsprinzip des vorgeschlagenen werkzeuginternen E-Beam-Recorders sind in Abb. 1 dargestellt. Während der E-Beam-Belichtung wird der vorgeschlagene On-Wafer-Detektor zuerst in der E-Beam-Kammer platziert, wie in dargestellt Abb. 1a, Sammeln der injizierten hochenergetischen Elektronen durch die Floating-Gate-Struktur. Wenn hochenergetische Elektronen mit Metall- und dielektrischen Schichten darüber kollidieren, nimmt folglich die Energie der entsprechenden Elektronen ab. Abhängig von der Beschleunigungsenergie der injizierten Elektronen erreicht ein Teil von ihnen die schwebenden Gates und ruht auf diesen, die dann nach der Belichtung auf dem erfassten Pegel gespeichert werden. Daher werden die projizierten Elektronenstrahlpegel an jedem Standort ohne Stromversorgung des Erkennungschips dann in dem einzigartigen 2 T-Pixel gespeichert, dessen Schema Fig. 1b entspricht. Nach der Inline-Elektronenstrahl-Belichtung kann die entsprechende Dosis und Beschleunigungsenergie durch Offline-Strom-Spannungs-(IV)-Messung ausgelesen werden, wie die Messdaten in Abb. 1c zeigen, die zur Rekonstruktion verwendet werden können die projizierte Elektronenstrahlabbildung, das Muster und in situ Intensitätsverteilung. Bei einem Detektorarray auf Chipebene kann die Bildauslesung stark verbessert werden, wenn eine parallele periphere Ausleseschaltung eingebaut ist, wobei die Auslesezeit voraussichtlich innerhalb von ms liegt. Außerdem kann das Detektor-Array nach dem Initialisierungsschritt innerhalb von Sekunden für die nächste E-Beam-Erkennung aufgefrischt werden.
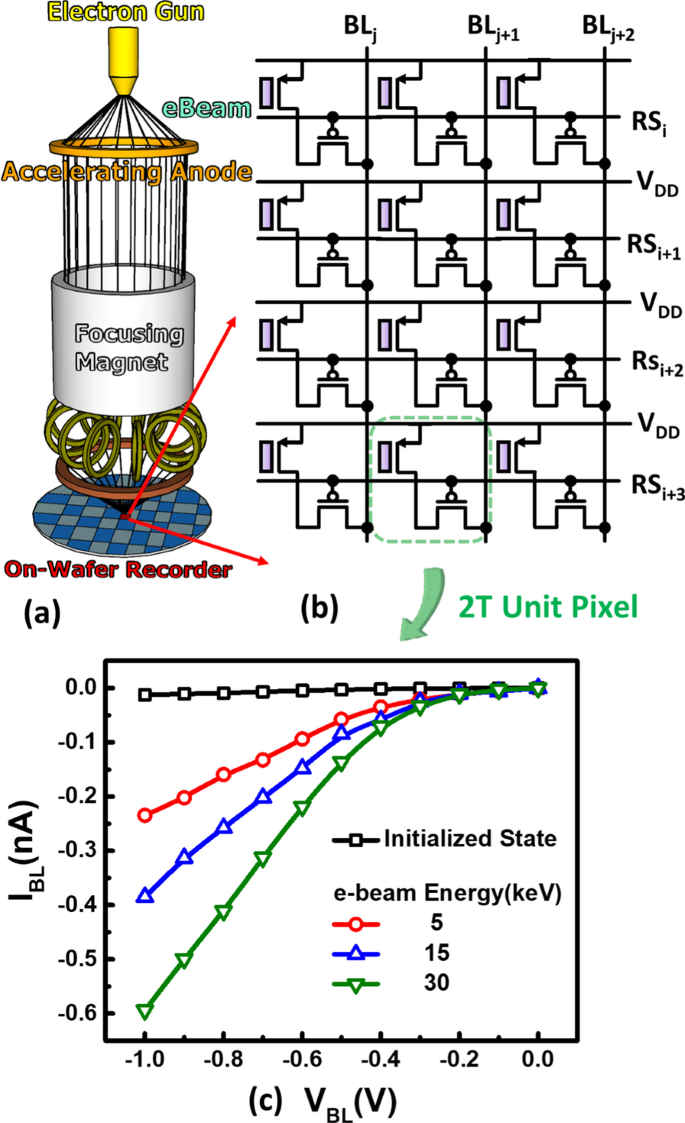
a Der Versuchsaufbau und b Schema des vorgeschlagenen Elektronenstrahldetektor-Arrays, beginnend mit In-Kammer-Detektion, On-Wafer-Offline-Auslesung und Intensitätsbild rekonstruiert von c seine Messergebnisse der elektrischen Eigenschaften
Die dreidimensionale Strukturdarstellung des vorgeschlagenen Elektronenstrahldetektors mit einem kompakten 2 T-Pixel ist wie in Fig. 2a, bestehend aus p-Kanal-Transistoren, die durch reine 16-nm-FinFET-CMOS-Technologien hergestellt werden, einschließlich eines Zeilenauswahltransistors (RS), der kann verwendet werden, um das sequentielle Auslesen zu steuern; und der andere ist ein Transistor mit schwebendem Gate (FG) zum Speichern der Abtastergebnisse. Die einzigartige kompakte Pixelstruktur und der In-Pixel-FG-Speicherknoten können durch die Transmissionselektronenmikroskop(TEM)-Bilder entlang der Bitleitung (BL) und dem entsprechenden Layout, wie in Fig. 2b bzw. c gezeigt, deutlich beobachtet werden. Der Pixelabstand des vorgeschlagenen 2 T-Pixels kann auf 0,7 μm herunterskaliert werden, was eine hohe räumliche Auflösung der Elektronenstrahlabbildung und -erkennung ermöglicht.
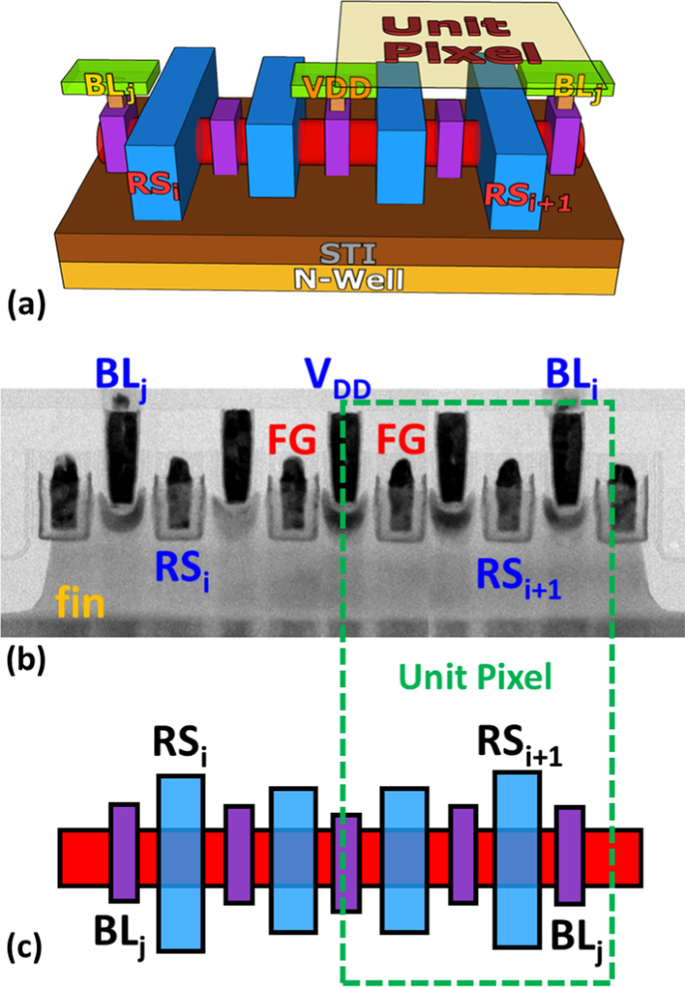
a Die 3D-Struktur, b TEM-Bild entlang BL und c Layout-Darstellung des vorgeschlagenen Elektronenstrahldetektors mit kompaktem 2-FinFET-Pixel mit einem FG-Speicher-/Sensorknoten durch 16-nm-FinFET-CMOS-Technologien
Während der Injektion treten sowohl die Emission von Sekundärelektronen (SE) als auch Rückstreuelektronen (BSE) auf. SE sind die Elektronen, die durch inelastische Streuung der Oberfläche aus dem Targetmaterial herausgeschleudert werden, während BSE die Elektronen des Primärstrahls sind, die das Targetmaterial injiziert und dann unter großen Winkeln elastisch ausgestreut haben [22]. Daher könnte dem belichteten Pixel durch den obigen Effekt eine positive Ladung zugeführt werden, diese positive Ladung könnte mit der gespeicherten negativen Ladung rekombiniert werden. Im Allgemeinen ist das Nettopotential des Speicherknotens in dieser Studie negativ, da der SE-Emissionskoeffizient, der als das Verhältnis zwischen dem SE-Strom und dem Primärelektronenstrom definiert ist, der meisten Metallarten für eine Energie größer als kleiner als 1 ist 5 keV [23]. Daher können sowohl positive als auch negative Ladungen in der Pixeleinheit gespeichert werden, und beide spiegeln sich im Auslesestrom wider.
Experimentelle Ergebnisse und Diskussion
Die Flugbahn des injizierten Elektronenstrahls kann durch die Monte-Carlo-Simulationsergebnisse [24] geschätzt werden, da die Daten in Abb. 3a zeigen, dass der Elektronenstrahl mit höherer Beschleunigungsenergie voraussichtlich tiefer wandert; Daher erhöhen sich die Sammeleffizienz sowie die Anzahl der Elektronen, die durch die Waferoberfläche zum vorgeschlagenen Detektor durchdrungen sind, für Elektronen mit höherer Energie (zwischen 0 und 30 keV) als die Simulationsdaten in Abb. 3b vorgeschlagen. Bei einer Elektronenstrahlenergie von mehr als 30 keV dringen die meisten Elektronen in das Siliziumsubstrat ein, wodurch die FG-Sammeleffizienz verringert wird. Die Sammeleffizienz (\(\upeta\)) ist wie folgt definiert:
$$\eta =\frac{{Q}_{FG}}{{Q}_{total}},$$ (1)wobei \({Q}_{FG}\) für die im FG gesammelte und gespeicherte Ladung steht und \({Q}_{total}\) die Gesamtzahl der injizierten Elektronen aus dem angelegten Elektronenstrahl darstellt.
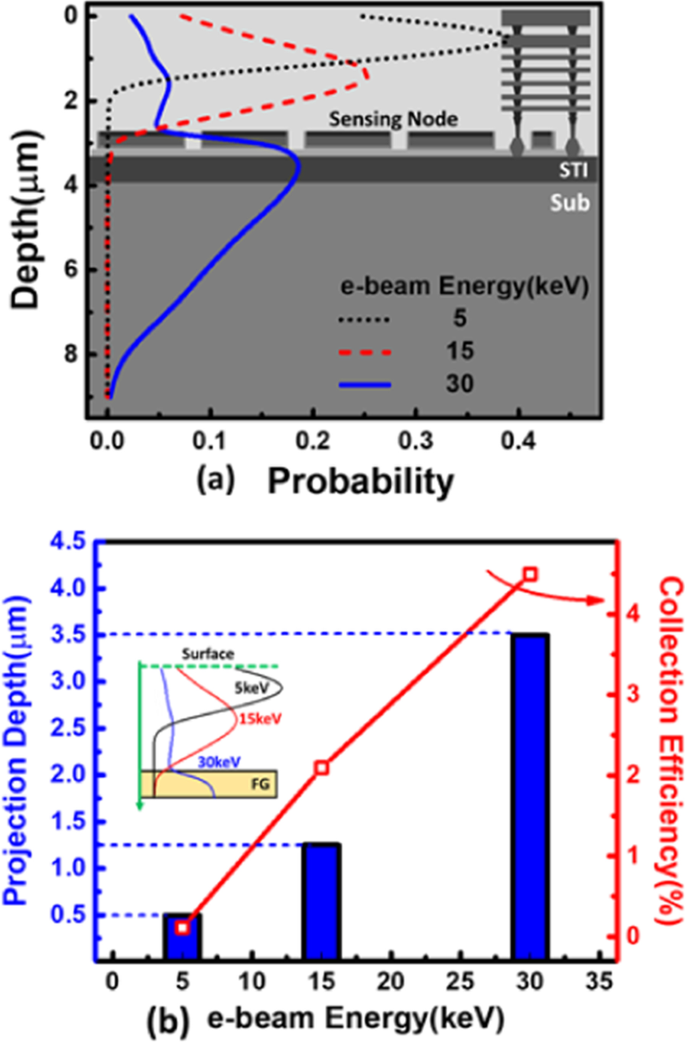
a Monte-Carlo-Simulationsergebnisse der projizierten Flugbahn des injizierten Elektrons mit unterschiedlicher Beschleunigungsenergie und b die entsprechende Projektionstiefe und Eindringwahrscheinlichkeit auf das Detektor-Array auf dem Wafer
Gemäß den Simulationsergebnissen in Abb. 3 wird erwartet, dass der Elektronenstrahl einige Mikrometer durchdringt und zurücklegt, und die Elektronengeschwindigkeit vor der Injektion kann bei einer Energie von 10 keV bis zu 6 cm/ns erreichen [25], die Reaktionszeit liegt schätzungsweise im µsec-Bereich [26], was eine Reaktion auf schnell scannende E-Strahlen ermöglicht.
Vor der Elektronenstrahlbelichtung in der Kammer wird die FG-Ladung (QFG ) aus den Prozessschritten der Halbleiterherstellung [27, 28] muss ausgeräumt werden. Hier wird ein Initialisierungsschritt durch Backen der Detektorchips bei 250 Grad Celsius durchgeführt, da die Messdaten, die in Fig. 4a bestätigt werden, die BL-Stromverteilung enger werden, wenn die zufällig platzierte Ladung entfernt wird. Der gesamte BL-Auslesestrom wird nach der Initialisierung niedriger als 0,1 pA, wie in Fig. 4b angeordnet, was darauf hindeutet, dass die FG-Ladung effektiv entleert werden kann.

a Die Verteilung des BL-Stroms wird nach dem Backen bei 250 °C für mehr als 100 k Sekunden enger und b das kumulative Diagramm zeigt eine Konvergenz des Lesestroms auf unter 0,1 pA an, wodurch QFG . weiter sichergestellt wird ist ausgeräumt
Die BL-Stromverteilung der Pixel in ihren initialisierten Zuständen und die nach zunehmender Elektronenstrahlstrahlung bei einer festen Energie von 30 keV ist in Abb. 5 dargestellt. Die Messdaten zeigen, dass der BL-Strom mit größerer Elektronenstrahldosis ansteigt. Die vom Detektor gesammelten injizierten Elektronen laden FG auf einen bestimmten negativen Vorspannungspegel auf, der die p-Kanal-FG-Transistoren allmählich einschaltet, was zu größeren Auslese-BL-Strömen führt. Darüber hinaus implizieren die gemessenen Daten, dass im Bereich von mehreren Größenordnungen noch Platz vorhanden ist, bevor der BL-Strom in die Sättigung eintritt, was ihn für die Erfassung mit breitem Dynamikbereich geeignet macht.

Die Verteilung der vorgeschlagenen Detektoren im initialisierten Zustand und nach der E-Beam-Exposition mit zunehmender Dosis bei einem festen Energieniveau von 30 keV
Wie die Messdaten in Abb. 6 zeigen, korreliert die ausgelesene BL-Stromverschiebung positiv mit der Beschleunigungsenergie des angelegten Elektronenstrahls, was von den Simulationsergebnissen in Abb. 3 erwartet wird. Die Validierung des vorgeschlagenen Detektors kann die Charakteristiken genau widerspiegeln der injizierten Elektronenstrahldosis und der Beschleunigungsenergie. Mit einer hohen räumlichen Auflösung von 700 nm im Abstand der Erfassungsebene kann dieser Detektor auch eine minimale Erfassungs-E-Strahl-Dosis von 24 μC/cm 2 . demonstrieren bei 5 keV.
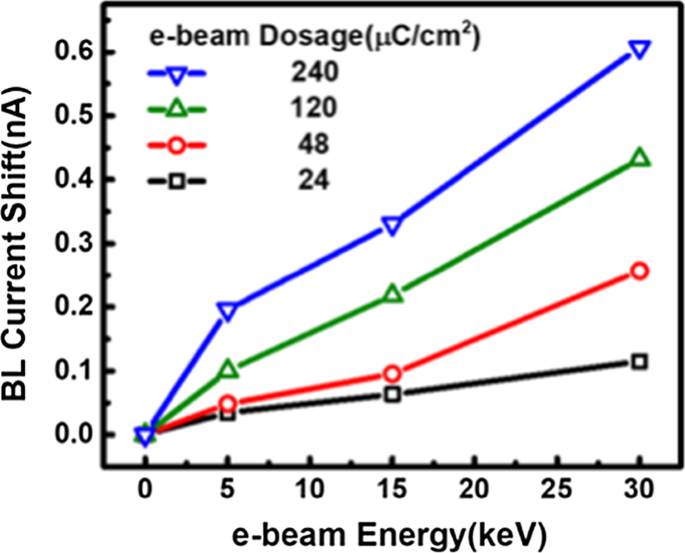
Die injizierte Dosis und ihre Beschleunigungsenergie können durch den resultierenden BL-Strom des E-Beam-belichteten Arrays genau reflektiert werden
Die zweidimensionalen Bilder auf den 8 × 8-Testarrays sind in Abb. 7 gezeigt, nach einem 30 keV-Elektronenstrahl mit einer Dosis von 0,2 μC/cm 2 , 0,6 μC/cm 2 und 1μC/cm 2 verglichen werden.

Die zweidimensionalen Bilder nach 30 keV-E-Strahl-Belichtung mit einer Dosis von a 0,2μC/cm 2 , b 0,6μC/cm 2 und c 1μC/cm 2 , bzw.
Der vorgeschlagene Elektronenstrahldetektor zeichnet sich nicht nur durch ein lineares und hohes Ansprechen auf Dosis und Beschleunigungsenergie aus, auch die Fähigkeit zur In-Pixel-Datenspeicherung ist eine seiner einzigartigen Eigenschaften. Wie die Daten in Abb. 8 zeigen, kann die durch die E-Beam-Exposition induzierte BL-Stromverschiebung bei 85 °C tagelang relativ stabil bleiben; Daher können die Ergebnisse der E-Beam-Erkennung ohne externe Stromversorgung im Speicherknoten verbleiben, was die anschließende elektrische Offline-Auslesung durch automatische Messsysteme ermöglicht.

Die Ergebnisse der Elektronenstrahlerfassung können im vorgeschlagenen Detektor gespeichert werden und die Daten bleiben tagelang relativ stabil, was das Offline-Auslesen auf dem Wafer ermöglicht
Das in Abb. 9 durchgeführte Experiment impliziert, dass die Sammeleffizienz des vorgeschlagenen Elektronenstrahldetektors leicht abnimmt, wenn das Nachbarpixel bereits geladen ist. Aufgrund des negativen Potentials benachbarter Pixel erfahren die Elektronen während der Injektion eine abstoßende Kraft; daher müssen Muster und Array-Design berücksichtigt werden, um einen solchen Musterschnittstelleneffekt zu reduzieren.
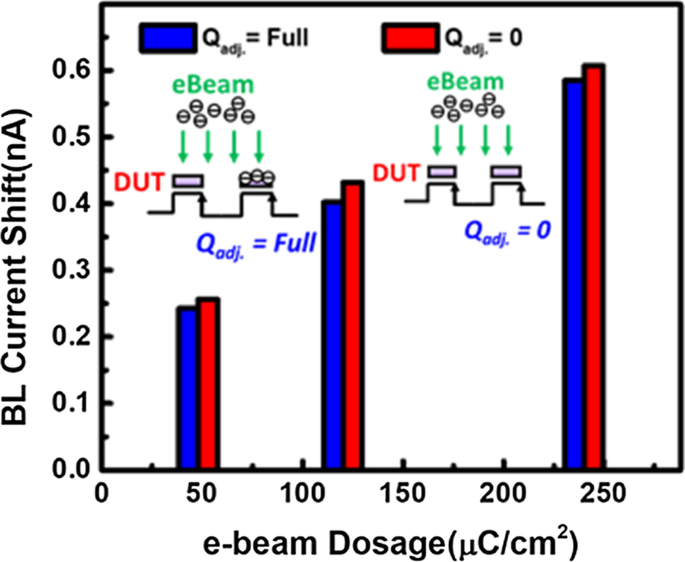
Es wurde festgestellt, dass die Sammeleffizienz durch ein vollständig gespeichertes Floating-Gate auf den benachbarten Zellen leicht reduziert wird, wo ein gewisser Musterinterferenzeffekt erwartet wird
Schlussfolgerungen
In dieser Arbeit wird ein werkzeuginternes On-Wafer-Elektronenstrahldetektor-Array mit FinFET-CMOS-Logikkompatibilität, großem Dynamikbereich und hoher Ansprechempfindlichkeit vorgestellt. Die einzigartige kompakte 2 T-Pixelstruktur kann die räumliche Auflösung mit einem Pixelabstand im Submikrometerbereich verbessern. Die projizierten Elektronenstrahlabbildungs- und Detektionsergebnisse können ohne externe Stromversorgung nichtflüchtig im Erfassungs-/Speicherknoten des vorgeschlagenen neuartigen Elektronenstrahldetektors gespeichert werden, was eine elektrische Offline-Auslesung ermöglicht. Schließlich wird angenommen, dass das vorgeschlagene Elektronenstrahldetektor-Array die vielversprechende Lösung zur Verbesserung der Stabilität zukünftiger Elektronenstrahllithographiesysteme und -prozesse ist.
Verfügbarkeit von Daten und Materialien
Nicht zutreffend.
Nanomaterialien
- Die 3 wichtigsten Möglichkeiten der Bluetooth Low Energy (LE)- und XLE-Technologie für die Verfolgung von Industrieanlagen
- IBM-Forscher nehmen Innovationspreis für Halbleiterforschung mit nach Hause
- Nutzung von Galliumphosphat für die Informationstechnologie der Zukunft
- Nachhaltigkeit sollte die nächste große Priorität für die drahtlose Technologie sein
- Das Design der Emissionsschicht für Elektronenvervielfacher
- Fortschritte bei eisenoxidbasierten Nanostrukturen für Anwendungen in der Energiespeicherung
- IoT-Technologie für den Energiesektor:Eine signifikante Transformation
- Einsatz von IIoT-Technologie zur Überwachung des Energieverbrauchs
- Laserdrucktechnologie für wasserdichte E-Textilien
- Ericsson:5G für die Fertigung



