Atomschichtabscheidung von Indiumoxid-Nanoschichten für Dünnschichttransistoren
Zusammenfassung
Atomlagenabscheidung (ALD) von In2 O3 Nanofilme wurden mit Cyclopentadienylindium (InCp) und Wasserstoffperoxid (H2 .) untersucht O2 ) als Vorläufer. Die In2 O3 Filme können bevorzugt bei relativ niedrigen Temperaturen von 160–200 °C abgeschieden werden und zeigen eine stabile Wachstumsrate von 1.4–1.5 Å/Zyklus. Die Oberflächenrauhigkeit des abgeschiedenen Films nimmt mit der Abscheidungstemperatur allmählich zu, was der verbesserten Kristallisation des Films bei einer höheren Abscheidungstemperatur zugeschrieben wird. Wenn die Abscheidungstemperatur von 150 auf 200 °C steigt, wird die optische Bandlücke (Eg ) des abgeschiedenen Films steigt von 3,42 auf 3,75 eV. Außerdem verschiebt sich mit der Erhöhung der Abscheidungstemperatur das Atomverhältnis von In zu O im abgeschiedenen Film allmählich in Richtung des im stöchiometrischen In2 . O3 , und auch der Kohlenstoffgehalt nimmt nach und nach ab. Bei einer Abscheidungstemperatur von 200°C weist der abgeschiedene Film ein In:O-Verhältnis von 1:1,36 und keinen Kohlenstoffeinbau auf. Darüber hinaus leistungsstarkes In2 O3 Dünnschichttransistoren mit einem Al2 O3 Gate-Dielektrikum wurde durch Nachglühen in Luft bei 300 °C für eine angemessene Zeit erreicht, was eine Feldeffektmobilität von 7,8 cm 2 . demonstrierte /V⋅s, ein unterschwelliger Hub von 0,32 V/Dez und ein Ein-/Aus-Stromverhältnis von 10 7 . Dies wurde der Passivierung von Sauerstoffleerstellen im Gerätekanal zugeschrieben.
Hintergrund
Indiumoxid (In2 O3 ) ist ein transparenter Metalloxidhalbleiter, der eine große Bandlücke von ~3.7 eV bei Raumtemperatur, eine hohe Transparenz für sichtbares Licht und eine ausgezeichnete chemische Stabilität aufweist [1, 2]. Daher In2 O3 wurde für verschiedene Anwendungen wie Photovoltaik, elektrochemische Sensoren und Flachbildschirme untersucht [3,4,5]. Bisher wurden mehrere Abscheidungstechniken entwickelt, um In2 . herzustellen O3 Dünnschichten, einschließlich Sputtern [6, 7], Sol-Gel [8, 9] und chemische Gasphasenabscheidung (CVD) [10, 11]. Jedoch leiden die Sputter- und Sol-Gel-Techniken gewöhnlich an einer schlechten Gleichmäßigkeit über einen großen Bereich sowie an einer ungenauen elementaren Zusammensetzung; die CVD-Technik erfordert im Allgemeinen relativ hohe Abscheidungstemperaturen von> 300 °C. Diese Nachteile machen es schwierig, ein einheitliches In2 . zu erreichen O3 Film mit präziser Dicken- und Zusammensetzungskontrolle bei niedriger Abscheidungstemperatur.
In den letzten Jahren hat sich die Atomlagenabscheidung (ALD) als vielversprechender Ansatz herausgestellt, der eine ausgezeichnete Stufenabdeckung, eine kontrollierbare Dicke der atomaren Skala, eine gute Gleichmäßigkeit und eine relativ niedrige Abscheidungstemperatur liefern kann. Dementsprechend ist das Wachstum von In2 O3 Dünnfilme wurden mittels ALD mit verschiedenen Vorstufen untersucht, darunter InCl3 -H2 O [12], InCl3 -H2 O2 [13], InCp-O3 [14], InCp-O2 -H2 O [15] und In (CH3 )3 -H2 O [16]. In Bezug auf die Vorläufer von InCl3 -H2 O und InCl3 -H2 O2 , die Abscheidungstemperaturen für In2 O3 Filme müssen auf ~ 300–500 °C erhöht werden [13]; inzwischen die InCl3 Behälter sollte auf 285 °C erhitzt werden, um reichlich InCl3 . zu erhalten Dampf [15]. Darüber hinaus kann das Nebenprodukt von korrosivem HCl die ALD-Ausrüstung beschädigen und das abgeschiedene In2 . ätzen O3 Film [17] und die Wachstumsrate von In2 O3 ist nur 0,25–0,40 Å/Zyklus. Obwohl andere Vorläufer wie TMIn-H2 O und TMIn-H2 O2 wurden für ALD In2 . übernommen O3 Filmen sind die Abscheidungstemperaturen trotz relativ hoher Wachstumsraten (1,3–2 Å/Zyklus) immer noch hoch (d. h. 200–450 °C) [18].
In dieser Arbeit werden InCp und H2 O2 wurden als Vorläufer von ALD In2 . vorgeschlagen O3 Dünnschichten, also die In2 O3 Dünnfilme wurden erfolgreich bei niedrigeren Temperaturen abgeschieden und zeigten eine zufriedenstellende Wachstumsrate. Außerdem wurden die physikalischen und chemischen Eigenschaften der abgeschiedenen Filme charakterisiert. Außerdem ist die In2 O3 Dünnschichttransistoren (TFTs) mit ALD Al2 O3 Gate-Dielektrika wurden hergestellt, die eine gute elektrische Leistung demonstrieren, wie z. B. eine Feldeffektmobilität von 7,8 cm 2 V −1 s −1 , und ein Ein-/Aus-Stromverhältnis von 10 7 usw.
Experimentell
Si(100)-Wafer wurden unter Verwendung des Standardverfahrens der Radio Corporation of America gereinigt und dienten als Ausgangssubstrate. In2 O3 Dünnschichten wurden auf den vorgereinigten Si(100)-Substraten unter Verwendung der ALD-Ausrüstung (Wuxi MNT Micro Nanotech Co., LTD, China) bei relativ niedrigen Temperaturen von 150–210 °C abgeschieden, wobei die Temperaturen von InCp (Fornano Electronic Technology Co., LTD, China, Verunreinigung:99,999 %) und H2 O2 (30% wässrige Lösung) Vorläufer wurden bei 130 bzw. 50 °C gehalten. Als Spülgas wurde Stickstoffgas verwendet. Zur Demonstration der Funktion des ALD In2 O3 Dünnschicht, die In2 O3 -basierte Kanal-TFTs wurden wie folgt hergestellt. Zuerst ein 38-nm-Al2 O3 Gatedielektrikumsfilm wurde auf einem vorgereinigten p-Typ Si (100) Substrat (< 0,0015 Ω·cm) bei 200 °C durch ALD unter Verwendung von Trimethylaluminium und H2 . gezüchtet O, und ein solches Siliziumsubstrat mit niedrigem spezifischen Widerstand diente als das Backgate. Dann ein 20-nm-In2 O3 Kanalschicht wurde auf dem Al2 . aufgewachsen O3 bei 160 °C filmen. Source/Drain-Kontakte von Ti/Au (30 nm/70 nm) Stapeln wurden wiederum durch optische Lithographie, Elektronenstrahlverdampfung und einen Lift-Off-Prozess gebildet. Schließlich wurden die hergestellten Bauelemente bei 300 °C an Luft für verschiedene Zeiten getempert.
Kristallinität, Oberflächenmorphologie, elementare Zusammensetzung, Absorptionskoeffizient und Dicke des In2 O3 Filme wurden durch Röntgenbeugung (XRD) (Bruker D8 Discover), Rasterkraftmikroskopie (AFM) (Bruker Icon), Röntgen-Photoelektronenspektroskopie (XPS) (Kratos Axis Ultra DLD), Ultraviolett-Vis-Spektroskopie (UV- VIS) bzw. Ellipsometer (Sopra GES-SE, Frankreich). Die elektrischen Messungen der Geräte wurden unter Verwendung eines Halbleiterparameteranalysators (B1500A, Agilent Technologies, Japan) mit Cascade-Sondenstation in Umgebungsluft bei Raumtemperatur durchgeführt.
Ergebnisse und Diskussion
Abbildung 1a zeigt die Wachstumsrate des In2 O3 Film als Funktion der Substrattemperatur. Es wurde festgestellt, dass eine stabile Wachstumsrate von ~ 1,46 Å/Zyklus im Bereich von 160 ~ 200 °C erreicht wird, was eine schnelle Wachstumsrate und ein wohldefiniertes Temperaturfenster für ALD In2 . offenbart O3 Filme. Wenn die Substrattemperatur auf 150 °C gesenkt oder auf 210 °C erhöht wurde, wurde die resultierende Wachstumsrate größer [19, 20]. Ersteres wird auf die Kondensation von InCp auf dem Substrat zurückgeführt, während letzteres auf die thermische Zersetzung von InCp bei einer höheren Temperatur zurückzuführen ist. Darüber hinaus ist die Entwicklung des abgelagerten In2 O3 Die Filmdicke wurde als Funktion der ALD-Zyklen bewertet, wie in Fig. 1b gezeigt. Es ist klar, dass die In2 O3 Die Filmdicke nimmt linear mit der Anzahl der Abscheidungszyklen zu, was auf ein ziemlich gleichmäßiges Wachstum hinweist.

a Wachstumsrate von ALD In2 O3 Film auf dem Si-Substrat als Funktion der Substrattemperatur und b Abhängigkeit des In2 O3 Schichtdicke von der Anzahl der ALD-Zyklen bei 160 °C
Um die Entwicklung des In2 . zu beobachten O3 Filmtextur mit Abscheidungstemperatur, die XRD-Muster des In2 O3 Bei unterschiedlichen Temperaturen abgeschiedene Filme sind in Abb. 2 dargestellt. Wenn die Abscheidungstemperatur 160 °C nicht überschreitet, kann kein Beugungspeak beobachtet werden. Dies zeigt an, dass das hinterlegte In2 O3 Filme bei niedrigeren Temperaturen sind amorph. Wenn die Abscheidungstemperatur auf 170 °C ansteigt, beginnen einige Beugungspeaks zu erscheinen. Wenn die Abscheidungstemperatur allmählich auf 210°C ansteigt, nehmen die Beugungspeak-Intensitäten dramatisch zu, typischerweise gezeigt durch die Peaks bei 2θ = 30,3° und 35,4°. Dies weist darauf hin, dass die Kristallinität und Korngröße des abgeschiedenen In2 O3 Film werden mit zunehmender Abscheidungstemperatur allmählich verstärkt. Abbildung 3 zeigt die Oberflächenmorphologien des repräsentativen In2 O3 Filme, die bei unterschiedlichen Temperaturen abgeschieden wurden. Es wurde festgestellt, dass die Filmoberfläche mit zunehmender Abscheidungstemperatur rauer und rauer wird, d. h. die resultierende quadratische Mittelwert-(RMS)-Rauhigkeit steigt von 0,36 auf 1,15 nm mit einer Erhöhung der Abscheidungstemperatur von 160 auf 210°C. Dies sollte mit der Kristallinität des In2 . zusammenhängen O3 Film. Bezogen auf die Abscheidungstemperatur von 160 °C ist das abgeschiedene In2 O3 Der Film ist amorph und weist eine sehr glatte Oberfläche auf. Wenn die Abscheidungstemperatur 180 °C erreicht, wird der abgeschiedene Film polykristallin. Dies bedeutet, dass der resultierende Film viele kristalline Körner enthält und die Korngrößen mit zunehmender Abscheidungstemperatur immer größer werden, wie in Abb. 2 gezeigt. Dies stimmt gut mit unserer Beobachtung überein, dass die Größe der Hügel auf der Filmoberfläche mit steigender Abscheidungstemperatur allmählich ansteigen, was zu einem erhöhten RMS-Wert führt.
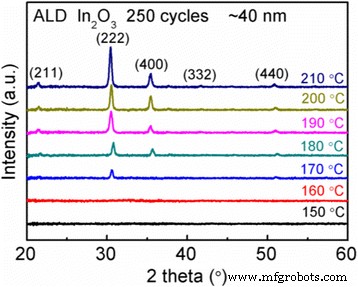
Röntgenbeugungsmuster des In2 O3 Filme, die bei verschiedenen Temperaturen für 250 Zyklen abgeschieden wurden

Die AFM-Bilder der In2 O3 Filme, die bei verschiedenen Temperaturen abgeschieden wurden:a 160 °C, b 180 °C, c 200 °C und d 210 °C. Die Abscheidungszyklen wurden für jeden Film auf 250 festgelegt
Abbildung 4 zeigt hochaufgelöste C 1 s, In 3d und O1s XPS Spektren des In2 O3 Filme, die bei unterschiedlichen Temperaturen abgeschieden wurden. Bezüglich der in Abb. 4a gezeigten C 1 s XPS-Spektren zeigt der bei 160 °C abgeschiedene Film einen Peak bei 289,8 eV, der C-O entsprechen sollte [21]. Wenn die Abscheidungstemperatur auf 180 °C erhöht wird, wird der Peak viel schwächer. Ferner verschwindet der C 1 s-Peak in Bezug auf die Abscheidungstemperatur von 200°C. Somit wird angezeigt, dass die Verunreinigung von C in dem abgeschiedenen In2 . umso geringer ist, je höher die Abscheidungstemperatur ist O3 Film. Abbildung 4b zeigt die In 3d XPS-Spektren des In2 O3 Filme, die eindeutig Ein-Dublett-Gaußsche Peaks bei 444,7 und 452,3 eV zeigen, die mit In 3d5/2 . assoziiert sind und In 3d5/2 Kernstufen für In2 O3 [22, 23]. Die O 1 s XPS-Spektren sind in Abb. 4c dargestellt. Es wurde festgestellt, dass das O 1 s-Spektrum für jede Probe gut in drei Peaks unterteilt werden kann, die bei 529,8, 531,0 bzw. 532,0 eV liegen. Diese Peaks entsprechen O 2− metallgebundene Ionen (O1), Sauerstoffleerstellen (O2) bzw. –OH/CO (O3) [24, 25]. Wenn die Abscheidungstemperatur von 160 auf 200 °C steigt, steigt der relative Anteil von O1 von 76 auf 92 %; und der relative O2-Anteil sinkt allmählich von 16 auf 4 %. Auch der relative Anteil von O3 weist einen rückläufigen Trend auf. Diese Ergebnisse zeigen, dass eine höhere Abscheidungstemperatur vorteilhaft ist, um die Konzentration von Sauerstoffleerstellen im abgeschiedenen Film sowie von Hydroxylgruppen und C-O-Bindungen zu reduzieren. Außerdem sind die elementaren Zusammensetzungen des In2 O3 Bei verschiedenen Temperaturen abgeschiedene Filme sind in Tabelle 1 aufgeführt. Interessanterweise nimmt das Atomverhältnis von In/O in dem abgeschiedenen Film mit steigender Abscheidungstemperatur graduell ab. Aber auch für das reine In2 O3 Bei 200 °C abgeschiedenen Films ist das Atomverhältnis (1:1.36) von In/O immer noch größer als das (1:1.5) des stöchiometrischen In2 O3 . Dies zeigt, dass die ALD In2 O3 Film ist im Allgemeinen reich an Sauerstoffleerstellen.

Hohe Auflösung a C 1s, b In 3d und c O 1 s XPS-Spektren des In2 O3 Filme, die bei 160, 180 bzw. 200 °C abgeschieden wurden. Um zufällige Oberflächenverunreinigungen zu entfernen, wurden alle Proben vor der Signalerfassung 6 min lang mit Ar-Ionenbeschuss in situ geätzt.
Abbildung 5a zeigt die Variation von (αhν) 2 als Funktion der Photonenenergie für das abgeschiedene In2 O3 Filme bei unterschiedlichen Abscheidungstemperaturen. Die optische Bandlücke (Eg ) der In2 O3 Film kann durch die Tauc-Beziehung bestimmt werden:αhν = A(hν-Eg ) n [26], wobei α ist der Absorptionskoeffizient, A ist eine Konstante, h ist die Plank-Konstante, ν ist die Frequenz und der Exponent n charakterisiert die Natur des Bandübergangs. Hier, n = 1/2, was anzeigt, dass In2 O3 ist ein Halbleiter mit einem direkt erlaubten Übergang. E g wird durch Extrapolieren des geraden Linienabschnitts auf die Energieabweichung bei α . extrahiert = 0 Das extrahierte E g für die In2 O3 Film ist in Fig. 5b gezeigt. Es ist zu sehen, dass E g steigt von 3,42 auf 3,75 eV an, wenn die Abscheidungstemperatur von 150 auf 200 °C erhöht wird. Das erhöhte E g bei höheren Abscheidungstemperaturen könnte aus der Verringerung von Sauerstoffleerstellen und C-Verunreinigungen in dem abgeschiedenen Film resultieren. Tatsächlich berichteten andere Forscher auch, dass, wenn viele Sauerstoffleerstellen in ZnO existierten, die Verunreinigungen stärker delokalisiert wurden und mit der Valenzbandkante überlappten, was zu einer Verengung der Bandlücke führte [27]. Darüber hinaus könnte die allmählich erhöhte Kristallinität als Funktion der Abscheidungstemperatur die optische Bandlücke des In2 . beeinflussen O3 Film. Dies lässt sich wie folgt erklären. Wenn die Abscheidungstemperatur ansteigt, wird die Korngröße des abgeschiedenen In2 O3 Film nimmt zu, wie in Abb. 2 dargestellt. Dies führt somit zu einer Abnahme der Dichte der Korngrenzen im Film. Da Elektronen leicht in den Korngrenzen gefangen werden, sollte die Zahl der freien Elektronen im In2 . zunehmen O3 Film mit weniger Korngrenzen [28, 29]. Daher führt eine solche erhöhte Elektronenkonzentration aufgrund der Burstein-Moss-Verschiebung zu einer größeren optischen Bandlücke [30].

a Darstellung von (αhν) 2 vs Photonenenergie für In2 O3 bei unterschiedlichen Temperaturen abgeschiedene Filme; b Abhängigkeit der extrahierten Bandlücke (Eg ) von In2 O3 auf Abscheidungstemperatur
Zur Demonstration der Funktion des ALD In2 O3 Film, der als TFT-Kanal fungiert, der In2 O3 -kanalbasierte TFTs mit auf Atomschichten abgeschiedenem Al2 O3 Gate-Dielektrika wurden hergestellt. Abbildung 6a zeigt die Übertragungseigenschaften von In2 O3 TFTs. Es zeigt sich, dass die werksseitig hergestellte Vorrichtung nicht die für Feldeffekttransistoren typischen Schalteigenschaften aufweist, sondern eine leiterartige zwischen Source und Drain. Dies sollte auf das Vorhandensein vieler Sauerstoff-Leerstellen in der In2 . zurückgeführt werden O3 Kanal, weil Sauerstoff-Leerstellen freie Elektronen liefern können. Um die Konzentration von Sauerstoffleerstellen im In2 . zu reduzieren, O3 Kanal wurde bei 300 °C an Luft nachgeglüht. Es ist klar, dass die In2 O3 TFT zeigt ein typisches Schaltverhalten nach 2-h-Annealing. Dies weist darauf hin, dass das Nachglühen an Luft die Geräteleistung signifikant verbessern kann. Wenn die Glühzeit allmählich auf 10 h ansteigt, wird die Schwellenspannung (Vth ) des TFT verschiebt sich in Richtung positiver Vorspannung, und der Unterschwellenhub (SS) verbessert sich nach und nach. Wenn die Glühzeit jedoch auf 11 h ansteigt, beginnt die Geräteleistung zu degenerieren. Es ist anzumerken, dass Wasserstoff während des Herstellungsprozesses in den Film eingebaut werden kann und als Elektronenfalle wirkt, indem er –OH-Bindungen im Kanal oder an der Grenzfläche zwischen Kanal und Dielektrikum bildet [31]. Diese Elektronenfallen führen möglicherweise zum Abbau von SS. Nach dem Tempern an Luft wurden die OH-Bindungen durch Einbau von O2 . reduziert Moleküle [32]. Dies könnte zu einer Verringerung der Fallendichte führen, wodurch die SS des Geräts verbessert wird. In Bezug auf 10 h Glühen an Luft ist das In2 O3 TFT zeigt eine Feldeffektmobilität (μEF ) von 7,8 cm 2 V −1 s −1 , ein Vte von -3,7 V, einen SS von 0,32 V/dez und ein Ein/Aus-Stromverhältnis (Iein /Iaus ) von 10 7 . Die entsprechenden Ausgangskennlinien sind auch in Fig. 6b dargestellt, die ein klares Abschnür- und Stromsättigungsverhalten bei verschiedenen positiven Gatespannungen zeigen. Darüber hinaus zeigen die Ausgangskurven auch ein n -Typ-Verbesserungsmodus. Zum Vergleich fasst Tabelle 2 die Eigenschaften der gemeldeten ALD In2 . zusammen O3 Filme und TFTs aus verschiedenen Forschungsgruppen [33,34,35,36,37]. Es ist nachgewiesen, dass unser In2 O3 Film zeigt eine überlegene Wachstumsrate bei einer relativ niedrigen Temperatur, und die hergestellte Vorrichtung weist auch einen kleinen SS auf. Die allgemeine Leistung des Geräts ist jedoch nicht so perfekt, was durch einige Prozess- und Gerätestrukturoptimierungen verbessert werden könnte.
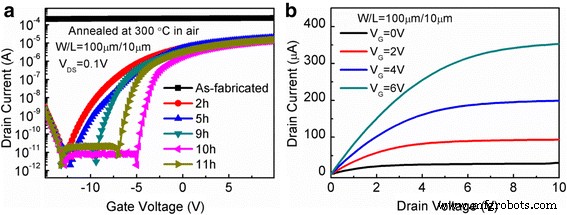
a Übertragungseigenschaften des In2 O3 TFTs, die bei 300 °C in Luft für unterschiedliche Zeit getempert wurden; b Ausgangscharakteristik des In2 O3 TFT getempert bei 300 °C in Luft für 10 h
Um den Einfluss des Nachglühens in Luft auf die Zusammensetzung des In2 . gut zu verstehen O3 Kanal, der In2 O3 Filme wurden unterschiedlich lange bei 300 °C getempert und anschließend mittels XPS analysiert. Tabelle 3 listet die elementaren Prozentsätze verschiedener getemperter Filme auf. Mit zunehmender Temperzeit von 2 auf 11 h sinkt das Atomverhältnis von In:O von 1:1,22 auf 1:1,48 und nähert sich allmählich dem (1:1,5) des stöchiometrischen In2 O3 . Dies bestätigt weiter, dass eine längere Glühzeit an Luft die Dichte der Sauerstoffleerstellen im In2 . effektiv reduziert hat O3 Film. Daher ist die Verbesserung der Leistung des In2 O3 TFT ist hauptsächlich auf die Passivierung von Sauerstoffleerstellen zurückzuführen, die sich im Bulk-Kanal und/oder der Grenzfläche zwischen Kanal und Dielektrikum befinden könnten [25]. Das übermäßige Tempern verschlechterte jedoch die Leistung der Vorrichtung, wie durch 11-stündiges Tempern gezeigt wurde. Dies könnte auf die Kristallisationsänderung des In2 . zurückgeführt werden O3 Kanalschicht sowie mögliche Oxidation von Ti-Elektroden beim überflüssigen Nachglühen an Luft. Daher ist eine angemessene Temperzeit erforderlich, um eine gute Leistung des In2 . zu erreichen O3 TFT.
Schlussfolgerungen
Das schnelle ALD-Wachstum des In2 O3 Filme wurden bei relativ niedrigen Temperaturen (160–200 °C) mit InCp und H2 . hergestellt O2 Vorstufen mit einer einheitlichen Wachstumsrate von 1,46 Å/Zyklus. Mit steigender Abscheidungstemperatur wurde die Kristallisation des abgeschiedenen Films allmählich verstärkt. Unterdessen wurden sowohl Sauerstoffleerstellen als auch Kohlenstoffverunreinigungen in den abgeschiedenen Filmen ebenfalls signifikant reduziert. Dies führte somit zu einem Anstieg des E g von In2 O3 . Mit dem ALD In2 O3 Kanalschicht, die TFTs mit einem ALD Al2 O3 Dielektrikum hergestellt. Da die Zeit nach dem Glühen in Luft verlängert wurde, wurde die elektrische Leistung des In2 O3 TFT wurde bis 10 h Annealing deutlich verbessert. Dies ist hauptsächlich auf die Passivierung von Sauerstoffleerstellen im Volumenkanal und/oder der Grenzfläche zwischen dem Kanal und dem Dielektrikum nach dem Tempern an Luft zurückzuführen. In Bezug auf eine 10-stündige Ausheilung zeigte das Gerät eine gute Leistung, wie z. B. eine Feldeffektmobilität von 7,8 cm 2 . /V⋅s, ein unterschwelliger Hub von 0,32 V/Dez und ein Ein-/Aus-Stromverhältnis von 10 7 . Bezogen auf eine Abscheidungstemperatur von 200 °C weist der abgeschiedene Film ein In:O-Verhältnis von 1:1,36 ohne nachweisbaren Kohlenstoff auf, was die Existenz von Sauerstoffleerstellen in dem abgeschiedenen Film offenbart.
Nanomaterialien
- Luftabstandshalter für 10-nm-Chips
- Advanced Atomic Layer Deposition Technologies für Mikro-LEDs und VCSELs
- Hochreflektierende Dünnschicht-Optimierung für Vollwinkel-Mikro-LEDs
- Auswirkung verschiedener Bindemittel auf die elektrochemische Leistung einer Metalloxidanode für Lithium-Ionen-Batterien
- Mesoporöse Nickeloxid (NiO)-Nanoblätter für die hochempfindliche Glukosemessung
- Eine nanokristalline Fe2O3-Filmanode, hergestellt durch gepulste Laserabscheidung für Lithium-Ionen-Batterien
- Polarisationsunempfindlicher Oberflächenplasmonen-Polarisations-Elektroabsorptionsmodulator auf Basis von Epsilon-nahezu Null Indiumzinnoxid
- Entwicklung von elektrogesponnenem Chitosan-Polyethylenoxid/Fibrinogen-Biokomposit für potenzielle Wundheilungsanwendungen
- Das anionische Tensid/ionische Flüssigkeiten mit interkaliertem reduziertem Graphenoxid für Hochleistungs-Superkondensatoren
- Dünnschicht-Hochfrequenz-Antennenarray für die drahtlose Kommunikation



