Erste-Prinzip-Studie von Punktdefekten in GaAs/AlAs-Übergittern:die Phasenstabilität und die Auswirkungen auf die Bandstruktur und Trägermobilität
Zusammenfassung
Hochentwickelte Halbleiter-Übergitter spielen eine wichtige Rolle in kritischen zukünftigen Hightech-Anwendungen wie der Luft- und Raumfahrt, der Hochenergiephysik, der Gravitationswellendetektion, der Astronomie und nuklearbezogenen Bereichen. Unter solch extremen Bedingungen, wie Umgebungen mit starker Strahlung, neigen diese Halbleiter-Übergitter dazu, verschiedene Defekte zu erzeugen, die letztendlich zum Ausfall der Vorrichtungen führen können. In Übergittern wie GaAs/AlAs sind jedoch die Phasenstabilität und der Einfluss von Punktdefekten auf die Bauelementleistung bis heute nicht klar. Die vorliegenden Berechnungen zeigen, dass in GaAs/AlAs-Übergittern die Antistellendefekte energetisch günstiger sind als Leerstellen und Zwischengitterdefekte. Das AsX (X =Al oder Ga) und XAs Defekte induzieren immer die Metallizität des GaAs/AlAs-Übergitters und GaAl und AlGa Antisite-Defekte haben leichte Auswirkungen auf die elektronische Struktur. Für GaAs/AlAs-Übergitter mit Zwischengitter- oder Leerstellendefekten wird eine signifikante Verringerung der Bandlücke oder der induzierten Metallizität gefunden. Weitere Rechnungen zeigen, dass die Zwischengitter- und Leerstellendefekte die Elektronenmobilität deutlich reduzieren, während die Antistellendefekte relativ kleinere Einflüsse haben. Die Ergebnisse verbessern das Verständnis der Strahlungsschädigungseffekte des GaAs/AlAs-Übergitters und bieten somit eine Anleitung für den Entwurf hochstabiler und langlebiger elektronischer und optoelektronischer Halbleiter auf Halbleiter-Übergitterbasis für Anwendungen in extremen Umgebungen.
Hintergrund
Das Superlattice (SL) ist ein künstliches Material, das aus abwechselnd dünnen Schichten aus zwei oder mehr unterschiedlichen Komponenten besteht. Die (GaAs)n /(AlAs)m ist eine der wichtigsten SL seit der Entwicklung von High Electron Mobility Transistors (HEMT) und Quantenkaskadenlasern (QCLs) vor einigen Jahrzehnten [1,2,3,4,5,6]. Vor kurzem mit den Fortschritten der Filmepitaxie und Nanofabrikationstechniken, die (GaAs)n /(AlAs)m basierte SLs und Nanogeräte mit (n + m) im Bereich von 2 bis 10 haben aufregende physikalische Eigenschaften in Bezug auf Lumineszenz und optische Absorption, Zwei-Phonon-Absorption und Raman- sowie Infrarotspektren gezeigt, die somit vielversprechende Anwendungen in der Optoelektronik, Sensorik, LED-, Energie- und Laser-bezogene zivile und industrielle Bereiche [7,8,9,10,11,12]. Bei anderen kritischen High-Tech-Anwendungen wie Luft- und Raumfahrt, Hochenergiephysik, Gravitationswellendetektion, Astronomie, Raumfahrt, nuklearen und sicherheitsrelevanten Bereichen sind die Halbleiter-SLs und -geräte unterschiedlichen Strahlungsumgebungen ausgesetzt, z. Strahlen, Neutronen, Elektronen, Ionen usw., die zur Erzeugung von Defekten führen können, die Verunreinigungen, Leerstellen, Zwischengitterplätze, Antistellen und Komplexe davon enthalten. Da die Halbleitermaterialien und die damit verbundenen physikalischen Eigenschaften eine wichtige Rolle beim Betrieb und Funktionieren dieser elektronischen Geräte und integrierten Schaltkreise spielen, können kleine Mengen von Defekten ihre optischen und Transporteigenschaften drastisch verändern, insbesondere in Mehrschichtsystemen [13].
Die Auswirkungen von Fremdverunreinigungen oder intrinsischen Defekten auf die Halbleiter-SLs und ihre Komponentenmaterialien wurden in den letzten Jahrzehnten umfassend untersucht. Zolloet al. haben die Methode der Dichtefunktionaltheorie (DFT) verwendet, um die Stabilität von Punktdefekten in GaAs zu untersuchen, und fanden heraus, dass die Antisite-Defekte günstiger waren [14]. Kahalyet al. haben die GaAs/AlAs SL-Struktur durch die DFT-Methode untersucht und die Arsen-Leerstelle (VAs ) Defekt an und nahe der Grenzfläche führte zu einem leitenden Quasi-2-DEG zwischen isolierendem Dielektrikum Arsenid [7]. Spasov et al. haben die Auswirkungen von Stickstoffverunreinigungen auf den Ladungsträgertransport und die Elektron-Loch-Rekombination in GaAs/AlAs-SL-Dioden untersucht [9]. Sie berichteten, dass die N-Verunreinigungen die Energie des elektronischen Minibands modifizierten und die Elektronendiffusion durch das SL-Miniband behinderten, was zu einer starken strahlenden Rekombination von Elektron-Loch-Paaren führen kann [9]. Wanget al. untersuchten die durch die Zn-Verunreinigung induzierte Interdiffusion in GaAs/AlAs SL-Strukturen unter Verwendung einer ab-initio Molekulardynamik (AIMD)-Methode [15]. Ihre Ergebnisse legten nahe, dass die Zn-Diffusion durch die Gruppe-III-Elemente unterstützt wurde, die in den interstitiellen Kanal geschleudert wurden und schnell diffundierten, wodurch das Übergitter ungeordnet wurde [15]. Mitra und Stark fanden, dass das Vorhandensein von Leerstellen die Ga/Al-Vermischung in GaAs/AlAs SL verstärkt, was auf den vorgeschlagenen Zweiatomring-Diffusionsmechanismus zurückzuführen ist [16]. Vor kurzem wurde eine AIMD-Simulation der Strahlungsantwort von GaAs/AlAs SL durchgeführt [17], in der die minimalen Energien für jedes Atom, das dauerhaft von seinem Gitterplatz verdrängt werden muss, bestimmt wurden, die Pfade für die Defekterzeugung angegeben wurden, und die Arten der erzeugten Fehler wurden identifiziert. Es zeigte sich, dass das erzeugte Ga (oder Al oder As) Frenkel-Paar und AsGa -GaAs Antisite-Paare haben tiefgreifende Auswirkungen auf die Dichte der Zustandsverteilung und die Bandstruktur von GaAs/AlAs SL [17].
Bisher sind die Stabilität von Punktdefekten in SL-Strukturen und die Transporteigenschaften wie Trägermobilität noch unbekannt. Daher ist es von entscheidender Bedeutung, zu untersuchen, wie das Vorhandensein von Leerstellen, Zwischengitter- und Antisite-Defekten die strukturelle Stabilität und die elektrischen Eigenschaften von GaAs/AlAs SL beeinflusst. In dieser Studie wurde die Phasenstabilität einzelner Ga (oder Al oder As)-Leerstellen, einzelner Ga (oder Al oder As)-Zwischengitter und einzelner GaAs (oder AlAs oder AsGa oder AsAl ) Antisite-Defekte wurden untersucht. Es wird gezeigt, dass die Antisite-Defekte energetisch günstiger sind als Leerstellen und Zwischengitterdefekte. Die Bandstrukturen dieser defekten Zustände wurden mit der Hybrid-DFT-Methode untersucht, die einen Teil des exakten Austauschs aus der Hartree-Fock-Theorie mit dem Rest der Austauschkorrelationsenergie aus anderen Quellen (ab initio oder empirisch) [18] und soll eine genauere Beschreibung der elektronischen Struktur von Halbleitermaterialien bieten als die Standard-DFT. Insbesondere wurde die Elektronenmobilität vorhergesagt. Es stellte sich heraus, dass die Zwischengitter- und Leerstellendefekte die Elektronenmobilität deutlich reduzieren, während die Antistellendefekte relativ kleinere Einflüsse haben. Diese Arbeit wird das Verständnis der Strahlungsschädigungseffekte des Halbleiter-Übergitters verbessern und eine Anleitung für den Entwurf hochstabiler und langlebiger elektronischer und optoelektronischer Halbleiter auf der Grundlage von Halbleiter-Übergittern für Anwendungen in extremen Umgebungen bieten.
Methoden
In dieser Studie werden die Strukturrelaxationen im Standard-DFT-Rahmen durchgeführt und die Bandstrukturen durch die Hybrid-DFT im Rahmen von Heyd-Scuseria-Emzefhof (HSE) [19] basierend auf den relaxierten Strukturen berechnet. Alle Berechnungen werden mit Wiener Ab Initio . durchgeführt Simulationspaket (VASP) [20]. Projektor-Augmented-Wave-Pseudopotentiale werden verwendet, um die Wechselwirkung zwischen Ionen und Elektronen zu beschreiben, und die Austauschkorrelationseffekte werden unter Verwendung der lokalen Dichte-Approximation in der Ceperley-Alder-Parametrisierung behandelt [21]. Die Konvergenzkriterien für die Gesamtenergien und -kräfte sind 10 −4 eV und 10 −3 eV/Å bzw. Die Ursprungspunktgruppe des AlAs- und GaAs-Kristalls ist das T d Gruppe der Zinkblende, wie in Abb. 1a gezeigt. Die Darstellung der betrachteten Punktdefekte ist in Abb. 1b dargestellt. Die GaAs/AlAs SL mit zwei Monoschichten aus GaAs im Wechsel mit zwei Monoschichten aus AlAs wird in dieser Studie betrachtet und die geometrische Konfiguration ist in Abb. 2 zusammen mit den betrachteten Punktdefekten dargestellt.

Schematische Darstellung der geometrischen Strukturen von a XAs (X =Ga oder Al); b die Fehler in XAs. V X :(X =Ga, Al oder As) X-Leerstelle; X int :X-Zwischengitter; X Wie :X besetzt den As-Gitterplatz; Wie X :Als Besetzung des X-Gitterplatzes. Die gelben und violetten Kugeln repräsentieren die Leerstelle bzw. die Zwischengitterdefekte

Schematische Darstellung der geometrischen Strukturen von a ideales GaAs/AlAs-Übergitter; b und c GaAs/AlAs-Übergitter mit verschiedenen Punktdefekten. X J :(X, Y =Ga, Al oder As) X besetzt den Y-Gitterplatz; V X :X-Stelle; X int :X-Interstitial. Die gelben und karminroten Kugeln repräsentieren die Leerstelle bzw. die Zwischengitterdefekte
Ergebnisse und Diskussion
Grundzustandseigenschaften von GaAs und AlAs
Wie in Tabelle 1 gezeigt, werden die Gitterkonstanten von GaAs und AlAs als Volumen mit 5,61 bzw. 5,63 bestimmt, was gut mit den experimentellen und anderen theoretischen Werten übereinstimmt [22,23,24]. Es scheint, dass die Gitterfehlanpassung zwischen GaAs und AlAs klein ist und die Gitterkonstante von GaAs/AlAs SL auf den Zwischenwert von 5,62 eingestellt ist. Der Volumenmodul wird berechnet durch \( B=\frac{1}{3}\left({C}_{11}+2{C}_{12}\right) \) [25], wobei C11 und C12 stellen die elastischen Konstanten dar. Der Volumenmodul von GaAs wird mit 76,3 GPa berechnet, was dem Ergebnis von 76,5 GPa für AlAs nahe kommt. Diese Ergebnisse stimmen gut mit den theoretischen und experimentellen Daten überein [22, 26, 27].
Die Defektbildungsenergie im GaAs/AlAs-Übergitter
Für GaAs/AlAs SL und Bulk-Zustände wird die Defektbildungsenergie berechnet durch \( {E}_f={E}_{def}-{E}_{undef}+\sum \limits_i\Delta {n}_i{ \mu}_i\) [28]. Hier, E def ist die Gesamtenergie der defekten Simulationszelle nach Relaxation, E undef ist die Gesamtenergie der entspannten idealen Superzelle, Δn ich ist die Änderung der Artenzahl i (ich = Ga, Al oder As) und μ ich ist das chemische Potenzial der Spezies i [28].
Für Bulk-XAs (X =Al oder Ga) gehorchen die chemischen Potentiale von As und X den folgenden Bedingungen:\( {\mu}_X\le {\mu}_X^{bulk} \), \( {\mu} _{As}\le {\mu}_{As}^{bulk} \), und \( {\mu}_{As}+{\mu}_X={\mu}_{XAs}^{bulk } \), wobei \( {\mu}_X^{bulk} \), \( {\mu}_{As}^{bulk} \) und \( {\mu}_{XAs}^{bulk } \) entsprechen der Gesamtenergie von Volumen X, Volumen As bzw. Volumen XAs. Die Defektbildungsenergien unter X-reichen Bedingungen, dh \( {\mu}_X={\mu}_X^{bulk}\) und \( {\mu}_{As}={\mu}_{XAs }^{bulk}-{\mu}_X^{bulk} \), und As-reiche Bedingung, dh \( {\mu}_{As}={\mu}_{As}^{bulk} \ ) und \( {\mu}_X={\mu}_{XAs}^{bulk}-{\mu}_{As}^{bulk} \), sind in Tabelle 2 zusammengefasst. Für GaAs unter As- reiche Bedingungen das AsGa (Da er den Ga-Gitterplatz besetzt) erweist sich der Antiplatz-Defekt als energetisch am günstigsten, was durch die kleinste Bildungsenergie von 1,57 eV angezeigt wird. Der nächste günstige Defekt ist das GaAs (Ga besetzt den As-Gitterplatz) Antiplatz-Defekt mit einer Bildungsenergie von 2,31 eV. Das As-Interstitial (Asint ) hat die größte Bildungsenergie von 5,20 eV, was darauf hindeutet, dass er schwieriger zu bilden ist als andere betrachtete Punktdefekte. Unter Ga-reichen Bedingungen ist das VGa , Asint und AsGa Defekte haben größere Bildungsenergien und die VAs , Gaint und GaAs Defekte haben im Vergleich zum As-reichen Zustand kleinere Bildungsenergien. Offensichtlich hängt die Defektstabilität von der chemischen Umgebung ab. Im Vergleich zu GaAs sind die Defektbildungsenergien in AlAs im Allgemeinen größer, außer in den Fällen von Asint und AsX (X =Al oder Ga) unter As-reichen Bedingungen. Die AsAl und AlAs Antisite-Defekte werden als der günstigste Defekt unter As-reichen bzw. Al-reichen Bedingungen bestimmt. Ähnlich wie bei GaAs ist das Asint ist auch in AlAs ungünstig. Die Defektbildungsenergien unter As-reichen und X-reichen (X =Ga oder Al) Bedingungen in Volumen-XAs sind in Abbildung 3 aufgetragen. Abbildung 3a zeigt, dass die AsGa und GaAs Antisite-Defekte sind unter As-reichen bzw. Ga-reichen Bedingungen günstiger. Es wird darauf hingewiesen, dass die AsAl Antisite-Defekt ist in den meisten Fällen vorzuziehen (siehe Abb. 3b). Unter Al-reichen Bedingungen ist die Phasenstabilität von AlAs , VAs und AsAl Defekte liegen nahe beieinander, wie durch die Bildungsenergien von 3,0, 3,16 bzw. 3,24 eV angezeigt. Außerdem stellen wir fest, dass sowohl bei GaAs als auch bei AlAs die Unvorteilhaftigkeit von Asint ist unabhängig von der chemischen Umgebung. Zolloet al. führten First-Principles-Rechnungen an GaAs durch und ihre DFT-Ergebnisse zeigten, dass die Bildungsenergien von AsGa und GaAs waren kleiner als die für Leerstellen und Zwischengitterdefekte [14], was mit unseren Ergebnissen übereinstimmt.
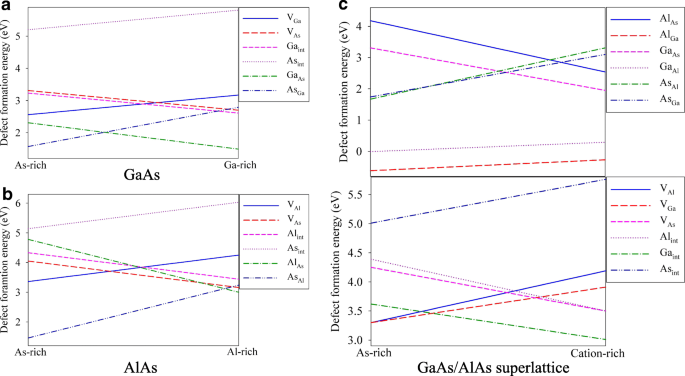
Die Defektbildungsenergien unter As-reichen und Kationen-reichen Bedingungen in a GaAs, b AlAs und c GaAs/AlAs-Übergitter. X J :(X, Y =Ga, Al oder As) X besetzt den Y-Gitterplatz; V X :X-Stelle; X int :X-Interstitial
Das E f in der GaAs/AlAs SL-Struktur werden auch unter As-reichen Bedingungen berechnet, dh \( {\mu}_{As}={\mu}_{As}^{bulk}\), \( {\mu}_ {Al}={\mu}_{Al As}^{bulk}-{\mu}_{As}^{bulk} \), und \( {\mu}_{Ga}={\mu}_ {Ga As}^{bulk}-{\mu}_{As}^{bulk} \) und kationenreicher Zustand, dh \( {\mu}_{Al}={\mu}_{Al }^{bulk} \),\( {\mu}_{Ga}={\mu}_{Ga}^{bulk} \) und \( {\mu}_{As}=\left({\ mu}_{SL}^{bulk}-{n}_{Al}\times {\mu}_{Al}^{bulk}-{n}_{Ga}\times {\mu}_{Ga} ^{bulk}\right)/{n}_{As} \), wobei n Al , n Ga , und n Wie die Anzahl der Al-, Ga- und As-Atome in der Simulationszelle darstellen. Wie in Tabelle 3 gezeigt, ist das AlGa Defekt hat negative Bildungsenergien, d. h. − 0,62 und − 0,27 eV unter As-reichen bzw. kationenreichen Bedingungen, was darauf hindeutet, dass die Bildung von AlGa Antisite-Defekt ist ein exothermer Prozess. Was GaAl . angeht Defektes sind die Bildungsenergien so klein wie − 0.01 eV unter As-reichen Bedingungen und 0.29 eV unter kationenreichen Bedingungen. Offensichtlich ist die Bildung von AlGa und GaAl Antisite-Defekte in der GaAs/AlAs-SL-Struktur sind viel einfacher als andere Punktdefekte. Unter As-reichen Bedingungen sind die Bildungsenergien der zweiten günstigen Defekte von AsGa und AsAl werden mit 1,67 bzw. 1,74 eV bestimmt. Bei den Zwischengitterplätzen folgt die Phasenstabilität sowohl dem Trend von Gaint> Alint> Asint unter As-reichen und kationenreichen Bedingungen. Die Defektbildungsenergien in der GaAs/AlAs SL-Struktur sind auch in Fig. 3c aufgetragen. Im Vergleich zu massivem GaAs sind die Punktdefekte in GaAs/AlAs SL im Allgemeinen schwieriger zu bilden, außer im Fall von Asint (siehe Abb. 3a, c). Die Bildungsenergien von Asint in Bulk-GaAs sind 5,20 und 5,81 eV unter As-reichen und Ga-reichen Bedingungen, die etwas größer sind als die entsprechenden Werte von 5,01 und 5,76 eV in GaAs/AlAs SL. Wie in Fig. 3b und c gezeigt, zeigt die Stabilität von Punktdefekten in Bulk-AlAs- und SL-Struktur unterschiedliche Charaktere. Die AlAs und Asint Defekte sind in GaAs/AlAs SL energetisch günstiger als in Bulk-AlAs, während VAs Ein Defekt ist in Bulk-AlAs stärker bevorzugt als in einer SL-Struktur. Es fällt auf, dass unter As-reichen und Al-reichen Bedingungen die Bildungsenergien von Alint in Bulk-AlAs sind mit denen in GaAs/AlAs SL vergleichbar. Ähnlich wie bei Alint , das VAl Defekte in Bulk-AlAs und SL-Struktur zeigen eine ähnliche Begünstigung, wie durch die vergleichbaren Bildungsenergien angezeigt. Im Fall von AsAl Defekt ist die Bildungsenergie unter As-reichen Bedingungen kleiner (1,46 eV) in der SL-Struktur, während unter kationenreichen Bedingungen der Wert kleiner ist (3,10 eV) in Bulk-AlAs, was darauf hindeutet, dass die Stabilität von AsAl hängt von der chemischen Umgebung ab.
Beim Vergleich der Defektstabilität in Bulk-AlAs, GaAs und GaAs/AlAs SL stellen wir fest, dass Antisite-Defekte immer bevorzugter sind als Leerstellen und Zwischengitter, insbesondere in den Fällen von GaAl und AlGa in GaAs/AlAs SL. Es wird auch darauf hingewiesen, dass unter As-reichen und kationenreichen Bedingungen das Asint Defekt ist sowohl im Bulk-Zustand als auch in der GaAs/AlAs-SL-Struktur am schwierigsten zu bilden.
Die Auswirkungen von Punktdefekten auf die Bandstrukturen von GaAs/AlAs-Übergitter
Der unberührte Zustand des GaAs/AlAs-Übergitters
Die Bandlücken für Bulk-GaAs, AlAs und GaAs/AlAs SL sind in Tabelle 4 zusammengefasst, und ihre Bandstrukturen sind in Abb. 4 dargestellt. Die Hybrid-DFT-Rechnungen bestimmen die direkte Bandlücke von GaAs zu 1,44 eV (siehe Abb. 4a ), was gut mit dem experimentellen Wert von 1,52 eV [29] und anderen Rechnungen [24] übereinstimmt. Im Gegensatz dazu sagt die Standard-DFT einen Bandlückenwert von 0.5 eV voraus, was die Bandlücke von GaAs stark unterschätzt. Für AlAs hat die Bandstruktur indirekten Charakter und die hybride DFT-Bandlücke beträgt 2,16 eV (siehe Abb. 4b), was 0,85 eV größer ist als das DFT-Ergebnis und in guter Übereinstimmung mit dem experimentellen Wert von 2,22 eV [23]. Wie in 4c gezeigt, wird die Bandlücke von GaAs/AlAs SL als direkt bestimmt und stimmt mit der Studie von Botti et al. überein, die die Bandlücke von (GaAs)m . gefunden haben /(AlAs)m SL (m ≥ 2) direkt am Γ-Punkt sein [3]. In unseren Berechnungen wird die direkte Bandlücke für GaAs/AlAs SL mit der Hybrid-DFT-Methode zu 2,06 eV bestimmt, was mit dem experimentellen Wert von 2,10 eV übereinstimmt [30].

Die Bandstrukturen von a GaAs, b AlAs und c GaAs/AlAs-Übergitter. Die Hybrid-DFT-Werte sind in den linken Feldern und die DFT-Ergebnisse in den rechten Feldern aufgetragen
Die Auswirkungen von Antisite-Defekten auf die Bandstruktur von GaAs/AlAs-Übergitter
In der GaAs/AlAs SL-Struktur ist das GaAl und AlGa Antisite-Defekte sind energetisch günstiger als andere Punktdefekte. Wie in Fig. 5a und b gezeigt, sind die Bandstrukturen von GaAl und AlGa Defekte Zustände sind denen des unberührten Zustands sehr ähnlich und die Bandlücken wurden mit 1,98 bzw. 2,01 eV bestimmt. Dies sollte auf die Tatsache zurückzuführen sein, dass die chemischen Elemente Al und Ga eine ähnliche Valenzelektronenkonfiguration aufweisen, d. h. 3s 2 3p 1 für Al und 4s 2 4p 1 für Ga, und bei der Bildung von GaAl . werden keine zusätzlichen Elektronen oder Löcher eingeführt und AlGa Antisite-Defekte. Die Bandstrukturen für AsGa und AsAl fehlerhafte Zustände sind in den Fig. 5c und d dargestellt. Es stellt sich heraus, dass diese beiden Defekte die Bandstruktur von GaAs/AlAs SL erheblich verändern. Sowohl das AsGa und AsAl Antisite-Defekte führen zusätzliche Elektronen ein und wirken als n-Dotierungsmittel. Die Verunreinigungsniveaus liegen weit von den Valenzbändern entfernt und kreuzen das Ferminiveau, wie in Abb. 5c und d gezeigt. Diese tiefen Defektebenen können als Rekombinationszentrum für Träger dienen.

Die Bandstrukturen defekter GaAs/AlAs-Übergitter mit verschiedenen Antisite-Defekten. a :Ga, das den Al-Gitterplatz besetzt; b :Al, das den Ga-Gitterplatz besetzt; c :Als Besetzung des Ga-Gitterplatzes; d :Als Besetzung des Al-Gitterplatzes
Abbildung 6 zeigt die Bandstrukturen und die partielle Zustandsdichte (PDOS) von defektem SL mit GaAs und AlAs Mängel. Wie in Fig. 6a gezeigt, ist die Bandstruktur für GaAs defekter SL hat Spin-Splitting-Charakter. In den Spin-Down-Subbändern geht das Fermi-Niveau durch die Defektniveaus, die durch das GaAs . eingeführt werden Defekt, der auf den halbmetallischen Charakter des defekten SL hinweist. Gemäß der Definition der halbmetallischen Lücke [31] ist die Bandlücke von GaAs defekter Zustand beträgt etwa 0,10 eV. Wie im PDOS des defekten SL mit GaAs . gezeigt , werden die Spin-Down-Subbänder in der Nähe des Fermi-Niveaus hauptsächlich von p . beigesteuert Teilwellen. Aufgrund der ähnlichen Valenzelektronenkonfigurationen zwischen Ga- und Al-Atomen sind die berechneten Spin-Up- und Spin-Down-Bandstrukturen von AlAs defekter Zustand bestimmt (siehe Fig. 6b), und die Bandlücke wird zu 0,15 eV berechnet. Insgesamt ist das AlGa und GaAl Antisite-Defekte haben vernachlässigbare Auswirkungen auf die elektronische Struktur von GaAs/AlAs SL. Es wird auch darauf hingewiesen, dass die defekte SL mit AsAl und AsGa Defekte zeigen Metallizität, während die defekten SLs mit GaAs und AlAs sind halbmetallisch.

Bandstrukturen und partielle Zustandsdichte defekter GaAs/AlAs-Übergitter mit a GaAs und b AlAs Antisite-Defekte. X Wie (X =Ga oder Al) X besetzt den As-Gitterplatz
Die Auswirkungen von Leerstellendefekten auf die Bandstruktur von GaAs/AlAs-Übergitter
Die Bandstrukturen der SL-Struktur mit unterschiedlichen Leerstellen sind in Abb. 7 aufgetragen und ihre entsprechenden PDOS sind in Abb. 8 dargestellt und VAl Defekte, wie in Abb. 7a und b gezeigt. Tatsächlich hinterlässt das Entfernen von Atomen aus ihren ursprünglichen Positionen vier baumelnde Bindungen, die mit dem sp . zusammenhängen 3 Orbitale. Während der Strukturrelaxation werden die nächstgelegenen Atome um die Leerstelle herum gleichmäßig in Richtung des leeren Gitterplatzes verschoben, was zu einer Platzsymmetrie führt, die durch das tetragonale D . definiert wird 2d Punktgruppe. Die induzierten Defektniveaus erscheinen nahe dem Valenzband und liegen im verbotenen Bereich des GaAs/AlAs SL. Die Bandlücke wird mit 0,47 und 0,44 eV für den SL mit VGa . bestimmt und VAl Mängel bzw. Wie in der PDOS der defekten SL mit VGa . gezeigt und VAl (siehe Abb. 8a und b), der Haupteinfluss der Gruppe-III-Stellenangebote liegt auf der p Zustände. Wie in Fig. 7c gezeigt, ist die Bandstruktur der defekten SL mit VAs Der Defekt teilt sich in Spin-up- und Spin-down-Teile auf, und die Defektniveaus erscheinen nahe dem Leitungsband. Da die VAs Defekt wirkt als n-Dotierstoff, das Ferminiveau verschiebt sich zu einer höheren Energie und kreuzt die Defektniveaukante. Kahalyet al. haben die elektrischen Eigenschaften der GaAs-AlAs-Heterogrenzflächen untersucht und festgestellt, dass VAs Defekt an der Grenzfläche führt zu Quasi-2-DEG [7], was mit unseren Ergebnissen übereinstimmt. Unsere Berechnungen zeigen, dass die Leerstellen unterschiedliche Auswirkungen auf die Bandstruktur von GaAs/AlAs SL haben, d. h. die VAs Defekt induziert Metallizität von GaAs/AlAs SL und VGa und VAl Defekte reduzieren die Bandlücke der SL-Struktur signifikant.

Die Bandstrukturen defekter GaAs/AlAs-Übergitter mit a VGa , b VAl und c VAs Leerstandsmängel. V X (X =Ga, Al oder As) X Leerstelle

Die partielle Zustandsdichte eines defekten GaAs/AlAs-Übergitters mit a VGa , b VAl und c VAs Leerstandsmängel. V X (X =Ga, Al oder As) X Leerstelle
Die Auswirkungen von Zwischengitterdefekten auf die Bandstruktur von GaAs/AlAs-Übergitter
Abbildung 9 zeigt die Bandstrukturen der SL-Struktur mit interstitiellen Defekten. Es ist anzumerken, dass sich das Fermi-Niveau zu hoher Energie verschiebt und die Leitungsbandkante kreuzt (siehe Fig. 9a und b), aufgrund der Tatsache, dass die Gruppe-III-Zwischengitter Donor-ähnliche Defekte sind. Folglich sind die defekten SLs mit Gaint und Alint metallischen Charakter zeigen. Wie in Fig. 9c gezeigt, erscheinen in den Spin-Up- und Spin-Down-Teilen der Bandstruktur die Störstellenniveaus nahe dem Leitungsband und das Ferminiveau kreuzt die Störstellenniveaukante, was die induzierte Metallität von defektem GaAs/AlAs SL mit anzeigt Alsint . Offensichtlich verändern die Zwischengitterdefekte die elektronischen Strukturen von GaAs/AlAs SL signifikant und induzieren im Allgemeinen Metallizität der defekten SL-Struktur.

Die Bandstrukturen defekter GaAs/AlAs-Übergitter mit a Gaint defekt, b Alint defekt und c Alsint Defekt. X int (X =Ga, Al oder As) X-Zwischengitter
Beim Vergleich der Bandstrukturen und der repräsentativen PDOS der GaAs/AlAs SL mit Antistellen, Leerstellen und Zwischengitterplätzen stellen wir fest, dass die Defekte die elektronischen Strukturen mit Ausnahme der Fälle von GaAl . erheblich verändern und AlGa Antisite-Defekte. Außerdem werden die Bandlückenverengung und sogar Metallizität induziert, was die Leistung von GaAs/AlAs SL drastisch beeinflusst.
Die Auswirkungen von Punktdefekten auf die Elektronenmobilität von GaAs/AlAs-Übergitter
Die Elektronenbeweglichkeit bei 0 K lässt sich aus der Gleichung μ . berechnen = eτ /m ∗ , wobei e ist die Elektronenladung, τ ist die Entspannungszeit und m ∗ ist die effektive Masse des Trägers [32]. Die effektiven Elektronenmassen lassen sich aus der Krümmung der Bandstrukturen über die Beziehung \({m}^{\ast}={\mathrm{\hslash}}^2{\left(\frac{d^2\varepsilon }{dk^2}\right)}^{-1} \) [32], wobei ℏ die reduzierte Planck-Konstante ist, k der Wellenvektor ist und ε ist die Energie des Leitungsbandminimums. Wie in Abb. 4a und b gezeigt, erhalten wir m * = 0,057 m e für GaAs und m * = 0,19 m e für AlAs, die gut mit den experimentellen Werten von 0,057 m . übereinstimmen e für GaAs [33] und 0,124 m e für AlAs [34], wobei m e ist die statische Elektronenmasse. Die Relaxationszeit für AlAs und GaAs wird mit 0,17 bzw. 0,48 ps angenommen [35]. Die Elektronenbeweglichkeit von GaAs und AlAs bei 0 K wird zu 1,48 × 10 4 . berechnet cm 2 /Vs und 1,57 × 10 3 cm 2 /Vs, vergleichbar mit den experimentellen Werten von 0,94 × 10 4 cm 2 /Vs für GaAs [36] und 0,28 × 10 3 cm 2 /Vs für AlAs [37].
Wie in Tabelle 5 gezeigt, wird die effektive Elektronenmasse am Г-Punkt (\( {m}_{\Gamma}^{\ast } \)) zu 0,113 m . bestimmt e für das reine GaAs/AlAs SL und die Relaxationszeit τ wird mit 0,4 ps angenommen [38]. Die Elektronenbeweglichkeit entlang der z-Richtung, d. h. Γ-X-Richtung in der Brillouin-Zone (μ Γ − X ) wird mit 0,623 × 10 4 . berechnet cm 2 /Vs für ideale GaAs/AlAs SL, vergleichbar mit dem experimentellen Wert von 1.0 × 10 4 cm 2 /Vs [38]. Bei der defekten SL mit Antisite-Defekten beträgt der Wert μ Γ − X ist mit der idealen SL vergleichbar, mit Ausnahme der Fälle von GaAs und AlAs Mängel. Die Elektronenbeweglichkeit entlang der Γ-X-Richtung wird zu 0,263 × 10 4 . bestimmt cm 2 /Vs und 0,311 × 10 4 cm 2 /Vs für GaAs und AlAs Defektzustände, die viel kleiner sind als der des Idealzustands. Es wird darauf hingewiesen, dass der Gaint , Alint und Asint Defekte reduzieren auch die Elektronenmobilität signifikant, wie durch die Werte von 0,225 × 10 4 . angezeigt cm 2 /Vs für Gaint , 0,243 × 10 4 cm 2 /Vs für Alint und 0,315 × 10 4 cm 2 /Vs für Asint . Im Vergleich zu Antisite- und interstitiellen Defekten haben die Leerstellen die tiefgreifendsten Auswirkungen. Für VGa und VAl Defekte, die Werte von μ Γ − X sind etwa sechsmal kleiner als die des unberührten Staates. Die VAs Defekt verringert auch signifikant die Elektronenmobilität, wie durch 0.127 × 10 4 . angezeigt cm 2 /vs. Tanakaet al. haben die Auswirkungen von Elektronenbestrahlung auf die elektrischen Eigenschaften von GaAs/AlGaAs-Heterostrukturen untersucht und festgestellt, dass die Elektronenmobilität bei Dosen von mehr als 5 × 10 20 . reduziert wurde cm −2 [10]. Especially, the defect creation in GaAs channel region, rather than n-AlGaAs layer, is thought to be the main cause of the mobility degradation [10]. Recently, it has been suggested that the electrons are possibly trapped by defects or impurity and produce metastable states accompanied by lattice relaxation [39]. Consequently, the electronic structure and carrier mobility of GaAs/AlAs SL are influenced significantly by the point defects. Therefore, it is necessary to enhance the radiation tolerance of GaAs/AlAs SL to improve its electronic performance under radiation environment.
Conclusions
In this work, a hybrid density functional theory study is performed to investigate the effects of point defect on the electrical properties of GaAs/AlAs superlattice (SL). The calculated defect formation energies show that the antisite defects are the most favorable in bulk GaAs and AlAs. In GaAs/AlAs SL structure, the antisite defects are always dominant under cation-rich and As-rich conditions and the interstitial defects are very difficult to form during the whole range of chemical potentials. It is shown that the different point defects have various effects on the electronic structures of GaAs/AlAs SL. The AsX (X =Al or Ga) and XAs antisite defects always induce metallicity, although the defective SLs with XAs antisites show spin splitting. As for vacancies, the defective SL with VAs shows metallicity character, and the group III vacancy defects reduce the band gap of the superlattice significantly. The metallicity is also found in the defective GaAs/AlAs SL with the interstitial defects. The further carrier mobility calculations show that the interstitial and vacancy defects reduce the electron mobility significantly, while the antisite defects have relatively smaller influence.
Abkürzungen
- 2-DEG:
-
Two-dimensional electron gas
- AIMD:
-
Ab initio molecular dynamics
- Al:
-
Aluminium
- AlAs:
-
Aluminum arsenide
- As:
-
Arsenic
- AsX :
-
As occupying the X lattice site
- DFT:
-
Dichtefunktionaltheorie
- Ga:
-
Gallium
- GaAs:
-
Gallium arsenide
- HEMT:
-
High electron mobility transistors
- HSE:
-
Heyd-Scuseria-Emzefhof
- LED:
-
Leuchtdiode
- N:
-
Stickstoff
- PDOS:
-
Partial density of state
- QCLs:
-
Quantum cascade lasers
- SL:
-
Superlattice
- VASP:
-
Vienna Ab Initio Simulation Package
- VX (X =Ga, Al or As):
-
X vacancy
- XAs :
-
X occupying the As lattice site
- Xint :
-
X interstitial
- Zn:
-
Zinc
Nanomaterialien
- Enthüllung der atomaren und elektronischen Struktur von gestapelten Kohlenstoff-Nanofasern
- Ultraschmalbandiger perfekter Absorber und seine Anwendung als plasmonischer Sensor im sichtbaren Bereich
- First-Principles-Studie zur Stabilität und dem STM-Image von Borophen
- Auswirkung einer In-situ-Annealing-Behandlung auf die Mobilität und Morphologie von TIPS-Pentacen-basierten organischen Feldeffekttransistoren
- Die Auswirkungen des Li/Nb-Verhältnisses auf die Herstellung und photokatalytische Leistung von Li-Nb-O-Verbindungen
- Einfluss von Wasser auf die Struktur und die dielektrischen Eigenschaften der mikrokristallinen und Nano-Cellulose
- Auswirkungen der Doppelschichtdicke auf die morphologischen, optischen und elektrischen Eigenschaften von Al2O3/ZnO-Nanolaminaten
- Experimentelle Studie zu den Strömungs- und Wärmeübertragungseigenschaften von TiO2-Wasser-Nanofluiden in einem spiralförmig geriffelten Rohr
- Die Kopplungseffekte von Oberflächenplasmonpolaritonen und magnetischen Dipolresonanzen in Metamaterialien
- Studie über den mehrstufigen Widerstandsschaltspeicher und die speicherzustandsabhängige Photospannung in Pt/Nd:SrTiO3-Übergängen



