SnSe2-Feldeffekttransistor mit hohem Ein-/Aus-Verhältnis und umschaltbarer Polarität
Zusammenfassung
SnSe2 Feldeffekttransistor wurde auf der Basis von abgeblättertem, mehrschichtigem SnSe2 . hergestellt Flocke, und ihre elektrischen und photoelektrischen Eigenschaften wurden im Detail untersucht. Mit Hilfe eines Tropfens entionisiertem (DI) Wasser wird das SnSe2 FET kann ein Ein/Aus-Verhältnis von bis zu ~ 10 4 . erreichen innerhalb von 1 V Vorspannung, was für SnSe2 . extrem schwierig ist aufgrund seiner ultrahohen Ladungsträgerdichte (10 18 /cm 3 ). Darüber hinaus werden der unterschwellige Swing und die Mobilität auf ∼ 62 mV/Dekade und ~ 127 cm 2 . verbessert V −1 s −1 bei 300 K, was aus der effizienten Abschirmung durch das flüssige dielektrische Gate resultiert. Interessanterweise ist das SnSe2 FET weist eine von der Gate-Vorspannung abhängige Photoleitfähigkeit auf, bei der eine Konkurrenz zwischen der Ladungsträgerkonzentration und der Mobilität unter Beleuchtung eine Schlüsselrolle bei der Bestimmung der Polarität der Photoleitfähigkeit spielt.
Einführung
Aufgrund des Quanteneinschlusseffekts verhalten sich zweidimensionale (2D) atomar geschichtete Materialien (ALMs) ganz anders als ihre 3D-Massengegenstücke und weisen einige einzigartige und faszinierende elektronische, optische, chemische, magnetische und thermische Eigenschaften auf [1]. 2D-ALMs bieten eine attraktive Plattform für physikalische und chemische Grundlagenforschung an der Grenze eines einzelnen Atoms oder einer Schichtdicke von wenigen Schichten. Darüber hinaus könnten ALMs flexibel in andere Geräte integriert werden, was einen größeren Raum oder die Freiheit bietet, neue Funktionen zu entwickeln, die über die Reichweite der bestehenden Materialien hinausgehen. In den letzten zehn Jahren wurden die 2D-ALMs umfassend untersucht und fanden potenzielle Anwendungen in Bereichen wie Sensoren, Energie und Umwelt [2, 3].
Als wichtiges Mitglied der IV-VI-Gruppe wurde vor kurzem Zinndiselenid (SnSe2 ) hat viel Aufmerksamkeit erregt. SnSe2 hat ein sechseckiges CdI2 -Typ Kristallstruktur, in der die Sn-Atome von zwei Schichten hexagonal gepackter Se-Atome mit der Raumgruppe \(\mathrm{p}\overline{3}\mathrm{m}1\) eingeschlossen sind [4]. Im Gegensatz zu Übergangsmetalldichalkogeniden (TMDs) ist SnSe2 besitzt eine schmalere Bandlücke mit indirekter Bandlückencharakteristik innerhalb des gesamten Dickenbereichs vom Bulk bis zur Monoschicht, die aus äußeren p-Elektronen von Sn resultiert, die an der strukturellen Bindung beteiligt sind, im Gegensatz zu d-Elektronen von Mo oder W in MoS2 oder WS2 [5]. SnSe2 Es wurde untersucht, dass es hervorragende Eigenschaften in Thermoelektrik, Phasenwechselspeicher, Lithium-Ionen-Batterien und verschiedenen elektronischen Logikgeräten aufweist [4, 6,7,8,9]. Insbesondere SnSe2 hat eine höhere Elektronenaffinität (5,2 eV) und findet daher eine spezielle Anwendung bei der Herstellung von Tunnel-Feldeffekttransistoren (FETs) [9,10,11]. Panet al. systematisch untersuchte FETs basierend auf mechanisch abgeblättertem SnS2 − x Sex Kristalle mit unterschiedlichem Selengehalt [12]. Sie fanden heraus, dass der Drain-Source-Strom (I d ) kann nicht vollständig deaktiviert werden, wenn der Se-Inhalt x reaching erreicht = 1,2 oder höher. Später Su et al. haben ein SnSe2 hergestellt MOSFET mit hohem Ansteuerstrom (160 μA/μm) bei 300 K mit dem gleichen Ergebnis ohne „AUS“-Zustand [13]. Der Hauptgrund für die Schwierigkeit, den „AUS“-Zustand von SnSe2 zu erreichen FET-Gerät ist die ultrahohe Elektronendichte (10 18 cm −3 in großen Mengen SnSe2 , verglichen mit 10 16 cm −3 in MoS2 ) [14, 15]. Daher effektive Modulation des Transports von Trägern in SnSe2 FETs ist eine anspruchsvolle Aufgabe. Baoet al. erfolgreich ausgeschaltet I d und erreichte ein Ein/Aus-Verhältnis von 10 4 bei Raumtemperatur bei Verwendung von HfO2 als Backgate kombiniert mit einer oberen Deckschicht aus Polymerelektrolyt. Die Leistung von SnSe2 kann aufgrund des irreversiblen Strukturübergangs durch Li + . mehrere Kehren nicht überleben Einlagerung in die Zwischenschicht von SnSe2 [16]. Guo et al. erreichte ein höheres Strom-Ein/Aus-Verhältnis von 10 5 mit einer Schwellenspannung von − 100 V durch Verdünnung des SnSe2 Flocken auf 6,6 nm [17]. Die Arbeitstemperatur beträgt jedoch nur 78 K, was für die praktische Anwendung nicht geeignet ist. Eine alternative Möglichkeit, die Modulation des Ladungsträgertransports in FETs zu verbessern, besteht darin, eine dielektrische High-k-Schicht als Top-Gate abzuscheiden, z. B. HfO2 und Al2 O3 [18, 19]. Die hohe Abscheidungstemperatur ändert jedoch die Eigenschaften von SnSe2 Schicht und verschlechtern die Geräteleistung weiter. Die Verwendung eines Festpolymerelektrolyt-Gates zur Modulation der Ladungsträgerdichte ist aufgrund der hocheffizienten Kontrolle der elektrischen Doppelschicht (EDL), die an der Grenzfläche zwischen Elektrolyt und Halbleiter gebildet wird, eine attraktive Methode [20,21,22]. Ein träger Ionenmigrationsprozess erfordert jedoch niedrige Vorspannungs-Sweep-Raten, um sich anzupassen. Also eine einfache, effiziente und praktische Methode, um die Träger von SnSe2 . zu modulieren ist sehr anspruchsvoll.
In dieser Arbeit haben wir nur einen Tropfen entionisiertes (DI) Wasser als Lösungs-Top-Gate verwendet und den Kanalstrom bei 300 K erfolgreich abgeschaltet. Darüber hinaus konnte das Ein/Aus-Verhältnis ~ 4 Ordnungen erreichen, gesteuert durch eine kleine Gate-Spannung von weniger als 1 V. Noch auffälliger ist das SnSe2 Gerät weist eine interessante vorspannungsabhängige negative und positive Photoleitfähigkeit auf, in der der mögliche Arbeitsmechanismus analysiert wurde.
Experimente
Das SnSe2 Flocken wurden aus hochwertigen Bulk-Kristallen durch mechanisches Peeling gewonnen. Dann wurde es auf einen Si-Wafer übertragen, der mit 100 nm SiO2 . bedeckt war . Die detaillierte Peeling- und Transfermethode wird in Huangs Artikel beschrieben [23]. Nach der Übertragung wurde optische Mikroskopie verwendet, um ausgewählte Flocken zu identifizieren, und die genaue Dicke wurde durch Rasterkraftmikroskopie gemessen. Das SnSe2 FETs wurden durch eine Standard-Photolithographie hergestellt. Der Ti/Au-Kontakt (5/50 nm) wurde durch einen thermischen Verdampfer abgeschieden, gefolgt von einem in-situ-Tempern bei 200 °C im Hochvakuum (10 −5 Pa) um den metallischen Kontakt zu verbessern. Für DI-Wasser-Top-Gate-FETs wurde eine zusätzliche Polymerschicht (Polymethylmethacrylat (PMMA) Typ 950 A5) auf den Bauelementen abgeschieden (Schleuderbeschichtung bei 3000 U/min, Dicke ∼ 400 nm), bei 180°C für 2 Minuten gebacken und durch UV-Photolithographie strukturiert, um Fenster für den Kontakt zwischen dem Wassertropfen und dem Gerätekanal zu öffnen.
Die elektrische Charakterisierung wurde mit einem Keithley Sourcemeter 2634B an einer Vier-Sonden-Station (Signatone) durchgeführt. Als Lichtquelle wurde eine Laserdiode mit einer Wellenlänge von 532 nm mit einer Leistungsdichte von 1 mW/mm 2 . verwendet um die photoelektrische Leistung von SnSe2 . zu untersuchen FET. Das Zeitverhalten wurde mit einem Oszilloskop MDO3000 aufgezeichnet.
Optische Bilder wurden unter Verwendung eines optischen Mikroskops (XTZ-2030JX mit einer CCD-Kamera) erhalten. Das Raman-Spektrum wurde im Renishaw in Via Raman-Mikroskop bei Raumtemperatur mit 532-nm-Laseranregung durchgeführt. Die AFM-Charakterisierung erfolgte mit einem Mikroskop von Bruker Multimode 8.
Ergebnisse und Diskussion
Abbildung 1a zeigt ein schematisches Diagramm von SnSe2 FET-Gerät. Die Kontakte sind mit einer Schicht PMMA (Typ 950 A5) bedeckt, um sie elektrisch vom oberen Gate zu isolieren, das aus einem Tropfen DI-Wasser besteht, das aus einer Pipette getropft wird. Das Gerät kann durch eine obere Gate-Spannung (V tg ) angelegt an eine Elektrode in Kontakt mit dem DI-Wassertropfen oder durch eine Back-Gate-Spannung (V bg ) aufgetragen über das SiO2 Unterstützung. Das optische Bild von SnSe2 Flocken mit gemusterten Elektroden ist in Abb. 1b gezeigt. Die Source-Drain-Lücke beträgt etwa 2 µm. Raman-Spektroskopie wurde verwendet, um SnSe2 . zu charakterisieren Material, wie in Abb. 1c gezeigt. Die Spitze des Fingerabdrucks liegt bei 187 cm −1 und 112 cm −1 entspricht dem Out-of-plane A 1g Modus und in der Ebene E g Modus, der gut mit den Berichten anderer übereinstimmt. Es ist jedoch schwierig, die Dicke für SnSe2 . zu bestimmen von der Position des Raman-Gipfels. Im Gegensatz zu MoS2 , ist die dickenabhängige Charakteristik der Raman-Peakposition nicht klar [24,25,26]. Daher haben wir die Rasterkraftmikroskopie (AFM) eingeführt, um die Flockendicke direkt zu messen. Wie in Fig. 1d gezeigt, ist die Dicke von SnSe2 Flocke ist ungefähr 34 nm.
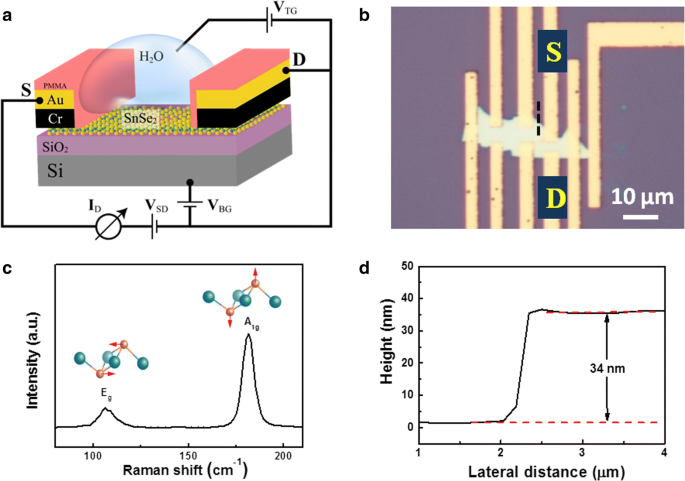
Eine Illustration von SnSe2 Fototransistor und einige grundlegende Charakterisierungen des SnSe2 Flocke. a Schematische Darstellung eines SnSe2 Feldeffekttransistor-Gerät. b Optisches Bild eines SnSe2 Flocke, wobei S und D die zu untersuchenden Source- bzw. Drain-Elektroden bezeichnen. c Raman-Spektrum eines SnSe2 Flocke. d Ein aus der schwarzen gestrichelten Linie extrahiertes Höhenprofil (dargestellt in Abb. 1b ) bei der AFM-Messung
Die Ausgangskurve des FET-Bauelements unter verschiedenen Back-Gate-Spannungen, gemessen im Dunkeln, ist in Fig. 2a gezeigt. Die lineare und symmetrische Beziehung von I d -V ds zeigt einen ohmschen Kontakt zwischen den Ti/Au-Elektroden und dem SnSe2 Kanal. Aus Abb. 2a haben wir herausgefunden, dass der Modulationseffekt der Leitfähigkeit von SnSe2 durch Back-Gate-Spannung ist sehr gering. Das Verhältnis von I d zwischen Gatespannung 30 und − 30 V beträgt nur 1,15 bei V ds von 50 mV. Das aktuelle Ich d an der Back-Gate-Spannung von − 30 V ist so groß wie ~ 1,47 μA bei V ds von 5 mV, die durch Backgate-Spannung nicht ausgeschaltet werden konnte. Selbst eine Erhöhung der großen Gatespannung auf 100 V brachte den Kanal immer noch nicht in den Aus-Zustand, da das Gate-Potential durch die ultrahohe Ladungsträgerdichte im SnSe2 . abgeschirmt wurde , über die in früheren Arbeiten von Pan und Su berichtet wurde [12, 13]. Nach der Halbleitertheorie können wir die Verarmungsbreite W . grob abschätzen einer Metall-Isolator-Halbleiter(MIS)-Struktur, die bestimmt ist durch \( W={\left(\frac{2{\varepsilon}_r{\varepsilon}_0{\varphi}_s}{e{N}_D }\right)}^{1/2} \), wobei φ s ist das Oberflächenpotential, N D die Konzentration der Donorverunreinigung und ε 0 und ε r Vakuum bzw. relative Permittivität. Einnahme von φ s , ε r , N D von 1 V, 9,97 und 1 × 10 18 /cm 3 in die Gleichung als konservative Berechnung die Verarmungsbreite W ist ungefähr 22 nm, was viel kleiner ist als die Dicke unseres SnSe2 Flocke (34 nm). Es ist also leicht zu verstehen, dass die Elektronen durch die Back-Gate-Modulation nicht verarmt werden.
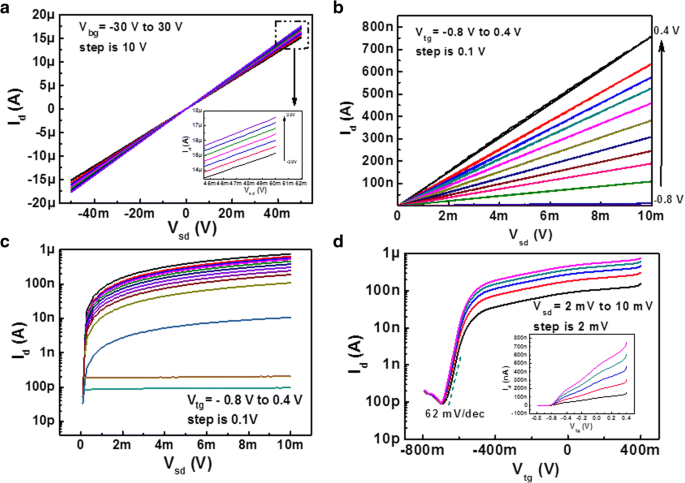
Ausgangs- und Übertragungscharakteristik von SnSe2 FET im Dunkeln gemessen. Ich d gegen V sd Charakteristik von SnSe2 FET mit verschiedenen Back-Gating-Spannungen V bg (a ), bei unterschiedlichen Top-Gating-Spannungen V tg in einer linearen Skala (b ) und an verschiedenen V tg in einer halblogarithmischen Skala (c ). Ich d gegen V tg Charakteristik von SnSe2 FET mit V sd im Bereich von 2 mV bis 10 mV in Schritten von 2 mV, gezeichnet in einer halblogarithmischen Skala, der Einschub ist ein linear skaliertes Diagramm von I d -V tg charakteristisch (d )
In auffallendem Gegensatz dazu, wenn DI-Wasser als Top-Gate verwendet wird, ist das I d -V ds Kurve zeigt eine effiziente Modulation selbst bei einer kleinen Gate-Vorspannung, wie in Fig. 2b gezeigt. Das Stromverhältnis zwischen den Gatespannungen von 0,4 V und – 0,8 V beträgt mehr als 10 3 , was deutlicher aus Fig. 2c ersichtlich ist, die in einem halblogarithmischen Maßstab gezeichnet ist. Die Transferkurven zu SnSe2 FET mit Top-Gate sind in Fig. 2d gezeigt, die ein typisches n-leitendes Verhalten zeigt. Die Spannung scannt von der negativen Richtung in die positive Richtung mit einer Abtastrate von 10 mV/s. Die elektrische Doppelschicht (EDL) in ionischer Flüssigkeit oder Festelektrolyt besitzt eine hohe Kapazität und kann verwendet werden, um eine sehr effiziente Ladungskopplung in 2D- und Schichtmaterialien zu erreichen. Jedoch erfordern langsame Ladungstransferprozesse aufgrund der großen Ionen in Größe und Masse niedrige Vorspannungsabtastraten, um das Gleichgewicht an der Gate-Kanal-Grenzfläche aufrechtzuerhalten. Im Gegensatz dazu werden bei Verwendung von DI-Wasser als dielektrische Schicht sowohl H + und OH − Ionen haben eine geringere Größe und Masse und Wasser hat eine niedrige Viskosität. Daher unterstützt DI-Wasser-Gating über die Doppelschicht an der Wasser-Halbleiter-Grenzfläche viel höhere Spannungs-Sweep-Raten und reagiert schneller als das Gating von ionischen Flüssigkeiten oder Festelektrolyt-Gating. Der Einschub ist ein linear skalierter Plot von I d -V tg charakteristisch. Bemerkenswert ist, dass DI-Wasser als Top-Gate die Transkonduktanzeigenschaften des SnSe2 . stark verbessert FET. Als V tg variiert von − 0,8 bis 0,4 V, I d ändert sich von 9,5 × 10 −11 bis 7,6 × 10 −7 A mit einem Ein-/Aus-Stromverhältnis von ∼ 10 4 . Der aus der Übertragungskennlinie berechnete unterschwellige Swing beträgt ∼ 62 mV/Dekade. Diese Werte sind gut genug für den praktischen Niederspannungsbetrieb von geschichteten Metallchalkogenid-FETs. Die Mobilität μ kann mit folgender Gleichung berechnet werden:\( \mu =\frac{d{I}_d}{d{V}_g}\cdotp \frac{L}{W{C}_{H2O}{V}_{ sd}} \), wobei L und W sind die Kanallänge und -breite (L = 2 μm, W = 5 μm) und C H2O ist die DI-Water-Gate-Kapazität pro Flächeneinheit. Hier ist die Kapazität von C H2O wurde mit 348 nF/cm 2 . gemessen , für die die detaillierte Berechnung dem Begleitmaterial beigefügt ist (Zusatzdatei 1:Abbildung S1a und b). Die erhaltene Elektronenmobilität beträgt 127 cm 2 /Vs, was im Vergleich zu anderen 2D-Materialien mit wenigen Schichten recht gut ist. Über den wesentlich verbesserten Modulationseffekt, der durch Top-Gate mit DI-Wasser als dielektrische Schicht realisiert wird, wurde jemals in Huangs Arbeit berichtet [27]. Sie haben DI Water Gate auf dem SnS2 . angewendet , MoS2 , und BP-Flake und erreichten ein hohes An/Aus-Verhältnis, einen idealen Schwung unter der Schwelle und eine ausgezeichnete Beweglichkeit. Sie führten diese Verbesserungen auf die perfekte Abschirmung der Flocken von den umgebenden Adsorbaten und die Passivierung der Grenzflächenzustände durch das hohe k . zurück Dielektrikum (ε r (H2O) = 80). Die Passivierungs- und Abschirmwirkung von DI-Wasser ist ähnlich wie bei anderen herkömmlichen hochdielektrischen Materialien wie HfO2 oder Al2 O3 [18, 19]. Darüber hinaus ist die effektive Kopplung zwischen dem DI-Wasser und dem SnSe2 durch die Flockenkanten scheint eine wichtige Rolle zu spielen, um auch bei dicken Flocken ein hohes An/Aus-Verhältnis zu erreichen. Im Vergleich zu SiO2 Back-Gating kann DI-Wasser-Gating den elektrischen Feldabstand effektiv reduzieren (von wenigen 100 nm auf weniger als 1 nm), sodass die Schwellen-Gate-Spannung ebenfalls von einigen zehn Volt auf weniger als 1 V absinkt. 2d, der kleine Stromsprung bei etwa V tg = 0.4 V wird möglicherweise durch die Elektrolyse von DI-Wasser aufgrund seines engen elektrochemischen Fensters verursacht, über das in Huangs Arbeit berichtet wurde [27].
Die zeitabhängige photoelektrische Reaktion des SnSe2 Ein durch Back- oder Top-Gating gesteuerter FET ist in Abb. 3 dargestellt. Interessanterweise ist der SnSe2 FET zeigt einen positiven Photostrom bei einem negativen Gate und einen negativen Photostrom bei einem positiven Gate, unabhängig vom Gate vom Backgate über SiO2 oder vom oberen Tor durch DI-Wasser. Aus Fig. 3a können wir sehen, dass die Größe des Photostroms mit zunehmender negativer Back-Gate-Spannung zunimmt. Wenn die Back-Gate-Spannung –80 V beträgt, ist die relative Photoleitfähigkeit (definiert als Δσ/σ 0 , wobei σ 0 ist die Dunkelleitfähigkeit und Δσ ist der Unterschied zwischen σ und σ 0 ) beträgt 5 %. Bei Verwendung von DI-Wasser als Top-Gate erhalten wir ein ähnliches Gesetz wie in Abb. 3b gezeigt. Bei einer Einstellung der oberen Gate-Spannung von – 0,4 V könnte die relative Photoleitfähigkeit 6% erreichen. Es ist jedoch leicht zu erkennen, dass die Reaktionszeit zwischen den beiden Arten von Gating ziemlich unterschiedlich ist. Für Back-Gating mit SiO2 als Dielektrikum beträgt die Ansprechzeit für die Anstiegsflanke etwa 30 µs. Beim Top-Gating mit DI-Wasser als Dielektrikum beträgt die Reaktionszeit dagegen nur 1,7 s. Als Reaktionszeit wird hier die Anstiegszeit von 10–90% (bzw. die Abfallzeit von 10–90%) definiert. Die viel schnellere Reaktionsgeschwindigkeit beim DI-Water-Gating sollte mit der höheren Trägermobilität (127 cm 2 /Vs) aufgrund der wirksamen Abschirmung von Verunreinigungen oder Streuung von Adsorbaten. Interessanterweise ist bei positiver Gatespannung der SnSe2 Film weist eine negative Photoleitfähigkeit (NPC) auf, wie in Fig. 3c und d gezeigt. Es sollte betont werden, dass die Gate-abhängige bipolare Photoleitfähigkeit nicht durch den Leckstrom zwischen Gate und Source induziert wird. Wir haben den Leckstrom von I . gemessen g beim Anlegen einer positiven oder negativen Gate-Vorspannung, wie in Zusatzdatei 1 gezeigt:Abbildung S2. Das Zeichen von Ich g folgt der Richtung von V gs und steht genau im Gegensatz zum Vorzeichen des Drain-zu-Source-Photostroms (I d ). Darüber hinaus ist die Größe von I g ist viel kleiner als ich d , sodass seine Auswirkungen ignoriert werden können. Im NPC von SnSe2 FET mit H2 O als Dielektrikum gibt es zwei Eigenschaften, die sich von der positiven Photoleitfähigkeit (PPC) unterscheiden. Einer ist der Absolutwert des relativen Photoleitfähigkeits-Gatings bei positivem V tg (~ 20%) ist deutlich größer als das Gating bei negativem V tg (6%). Das andere ist das SnSe2 FET zeigt eine viel längere Reaktionszeit (~ 30 s) bei positiver V tg als bei negativem V tg (1.7 s).

Zeitabhängigkeit der Photoantwort von SnSe2 FET mit V . vorgespannt sd = 5 mV bei unterschiedlichen negativen Back-Gating-Spannungen V bg (a ), negative Top-Gating-Spannungen V tg (b ), positive Back-Gating-Spannungen V bg (c ) und positive obere Gate-Spannungen V tg (d )
Das Phänomen der negativen Photoleitfähigkeit (NPC) wurde bei mehreren Halbleiter-Nanostrukturen wie Kohlenstoff-Nanoröhren, InAs-Nanodrähten und ZnSe-Nanodrähten berichtet [28,29,30]. Es wird allgemein angenommen, dass molekulare Sauerstoffadsorption und Photodesorption für den NPC-Effekt verantwortlich sind. Eine solche Erklärung gilt jedoch nicht für unser SnSe2 System, da die Sauerstoffdesorption nur zu einer höheren Elektronenkonzentration und Leitfähigkeit führen würde. Um den NPC-Effekt und die Koexistenz von NPC und PPC in SnSe zu verstehen2 , wir haben das I gemessen d -V tg Kurven von SnSe2 FET unter Beleuchtung, wie in Abb. 4 gezeigt. Zum besseren Vergleich wurden auch die Transferkurven im Dunkeln hinzugefügt. Man erkennt, dass das Bauelement eine bipolare Photoleitfähigkeit aufweist, die durch Gatespannung geschaltet werden kann. Die unter Beleuchtung und im Dunkeln gemessenen Übertragungskurven schneiden sich fast bei einer Gatespannung von 0 V. Daher zeigt das Gerät eine positive Photoleitfähigkeit bei einer negativen Gate-Vorspannung und eine negative Photoleitfähigkeit bei einer positiven Gate-Vorspannung, was mit den Ergebnissen übereinstimmt in Abb. 3 dargestellt. Bekanntlich beträgt die Leitfähigkeit σ wird bestimmt als σ = neμ , wobei n , e , und μ sind Ladungsträgerkonzentration, Elektronenladung bzw. Mobilität. Die Leitfähigkeit wird also durch das Produkt aus Ladungsträgerkonzentration und Mobilität bestimmt. In der Übertragungskurve unter Licht die Änderung der Steilheit g m über der Null-Gate-Spannung impliziert eine Änderung der Mobilität. Aus den Transferkurven kann die Beweglichkeit von Beleuchtung und Dunkelheit berechnet werden, wie in den Tabellen 1 und 2 gezeigt. Die Beweglichkeit von SnSe2 im Dunkeln etwa 70 cm 2 /Vs, während die Mobilität unter Beleuchtung zwei Werte hat:etwa 60 cm 2 /Vs bei minus Gate-Bias und ~ 4 cm 2 /Vs bei plus Gate-Vorspannung. Bei negativem V tg , ist die Beweglichkeit des hellen und des dunklen Zustands fast gleich, während die Ladungsträgerkonzentration bei Lichtanregung größer ist als die des dunklen Zustands. Das Gerät weist also eine positive Photoleitfähigkeit auf. Bei positivem V tg , ist die Beweglichkeit mehr als eine Ordnung kleiner als bei negativem V tg , und die Abnahme der Mobilität übersteigt die Zunahme der Ladungsträgerkonzentration und dominiert die Entwicklung der Photoleitfähigkeit. Somit tritt eine negative Netto-Photoleitfähigkeit anstelle der positiven Photoleitfähigkeit auf.
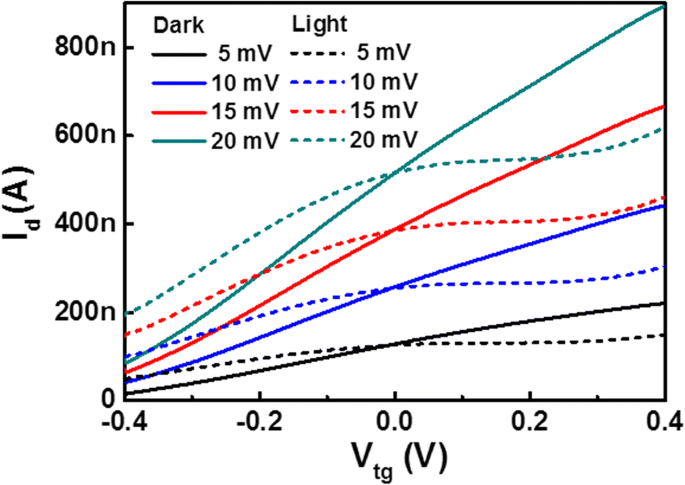
Ich d -V tg Charakteristik von SnSe2 FET bei Beleuchtung und im Dunkeln
Pai-Chun Wei et al. fanden einen NPC-Effekt in einer kleinen Bandlücke und einem entarteten InN-Film und schrieben ihn der durch starke Streuung von den geladenen Rekombinationszentren verursachten Verringerung der Mobilität zu [31], die auf unser SnSe2 . angewendet werden kann System. Aber warum die Mobilität abnimmt, wenn die Gate-Vorspannung von der negativen zur positiven Spannung scannt, ist nicht klar. Wir glauben, dass dieses Phänomen von einigen In-Gap-Staaten stammt. Die In-Gap-Zustände können durch einige Punktdefekte, wie beispielsweise Se-Leerstellen, verursacht werden. Bei Beleuchtung sind die Zustände in der Lücke unter E f wird einige photogenerierte Löcher einfangen und zu positiv geladenen Streuzentren werden. Mit V tg Scannen vom negativen zum positiven Bias, mehr Zustände in der Lücke fallen unter E f werden zu aufgeladenen Streuzentren, was zu einem Rückgang der Mobilität führt. Es sind weitere Arbeiten erforderlich, um den Mechanismus von NPC vollständig zu verstehen.
Schlussfolgerungen
Zusammenfassend ist SnSe2 Feldeffekttransistor (FET) wurde auf Basis von SnSe2 . hergestellt Flocken Peeling aus Einkristall. Mit einem Tropfen Wasser als oberes dielektrisches Gate haben wir das Gerät mit einem hohen Stromunterdrückungsverhältnis von ~ 10 4 . erfolgreich ausgeschaltet . Im Vergleich zu SiO2 dielektrisches Gate, das DI-Wasser kann das Transportverhalten von SnSe2 . eminent verbessern FET mit einem idealen unterschwelligen Swing von ∼ 62 mV/Dekade und einer exzellenten Elektronenmobilität von ~ 127 cm 2 V −1 s −1 bei 300 K. Besonders das SnSe2 FET zeigt bipolare Photoleitfähigkeit, wenn die Vorspannung des oberen Gates von – 0,4 bis + 0,4 V abtastet. Die Polarität könnte durch das Vorzeichen der Gate-Spannung umgeschaltet werden. Bei einer negativen Gate-Vorspannung wird die positive Photoleitfähigkeit von der Zunahme der Ladungsträgerkonzentration dominiert. Bei einer positiven Vorspannung wird die negative Photoleitfähigkeit durch einen starken Abfall der Mobilität verursacht. Ein Wettbewerb zwischen der Ladungsträgerkonzentration und der Mobilität bestimmt die Entwicklung der Photoleitfähigkeit. Mit einer einfachen Solution-Gate-Methode, die in dieser Arbeit vorgestellt wird, ist die SnSe2 FET weist hervorragende elektrische Eigenschaften auf und präsentiert gleichzeitig eine interessante polaritätsumschaltbare Photoleitfähigkeit, die einen neuen Modulationsweg für optoelektronische Hochleistungsgeräte eröffnen wird.
Abkürzungen
- 2D:
-
Zweidimensional
- AFM:
-
Rasterkraftmikroskopie
- ALMs:
-
Atomar geschichtete Materialien
- DI:
-
Entionisiert
- FETs:
-
Feldeffekttransistoren
- MIS:
-
Metall-Isolator-Halbleiter
- NPC:
-
Negative Photoleitfähigkeit
- PMMA:
-
Polymethylmethacrylat
- PPC:
-
Positive Photoleitfähigkeit
- TMDs:
-
Übergangsmetalldichalkogenide
Nanomaterialien
- Digitale (EIN/AUS) Hall-Effekt-Geräte:Schalter und Verriegelungen
- DATENMODUL:Großformatige Open-Frame-Monitore mit hoher Helligkeit und easyTouch-Funktion
- Mehrschichtige SnSe-Nanoflake-Feldeffekttransistoren mit niederohmigen Au-Ohm-Kontakten
- RGO und dreidimensionale Graphen-Netzwerke modifizierte TIMs mit hoher Leistung gemeinsam
- Graphen/Polyanilin-Aerogel mit Superelastizität und hoher Kapazität als hochkompressionstolerante Superkondensatorelektrode
- Lateraler, doppelt diffundierter Metall-Oxid-Halbleiter-Transistor mit extrem niedrigem spezifischen On-Widerstand mit verbessertem Dual-Gate und partieller P-vergrabener Schicht
- Eine widerstandslose Spannungsreferenz im Nanomaßstab mit hohem PSRR
- Ge-pMOSFETs hoher Mobilität mit amorpher Si-Passivierung:Einfluss der Oberflächenorientierung
- Hochleistungskathodenmaterial aus FeF3·0.33H2O, modifiziert mit Kohlenstoffnanoröhren und Graphen für Lithium-Ionen-Batterien
- poröse ZnO-Nanoblätter mit partieller Oberflächenmodifikation für verbesserte Ladungstrennung und hohe photokatalytische Aktivität unter Sonnenbestrahlung



