Verbesserte ferroelektrische Leistung von Mg-dotierten LiNbO3-Filmen durch eine ideale Atomschicht mit abgeschiedener Al2O3-Tunnelschaltschicht
Zusammenfassung
Doppelschichtstrukturen bestehend aus 5 % Mg-dotiertem LiNbO3 Einkristallfilme und ultradünnes Al2 O3 Schichten mit einer Dicke im Bereich von 2 bis 6 nm wurden unter Verwendung der Ionenslicing-Technik in Kombination mit der Atomlagenabscheidungsmethode hergestellt. Die Messergebnisse des Übergangsbereichsschaltstroms zeigen, dass der P-V Hystereseschleifen sind im Typ-II-Modus mit einem einzigen Spannungsimpuls pro Zyklus symmetrisch, was auf das eingebaute elektrische Feld zurückzuführen ist, das durch asymmetrische Elektroden und die Kompensation eines internen Aufdruckfeldes gebildet wird. Außerdem ist das eingelegte Al2 O3 , als ideale Tunnelschaltschicht, schaltet während des ferroelektrischen Schaltens ein, schließt jedoch während des Nachschaltens oder Nicht-Schaltens unter der angelegten Pulsspannung. Die Al2 O3 Schicht blockiert die nachteiligen Effekte wie die Ladungsinjektion durch die Elektrode und verbessert die Dauerfestigkeitseigenschaften von Mg-dotiertem LiNbO3 ferroelektrische Kondensatoren. Diese Studie bietet einen möglichen Weg, um die Zuverlässigkeitseigenschaften von ferroelektrischen Bauelementen in der Anwendung nichtflüchtiger Speicher zu verbessern.
Hintergrund
Lithiumniobat(LN)-Einkristallfilme werden aufgrund ihrer hervorragenden physikalischen Eigenschaften [1,2,3,4,5,6] häufig in Oberflächenwellenoszillatoren, elektrooptischen Modulatoren und Datenspeichern auf Basis von der Domänenwechsel. Kürzlich wird ein Lithium-Niobat-auf-Isolator (LNOI) im Wafermaßstab, der ein großes Anwendungspotenzial für hochdichte integrierte Schaltkreise in elektro-optischen, akusto-optischen und Datenspeichergeräten hat, durch eine Ionenimplantations- und Wafer-Bonding-Technologie hergestellt . Diese Technologie ermöglicht eine Vielzahl von Substraten wie LN, Silizium und sogar die CMOS-Schaltung [3, 7,8,9]. Die Prägehystereseschleife stammt jedoch aus bevorzugten Orientierungen und der geringen Ermüdungsbeständigkeit von LN-Filmen aufgrund der Ladungsinjektion durch die Elektrode destabilisiert die Beibehaltung der Polarisationsumkehr, was ihre Anwendung in nichtflüchtigen Speichervorrichtungen einschränkt [10,11,12 ,13]. Die bevorzugten Orientierungen beziehen sich auf passive Grenzflächenschichten, die zwischen ferroelektrischen Schichten und Elektroden gebildet werden, die ein starkes Depolarisationsfeld in der entgegengesetzten Polarisationsrichtung induzieren können. Es kann die injizierten Ladungen nach dem Entfernen der angelegten Spannung oder während der intermittierenden Zeit der nachfolgenden Pulsbelastung austreiben [11, 12]. Andererseits wird aufgrund des Vorhandenseins von passiven Grenzflächenschichten die Ermüdungsbeständigkeit von LN-Filmen verbessert, indem die Ladungsinjektion von der Nebenelektrode nach dem ferroelektrischen Schalten blockiert wird. Der Ermüdungsprozess beschleunigt sich jedoch, wenn die Zeit der angelegten Pulsperiode unter 0,5 µs verkürzt wird. Dies wird durch den Beitrag der passiven Grenzflächenschichten zur akkumulierten Raumladung bei bestimmten Frequenzen beschrieben [11]. Es wird berichtet, dass ein eingelegtes Al2 O3 dielektrischer Film kann als Tunnelschalter im dielektrischen/ferroelektrischen Doppelschichtkondensator spielen, zum Beispiel in Al2 O3 /Pb (Zr,Ti)O3 , und Al2 O3 /Mn-dotiertes BiFeO3 Doppelschichtstrukturen [14,15,16]. Die Al2 O3 Tunnelschalter schaltet während der Polarisationsumschaltung als Leiter ein, schaltet aber als Isolator aus, um die Ladungsinjektion durch die Elektrode nach abgeschlossener Polarisationsumschaltung oder keinem Schaltvorgang zu blockieren [14]. Daher kann es die unerwünschten injizierten Ladungen und das Polarisationsrückschalten verhindern und dann die Zuverlässigkeit des dielektrischen/ferroelektrischen Doppelschichtkondensators verbessern.
In dieser Arbeit haben wir einen 200 nm dicken Z-Schnitt mit 5 % Mg-dotierten kongruenten LN-Einkristall-Dünnschichten hergestellt und dann ultradünnes Al2 . abgeschieden O3 Schichten mit verschiedenen Dicken (2–6 nm) auf LN, um Doppelschichtkondensatorstrukturen zu bilden. Die Al2 O3 Folien als Tunnelschalterschichten können die Ermüdungsbeständigkeit verbessern. Asymmetrische Elektroden (Au/Pt-Elektroden) sind so konstruiert, dass sie ein eingebautes elektrisches Feld gegen das durch die passiven Grenzflächenschichten induzierte Depolarisationsfeld bilden. Die elektrischen Ergebnisse zeigen die Symmetrierung der Hystereseschleife, die mit der Zeit von den Domänenschaltstromtransienten übertragen wird. Inzwischen beweist es auch, dass das eingelegte Al2 O3 Die Schicht spielt als Tunnelschaltschicht, die während des ferroelektrischen Schaltens auftauchen und sich nach abgeschlossenem Polarisationsschalten oder keinem Schaltvorgang schließen kann.
Methoden
Das 5 % Mg-dotierte kongruente LiNbO3 . mit Z-Schnitt (LN) einkristalline Dünnfilme wurden von ihren Volumenkristallen durch Verwendung einer Ionenimplantations- und Waferbonding-Technologie abgezogen, wie an anderer Stelle beschrieben [10, 11, 17, 18]. Im Einzelnen wurde die Oberflächenschicht eines LN-Volumenkristalls zuerst mit He-Ionen in der gewünschten Tiefe implantiert, indem die Implantationsenergie und die Dosis der injizierten Ionen kontrolliert wurden, und dann wurden eine 5 nm Cr-Adhäsionsschicht und eine 100 nm Pt-Bodenelektrodenschicht durch DC abgeschieden Sputtern (KJ Lesker PVD-75). Die Oberflächenschicht wurde mit einem anderen LN-Substrat verbunden, das mit 1 µm dickem SiO2 . bedeckt war Pufferschicht und abgeschnitten. Die Dicke des LN-Films wird durch chemisch-mechanisches Polieren auf etwa 200 nm kontrolliert. Anschließend ultradünnes Al2 O3 Folien mit Dicken (d ) von 2–6 nm wurden von ALD (TFS-200, Beneq, Finnland) hinterlegt. Im Einzelnen handelt es sich bei den Vorläufergasen um Diethylzink und entionisiertes Wasser. Sie wurden abwechselnd mit einer Pulszeit von 50 µm in die Reaktionskammer gepulst und durch Spülschritte mit Argon für 2 µs bei einer Reaktionstemperatur von 200 °C getrennt [19]. Schließlich obere quadratische Au-Elektroden mit Flächen von 1.0 × 10 –4 cm 2 wurden durch eine flache Metallmaske abgeschieden.
Die Dicken von Al2 O3 als Kontrast auf dem Si-Wafer abgeschiedene Schichten wurden mit einem spektroskopischen Ellipsometriesystem (GES-5E, SOPRA, Courbevoie, Frankreich) gemessen. Die Filmstruktur wurde durch Röntgenbeugung (XRD) (Bruker D8 Advance) in einem θ-2θ-Scanmodus mit Cu K . analysiert α Strahlung sowie Querschnitts-Rasterelektronenmikroskopie (REM, Sigma HD, Zeiss). Um die Domänenschaltdynamik zu untersuchen, wurden mehrere Rechteckimpulse mit einer Anstiegszeit von 10 ns an die oberen Elektroden angelegt, indem ein Einkanal-Impulsgenerator Agilent 8114A verwendet wurde, wobei die unteren Elektroden geerdet waren. In der Schaltung wird der Domänenschaltstrom (I sw ) über in Reihe geschaltete interne Widerstände aller Instrumente mit dem Gesamtwiderstand wurde mit einem LeCroy HDO6054 Oszilloskop überwacht. Die Werte der beiden Ausgangswiderstände des Impulsgenerators R W und der Eingangswiderstand des Oszilloskops R O sind jeweils 50 Ω.
Ergebnisse und Diskussion
Abbildung 1a zeigt das XRD-Ergebnis des LN-Dünnfilms auf einem Pt/Cr/SiO2 . /LN-Substrat. Der Film hat starke (00 l ) Reflexe, die in der rhomboedrischen Phasensymmetrie indiziert sind. Darüber hinaus gibt es auch einige Beugungspeaks von Pt- und Cr-Filmen, die in Abb. 1a markiert sind. Das Fehlen anderer Peaks bestätigt die hohe Kristallinität des LN-Films ohne Phasenverunreinigung. Das REM-Querschnittsbild der in Abb. 1b gezeigten Probe zeigt die klare Grenzflächenstruktur mit LN, Pt, Cr und SiO2 Stapeln von Schichten.
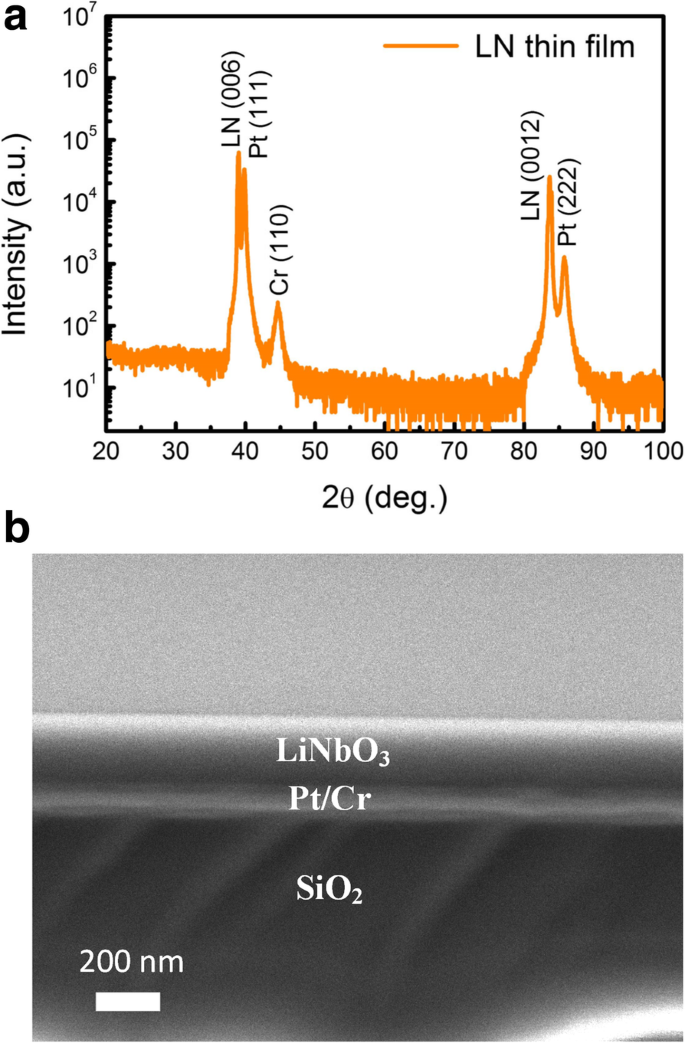
a Das XRD-Muster und b Querschnitts-REM-Aufnahme des 200 nm dicken LN/Pt/Cr/SiO2 . mit Z-Schnitt /LN-Film
Um den kinetischen Mechanismus des Domänenumschaltens zu untersuchen, werden zwei Arten von Pulsspannungsmoden entworfen, wie in Abb. 2a und b deutlich gezeigt [11]. Typ I ist als Doppelimpulse in entgegengesetzter Polarität mit einem Zeitintervall von 5 s konfiguriert. Der erste Impuls wird angelegt, um den auf die obere Elektrode zeigenden Aufwärtspolarisationszustand umzuschalten, und der zweite kann die Abwärtspolarisation umschalten. Begrenzt durch die Programmierzeit einer Einkanal-Impulserzeugung ist jedoch das minimale Zeitintervall aufgrund der bevorzugten Domänenorientierung zu lang, um den durch den zweiten Impuls hervorgerufenen Domänenumschaltstrom-Übergang zu erfassen. Um den Transienten des Domänenschaltstroms abzufangen, wird beim Typ II ein einzelner Impuls vorgeschlagen, der eine negative Grundlinien-DC-Vorspannung überlappt, wobei die anfängliche negative DC-Vorspannung den Polarisationszustand nach oben schalten kann und der positive Impuls die Domäne nach unten setzt. Hier ist die Breite der beiden Impulstypen auf 1 μs eingestellt.

Die Skizze der beiden Sequenzpulsspannungsmodi mit a Typ I (Doppelpulse in zwei entgegengesetzten Polaritäten) und b Typ II (ein einzelner Schaltimpuls, der eine negative DC-Vorspannung überlappt). Stromtransienten beim Domänenumschalten unter verschiedenen V angewendet auf eine jungfräuliche Probe in c Typ I und d Moden vom Typ II, wobei die Einschübe die lineare Anpassung der Abhängigkeit der Plateaus des Domänenschaltstroms von V . zeigen . P -V Hystereseschleifen unter verschiedenen V übertragen von Domain-Switching-Stromtransienten in e Typ I und f Typ II. Schematische Darstellung der Au/LN/Pt-Struktur und die Richtungen des eingebauten elektrischen Feldes E b und Depolarisationsfeld E d im Einschub von e
Abbildung 2c und d zeigen die Transienten des Domänenschaltstroms im Vergleich zur Zeit (t ) einer Au/LN/Pt-Strukturprobe unter verschiedenen angelegten Spannungen (V ) im Modus Typ I bzw. Typ II. Die Plateaus von Domänenschaltstromtransienten werden beobachtet, die in der Breite schmal sind, aber mit V . in der Höhe zunehmen steigt nach dem anfänglichen Kondensatorladestrom bei 30 ns an. Die Plateauhöhe in zwei Modi zeigt beide eine lineare Beziehung mit der Zunahme von V und die Ergebnisse sind in den Einfügungen durch die durchgezogene Anpassung der Daten zusammengefasst [11, 13]. Die Koerzitivspannung (V c )-Wert in den beiden Modi auf etwa 24,7 V aus der Leitungsunterbrechung mit der Spannungsachse abgeleitet werden. Nach Beendigung des Schaltimpulses tritt der Kondensatorentladestrom nach 1 μs auf, was darauf hindeutet, dass die bevorzugte Domänenorientierung der aufwärts gerichtete Polarisationszustand ist, der zur oberen Elektrode zeigt.
P -V Hystereseschleifen unter verschiedenen angelegten Spannungen in zwei Typenmodi können direkt von den entsprechenden Domänenschaltstromtransienten in Abb. 2c und d übertragen werden, und die Ergebnisse sind in Abb. 2e bzw. f gezeigt [11, 20]. Eine bestimmte Vorwärtskoerzitivspannung von ungefähr 25 V unveränderlich mit V wird in den beiden Arten von Impulsen erhalten. Die Koerzitivspannung nähert sich V c extrahiert aus dem linearen I sw -V Plot im Einschub von Abb. 2c und d. Im Gegensatz zum undotierten LN-Film ist der V c ist variabel und der Wert entspricht den maximal angelegten Spannungen [10]. Für das 5 % Mg-dotierte LN ist das definierte V c ist unveränderlich mit V , wie in Abb. 2e und f gezeigt. Dies liegt daran, dass die Mg-Dotierung Li-Stellen-Metallleerstellen und Sauerstoffleerstellen-bezogene Defekte erzeugen kann, [21,22,23] die Raumladungen einfangen und die Widerstandsabbauzeit über die Grenzflächenschichten zwischen dem Film und dem oberen/unteren effektiv verkürzen können Elektroden [11]. Daher überlappen Domänenschaltströme mit Kondensatorladeströmen bei der Beschleunigung der Domänenschaltgeschwindigkeit mit einem definierten V c , wie in Abb. 2c und d gezeigt. Durch den Pulsgenerator begrenzt, kann die Ausgangs-Grundlinienspannung im Typ-II-Modus jedoch nicht symmetrisch verschoben werden, wenn die angelegte Pulsspannung über 32 V erhöht wird. Im Vergleich zu den eingeprägten Schleifen entlang der positiven Spannungsachse in Fig. 2e ist die Symmetrierung der Schleifen entlang der Spannungsachse in Abb. 2f erreicht, anders als in Pt/LiNbO3 /Pt-Strukturen, bei denen das P -V Hystereseschleifen entweder vom Typ I oder vom Typ II werden in Richtung einer positiven Spannung eingeprägt [11]. Der Grund des symmetrischen P -V Schleifen in Abb. 2f können auf die entworfenen asymmetrischen Elektroden (hier Au/Pt) zurückgeführt werden. Die Austrittsarbeit der Au-Elektrode beträgt 5,1 eV, was etwas kleiner ist als die von Pt (5,65 eV) [24]. Es wird ein eingebautes elektrisches Feld (E b ) mit der Richtung, die von der oberen Elektrode zur unteren Elektrode zeigt, gezeigt im Einschub von Fig. 2e. Das Depolarisationsfeld (E d ) induziert durch die passiven Grenzflächenschichten hat die entgegengesetzte Richtung zu E b . Das E d kann bei Typ II für die symmetrischen Elektroden (Pt/Pt) die Polarisation in kürzester Zeit nach Beendigung des Schaltpulses zurückschalten [11]. In unserem Experiment ist das E b kann das E partially teilweise abschirmen d und akkumulieren injizierte Ladungen als Kompensation eines internen Prägefeldes, [16] was die Rückschaltzeit verlangsamen kann. Daher kann die geschaltete Domäne aufrechterhalten, und rückschaltende Stromtransienten werden durch Typ-II-Impulse erfasst. Allerdings ist das Zeitintervall der beiden Pulse mit entgegengesetzter Polarität im Typ-I-Modus zu lang. Nach dem ersten Impuls werden die eingefangenen injizierten Ladungen um E b wird nach und nach aus dem Film vertrieben von E d vor dem Eintreffen des zweiten Pulses bei Typ I [11]. Um die Zuordnung des eingebauten elektrischen Feldes zur Symmetrierung der Schleifen zu beweisen, wurde Pt/LiNbO3 Eine Probe mit symmetrischer /Pt-Struktur wurde hergestellt und die eingeprägten Schleifen entlang der positiven Spannungsachse wurden direkt von den entsprechenden Domänenschaltstromtransienten in zusätzliche Datei 1 übertragen:Abbildung S1a bei positivem Impuls mit Spannungen/Breiten von 30–40 V/500 ns, gezeigt in Zusatzdatei 1:Abbildung S1b.
Abbildung 3a und b zeigen den Domänenwechselstrom (I sw ) Transienten gegen die Zeit (t ) von LN und Al2 O3 (6 nm)/LN-Proben unter unterschiedlicher angelegter Spannung (V ) im Modus Typ I. Nach dem Plateau des Domänenwechsels beträgt der Schaltstrom I sw zerfällt und ist gegeben durch:[13]
$$ {I}_{\textrm{sw}}={I_{\textrm{sw}}}^0\exp \left(-\frac{t-{t}_0}{R_{\textrm{L} }{C}_{\mathrm{i}}}\right)\\left({t}_0\le t\le {t}_{\mathrm{sw}}\right) $$ (1)wo t 0 , t sw , R L , und C ich sind die Anfangszeit der Domänenumschaltung, die Beendigungszeit der Domänenumschaltung, der Gesamtwiderstand aller Reihenwiderstände in der Schaltung bzw. die nichtferroelektrische Grenzflächenkapazität. Dies beschreibt den Ladungseinfangeffekt, der als passive Grenzflächenschicht in Reihe mit einer idealen ferroelektrischen Schicht modelliert werden kann. Ich sw 0 wird als Schaltstrom definiert und ist gegeben durch:
$$ {I_{\mathrm{sw}}}^0=\frac{V-{V}_{\mathrm{fc}}}{R_{\mathrm{L}}} $$ (2)
a , b Ich sw -t Abhängigkeiten vom Typ I unter verschiedenen V angewendet auf Al2 O3 /LN-Doppelschicht mit dem Al2 O3 Dicke d = 0 bzw. 6 nm, angepasst durch eine Reihe paralleler gestrichelter Linien an Gl. (1). c Die Plateaus des Domänenschaltstroms als Funktion der angelegten Spannung mit verschiedenen Al2 O3 Schichtdicken, wobei die durchgezogenen Linien die beste Anpassung der Daten an Gl. (2). d Die Al2 O3 -Schichtdicke d Abhängigkeit der Koerzitivspannung (V c ) extrahiert aus c . e , f Die extrahierte Grenzflächenkapazität C ich und Kontaktwiderstand R C als Funktionen des Al2 O3 Schichtdicke d
Während der Domänenumschaltung wird die an der ferroelektrischen Schicht angelegte Spannung auf die Koerzitivspannung V . festgelegt fc , und die zusätzliche Spannung (V -V fc ) wird auf R . angewendet L . R L auch der parasitäre Schaltungswiderstand (R P ) und Übergangswiderstand (R C ) zwischen dem Film und den Elektroden; daher R L = R O + R W + R P + R C . Der abklingende Teil der Schaltstromtransienten über der Zeit kann durch Gl. (1). Die Zeitkonstante R L C ich kann aus der Steigung der Anpassungslinien geschätzt werden. Abbildung 3c zeigt I sw 0 -V Plots mit verschiedenen Al2 O3 Dicken. R L und V C wurden aus den Steigungen und dem X . geschätzt -Achsenabschnitt der linearen Anpassungslinien. Es ist zu erkennen, dass das V C wird mit zunehmendem Al2 . linear erhöht O3 Dicke d , wie in Abb. 3d gezeigt. Hier das C ich Werte wurden als Fehlergrenzen bei jedem V . geschätzt in Abb. 3e [13]. Die Ergebnisse zeigen, dass C ich Wert nahezu konstant gehalten (1.4 ± 0.2) nF mit steigendem Al2 O3 Schichtdicke von 0 bis 6 nm.
Um R . zu berechnen C , werden die obere und untere Elektrode kurzgeschlossen, wodurch das R . erreicht werden kann P (~ 2 Ω) mit unterschiedlichen angelegten Spannungen, dargestellt als Schaltungskalibrierung durch die geöffneten Symbole in Abb. 3c. Daher ist die R C entspricht d berechnet und das Ergebnis ist in Abb. 3f dargestellt. R C steigt linear von 3 ± 2,5 Ω bei d = 0 bis 55 ± 10 Ω bei d = 6 nm. Die fast d -unabhängiges großes C ich Werte legen nahe, dass die Al2 O3 Schicht arbeitet als Reihenwiderstand während der Domänenumschaltung. Dies bedeutet, dass die Al2 O3 Tunnelschalter wurde während der FE-Umschaltung eingeschaltet.
Um die Gesamtkapazität der Doppelschicht während des FE-Nichtschaltens zu erhalten, muss das Schalten (P sw ) und nicht schaltend (P nsw ) Polarisationen vesus V mit d von 0 auf 6 nm unter Pulsen im Typ-I-Modus erhöht, gemessen und das Ergebnis ist in Abb. 4a dargestellt. Der Zweck der Wahl des Pulses vom Typ I besteht darin, die Kurve von P . zu erhalten nsw -V wenn die Richtung der angelegten Spannung mit der Polarisationsrichtung übereinstimmt, woraus die Gesamtkapazität (C tot ) der Doppelschicht kann aus der Beziehung C . berechnet werden tot = S ·dP nsw /dV , wobei S ist die Elektrodenfläche. Es kann die Ladungseffekte durch FE-Schalten im Impulsmodus vom Typ I vollständig ausschließen, aber die Verwendung des Modus vom Typ II kann diesen Effekt nicht mit der negativen Schaltpolarisation erreichen, die die mit der Ladungsinjektion verbundene Polarisation zurückschalten kann. Der Unterschied zwischen P sw und P nsw 2Pr ist, wie in Fig. 4a gezeigt. Es hat Kleingeld mit d von 0 bis 6 nm, während das P nsw (offene Symbole) Signale sind zu schwach, um von einem Oszilloskop überwacht zu werden. Um die Al2 . zu beweisen O3 Tunnelschalterschicht, die als dielektrischer Kondensator arbeitet, der direkte C tot Messungen mit einem Niederfrequenz-Impedanzanalysator bei 100 kHz ohne zusätzliche DC-Vorspannung wurden durchgeführt und ihre Ergebnisse sind in Abb. 4b gezeigt, die durch Gl. (3):
$$ \frac{1}{C_{\mathrm{tot}}}=\frac{1}{C_{\mathrm{f}}}+\frac{d}{\varepsilon_0{\varepsilon}_{\mathrm {Al}}S} $$ (3)wo ε Al ist die Dielektrizitätskonstante von Al2 O3 Schicht und ε 0 ist die Vakuumpermittivität des freien Raums. C f und S repräsentieren die Kapazität der ferroelektrischen Schicht bzw. der Elektrodenfläche. Abbildung 4b zeigt das lineare 1/C tot gegen d Plot, der darauf hindeutet, dass die Al2 O3 Schicht wird zu einem hochisolierenden dielektrischen Film in einer Nicht-Schalt-Situation oder nach dem Schalten. Daraus lässt sich ableiten, dass C f ≈ 14 pF und ε Al ≈ 7,9 aus Gl. (3). Daher ist das zwischengelagerte dünne Al2 O3 Schicht hat sich als dielektrischer Kondensator erwiesen. Während des FE-Nicht-Schaltens sowie nach dem FE-Schalten ist der Al2 O3 Tunnelschalter schließt als Isolator.
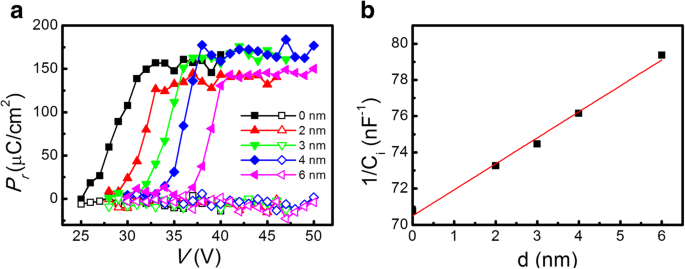
a Die Umschaltung (P sw ) und nicht schaltend (P nsw ) Polarisationen gegenüber V mit d von 0 auf 6 nm unter Pulsen im Typ I-Modus erhöht. b Die Al2 O3 -Schichtdicke d Abhängigkeit von 1/C tot gemessen von einem Impedanzanalysator bei 100 kHz
Abbildungen 5 zeigen schematische Diagramme des Al2 . O3 /LN-Doppelschichtstruktur geschaltet im Typ-I- oder Typ-II-Modus. Abbildung 5a skizziert die äquivalente Ein-Aus-Schaltung der Reihenwiderstände und Kondensatoren für das Al2 . O3 Tunnelschalter. Im Anfangszustand, wie in Fig. 5b gezeigt, ist die bevorzugte Polarisationsorientierung der aufwärts gerichtete Polarisationszustand, der auf die obere Elektrode zeigt. Das von den asymmetrischen Elektroden induzierte eingebaute elektrische Feld leitet von der Au-Elektrode zur Pt-Elektrode. Beim Anlegen der Polarisationsspannung erfolgt die FE-Umschaltung. Es versteht sich, dass die Spannung umgekehrt proportional zur Kapazität in der Schaltung angelegt wird. In Al2 O3 /LN-Doppelschichtstruktur, während des FE-Schaltens weist die LN-Schicht eine große Kapazität auf. Daher liegt der größte Teil der extern angelegten Spannung an Al2 . an O3 Schicht. Ultradünnes Al2 O3 Schicht wird durch Elektrodenladung injiziert. Es schaltet als Widerstand ein, wenn die angelegte Spannung den Al2 . überschreitet O3 Tunnelschwelle, wie in Abb. 5c gezeigt. Nach Beendigung des FE-Schaltens oder im Fall einer Nicht-Schalt-Situation ist die Kapazität der LN-Schicht sehr klein und die angelegte Spannung an Al2 O3 niedriger als die Tunnelschwellenspannung abfällt. In diesem Moment ist die Al2 O3 Schicht wirkt wie ein Isolator und schaltet ab, wie in Abb. 5d gezeigt.
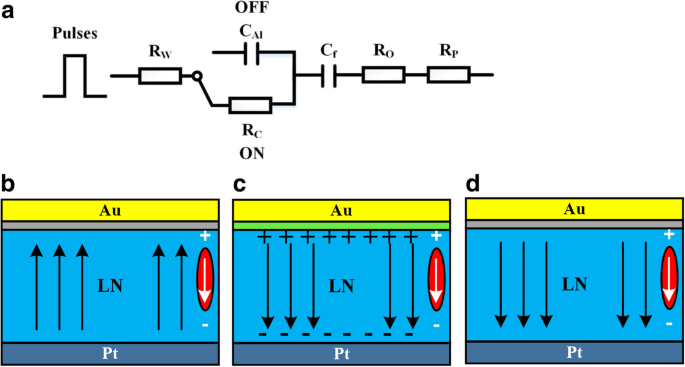
Schematische Darstellung des Al2 O3 /LN-Doppelschichtstruktur geschaltet in Typ I oder Typ II. a Die Skizze der äquivalenten Ein-Aus-Schaltung der Reihenwiderstände und Kondensatoren für das Al2 O3 Tunnelschalter. b Anfängliche bevorzugte Polarisationsorientierung und eingebautes elektrisches Feld; c Die Al2 O3 Tunnelschalter einschalten und Domänenwechsel; d Die Al2 O3 Tunnelschalter ausschalten und Polarisation halten
Abbildung 6 zeigt die Zyklenzahlabhängigkeiten der geschalteten Polarisationen in Al2 O3 /LN-Doppelschichtstruktur mit der Dicke von Al2 O3 im Bereich von 0 bis 6 nm im Typ-I-Modus. Die Pulsbreite beträgt 1000 ns mit einer Periodizität von 0,5 s. Es ist deutlich zu erkennen, dass die Dauerfestigkeit des Al2 O3 /LN-Doppelschichtstruktur wird mit zunehmendem Al2 . allmählich verbessert O3 Dicke mit über 10 4 Zyklen der Pulsbelastung. Die Ermüdungseigenschaft im Typ-II-Modus ähnelt dem Ergebnis im Typ-I-Modus, das in der Zusatzdatei 1:Abbildung S2 der unterstützenden Informationen gezeigt wurde. Leider würde der elektrische Durchschlag im Typ-II-Modus leicht auftreten, nachdem eine Langzeit-Gleichspannung von fast 10 4 . angelegt wurde Zyklen der Pulsbelastung. Die Daten können mit dem Modell für die Koexistenz von Domänenwand-Pinning und Depinning innerhalb jedes Zyklus angepasst werden, wie durch die durchgezogenen Linien in Abb. 6 gezeigt, wobei die Ermüdungsphysik der Ladungsinjektion durch die Elektrode zugeschrieben wurde [13]. Wenn die Al2 O3 zwischen der Au-Elektrode und der LN-Schicht eingefügt, kann sie den Nebenelektroden-Injektions-Ladungspfad blockieren und die Ermüdungsbeständigkeit verbessern. Bei der Doppelschichtstruktur sollten jedoch einige Aspekte weiter berücksichtigt werden. Zum Beispiel mit zunehmender Dicke von Al2 O3 von 0 auf 6 nm vergrößerte sich die Koerzitivspannung von nahe 25 auf 34 V, was durch Verbesserung der Qualität des Al2 . reduziert werden kann O3 Schicht. Tatsächlich sind einige Atomschichten aus Al2 O3 mit hoher Qualität oder weniger Defekten können die von Elektroden injizierten Ladungen effektiv blockieren, was an anderer Stelle durch Optimierung der Verarbeitungsbedingungen für die Atomlagenabscheidung (wie Temperatur und Zeit) bestätigt wird [25].
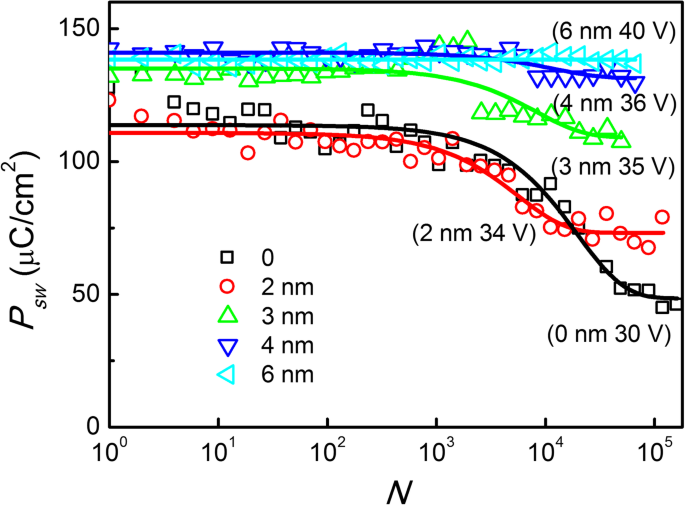
Zyklenzahlabhängigkeiten geschalteter Polarisationen in Al2 O3 /LN-Doppelschichtstruktur mit der Dicke von Al2 O3 von 0 bis 6 nm unter über 10 4 Zyklen der Pulsbelastung. Die Pulsbreite beträgt 1000 ns in der Periodizität von 0,5 s
Kürzlich wurden in unseren folgenden Forschungsarbeiten ferroelektrische Domänenwandspeicher vorgeschlagen, die auf den löschbaren leitenden geladenen Domänenwänden und dem zerstörungsfreien elektrischen Auslesen der Polarisationszustände basieren [26, 27]. Eine hohe Leitfähigkeit geladener Domänenwände in Lithiumniobat-Einkristallen wird nach Domänenwechsel erhalten [28, 29]. Daher sind die dünneren Lithiumniobat-Einkristall-Dünnschichten auf Siliziumsubstraten die vielversprechenden Materialien für integrierte ferroelektrische Domänenwandspeicher und ihre Retentions- und Ermüdungsbeständigkeitseigenschaften können durch das Design von Al2 . verbessert werden O3 /Lithiumniobat-Doppelschicht.
Schlussfolgerungen
Zweihundert Nanometer LiNbO3 Einkristallfilme mit 5% Mg-Dotierung wurden durch Ionenslicen von Oberflächenschichten aus massiven LN-Einkristallen hergestellt, und dann das ultradünne Al2 O3 Filme mit Dicken im Bereich von 2 bis 6 nm als Tunnelschaltschichten wurden auf einem 5% Mg-dotierten LN-Film abgeschieden, um Doppelschichtstrukturen durch Atomlagenabscheidung zu bilden. Das symmetrisierte P-V Hystereseschleifen entlang der Spannungsachse werden unter angelegten Pulsspannungen im Typ-II-Modus beobachtet, was auf das eingebaute elektrische Feld zurückgeführt werden kann, das durch asymmetrische Elektroden in Au/LiNbO3 . induziert wird /Pt und Kompensation des internen Aufdruckfeldes. Der Domänenumschaltstrom (I sw ) Transienten und ihre übertragenen P-V Hystereseschleifen zeigen, dass das ultradünne Al2 O3 Layer spielt als Ideentunnelschalter. Es schaltet sich während des FE-Schaltens ein, schließt jedoch während des Nicht-Schaltens oder nach dem FE-Schalten, wodurch die nachteiligen Störungen beim FE-Schalten minimiert werden. Darüber hinaus wird die Ermüdungsbeständigkeit des FE-Kondensators allmählich verbessert, wenn die Dicke der Tunnelschalterschicht von 2 auf 6 nm erhöht wird. Die Al2 O3 /LN-Doppelschichtstruktur ebnet den Weg zur Entwicklung robuster ferroelektrischer Bauelemente, um das Ermüdungsproblem durch Ladungsinjektion der Elektrode zu lindern.
Abkürzungen
- ALD:
-
Atomlagenabscheidung
- CMOS:
-
Komplementärer Metalloxid-Halbleiter
- FE:
-
Ferroelektrisch
- LN:
-
Lithiumniobat
- SEM:
-
Rasterelektronenmikroskopie
- XRD:
-
Röntgenbeugung
Nanomaterialien
- Advanced Atomic Layer Deposition Technologies für Mikro-LEDs und VCSELs
- Bipolar-resistive Schalteigenschaften von HfO2/TiO2/HfO2-RRAM-Bauelementen mit dreischichtiger Struktur auf Pt- und TiN-beschichteten Substraten, die durch Atomlagenabscheidung hergestellt wurden
- Photokatalytische Eigenschaften von Co3O4-beschichteten TiO2-Pulvern, hergestellt durch plasmaunterstützte Atomlagenabscheidung
- Abstimmung der Oberflächenmorphologien und -eigenschaften von ZnO-Filmen durch das Design der Grenzflächenschicht
- Fermi-Level-Tuning von ZnO-Filmen durch Supercycling-Atomschichtabscheidung
- Herstellung hierarchischer ZnO@NiO-Kern-Schale-Heterostrukturen für verbesserte photokatalytische Leistung
- Dickenabhängigkeit von Grenzflächen- und elektrischen Eigenschaften in Atomlagen-abgeschiedenem AlN auf c-Ebenen-GaN
- Auswirkungen von Ätzvariationen auf die Ge/Si-Kanalbildung und die Geräteleistung
- Analog/HF-Leistung eines T-Gate-Dual-Source-Tunnel-Feldeffekttransistors
- Verbesserte thermoelektrische Leistung von c-Achsen-orientierten epitaktischen Ba-dotierten BiCuSeO-Dünnschichten



