Indium-Quantenpunkte mit einheitlicher Größe, die auf der Oberfläche einer epitaktischen InGaN-Schicht durch einen zweistufigen Kühlprozess aufgewachsen sind
Zusammenfassung
Ein neues Verfahren zum Aufwachsen von Indium-Quantenpunkten (In QDs) auf der Oberfläche einer epitaktischen InGaN-Schicht durch MOCVD wird vorgeschlagen. Es wurde festgestellt, dass sich In-Quantenpunkte einheitlicher Größe auf der Oberfläche einer InGaN-Schicht bilden, wenn ein zweistufiger Kühlprozess durchgeführt wird. Durch Analysen haben wir festgestellt, dass die Bildung von In-QDs auf der Oberfläche auf die Reaktion zwischen der In-reichen Oberflächenschicht und dem Trägergas H2 . zurückzuführen ist bei der niedrigeren Temperaturperiode im zweistufigen Kühlprozess. Da gleichzeitig die Dichte der In-QDs stark von der In-reichen Schicht der Oberfläche abhängt, bietet uns dies eine Möglichkeit, die Oberflächeneigenschaft der InGaN-Schicht direkt zu untersuchen.
Einführung
In den letzten Jahren haben (Al, In, Ga)N-basierte Materialien aufgrund ihrer erfolgreichen Anwendung in lichtemittierenden Bauelementen (LED) und Laserdioden (LD) viel Aufmerksamkeit auf sich gezogen [1,2,3,4, 5]. InGaN hat eine hohe Absorption, eine breite spektrale Abdeckung und Strahlungshärte und wird immer als aktives Material für die Herstellung optoelektronischer Bauelemente verwendet. Aufgrund einer Reihe von Problemen ist es jedoch eine große Herausforderung, hochwertige InGaN-Materialien zu züchten. Beispielsweise führt der große Unterschied in der Gitterkonstante zwischen InN und GaN zu einer Festphasen-Mischungslücke [6, 7]. Der relativ hohe Dampfdruck von InN im Vergleich zu GaN führt zu einem geringen Indiumeinbau in die InGaN-Legierung [8]. Darüber hinaus verursacht ein großer Unterschied der Bildungsenthalpien für InN und GaN eine starke Indium-Oberflächenseigerung an der Wachstumsfront [9]. Andererseits existiert beim Aufwachsen der InGaN-Schicht aufgrund des Zieheffekts immer eine In-reiche Schicht auf der Oberfläche, die die Qualität der nachfolgenden Schicht des InGaN/GaN-Mehrfachquantentopfs (MQW) um . beeinflusst Einführung von Indiumatomen beim anschließenden Wachstum der GaN-Schicht [10]. Um die hohe Leistung optoelektronischer Bauelemente auf InGaN-Basis zu erreichen, müssen wir all diese Hindernisse überwinden. Während der Forschung wird immer das Wachstum einer einzelnen InGaN-Schicht verwendet, um den Wachstumsparameter von InGaN/GaN-MQW zu optimieren. In diesem Artikel stellten wir gelegentlich fest, dass sich In-Quantenpunkte mit einheitlicher Größe auf der Oberfläche der einzelnen InGaN-Schicht bilden, wenn ein zweistufiger Abkühlprozess durchgeführt wird, der den regulären einstufigen Abkühlprozess nach dem Wachstum der einzelnen InGaN-Schicht ersetzt. Durch Analysen haben wir festgestellt, dass die Bildung von In-QDs mit der In-reichen Schicht auf der Oberfläche der InGaN-Schicht zusammenhängt, und dies bietet uns eine Möglichkeit, die In-reiche Oberflächenschicht direkt zu untersuchen.
Experiment
Die in dieser Studie verwendeten Proben waren einzelne InGaN-Schichten, die auf einem C-Plane-Saphirsubstrat mit einem AIXTRON 6 × 2 in einem nah gekoppelten Showerhead-Reaktor mit metallorganischer chemischer Abscheidung (MOCVD) in einem N2 . aufgewachsen wurden Atmosphäre. Trimethylgallium (TMGa), Trimethylindium (TMIn) und Ammoniak (NH3 .) ) werden als Ga-, In- bzw. N-Source-Vorläufer verwendet. Die einzelnen InGaN-Schichten mit einer Dicke unter 60 nm und einem In-Gehalt von weniger als 15% wurden auf einer 2 µm dicken ungewollt dotierten GaN-Schicht nach einer 25 nm großen GaN-Pufferschicht auf einem Saphirsubstrat aufgewachsen. Das Strukturschema ist in Abb. 1 dargestellt. H2 und N2 werden in verschiedenen Phasen des Wachstumsprozesses als Trägergas verwendet. Herkömmlicherweise ist die N2 wird als Trägergas beim Wachstum der InGaN-Schicht verwendet, da H2 hat eine korrosive Wirkung auf die InGaN-Schicht, die die Effizienz des In-Einbaus stark verringert [11, 12]. Allerdings H2 als Trägergas kann die Oberflächenmobilität von Atomen stark verbessern und die Verunreinigungskonzentration verringern. Daher H2 wird bevorzugt als Trägergas während des Wachstums der GaN-Schicht verwendet, um die Kristallqualität zu verbessern. Im Allgemeinen wurde, wenn das Wachstum der InGaN-Schicht beendet war, die Temperatur in einer Stickstoffatmosphäre direkt auf Raumtemperatur gesenkt. Wir nennen einen solchen Prozess hier „einstufige Kühlung“. In dieser Arbeit wurde ein sogenannter zweistufiger Kühlprozess nach dem InGaN-Schichtwachstum aufgegriffen, bei dem die Temperatur in einer Stickstoffatmosphäre zunächst auf 400°C abgesenkt und anschließend auf Raumtemperatur abgesenkt wird in einem H2 Atmosphäre. Zur Charakterisierung der InGaN-Proben werden hochauflösende Röntgenbeugung (XRD), Rasterkraftmikroskopie (AFM), Rasterelektronenmikroskop (REM) und energiedispersives Spektrometer (EDS) verwendet.
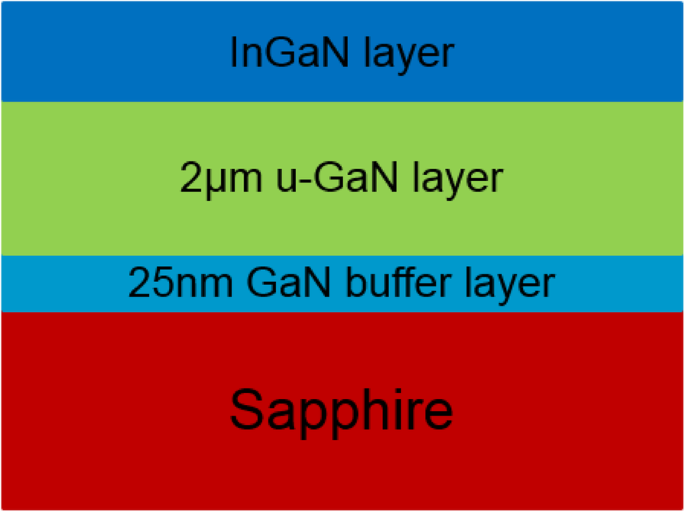
Das Strukturschema der einzelnen InGaN-Schicht, die auf einer GaN-Vorlage unter Verwendung eines Saphirsubstrats aufgewachsen wurde
Ergebnis und Diskussion
Beim Aufwachsen auf einer einzelnen InGaN-Schicht auf der GaN-Vorlage mit einem zweistufigen Abkühlprozess wurde eine abnormale Oberflächentopographie der InGaN-Schicht gefunden. Die AFM-Oberflächenmorphologie der InGaN-Proben mit einstufiger Kühlung und zweistufiger Kühlung ist in Abb. 2a bzw. b dargestellt. Abbildung 2a zeigt eine typische Oberflächenmorphologie der InGaN-Epischicht, aus der hervorgeht, dass die InGaN-Schicht ein klares 2D-Wachstum mit Stufenfluss aufweist. Gleichzeitig existieren viele 3D-Inseln auf der Probenoberfläche, die auf Schraubenversetzungslinien in der GaN-Schicht zurückgeführt werden. Es ist auch zu sehen, dass sich oben auf jeder 3D-Insel ein dunkler Punkt befindet, der nachweislich die entlang der Schraubenversetzung gebildete v-Vertiefung ist [13, 14]. Im Unterschied zu Fig. 2a gibt es außer der Stufenströmungsfläche und den 3D-Inseln auch viele gleichgroße Quantenpunkte (die kleinen weißen Punkte im Bild) in Fig. 2b. Kombiniert mit dem Einschub von Abb. 2b in der linken oberen Ecke, der ein 3D-Diagramm der Oberfläche ist, können wir die durchschnittliche Größe dieser Quantenpunkte von etwa 100 nm × 100 nm erhalten, die durchschnittliche Höhe beträgt etwa 20 nm und die Dichte beträgt etwa 1,6 × 10 8 cm −2 . Es sei darauf hingewiesen, dass der Hauptunterschied zwischen diesen beiden verschiedenen Arten der Probenkühlung darin besteht, dass H2 wird anstelle von N2 . als Trägergas verwendet in der zweiten Kühlperiode des zweistufigen Kühlprozesses. Daher hängt die Bildung von Quantenpunkten auf der Oberfläche der InGaN-Schicht mit dem Trägergas H2 . zusammen im Niedertemperatur-Kühlprozess.
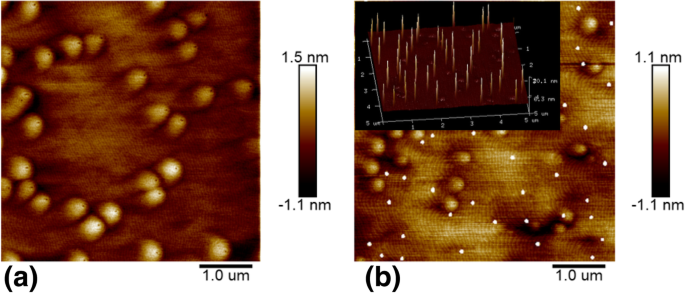
AFM-Oberflächentopographie von a InGaN-Probe mit einstufiger Kühlung und b InGaN-Probe mit zweistufigem Kühlprozess, wobei der Einschub ein 3D-Diagramm der Oberfläche ist
Um zu verstehen, wie dies geschieht, wenn bei InGaN-Proben ein zweistufiger Kühlprozess durchgeführt wird, führen wir ein zweistufiges Kühlexperiment mit GaN anstelle von InGaN durch. Diese GaN-Schicht wurde unter denselben Bedingungen wie die einzelnen InGaN-Schichtproben, die in dieser Arbeit untersucht wurden, aufgewachsen, d. h. bei einer relativ niedrigeren Wachstumstemperatur von 740 °C und N2 wird als Trägergas verwendet. Die AFM-Oberflächentopographie der GaN-Schicht nach einem zweistufigen Kühlprozess ist in Abb. 3a dargestellt. Wir können feststellen, dass es keine Quantenpunkte auf der Oberfläche gibt und die Oberfläche der einstufigen Kühlung von MOCVD-gewachsenen GaN-Schichtproben gleicht, wie weithin berichtet wurde [15]. Außerdem haben wir überprüft, was passiert, wenn der zweistufige Kühlprozess für eine InGaN-Schichtprobe mit sehr geringem In-Gehalt verwendet wird, bei der der In-Gehalt nur 1% beträgt. Abb. 3b zeigt die AFM-Oberflächenmorphologie dieser InGaN-Probe mit niedrigem In-Gehalt nach einem zweistufigen Kühlprozess. Es hat sich herausgestellt, dass die Dichte der Quantenpunkte im Vergleich zu der oben erwähnten InGaN-Probe mit hohem In-Gehalt, deren In-Gehalt etwa 13% beträgt, sehr stark abnimmt. Diese Ergebnisse bedeuten, dass die Bildung von Quantenpunkten auf der Oberfläche der InGaN-Schicht in dem zweistufigen Kühlprozess mit dem In-Atom korreliert, und diese Quantenpunkte können einer im In-Zustand sein, der aufgrund der Reaktion zwischen dem InGaN . gebildet wird Schicht und Trägergas H2 im Prozess der zweiten Abkühlung.
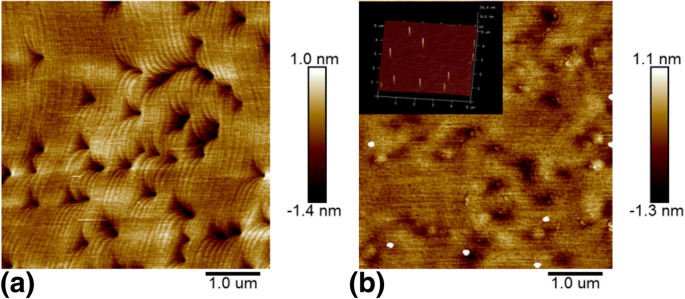
AFM-Oberflächentopographie von Proben mit zweistufiger Kühlung. a GaN-Schicht. b InGaN-Schicht mit 1% In-Gehalt
Frühere Studien haben gezeigt, dass es im Prozess des InGaN-Schichtwachstums drei verschiedene Zustände von In-Atomen gibt [16, 17]. Der erste sind die In-Atome im Kristallgitter der InGaN-Legierung, die den Hauptteil und das Zielprodukt des InGaN-Schichtwachstums darstellen; die zweite ist die InN-Legierung, die immer auf der Oberfläche der InGaN-Schicht erscheint; und das dritte ist das In-Tröpfchen, das unter bestimmten Wachstumsbedingungen auftreten kann. Verschiedene Zustände des In-Atoms können durch XRD-Spektren unterschieden werden, da sie im ω/2θ-Scanmodus unterschiedliche Beugungspeaks aufweisen. Um zu bestimmen, zu welchem In-Zustand diese Punkte gehören, wurden XRD-Messungen für die InGaN-Proben mit einstufigen oder zweistufigen Kühlprozessen durchgeführt. Abbildung 4 zeigt die typischen XRD-ω/2θ-Spektren für Proben mit zweistufiger Kühlung (rote Linie) und einstufiger Kühlung (blaue Linie). Für die Proben mit zweistufiger Kühlung wurden drei charakteristische Peaks gefunden, während es für Proben mit einstufiger Kühlung nur zwei charakteristische Peaks gibt. Der zusätzliche charakteristische Peak für die Proben mit zweistufiger Kühlung kann also die Quantenpunkte darstellen, die sich auf der Oberfläche bilden. Die beiden charakteristischen Peaks, die üblicherweise in diesen Proben vorkommen, liegen bei etwa 33,5° und 34,5°. Sie gehören zum InGaN- bzw. GaN-Kristall. Während der zusätzliche charakteristische Peak, der sich bei 2θ = 32,8° befindet, bestätigt wurde, dass er vom In-Tröpfchen stammt [16, 17]. Wir können also den Schluss ziehen, dass die Quantenpunkte, die wir mit dem zweistufigen Kühlprozess auf der InGaN-Oberfläche beobachtet haben, das In-Tröpfchen sind. Um diese Schlussfolgerung zu bestätigen, wurde eine REM-Messung an den Proben mit einem zweistufigen Kühlprozess durchgeführt, das Ergebnis ist in Abb. 5a gezeigt, aus der wir auch die Punkte auf der Oberfläche finden können. Um diese Punkte zu identifizieren, wurde EDS an derselben Stelle aufgenommen. Abb. 5b–d zeigen die Oberflächenatomverteilung für In, Ga bzw. N, aus der wir entnehmen können, dass die Atome von Ga und N gleichmäßig auf . verteilt sind der Oberfläche, während die Konzentration der In-Atome auf den Punkten viel größer ist als in ihrer Umgebung, was darauf hindeutet, dass diese Punkte reich an In sind. Zusammen mit der obigen Analyse können wir also schließen, dass das Trägergas H2 kann bei niedriger Temperatur mit der InGaN-Schicht reagieren und In-Tröpfchen auf der Oberfläche bilden.
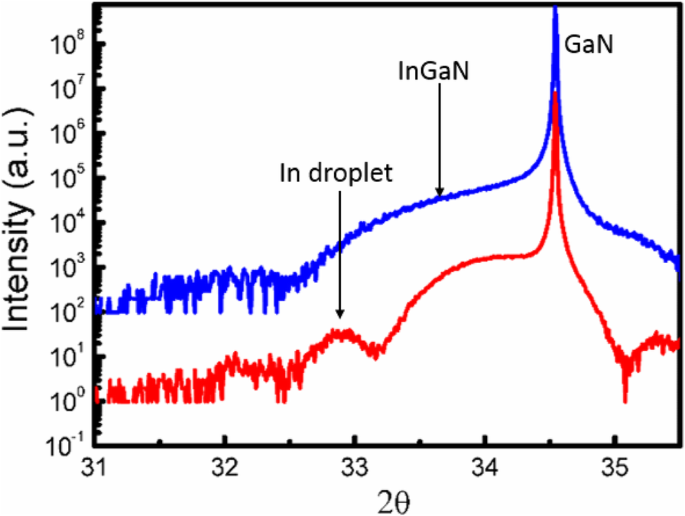
Die XRD-Spektren für Proben mit zweistufiger Kühlung (rote Linie) und einstufiger Kühlung (blaue Linie)
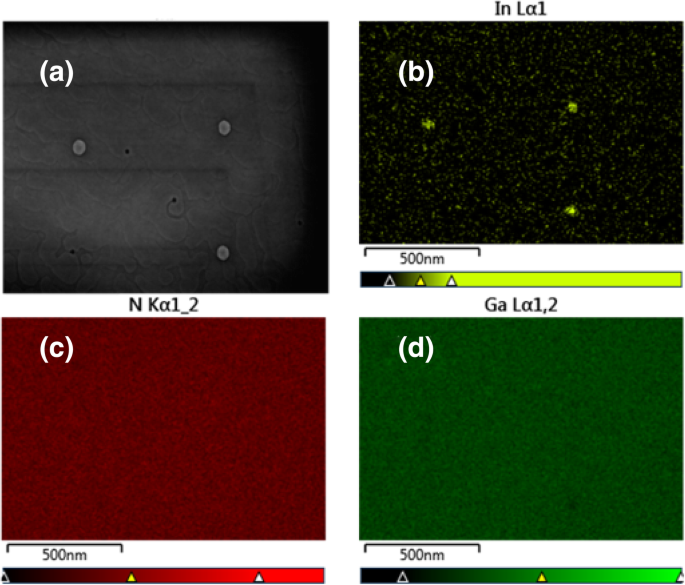
a Die REM-Oberflächenfotografie der Probe mit einem zweistufigen Kühlprozess, b –d ist das Ergebnis der EDS-Elementanalyse für Atom In, N bzw. Ga
Es wurde berichtet, dass aufgrund des Oberflächenzieheffekts häufig eine In-reiche Schicht auf der Oberfläche der epitaktischen InGaN-Schicht gebildet wird [10]. In unserem Experiment wurden die Proben nach dem Aufwachsen einer einzelnen InGaN-Schicht direkt auf Raumtemperatur abgekühlt, so dass die In-reiche Oberflächenschicht beim Abkühlen noch auf der Oberfläche vorhanden ist. Daher gibt es zwei Möglichkeiten der Herkunft des In-Atoms für die von uns beobachteten In-QDs:die InGaN-Schicht bzw. die In-reiche Oberflächenschicht. Um zu wissen, woher das In-Atom der In-Quantenpunkte kommt und wie die Reaktion abläuft, wurden weitere Experimente durchgeführt. Es ist bekannt, dass ein Glühprozess die In-reiche Schicht abwischen kann [18]. Daher nehmen wir für die InGaN-Proben einen thermischen Glühprozess vor dem zweistufigen Abkühlprozess. Die Zeit des thermischen Glühprozesses wird auf 60 s eingestellt, und die Temperatur beträgt etwa 800°C, was 60° höher ist als die Wachstumstemperatur der InGaN-Schicht. Die AFM-Topographie der InGaN-Probe mit einem Temperprozess vor dem zweistufigen Kühlprozess ist in Abb. 6 gezeigt, offensichtlich gibt es keine Quantenpunkte auf der Oberfläche. Allerdings ist im Vergleich zu Abb. 2a eine große Veränderung der Oberflächentopographie zu erkennen, die Oberfläche wird rauer. Das Fehlen von In-Quantenpunkten auf der Oberfläche zeigt, dass die InGaN-Schicht mit H2 . keine In-QDs bilden würde im zweiten Abkühlprozess, da durch thermisches Glühen nur die In-reiche Schicht weggewischt werden kann. Die Bildung von In-Quantenpunkten auf der Oberfläche der InGaN-Schicht in dem zweistufigen Kühlprozess ist also auf die Reaktion zwischen der In-reichen Oberflächenschicht und dem Trägergas H2 . zurückzuführen im Tieftemperaturbereich.
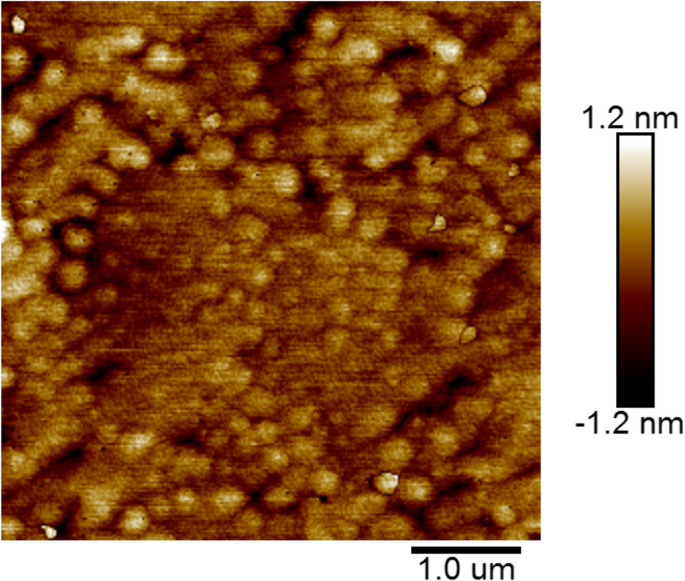
Die AFM-Oberflächentopographie der InGaN-Schicht mit einem thermischen Tempern vor dem zweistufigen Abkühlen.
Die korrosive Wirkung von H2 über das Wachstum der InGaN-Schicht wurde weitgehend berichtet. Es ist bekannt, dass H2 können die In-Atome daran hindern, in das Gitter einzubauen [19, 20], und das ist der Hauptgrund, warum konventionell nur N2 wird als Trägergas beim MOCVD-Wachstum von InGaN-Schichten verwendet. Die korrosive Wirkung von H2 auf der InGaN-Schicht kann als umgekehrter Prozess des InGaN-Schichtwachstums angesehen werden, der durch die folgende chemische Reaktion ausgedrückt werden kann:
$$ {3\mathrm{H}}_2+2\mathrm{In}\mathrm{N}\to 2\mathrm{In}+{2\mathrm{NH}}_3 $$Die Bildung von In-Quantenpunkten in dem zweistufigen Kühlprozess kann als eine Art korrosiver Effekt angesehen werden, aber es gibt einige Unterschiede zwischen hoher Temperatur (zum Züchten von InGaN mit H2 ) und niedrige Temperatur (um InGaN abzukühlen und In-QDs mit H2 . zu bilden ). Bei hoher Temperatur haben die durch die korrosive Wirkung auf der Oberfläche gebildeten In-Atome genügend Energie, um über die Oberflächengrenzschicht zu entweichen, wodurch die Effizienz des In-Einbaus verringert wird. Bei niedrigen Temperaturen (unter 400°C) zeigen unsere Ergebnisse jedoch, dass H2 hat nur eine korrosive Wirkung auf stark In-haltige Oberflächenschichten, da diese Schicht instabiler ist als die InGaN-Schicht. Auf der anderen Seite können die In-Atome, die sich auf der Oberfläche bilden, viel weniger rechtzeitig über die Oberflächengrenze entweichen, wenn die Temperatur unter 400°C liegt, sodass sie auf der Probenoberfläche wandern und dann auf der Oberfläche In-Tropfen bilden.
Da in unserer Studie die Bildung von In-QDs mit der hohen In-haltigen Schicht auf der InGaN-Oberfläche zusammenhängt, können sie direkt einige Informationen über die In-reiche Oberflächenschicht von InGaN liefern. Die Proben der InGaN-Schicht mit unterschiedlichem In-Gehalt und unterschiedlicher Dicke werden verwendet, um zweistufige Kühlbehandlungsexperimente durchzuführen. Abbildung 7 zeigt die Oberflächentopographie von InGaN-Schichten mit unterschiedlichem In-Gehalt und unterschiedlicher Dicke. Der In-Gehalt beträgt 7,65 %, 8,45 % bzw. 9,6 % für die Proben A, B und C, und die Dicke der InGaN-Schicht für diese drei Proben ist fast gleich (ungefähr 13,4 nm). Aus den AFM-Oberflächenmorphologien der Proben A, B und C können wir feststellen, dass die Dichte der In-QDs mit dem In-Gehalt in der InGaN-Schicht zunimmt. Und die Dichte der QDs beträgt ungefähr 2,4 × 10 7 cm −3 , 4,8 × 10 7 cm −3 , und 9,2 × 10 7 cm −3 jeweils für die Stichproben A, B und C, während die Größe der QDs für diese Stichproben fast gleich ist. Andererseits weist Probe D den gleichen In-Gehalt wie Probe A (7,65 %) auf, während ihre Schichtdicke etwa 41 nm beträgt. Vergleicht man die Oberfläche von zwei Proben von A und D, wird deutlich, dass die Dichte der In-Quantenpunkte zunimmt, wenn die Dicke der InGaN-Schicht zunimmt. Aus unserer oben erwähnten Analyse geht hervor, dass die Bildung dieser In-Quantenpunkte durch die Reaktion von H2 . verursacht wird mit der reicheren Oberflächenschicht bei niedriger Temperatur. Die sich ändernde Tendenz der In-QDs-Dichte kann also den Zustand der In-reichen Oberflächenschicht widerspiegeln, dh die instabilen In-Atome, die in der In-reichen Oberflächenschicht vorhanden sind, nehmen zusammen mit der Zunahme des In-Gehalts und der Dicke des InGaN . zu Schicht. Dieses Ergebnis steht im Einklang mit früheren theoretischen Studien, die gezeigt haben, dass der In-Gehalt der In-reichen Oberflächenschicht mit dem In-Gehalt und der Dicke der InGaN-Schichten zusammenhängt [21]. Dies beweist auch, dass der Bildungsmechanismus von In-Quantenpunkten tatsächlich mit der Oberfläche der In-reichen Schicht zusammenhängt.
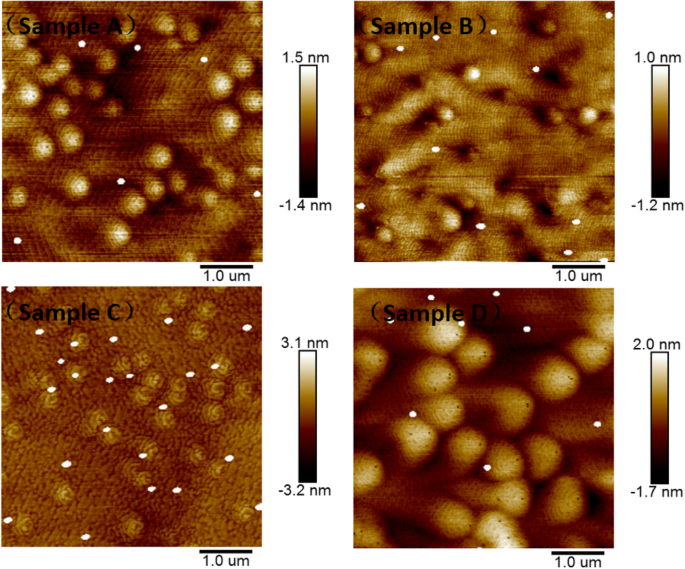
Die AFM-Oberflächentopographie von InGaN-Schichten a , b , c , und d mit unterschiedlichem Inhalt und Dicke (siehe Text)
Schlussfolgerung
In diesem Artikel haben wir eine neue Methode vorgestellt, um In-QDs mit einheitlicher Größe auf der Oberfläche einer InGaN-Schicht zu erhalten. Wir haben festgestellt, dass sich auf der Oberfläche einer InGaN-Schicht In-QDs mit einheitlicher Größe bilden, wenn diese einem zweistufigen Kühlprozess unterzogen wird. Durch eine detaillierte Analyse haben wir festgestellt, dass die Bildung von In-Quantenpunkten auf der Oberfläche auf die Reaktion zwischen der In-reichen Oberflächenschicht und dem Trägergas H2 . zurückzuführen ist bei niedriger Temperatur. Gleichzeitig zeigen unsere Experimente, dass H2 hat nur eine korrosive Wirkung auf die In-reiche Oberflächenschicht, wenn die Temperatur niedriger als 400°C ist, und dieser korrosive Prozess wird In-QDs auf der Oberfläche bilden. Da die Bildung von In-QDs andererseits eng mit der In-reichen Schicht auf der Oberfläche zusammenhängt, kann uns ein solcher Prozess eine Möglichkeit bieten, die Eigenschaften dieser Schicht direkt zu untersuchen.
Methode
Das Ziel dieser Arbeit ist es, eine neue Methode vorzustellen, um In-QDs einheitlicher Größe auf der Oberfläche der InGaN-Schicht zu erhalten. Die in dieser Studie verwendeten Proben wurden mit einem AIXTRON 6 × 2 in einem nah gekoppelten Duschkopfreaktor mit metallorganischer chemischer Abscheidung (MOCVD) gezüchtet. Zur Charakterisierung der InGaN-Proben werden hochauflösende Röntgenbeugung (XRD), Rasterkraftmikroskopie (AFM), Rasterelektronenmikroskop (REM) und energiedispersives Spektrometer (EDS) verwendet. Alle Teilnehmer dieser Studie sind Wissenschaftler der University of Chinese Academy of Sciences of China.
Verfügbarkeit von Daten und Materialien
Die in der aktuellen Studie verwendeten und/oder analysierten Datensätze sind auf begründete Anfrage beim entsprechenden Autor erhältlich.
Abkürzungen
- AFM:
-
Rasterkraftmikroskopie
- EDS:
-
Energiedispersives Spektrometer
- GaN:
-
Galliumnitrid
- In QDs:
-
Indium-Quantenpunkte
- InGaN:
-
Indium-Gallium-Nitrid
- InN:
-
Indiumnitrid
- LD:
-
Laserdiode
- LED:
-
Lichtemittierendes Gerät
- MOCVD:
-
Metallorganische chemische Abscheidung
- MQW:
-
Mehrfachquantentopf
- NH3 :
-
Ammoniak
- QDs:
-
Quantenpunkte
- SEM:
-
Rasterelektronenmikroskop
- TMGa:
-
Trimethylgallium
- TMIn:
-
Trimethylindium
- XRD:
-
Röntgenbeugung
Nanomaterialien
- N,N-Dimethylformamid, das die Fluoreszenz von MXen-Quantenpunkten für die empfindliche Bestimmung von Fe3+ reguliert
- Das Design der Emissionsschicht für Elektronenvervielfacher
- Wismut-Quantenpunkte in geglühten GaAsBi/AlAs-Quantenbrunnen
- Amorphe Silizium-Nanodrähte, die durch Glühen auf Siliziumoxid-Film gewachsen sind
- Abstimmung der Oberflächenmorphologien und -eigenschaften von ZnO-Filmen durch das Design der Grenzflächenschicht
- Defekte auf der Oberfläche von Ti-dotiertem MgAl2O4-Nanophosphor
- Kontrollieren des Wachstums von Indiumselenid (In2Se3)-Nanodrähten mit hoher Gleichmäßigkeit durch den schnellen thermischen Glühprozess bei niedrigen Temperaturen
- Herstellung und Charakterisierung von ZnO-Nano-Clips durch das Polyol-vermittelte Verfahren
- Interband-Photoleitfähigkeit von metamorphen InAs/InGaAs-Quantenpunkten im 1,3–1,55-μm-Fenster
- Schlüsselfaktoren, die die Ergebnisse des Oberflächenschleifprozesses beeinflussen



