Analoges Schalten und künstliches synaptisches Verhalten von Ag/SiOx:Ag/TiOx/p++-Si Memristor-Bauelementen
Zusammenfassung
In dieser Studie wurde durch Einfügen einer Pufferschicht aus TiOx zwischen dem SiOx :Ag-Schicht und der unteren Elektrode haben wir einen Memristor mit einer einfachen Struktur aus Ag/SiOx . entwickelt :Ag/TiOx /p ++ -Si durch ein physikalisches Gasphasenabscheidungsverfahren, bei dem das Filamentwachstum und -bruch während des analogen Schaltens effizient gesteuert werden kann. Die synaptischen Eigenschaften des Memristorbauelements mit einem breiten Widerstandsänderungsbereich für die Gewichtsmodulation durch Implementierung positiver oder negativer Impulsfolgen wurden umfassend untersucht. Mehrere Lern- und Gedächtnisfunktionen wurden gleichzeitig erreicht, darunter Potenzierung/Depression, Paired-Pulse-Facilitation (PPF), Kurzzeitplastizität (STP) und STP-zu-LTP (Langzeitplastizität)-Übergang, gesteuert durch sich wiederholende Pulse mehr als eine Probeoperation, und auch Spike-Time-dependent-plasticity (STDP). Basierend auf der Analyse der logarithmischen I-V-Eigenschaften wurde festgestellt, dass die kontrollierte Entwicklung/Auflösung von leitfähigen Ag-Filamenten über die dielektrischen Schichten die Leistung des Memristor-Testbauelements verbessern kann.
Einführung
2008 wurde Prof. Chuas theoretisches Konzept des Memristors [1] Wirklichkeit, als Strukov et al. veröffentlichten ihre Studien zum Zusammenhang zwischen magnetischem Fluss und Ladung in einem TiO2 -basiert erstmals zwei kompakte Endgeräte [2], was das Interesse von Forschern rund um den Globus geweckt hat. Abgesehen von verschiedenen potentiellen Anwendungen, die von logischen Operationen und rekonfigurierbaren Hochfrequenzsystemen bis hin zu nichtflüchtigen Speicheranwendungen reichen [2,3,4], wurden auch Memristoren aufgrund ihrer ähnlichen Struktur und Arbeitsdynamik untersucht, um die biosynaptischen Funktionen zu emulieren. Heutzutage ist es allgemein anerkannt, dass die direkte Emulation synaptischer Funktionen in einem elektronischen Gerät entscheidend für die Entwicklung gehirninspirierter neuromorpher Computersysteme ist [5,6,7]. Die traditionell konstruierten elektronischen Synapsen basieren jedoch auf komplementären Metall-Oxid-Halbleiter-(CMOS)-Technologien, die hinsichtlich des komplizierten Rechenablaufs, der Grenzen der Integrationsdichte und der Energiedissipation unter dem von Neumann-Engpasseffekt leiden. Daher hat die Verwendung eines einstellbaren zweipoligen Bauelements viele vielversprechende Möglichkeiten zur Entwicklung neuer Strukturen für elektronische Synapsen eröffnet, die sich aus den einzigartigen Eigenschaften von Memristoren mit nichtflüchtiger Charakteristik, nanoskaliger Größe, geringem Stromverbrauch, schnellerem Ansprechverhalten usw. ergeben . [8, 9].
In letzter Zeit haben verschiedene Materialien (z. B. Metalloxide wie ZnO2 , WOx , SnOx [10, 11], Chalkogenide wie Cu2 S, Ag2 S [12, 13] und ferroelektrische Materialien wie La2 O3 , Pb0,8 Ba0,2 ZrO3 [14, 15]) wurden für den Entwurf und die Herstellung von Memristor-Bauelementen untersucht. Bei vielen Geräten wird die Widerstandsänderung der feldinduzierten Wanderung von Sauerstoffleerstellen oder Metallionen (z. B. Ag + , Cu 2+ , und Al 3+ ) und die Bildung einer hochleitfähigen Bahn. Die Leiterbahn in Memristoren wird allgemein als „Leitfaden (CF)“ bezeichnet, der später bei einem Schaltvorgang unterbrochen werden kann. Im Allgemeinen wurden bei Memristoren zwei Arten von Schaltverhalten beobachtet, d. h. abrupt (digitales Schalten) und allmählich (analoges Schalten). Die abrupte Widerstandsänderung stimmt mit dem digitalen Signal (0 oder 1) überein, was für die Speicherung von Informationen von Vorteil ist [16, 17].
Im Gegensatz zum digitalen Schalten weist die kontinuierliche Durchstimmbarkeit des Leitwerts bei Memristoren einige Ähnlichkeiten mit einer biologischen Synapse auf, die die zelluläre Grundeinheit für die Lern- und Gedächtnisfunktionen im menschlichen Gehirn ist [18]. In mehreren Memristor-Bauelementen wurden die analogen Leitwertänderungen realisiert, die verwendet wurden, um die Gewichtsmodulation biologischer Synapsen zu emulieren [19, 20]. Diffusives Ag in a-Si- und oxidbasierten Memristoren mit Pt/a-Si:Ag/Pt und Pt/SiOx Ny :Ag/Pt-Strukturen haben erfolgreich Ca 2+ . nachgeahmt oder Na + Dynamik in Biosynapsen [21, 22]. In ähnlicher Weise wurden auch Sauerstoffionen/Leerstellen-Filamente in Memristoren auf Metalloxidbasis vorgeschlagen, um synaptische Funktionen zu realisieren, einschließlich Kurzzeitpotenzierung (STP) und Paired-Pulse-Erleichterung (PPF) [23, 24]. Die biologischen Lernregeln sind jedoch vielfältig, und bisher sind nicht alle synaptischen Funktionen in die Memristor-Modelle involviert [16].
Neben der Materialauswahl bietet die Kontrolle des Filamentwachstums und des Filamentbruchs durch Einfügen einer zusätzlichen dielektrischen Schicht in die „Metall/memristive Schicht/Metall“-Struktur bestimmte Vorteile zur Emulation synaptischer Funktionen, einschließlich STP und LTP sowie einen geringen Stromverbrauch. Vor kurzem haben Wang et al. [25] haben das analoge Schaltverhalten durch Einfügen eines SiO2 Schicht in einem TaOx -basierter Memristor. Wan et al. [26] haben auch das analoge Schalten und die emulierten STP- und STDP-Funktionen realisiert, indem eine reduzierte Graphenoxidschicht in die Struktur von Ag/SrTiO3 . eingefügt wurde /FTO-Memristor zur Kontrolle des Überwachsens der Ag-Filamente. Darüber hinaus wurde berichtet [27, 28], dass basierend auf den Kenntnissen über TiOx Material mit einer hohen Dielektrizitätskonstante (~40) und einer geringen Bandlücke (~3 eV) wurde die Leistung des Memristorbauelements in Bezug auf Zyklenfestigkeit und Gleichmäßigkeit durch den Einsatz eines TiO2 . deutlich verbessert dünne Schicht mit dem HfO2 memristive Schicht. Abgesehen davon wurde berichtet [24], dass aufgrund der geringen Ionenmobilität und der niedrigen Redoxreaktionsgeschwindigkeit das TiOx Dünnfilm kann auch als Pufferschicht wirken, um das Überwachsen des leitfähigen Filaments zu verhindern, ein besseres synaptisches Verhalten zu ermöglichen und einen guten Kontakt des leitfähigen Filaments während der Widerstandsschaltprozesse aufrechtzuerhalten.
In diesem Artikel berichten wir über eine neue Struktur von Ag/SiOx :Ag/TiOx /p ++ -Si Memristor-Geräte und ihr analoges Schaltverhalten. Im Vergleich zu einem einschichtigen Gerät, über das früher berichtet wurde [22, 29], wurde festgestellt, dass die Insertion eines TiOx Schicht, wie in der obigen Struktur gezeigt, beeinflusst das Schaltverhalten des Memristorbauelements im Hinblick auf das Vergrößern des Leitfähigkeitsfensters und das Aufrechterhalten eines stabilen Zustands während Schaltvorgängen. Außerdem kann der Leitwert des Memristorbauelements sowohl bei positiven als auch bei negativen Impulsfolgen leicht abgestimmt werden. Unsere jüngsten Ergebnisse zeigen, dass wir erfolgreich ein zuverlässiges analoges Schalten und pflichtbewusst emulierte biosynaptische Funktionen wie Kurz- und Langzeitplastizität (STP und LTP), Paired-Pulse-Facilitation (PPF)-Funktion, Spike-Time-abhängige Plastizität ( STDP) sowie STP-zu-LTP-Übergang in Ag/SiOx :Ag/TiOx /p ++ -Si Memristor-Gerät.
Methoden
- ich.
Gerätefertigung:Wie in Abb. 1a gezeigt, wurde unser Memristor als Ag/SiOx . konstruiert :Ag/TiOx /p ++ -Si-Struktur. Die p ++ -Si-Substrate (15 × 15 mm 2 ) mit einem spezifischen Widerstand von etwa 0,01 Ω cm wurden nach einem Standardverfahren gereinigt und dann wurden die Bauelemente darauf hergestellt. Alle folgenden Prozesse wurden bei Raumtemperatur in einem Hochvakuumsystem durchgeführt. Zuerst wurde eine ~10 nm dicke Titanoxidschicht auf p ++ . abgeschieden -Si-Substrate durch HF-Magnetron-Sputtern unter Verwendung einer hochreinen Keramik TiO2 Ziel. Dann ein ~95 nm dickes SiOx :Ag-Schicht wurde durch RF-Co-Sputtern unter Verwendung eines SiO2 . abgeschieden Target mit kleinen Ag-Scheiben auf dem magnetischen Sputterpfad. Während des Abscheidungsprozesses wurden die Ar-Flussrate und der Ar-Druck bei 50 sccm bzw. 20 mTorr gehalten, während die HF-Leistung bei 80 W gehalten wurde. Schließlich wurde die obere Elektrode (TE) der ~30 nm dicken Ag-Schicht strukturiert durch eine Photolithographie- und Abhebetechnik, bei der die dünnen Metallschichten unter Verwendung von DC-Magnetron-Sputtern abgeschieden wurden. Der individuelle Elektrodendurchmesser beträgt ca. 150 μm.
- ii.
Charakterisierungsmethoden:Transmissionselektronenmikroskopie (TEM)-Messungen und Röntgen-Photoelektronen-Spektroskopie (XPS)-Analysen wurden durchgeführt, um die Mikrostruktur von SiOx . zu analysieren :Ag und TiOx Schichten und der chemische Zustand von Ag-Atomen, in denen die TEM-Probe zunächst mit fokussiertem Ionenstrahl (FIB, FEI Nova Nano Lab 200) hergestellt und dann unter einem FEI Phillips CM10-Supra TEM-System beobachtet wurde. Elektrische Charakterisierungen wurden mit einem Halbleiteranalysator (Keithley 2636B) durchgeführt, der mit einer Sondenstation verbunden war. Während der elektrischen Messung wurden die positiven und negativen Vorspannungen durch den Strom definiert, der zwischen der oberen und der unteren Elektrode fließt. Alle elektrischen Messungen wurden bei Raumtemperatur an der Luft durchgeführt.

Schema des Ag/SiOx :Ag/TiOx /p ++ -Si-Memristor-Bauelement und seine Querschnitts-TEM-Analyse. a Schematische Darstellung des Geräts und Analogie zwischen der biologischen Synapse und der elektronischen Synapse. b Querschnitts-TEM-Ansicht einer einzelnen Memristoreinheit aus Ag/SiOx :Ag/TiOx /p ++ -Si-Struktur. Das SiOx :Ag und TiOx dünne Filme zwischen Ag TE und p ++ -Si BE Elektroden. c Die elementare Abbildung des Gerätequerschnitts
Ergebnisse und Diskussion
Eine schematische Darstellung des Geräts und der Messkonfiguration ist in Abb. 1a beschrieben. Das Gerät hat eine einfache Struktur bestehend aus SiOx :Ag und TiOx dünne Schichten zwischen einem Ag TE und einem p ++ -Si BE, das durch das Querschnitts-TEM der Memristorzelle und die Elementabbildung in Fig. 1b und c bestätigt wird. Der chemische Zustand von Ag-Atomen auf der Oberfläche von SiOx wird von XPS analysiert, wie in Zusatzdatei 1 gezeigt:Abbildung S1. Das Ag3d-Spektrum für Ag wird in ein einzelnes Dublett mit Bindungsenergien von 368.0 eV für Ag3d5/2 . entfaltet und 374.0 eV für Ag3d3/2 , die genau dem metallischen Zustand Ag zugeordnet werden. Das HRTEM-Bild in Zusatzdatei 1:Abbildung S2 zeigt einen Querschnitt des amorphen TiOx Schicht, während die kleinen Ag-Nanocluster in SiOx . sichtbar sind :Ag-Schicht, die wahrscheinlich durch die Ausdiffusion von Ag während des TEM-Probenvorbereitungsprozesses verursacht wird, um die Gesamtgrenzflächenenergie des Materialsystems zu minimieren [22]. Darüber hinaus bestätigt die schnelle Fourier-Transformation (FFT), dass die in SiOx . eingebetteten Ag-Nanocluster haben eine polykristalline Struktur, wie Ag (111)- und Ag (002)-Nanokristalle. Im Ag/SiOx :Ag/TiOx /p ++ -Si-Memristorgerät, das Ag/SiOx :Ag und das TiOx /p ++ -Si als präsynaptische Membran bzw. postsynaptische Membran, wie in Fig. 1a dargestellt. Das synaptische Gewicht ändert sich durch die Freisetzung von Ca 2+ oder Na 2+ Ionen in einer Lücke zwischen prä- und postsynaptischen Membranen, die von der präsynaptischen Membran als „Spalte“ bezeichnet wird, wenn die neuralen Impulse empfangen werden. Ebenso die Leitfähigkeit von Ag/SiOx :Ag/TiOx /p ++ -Si-Memristor-Bauelement kann durch die Wanderung von Ag-Ionen unter den Spannungsimpulsen als elektronische Synapse künstlich moduliert werden.
Abbildung 2a zeigt die Strom-Spannungs-Kurve (I-V) des Ag/SiOx :Ag/TiOx /p ++ -Si Memristor-Gerät im halblogarithmischen Maßstab. Unter der Wobbelvorspannung von 0 V → +4,0 V → –4,0 V → 0 V zeigt die gemessene I-V-Kurve eine eingeklemmte Hystereseschleife, die ein Fingerabdruck eines Memristors ist. Wenn eine positive Vorspannung an den Ag TE angelegt wird, wird der Strom allmählich bis zur Einhaltung der Stromgrenze (Icc ) auftritt, und der Widerstandszustand des Geräts wird von einem hochohmigen Zustand (HRS) in einen niederohmigen Zustand (LRS) geändert, was als „SET“-Prozess bezeichnet wird. Wenn dagegen eine negative Vorspannung an das Ag TE angelegt wird, tritt eine Stromabnahme auf und der Widerstandszustand wird von LRS auf HRS zurückgeführt, was als "RESET"-Prozess bezeichnet wird. Es zeigt an, dass die Leitfähigkeit des Bauelements entsprechend mit einer positiven oder negativen Sweep-Vorspannung moduliert werden kann, was ein bipolares Widerstandsschaltverhalten zeigt. Anstelle eines abrupten Anstiegs oder Abfalls des Stroms während SET- und RESET-Prozessen bei einem Hochspannungsbereich steigt oder fällt der Gerätestrom interessanterweise unter dem wiederholten Spannungsdurchlauf von 0 V → +2,1 V oder 0 V → -2,1 V fortlaufend. wie in Abb. 2b gezeigt. Die Beziehung von Strom und Spannung über der Zeit (I-V-t) ist auch im Einschub von Fig. 2b aufgetragen, um die Änderungen der Leitfähigkeit deutlicher zu zeigen. Wie in einer Biosynapse wird eine offensichtliche Geräteantwort der Abwärts-Aufwärts- oder Aufwärts-Abwärts-Entwicklung des Stroms nach der Implementierung von aufeinanderfolgenden positiven (1.-5.) bzw. negativen (6.-10.) Teil der I-V-Kurven beobachtet. Die kontinuierliche Zunahme (oder Abnahme) des Stroms während der positiven (oder negativen) Spannungs-Sweeps zeigt an, dass der Gerätewiderstand durch den DC-Sweep-Modus moduliert werden kann. Es ist auch zu beobachten, dass bei jedem nachfolgenden positiven oder negativen Sweep die I-V-Kurve dort ansetzt, wo die letzte weggelassen wird, was eine typische analoge Schaltfunktion für ein Memristor-Bauelement zeigt. Die Dauerleistung des Memristorbauelements kann bewertet werden, indem eine breitere bipolare Wobbelspannung bei einer Auslesespannung von +0,3 V implementiert wird, wie in Fig. 2c gezeigt, was zeigt, dass das Bauelement während des Setzens/Rücksetzens stabil und gleichmäßig zwischen LRS und HRS betrieben werden kann Betrieb über 10 3 Zyklen.

I-V-Eigenschaften von Ag/SiOx :Ag/TiOx /p ++ -Si Memristor-Gerät. a Bipolares Schaltverhalten b Potenzierung oder Depression durch wiederholte Spannungsdurchläufe. Der Einschub zeigt die Beziehung zwischen Spannung und Strom in Abhängigkeit von der Zeit (V-I-t) und zeigt den Leitfähigkeitszustand während der Potenzierung oder Depression. c Dauerzyklus-Leistungstest bei einer Auslesespannung von -0,3 V für 10 3 Zyklen eines breiteren Bereichs bipolarer Sweeps von 0 bis +4,0 V für Set und 0 bis -4,0 V für Reset. d Wiederholte Eigenschaften der Leitwertmodulation
Die Memristor-Vorrichtung kann auch unter den Impulssignalen anstelle der DC-Bias-Sweep-Spannung betrieben werden. 2d zeigt die Reaktion der Vorrichtung in Form einer Potenzierung oder Depression nach der Implementierung von sich wiederholenden Potenzierungs- (positive Vorspannung) und Niederdrücken (negative Vorspannung) Impulse. Die Amplituden der Potenzierungs- und Niederdrückimpulse betragen +1,2 V bzw. -1,2 V, und alle Pulsbreiten und Intervalle sind auf 5 ms festgelegt. Hier wird die Leitwertmodulation im Gerät unabhängig von positiver oder negativer Impulsvorspannung beobachtet, die der synaptischen Reaktion in Form von Potenzierung oder Depression unter dem potenzierenden bzw. depressiven Stimulus ähnelt. Es wurde offensichtlich festgestellt, dass die Reaktion des Geräts von Zyklus zu Zyklus in Abhängigkeit von der Anzahl der Stimulationsimpulse angepasst werden kann, was darauf hindeutet, dass eine stabile und gleichmäßige Potenzierung und Depression über die Polarität der angelegten Vorspannung hinaus verwendet werden kann, um die Gewichtseinstellung und den Speicher zu emulieren Verbesserung in einer elektronischen Synapse [30].
Zum Verständnis des Schaltverhaltens werden die Leitungsmechanismen durch Anpassung der I-U-Kennlinien analysiert. Zu diesem Zweck wird ein eigenständiges SiOx :Ag-dünnschichtbasierter Memristor mit der Struktur von Ag/SiOx :Ag/p ++ -Si wird auch hergestellt. Wie in Abb. 3a gezeigt, weist die Reaktion des Bauelements auf die Quasi-DC-Spannungsdurchläufe auf ein typisches Schwellenschaltverhalten hin, wie bereits berichtet [29, 31]. Die Pfeilrichtungen zeigen, dass das Gerät als flüchtiger Speicher zwischen den beiden Zuständen zyklisch gewechselt werden kann. Die I-V-Kurve von Ag/SiOx :Ag/TiOx /p ++ -Si-Memristor-Gerät zeigt, dass die Situation ganz anders ist als beim eigenständigen SiOx :Memristor-Bauelement auf Ag-Basis. Abbildung 3b zeigt, dass das Gerät im Hinblick auf LRS und HRS unter dem positiven und negativen Teil der I-V-Kurve ein bipolares Schaltverhalten zeigt, während die Betriebsspannungen relativ höher sind. Abbildung 3c zeigt die I-V-Kurve von Ag/SiOx :Ag/TiOx /p ++ -Si-Memristor-Bauelement, das als Ln(I) gegenüber Ln(V) der positiven Bereichsdaten für HRS und LRS angepasst ist. Diese Anpassungsergebnisse zeigen, dass das Ladungstransportverhalten bei HRS mit einem klassischen Fallen-kontrollierten raumladungsbegrenzten Leitungsmechanismus (SCLC) übereinstimmt, der aus drei Teilen besteht, wie der Ohmschen Region (I/V), der Child-Gesetz-Region (I/ V 2 ) und der steile Stromanstiegsbereich [32]. Dagegen zeigt das lineare Verhalten bei LRS, wo die Steigung = 1 ist, ein ausgezeichnetes ohmsches Verhalten an, wie in Fig. 3c gezeigt. Das unterschiedliche Leitungsverhalten bei HRS und LHR wird durch die Bildung leitfähiger Ag-Filamente bei LRS belegt [32]. Fig. 3d unterstützt ferner, dass das ohmsche Schalten durch die Bildung/den Bruch eines leitenden Filaments verursacht wird. Es ist ersichtlich, dass, während die LRS des Geräts unabhängig von der Zellengröße des Geräts ist, die HRS des Geräts proportional zur Zellengröße ist. Diese größenunabhängige Eigenschaft am LRS wurde im Allgemeinen bei leitenden filamentbasierten Speichervorrichtungen beobachtet [33]. Daraus kann geschlossen werden, dass das Widerstandsschaltphänomen in Ag/SiOx :Ag/TiOx /p ++ -Si-Memristor-Bauelemente stammen typischerweise aus der kontrollierten Bildung/dem kontrollierten Zerreißen eines leitenden Glühfadens unter der positiven/negativen Vorspannung. Die allmählichen Änderungen der Leitfähigkeit könnten auf die Variation der Querschnittslücke zwischen TE und BE unter dem elektrischen Feld zurückzuführen sein, ähnlich wie in anderen Berichten [34]. Der Gesamtwiderstand des Geräts kann also gemäß dem Ersatzschaltbild als R =Rij =V/I beschrieben werden, wobei Rij als der Widerstand in Bezug auf die seitliche Lückengröße von CF zwischen TE und BE definiert ist. Wenn diese Lücke durch Modulieren der Ag-CF-Größe zwischen TE und BE unter Verwendung einer geeignet programmierten Vorspannung eingestellt werden kann, dann kann die Leitung oder der Widerstand der memristiven Vorrichtung allmählich abgestimmt werden.

Analyse des Leitungsmechanismus von Ag/SiOx :Ag/p ++ -Si und Ag/SiOx :Ag/TiOx /p ++ -Si-Geräte. a Die lineare I-V-Kurve von Ag/SiOx :Ag/p ++ -Si und b Ag/SiOx :Ag/TiOx /p ++ -Si-Gerät. c Die Leitungsmechanismen entsprechen SCLC bei HRS und Ohmic bei LRS für Ag/SiOx :Ag/TiOx /p ++ -Si-Gerät gemäß den Anpassungsergebnissen des positiven Bereichs der I-V-Kurve in (b ). d Zellflächenabhängigkeit der Leitfähigkeit am LRS oder HRS
Ein entsprechendes physikalisches Modell ist auch in Abb. 4 dargestellt, um den Schaltmechanismus in eigenständigem SiOx . zu interpretieren :Ag und SiOx :Ag/TiOx -basierte Memristor-Geräte. Das Verhalten von Ag-Nanopartikeln in SiOx -basierte Zellen können basierend auf elektrochemischen Reaktionen (Migration und Ansammlung von Ag-Ionen und Ag-Atomen) zwischen den bipolaren Elektroden interpretiert werden, ähnlich wie zuvor berichtet [22, 35]. Wenn die Wobbelspannung angelegt wird, wachsen die Ag-Nanopartikel weiter, um die Lücke zwischen den Elektroden zu überbrücken, was zu einem abrupten Stromanstieg bis zum Compliance-Niveau führt, und der Memristor wird in LRS eingeschaltet (wie im mittleren Feld von Abb. 4a). Nach dem Entfernen der elektrischen Vorspannung werden die langgestreckten Ag-Nanocluster, die die Brücke früh bildeten, jetzt schnell zusammengezogen [22], und das Gerät kehrt zu HRS zurück (wie im letzten Feld von Abb. 3a gezeigt) [35], was auf eine bipolare Schwellenschaltung hinweist Verhalten in einem Memristor, der zwischen den beiden Zuständen wie in flüchtigen Speichergeräten zyklisch wechseln kann.
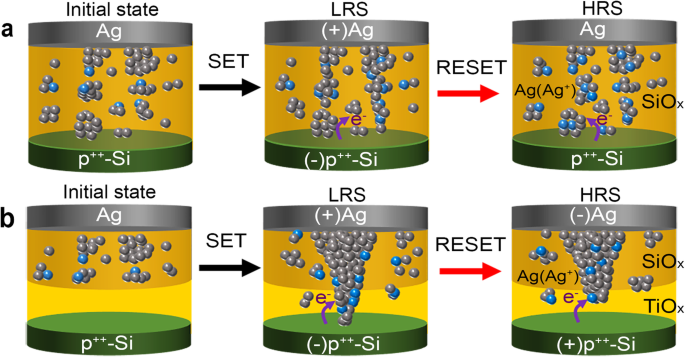
Schematische Darstellung des physikalischen Modells für das Schaltverhalten. a Ag/SiOx :Ag/p ++ -Si Memristor-Gerät; b Ag/SiOx :Ag/TiOx /p ++ -Si Memristor-Gerät
Ganz anders verhält es sich bei SiOx :Ag/TiOx -basiertes Memristorgerät, bei dem das SiOx dünne Schicht hat eine große Bandlücke (~9 eV) und eine niedrigere Dielektrizitätskonstante (~3), aber das TiOx Schicht hat eine niedrige Bandlücke (~3 eV) und eine hohe Dielektrizitätskonstante (~40), wodurch das elektrische Feld über SiOx Schicht höher als die des TiOx Schicht, die mehr Ag-Atome in der Schaltschicht auflöst [28]. Es ist die geringe Ionenmobilität und niedrige Redoxreaktionsgeschwindigkeit von Titanoxid, die die Wanderung und Ansammlung von Ag-Atomen und Ag-Ionen über die Grenzschicht kontrolliert [36]. Diese beiden Tatsachen können, wie oben erwähnt, die Bildung von nanokonusförmigen Filamenten von TE zu BE verursachen [37]. Der konzentrierte metallische Bereich in Form einer effektiven Begrenzung des Filamentwachstums in Form eines Nanokegels von TE bis BE kann eine Kontrolle der Widerstandszustände während des zyklischen Betriebs bieten [38]. Wenn die obere Ag-Elektrode über die Doppelschichten ausreichend positiv vorgespannt ist, reicht das elektrische Feld über den dielektrischen Schichten aus, um die Ag-Ionen vom Ag-TE auf p ++ . zu treiben -Si BE durch die Grenzschicht, was zu einer Verringerung des effektiven Abstands zwischen den Elektroden führt (wie in der mittleren Tafel von Fig. 4b gezeigt). Die Ag-Filamente werden nicht aufgelöst, es sei denn, eine negative Spannung angelegt wird, und neigen dazu, ihre ursprüngliche Form beizubehalten, selbst wenn die Vorspannung entfernt wird. Beim Anlegen einer negativen Spannung beginnt ein normaler RESET, und Ag-CFs werden aufgrund des thermisch unterstützten elektrochemischen Prozesses teilweise desolat (normalerweise an der dünnsten Stelle) [39]. Die Memristorvorrichtung schaltet AUS und kehrt zu HRS zurück (letzte Tafel von Fig. 4b) und wechselt dann reversibel zwischen zwei Zuständen (in Fig. 3b gezeigt) als nichtflüchtige Speichervorrichtung. Das linke Feld von Fig. 4b zeigt, dass die hier gebildeten Filamente dicker sein sollten als die im mittleren Feld von Fig. 4a, die nicht aufgelöst und zerrissen werden können, wenn keine negative Spannung angelegt wird. Der Filamentanteil im SiOx Schicht ist immer noch viel dünner als die des Nanokegelteils im TiOx Schicht, und die Form des gesamten Filaments ist irgendwie wie ein Nano-Kegel. Wenn also eine negative Vorspannung angelegt wird, reißt der Glühfaden schnell, wenn eine negative Spannung angelegt wird (Abb. 3b), während die Spannung weiter erhöht und der Strom wieder erhöht wird, was auf die Gefahr eines negativen SET bei hoher Vorspannung hinweist aufgrund der Reste von Ag-Atomen, die nahe der Oberfläche von BE vorhanden sind.
Tatsächlich hängt der Memristor-Gesamtwiderstand am HRS nur mit der Lücke zwischen der Spitze des Filament-Nanokonus und der unteren Elektrode zusammen, die durch Einstellen der elektrischen Vorspannung erhöht oder verringert werden kann [33]. Diese Tendenz, die HRS in Memristoren zu ändern, ist in Abb. 2b zu sehen, in der der Strom nacheinander unter der wiederholten Sweep-Vorspannung von 0 V auf +2,1 V bzw. von 0 V auf -2,1 V erhöht oder verringert werden kann. Andererseits reicht das konstante Durchstreichen einer Spannung unter +2,1 V nicht aus, um einen leitenden Faden über TE und BE zu bilden. Stattdessen kann das leitende Ag-Filament allmählich Ag-Atome ansammeln, was zu einer Verringerung des effektiven Abstands zwischen den Elektroden führt, wie in Zusätzliche Datei 1:Abbildung S3 gezeigt. Daher kann durch Verwenden einer geeigneten Programmiervorspannung der Übergang von typischem Schwellenschalten zu allmählichem Schalten realisiert werden, und der Gesamtwiderstand der Speicherzelle kann durch Einstellen des effektiven Abstands zwischen den Elektroden abgestimmt werden, wie er in einer biologischen Synapse beobachtet werden kann.
Ähnlich einer Biosynapse können Eingangsstimuli mit geeigneter Pulsprogrammierung die Leitfähigkeitszustände der Memristorvorrichtung ändern, um verschiedene neuronale Aufgaben auszuführen. PPF ist eine weitere Art von entscheidender Funktion, die die Leitfähigkeit durch zeitliche Summation von Eingangsreizen anpassen und mehrere kurzfristige neuronale Aufgaben ausführen kann, einschließlich synaptischer Filterung und Anpassung [40, 41]. Die PPF-Funktion in einer Biosynapse funktioniert wie folgt:Die zweite postsynaptische Reaktion wird während zweier aufeinanderfolgender Spike-Stimuli höher als die der ersten, wodurch die Intervallzeit der Spikes kürzer bleibt als die Erholungszeit [22]. Abbildung 5a zeigt die Geräteantwort, die nach der Implementierung eines Paars von Erleichterungsimpulsen mit einer Amplitude von +2,0 V mit einer festen Breite und einem Intervall, das als Skala von 0,08 s bezeichnet wird, überwacht wird. Als Reaktion auf den zweiten Puls wird ein merklicher Stromanstieg beobachtet als beim ersten, was auf eine offensichtliche Änderung des Leitfähigkeitszustands nach der Implementierung einer geeigneten Pulsprogrammierung hinweist. Während des Intervalls zwischen zwei aufeinanderfolgenden Pulsen wird ein Stromabfall beobachtet, der auf das Vorhandensein eines flüchtigen Charakters in der Vorrichtung zurückgeführt werden kann. Der Abfall der Leitfähigkeit könnte der Diffusion von Ag-Atomen nach dem Entfernen des Potenzierungspulses entsprechen [42]. Die erfolgreiche PPF-Funktion kann nur ausgeführt werden, wenn das Zeitintervall zwischen zwei aufeinanderfolgenden Pulsen kleiner ist als die Diffusionsrelaxationszeit von Ag-Atomen, wodurch mehr Ag-Atome in das SiOx . gedrückt werden :Ag/TiOx Schicht. Darüber hinaus wird ein Sättigungszustand erreicht, wenn die Vorrichtung kontinuierlich mit einer Anzahl von Erleichterungsimpulsen mit einer Amplitude von +2,0 V und einer festen Breite und einem als Skala von 0,08 s bezeichneten Intervall stimuliert wird, wie in Fig. 5b gezeigt. Die Ergebnisse zeigen, dass bei Anwendung von Hochfrequenzpulsen, die mehr Ag-Atome in das SiOx Schicht, bis eine leitende Brücke zwischen TE und BE gebildet wird, wodurch ein Sättigungsniveau erreicht wird [22]. Dieses Phänomen ist der Hebbschen Lernregel ziemlich ähnlich, bei der die synaptischen Gewichtsänderungen einen gesättigten Wert haben müssen, um eine übermäßige Erregbarkeit von Neuronen mit den nicht gefärbten Spitzen der angewendeten Pulsfolge zu vermeiden [43].
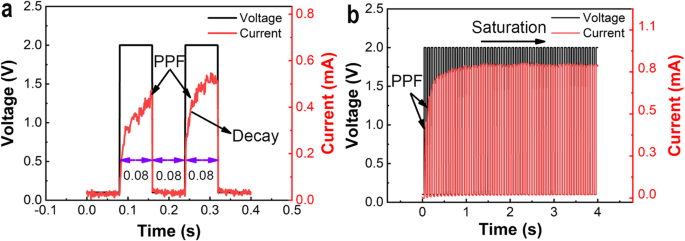
Experimentelle Ergebnisse der Paired-Pulse-Facilitation (PPF). a Implementierung von PPF auf Ag/SiOx :Ag/TiOx /p ++ -Si-Gerät mit +2,0 V Pulshöhe mit 0,08 s. b Demonstration der synaptischen Gewichtsbewegung der Sättigung unter Verwendung einer Pulsfolge mit einer Amplitude von +2,0 V mit derselben Breite und einem Intervall von 0,08 s
Darüber hinaus erleidet ein Memristor, ebenso wie in einer biologischen Synapse, einen Gedächtnisverlust mit einem plötzlichen Stromabfall nach der Implementierung eines potenzierenden Spikes, der auf das Vorhandensein von STP im Memristor zurückgeführt werden kann [44, 45]. In der Neurobiologie werden STP und LTP häufig als Kurzzeitgedächtnis (STM) und Langzeitgedächtnis (LTM) bezeichnet [46]. Es wurde festgestellt, dass der Übergang von STP zu LTP durch sich wiederholende Reize (d. h. einen Prozess der Probe) erfolgen könnte [46, 47]. Um dieses Verhalten zu verifizieren und mit dem in biologischen Synapsen beobachteten zu vergleichen, wurde eine Sequenz von Spannungsimpulsen auf unser Ag/SiOx . implementiert :Ag/TiOx /p ++ -Si Memristor-Geräte. Abbildung 6a zeigt den Anstieg des Stroms von einem Anfangszustand von 0,05 mA auf 1,8 mA nach der Implementierung von 15 aufeinanderfolgenden Impulsen (Amplitude +1,4 V, Breite und Intervall 5 ms). Der normalisierte Stromabfall ((It -Io )/Io × 100%) wird bei einer Lesespannung von +0,3 V unmittelbar nach dem Auferlegen von Potenzierungsimpulsen mit der Zeit (t ), wie in Abb. 6b gezeigt. Die Beziehung zwischen dem normierten Stromabfall und der Zeit passt sich gut an die in Gl. (1) [48]:
$$ {\Updelta I}_t/{\Updelta I}_o\times 100\%=\exp \left[-{\left(t/\tau\right)}^{\beta}\right] $$ ( 1)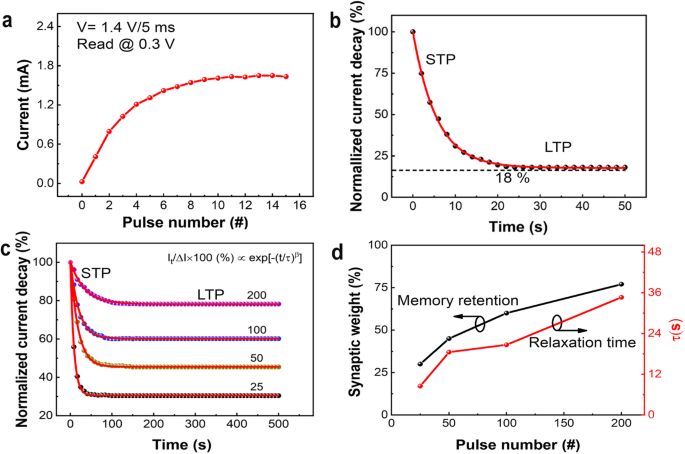
Stromzerfall und Gedächtnisspeicherung in Ag/SiOx :Ag/TiOx /p ++ -Si-Memristor. a Stromerhöhung nach Durchführung von 15 aufeinanderfolgenden identischen Potenzierungsimpulsen. b Der Stromabfall wird bei einer Lesespannung von +0,3 V nach der Stimulation des Geräts überwacht. c Der normalisierte Stromabfall über der Zeit zeigt den Übergang von STP zu LTP nach der Implementierung von Impulsfolgen der Stimulationsanzahl. d Die Erinnerungs- und Entspannungszeit (τ ) zu Impulszahlen
hier, τ heißt Relaxationszeit und β heißt Dehnungsindex (0 <β <1). Im Allgemeinen wird diese Beziehung verwendet, um Relaxationsprozesse in ungeordneten Materialien mit zufälliger Energieverteilung zu beschreiben. Die Kurve zeigt, dass der Abbau des synaptischen Gewichtes der „Vergessenskurve“ des menschlichen Gedächtnisses in der Psychologie [49] ähnelt, die zu Beginn einen schnellen Abfall aufweist, der als STP bezeichnet werden könnte und dann allmählich ein stabiles Niveau erreicht, das als LTP bezeichnet werden könnte im Gerät. Allerdings wird in einem sehr kurzen Zeitintervall (t ) und erreicht dann einen Sättigungsgrad bei einem niedrigen Leitwert (bis zu 16% in 50 s). Unter dieser Situation haben wir ohne weitere Änderung der Pulsparameter einen weiteren Simulationsprozess mit einer wiederholten Anzahl von Pulsen durchgeführt. The current is measured at a read voltage of +0.3 V immediately after imposing different numbers of pulses (i.e., 25, 50, 100, and 200) from the same initial state for each set of pulse trains. Figure 6c shows that the normalized current decay with time in each set of measurements is fitted by the relation given in Eq. (1). Figure 6d shows that by an increase of the stimulation number, the relaxation time (τ ) increases, indicating forgetting process fades slowly. Meanwhile, an obvious elevation of the current level is observed, implying a positive change in synaptic weight (conductance), as shown in Fig. 6d by the black line. These results presented in Fig. 6 provide clear evidence of the existence of STP and LTP in our device. A smaller number of stimulations can only induce STP in the device, with a slight rise in conductance at saturation level. Therefore, by increasing the number of repetitive stimulations, the rehearsal process not only rises a conductance level but also is achieved a long-lasting memory retention phenomenon, as shown in Fig. 6d by the red line.
The conventional digital-type memories require the non-volatility to store the information, while in bio-synapse, information processes and accordingly reconfigures the memory status. It can be seen in Fig. 6 that the transition from STP to LTP is realized, and the synaptic weight is adjusted accordingly, while the unimportant ones with small synaptic weight are temporarily stored and then diminished with time. This phenomenon is quite similar to the “multi-store model” presented by Atkinson and Shiffrin [50]. In this model, first input information is analyzed, then stored in different hierarchy levels, according to the importance of “synaptic weight” through the rehearsal process. Therefore, an increase in synaptic weight and resultant prolonged relaxation time (τ ) in our device as a function of stimulation numbers has best verified the rehearsal scheme.
Besides the pulse repetition process, the transition of the STP to the LTP phenomenon is further examined as a function of pulse strength. The device response is monitored after implementation of different pulse amplitudes, i.e., +1.2 V, +1.6 V, +2.0 V, and +2.8 V with similar width and interval scale of 3 ms, as shown in Fig. 7a. The current is monitored with a readout voltage of +0.3 V after imposing each pulse train consisting of 50 pulses. The fitted results with the stretched exponential relaxation model in Fig. 7a shows that the relaxation time is increased as a function of pulse strength (as shown in Fig. 7b red line). Meanwhile, as shown in Fig. 7b, an elevation of the synaptic weight of about 90% is observed at a larger τ of 43 s and +2.8 V amplitude, which is much higher than the synaptic weight of about 25% at a smaller τ of 10 s and +1.2 V amplitude (as shown in Fig. 7b black line), indicating the formation of LTP. Based on these results, it is easy to find that the formation and persistence of LTP in our device are highly dependent on both pulse numbers or pulse amplitude. These results coincide with the facts that the memory states, i.e., STM and LTM, and their stabilities in bio-synapses are related to the input stimulus characteristics.
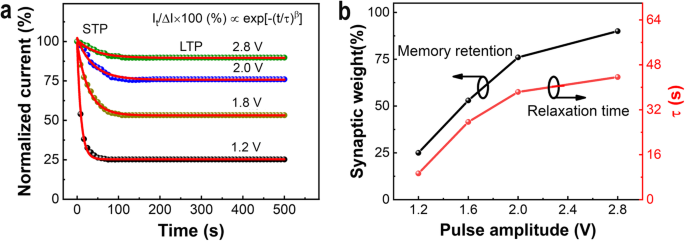
Experimental results of current decay in Ag/SiOx :Ag/TiOx /p ++ -Si memristor device after the stimulation process. a The normalized current decay versus time showing the transformation from STP to LTP; b The memory retention and relaxation time (τ ) as a function of the pulse amplitude
The spike-time-dependent-plasticity (STDP) is another fundamental character for learning and memory function [51] in a biological synapse. It has been reported [52] that in the electronic synapse, the weight can be modulated by a relative timing of pre- and post-synaptic pulses. The Hebbian STDP rule works as follows:if the pre-spike precedes the post-spike (Δt> 0), it could reinforce the connection strength between two neurons. In contrast, if the post-spike heads the pre-spike (Δt <0), it could weaken the connection strength between two neurons. Such kinds of reinforcement and weakening of connection strength between two neurons are also called LTP and LTD, respectively [45]. In the whole process, the order of pre- and post-spikes with respect to time determines the weight change (ΔW) polarity. In order to emulate the STDP rule in our device, a pair of pulses (+1.2 V, 5 ms, and −1.2 V, 5 ms) as pre- and post-spiking signals are implemented, as shown in Fig. 8a. It can be seen that there will emerge a more considerable conductance change (synaptic weight) with the decrease of Δt (in both cases when Δt> 0 and Δt <0). The percentage change in synaptic weight is defined as ΔW =(Gt −G0 )/G0 × 100%. Here, G0 is the conductance measured before stimulation and Gt is the conductance measured after the stimulation using pre- and post-spiking pairs, respectively. A plot is shown in Fig. 8b, that can explain the relationship between ΔW and Δt before and after the simulation process. It can be seen that when the pre-synapse (positive) appears before the post-spike (negative) (Δt> 0), the conductance is enhanced with an increase in ΔW along with the decrease in Δt. On the contrary, when the pre-synapse (positive) appears after the post-spike (negative) (Δt <0), the net conductance of the device is decreased (depressed) in ΔW along with the increase in Δt. These results have demonstrated that our Ag/SiOx :Ag/TiOx /p ++ -Si memristor device has successfully emulated the Hebbian STDP learning rule in the form of an artificial synapse.
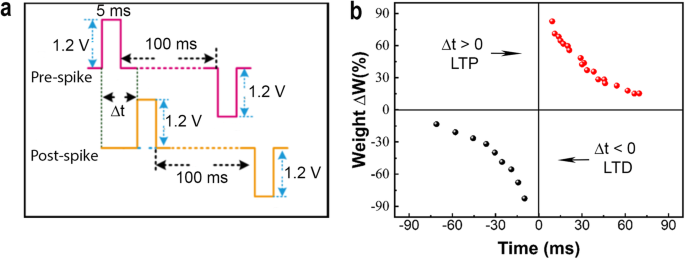
Experimental results for implementation of STDP rule in Ag/SiOx :Ag/TiOx /p ++ -Si memristor device. a The schematic illustration of implementing electrical programming bias comprising the pair of pulses at amplitudes +1.2 V and −1.2 V fixed with the same width of 5 ms. The approaching time difference between stimulus pulses is Δt ms (t =±10n, n =1, 2, …, 10); b The synaptic weight (ΔW) as a function of spike timing (Δt), demonstrating well on the potentiation and depression behaviors in the memristor device
Schlussfolgerungen
In summary, a new kind of memristor device with the simple structure of Ag/SiOx :Ag/TiOx /p ++ -Si has been fabricated by a physical vapor deposition process. The synaptic characteristics of the memristor with a wide range of resistance change for synaptic weight modulation by implementing positive or negative pulse trains have been investigated extensively. Several crucial learning and memory functions have been demonstrated simultaneously in such a single fabricated memristor device, including short-/long-term potentiation and depression (STP/STD, LTP/LTD), PPF and the STP-to-LTP transition as well as STDP, which are adjusted and controlled by repeating pulses more than a rehearsal operation. Furthermore, the analysis of logarithmic I-V characteristics with corresponding physical model indicates that the controlled formation/dissolution of Ag-filaments across the Ag and p ++ -Si electrodes could improve the performance of the new Ag/SiOx :Ag/TiOx /p ++ -Si memristor device with a buffer layer of TiOx between the SiOx :Ag layer and the bottom electrode. This developed device, as an artificial synapse, might bring a potential research prospect in the design and hardware implementation of new-generation biomimetic neural networks and computing systems.
Verfügbarkeit von Daten und Materialien
Alle Daten sind uneingeschränkt verfügbar.
Abkürzungen
- BE:
-
Untere Elektrode
- HRS:
-
High-resistance state
- I-V:
-
Strom-Spannung
- LRS:
-
Low-resistance state
- LTM:
-
Long-term memory
- LTP:
-
Long-term plasticity
- PPF:
-
Paired-pulse-facilitation
- SCLC:
-
Space-charge limited conduction
- STDP:
-
Spike-time-dependent-plasticity
- STM:
-
Short-term memory
- STP:
-
Short-term plasticity
- TE:
-
Top-Elektrode
- TEM:
-
Transmissionselektronenmikroskopie
- XPS:
-
Röntgenphotoelektronenspektroskopie
Nanomaterialien
- Analoge und digitale Signale
- Typen analoger und digitaler Sensoren mit Anwendungen
- Doppelfunktionen von V/SiOx/AlOy/p++Si-Gerät als Selektor und Speicher
- Auswirkungen von Ätzvariationen auf die Ge/Si-Kanalbildung und die Geräteleistung
- Auswirkung von CeO2−x/ZnO- und ZnO/CeO2−x-Doppelschichten-Heterostrukturen und Galvanoformungspolarität auf die Schalteigenschaften von nichtflüchtigem Speicher
- Verbesserter Nahinfrarot-Absorber:zweistufig hergestelltes strukturiertes schwarzes Silizium und seine Anwendung
- Verbesserte photokatalytische Eigenschaften von Ag/BiPbO2Cl-Nanoblatt-Verbundwerkstoffen, die auf sichtbares Licht reagieren
- Multifunktionales Gerät mit schaltbaren Funktionen der Absorption und Polarisationsumwandlung im Terahertz-Bereich
- Künstliche Intelligenz sagt das Verhalten von Quantensystemen voraus
- Vor- und Nachteile künstlicher Intelligenz



