Alternative Strategie zur Reduzierung der Oberflächenrekombination für InGaN/GaN-Mikrolicht-emittierende Dioden – Dünner werden der Quantenbarrieren zur Steuerung der Stromverteilung
Zusammenfassung
Aufgrund des hohen Oberfläche-zu-Volumen-Verhältnisses leiden InGaN-basierte Mikro-Leuchtdioden (μLEDs) stark unter Oberflächenrekombination, die durch Seitenwanddefekte induziert wird. Darüber hinaus wird mit abnehmender Chipgröße die Stromspreizung entsprechend verstärkt, wodurch die Ladungsträgerinjektion und die externe Quanteneffizienz (EQE) weiter eingeschränkt werden. In dieser Arbeit schlagen wir vor, die strahlungslose Rekombinationsrate an Seitenwanddefekten zu reduzieren, indem der Stromausbreitungseffekt gesteuert wird. Zu diesem Zweck reduzieren wir den vertikalen spezifischen Widerstand richtig, indem wir die Dicke der Quantenbarriere verringern, sodass der Strom weniger horizontal auf Seitenwanddefekte verteilt wird. Als Ergebnis werden viel weniger Ladungsträger im Wege der strahlungslosen Oberflächenrekombination verbraucht. Unsere berechneten Ergebnisse zeigen, dass die unterdrückte nichtstrahlende Oberflächenrekombination die Lochinjektionseffizienz besser begünstigen kann. Wir stellen auch die auf Si-Substraten aufgewachsenen μLEDs her, und die gemessenen Ergebnisse stimmen mit den numerischen Berechnungen überein, sodass die EQE für die vorgeschlagenen μLEDs mit richtig dünnen Quantenbarrieren dank des geringeren Stromausbreitungseffekts und der verringerten . verbessert werden kann strahlungslose Oberflächenrekombination.
Einführung
Aufgrund der charakteristischen Eigenschaften hoher Helligkeit, geringer Leistungsaufnahme und langer Betriebslebensdauer [1] haben Leuchtdioden (LEDs) auf der Basis von III-Nitrid ein umfangreiches Forschungsinteresse gefunden [2, 3]. Bisher wurden enorme Fortschritte bei großformatigen blauen InGaN/GaN-LEDs erzielt und kommerzialisiert [3], die Anwendungen in der Festkörperbeleuchtung und großformatigen Panel-Displays gefunden haben. Herkömmliche InGaN/GaN-LEDs haben jedoch eine kleine Modulationsbandbreite, was sie beispielsweise für die Kommunikation mit sichtbarem Licht (VLC) ungeeignet macht [4,5,6]. Indessen macht die große Chipgröße die Pixelkapazität für z. B. Handydisplays, tragbare Uhrendisplays gering. Daher haben InGaN/GaN-Mikro-LEDs (d. h. µLEDs) mit einer Chipgröße von weniger als 100 µm große Aufmerksamkeit auf sich gezogen. Trotz der genannten Vorteile sind bei der Weiterentwicklung von μLEDs noch viele Fragen zu lösen, wie beispielsweise der hochpräzise Stofftransport [7,8,9] und die größenabhängige Effizienz [10]. Die größenabhängige Effizienz ergibt sich aus Oberflächenschäden, die durch Trockenätzen bei der Herstellung von Mesas verursacht werden, und daher werden eine große Anzahl von Defekten erzeugt, die zu einer nichtstrahlenden Oberflächenrekombination führen. Beachten Sie, dass für verschiedene Arten von optoelektronischen Geräten die Kristallqualität und der Ladungstransport zu den wesentlichen Parametern gehören, die die photoelektronischen Eigenschaften beeinflussen [11,12,13,14,15,16]. Einzigartig für μLEDs kann die Oberflächenrekombination an defekten Regionen die interne Quanteneffizienz (IQE) für μLEDs signifikant reduzieren [17]. Kürzlich haben Kou et al. stellen außerdem fest, dass mit abnehmender Chipgröße Löcher leichter von den Defekten eingefangen werden und die Lochinjektionsfähigkeit für μLEDs mit abnehmender Chipgröße noch schlechter werden kann [18]. Daher ist es wichtig, die Seitenwanddefektdichte zu reduzieren. Ein sehr bequemes Verfahren zum Passivieren von Seitenwanddefekten ist das Abscheiden der dielektrischen Passivierungsschicht [19], was unter Verwendung eines plasmaunterstützten chemischen Gasphasenabscheidungsverfahrens (PECVD) oder eines Atomschichtabscheidungsverfahrens (ALD) möglich ist. Es wird gezeigt, dass die dielektrische Passivierungsschicht aufgrund der noch besseren Qualität der gewachsenen Schicht Seitenwanddefekte durch Verwendung der ALD-Technik besser vernichten kann [20]. Die Anzahl der Seitenwanddefekte kann dann durch thermisches Ausheilen der Passivierungsschicht weiter verringert werden [21], was den verbesserten EQE sogar für die 6 μm × 6 μm μLED zeigt. Die Stromspreizung kann bekanntlich noch besser werden, wenn die Chipgröße aufgrund des geringeren lateralen Widerstands weiter abnimmt [22]. Daher schlagen wir vor, den vertikalen spezifischen Widerstand zu reduzieren, um den Strom besser innerhalb von Mesas zu begrenzen, was dann die Ladungsträger von Seitenwanddefekten fernhält und hilft, die strahlungslose Oberflächenrekombination zu unterdrücken.
Um das Ziel zu erreichen, schlagen wir daher vor, die Dicke der Quantenbarrieren zu verringern, um die Energiebarrieren und den vertikalen Widerstand zu beherrschen. Unsere numerischen Berechnungen zeigen, dass der Strom seitlich stärker auf die Mesa begrenzt werden kann, was daher den Lochverbrauch durch strahlungslose Oberflächenrekombination reduziert. Die reduzierte strahlungslose Oberflächenrekombination trägt auch dazu bei, die Lochinjektion gemäß unserem vorherigen Bericht zu erleichtern [18]. Darüber hinaus homogenisieren die verdünnten Quantenbarrieren die Lochverteilung über die multiplen Quantentrogs (MQWs). Experimentelle Ergebnisse zeigen, dass die EQE für μLEDs mit reduzierter Quantenbarrierendicke verbessert ist.
Forschungsmethoden und Physikmodelle
Um die Effektivität der vorgeschlagenen Strukturen bei der Unterdrückung der Oberflächenrekombination, der Förderung der Lochinjektion und der Verbesserung der EQE für InGaN-μLEDs zu beweisen, werden verschiedene Sätze von μLEDs entworfen, die auf [111]-orientierten Si-Substraten unter Verwendung von metallorganischen Chemische Gasphasenabscheidung (MOCVD)-System [23, 24]. Alle Geräte verfügen über eine 4 µm dicke n-GaN-Schicht mit einer Elektronenkonzentration von 5 × 10 18 cm −3 . Dann vier Paar In0,18 Ga0,82 N/GaN-MQWs werden verwendet, um Photonen zu erzeugen. Die Strukturinformationen sind in Tabelle 1 dargestellt. Als nächstes wird ein 26 nm dickes p-Al0,15 Ga0,85 Die N-Schicht dient als p-Typ-Elektronenblockierschicht (p-EBL), für die das Lochkonzentrationsniveau 3 × 10 17 . beträgt cm −3 , der p-EBL wird dann mit einer 100 nm dicken p-GaN-Schicht mit einer Lochkonzentration von 3 × 10 17 . bedeckt cm −3 . Schließlich werden beide μLED-Proben mit einer 20-nm-p-GaN-Schicht bedeckt. Alle untersuchten blauen μLEDs auf InGaN-Basis haben die Chipgröße von 10 × 10 μm 2 . Als Stromverteilungsschicht wird 200 nm ITO verwendet, das 120 s lang bei einer Temperatur von 500 °C getempert wird, um einen ohmschen Kontakt mit der p-GaN-Schicht zu bilden. Dann wird gleichzeitig eine Ti/Al/Ni/Au/-Legierung auf der Stromaufweitungsschicht und der n-GaN-Schicht, die als p-Elektrode bzw. n-Elektrode dient, abgeschieden
Um die Gerätephysik auf einer tieferen Ebene aufzudecken, werden die untersuchten Geräte mit APSYS [25, 26] berechnet, das Drift-Diffusions-Gleichungen, Schrödinger- und Poisson-Gleichungen selbstkonsistent lösen kann. Die Lichtextraktionseffizienz wird für Flip-Chip-Geräte auf 88,1% eingestellt [27]. Das Energieband-Offset-Verhältnis zwischen dem Leitungsband und dem Valenzband in den InGaN/GaN-MQWs ist auf 70:30 eingestellt [28]. In unseren Berechnungen werden auch Trägerverluste aufgrund strahlungsloser Rekombination berücksichtigt, einschließlich der Auger-Rekombination mit dem Rekombinationskoeffizienten von 1 × 10 −30 cm 6 s −1 und Shockley-Read-Hall (SRH)-Rekombination mit einer Trägerlebensdauer von 100 ns [29]. Die an Mesa-Oberflächen auftretende strahlungslose Rekombination ist bei µLEDs nicht zu vernachlässigen. Um die Oberflächenrekombination genau zu modellieren, werden die Fallenniveaus für Elektronen und Löcher auf 0,24 eV unter dem Leitungsband eingestellt (d. h. Ec − 0,24 eV) und 0,46 eV über dem Valenzband (d. h. Ev + 0,46 eV). Der Erfassungsquerschnitt von 3,4 × 10 −17 cm 2 und die Fallendichte von 1 × 10 13 cm −3 sind für Elektronenfallen eingestellt [30]. Der Erfassungsquerschnitt von 2,1 × 10 –15 cm 2 und die Fallendichte von 1,6 × 10 13 cm −3 sind auf Löcher eingestellt [31]. Andere Parameter finden Sie an anderer Stelle [32].
Ergebnisse und Diskussionen
Beweis der besseren Strombegrenzung innerhalb der Mesa-Region durch dünner werdende Quantenbarrieren für μLEDs
Es ist bekannt, dass eine günstigere Lochinjektion erzielt werden kann, wenn die Quantenbarrieren dünn werden [33]. Es ist jedoch nicht klar, ob dünne Quantenbarrieren dazu beitragen, den Strom in Mesas für μLEDs zu begrenzen. Um den Punkt anzusprechen, haben wir hier μLEDs A, B und C, für die die Quantenbarrierendicken gemäß Tabelle 1 auf 6 nm, 9 nm bzw. 12 nm eingestellt sind. Um den Einfluss der Oberflächenrekombination auf die Ladungsträgerverteilung auszuschließen [18], betrachten wir für die untersuchten μLEDs keine Fallen in der Mesa-Peripherie. Abbildung 1 zeigt den berechneten EQE und die optische Leistung in Bezug auf die Injektionsstromdichte für die μLEDs A, B bzw. C. Wie in Abb. 1 gezeigt, nehmen sowohl die EQE als auch die optische Leistung zu, wenn die Dicke der Quantenbarriere verringert wird, sodass die EQE-Werte für die µLEDs A, B und C 28,8 %, 24,0 % und 22,2 % bei 40 A/ betragen. cm 2 .
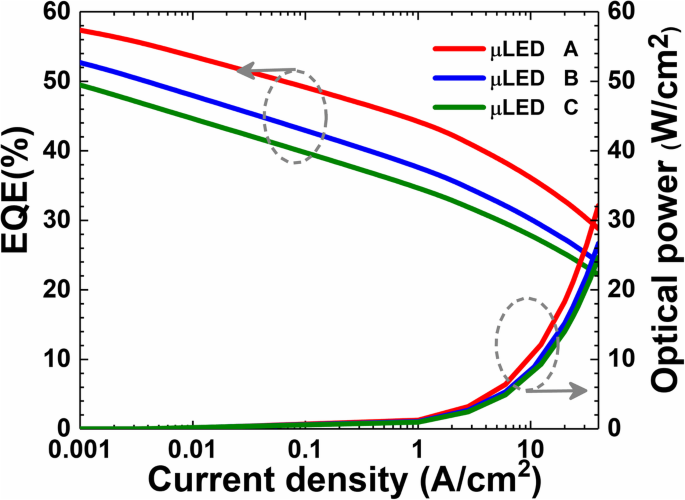
Berechnete EQE und optische Leistungsdichte in Bezug auf die Injektionsstromdichte für die μLEDs A, B bzw. C
Abbildung 2 zeigt die Lochkonzentrationsprofile im MQW-Bereich für die μLEDs A, B und C bei einer Stromdichte von 40 A/cm 2 . Wir sehen, wenn die Dicke der Quantenbarriere verringert wird, steigt die Lochkonzentration in den Quantentöpfen. Inzwischen kann auch die räumliche Gleichmäßigkeit der Lochverteilung in den vier Quantentöpfen verbessert werden. Daher stimmen die Ergebnisse hier für μLEDs mit denen für großformatige LEDs überein, sodass richtig dünne Quantenbarrieren den Lochtransport fördern können [33]. Wie bereits erwähnt, kann der Strom weniger zum Mesarand gespreizt werden, wenn dünne Quantenbarrieren verwendet werden. Wir präsentieren dann die laterale Lochverteilung im ersten Quantentopf, der der p-EBL in Abb. 3a am nächsten liegt. Wir stellen fest, dass die Lochkonzentration mit der lateralen Position abseits der p-Elektrode abnimmt. Wir berechnen dann den Droop-Level für Löcher, der als plinks . definiert ist -prechts /plinks . Hier, plinks und prechts werden als Lochkonzentration an der linken Mesakante bzw. der rechten Mesakante bezeichnet. Die Droop-Werte betragen 10,7 %, 10,3 % und 9,8 % für die µLEDs A, B bzw. C. Zur besseren Veranschaulichung normalisieren wir die laterale Lochkonzentration, die in Abb. 3b dargestellt ist. Es zeigt auch, dass das Droop-Niveau zunimmt, wenn die Quantenbarriere dünner wird.
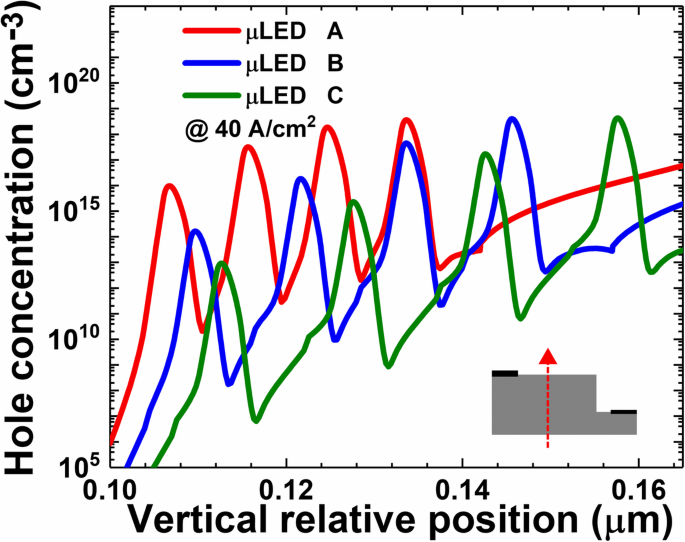
Numerisch berechnete Lochkonzentrationsprofile in MQW-Regionen für μLEDs A, B und C. Die Daten werden bei einer Stromdichte von 40 A/cm 2 . berechnet . Die eingefügte Abbildung zeigt die Position, an der die Datumsprofile erfasst werden
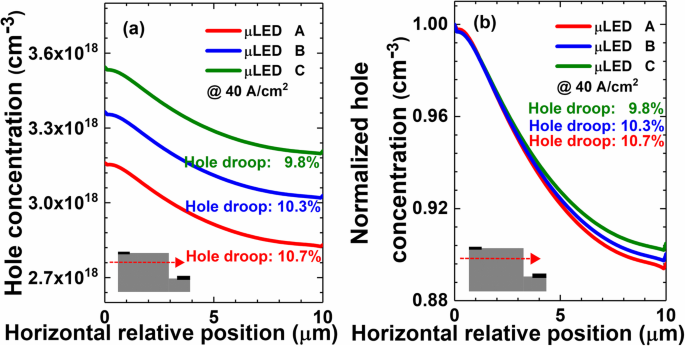
(a ) Numerisch berechnete Lochkonzentrationsprofile und (b ) normalisierte Lochkonzentrationsprofile im ersten Quantentopf nahe der p-EBL für die μLEDs A, B bzw. C. Die eingefügte Abbildung zeigt die Position, entlang der die Lochkonzentrationsprofile erfasst werden. Die Daten werden bei einer Stromdichte von 40 A/cm 2 . berechnet
Anschließend zeigen wir die Energiebanddiagramme für die μLEDs A, B und C in Abb. 4a–c. Es veranschaulicht, dass die Höhe der Valenzbandbarrieren für alle Quantenbarrieren kleiner wird, wenn die Dicke der Quantenbarriere abnimmt. Die reduzierte Höhe der Valenzbandbarrieren kann den Lochtransport durch den MQW-Bereich besser erleichtern, was mit 2 übereinstimmt. Andererseits wird, wenn die Quantenbarrieren dünner werden, entsprechend ein verringerter vertikaler spezifischer Widerstand erzeugt. Nach dem Bericht von Che et al. [34], wenn der vertikale Widerstand verringert wird, kann die seitliche Stromausbreitung unterdrückt werden, so dass der Strom dazu neigt, von der Mesakante entfernt zu sein. Diese Spekulation wird auch bewiesen, wenn wir uns auf Abb. 3a und b beziehen.
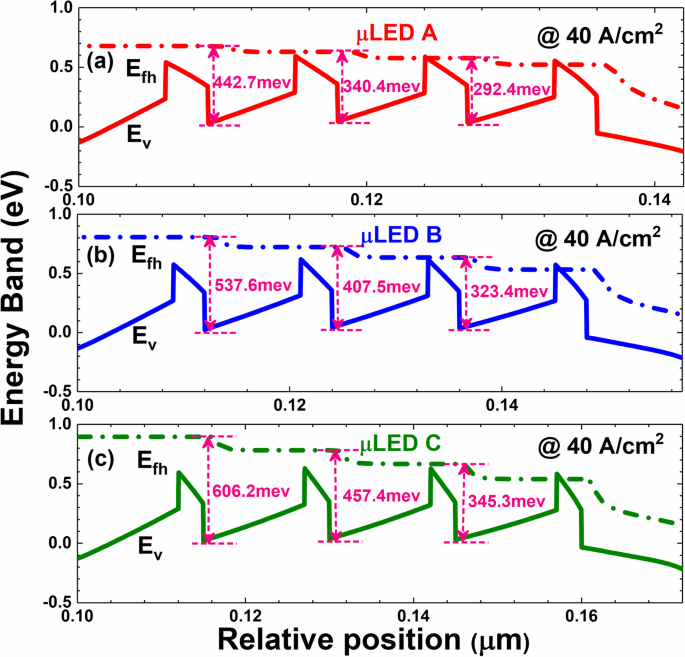
Energiebanddiagramme für μLEDs (a ) A, (b ) B und (c ) C. Ev , und Efh bezeichnen das Valenzband bzw. das Quasi-Fermi-Niveau für Löcher. Die Datenpflege berechnet bei einer Stromdichte von 40 A/cm 2
Wie oben erwähnt, wird die Stromausbreitung durch verdickende Quantenbarrieren verstärkt, was sicherlich die Ladungsträgerrekombinationsprozesse beeinflusst. Wir zeigen dann die Verhältnisse zwischen der SRH-Rekombination und der strahlenden Rekombination am Rand für die Mesas (siehe Abb. 5). Das Verhältnis wird berechnet mit \( {R}_{\mathrm{SRH}}/{R}_{\mathrm{rad}}={\int}_0^{{\mathrm{t}}_{\mathrm {M}\mathrm{QW}}}{R}_{\mathrm{SRH}}(x)\times \mathrm{dx}/{\int}_0^{{\mathrm{t}}_{{{ }_{\mathrm{M}}}_{\mathrm{QW}}}}{R}_{\mathrm{rad}}(x)\times \mathrm{dx}\), wobei R SRH (x) steht für die SRH-Rekombinationsrate, R rad (x) bezeichnet die Strahlungsrekombinationsrate und tMQW ist die Gesamtdicke für die MQW-Region. Abbildung 5 zeigt, dass die Verhältnisse von R SRH /R rad beide am Rand der Mesa nehmen mit zunehmender Dicke der Quantenbarriere ab, was bedeutet, dass die Strahlungsrekombinationsrate durch Verbesserung des Stromaufweitungseffekts für ideale μLED-Architekturen erhöht werden kann. Dies bedeutet, dass μLEDs aufgrund der deutlich reduzierten Chipgröße eine ausgezeichnete Stromverteilung aufweisen können [21, 22]. Beachten Sie, dass wir die Oberflächenrekombination für Abb. 5 noch nicht berücksichtigt haben. Daher können wir spekulieren, dass der viel bessere Stromverteilungseffekt für realistische μLEDs die Strahlungsrekombination des Trägers opfern kann, die durch Berücksichtigung von Oberflächenfehlern modelliert werden kann, und die ausführliche Diskussionen werden anschließend geführt.
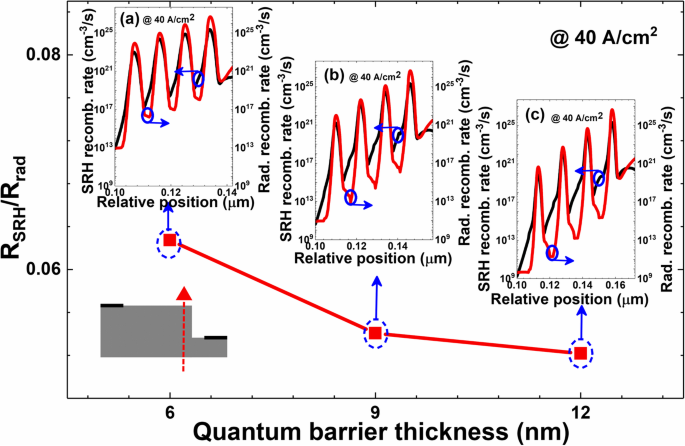
Verhältnisse der integrierten SRH-Rekombinationsrate (SRH) und der integrierten Strahlungsrekombinationsrate für die μLEDs A, B und C. Einschübe (a ), (b ) und (c ) sind die Profile für die SRH-Rekombinationsrate (SRH) und die Strahlungsrekombinationsrate an der Mesakante für die μLEDs A, B bzw. C. Die Daten werden bei einer Stromdichte von 40 A/cm 2 . berechnet
Reduzierte Oberflächenrekombination durch Verwendung von MQWs mit dünnen Quantenbarrieren
Um den Einfluss der Oberflächenrekombination auf die Lochinjektion für μLEDs mit unterschiedlichen Quantenbarrierendicken zu untersuchen, entwickeln wir weiterhin die μLEDs I, II und III. Die Strukturinformationen der MQWs für μLEDs I, II und III sind identisch mit denen für μLEDs A, B bzw. C (siehe Tabelle 1), außer dass die Oberflächendefekte für μLEDs I, II und III berücksichtigt werden, wie z dass die Breite des defekten Bereichs für μLEDs I, II und III auf 0,5 μm von der geätzten Mesakante eingestellt ist.
Der numerisch berechnete EQE und die optische Leistung als Funktion der Stromdichte sind in Abb. 6 dargestellt. Abb. 6 zeigt, dass die optische Intensität bei Betrachtung der nichtstrahlenden Oberflächenrekombination deutlich verringert werden kann. Dies bestätigt daher weiter, dass die strahlungslose Oberflächenrekombination für μLEDs nicht ignoriert werden kann [10, 17, 18]. In der Zwischenzeit, gut mit den Beobachtungen in Abb. 1 übereinstimmend, werden EQE und optische Leistung auch erhöht, wenn die Dicke der Quantenbarriere abnimmt, z. B. μLED I mit der dünnsten Quantenbarriere hat die größte EQE und optische Leistung. Die experimentell gemessenen EQE für μLEDs I und III sind im Einschub in Abb. 6a dargestellt, der den gleichen Trend wie die numerischen Berechnungsergebnisse zeigt. Darüber hinaus messen und zeigen wir die normalisierten Elektrolumineszenz(EL)-Spektren für die μLEDs I und III in Abb. 6b bzw. c. Die Spitzenemissionswellenlänge aller getesteten μLEDs beträgt ~450 nm. Die gemessene EL kann von unseren Modellen reproduziert werden. Dies zeigt an, dass die von uns verwendeten physikalischen Parameter richtig eingestellt sind, z. B. das Polarisationsniveau und die InN-Zusammensetzung in den MQWs, die die Emissionswellenlänge bestimmen, wurden richtig eingestellt.
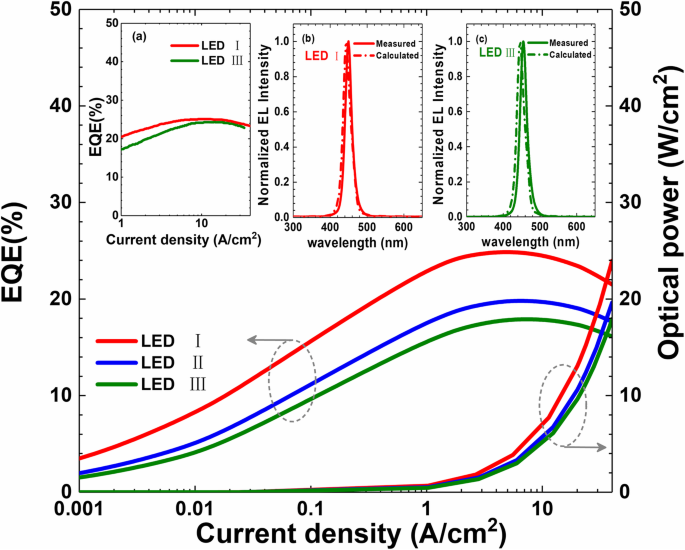
Berechnete EQE und optische Leistungsdichte in Bezug auf die Injektionsstromdichte für μLEDs I, II bzw. III. Eingesetzte Feige von (a ) zeigt die experimentell gemessene EQE für µLEDs I bzw. III. Eingesetzte Figuren von (b ) und (c ) präsentieren die gemessenen und numerisch berechneten EL-Spektren für μLEDs I und III. Daten für eingesetzte Feigen (b ) und (c ) werden bei einer Stromdichte von 40 A∕cm 2 . gesammelt
Um die Wirkung der Seitenwanddefekte auf die Lochinjektionseffizienz für μLEDs I, II und III aufzuzeigen, sind die Lochkonzentrationen in Fig. 7 gezeigt. Beachten Sie, dass die Lochkonzentration in Fig. 7a im mittleren Bereich auf . sondiert wird die Geräte [wie durch den roten Pfeil im Einschub von Abb. 7a angezeigt]. Abbildung 7b zeigt die Lochkonzentration im defekten Bereich für die Bauelemente [wie durch den roten Pfeil im Einschub von Abbildung 7b angezeigt]. Wie Fig. 7a und b veranschaulichen, begünstigt die reduzierte Dicke der Quantenbarrieren sowohl für den nicht-defekten Bereich als auch den Seitenwandbereich den Lochtransport durch die MQWs. Die Ergebnisse hier stimmen mit 2 überein. Ein weiterer Vergleich zwischen 7a und b zeigt, dass die Lochinjektionseffizienz in den defekten Seitenwandbereichen offensichtlich niedriger ist als die in dem nicht defekten Bereich. Die Beobachtungen hier stimmen gut mit Kou et al. [18], was weiter zeigt, dass es im Wesentlichen erforderlich ist, den Strom weniger auf die defekten Seitenwände auszubreiten, indem die Dicke der Quantenbarriere richtig reduziert wird (siehe Abb. 3a und b).

Numerisch berechnete Lochkonzentrationsprofile in der MQW-Region (a ) in der Mitte, (b ) am Rand der Mesas für μLEDs I, II bzw. III. Die Daten werden bei einer Stromdichte von 40 A/cm 2 . berechnet . Eingefügte Abbildungen zeigen die Position, entlang der die Lochkonzentrationsprofile erfasst werden
Wir wiederholen dann unsere Analyse wie in Abb. 5, deren Werte nun in Abb. 8 demonstriert werden. Wir sehen, dass das Verhältnis für R SRH /R rad an der Mesakante nimmt zu, wenn die Quantenbarriere verdickt wird, was eindeutig der deutlich erhöhten nichtstrahlenden Rekombinationsrate der Oberfläche zugeschrieben wird. Wie wir vorgeschlagen haben, ermöglichen dicke Quantenbarrieren dem Strom, an Mesakanten anzukommen und die strahlungslose Oberflächenrekombination auszulösen. Als Ergebnis zeigt der Einschub in Abb. a–c auch, dass die strahlungslose Oberflächenrekombination an den Mesakanten extrem stark wird. Die strahlungslose Rekombinationsrate an den Seitenwänden übertrifft sogar die strahlende Rekombinationsrate.

Verhältnisse der integrierten SRH-Rekombinationsrate (SRH) und der integrierten Strahlungsrekombinationsrate für μLEDs I, II und III. Eingesetzte Figuren (a ), (b ) und (c ) sind die Profile für die SRH-Rekombinationsrate (SRH) und die Strahlungsrekombinationsrate an der Mesakante für die μLEDs I, II bzw. III. Die Daten werden bei einer Stromdichte von 40 A/cm 2 . berechnet
Schlussfolgerungen
Zusammenfassend haben wir den Einfluss unterschiedlicher Quantenbarrierendicken auf die Lochinjektion und die Stromausbreitung für InGaN-basierte μLEDs numerisch untersucht und demonstriert. Die Ergebnisse zeigen, dass durch Verdünnen der Dicke der Quantenbarriere eine bessere Strombegrenzung innerhalb des Mesa-Bereichs ermöglicht werden kann. Dementsprechend kann die Stromausbreitung gut gesteuert werden, um abseits von Mesakanten zu liegen, was dann die nichtstrahlende Oberflächenrekombination unterdrückt. Sowohl numerisch als auch experimentell beobachten wir die verbesserte externe Quanteneffizienz für InGaN-basierte μLEDs mit richtig dünnen Quantenbarrieren. Wir glauben, dass der vorgeschlagene Ansatz vielversprechend ist, um den Engpass zu beseitigen, der die Entwicklung von Hochleistungs-μLEDs begrenzt. Darüber hinaus wird die in dieser Arbeit vorgestellte Gerätephysik das Verständnis von InGaN-basierten μLEDs verbessern.
Verfügbarkeit von Daten und Materialien
Die Daten und die Analysen in der aktuellen Arbeit sind auf begründete Anfrage bei den entsprechenden Autoren erhältlich.
Abkürzungen
- μLEDs:
-
Mikro-Leuchtdioden
- EQE:
-
Externe Quanteneffizienz
- LEDs:
-
Leuchtdioden
- InGaN:
-
Indium-Gallium-Nitrid
- GaN:
-
Galliumnitrid
- VLC:
-
Kommunikation mit sichtbarem Licht
- IQE:
-
Interne Quanteneffizienz
- PECVD:
-
Plasmaunterstützte chemische Gasphasenabscheidung
- ALD:
-
Atomlagenabscheidung
- MQWs:
-
Mehrere Quantentöpfe
- MOCVD:
-
Metall-organische chemische Gasphasenabscheidung
- p-EBL:
-
p-Typ-Elektronenblockierschicht
- APSYS:
-
Erweiterte physikalische Modelle von Halbleiterbauelementen
- SRH:
-
Shockley-Read-Hall
Nanomaterialien
- Bewältigen Sie diese Herausforderungen bei der Implementierung, um die Kosten von Skype for Business zu senken
- N,N-Dimethylformamid, das die Fluoreszenz von MXen-Quantenpunkten für die empfindliche Bestimmung von Fe3+ reguliert
- Untersuchung der Oberflächenpolarisation einer Al2O3-beschichteten GaN/AlGaN/GaN-Heterostruktur durch winkelaufgelöste Röntgenphotoelektronenspektroskopie
- Optimale Silizium-Dotierungsschichten von Quantenbarrieren in der Wachstumssequenz, die ein weiches Einschlusspotential von In0,2Ga0,8N/GaN-Quantenquellen von Blau mit acht Perioden bilden LEDs
- Stammkontrollierte Rekombination in InGaN/GaN-Mehrfachquantenquellen auf Siliziumsubstraten
- Über die p-AlGaN/n-AlGaN/p-AlGaN-Stromaufweitungsschicht für AlGaN-basierte tief ultraviolette Leuchtdioden
- Wechselwirkung von Temperatur und Anregungsintensität auf die Photolumineszenzeigenschaften von InGaAs/GaAs-Oberflächenquantenpunkten
- Trägerumverteilung zwischen zwei Arten von lokalisierten Zuständen in den durch Photolumineszenz untersuchten InGaN/GaN-Quantenquellen
- Tipps für Trucker zur Stressbewältigung auf der Straße
- Was sind die häufigsten Anwendungen für Wechselstrom?



