Verbesserung des Speicherfensters und der Lebensdauer von Hf0.5Zr0.5O2-basierten FeFETs mit ZrO2-Keimschichten, gekennzeichnet durch schnelle Spannungspulsmessungen
Zusammenfassung
Das HfO2 -basierter ferroelektrischer Feldeffekttransistor (FeFET) mit einem Metall/Ferroelektrisch/Isolator/Halbleiter (MFIS) Gate-Stapel wird derzeit als möglicher Kandidat für hochdichte und schnelle nichtflüchtige Speicher betrachtet. Obwohl die Rückhalteleistung des HfO2 -basierter FeFET mit einem MFIS-Gate-Stack könnte die Anforderungen für praktische Anwendungen erfüllen, sein Speicherfenster (MW) und die Zuverlässigkeit in Bezug auf die Lebensdauer sollen weiter verbessert werden. Diese Arbeit untersucht den Vorteil der Verwendung von ZrO2 Saatschichten auf MW, Retention und Beständigkeit des Hf0,5 Zr0,5 O2 (HZO)-basierte FeFETs mit MFIS-Gate-Stacks, unter Verwendung von schnellen Spannungspulsmessungen. Es zeigt sich, dass der HZO-basierte FeFET mit einem ZrO2 Die Saatschicht zeigt ein größeres anfängliches und auf 10 Jahre extrapoliertes MW sowie eine verbesserte Lebensdauerleistung im Vergleich zum HZO-basierten FeFET ohne ZrO2 Samenschicht. Die Ergebnisse zeigen, dass der Einsatz eines direktkristallinen Gate-Stapels mit hohem k/Si das MW und die Zuverlässigkeit des HfO2 . weiter verbessern würde -basierte FeFETs.
Hintergrund
HfO2 -basierte ferroelektrische Dünnschichten gelten aufgrund ihrer Komplementär-Metall-Oxid-Halbleiter (CMOS)-Kompatibilität und Skalierbarkeit als vielversprechende Gate-Stack-Materialien für ferroelektrische Feldeffekttransistoren (FeFETs). Unter mehreren Arten von Gatestapelstrukturen, die in FeFETs verwendet werden können, stellt ein Metall/Ferroelektrisch/Isolator/Halbleiter (MFIS) eine praktischere Konfiguration dar, da sie den aktuellen MOS-Bauelementenarchitekturen folgt und gut mit dem modernen High-k-Metall-Gate harmoniert (HKMG) Prozesse. Daher wurden große Anstrengungen unternommen, um FeFETs mit MFIS-Gate-Stack-Strukturen für Anwendungen in eingebetteten nichtflüchtigen Speichern, Feldeffekttransistoren mit negativer Kapazität, künstlichen Neuronen, Synapsen und Logik-im-Speicher-Bauelementen zu entwerfen und herzustellen [1,2,3,4 ,5,6,7,8].
Bisher wurden FeFETs mit hoher Dichte und hoher Schreibgeschwindigkeit mit MFIS-Gate-Stack-Strukturen erfolgreich mit HKMG-Prozessen hergestellt [9, 10]. Für den Einsatz von FeFETs für nichtflüchtige Speicheranwendungen sind neben der hohen Integrationsdichte und schnellen Schreibgeschwindigkeit auch ein großes Speicherfenster (MW) und eine hohe Zuverlässigkeit hinsichtlich Retention und Ausdauer entscheidend [11,12,13,14]. Aufgrund eines großen Bandversatzes zu Silizium, einem hohen Koerzitivfeld und einer moderaten Dielektrizitätskonstante des HfO2 -basierte ferroelektrische Dünnschichten, HfO2 -basierte FeFETs mit MFIS-Gate-Stack-Strukturen zeigen zuverlässige Retentionseigenschaften (10-Jahres-Extrapolation) [15,16,17]. Obwohl das HfO2 -basierte Dünnschichten weisen eine mäßige Beständigkeit von über 1 × 10 9 . auf Schaltzyklen [14, 18], HfO2 -basierte FeFETs mit MFIS-Gate-Stack-Strukturen haben eine eher begrenzte Lebensdauer im Bereich von 1 × 10 4 bis 1 × 10 7 Schaltzyklen [17, 19, 20, 21, 22, 23]. Theoretisch wird erwartet, dass die Verwendung von High-k-Isolatorschichten das elektrische Feld im MFIS-Gate-Stapel reduziert, was die Bandbiegung mildern würde, wodurch die Lebensdauereigenschaften und die MWs des HfO2 . verbessert werden -basierte FeFETs [12, 14]. Experimentell haben Ali et al. verifiziert, dass eine Erhöhung des k-Wertes der ultradünnen Isolatorschicht (d. h. Verwendung von SiON anstelle von SiO2 ) kann die Ausdauereigenschaften sowie das MW des HfO2 . effektiv verbessern -basierte FeFETs [13]. In unserer früheren Forschung [24] berichteten wir, dass die Insertion eines kristallinen ZrO2 High-k-Schicht in den MFIS-Gate-Stacks könnte die kristalline Qualität verbessern und die Bildung einer monoklinen Phase in Hf0,5 . unterdrücken Zr0,5 O2 (HZO) dünne Filme, was zu einem großen MW von 2,8 V führt, charakterisiert durch die DC-Spannungs-Sweep-Methode.
In dieser Arbeit berichten wir über die Charakterisierung der MWs, Retention und Lebensdauer der HZO-basierten FeFETs mit und ohne kristallinem ZrO2 Saatschichten durch schnelle positive und negative Spannungsimpulsmessungen. Darüber hinaus ist der Vorteil der Verwendung von kristallinem ZrO2 Saatschichten auf die MW- und Ausdauereigenschaften werden diskutiert.
Methoden
Die n-Kanal-FeFETs mit und ohne ZrO2 Saatschichten wurden unter Verwendung eines Gate-Last-Prozesses hergestellt, wie in [24] beschrieben. Das ZrO2 Saatschicht und HZO-Schicht wurden beide bei einer Wachstumstemperatur von 300 o . gezüchtet C durch Atomlagenabscheidung (ALD). Das Schema der hergestellten FeFETs ist in Abb. 1a gezeigt, deren Kanalbreite (W ) und Länge (L ) betrugen 80 bzw. 7 µm. Unterdessen TaN/HZO/TaN und TaN/HZO/ZrO2 /TaN-Kondensatoren wurden auch hergestellt, um die ferroelektrischen Eigenschaften der HZO-Dünnfilme zu bewerten. Die Polarisationsspannung (P-V ) Hystereseschleifen der Kondensatoren wurden mit einem ferroelektrischen Testsystem RT66A von Radiant Technologies gemessen, während die Geräteeigenschaften von FeFETs mit einem Agilent B1500A Halbleiter-Geräteanalysator mit einer Pulsgeneratoreinheit (B1525A) gemessen wurden [20]. Zwei Haupttestsequenzen für MW- und Dauerlaufmessungen sind in Abb. 1b und c dargestellt. Für MW- und Retentionsmessungen wurden zunächst Programmier-/Löschimpulse (P/E) an die Gates von FeFETs angelegt und Lesevorgänge in unterschiedlichen Zeitintervallen unter Verwendung von I . durchgeführt D –V G fegen (V D = 0.1 V), um V . zu messen TH . Im Allgemeinen V TH wird als eine Gate-Spannung entsprechend einem Drain-Strom von 10 –7 bestimmt A∙W/L [25], und MW ist definiert als die Differenz von V TH Werte zwischen programmierten und gelöschten Zuständen. Für Dauermessungen wurde das MW nach einer bestimmten Anzahl von abwechselnden P/E-Pulsen gemessen.

a Schema der hergestellten FeFETs. Das zusätzliche kristalline ZrO2 Die Saatschicht ist durch schwarze Gitterlinien gekennzeichnet. b , c Testsequenzen für MW- und Dauermessungen
Ergebnisse und Diskussion
Abbildung 2a zeigt die P–V Hystereseschleifen von TaN/HZO/TaN und TaN/HZO/ZrO2 /TaN-Kondensatoren. Bemerkenswert ist, dass die TaN/HZO/ZrO2 /TaN-Kondensator besitzt sogar bessere ferroelektrische Eigenschaften als der TaN/HZO/TaN-Kondensator, was mit den berichteten Ergebnissen übereinstimmt [26], was darauf hindeutet, dass das kristalline ZrO2 Die Saatschicht könnte in der Tat die kristalline Qualität verbessern und die Bildung einer monoklinen Phase in HZO-Dünnschichten unterdrücken [24]. Abbildung 2b zeigt das I D –V G Kurven der HZO-basierten FeFETs mit und ohne zusätzliches kristallines ZrO2 Saatschichten nach P/E-Pulsen. Die roten Symbollinien repräsentieren das I D –V G Kurven nach Anlegen eines Programmpulses von 7 V/100 ns, während die blauen Symbollinien die I D –V G Kurven nach Anlegen eines Löschimpulses von – 7 V/100 ns. Man sieht, dass das Ich D –V G Die Kurven beider FeFETs zeigen Schaltcharakteristiken gegen den Uhrzeigersinn, was darauf hindeutet, dass die MWs der vorliegenden FeFETs eher vom Polarisationsschalten der HZO-Schichten als vom Ladungseinfang und der Ladungsinjektion stammen. Dennoch ist der HZO-basierte FeFET mit dem zusätzlichen kristallinen ZrO2 Die Keimschicht weist ein verbessertes MW von 1,4 V auf, ungefähr 1,8 mal größer als das (0,8 V) des HZO-basierten FeFET ohne das zusätzliche kristalline ZrO2 Samenschicht. Darüber hinaus ist das erhaltene MW von 1,4 V mit den besten bisher berichteten Ergebnissen vergleichbar [9, 11, 14, 17, 21, 22, 23, 27].
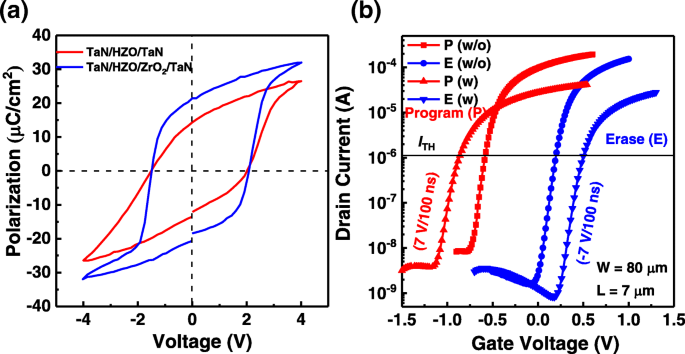
a P–V Hystereseschleifen von TaN/HZO/TaN und TaN/HZO/ZrO2 /TaN MFM-Strukturen gemessen bei 4 V und einer Frequenz von 5 kHz. b Ich D –V G Kurven von HZO-basierten FeFETs mit (w) und ohne (w/o) ZrO2 Saatschichten nach einem Programmierimpuls (+ 7 V/100 ns) und einem Löschimpuls (− 7 V/100 ns)
Zuverlässigkeit bezüglich der Retention der HZO-basierten FeFETs mit und ohne zusätzliches kristallines ZrO2 Saatschichten wurden ebenfalls bewertet. Abbildung 3 zeigt das V TH Retentionseigenschaften nach Anlegen eines Programmierpulses von 7 V/100 ns und eines Löschpulses von – 7 V/100 ns bei Raumtemperatur. Es ist klar, dass die V TH Werte sind ungefähr linear mit der logarithmischen Zeitskala. Das extrapolierte MW nach 10 Jahren für den HZO-basierten FeFET mit dem zusätzlichen kristallinen ZrO2 Saatschicht ist 0,9 V, größer als die (0,6 V) für den HZO-basierten FeFET ohne das zusätzliche kristalline ZrO2 Samenschicht. Da die äquivalente Dicke der dicken Kapazität (CET) des ZrO2 (1,5 nm)/SiO2 (2,6 nm) Gate-Isolatorschichten würden zu einem verstärkten Depolarisationsfeld im Gate-Stapel führen [13, 15], eine weitere Verbesserung der Retentionseigenschaften könnte erwartet werden, wenn die Dicke des SiO2 Schicht wird reduziert.

Retentionseigenschaften von HZO-basierten FeFETs mit und ohne ZrO2 Saatschichten
Abbildung 4 zeigt die Entwicklung von I D –V G Kurven nach ± 7 V/100 ns abwechselnden P/E-Zyklen. Für den FeFET ohne das zusätzliche kristalline ZrO2 Saatschicht, sowohl signifikante Verschiebung als auch Neigungsverschlechterung im I D –V G Kurven werden von den frühen Stadien des P/E-Cyclings beobachtet, und die I D –V G Kurven in den gelöschten Zuständen weisen im Vergleich zu den Programmzuständen eine stärkere Verschlechterung der Steigung auf. Für den FeFET mit dem zusätzlichen kristallinen ZrO2 Samenschicht, obwohl das I D –V G Kurven in gelöschten Zuständen zeigen eine offensichtliche positive Verschiebung während der frühen Phasen des P/E-Cyclings, die dem „Wake-up“-Effekt zugeschrieben wird [13, 28, 29, 30, 31, 32], keine offensichtliche Verschiebung von I D –V G Kurven in den Programmzuständen wird bis zu 1 × 10 3 . beobachtet Fahrräder. Für den FeFET mit dem zusätzlichen kristallinen ZrO2 Saatschicht, das I D –V G Kurven sowohl im gelöschten als auch im programmierten Zustand zeigen nur eine leichte Verschlechterung der Steigung bis zu 1 × 10 3 Zyklen.
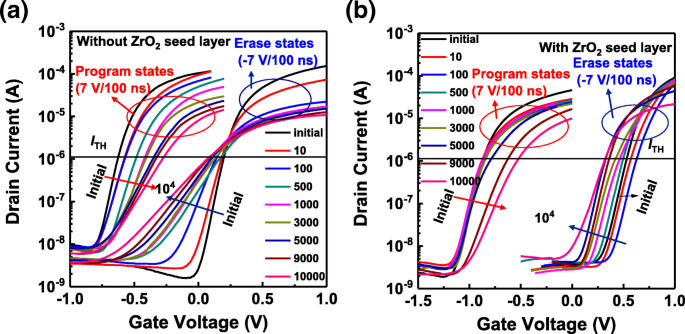
Entwicklung von Ich D –V G Kurven von HZO-basierten FeFETs a ohne und b mit ZrO2 Saatschichten mit P/E-Cycling
Nach früheren Berichten [12, 28, 33] ist die Parallelverschiebung in I D –V G Kurven wird der allmählichen Akkumulation gefangener Ladungen im Gate-Stapel zugeschrieben, während die Steigungsverschlechterung in I D –V G Kurven ist das Ergebnis der Erzeugung von Schnittstellenfallen. Da eingefangene Ladungen mit elektrischen Mitteln abgefangen werden können, die Erzeugung von Grenzflächenfallen jedoch irreversibel ist, ist die Minimierung der Erzeugung von Grenzflächenfallen äußerst wichtig, um die Beständigkeitseigenschaften zu verbessern [28]. Die durch P/E-Cycling erzeugten Schnittstellenfallen (ΔN es ) kann mit Gl. (1) [34, 35]:
$$ \Updelta \mathrm{SS}=\frac{\Updelta {N}_{it} kT\ln 10}{C_{FI}{\varnothing}_F} $$ (1)wobei ΔSS die Änderung des unterschwelligen Swings ist, k ist die Boltzmann-Konstante, T ist die absolute Temperatur, C FI die Gesamtkapazität des Gatestapels ist und ∅ F ist das Fermipotential. Die ΔN es als Funktion des P/E-Zyklus für die HZO-basierten FeFETs mit und ohne zusätzliches kristallines ZrO2 Saatschichten sind in Abb. 5 dargestellt. Für den FeFET ohne das zusätzliche kristalline ZrO2 Saatschicht, die ΔN es steigt offensichtlich von den frühen Stadien des P/E-Zyklus an, und ΔN es in den gelöschten Zuständen ist viel größer als in den Programmzuständen. Die ΔN es für den FeFET mit dem zusätzlichen kristallinen ZrO2 Saatschicht ändert sich fast nicht bis zu 1 × 10 3 Zyklen und ist immer kleiner als beim FeFET ohne das zusätzliche kristalline ZrO2 Samenschicht. Da das Einfügen des zusätzlichen ZrO2 Die Saatschicht reduziert das elektrische Feld im Gate-Stapel und somit ist die Bandverbiegung schwächer, die Erzeugung von Grenzflächenfallen wird abgeschwächt [12, 14].
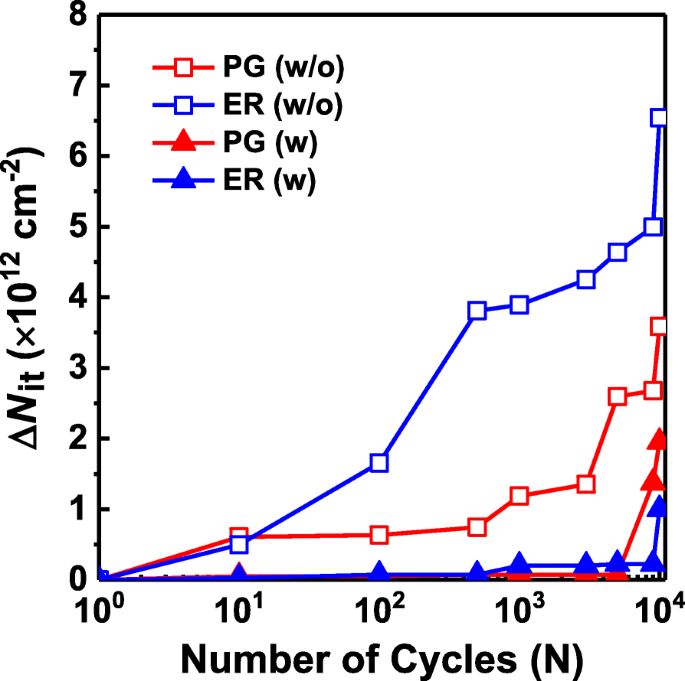
Entwicklung von ∆N es mit P/E-Radfahren
Abbildung 6 zeigt die Entwicklung der Gate-Leckstromcharakteristik (I G –V G Kurven) von HZO-basierten FeFETs mit und ohne ZrO2 Saatschichten mit P/E-Cycling. Für den FeFET ohne das zusätzliche kristalline ZrO2 Seed-Schicht steigt der Gate-Leckstrom von den frühen Stadien des P/E-Zyklus dramatisch an. Der Gate-Leckstrom für den FeFET mit dem zusätzlichen kristallinen ZrO2 Saatschicht ändert sich fast nicht bis zu 5 × 10 2 Zyklen und ist immer kleiner als beim FeFET ohne das zusätzliche kristalline ZrO2 Samenschicht. Es wird berichtet, dass der Anstieg des Gate-Leckstroms mit den erzeugten Grenzflächenfallen zusammenhängen könnte [28]. Die Reduzierung des Gate-Leckstroms beim Zyklen für den FeFET mit dem zusätzlichen kristallinen ZrO2 Saatschicht würde auf die Unterdrückung der Erzeugung von Grenzflächenfallen zurückgeführt.
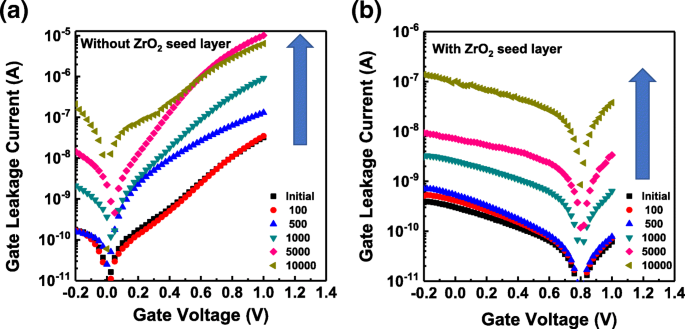
Entwicklung der Gate-Leckstromcharakteristik (I G –V G Kurven) von HZO-basierten FeFETs a ohne und b mit ZrO2 Saatschichten mit P/E-Cycling
Das V TH Werte für Programm- und Löschzustände, die aus dem I . extrahiert wurden D –V G Kurven der HZO-basierten FeFETs mit und ohne zusätzliches kristallines ZrO2 Saatschichten sind in Abb. 7 dargestellt. Der HZO-basierte FeFET mit dem zusätzlichen kristallinen ZrO2 Saatschicht weist immer ein größeres MW auf als der HZO-basierte FeFET ohne das zusätzliche kristalline ZrO2 Samenschicht. Darüber hinaus ist das MW des HZO-basierten FeFET ohne das zusätzliche kristalline ZrO2 Saatschicht nimmt offensichtlich ab den frühen Stadien des P/E-Zyklus ab, während das MW des HZO-basierten FeFET mit dem zusätzlichen kristallinen ZrO2 Die Saatschicht nimmt bis zu 1 × 10 3 . leicht ab Fahrräder. Da die P/E-Zykluszahl weiter erhöht wird, wird der HZO-basierte FeFET mit dem zusätzlichen kristallinen ZrO2 Die Saatschicht zeigt auch eine deutliche Verschlechterung der Steigung des I D –V G Kurven und MW, aufgrund der verbesserten Erzeugung von Grenzflächenfallen. Das MW des HZO-basierten FeFET mit dem zusätzlichen kristallinen ZrO2 Saatschicht ist immer noch größer als 0,9 V bis zu 1 × 10 4 Zyklen, die ungefähr 2,3-mal größer ist als die (0,4 V) des HZO-basierten FeFET ohne das zusätzliche kristalline ZrO2 Samenschicht. Wie bereits erwähnt, ist die Verringerung des erforderlichen elektrischen Felds zum Erhalten gesättigterer Polarisationszustände wahrscheinlich für die verbesserten Lebensdauereigenschaften verantwortlich.

Entwicklung von V TH mit P/E-Radfahren
Schlussfolgerungen
Die MWs sowie die Zuverlässigkeit bezüglich Retention und Lebensdauer der HZO-basierten FeFETs mit dem TaN/HZO/SiO2 /Si und TaN/HZO/ZrO2 /SiO2 /Si MFIS-Gate-Stacks wurden durch schnelle Spannungspulsmessungen charakterisiert. Die Ergebnisse zeigen, dass der HZO-basierte FeFET mit dem zusätzlichen kristallinen ZrO2 Die Keimschicht weist ein großes anfängliches Speicherfenster von 1,4 V und eine extrapolierte 10-Jahres-Retention von 0,9 V auf, größer als das anfängliche Speicherfenster (0,8 V) des HZO-basierten FeFET ohne das zusätzliche kristalline ZrO2 Samenschicht. Darüber hinaus kann die Zuverlässigkeit in Bezug auf die Lebensdauer des HZO-basierten FeFET durch Einfügen des kristallinen ZrO2 . verbessert werden Saatschicht zwischen der HZO-Schicht und dem SiO2 /Si-Substrat. Die MW- und Lebensdauerverbesserung von HZO-basierten FeFETs mit ZrO2 Keimschichten hängen hauptsächlich mit der verbesserten kristallinen Qualität der HZO-Schicht und der unterdrückten Erzeugung von Grenzflächenfallen aufgrund der Abnahme des erforderlichen elektrischen Felds zum Erhalten gesättigterer Polarisationszustände zusammen. Auf der Grundlage dieser Arbeit wird erwartet, dass der Einsatz eines direkt kristallinen Gate-Stapels mit hohem k/Si die MWs und die Zuverlässigkeit des HfO2 . weiter verbessern würde -basierte FeFETs und rechtfertigen daher weitere Studien und Entwicklungen.
Verfügbarkeit von Daten und Materialien
Die Datensätze, die die Schlussfolgerungen dieses Artikels unterstützen, sind im Artikel enthalten.
Abkürzungen
- CMOS:
-
Komplementärer Metalloxid-Halbleiter
- FeFET:
-
Ferroelektrischer Feldeffekttransistor
- FeFETs:
-
Ferroelektrische Feldeffekttransistoren
- HKMG:
-
High-k-Metall-Gate
- HZO:
-
Hf0,5 Zr0,5 O2
- I D :
-
Strom entziehen
- L:
-
Länge
- MFIS:
-
Metall/ferroelektrisch/Isolator/Halbleiter
- MW:
-
Speicherfenster
- P/E:
-
Programmieren/Löschen
- P–V :
-
Polarisation–Spannung
- SS :
-
Schwung unter der Schwelle
- V G :
-
Gatespannung
- V TH :
-
Schwellenspannung
- W:
-
Breite
- ΔN es :
-
Die generierten Schnittstellenfallen
Nanomaterialien
- ST:8-Bit-MCUs mit Rich Analog und DMA im kostengünstigen SO-8-Paket
- Intelligentes Nanomaterial und Nanokomposit mit fortschrittlichen agrochemischen Aktivitäten
- Compliance-freier ZrO2/ZrO2 − x /ZrO2 Resistiver Speicher mit steuerbarem Grenzflächen-Mehrzustands-Schaltverhalten
- Leitungsmechanismus und verbesserte Ausdauer bei HfO2-basiertem RRAM mit Nitridierungsbehandlung
- Frequenzmodulation und Absorptionsverbesserung von THz-Mikrobolometern mit Mikrobrückenstruktur durch spiralförmige Antennen
- Morphologie, Struktur und optische Eigenschaften von Halbleiterfilmen mit GeSiSn-Nanoinseln und gespannten Schichten
- Hochleistungs-U-Kanal-FETs mit rechteckigem Gate und nur 2 nm Abstand zwischen Source- und Drain-Kontakten
- Eine widerstandslose Spannungsreferenz im Nanomaßstab mit hohem PSRR
- Auf Hf0.5Zr0.5O2-basierter Hf0.5Zr0.5O2-basierter flexibler Memristor mit kurz-/langfristiger synaptischer Plastizität
- Hohe Durchbruchspannung und niedriger dynamischer EIN-Widerstand AlGaN/GaN-HEMT mit Fluorionenimplantation in SiNx-Passivierungsschicht



