Eliminierung der bimodalen Größe in InAs/GaAs-Quantenpunkten zur Herstellung von 1,3-μm-Quantenpunktlasern
Zusammenfassung
Die Geräteeigenschaften von Halbleiter-Quantenpunktlasern wurden mit dem Fortschritt bei den aktiven Schichtstrukturen verbessert. Selbstorganisierende InAs-Quantenpunkte, die auf GaAs aufgewachsen sind, wurden intensiv gefördert, um Quantenpunktlaser mit überlegenen Geräteleistungen zu erzielen. Beim Wachsen von hochdichten InAs/GaAs-Quantenpunkten tritt eine bimodale Größe aufgrund einer großen Fehlanpassung und anderer Faktoren auf. Die bimodale Größe im InAs/GaAs-Quantenpunktsystem wird durch das Verfahren des Hochtemperaturglühens eliminiert und die in situ Glühtemperatur optimiert. Die Glühtemperatur wird als die wichtigsten Optimierungsparameter verwendet, und die optimale Glühtemperatur von 680 °C wurde erhalten. Bei diesem Prozess werden die Quantenpunkt-Wachstumstemperatur, die InAs-Abscheidung und der Arsen-(As)-Druck optimiert, um die Quantenpunktqualität und Emissionswellenlänge zu verbessern. Ein 1,3-μm-Hochleistungs-F-P-Quantenpunktlaser mit einer Schwellenstromdichte von 110 A/cm 2 wurde demonstriert.
Einführung
Vor zehn Jahren wurde der 1,3-μm-Quantenpunktlaser (QD) entwickelt; jedoch gab es seitdem bis heute keine deutliche Entwicklung oder Fortschritte beim Quantenpunktwachstum. Der 1,3-μm-Quantenpunktlaser ist erneut ein heißes Studienthema. Es hat sich zu einem der starken Konkurrenten für die optische Hochgeschwindigkeits-Lichtquelle für lokale Netzwerke (LAN) entwickelt. Die hohe Dichte von Quantenpunkten ist ein wichtiger Faktor, der zu niedrigem Stromverbrauch, Hochtemperaturstabilität und hoher Geschwindigkeit führt. Wie allgemein bekannt ist, wird erwartet, dass der 1,3-μm-InAs/GaAs-Quantenpunktlaser aufgrund der dreidimensionalen Quantenbeschränkungen eine hervorragende Leistung beim Schwellenstrom, Temperaturstabilität und Modulationseigenschaften aufweist [1]. In den letzten 10 Jahren haben sehr viele Labore auf der ganzen Welt ihr Ziel erreicht, die Leistung von QD-Lasern stark zu verbessern [2,3,4,5]. Die bimodale Größe im InAs/GaAs-Quantenpunktsystem existiert jedoch immer noch [6, 7]. Die Quantenpunktqualität kann gesteigert werden, wenn die bimodale Größe eliminiert werden kann.
Durch Molekularstrahlepitaxie (MBE) gezüchtete InAs/GaAs-Heterostrukturen wurden viel Aufmerksamkeit geschenkt, um niedrigdimensionale Nanostrukturen herzustellen, wie selbstorganisierte QDs aufgrund einer großen Gitterfehlanpassung (~ 7%) zwischen InAs-Schichten und GaAs-Substrat [8] . Das Wachstum von InAs auf GaAs (001)-Substrat führt zur Bildung einer dreidimensionalen (3D) Inselform auf dem InAs mit dem Stranski-Krastanov (SK)-Wachstumsmodus. Es wird erwartet, dass die SK-Wachstumstechnik eine bequeme Herstellungsmethode für hochdichte kohärente QDs ist und immer noch eine offene Herausforderung darstellt [9, 10]. SK-QDs haben jedoch einige Probleme, wie die große inhomogene Verbreiterung der QD-Energieniveaus und das bimodale Größenproblem [11,12,13,14,15]. Für MBE-Wachstumsquantenpunkte mit hoher Dichte besteht der herkömmliche Weg darin, die Abscheidungsrate von InAs zu erhöhen und die Wachstumstemperatur zu senken. Der Zweck dieses Ansatzes besteht darin, die Migrationsrate zu reduzieren, die die Bildung der Insel schnell machen kann. Ein Wachstum bei niedriger Temperatur kann jedoch die Gitterqualität des epitaktischen Materials verringern. Andererseits kann schnelles Wachstum die Quantenpunktdichte erhöhen, aber es erzeugt auch mehr Versetzungen. Dementsprechend wurde die Photolumineszenzintensität von InAs-QDs schwach, als wir mit dem herkömmlichen Ansatz eine hohe Dichte von InAs-QDs erreichten.
In diesem Brief kann ein einschichtiges Hochtemperaturglühen die Defekte des Deckmaterials effektiv beseitigen und die Wachstumsrichtung von Versetzungen ändern. Die Größe und Form von InAs SK-Quantenpunkten zeigt einen hohen Grad an Gleichförmigkeit durch einschichtiges Tempern, das auf GaAs (001)-Substraten aufgewachsen ist. Es gab eine Zunahme der Abscheidung von InAs, was gleichzeitig die Sättigung jedes QD verbesserte. Die PL-Spektren der einheitlichen InAs-QDs zeigten eine schmale Linienbreite von weniger als 26 meV. Es werden 1,3-μm-InAs/GaAs-QD-Laser hergestellt, die einen Laserschwellenstrom I . aufweisen te von 220 mA und einer Schwellenstromdichte von 110 A/cm 2 .
Materialoptimierung
In dieser Studie wird die Quantenpunktstruktur auf GaAs (001) (N+)-Substraten in einem Veeco Gen 930 MBE-System aufgewachsen. Die Glühtemperatur wurde untersucht und die Glühtemperaturen für diese vier Proben (N170813, N170824A-N17084C) betragen 630, 680, 730 bzw. 780 °C. Die Wachstumsparameter der Quantenpunkte dieser vier Proben sind genau gleich (Tabelle 1).
Photolumineszenz (PL)-Messungen wurden für die vier Proben durchgeführt. Mit der Erhöhung der Glühtemperatur wurde die stärkste PL-Intensität bei der Glühtemperatur von 680 °C erreicht (wie in Abb. 1 gezeigt). Dies liegt daran, dass Arsen (As) und Ga desorbiert werden, wenn die Glühtemperatur höher ansteigt. Dieser Prozess kann mehr Defekte erzeugen und das Gitter der InAs-Quantenpunkte hat sich bei hohen Temperaturen verändert.
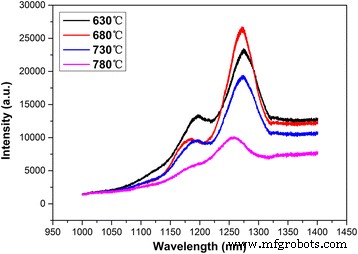
Vergleich der Photolumineszenz(PL)-Spektren von Epitaxiewafern bei unterschiedlichen Tempertemperaturen
Die aktive Fläche des Quantenpunktlasers wurde bei dem niedrigen Arsendruck von 4 × 10 − 7 . optimiert Torr [16] und niedrige Wachstumsrate von 0,025 ML/s. Nach dem Tempern stellten wir fest, dass die Wellenlänge weniger als 1300 nm betrug; Daher haben wir die Wachstumsbedingungen verfeinert. Ein 2,5 Monolayer (ML) dickes InAs wurde bei 520 °C gezüchtet und mit einem 5 nm dicken In0,15 . bedeckt Ga0,85 Als spannungsreduzierende Schicht bei gleicher Temperatur. Auf diese Schicht folgte eine 15-nm-GaAs-Schicht, die bei einer niedrigeren Temperatur (LT) von 520 °C abgeschieden wurde. Dann züchteten wir die letzte 20-nm-GaAs-Schicht bei einer höheren Temperatur (HT) von 630 °C (wie in Abb. 2a gezeigt).
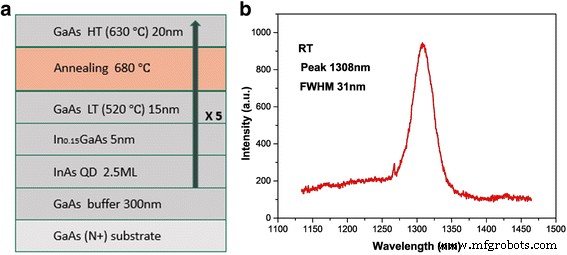
Die Struktur der aktiven Region und das PL-Spektrum. a Die Struktur des undotierten QD-Laseraktivbereichs. b PL-Spektrum der aktiven QD-Laserregion bei Raumtemperatur (RT). Die Emissionsspitze liegt bei 1305 nm und die FWHM bei etwa 31 nm
Für die Testprobe wurden das PL-Spektrum und die Rasterkraftmikroskopie (AFM)-Bilder der Oberfläche der QDs gemessen. Der Emissionspeak von 1308 nm ist auf den Grundzustandsübergang zurückzuführen, und die Halbwertsbreite (FWHM) des Peaks beträgt etwa 31 nm (wie in Abb. 2b gezeigt). Für die AFM-Messung ließen wir eine Schicht aus bloßen Quantenpunkten auf der vergrabenen Schicht von fünf Schichten in der Testprobe wachsen. Die Wachstumsbedingungen sind genau die gleichen wie bei den zuvor beschriebenen vergrabenen Quantenpunkten. Das AFM-Bild der Oberfläche der QDs zeigt, dass die QD-Dichte der getemperten Probe etwa 3,2 × 10 10 . beträgt cm − 2 (wie in Abb. 3a gezeigt). Der Quantenpunkt hat eine durchschnittliche Höhe von 8 nm. Im Gegenteil, die Größe und Verteilung der ungetemperten Quantenpunktprobe sind nicht einheitlich. Die bimodale Größe ist zu sehen und die QD-Dichte beträgt etwa 2,9 × 10 10 cm − 2 . Der Quantenpunkt hat eine Höhe von 5–7 nm (wie in Abb. 3b gezeigt).
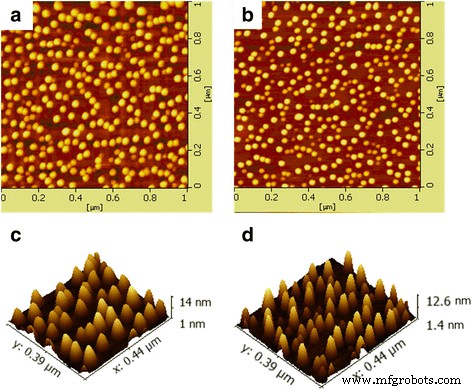
AFM-Bilder der InAs/GaAs-QDs. a Einschichtiges Hochtemperaturglühen. b Kein Glühen. c 3D-Bild mit kleiner Flächengrößenverteilung mit Hochtemperaturglühen. d 3D-Bild mit kleiner Flächengrößenverteilung ohne Tempern
Beim epitaktischen Wachstum eines 1,3-μm-Quantenpunktlasers kann die bimodale Größe von InAs-Quantenpunkten durch das einlagige Tempern für den laseraktiven Bereich gut eliminiert werden. Verglichen mit der ohne Glühen gewachsenen Probe (wie in Abb. 3c gezeigt) wurde die Probe mit einer Glühtemperatur von 680 ° . gewachsen C (wie in Fig. 3d gezeigt) hat eine höhere Quantenpunktdichte und eine gleichmäßige Quantenpunktgröße. Das kann auf folgende Gründe zurückgeführt werden. Zunächst wächst die GaAs-Deckschicht unmittelbar nach dem Wachstum von InAs-Quantenpunkten, so dass sie nur bei einer niedrigen Temperatur wachsen kann, was die Gitterqualität von GaAs verringert und Defekte einführt. Hochtemperaturglühen kann Defekte beseitigen und kann eine hochwertige GaAs-Deckschicht wachsen lassen, die verwendet wird, um das Wachstum von InAs-Quantenpunkten fortzusetzen. Darüber hinaus werden die Versetzungen während der InAs/GaAs-Heterepitaxie erzeugt. In-situ-Einzelschichtglühen kann Versetzungen beseitigen oder die Wachstumsrichtung der Versetzungen ändern und dann die Qualität der InAs-Quantenpunkte verbessern.
Gerätedesign und -vorbereitung
Die Struktur des Lasers bestand aus einer GaAs-Schicht, in die fünf Schichten selbstorganisierter InAs-QD-Kernschichten eingebettet waren. Die 200 nm n-Wellenleiterschicht und die p-Wellenleiterschicht wurden auf der Ober- und Unterseite der QD-Struktur aufgewachsen. Der aktive QD-Bereich und die Wellenleiterschicht wurden zwischen zwei 1,8-μm-p-Typ (Be:4E18) und n-Typ (Si:2E18) Al0,45 . eingeschlossen Ga0,55 Als Schichten. Für den elektrischen Kontakt wurde eine 200-nm-p+-GaAs-Schicht (Be:3E19) abgeschieden (wie in Fig. 4a gezeigt).
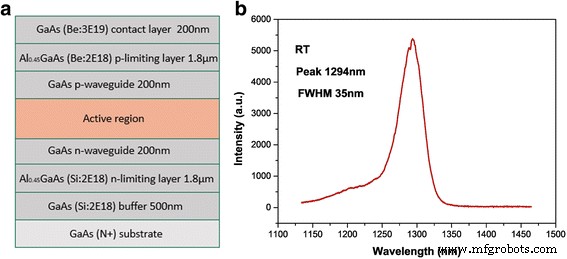
Gerätestruktur. a Epitaxiestruktur des 1,3-μm-Quantenpunkt-F-P-Breitflächenlasers. b PL-Spektrum der epitaktischen Struktur des QDs-Lasers bei RT. Die zentrale Wellenlänge beträgt 1294 nm
Ein kleiner Teil des Wafers wird durch chemisches Ätzen geätzt, um die obere Mantelschicht mit H3 . zu verdünnen PO4 -H2 O2 -H2 O (1:1:4) nach Fertigstellung der Laserepitaxiestruktur [17, 18]. Es ist zu erkennen, dass das PL-Spektrum dieser Probe eine zentrale Wellenlänge von 1294 nm hat (wie in Abb. 4b gezeigt). Die Blauverschiebung der Mittenwellenlänge im Vergleich zum oben genannten Testmuster (wie in Abb. 2a gezeigt) ist auf das Hochtemperaturwachstum (650 °C) während des Wachstumsschrittes des oberen Mantels mit einer Wachstumszeit von mehr als 2 h . zurückzuführen . Es kann auch von der Indium-(In)-Komponente des In0,15 . stammen Gesteinsverwehungen der GaAs-Deckschicht.
Der InAs/GaAs-QD-Laserwafer wurde mit Fotolack beschichtet, um das Oberflächenmuster zu definieren. Die erste Auflage der Fotolithografie bildet ein Rillenmuster von 100 μm. Der Stegwellenleiter wurde durch Ätzen mit induktiv gekoppeltem Plasma (ICP) mit einer Ätztiefe von 2 μm hergestellt, gefolgt von plasmaunterstützter chemischer Gasphasenabscheidung (PECVD), um SiO2 . zu bilden Isolierung. Im nächsten Schritt haben wir auf dem Grat ein Kontaktfenster von 90 μm Breite für die Strominjektion hergestellt. Dann wurde Ti/Pt/Au 51 nm/94,7 nm/1122 nm als p-Elektrode mit Magnetron-Sputtern abgeschieden (wie in Fig. 5 gezeigt). Der Wafer wird auf 120 μm gedünnt, und auf der Rückseite des Wafers wurde ein 50 nm dickes AuGeNi (80:10:10 Gew.-% Legierung) mit einer 300 nm dicken Au-Schicht abgeschieden [19, 20]. Die gesamte Probe wurde bei 460 °C für 10 s getempert, um einen ohmschen Kontakt zu bilden. Während des gesamten Herstellungsprozesses wurde die Probe nacheinander mit Aceton und Isopropylalkohol gereinigt und mit entionisiertem Wasser gespült.
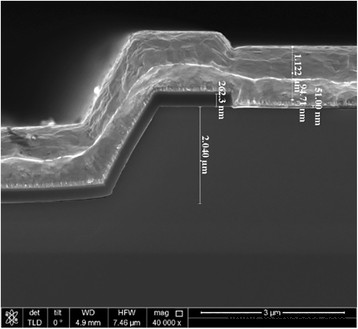
SEM-Bild des Laserquerschnitts. Der F-P-Breitflächenlaser mit einem Standard-Laserherstellungsprozess. Die Ätztiefe von GaAs/AlGaAs beträgt etwa 2 µm. Das PECVD bildete SiO2 beträgt 260 nm
Die elektrischen und optischen Eigenschaften des Geräts wurden gemessen, als der Laser fertig war. Leistung-Strom-Spannung (P −I−V ) wurden die Eigenschaften von Breitbandlasern im Dauerstrich (CW) bei RT getestet. Die Schwellenstromdichte des Lasers beträgt 110 A/cm 2 (wie in Abb. 6a gezeigt) und die zentrale Wellenlänge des Laserspektrums beträgt 1,3 μm (wie in Abb. 6b gezeigt). Aus dem Laserspektrum ist ersichtlich, dass die zentrale Wellenlänge des Lasers bei Raumtemperatur aufgrund des Heizeffekts des Laserbetriebs rotverschoben ist. In dieser Studie kann der Laser bei Raumtemperatur kontinuierlich lasern und erreicht eine gute Schwellenstromdichte sowie eine gute Ausgangsleistung ohne Facettenbeschichtung und Undotierung im aktiven Bereich, was auf die hohe Kristallqualität des Lasers hinweist. Das Einschicht-Annealing-Verfahren hat einen gewissen Effekt auf das Quantenpunktsystem mit bimodaler Größe. Auf dieser Grundlage werden tiefergehende Forschungen untersucht, um die Dichte der QDs weiter zu verbessern, um einen niedrigeren Schwellenstrom, einen geringeren Stromverbrauch, eine höhere Ausgangsleistung und eine hohe charakteristische Temperatur zu erreichen.
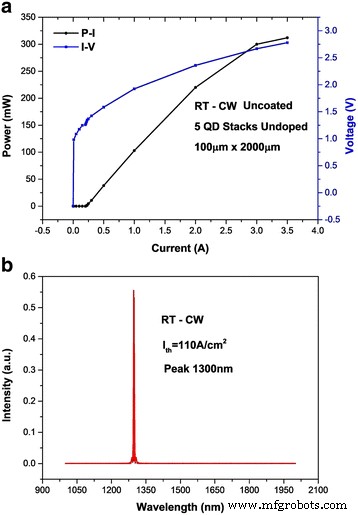
Gerätemessungen. a P-I-V-Kurven eines QD-Lasers. b Die Laserwellenlänge beträgt 1,3 μm
Schlussfolgerungen
Es wurde eine Reihe von Optimierungen der Wachstumsparameter von Quantenpunkten mit hoher Dichte untersucht. Das Single-Layer-Annealing-Verfahren wurde verwendet, um die Bildung des bimodalen Größensystems von Quantenpunkten erfolgreich zu unterdrücken. Wir haben die Glühtemperatur und die Lage der Glühschicht im Detail untersucht. Es wurde eine optimierte Annealing-Temperatur von 680 °C und ein Abstand von der Quantenpunktschicht von 20 nm erreicht. Eine Schwellenstromdichte von 110 A/cm 2 wurde für einen 1,3-μm-InAs/GaAs-QD-F-P-Laser bei Raumtemperatur und Dauerstrichbetrieb mit einer Laserwellenlänge von 1,3 μm erreicht.
Abkürzungen
- AFM:
-
Rasterkraftmikroskop
- Glühen T:
-
Glühtemperatur
- CW:
-
Dauerwelle
- F-P:
-
Fabry–Perot
- FWHM:
-
Volle Breite auf halbem Maximum
- Wachstum T:
-
Wachstumstemperatur
- HT:
-
Hohe Temperatur
- LT:
-
Niedrige Temperatur
- MBE:
-
Molekularstrahlepitaxie
- PL:
-
Photolumineszenz
- QD:
-
Quantenpunkt
- RT:
-
Raumtemperatur
- SEM:
-
Rasterelektronenmikroskop
- WPE:
-
Effizienz der Wandsteckdose
Nanomaterialien
- N,N-Dimethylformamid, das die Fluoreszenz von MXen-Quantenpunkten für die empfindliche Bestimmung von Fe3+ reguliert
- S, N codotierte Graphen-Quantenpunkt/TiO2-Komposite für eine effiziente photokatalytische Wasserstofferzeugung
- Helle Einzelphotonenquelle bei 1,3 μm basierend auf InAs-Doppelschicht-Quantenpunkt in Micropillar
- Erkennen von räumlich lokalisiertem Exziton in selbstorganisierten InAs/InGaAs-Quantenpunkt-Übergittern:ein Weg zur Verbesserung der Photovoltaik-Effizienz
- Wismut-Quantenpunkte in geglühten GaAsBi/AlAs-Quantenbrunnen
- Bipolare Effekte der Photospannung metamorpher InAs/InGaAs/GaAs-Quantenpunkt-Heterostrukturen:Charakterisierungs- und Designlösungen für lichtempfindliche Bauelemente
- Grüne Synthese von InP/ZnS-Kern/Schale-Quantenpunkten für die Anwendung in schwermetallfreien Leuchtdioden
- Ein einfacher Ansatz zur Synthese von fluoreszierenden Kohlenstoffquantenpunkten aus Tofu-Abwasser
- Einstufige Kugelmahlvorbereitung von nanoskaligem CL-20/Graphenoxid für deutlich reduzierte Partikelgröße und Empfindlichkeit
- Interband-Photoleitfähigkeit von metamorphen InAs/InGaAs-Quantenpunkten im 1,3–1,55-μm-Fenster



