Interband-Photoleitfähigkeit von metamorphen InAs/InGaAs-Quantenpunkten im 1,3–1,55-μm-Fenster
Zusammenfassung
Photoelektrische Eigenschaften des metamorphen InAs/In x Ga1 − x Als Quantenpunkt (QD) wurden Nanostrukturen bei Raumtemperatur untersucht, wobei Photoleitfähigkeits- (PC) und Photolumineszenz-Spektroskopie, elektrische Messungen und theoretische Modellierung verwendet wurden. Vier Proben mit unterschiedlicher Stöchiometrie von In x Ga1 − x Als Mantelschicht aufgewachsen:Indiumgehalt x betrug 0,15, 0,24, 0,28 und 0,31. InAs/In0,15 Ga0,85 Als QD-Struktur wurde festgestellt, dass sie im Telekommunikationsbereich bei 1,3 μm lichtempfindlich ist. Als x zunimmt, wurde für alle Proben eine Rotverschiebung beobachtet, die Struktur mit x = 0,31 erwies sich in der Nähe von 1,55 μm als empfindlich, d. h. beim dritten Telekommunikationsfenster. Gleichzeitig wurde nur eine leichte Abnahme des QD-PC für die Erhöhung von x . verzeichnet , was eine gute Photoreaktion bestätigt, die mit der von In0,15 . vergleichbar ist Ga0,75 B.-Strukturen und von GaAs-basierten QD-Nanostrukturen. Außerdem korreliert die PC-Reduktion mit der ähnlichen Reduktion der Photolumineszenzintensität. Durch die theoretische Simulation des Quantenenergiesystems und der Ladungsträgerlokalisation in QDs gewannen wir Einblicke in den PC-Mechanismus und konnten Gründe für die Photostromreduktion vorschlagen, indem wir sie mit dem eigentümlichen Verhalten von Defekten in solchen Strukturen in Verbindung brachten. All dies impliziert, dass metamorphe QDs mit einem hohen x sind gültige Strukturen für optoelektronische Infrarotlichtempfindliche Geräte.
Hintergrund
Metamorphes InAs/In x Ga1 − x Da QD-Nanostrukturen im letzten Jahrzehnt aufgrund vieler Vorteile auf großes Interesse gestoßen sind [1,2,3,4,5,6,7]. Ihr attraktivstes Merkmal ist, dass man durch Aufwachsen der QDs auf einem metamorphen InGaAs-Puffer (MB) eine signifikante Reduzierung der Übergangsenergie zwischen den QD-Niveaus [8] im Vergleich zu herkömmlichen In(Ga)As/GaAs-QD-Strukturen erreichen kann . Dies geschieht aufgrund der Verringerung der InAs-QD-Bandlücke als Ergebnis der Gitterfehlanpassungsreduktion zwischen InAs-QDs und InGaAs-Puffer und damit der Spannung in QDs [9,10,11]. Die Anwendung eines MB als eingrenzendes Material ermöglicht es also, den Emissionswellenlängenwert tiefer in den Infrarotbereich (IR) zu verschieben, insbesondere in die Telekommunikationsfenster bei 1,3 und 1,55 μm, während eine hohe Effizienz beibehalten wird [4, 12, 13]. Darüber hinaus haben metamorphe QDs interessante Eigenschaften gezeigt, wie (i) eine hohe QD-Dichte [14], (ii) die Möglichkeit, die QD- und Benetzungsschicht(WL)-Niveaus weit abzustimmen [10, 15] und (iii) gute Leistungen von aktive Elemente in lichtemittierenden Geräten [16]. Die jüngsten Untersuchungen tiefer Ebenen in metamorphen QDs zeigten jedoch, dass trotz InAs/In0,15 Ga0,85 Als QD-Strukturen mit einer Gesamtdefektdichte nahe der QD-Schicht vergleichbar mit der von pseudomorphen InGaAs/GaAs-QDs, metamorphe Strukturen mit höherem x zeigten höhere Defektdichten [17, 18].
Metamorphe InAs-QD-Strukturen haben erfolgreiche Anwendungen beim Design und der Herstellung von photonischen und lichtempfindlichen IR-Geräten gefunden, wie z. B. Lasern [19, 20], Einzelphotonenquellen [3, 7, 21, 22] und Solarzellen [23 ,24,25]. In(Ga)As-QD-Photodetektoren auf der Grundlage von Interband- und Intersubband-Übergängen werden derzeit aufgrund ihrer Reaktion auf die Bestrahlung bei senkrechtem Einfall aktiv auf eine verbesserte Detektion vom nahen IR- zum langwelligen IR-Bereich untersucht [26,27,28,29,30] . Zum Beispiel können die Intersubband-Übergänge von Elektronen zwischen quantenbegrenzten Niveaus und Kontinuumszuständen durch Einbetten von InAs-QDs in InGaAs-Schichten erzeugt werden [29,30,31,32], da dieses Design es ermöglicht, die Detektionspeakwellenlänge abzustimmen, um die Reaktion durch einen extern angelegten Bias und zur Reduzierung des Dunkelstroms [33, 34]. Bis heute gibt es keine Veröffentlichungen über die Implementierung metamorpher QD-Strukturen in Photodetektoren.
Die Schlüsselrolle bei der Entwicklung dieses Gebietes liegt in der Erhaltung einer hohen Emissionseffizienz und Lichtempfindlichkeit metamorpher QD-Strukturen, die mit denen konventioneller InAs/GaAs-QD-Strukturen mindestens vergleichbar sein müssen [1, 5, 35]. Im Grundlagen- und Anwendungsbereich wurden viele Studien durchgeführt, um das Strukturdesign zu entwickeln [6, 14, 21], um die photoelektrischen Eigenschaften zu verbessern [5, 13] und um dehnungsbedingte Defekte in den Heterostrukturen zu kontrollieren/reduzieren [4, 36, 37].
Daher InAs/In x Ga1 − x Als metamorphe QD-Nanostrukturen sind interessante Nanostrukturen, die eine Emissions- oder Photoempfindlichkeit im 1,3- und 1,55-μm-IR-Bereich ermöglichen [1,2,3,4,5,6,7]. Darüber hinaus wurde von uns zuvor berichtet, dass vertikale InAs/In0,15 Ga0,75 Da QD-Strukturen eine Lichtempfindlichkeit aufweisen, die mit denen auf GaAs-Basis vergleichbar ist [5]. Solche metamorphen Strukturen werden jedoch selten in photoelektrischen Messungen mit lateraler Geometrie untersucht, bei denen der Photostrom durch den Transport von Ladungsträgern in der Ebene über Kanäle zwischen zwei oberen Kontakten verläuft. Im Allgemeinen bilden die QD-Schichten zusammen mit der zugehörigen WL diese Leitfähigkeitskanäle in den mit lateraler Geometrie entworfenen GaAs-basierten Strukturen [38]. Aufgrund dieser besonderen Art der Leitfähigkeit wird QD-Photodetektoren mit lateralem Transport ein Potenzial für eine hohe Photoempfindlichkeit zugeschrieben [39, 40]. Eine eingehende Untersuchung metamorpher InAs/InGaAs-QD-Nanostrukturen in lateraler Konfiguration kann grundlegende Kenntnisse über den Photoleitfähigkeitsmechanismus (PC) und die Effizienz des In-Plain-Carrier-Transports liefern. In unserer aktuellen Arbeit über Defekte in metamorphen QD-Strukturen [17] berichteten wir über laterale PC-Messungen bei tiefen Temperaturen, wobei nur die von Defekten herrührenden IR-Spektrenkanten berücksichtigt wurden. Wir glauben jedoch, dass eine ordnungsgemäße Charakterisierung und grundlegende Untersuchung der Struktur bei Raumtemperatur wertvolle Erkenntnisse für die weitere Verbesserung neuartiger lichtempfindlicher Geräte wie Nah-IR-Photodetektoren, lineare Arrays und Kameramatrizen durch die Implementierung metamorpher QDs liefern kann.
In der vorliegenden Arbeit haben wir die photoelektrischen Eigenschaften des metamorphen InAs/In x . in der Ebene untersucht Ga1 − x Als durch Molekularstrahlepitaxie gewachsene QD-Nanostrukturen mit unterschiedlicher In-Zusammensetzung x , unter Verwendung von PC- und Photolumineszenz(PL)-Spektroskopie, lateralen elektrischen Messungen und Modellrechnungen. Insbesondere konzentrierten wir uns auf die Beobachtung einer möglichen Rotverschiebung der Photoreaktion der QD-Schicht in Richtung IR über 1,3 μm, während die Lichtempfindlichkeit gleichermaßen für In0,15 . erhalten blieb Ga0,85 As- und GaAs-QD-lichtempfindliche Strukturen. Eine hohe Lichtempfindlichkeit im Nah-IR-Wellenlängenbereich bei Raumtemperatur ist ein Hinweis darauf, dass diese Nanostrukturen nicht nur für Geräte, die auf Interband-Übergängen basieren, sondern auch für Intersubband-Photodetektoren, die über 10 μm arbeiten, nützlich sein können.
Methoden
Probenvorbereitung und -beschreibung
Die in Abb. 1 schematisch gezeigten untersuchten Strukturen wurden durch Molekularstrahlepitaxie gezüchtet. Zuerst wurde ein halbisolierendes (100) GaAs-Substrat mit einem 100 nm dicken GaAs-Puffer bei 600 °C bedeckt, gefolgt von der Abscheidung eines undotierten InGaAs-MB mit einer Dicke von 500 nm bei 490 °C. Dann wurden nach der vorherigen Wachstumsunterbrechung von 210 s zum Abkühlen des Substrats 3,0 ML (Monoschichten) InAs bei 460 °C gezüchtet. Schließlich wurden diese selbstorganisierten QDs mit 20 nm undotiertem In x . bedeckt Ga1 − x Wie bei der gleichen MB-Stöchiometrie. Vier Proben mit unterschiedlicher Stöchiometrie von In x Ga1 − x Als Deckschicht wurden hergestellt:Im Inhalt x war 0,15, 0,24, 0,28 und 0,31.
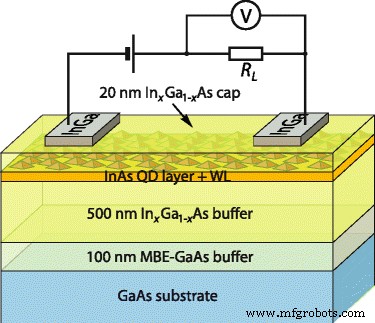
Farbe online. Schema des metamorphen InAs/In x Ga1 − x Als QD-Strukturen und deren Anschluss für die photoelektrischen Messungen
Theoretische Modellierung
Für das Design metamorpher Strukturen sowie das Verständnis des Energieprofils wurden die Berechnungen des Quantenenergiesystems bestehend aus In(Ga)As-QDs, undotiertem MB und Deckschicht mit der Tibercad-Software [41] durchgeführt, die wir demonstriert haben ausreichend sein, um die optischen Eigenschaften von niederdimensionalen Halbleiter-Nanostrukturen zu simulieren [2, 15, 42].
Wir betrachten ein InAs-QD mit kegelstumpfförmiger Form und Größen aus experimentellen Rasterkraftmikroskopiedaten [14]; wir schließen das Vorhandensein von InAs WL ein, dessen Parameter von der In x . abhängen Ga1 − x Als metamorphe Schichteigenschaften [15].
Zuerst werden Dehnungsberechnungen für die Struktur durchgeführt, indem die Dehnungstensorkomponenten der QD berechnet werden, die durch die Fehlanpassung f . induziert werden QD zwischen QD und MB, definiert als
$$ {f}_{\mathrm{QD}}=\left[{a}_{\mathrm{InAs}}\hbox{--} {a}_{\mathrm{MB}}(x)\right ]/{a}_{\mathrm{MB}}(x) $$ (1)wo a MB (x ) ist der Gitterparameter von In x Ga1 − x Als MB und a InAs ist der Gitterparameter von InAs. Bandprofile für QDs und Einbettungsschichten hängen dann von den Verformungspotentialen der relevanten Materialien ab (InAs für QDs und WLs und relaxiertes InGaAs für MB).
Schließlich die Schrödinger-Gleichung
$$ \boldsymbol{H}\psi =E\psi $$ (2)wird in der Hüllkurvenfunktions-Approximation durch einen Einband-Effektivmassen-Ansatz für Elektronen und einen 6-Band-k•p-Ansatz für Löcher gelöst, wobei der 3D-Hamiltonian
. ist $$ \widehat{H}=-\frac{\upeta^2}{2}{\nabla}_{\mathbf{r}}\left(\frac{1}{m\left(E,\mathbf{ r}\right)}\right){\nabla}_{\mathbf{r}}+V\left(\mathbf{r}\right), $$ (3)mit V (r ) ist das 3D-Potenzial.
Eine solche Näherung wird bei der QD-Grundzustandsberechnung als zufriedenstellend angesehen [2]. Auf diese Weise erhält man neben deren Wahrscheinlichkeitsdichten auch Masseniveaus für Elektronen und schwere Löcher. Die Photolumineszenz-Emissionsenergien wurden abgeleitet, indem der Energieunterschied zwischen eingeschlossenen Niveaus für Elektronen und schwere Löcher genommen wurde, reduziert um 20 meV, um exzitonische Effekte zu berücksichtigen.
Eine genauere Beschreibung der Modellrechnungen finden Sie in Lit. [2].
Photoelektrische Charakterisierung
Für die seitlichen photoelektrischen Messungen wurden zwei eutektische InGa-Oberflächenkontakte über 5 × 2 mm großen Stücken der Strukturen abgeschieden. Gemessenes lineares I –V Die in Abb. 2 angegebenen Charakteristiken haben den Kontaktwiderstand bestätigt. Der durch die Proben fließende Strom wurde mit einem Siglent SDM3055-Multimeter unter Verwendung einer Standard-Gleichstromtechnik [43, 44] als Spannungsabfall über einem Reihenlastwiderstand R . gemessen L von 1 MΩ, was viel geringer war als der Probenwiderstand. Der Photostrom wurde durch eine 250-W-Halogenlampe angeregt, die mit einem Prismenmonochromer zerstreut wurde, und PC-Spektren wurden im Bereich von 0,6 bis 1,6 eV aufgenommen [44,45,46]. Die Spektren wurden auf die Anregungsquantenzahl der Lichtquelle normiert. PL-Spektren wurden mit einem 532-nm-Laser als Anregungsquelle mit einer Leistungsdichte von 5 W/cm 2 . aufgenommen . Alle Messungen wurden bei Raumtemperatur (300 K) durchgeführt.

Farbe online. Ich –V Eigenschaften der InAs/In x Ga1 − x Als Strukturen mit x = 0,15 (a ), 0,24 (b ), 0,28 (c ) und 0,31 (d ) für die Dunkelheit (schwarz) und bei einer Beleuchtung von 350 μW/cm 2 (Farbe) bei Energien des PL-Spektrumpeaks (QD-Anregung) und 1,3 eV (effektive Absorption in InGaAs). Einschübe:Photostrom-Abhängigkeit von der Vorspannung
Ergebnisse und Diskussion
PC-Spektren des untersuchten metamorphen InAs/In x Ga1 − x Als QD-Strukturen bei Raumtemperatur sind in Abb. 3 zusammen mit den PL-Bändern angegeben, die die optischen Übergänge zwischen den QD-Grundzuständen zeigen. Die relativen Intensitäten und Positionen der PL-Bänder sind auch in Abb. 4b gezeigt. Auf den PC-Kurven werden Merkmale aufgrund der QDs, der InGaAs-Begrenzungsschichten und der unteren GaAs-Schichten beobachtet. Das Photostromsignal bei den Energien unterhalb des PL-Bandbeginns könnte mit den früher entdeckten Strukturdefekten in Verbindung gebracht werden [17].

Farbe online. PC-Spektren des metamorphen InAs/In x Ga1 − x Als Strukturen bei Raumtemperatur und einer Vorspannung von 11 V für x = 0,15 (a ), 0,24 (b ), 0,28 (c ) und 0,31 (d ). Die Anregungsintensitäten für die schwarzen, roten und blauen Kurven bei 1,3 eV entsprechen 88, 350 und 1400 μW/cm 2 , bzw. Für die Energiepositionierung von QD-Grundzustandsübergängen werden PL-Spektren in willkürlichen Einheiten angegeben. Die vertikalen Pfeile markieren die InGaAs-Bandlücken (ε g ) berechnet in Anlehnung an Paul et al. [48] und Spektralpositionen, bei denen die PC-Abhängigkeiten von der Anregungsintensität gemessen wurden (in Abb. 5)

Farbe online. Modellrechnungen für das metamorphe InAs/In x Ga1 − x Als QD-Strukturen:a Bandprofile in den Strukturen mit unterschiedlichen x entlang der Wachstumsachse; b die realen QD-PL-Bänder und ihre berechneten Spitzenpositionen (gestrichelte Vertikalen); und c Wahrscheinlichkeitsdichten der eingeschlossenen Elektronen und Löcher für das InAs/In0,15 Ga0,85 Als QD. Alle Berechnungen der modellierten Strukturen wurden für 300 K
. durchgeführtDas untersuchte metamorphe InAs/In0.15 Ga0,85 Als QD-Struktur wurde festgestellt, dass sie im Telekommunikationsbereich bei 0,95 eV (1,3 μm) lichtempfindlich ist (Abb. 3a). Als x erhöht, wurde für alle Proben eine Rotverschiebung beobachtet:die Struktur mit x = 0,31 erwies sich in der Nähe von 0,8 eV (1,55 μm) als empfindlich (Abb. 3d), d. h. am dritten Telekommunikationsfenster [47]. Die Verschiebung hängt mit der Verringerung der Gitterfehlanpassung zwischen den Materialien von InAs QD und In x . zusammen Ga1 − x Als Puffer mit einer Erhöhung von x und damit eine Abnahme der Dehnung in QDs. Dies führt zu einer Verengung der InAs-QD-Bandlücke und wiederum zur Rotverschiebung der PL-Bande sowie zum Einsetzen der Photoreaktion in Richtung IR [1,2,3,4,5,6, 19, 35].
Gleichzeitig wurde nur eine leichte Abnahme des QD-Photostromsignals aufgezeichnet, was die Beibehaltung einer guten Photoempfindlichkeit, vergleichbar mit der des In0,15 ., bestätigt Ga0,75 Als Probe. Wie wir kürzlich diskutiert haben [5], sind metamorphe QD-Strukturen mit x = 0.15 zeigen eine Photoantwort, die denen von pseudomorphen InAs/GaAs-QD-Nanostrukturen sehr ähnlich ist. Außerdem korreliert die PC-Reduktion mit der PL-Reduktion, wie in Abb. 3 zu sehen ist.
Ein solcher Effekt für unsere Stichproben erwies sich in Abb. 2 als am bemerkenswertesten, wo das I –V Abhängigkeiten im Dunkeln und unter Beleuchtung an verschiedenen charakteristischen Spektralpunkten von der Vorspannung sind zusammen mit den Photostrom-Abhängigkeiten in den Einfügungen gezeigt. Wie in Abb. 3 impliziert der Fotostromwert nur den fotoinduzierten Teil des Stroms, der aus dem Gesamtstrom unter Beleuchtung durch Subtrahieren des Dunkelstromwerts erhalten wird. Diese Spektralpunkte sind die PL-Bandmaxima und 1,3 eV, bei denen eine effektive Band-zu-Band-Absorption in InGaAs MB auftritt. Sowie für die dunklen I –V Eigenschaften sind diese Abhängigkeiten innerhalb des experimentellen Fehlers linear.
Die beste Lichtempfindlichkeit wurde in der Struktur mit dem minimalen In-Gehalt in den eingrenzenden Schichten gemessen. Es hatte auch den niedrigsten Dunkelstrom. Der Photostromwert bei der angelegten Anregungsstufe (350 μW/cm 2 ) im InAs/In0,15 Ga0,85 Da die Struktur beim Pumpen von MB zwei- bis dreimal über dem Dunkelstrom lag. Die Photoantwort bei QD-Anregung war vergleichbar mit dem Dunkelstrom; Es sollte jedoch berücksichtigt werden, dass unsere Strukturen nur eine QD-Schicht hatten. Die Herstellung der mehrschichtigen QD-Strukturen würde sicherlich zu einer signifikanten Erhöhung der IR-Photoantwort führen. Andere Strukturen mit höherem x zeigte niedrigere Photostromsignale; die detektierten Größen an beiden Spektralpunkten waren ungefähr eine Größenordnung niedriger als die Dunkelstromwerte in einem weiten Bereich der angelegten Spannung. Die niedrigste Photoresponse wurde für InAs/In0,31 . gefunden Ga0.69 Als Struktur mit dem maximalen MB-In-Inhalt.
Höchstwahrscheinlich hängt diese Abnahme der Photoempfindlichkeit mit einer Zunahme der MB-Defektdichte mit x . zusammen , das zuvor für diese Strukturen unter Verwendung thermisch stimulierter Stromspektroskopie auf tiefer Ebene [17] bestimmt wurde, die gut mit der Strukturanalyse solcher Nanostrukturen korreliert [1]. Wir haben berichtet, dass die InAs/In0,15 Ga0,85 Da die QD-Struktur eine Gesamtdefektdichte nahe der QD-Schicht hatte, die mit InGaAs/GaAs vergleichbar war, während andere Strukturen mit höherem In-Gehalt höhere Defektdichten aufwiesen, wie die bekannten GaAs-bezogenen Punktdefektkomplexe EL2, EL6, EL7, EL9 und EL10 in der Nähe der QD-Schicht und drei Ebenen, die auf ausgedehnte Defekte zurückzuführen sind, die sich durch den Puffer ausbreiten.
In Bezug auf die Spektralform (Abb. 3) tritt oberhalb der QD-Anregung die Lichtabsorption und damit die Ladungsträgererzeugung hauptsächlich im MB bei Energien oberhalb der Bandlücke der InGaAs-Einschlussschicht auf ε g , welche Werte für verschiedene x wurden durch eine empirische Formel geschätzt [48]. Es ist jedoch bemerkenswert, dass ein Anstieg der Photonenenergie über ε g führt zu einer leichten Abnahme der Photoreaktion. Dies bestätigt natürlich, dass metamorphe QDs, obwohl sie effektive Rekombinationszentren sind [1, 2, 12, 22], effizienter zum Photostrom beitragen als MB [5, 6, 23].
Um den PC-Mechanismus dieser Besonderheit zu verstehen, sollte man sich Abb. 4a ansehen, in der wir die berechneten QD-Bandenprofile entlang der Wachstumsrichtung für unsere Proben zeigen. Die Berechnungen werden durch das Ergebnis der Quantenenergieniveaus für Elektronen und Löcher validiert:Die erwarteten PL-Emissionsenergien stimmen mit dem experimentell gemessenen PL-QD-Grundzustandsübergang überein (Abb. 4b). In Abb. 4c zeigen wir die simulierten Wahrscheinlichkeitsdichten für eingeschlossene Elektronen und Löcher, die durch die mit der Tibercad-Modellierung berechneten Trägerwellenfunktionen erhalten wurden und eine höhere Lokalisierung für schwere Löcher im Vergleich zu Elektronen anzeigen.
Um zum Photostromsignal beizutragen, müssen durch QD-Interbandabsorption erzeugte Elektron-Loch-Paare durch thermische Emission aus QDs entweichen. In einer früheren Studie [49] wurde festgestellt, dass in metamorphen QDs Elektronen und schwere Löcher gleichzeitig als korrelierte Paare aus QDs entweichen. Darüber hinaus wurde auch gezeigt, dass die Aktivierungsenergie für einen solchen Prozess der Summe der Aktivierungsenergien der beiden Teilchen entspricht [50].
Bei der Untersuchung der thermischen Löschung der PL-Emission aus metamorphen QDs [10, 51] haben wir bewiesen, dass solche Aktivierungsenergien gleich der Summe der Energiedistanzen von den WL-Niveaus und QD-Zuständen sind und von 250 meV für x = 0,15 bis zu 150 meV für x = 0,31. Wie ausführlich in Ref. [51] verursachen diese Werte eine starke Löschung der PL-Emission bei Raumtemperatur durch das thermische Entweichen von eingeschlossenen Ladungsträgern.
Auf dieser Grundlage können wir folgern, dass in QDs angeregte Ladungsträger thermisch zu WL und MB entweichen können:Dort werden Elektronen und schwere Löcher durch die Bandkrümmung in der Nähe von QDs getrennt (Abb. 4a), was das Einfangen von Löchern zurück zu QDs fördert und, während es eine Barriere für Elektronen ist, unterdrückt es dadurch effektiv ihre Strahlungsrekombination. Infolgedessen konzentrieren sich schwere Löcher an der QD-Peripherie (Abb. 4c), während sich Elektronen frei entlang der Potenzialmulde von WL und MB bewegen können, die zur Leitfähigkeit beitragen. Es ist erwähnenswert, dass in Ref. [49] wird diskutiert, dass Träger, obwohl sie während des Fluchtprozesses korreliert sind, bei Raumtemperatur nicht als Exzitonen betrachtet werden können; fortan können sie durch die Bandbiegung in der Nähe von QDs leicht getrennt werden.
Andernfalls werden beim Anregen des MB Nichtgleichgewichtslöcher in den Begrenzungsschichten erzeugt und rekombinieren mit Elektronen. An dieser Stelle sollte erwähnt werden, dass die WL als Leitfähigkeitskanal für Nanostrukturen auf Basis von GaAs bekannt ist [52] und in unseren lateralen Strukturen mit Oberflächenkontakten kein Heteroübergang vorhanden ist, sodass Ladungsträger effizient in der Nähe der Oberflächenebene gesammelt werden.
In Abb. 3 der Abfall des PC-Signals knapp über ε g in den Anstieg bei höheren Energien umgewandelt, z. B. über 1,3 oder 1,1 eV für Probe mit x von 0,15 bzw. 0,31. Dies wurde möglicherweise durch die optische Absorption näher an der Oberfläche und der QD-Schicht verursacht, was zu flacheren Fallen führte. Wie für diese Strukturen durch thermisch stimulierte Stromspektroskopie und Deep-Level-Transient-Spektroskopie festgestellt wurde [17, 18], befinden sich die tieferen Elektronenfallen hauptsächlich in der InGaAs-MB-Schicht, während die flacheren nahe der Oberfläche konzentriert sind (in Bezug auf diese Proben, in der Nähe der QD-Schicht). Die in den flacheren Fallen gefangenen Elektronen können bei Raumtemperatur leichter zurück in das Leitungsband entweichen. Daher sind freie Elektronen in der Nähe der QD-Schicht beweglicher als diejenigen, die tiefer in der MB angeregt werden, und tragen daher stärker zum Ladungstransfer bei. Darüber hinaus können die in der Nähe der Oberfläche erzeugten Elektronen ungehindert auf den WL-Leitfähigkeitskanal übertragen.
Ein ähnlicher Abfall des Photostroms nach einem Anstieg über die GaAs-Bandlücke (nahe 1,4 eV) wurde beobachtet. Dieser Effekt könnte auf die Ladungsträgererzeugung in der Nähe der InGaAs/GaAs-Grenzfläche zurückzuführen sein, von der bekannt ist, dass sie eine höhere Dichte an Defektzuständen als Fallen und Rekombinationszentren aufweist.
Der relative Beitrag verschiedener optischer Übergänge zur Strukturphotoantwort variierte mit der Pumpintensität. Dies ist besser in Abb. 5 zu sehen, die Photostromwerte als Funktion der Anregungsintensität an verschiedenen charakteristischen Spektralpunkten zeigt:dem Beginn des PL-Bandes (resonante Anregung des QD-Ensembles) oder der effizienten Band-zu-Band-Absorption in InGaAs (1,3 eV) und GaAs (1,5 eV).
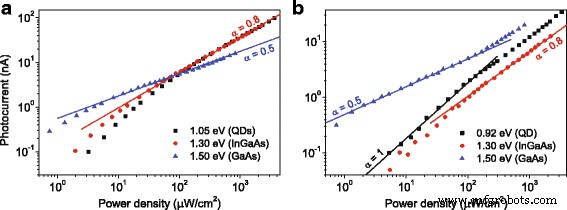
Farbe online. Photostrom vs. Anregungsintensität für InAs/In x Ga1 − x Als Strukturen mit a x = 0,15 und b 0,31. Die Linien entsprechen den Funktionen f (x ) ~ x α
Die Strukturen mit unterschiedlichen In-Gehalten in den Begrenzungsschichten zeigten ähnliche Abhängigkeiten bei äquivalenten Spektralbereichen. Die Band-zu-Band-Anregung in GaAs (1,5 eV) zeigt also bei den meisten Intensitätswerten eine quadratische Abhängigkeit. Dies ist typisch für die Band-zu-Band-Rekombination von Nicht-Gleichgewichts-Ladungsträgern, beispielsweise wenn sie unter den Gleichgewichtsträgern stark vorherrschen [53]:Dies ist in unseren undotierten Strukturen zu erwarten. Die Abhängigkeiten bei der Anregung in den QD- und InGaAs-Begrenzungsschichten sind einander sehr ähnlich, aber verschieden von denen für GaAs. Sie sind bei niedrigen Anregungsintensitäten linear und werden bei höheren Intensitäten sublinear. Dieses Verhalten weist offensichtlich auf die Trägerrekombination mit Shockley-Read-Zentren hin:Die lineare Abhängigkeit wird sublinear, da einige der Zentren bei höheren Trägererzeugungsraten gesättigt sind [54]. Diese Ergebnisse intensitätsabhängiger Messungen zeigen deutlich eine effiziente Erzeugung von Hauptladungsträgern bei relativ geringer Rekombinationsrate in QD-Einbettungsschichten und einer viel höheren Dichte an Rekombinationszentren in GaAs-Schichten. Beispielsweise zeigten während der QD-Anregung in ähnlichen Charakterisierungen lichtempfindliche InGaAs/GaAs-QD-Strukturen eine Intensitätsabhängigkeit als PC (Ich ) ~ Ich 0,25 , die aufgrund einer hohen Rate der nichtstrahlenden Rekombination durch Defektniveaus zusammen mit der strahlenden QD-Rekombination auftrat [40, 55]. Es ist jedoch erwähnenswert, dass die InGaAs/GaAs-Struktur mehrschichtig mit sieben QD-Schichten war
Aus diesen Messungen und ihrer Interpretation lassen sich einige Hinweise für die Verwendung metamorpher QDs zur IR-Detektion hervorheben:(i) bei Verwendung von x> 0,15 sollten fortschrittliche Designs verwendet werden, die eine Kontrolle von dehnungsbedingten Defekten ermöglichen, ähnlich wie bei der Entwicklung metamorpher QDs [19, 20, 37]; (ii) mehrschichtige QD-Stapel (mit mindestens 10 Schichten) sind erforderlich, um einen QD-PC über dem Dunkelstrom zu erhalten [27, 56]; und (iii) da eine höhere Eingrenzung schwerer Löcher für den beim Anregen von QDs erhaltenen Photostrom von Vorteil ist, könnten fortschrittliche Designs mit Barrieren mit höherer Lücke für schwere Löcher in Betracht gezogen werden [51, 57]. Daher können diese Ergebnisse für das Design metamorpher QDs mit dem Ziel der IR-Detektion und die Entwicklung metamorpher QD-Photodetektoren sehr nützlich sein.
Schlussfolgerungen
Photoelektrische Eigenschaften des metamorphen InAs/In x Ga1 − x Als QD-Nanostrukturen wurden bei Raumtemperatur mit PC- und PL-Spektroskopie, elektrischen Messungen und theoretischen Modellsimulationen untersucht. Das untersuchte metamorphe InAs/In x Ga1 − x Da sich QD-Nanostrukturen in den Telekommunikationsfenstern bei 1,3 (x = 0,15 und 1,55 μm (x = 0,31). Der QD-PC sowie die PL-Effizienzen der Strukturen mit höherem In-Gehalt in MB wurden jedoch als niedriger eingeschätzt und dennoch vergleichbar mit denen des InAs/In0,15 Ga0,85 As-Struktur, die eine ähnliche Empfindlichkeit wie InGaAs/GaAs-QD-Strukturen aufweist. Diese Verringerung der Lichtempfindlichkeit hängt mit einer Zunahme der MB-Defektdichte mit x . zusammen . Außerdem lieferten wir dank Modellrechnungen Einblicke in den PC-Mechanismus in der untersuchten Art von QD-Strukturen. All dies impliziert, dass metamorphe QDs mit einem hohen x sind gültige Strukturen für optoelektronische IR-lichtempfindliche Bauelemente, vorausgesetzt, dass einige Bedenken durch Optimierung des Designs der Nanostruktur angegangen werden.
Abkürzungen
- ε g :
-
Bandlücke der InGaAs-Begrenzungsschicht
- E c und E v :
-
Leitfähigkeitsenergie und Valenzbänder
- IR:
-
Infrarot
- MB:
-
Metamorpher Puffer
- ML:
-
Monoschicht
- PC:
-
Lichtleitfähigkeit
- PL:
-
Photolumineszenz
- QD:
-
Quantenpunkt
- R L :
-
Der Lastwiderstand
- WL:
-
Benetzungsschicht
Nanomaterialien
- N,N-Dimethylformamid, das die Fluoreszenz von MXen-Quantenpunkten für die empfindliche Bestimmung von Fe3+ reguliert
- Helle Einzelphotonenquelle bei 1,3 μm basierend auf InAs-Doppelschicht-Quantenpunkt in Micropillar
- Synthese von Pyridin-reichen N,S-codotierten Kohlenstoff-Quantenpunkten als wirksame Enzymnachahmer
- Erkennen von räumlich lokalisiertem Exziton in selbstorganisierten InAs/InGaAs-Quantenpunkt-Übergittern:ein Weg zur Verbesserung der Photovoltaik-Effizienz
- Wismut-Quantenpunkte in geglühten GaAsBi/AlAs-Quantenbrunnen
- Bipolare Effekte der Photospannung metamorpher InAs/InGaAs/GaAs-Quantenpunkt-Heterostrukturen:Charakterisierungs- und Designlösungen für lichtempfindliche Bauelemente
- Ein einfacher Ansatz zur Synthese von fluoreszierenden Kohlenstoffquantenpunkten aus Tofu-Abwasser
- Synthese wasserlöslicher Antimonsulfid-Quantenpunkte und ihre photoelektrischen Eigenschaften
- Einfache sonochemische Synthese in einem Schritt und photokatalytische Eigenschaften von Graphen/Ag3PO4-Quantenpunkt-Kompositen
- Ein vollständiger Überblick über den Datenbus:Connect the Dots!



